Method Article
新規材料の低温磁気伝導測定のための高度な実験方法
要約
We describe the methodology of mechanical exfoliation and deposition of flakes of novel materials with micron-sized dimensions onto substrate, fabrication of experimental device structures for transport experimentation, and the magnetotransport measurement in a dry helium close-cycle cryostat at temperatures down to 0.300 K and magnetic fields up to 12 T.
要約
Novel electronic materials are often produced for the first time by synthesis processes that yield bulk crystals (in contrast to single crystal thin film synthesis) for the purpose of exploratory materials research. Certain materials pose a challenge wherein the traditional bulk Hall bar device fabrication method is insufficient to produce a measureable device for sample transport measurement, principally because the single crystal size is too small to attach wire leads to the sample in a Hall bar configuration. This can be, for example, because the first batch of a new material synthesized yields very small single crystals or because flakes of samples of one to very few monolayers are desired. In order to enable rapid characterization of materials that may be carried out in parallel with improvements to their growth methodology, a method of device fabrication for very small samples has been devised to permit the characterization of novel materials as soon as a preliminary batch has been produced. A slight variation of this methodology is applicable to producing devices using exfoliated samples of two-dimensional materials such as graphene, hexagonal boron nitride (hBN), and transition metal dichalcogenides (TMDs), as well as multilayer heterostructures of such materials. Here we present detailed protocols for the experimental device fabrication of fragments and flakes of novel materials with micron-sized dimensions onto substrate and subsequent measurement in a commercial superconducting magnet, dry helium close-cycle cryostat magnetotransport system at temperatures down to 0.300 K and magnetic fields up to 12 T.
概要
高度なエレクトロニクス技術のための材料プラットフォームの追求は、ハイスループット材料の合成およびその後の特徴づけのための方法が求められています。この追求に関心の新規な材料は、分子線エピタキシー又はより複雑単結晶薄膜堆積技術よりも迅速な方法で直接反応合成1,2-、電気化学的成長3,4、及び他の方法5によって大量に生産することができます化学蒸着。バルク結晶サンプルの輸送特性を測定するための従来の方法は、約1ミリメートル×1ミリメートル×6mmの寸法を有する直方体状の断片を切断し、ワイヤは、ホールバー構成6のサンプルに導く取り付けることです。
特定の材料は、従来のバルクホールバー装置の製造方法は、検体搬送測定に測定可能な装置を製造するには不十分であることを特徴と課題を提起します。これは、することができます所望のサンプルの厚さはわずか数の単層への1程度であるため、または1つは、層状の二次元の積層体を測定することを目的とするため、生成した結晶は、さらに強力な光学顕微鏡下で、リード線を取り付けるには小さすぎる原因近またはサブナノメートルの厚さを有する材料。最初のカテゴリは、例えば、ナノワイヤのため、で構成され、モリブデン酸化物の特定の製剤は、7ブロンズ。第二のカテゴリーは、グラフェン8のような2次元の物質の単一の非常に-数層で構成され、のTMD(MoS 2、WTE 2、 など)、およびトポロジカル絶縁体( の Bi 2 Seの3は 、BiがSbを1-X Teの3 xは 、 等 )。第三のカテゴリーは、層転写、hBNの-グラフェンのhBN 9の最も顕著な三層スタックを介して、手動アセンブリによって二次元の材料の個々の層を積層することにより製造ヘテロ構造で構成されています。
小説の電子の探索的研究lectronic材料が困難な測定サンプル上のデバイスを製造するための適切な方法が求められています。多くの場合、直接反応または電気化学的成長により合成された新素材の最初のバッチは、ミクロンの大きさのオーダーの大きさで、非常に小さな単結晶が得られます。このようなサンプルは、歴史的に、新規な材料のハイスループット研究に障害物を提示する、より簡単に輸送装置の製造のためのより大きな結晶を得るためにサンプルの成長パラメータの改善が必要に金属接点を接続する非常に困難であることが判明しています。材料の迅速な特徴付けを可能にするために、非常に少量の試料のためのデバイスの製造の方法は、すぐに予備バッチが製造されているように、新規な材料の特徴付けを可能にするために考案されています。この方法のわずかな変化は、例えば、グラフェン、のhBNて、TMDSのような2次元材料から剥離した試料を使用するデバイス、ならびにそのようなMAの多層ヘテロ構造を製造に適用可能ですterials。装置は、市販の超伝導磁石、乾燥ヘリウムクローズサイクルクライオスタット磁気輸送システムに挿入するためのパッケージに付着し、ワイヤボンディングされています。輸送測定は、T 12まで0.300 Kまでの温度と磁場で撮影されています
プロトコル
基板の作製
- SiO 2を300nm程度で覆われた高濃度にドープされたp型ドープされたSiから成る4インチのシリコン(Si)ウエハを入手します。この基板構造は、基板がバックゲートとして機能することを可能にします。
- 製図/設計ソフトウェアを使用して、xおよびy方向(電子ビームリソグラフィのための転送サンプルフレーク及びアライメントマークのために基板上に位置ロケータとして使用するために、そのような列挙交配として等間隔特徴と1cm角のパターンを設計します図1)。
- AutoCADなどの製図プログラムで新しいファイルを開きます。
- 以下のマークを描画するポリラインを使用した:i)8.25ミクロン×14.25μmの数字で標識された2.25ミクロン×12.00μmの長方形を交差で形成された十字離間した150ミクロン; II)の角で形成されたグローバルな位置識別子は、16.50×28.50μmの数値キャラで標識された30ミクロンの正方形を接続しましたcters; ⅲ)任意の4の位置識別子から等距離小は15μm×15μmの十字が離れて150μmの間隔をあけ。
- 全ての位置識別子は1cm角の制限内に収まることを確認してください。
- .gdsファイルとしてファイルを保存するか(例えば.DXFなど)別のファイルとして保存し、.gdsファイルに変換します。
- 商用電源4インチSiウェハ上のパターンのコピーを完全にカバーを可能にするために、4インチ×4インチのスペース全体に配列された上記の1cm角のパターンを持つフォトマスクから開発や注文。
- Siウエハ上にリソグラフィによりパターンのフォトレジストマスク。
- フォトレジストスピナーに4インチウエハチャックを取り付けます。それが適切に固定されていることを確認します。
- きれいなピンセットを使用して、スピナーチャック上にSiウエハを配置します。ウェハをチャックに集中していることを確認してください。
- プラスチックピペットを用いて、ポリジメチルベースリフトオフでウェハ全体をカバー(LOR)を抵抗します。
- LORでコーティングされたウェーハをスピン45秒間4,000 rpmで。
- 5分間170℃でのLORでコーティングされたウェハ焼きます。
- 1-2分間のクールなLORでコーティングされたウェハをしてみましょう。
- きれいなピンセットを使用して、スピナーチャック上にLORで被覆されたSiウエハを配置します。ウェハをチャックに集中していることを確認してください。
- プラスチックピペットを用いて、12.3 KAコートを生成するために115℃で60秒間ベーク用に設計された従来のノボラックのポジ型フォトレジストでウェハ全体をカバーしています。
- 60秒間5000rpmでウエハをスピン。
- 60秒間90〜110℃でウエハを焼きます。
- 1-2分間ウェーハを冷まします。
- フォトレジストをマスクに向かって(上を向くように、マスクの下の二層フォトレジスト塗布されたウエハを(ウエハに向けて)下向きにして、マスクのパターン化されたクロムマスクアライナでフォトマスクを配置し、ロードすることにより、コンタクトリソグラフィの準備)。
- ウェハの全体が配列された1センチメートルでパターン化されるように、マスクにウェハの位置を合わせます15; 1cmのパターン。
- UV-広帯域は100mJ / cm 2で、4.8秒間20ミリワット/ cm 2のI線(365nmバンドパスフィルタ)を用いた光(350nmから450nmまで)にさらします。
- 露光に続いて、穏やかな、一貫性に撹拌しながら40〜60秒間、室温で従来のノボラックのポジ型フォトレジスト互換現像液に浸漬することにより、ウエハを塗布フォトレジストを開発しています。
- 現像液の浴への浸漬後、純水でウェハをすすぎます。
- 窒素ガンを使用して、現像されたフォトレジストマスクで被覆されたウェハをブロードライ。
- 電子ビーム蒸発器を用いてフォトレジストマスクで被覆されたウェハ上にデポジットのCr / Au金属。
- 電子ビーム蒸発チャンバベント。
- 場所は、サンプルホルダープレートに伏せてウエハ。
- オープン電子ビーム蒸発器室のドア。
- ウエハを下に向けて基板ホルダ内に試料ホルダープレートを置きます。
- CrおよびAuを間にあることを確認してください蒸着源。
- 電子ビーム蒸発器室のドアを閉じ、少なくとも4×10にチャンバーをポンプ-5 Paの(3×10 -7トル)。
- 0.5オングストローム/秒でのCrの預金50オングストローム。
- 1オングストローム/秒での金の預金750オングストローム。
- 堆積に続いて、チャンバを約20分間冷却します。
- 電子ビーム蒸発チャンバベント。
- サンプルホルダプレートを外し、プレートからウエハを取り外します。
- 電子ビーム蒸発器室のドアを閉じ、チャンバーをポンプ。
- 金属リフトオフを行います。
- アセトン浴を準備または N 4インチウエハを浸漬するのに十分な溶剤メチル-2-ピロリドンに基づきます。ホットプレート上で75℃に溶剤浴を加熱し、この温度で保持します。
- 溶剤浴中の4インチウエハを浸し。溶剤が過度に蒸発しないようにお風呂をカバー。
- ウェハは75で溶媒浴に座ってみましょう6-24時間Cを°。溶剤蒸発のすべてをさせないように注意してください。
- ちょうどピンセットを用いて溶媒の表面の下にサンプルを保持し、繊細なリフトオフ金属を除去するために、ウエハの表面を横切るスプレーボトルからアセトンをスプレー。
- 1-2分間のイソプロパノール浴中でウェハをすすぎます。
- 1-2分間脱イオン水の浴中でウェハをすすぎます。
- 窒素ガンを用いて、ブロードライウエハ。
- ダイスダイヤモンドスクライブやダイシングソーを使用して、個々の試料片にウエハ。ダイシングソーを使用する場合は、PMMAマスクとウェハ表面を保護します。
- フォトレジストスピナーに4インチウエハチャックを取り付けます。それが適切に固定されていることを確認します。
- きれいなピンセットを使用して、スピナーチャック上にウエハを配置します。ウェハをチャックに集中していることを確認してください。
- プラスチックピペットを用いて、ポリメチルメタクリレート(PMMA)でウェハ全体を覆います。
- 5,000 rpmでPMMAで被覆されたウェーハをスピン120秒。
- 120秒間180℃のPMMAで被覆されたウェハ焼きます。
- 1-2分間のクールなPMMAで被覆されたウェハをしてみましょう。
- サイコロ個々の試料片にサンプル約1cmのサイズで×1cmの。
- ウェハ表面から有機残留物を除去します。
- 硫酸と過酸化水素系の剥離剤/有機洗浄剤、アセトンの浴、イソプロパノールの浴、及び脱イオン水の2バスのバスを準備します。
- 基板片は、高周波超音波により攪拌しながら15分間アセトン浴中に浸漬してみましょう。
- イソプロパノール浴に基板ピースを移動し、それは、高周波超音波により攪拌しながら15分間浸してみましょう。
- 脱イオン水浴に基板ピースを移動し、それは、高周波超音波により攪拌しながら15分間浸してみましょう。
- 他の脱イオン水浴に基板ピースを移動し、それは、高周波超音波により攪拌しながら15分間浸してみましょう。
- 硫酸と過酸化水素系の剥離剤/有機クリーナー浴に基板ピースを移動し、それは攪拌しながら60分間浸してみましょう。
- 基板片が有機クリーナー浴であるが、適切に他の浴の内容を配置し、ガラス製品を清掃してください。二つの新しい純水浴場を準備します。
- 有機剥離後、脱イオン水浴中に基板の部分を配置し、高周波超音波により攪拌しながら5分間浸漬させ。
- 他の脱イオン水浴に基板ピースを移動し、それは、高周波超音波処理によって攪拌しながら5分間浸してみましょう。
- 窒素ガンを使用して、ブロードライ基板片を。
2.基板にサンプルフレークの転送
- 合成または共同研究者または商業的供給源からの高品質のバルク試料を得ました。
- サンプル薄片を剥離。
- TAをダイシング標準ウエハのいくつかの部分をカット接着剤を覆う剥離紙を残して、やや大1cmより×3センチPE。
- 接着剤のわずか1cm以内×1センチメートルは、テープの各部分に露出するように鋭利なカミソリを使用して、慎重に剥離紙の一部を除去します。
- しっかりとバルクサンプルに対するテープの一方の準備片の接着部を押してください。バルクサンプルは非常に小さい粉末状片で構成されている場合は、スライドガラス上に少量の試料を注ぎ、スライド上の蓄積したサンプルにテープを押してください。
- ピール接着剤にサンプルの良好なカバレッジを確保するバルクサンプルからテープ。
- テープの別の部分の接着面に対して非常にしっかりとサンプルフレークとテープの接着剤側を押します。
- 離れてテープの二枚の皮をむくと、視覚的にテープの両方の作品にサンプルカバレッジを検査します。
- サンプルフレークはほぼ透明で表示されるまでのプロセス2.2.5と2.2.6を繰り返します。
- しっかりとテープのウィットの接着剤側を押してください基板に付着した試料薄片を残すために、ステップ1ピール離れてテープから準備された基板の一部に対する時間サンプルフレーク。
- 視覚的、光学顕微鏡( 図2)を使用して、適切なサンプルフレークを検索し、ステップ1.2から1.4にパターニング位置マークを利用して基板上の位置に注意してください。
- 原子間力顕微鏡(AFM)を用いて、サンプルフレークの厚さを測定します。サンプルフレークは、厚さ10で、100nm未満である必要があります。
- 預金スパッタ二酸化ケイ素(オプション)。
注:基板にサンプルを付着するファンデルワールス力は、十分な接着性には不十分である場合、この手順は必要なだけです。これを行うと、この紙(ステップ3.3)で説明した手順により、ホールバーにサンプルの製造を禁止します。- スパッタリング装置のロードロックベント。
- オープンロードロックドア。
- 場所試料片を試料ホルダーと場所サンプルにサンプルフレーク転送収容します搬送アームのホルダー。
- ロードロックドアを閉じて、ロードロックをポンプダウン。
- スパッタリングチャンバに試料ホルダーを転送するシーケンスを開始します。
- 2.7×10 -5 Paの(2×10 -7)のベース真空を待ちます。
- DC電源を使用して、転送サンプルフレークを収容する試験片の上にSiO 2を100〜200nmのスパッタ。
- 堆積に続いて、ロードロックにサンプルホルダーを返すようにシーケンスを開始します。
- ロードロックをベントし、試料ホルダーを削除します。
- 試料ホルダーからピースを削除します。
- スパッタリング装置のロードロックをポンプダウン。
- 層状物質のフレークのスタックを準備
注:研究者がステップ2.1から2.4に剥離し、特定され、複数のフレークから成るヘテロ構造を生成することを希望する場合は、このステップが必要なだけです。- Pの小滴を配置することによって、透明な機械的なスタンプを作成します。真空中でガラススライドおよび硬化のolydimethylsiloxane(PDMS)。
- スタンプと層状材料との間の直接接触として機能するように、PDMSの上にポリプロピレンカーボネート(PPC)をスピン。
- ヘテロスタックで使用される層状材料の最初のフレークの上に機械的にスタンプを配置します。
- ダウンサンプルフレークにスタンプを押します。
- PPCとサンプルフレークの間の引力を増加させるために約40℃に、システムを加熱します。
- ゆっくりとPPCに接続されているサンプルフレークでスタンプを持ち上げます。
- ヘテロスタックで使用される層状材料の次のフレークの上に付着したサンプルフレークと機械的にスタンプを置きます。
- 位置合わせされた2つのサンプルフレークを保つようにしてください作り、PPCに接続されているフレークはヘテロスタックで使用される層状材料の次のフレークと接触するようにゆっくりとスタンプを下げます。
- 軽くsamplにスタンプを押し下げEフレーク。
- サンプルフレークの間の引力を増加させるために約40℃に、システムを加熱します。
- ゆっくりスタックに添付されているサンプルフレークでスタンプを持ち上げます。
- 手順を繰り返します2.6.7-2.6.11所望の構造が完了するまで。
- 優しく基板片に層状材料のスタックを含むスタンプを押して、新たな基板にヘテロ構造スタックを転送します。
- 100℃にシステムを加熱します。
- ゆっくりと基板片に付着した層状材料のフレークのスタックを残して、スタンプを持ち上げ。
デバイス構造の3電子ビームリソグラフィ
- 光学顕微鏡を使用して、デバイスのパターニングに使用されるサンプル薄片/フレークスタックの20Xと100Xの倍率でよく集中写真を撮ります。電子ビームパターンDの間に位置合わせのために画像の手順1.2-1.4にパターニング少なくとも一つの位置マークを含みますESIGN。
- 製図/設計ソフトウェアを使用して、電子ビームリソグラフィのための設計を準備します。
- ステップ1.2で生成しオープンデザインファイル。
- インポート20Xステップ3.1からの画像とデザインで適切にスケーリングするためにそれに応じて画像のサイズを調整します。
- サンプルフレークは、パターニングされた基板片に配置されている場所に対応する設計の位置マークに画像の位置を合わせます。
- 繰り返し100Xの画像を使用して、3.2.2と3.2.3を繰り返します。
- 設計プログラムに新しいレイヤーを作成し、露出領域は、ホールバーを残して、エッチング除去されるようにサンプル画像の上に6端子のホール・バー・パターンを描画します。
- パッドに接触するように、サンプル上の端子からリードする電気金属接点のための設計プログラムに別の新しいレイヤーを作成します。
- .gdsファイルにファイルを保存するか、別の形式で保存し、.gdsファイルに変換します。
- SiO 2の場合、パターン6端子のホールバーPMMAマスクが(このステップをスキップコーティング層)が、ステップ2.5で成膜しました。
- PMMAの層をスピン手順1.7.6に1.7.1に概説した手順に従って、試料上に95万の分子量を用いて配合。
- 電子ビームリソグラフィーシステムに負荷サンプル。
- 走査電子顕微鏡(SEM)を使用して、試料11から遠い基板上のアライメントマークを見つけます。
- 使用される電子ビーム描画装置に固有の手順に従って、適切なステージ回転および長さスケールのためのシステムを較正します。
- PMMAの不要な暴露を防止し、ステップ3.2で作成したパターンの中心にビーム位置を中央に電子ビームをオフにします。
- .gdsが電子ビームリソグラフィーシステムのコンピュータプログラムに使用される電子ビームリソグラフィーシステムに固有の手順に従って、所望の解像度を有するステップ3.2.5からのホールパターン層を印刷するためのシステムファイルのロード。
- トンを実行します彼は、システムのマニュアルに従って、電子ビームにPMMAを露光するビーム方式のパターン形成プログラムを電子。
- 電子ビームシステムからサンプルを削除します。
- 6端子のホールバー(SiO 2のコーティング層はステップ2.5で堆積した場合は、このステップをスキップ)に試料をエッチングします。
- 反応性イオンエッチング装置をベント。
- エッチングチャンバー内にロードしたサンプル。
- 約1.3×10 -3 Pa程度 (1×10 -5トル)にポンプシステム。
- サンプルをエッチングするために、サンプル材料に固有のエッチレシピを活用。注:のhBN /グラフェン/のhBNは、スタックは、4標準立方センチメートル(sccm)とO 2と40sccmのCHF 3、60 Wの無線周波数(RF)電力から生成されたプラズマは、約30nm /分のエッチング速度を有します。 1〜2分のエッチングは、通常は十分です。
- エッチング処理が完了すると、エッチングチャンバベント。
- サンプルポンプエッチングチャンバをアンロードします。
- すすぎ1-2分間アセトンの浴のサンプル。
- 1-2分間のイソプロパノール浴中でサンプルを洗浄します。
- 1-2分間脱イオン水の浴でサンプルを洗浄します。
- パターンPMMAは、金属コンタクトの蒸着用マスク。
- PMMAの層をスピン手順1.7.6に1.7.1に概説した手順に従って、試料上に495,000の分子量を用いて配合。
- 手順1.7.6に1.7.1に概説した手順に従って、試料上に95万の分子量を用いて製剤化PMMAの第二の層をスピン。
- 繰り返し3.3.2-3.3.8、ステップ3.2.6からコンタクトパターン層を利用し、この時の手順。
- SiO 2のコーティング層は2.5ステップで堆積された場合、電気接点は、サンプルフレークと直接インターフェースすることを可能にするために、マスクによって露出された領域中のSiO 2をエッチング 。
- ハード5分間180℃でマスクを焼きます。
- 1-2分間のサンプルを冷まします。
- 100ナノメートルのSiO 2、約1~2分、視覚にすべての10~20秒のエッチングの進行をチェックする- PMMAマスクに損傷を与えることなく、サンプルフレークを露出するのに十分な期間、2%のHF浴中で露出したSiO 2をエッチング PMMAが損傷していないままでいることを確認してください。
- PMMAマスクが損傷している場合は、ブロー乾燥後、ステップ3.5を繰り返し、窒素ガンを使用したサンプルを、60秒間、60秒間、次にイソプロパノール、60秒間アセトンでサンプルをすすぐことによって、その後、脱イオン水を、PMMAを削除します。
- ステップ1.5を繰り返すことにより、電子ビーム蒸発器を用いて試料上に堆積物のCr / Au金属。
- ステップ1.6を繰り返して、金属リフトオフを行います。
4.磁気輸送実験を行います
- 銀ペーストで輸送システムのプローブ先端に装填し、乾燥させてくださいする電気輸送システムパッケージにサンプルを付着させることによって製造されたサンプルと電気輸送パッケージを準備します。コンするワイヤボンダーを使用してくださいパッケージのコンタクトパッドへのデバイスのコンタクトパッドから細い金線をNECT。
- 磁気輸送システムにサンプルをロードします。
- 磁気輸送システムに挿入されるプローブチップ上にパッケージを取り付け、それがしっかりと接続されていることを確認。プローブと、すべての3つの温度制御チャネルおよび電気測定チャネルに接続するために、電気測定デバイス(sourcemeters、アンプ内のロックなど)を接続します。
- エアロックをベントし、エアロック内にプローブ先端を挿入し、クランプとOリングを所定の位置にロックします。
注:4.2.3と4.2.8 4.2.4-4.2.6とは彼-3プローブを使用して輸送測定を行うために必要な手順に対応してステップ。 - 水蒸気を除去し、ガス交換弁を開き、圧力を0.67 Paの(5×10 -3トル)未満になるまで、約30分間真空ポンプを使用してシステムをポンプするために330 Kに挿入でミニソーブ温度を設定します。
- 閉じる交換弁とエアロック弁と測定空間からエアロック空間を分離するバルブを開きます。
- 簡単に言うと、オープン(これ以上2秒以下の場合)とプローブ空間にはHe-4少量のガスを導入する交換弁を閉じます。
- 40 Kに25 Kのミニソーブ温度とmainsorb温度を設定します。
- サンプルが視野中心になるまでゆっくりと測定空間にプローブを下げます。
- システムは2 Kに達すると、0.300 K.という低い温度を達成するために、コントローラソフトウェアのヘリウム3凝縮シーケンスを押し
- 等温度、磁場、ゲート電圧の範囲で輸送測定を行います
- 全ての測定のために、同時に、データファイルに、電圧計によって測定された電流源、(供給された電流に平行な)縦方向電圧によって供給される電流を保存する/ロックインアンプこの測定は、試料温度に特化サンプルの近くに配置された温度センサと、磁石が発生する磁界により測定しました。
- ホール測定が所望される場合、データファイルに(供給される電流の横方向)のホール電圧を保存し、ゲート電圧を調整するために、チャネル内のキャリア密度を供給すると、のように、対応する電圧源によって供給されるゲート電圧を保存しますよく、所望のサンプリングレートで、各測定のために。
注:測定のためのサンプリングレートが変化実験パラメータ(温度、フィールド、 電圧など)が掃引されているかどうかに依存します(1大切で開始し、一定の変化率で設定値で終わる)またはステップ(安定化所定の値で)。前者の場合、サンプリングレートは、それらが生成するデータファイルのサイズに基づいて、研究者の判断次第です。後者の場合、測定値は変化実験的パラメータの安定化の際に採取されます。生成とDATを保存ファイルは、データ収集ソフトウェアによって処理されます。
結果
図3は、低温の磁気輸送実験の目的のための典型的なパターン化されたホールバー装置を示しています。上図中の光学像が正常に製作グラフェン/ hBNのホールバーを示しています。下側の画像はランダウレベル(LLS)から生じるランダウアー-Büttiker端状態、量子化されたホール抵抗の値を計算するために使用することができるトランスポート機構として議論される実験調査にデバイスの概略図を示しています本論文では詳細な実験手法の代表的なアプリケーションです。多くの場合、ホールバー構造の製造には、全体的な製造プロセスにおいて多大な挑戦となります。この形状に試料をエッチングする際に含まれるステップをスキップすることができ、これらは、基板片への移行を、以下の通りであるリードは、サンプルフレークに直接取り付けられてもよいです。しかし、不完全な形状は、車を許可しませんそうホールバー構造に試料をエッチングする際に必要な手順をスキップ輸送特性のeful測定は、初期測定に制限されるべきです。
実験パラメータは、12 Tと高い磁場を含む、30 Vの交流電流と同じ高0.300 Kという低い温度、およびゲート電圧は、関連するロックインAC電圧測定値とロックイン増幅器からの発振器によって供給されてもよいです直流電流は、関連するDC電圧測定とソースメータによって供給されてもよいです。直流電流と電流の大きさに対する交流電流は、研究された材料の注意深く抵抗とブレークダウン特性を含む特性に基づいて選択されなければならないパラメータです。ホール抵抗の両端の測定の間に、または電圧の電位差として定義され、印加された電流で除算図3の 6及び2を導きます。縦再sistanceを横切って測定の間に、または電圧の電位差として定義され、図2及び図3に印加される電流によって分割を導きます。完全にグラフェンをカプセル化するのhBNフレークで保護上面とグラフェンホールバーは-6から、T 6、Tおよび-30 Vから30 Vの図4の範囲のバックゲート電圧範囲の磁場で1.7 Kで測定しました。ホール抵抗は、このパラメータ空間内でどのように変化するかを示しています。グラフェン/ hBNのホールバー、ランダウ準位充填に対応するホール抵抗で特に観察可能な台地で測定されたホール抵抗の挙動は、量子ホール効果のモデル例、のみなどのアプリケーションによって観察量子力学的な現象でありますこのホワイトペーパーで説明したように、高度な磁気輸送技術。
図5は、ホール抵抗(R XYで、B = 6 Tにおいて、図4に示すデータのスライスを示しています)バックゲート電圧の関数としてのバックゲート電圧と対応する長手方向の抵抗(R XX)の関数として示します。測定が明らかに示していグラフェンは、整数値ランダウレベルの数nは 、プランク定数 h、電子電荷 eとの量子化されたホール抵抗値と量子ホール効果を発揮します。量子化ホール抵抗プラトーは、長手方向の抵抗を消失と一致しています。

1.基板パターン図。パターン化された金の位置/アライメントマークの(A)試料基板用のリソグラフィでパターン化された位置/アライメントマークのために設計された構成の範囲。(B)コンピュータのレンダリング。 拡大版を表示するには、こちらをクリックしてくださいこの図の。

図2.グラフェンのフレーク。光学顕微鏡で観察のCr / Auの位置マーカーに隣接する単層グラフェンのフレークの画像。 この図の拡大版をご覧になるにはこちらをクリックしてください。
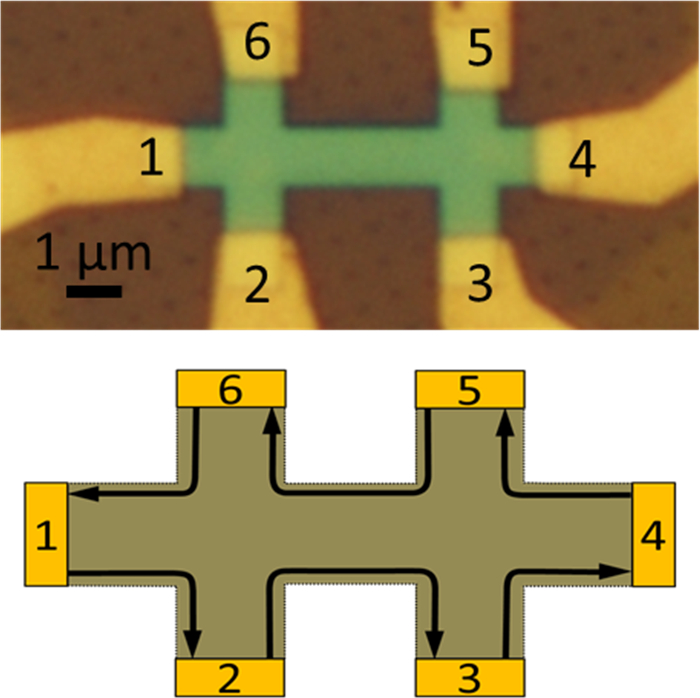
図3.ホールバー素子。上図は、端子に接触金属リードとグラフェン/ hBNのホールバー装置の光学像。下の図は、デバイスの光学像で数値的にラベルされた端末に対応する番号の接触リードとデバイスの概略図。矢印は、現在の生じるランダウアー-Büttikerのエッジ状態の流れを示しています。ES / ftp_upload / 53506 / 53506fig3large.jpg「ターゲット= "_空白">この図の拡大版をご覧になるにはこちらをクリックしてください。
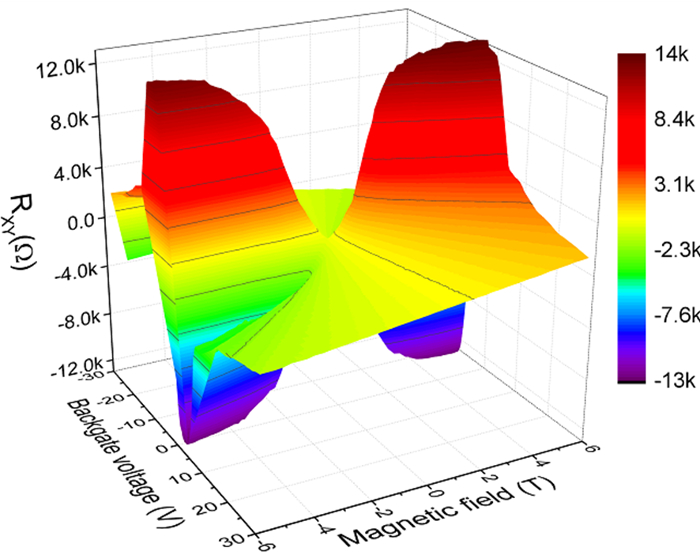
磁場とグローバルバックゲートの関数としてのホール抵抗の図4. 3Dプロット。1.7 Kは量子輸送挙動を示すことで、磁場とグローバルバックゲートの関数としての量子ホール領域におけるグラフェンホールバーのホール抵抗の3Dプロット。 この図の拡大版をご覧になるにはこちらをクリックしてください。

図5.ホール、縦磁気抵抗。ホール(R xyの)と縦(R xxの)修正のグローバルバックゲートの関数としての抵抗ED磁場│B│縦抵抗を消失と一致する量子化ホール抵抗値の量子ホール効果を実証= 6、T。 この図の拡大版をご覧になるにはこちらをクリックしてください。
ディスカッション
適切な組成および構造を確保するために特徴の高品質バルクサンプルの取得後、サンプルは、基板から1cm×1cmの小片に試料の薄片を剥離することによって示される形状にパターニングします。これらは、バックゲートの適用を可能にすることによって、実験的パラメータ空間を増大させるようにSiO 2を300nm程度で覆われた高濃度にp型にドープされたシリコンからなる基板が好ましいです。 10ナノメートルよりも少ない - - 試料が十分に薄くなければならない調整するために、ホール・バー・デバイスの導電チャネルの全体で化学ポテンシャルが十分な電界効果を生成します。サンプルの厚さは十分に標準ウエハーダイシングテープを用いて、バルク材料からフレークを剥離やフレークは計画実験の目的のために十分な厚さになるまで繰り返して新たなテープに付着したフレークを有するテープを押すことによって制御されます。作品を基板に転写サンプルは、参照するには小さすぎます肉眼で、そのように光学顕微鏡は、ホールバーに製造するのに適した転送の部分を同定するために利用されなければなりません。サンプルフレークの厚さは正確に、原子間力顕微鏡(AFM)を用いて測定されるが、十分な経験を持つ研究者は、フレークの色に基づいて、所望の厚さのサンプルを識別することができるかもしれません。
この原稿に記載の技術の手順に注目すべき課題は、サンプルフレークは十分にファンデルワールス力によって作品を基板に接着しない場合に生じます。この場合、(特に溶媒への浸漬時)製造手順のステップの任意の数の中にサンプルフレークは、基板片表面からノックまたは洗浄されます。これは、サンプルフレークがスパッタのSiO 2部分を被覆することによって基材片に固定されていることにより、この原稿に記載された新規の技術によって対処されます。これが行われると、サンプルフレークの部分は直接Aを可能にするために露出されなければなりません金属接点のdherence。これらの接点の堆積に使用されるマスクは、これはサンプルの電気的接触を可能にして、金属コンタクトが堆積される正確な場所にSiO 2をエッチングするであろうように、SiO 2のエッチングのためのマスクとして機能することにより、この目的に合わせて使用することができますまだその面積の大部分の上にスパッタリングされたSiO 2で固定フレークを維持したままフレーク。この手順を実行すると、探索的材料科学研究の追求の一環として、多くの新しい材料の輸送研究のためにできるように、バルク材料の従来の輸送測定のために不十分なサイズの結晶に合成されている小説バルク材料の輸送の測定を可能にします。
このホワイトペーパーで説明する実験技術によって提供される深遠な技術的進歩は、ヘテロ構造の中に、複数の層状材料を積層する能力から来ます。これは、多くの利点を有します。六方晶窒化ホウ素(hBNの)とすることができますキャリアの状態をより正確に、無欠陥の輸送測定を可能にするなど、グラフェンなどの他の2D材料は、空気との相互作用から生じる欠陥の生成物への表面は、サンドイッチに使用します。さらに、興味深い緊急行動は、異なる材料12のスタックから形成されたヘテロ構造において観察することができます。剥離、作品を基板に転送し、適切なサンプルフレークを同定した後、手順は、ポリマーのポリジメチルシロキサン(PDMA)を注意深く使用することによりサンプル移送とポリプロピレンカーボネート(PPC)を含む多層材料のヘテロ構造スタックを生成するために従うことができます。スタッキングが一緒に層状材料の清浄な表面を押すことにより発生したように、この方法は、隣接する材料間の汚染物質としてこれらのポリマーの小球を導入することなく、そのような積み重ねを可能にします。完成したヘテロ構造のスタックは、デバイス製造のための新たな基板片に移すことができます。
デバイスファブリカチオンは、多くのステップを伴う厳格なプロセスです。適切な試料片が複数の個々のフレークから成るヘテロ構造に積層され、必要に応じて、転送され識別され、一旦、ポリマーマスクの適用およびパターン化および製造プロセスに関与するエッチング及び金属堆積物のいくつかの反復のステップは、いくつかを取ることができます日は、単一の高品質のサンプルを作製しました。所望の大きさ、厚さ、及び品質のフレークは、一片が同定された後に決定されなければならない基材片と、ホールバーの寸法上のどこにでも見ることができることにより、この方法の検索、およびプローブの性質に、リソグラフィが行われなければなりません電子ビームリソグラフィによって。電子ビームリソグラフィは、電子の集束ビームのスキャンによるダウンほぼ5ナノメートル寸法の構造の直接書き込みを可能にする先進的なリソグラフィ技術です。具体的なデバイス構造は、各サンプルのために調製されます。等方性エッチングは、プラズマの遺伝子を使用して行われます反応性イオンエッチング(RIE)システムで評価しました。六方晶窒化ホウ素/グラフェン/六方晶窒化ホウ素のスタックのエッチングのために、このプラズマエッチングに用いるガスは、O 2とCHF 3の混合物です。堆積された金属接点が接着層として機能することを意味クロムの薄い層と、その高い導電率のために選択されたAuを750nmでの第二の層、から成り、電子ビーム蒸着チャンバ内の高真空中で連続的に堆積されます。デバイスの製造は、デバイスがパッケージに結合し、実験的測定のための磁気伝導クライオスタット内にロードすることができる点に成功した後、金属リフトオフ以下の金属堆積の後に完了する。
この原稿で説明した製造と実験技術の進歩は、個々のフレークがヘテロ構造に積層してもよいする手順の改善を伴います。さらに、個々のフレークと層状材料の積層の剥離この原稿に記載された技術によって、ヘテロ構造にSは、空気への暴露によって影響されていない材料に限定されています。追加の考慮事項は、このような不活性環境での手順の多くを引き受けるように、このような遷移金属ジカルコゲニドとBi-カルコゲナイドトポロジカル絶縁体として、酸化によって破壊される材料のために取られなければなりません。磁気輸送システムは、強い磁石と低温クライオスタットが操作されているように、より強力な実験的な測定能力につながる、改善が見ていきます。
開示事項
The authors declare no competing financial interests. Commercial materials, instruments and equipment are identified in this paper to specify the experimental procedure as completely as possible. In no case does such identification imply a recommendation or endorsement by the National Institute of Standards.
謝辞
This work is supported by the National Institute of Standards and Technology of the United States Department of Commerce.
資料
| Name | Company | Catalog Number | Comments |
| Cryogenic Limited 12 T CFMS | Cryogen Limited | CFM-12T-H3- IVTI-25 | Magnetotransport system customized with modulated field magnet (step 4) |
| 7270 DSP Lock-in amplifier | Signal Recovery | 7270 | lock-in amplifier for source/drain and voltage measurements (step 4) |
| GS200 DC Voltage/Current Source | Yokogawa | GS200 | Voltage source for gate voltage application (step 4) |
| 2636B System Sourcemeter | Keithley | 2636B | Sourcemeter for source/drain and voltage measurements |
| DWL 2000 Laser Pattern Generator | Heidelberg Instruments | DWL 2000 | Generate chrome mask for lithography of substrate location/alignment feature pattern (step 1.3) |
| Suss MicroTec MA6/BA6 Contact Aligner | Suss | MA6 | Used for the lithography of substrate location/alignment feature pattern (step 1.4.12) |
| JEOL Direct Write Electron Beam Lithography System | JEOL | JBX 6300-FS | Perform high-resolution lithography of devices |
| Discovery 550 Sputtering System | Denton Vacuum | Discovery 550 | Perform SiO2 sputtering (step 2.5) |
| Infinity 22 Electron Beam Evaporator | Denton Vacuum | Infinty 22 | Perform Cr/Au deposition (steps 1.5 and 3.7) |
| Unaxis 790 Reactive Ion Etcher | Unaxis | Unaxis 790 | Etch sample into Hall bar structure (step 3.4) |
| PMMA 495 A4 | MicroChem | PMMA 495 A4 | Polymer coating/electron beam mask for lithography (step 3.5.1) |
| PMMA 950 A4 | MicroChem | PMMA 950 A4 | Polymer coating/electron beam mask for sample dicing and lithography (steps 1.7.3, 3.3.1, and 3.5.2) |
| S1813 positive photoresist | MicroChem | S1813 G2 | Positive photoresist (step 1.4.8) |
| LOR resist | MicroChem | LOR 3A | Lift off resist (step 1.4.3) |
| 1:3 MIBK:IPA PMMA developer | MicroChem | 1:3 MIBK:IPA | PMMA developer |
| MF-321 Developer | MicroChem | MF-321 | Novolac positive photoresist-compatible developer solution (step 1.4.15) |
| Diglycidiyl ether-terminated polydimethylsiloxane | Sigma Aldrich | SA 480282 | For layered material stacking (step 2.6.1) |
| Polypropylene carbonate | Sigma Aldrich | SA 389021 | For layered material stacking (step 2.6.2) |
参考文献
- Doty, F. P. Properties of CdZnTe crystals grown by a high pressure Bridgman method. Journal of Vacuum Science & Technology B. 10 (4), 1418-1422 (1992).
- Ikesue, A., Kinoshita, T., Kamata, K., Yoshida, K. Fabrication and optical properties of high-performance polycrystalline Nd-YAG Ceramics for Solid-State Lasers. Journal of the American Ceramic Society. 78 (4), 1033-1040 (1995).
- Elwell, D., Scheel, H. J. Crystal Growth From High-Temperature Solutions. , Academic Press. London. (2011).
- Doty, F. P. Properties of CdZnTe crystals grown by a high pressure Bridgman method. Journal of Vacuum Science & Technology B. 10 (4), 1418-1422 (1992).
- Ikesue, A., Kinoshita, T., Kamata, K., Yoshida, K. Fabrication and optical properties of high-performance polycrystalline Nd-YAG Ceramics for Solid-State Lasers. Journal of the American Ceramic Society. 78 (4), 1033-1040 (1995).
- Elwell, D., Scheel, H. J. Crystal Growth From High-Temperature Solutions. , Academic Press. London. (2011).
- Therese, G. H. A., Kamath, P. V. Electrochemical Synthesis of Metal Oxides and Hydroxides. Chemistry of Materials. 12, 1195-1294 (2000).
- Capper, P. Bulk Crystal Growth - Methods and Materials. Handbook of Electronic and Photonic Materials. , Springer. New York. 231-254 (2007).
- Seiler, D. G., Becker, W. M., Roth, L. M. Inversion-Asymmetry Splitting of the Conduction Band in GaSb from Shubnikov-de Haas Measurements. Physical Review B. 1, 764-775 (1970).
- Greenblatt, M. Molybdenum Oxide Bronzes with Quasi-Low-Dimensional Properties. Chemical Reviews. 88, 31-53 (1988).
- Novoselov, K. S., et al. Two-dimensional gas of massless Dirac fermions in graphene. Nature. 438, 197-200 (2005).
- Wang, L., et al. One-Dimensional Electrical Contact to a Two-Dimensional Metal. Science. 342, 614-617 (2013).
- Giessibl, F. J. Advances in Atomic Force Microscopy. Reviews of Modern Physics. 75, 949-983 (2003).
- Smith, K. C. A., Oatley, C. W. The Scanning Electron Microscope and its Fields of Applications. British Journal of Applied Physics. 6, 391-399 (1955).
- Geim, A. K., Grigorieva, I. V. Van der Waals heterostructures. Nature. 499, 419-425 (2013).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved