Method Article
Tek basamaklı nanometre elektron ışını litografi bir sapma düzeltilmiş tarama transmisyon elektron mikroskobu ile
Bu Makalede
Özet
İki yaygın olarak kullanılan elektron ışın direnir içinde tek haneli nanometre desenleri tanımlamak için bir sapma düzeltilmiş tarama transmisyon elektron mikroskobu kullanın: Poli (Metil metakrilat) ve hidrojen silsesquioxane. Karşı koymak desenleri tercih hedef malzemelerinde kalkış, aşındırma, plazma kullanarak tek basamaklı nanometre sadakat ile çoğaltılabilir ve organometallics tarafından infiltrasyon karşı.
Özet
Elektron ışını litografi geleneksel kullanımının uzantısını direnir ve pozlama aracı olarak bir sapma düzeltilmiş tarama transmisyon elektron mikroskobu istihdam ederek tek basamaklı nanometre boyutları için desen aktarma işler göstermektedir. Burada, iki yaygın olarak kullanılan elektron ışını direnir, tek basamaklı nanometre desenlendirme sonuçlarını mevcut: Poli (Metil metakrilat) ve hidrojen silsesquioxane. Yöntem poli (Metil metakrilat) alt-5 nanometre özellikleri ve hidrojen silsesquioxane alt-10 nanometre çözünürlük sağlar. Bu kalıpları yüksek sadakat transfer hedef malzemeler tercih içine metal kalkış kullanılarak gerçekleştirilebilir, plazma etch ve organometallics ile infiltrasyon karşı.
Giriş
Bu el yazması sunulan iletişim kuralı tek basamaklı nanometre çözünürlük desenlerle poli (Metil metakrilat) (PMMA) tanımlamak için rehberlik sağlar ve iki ortak elektron ışını direnir olan hidrojen silsesquioxane (HSQ), kullanılan yüksek çözünürlüklü desenlendirme elektron ışını litografi tarafından. Elektron ışını kontrol etmek için bir desen jeneratör ile outfitted pozlama aracı olarak bir sapma düzeltilmiş tarama transmisyon elektron mikroskobu (kök) kullanarak bu sonuçlar elde etmek. Resist maruz kaldıktan sonra nano desenleri hedef malzemeler1böylece etkinleştirme tek basamaklı nanometre çözünürlükte roman cihazları imalatı, çeşitli aktarılabilir.
Önceki çalışmalarda elektron ışını litografi (EBL) desen tanımlama kapasitesine sahip olduğunu göstermiştir resist içinde malzemeleri ile alt-10 nm boyut2,3,4,5,6ölçek. Her nasıl, için boyutları yaklaşık 4 nm, bu gösteriler gerekli kullanımı gibi standart prosedürler yardımcı yapıları7 veya kendini geliştirmek için uzun pozlama süreleri8direnir. Bunlar gerektirse de önemli ölçüde diğer nanopatterning, elektron ışını ifade9 indüklenen veya tarama prob litografi10,11, gibi alt-4 nm çözünürlük, ulaşma yeteneğine sahip kanıtlanmış teknikleri EBL için karşılaştırıldığında daha uzun pozlama süreleri.
Modern özel EBL sistemleri elektron ışınları ile alt-10 nm kararlılık belirleyici desenler çok zor kılan birkaç nanometre uzunluğu ölçeğinde (2-10 nm), nokta boyutları ile üretmek. Buna ek olarak, bizim protokolünü EBL angstrom uzunluğu ölçeklerde malzeme karakterizasyonu için çok optimize edilmiş bir araçtır bir sapma düzeltilmiş kök kullanarak uygular. Bu fark rutin desenlendirme tek nanometre çözüm1ile rekor kırma taş özellikleri sağlar. State-of--art, süre ticari sapmaları düzeltilmiş kök sistemleri milyonlarca dolar aralığında fiyatına, onlar çeşitli ulusal Kullanıcı tesislerinde kullanılabilir ve bazı maliyet olmadan erişilebilir.
Protokol
1. numune hazırlama için direnmek kaplama
Not: Bu çalışmada, PMMA (pozitif ve negatif-tonlu) desenleri tek basamaklı nanometre çözünürlük ile tanımlanır ve HSQ direnir, hangi spin-döküm üzerine piyasada bulunan TEM windows (yaklaşık 50 µm x 50 µm) SiNx veya SiO2 Membranlar ile 5 arasında değişen kalınlıklarda nm 50 nm. Bir veya daha fazla TEM pencere çerçeve (100 µm kalınlığında) işleme bir 3 mm çapında silikon cihazlarında. Bu makale, biz bütün birim olarak TEM çip ve elektron ışını şeffaf membran TEM pencere olarak bakın.
- O2 plazma için 30 temizlik gerçekleştirerek TEM küçük parça--dan herhangi bir organik kalıntı Kaldır s 100 W (yaklaşık 5 sccm O2 akışı, 230 mT odası baskısı).
- Silikon gofret, yaklaşık 2 cm x 2 cm boyutunda bir tutucu olarak TEM küçük parça için iplik resist sırasında kullanmak için bir parça ayırmak.
- (Bkz. Şekil 1) karbon çift taraflı bant yaklaşık eşit uzaklıkta silikon sahibinin Merkezi'nden ve TEM çapı daha biraz daha az ayrılmış iki çizgiler chip yer. İzopropil alkol (IPA) onların yapıştırıcı gücü azaltmak için çizgili durulayın. Bu hassas TEM çip Si sahibinden kaldırma sırasında bozulmaması gereklidir.
- Bu iki zıt kenarlarında sadece karbon teyp çizgili Şekil 1' de gösterildiği gibi bağlı olduğu emin Silikon tutucu üzerinde TEM çip monte.

Resim 1 : TEM çip tutucu iplik direnmek için. TEM çip yüzey alanı iletişim azaltmak sadece iki kenarlardaki silikon sahibine bağlı olduğu ve bu nedenle, yapışma gücü dikkat edin. Bu rakam daha büyük bir versiyonunu görüntülemek için buraya tıklayınız.
2. spin kat parametreleri PMMA (pozitif ve negatif sesi) ve HSQ için direnir
Not: Resist kalınlığı doğrudan TEM çipte küçük olduğu için ve genellikle resist diğer ince tabakalar (Örneğin, SiO2 membran Si filmde), hangi ölçü birimi olmak zordur artığını ölçülen değildir. Bunun yerine, direnmek kalınlığı reflectometry ölçümleri filmlerden döküm bir toplu Si örnek kullanılarak kalibre dönüş hızı tarafından belirlenir. Reflectometry sonuçları, genellikle %20 iyi bir hassasiyetle kök tepeden görüntülerini daraltılmış yapıları tarafından doğrulanmıştır.
- Silikon tutucu spinner chuck dağ ve TEM pencerenin merkezine yaklaşık spinner rotor merkezi ile hizalamak.
- PMMA kapak tüm TEM pencereyi bir damla (yaklaşık 0.05 mL) ile bir pipet kullanarak (A2 950 PMMA seyreltilmiş ANISOL 0.5-1.0 içinde K %) veya HSQ (% 1 katı XR-1541).
- Kullanılan resist bağlı olarak kaplama ve Tablo 1' de gösterilen parametreler pişirme spin izleyin.
- Dikkatli bir şekilde TEM çip silikon sahibinden çıkarın. Resist tekdüzelik bir optik mikroskop kullanarak TEM penceresi üzerinde kontrol edin. Film membran Merkez Bölgesi homojen ise, sonraki adıma geçin; Aksi takdirde, bir taze TEM pencere resist kaplama işlemi yineleyin.
| Karşı koymak | Dönüş hızı (g) x | Film Kalınlığı (nm) | Fırın sıcaklığı (° C) | Pişirme süresi (min) |
| Pozitif tonlu PMMA | 60 | 30 | 200bir | 2bir |
| Negatif tonlu PMMA | 60 | 15 | 200bir | 2bir |
| HSQ | 107 | 10 | Gerekli değilb | Gerekli değilb |
| birRef.12 görmek; bbkz: Ref. 13 | ||||
Tablo 1: karşı koymak kaplama ve parametreleri pişirme spin. Spin hız birimleri içinde g x 3-mm çap TEM çip göz önünde bulundurun. Pişirme sıcak tabakta PMMA için gerçekleştirilir. Hiçbir pişirme HSQ13için gereklidir. Bu oda sıcaklığına iplik önce ısınmak gerekir bu yüzden HSQ resist buzdolabında, depolanır.
3. yük örnek kök, penceresinin koordinatları harita ve yüksek çözünürlüklü odaklanarak gerçekleştirmek
- Işın en iyi şekilde örnek üst kısmında odaklandığı resist-vakum arabirimi gelen ışın, yüzleri emin kök örnek kutusunda resist kaplı TEM çip monte. Ayrıca, TEM pencerenin yaklaşık x - ve y - ekseni ile kök sahne alanı'nın hizalandığından emin olun. Bu TEM penceresine gezinme kolaylaştıracaktır.
- TEM çip mikroskop ve örnek odasında kirletici madde azalttığı gecede pompa yüklemek.
- Öyle ki ışın 100'den fazla µm (yanlışlıkla maruz önlemek için) TEM pencerenin merkezine uzak sahne alanı (x, y) koordinatlarına taşıyın. Geçerli kök sonda kiriş ve 34 pA için enerji ve 200 ayarla keV, anılan sıraya göre.
- (Sabit ışın, z-karşıtlık modu ve orta açı anüler karanlık alan dedektörü) görüntüleme kırınım modunda büyütme yak²n bir TEM pencerenin kenarına bulmak kolay hale getiren kirişli 30 kX için ayarlayın.
Not: TEM pencere kenarları görüntüleme modunda da bulunabilir. Işın taranmış bir görüntü oluşturmak için gerekli değildir bu yana daha hızlı, çünkü biz kırınım modunu kullanın. - Bir pencerenin kenarına kırınım resmine görülmektedir kadar TEM pencereye doğru gezinin. Pencere kenarları ve kaydı gezinmek (x, y) koordinatları TEM penceresinin dört köşe.
- Vasıl belgili tanımlık son pencere köşe, 50 kX için büyütmeyi ve kaba odaklanarak gerçekleştirmek kırınım crossover kadar sahne z koordinatını (z-yükseklik ayarı) hareket ettirerek pencere membran üzerinde desen yönlendirme görülmektedir. Daha sonra iyi objektif lens geçerli ayarlayarak odaklanarak gerçekleştirin.
- Büyütmeyi 180 kX için. Odak, ayarlamak Şekil 2Biçinde gösterildiği gibi pencere membran sapmaları düzeltilmiş kırınım görüntüsünü elde etmek için stigmation ve sapmaları düzeltme ayarları. Odaklama bu yöntem Ronchigram Yöntem14olarak bilinir.

Resim 2 : TEM pencere membran görüntüsünü kırınım. (A) odaklı ama tır görüntü. Bu görüntü için sapmaları-düzeltme ayarlarını tarafından yakından aralıklı kırınım saçaklar kanıtladığı gibi en uygun değildir. (B) düzgün Yaylası kırınım deseni gösterilen pozlama hazır stigmated görüntü. Bu rakam daha büyük bir versiyonunu görüntülemek için buraya tıklayınız.
4. bir desen jeneratör sistemi ile donatılmış bir sapma düzeltilmiş kök kullanarak desenleri ortaya çıkarmak.
Not: bilgisayar destekli tasarım (CAD) yazılımıyla tanımlanan desenleri ortaya çıkarmak için elektron ışını pozisyon denetleyen bir desen jeneratör sistemi ile (PGS), bu çalışmada kullanılan sapmaları düzeltilmiş kök bulunuyor. Doz pozlama noktaları (adım boyu) ve çekim hızı her noktası arasındaki aralığı tanımlayarak kontrol edilir. Tablo 2 bu protokol için kullanılan Pozlama Parametreler özetlenmiştir. Desen "sürekli modu," TEM penceresinde ortasındaki maruz kalan bu çalışmada kullanılan kök bir ışın blanker dahil değildir beri. Önce ve maruz kaldıktan sonra PGS ışını görüş alanı (FOV), herhangi bir kullanıcı tarafından tanımlanan noktada desen alan uzak tercihen konumlandırır. Biz bu protokol için sağ üst ve alt doğru köşe-in FOV ilk ve son ışın konumlarını, sırasıyla kullanın.
| Karşı koymak | Nokta pozlama | Satır pozlama | Alan pozlama | ||
| Doz (fC/nokta) | Adım boyu. (nm) | Doz (nC/cm) | Adım boyu. (nm) | Doz (µC/cm2) | |
| Pozitif sesi PMMA | 10-100 | 0,5 | 2 – 8 | 0,5 | 2.000 |
| Olumsuz sesi PMMA | 50-500 | 0,5 | 20-40 | 0,5 | 50.000-80.000 |
| HSQ | 10-100 | 0,5 | 10-20 | 0,5 | 20.000-30.000 |
Tablo 2: pozlama parametreleri PMMA (pozitif ve negatif sesi) ve HSQ için direnir. Beri en uygun doz değerleri belirli desen tasarımı üzerinde bağlıdır ve özellik boyutları hedef gösterilen değerler genel, vardır.
- Sahne alanı resist herhangi bir kaza sonucu maruz önlemek için kiriş kapı Vanayı kapat. 34 pA ışın geçerli olduğunu ve büyütme 180 kX olduğunu doğrulayın.
- FOV merkezi 5 mikron pencerenin ortasına uzak olması önceden kaydedilmiş penceresinin köşe koordinatları sahne alanı taşımak için kullanın. Kiriş kapı Vana ve odak bu noktada adım 3.6 içinde açıklanan Ronchigram yöntemini kullanarak açın.
- Kiriş kapı Vanayı kapat. Sahne Alanı ' FOV TEM pencerenin ortasına yerleştirmek için taşıyın. 18 kX (FOV biçimlenme bir 5 mikron x 5 µm karşılık gelen) için büyütme oranını değiştirme. Işın kontrol PGS için transfer ve ışın (Bu protokol için sağ üst köşedeki kullandığımız) desen alan uzak herhangi bir konuma.
- İlk ve son ışın pozisyonlarda resist pozlamayı önlemek için hızlı bir şekilde aşağıdaki eylemleri gerçekleştirin.
- Kapı valfi açın ve ışın odak (aynı derecede içinde Şekil 2B) ilk ışın konumda olup ışını kırınım deseni görüntü gözlemleyerek doğrulayın. Desen kullanır.
- Pozlama tamamlandığında, kırınım deseni görüntü odak son ışın konumda kalır, kontrol edin. Son olarak, kapı Vanayı kapat.
- TEM yonga kök çıkarmak.
5. Kalkınma ve kritik nokta kurutma karşı
Not: Kullanılan resist üzerinde geliştirme süreci bağlıdır. 5.1, 5.2 ve 5.3 adımları gelişmekte olan süreci olumlu tonlu PMMA, negatif-sesi PMMA ve HSQ, için sırasıyla açıklanmaktadır. Ancak, tüm direnir payı nedeniyle yüksek-boy oranı bu iletişim kuralı ile fabrikasyon desen desen çöküşü önlemek gerekli olan işlemi, kurutma aynı son kritik nokta. Kritik noktası (GBM) kurutma sıvı CO2 hangi su ile karışan değil çalışma sıvı kullanır. Sonuç olarak, örnek dehidratasyon (adım 5.4-5.7) ACS reaktif sınıf izopropil alkol (IPA) kullanımını gerektirir.
- Pozitif tonlu PMMA15geliştirme: 3:1 çözüm IPA:methyl izobütil-keton (MIBK) ile 100 mL kabı hazırlamak. Kabı (0 ° C'de bir buz banyosu daha düşük bir maliyet alternatif olduğunu) 0 ° C'de bir banyo sirkülatörün yerleştirin ve sıcaklık equalized kadar bekleyin. TEM çip cımbız bir çift ile kapmak ve hafifçe adım 5.4 ile 30 s. devam et için soğuk çözümde karıştırın.
- Negatif tonlu PMMA16tane geliştirme: hafifçe MIBK TEM yongasında (24 ° C) Oda sıcaklığında 2 dk. aseton çözümünü örnek aktarmak için ilave edin ve 3 dk. Proceed adım 5.4 ile karıştırın.
- HSQ13/ geliştirme: TEM çip 1 wt % NaOH ve 4 wt % NaCl, 24 ° C'de 4 dk için içeren bir "tuzlu" deiyonize su çözüm ilave edin Saf deiyonize su (durulama tuzlu Geliştirici) 2 min için yongasında karıştırın. Adım 5.4 ile devam edin.
- ACS reaktif sınıf IPA TEM yongasında daldırma ve hafifçe için 30 karıştırın s.
- Hızlı bir şekilde TEM çip özel 2" Si gofret Şekil 3Aiçinde gösterilen yerleştirin. TEM çip her zaman transfer sırasında IPA ile ıslak olduğundan emin olun. Yaklaşık 2-3 dakika sonra Şekil 3B' tasvir CPD gofret tutucu derleme kapatın. Bütün birim ACS reaktif sınıf IPA ek 15 dakika tamamen IPA içinde dalmış sırılsıklam bırakın.
- Hızlı bir şekilde taze ACS reaktif sınıf IPA ile ikinci bir konteyner tam CPD gofret tutucu derleme aktarmak ve tamamen IPA içinde dalmış 15dk için bırakın.
- CPD gofret tutucu derleme CPD enstrüman işlem odasına (yaklaştırmayın TEM küçük parça-meli var olmak tamamen IPA batırma) aktarın. Cihazın işletim talimatları CPD işlemini çalıştırın.
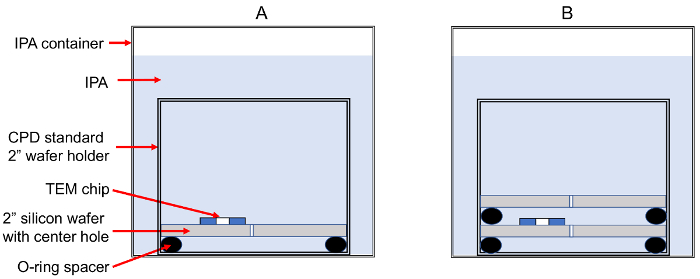
Şekil 3 : Kurum içi çözüm TEM susuzluktan için fiş bir CPD Standart 2" gofret sahibi. (A) TEM çip şematik yan görünüm üzerinde bir özel 2" Si gofret küçük bir delik ile delinmiş (yaklaşık 500 mikron çapında) Center'da sıvı akışı izin vermek. CPD sistem üreticisi tarafından sağlanan bir CPD Standart 2" gofret tutucu gofret uyuyor. (B) ikinci bir özel Si gofret böylece türbülanslı akış CPD işlemi sırasında azaltarak TEM çipi içine alır. İçinde A ve B, CPD gofret tutucu ACS reaktif sınıfta IPA tamamen batırılır. Bu rakam daha büyük bir versiyonunu görüntülemek için buraya tıklayınız.
Sonuçlar
Şekil 4 taş desen pozitif tonlu PMMA (resist maruz kalan bölgelerden sonra geliştirme kaldırıldı) ve negatif tonlu PMMA (resist yıkamaya alanlarından kaldırıldı) gösterir. TEM windows yaklaşık 30 nm kalın PMMA direnmek için pozitif tonlu PMMA oluşuyordu (15 nm negatif tonlu PMMA için kalın) spin bir 5 nm kalın SiNx membran üzerinde döküm. İnce bir metal film (10 nm AuPd üzerinde 5 nm Ti) kontrast kök görüntüleme sırasında geliştirmek için pozitif tonlu PMMA gelişimi sonra yatırılır. En küçük adım desen 17,5 pozitif tonlu PMMA için en küçük izole ortalama Özellik 2,5 ± 0.7 nm (Şekil 4 c, 4 D), iken nm (Şekil 4F). En küçük adım desen 10,7 negatif tonlu PMMA için en küçük izole ortalama Özellik 1.7 ± 0.5 nm (Şekil 4 g), iken nm (Şekil 4J).

Şekil 4 : Sapmaları düzeltilmiş elektron ışını litografi, pozitif ve negatif-tonlu PMMA. (İnce bir film 10 nm AuPd üzerinde 5 nm Ti bu şekilde gösterildiği tüm pozitif tonlu PMMA örgülerine yatırılır.) (A) SEM görüntüsü rasgele pozitif tonlu PMMA modellerinde. (B) negatif tonlu PMMA rasgele desen TEM görüntüsü. (C, D) SEM görüntüleri en küçük pozitif tonlu PMMA, ortalama delik çapı 2,5 ± 0.7 Nm ile delikler desenli. (E, F) SEM görüntüleri pozitif tonlu PMMA ile 21,5 perdesini tanımlanan delik dizilerin nm (E) ve 17,5 nm (F). (G, H) Negatif tonlu PMMA ortalama ayağı çapı 1,7 ± 0.5 Nm (G) ve 1.8 ± 0.5 nm (H) ile 20 nm pitch ile dizide ayağı TEM görüntüleri. (I, J) Negatif tonlu PMMA TEM görüntüleri dizileri 15.2 ve 10.7 nm perde, sırasıyla ayağı. Tüm ölçek çubukları vardır 40 nm. Bu rakam yeniden Manfrinato, V.R., Stein, A., Zhang, L., Nam, C.-Y., Yager, K.G., Stach, E.A ve siyah, tomografi Aberration-Corrected elektron ışını litografi bir nanometre uzunluğu ölçekte. Nano Letonyalı. 17 (8), 4562-4567 (2017). Bu rakam daha büyük bir versiyonunu görüntülemek için buraya tıklayınız.
Şekil 5 HSQ resist üzerinde tanımlanan desenler görüntüler. HSQ litografi için kullanılan TEM penceresi bir 27 nm kalın Si membran üzerinde döküm yaklaşık 10 nm kalın HSQ resist spin oluşuyordu. Pozlama ve resist geliştirme, 3-4 nm pencerenin HSQ serbest bölgelerde (yıkamaya alanları) ultra-ince Si tabakasının çıkarıldı sonra endüktif tarafından bir odası baskısı 50 sccm HBr ve 20 sccm Cl2 gaz karışımı kullanarak plazma (ICP) gravür birleştiğinde 10 mT (önyargı ve ICP gücü 60 W ve 250 W, sırasıyla). Şekil 5A kısa dikey çizgiler, dört satırlarından oluşur. İki satır satır doz ile maruz kaldılar üst katlanarak 120 nC/cm (0 tasarlanmış nm genişliği bu satırları için) için 2'den çıktı. Alt iki satır katlanarak 60.000 μC/cm2 ' ye (5 nm kadar tasarlanmış geniş ve 200 nm dikdörtgenler) 3000 adım attı bir alan dozla maruz bırakıldı. Şekil 5B Şekil 5Aalt satırda merkezi bölgenin yakınlaştırılmış bir görüntüdür. İki en soldaki, dört merkezi ve dört en sağdaki satır 23,300, 27,300 ve 32.000 μC/cm2, bir alan dozu ile sırasıyla maruz kalmışlar. Ortalama ölçülen genişliği 7 dört merkezi çizgiye sahip nm.

Şekil 5 : Sapmaları düzeltilmiş elektron ışını litografi, HSQ resist. (Bu şekilde kullanılan TEM penceresi 27 nm-kalın sı yapılmıştır. Sonra HSQ geliştirme, endüktif Eşleşmiş Plazma gravür 3-4 nm si HSQ tarafından kapsanmayan alanları kaldırmak için kullanılmıştır.) (A) dikey çizgiler dört satır TEM görüntüsü katlanarak 120 nC/cm (en iyi iki satır) ve 3000-60.000 μC/cm2 (alt iki satır) den 2 farklı dozlarda maruz. Işın adım boyu 0.5 oldu nm tüm satırları için. (A) alt satırda merkezi alan (B) yüksek büyütme TEM görüntüsü. Merkezi 4 satır ortalama grubunuz ölçülen genişliği 7 nm ve 27,300 μC/cm2bir alan dozu ile maruz kaldılar. Bu rakam daha büyük bir versiyonunu görüntülemek için buraya tıklayınız.
Tartışmalar
İletişim kuralı en kritik adım pozlama önce elektron ışını duruluyor vardır. Bu yüksek çözünürlüklü desenlendirme elde etmek gereklidir. Birden çok pozlamayı (TEM çip birden fazla pencere vardır ve her desenlimesela ) işlemi sırasında daha önce pozlama alan çoğu, 5 mikron mesafeden her maruz kiriş yönlendirmesi önemlidir. Protokolü de önce ve pozlama bazı defocusing desenlendirme sırasında örneğin nedeniyle oluşup bir kararlılık sağlayan iki aşırı pozisyonlarda desenlendirme çevrenin (köşeler) üst ve alt, sonra ışın netlemeyi kontrol için adımları içerir bir membran desenlendirme bölgede yerel olarak eğik.
Bu iletişim kuralı bir önemli adım kritik noktası (GBM) kurutma kurutmak için kullanıyor maruz geliştirme sonra örnekleri karşı koymak desenleri. Bu adım desen desenli yapıları (desenliYani, resist yanal boyutları kalınlığı küçük) yüksek en boy oranı nedeniyle sık sık çökecek. CPD sistemlerin çoğu bir standart 2" gofret tutucu kaynağı. Ancak, beri TEM cips çok küçük ve oldukça hassas desenli yapılardır, onlar daha büyük örnekler için tasarlanmış sahipleri yerleştirildiğinde CPD işlemi sırasında zarar görmüş olabilir. Şekil 3 TEM CPD fiş bir standart gofret tutucu kullanarak şirket içi bir çözüm gösterir. Merkezi, akışı sağlayan delikle iki gofret TEM yonga içine alın ve türbülanslı akış CPD işlemi sırasında korumak.
En iyi resist film kalınlığı belirlenmesi rakip gereksinimleri dengelemek için çalışır. Bir yandan, en yüksek çözünürlükte elde etmek ve desen çöküşü önlemek için mümkün olduğunca ince olmalı, ama öte yandan, kalkış ve dağlama gibi desen aktarma uygulamalar için kalın olmalıdır. Bu iletişim kuralı % 1 kullanır HSQ, en düşük fiyat seyreltme ticari olarak mevcut olan ve laboratuvarda daha fazla olan seyreltme (seyreltilmiş HSQ genellikle için kısmi crosslinking açar bizim deneyim gösterir) tavsiye edilmez. Ancak, % 1'için pozitif tonlu PMMA çünkü seyreltilmiş PMMA tekrarlanabilir sonuçlar vermek, bu iletişimi kullanan (30 nm kalınlık) ve % 0,5 ve olumsuz sesi için % 1 (15 ve 30 nm kalınlığının, sırasıyla). Bu pozitif tonlu PMMA direnmek değil acı desen Daralt negatif tonlu PMMA yaptığı gibi böylece daha ince kalınlık kullanım için olumsuz sesi gösterildiği gibi bulduk Tablo 1. Buna ek olarak, negatif tonlu PMMA e-beam maruz kaldıktan sonra (ve geliştirme önce), ~ %50 kalınlık kaybı yoktur yani negatif tonlu PMMA son kalınlığını ~ 7-15 nm. ( Şekil 4 1.7 ve 1.8 nm özellikleri desen Daralt bu kadar yaklaşık 7 nm resist kalınlığı vardır.) Şekil 4 ' te gösterilen PMMA desenleri CPD adım kullanımı yoktu; Ancak, varsa, bu iletişim kuralını CPD kullanımı PMMA desen geliştirme sonra önerir. Buna ek olarak, biz CPD gerçeğini o daha fazla (daha ince kalınlık elde etmek için) seyreltilmiş olamaz nedeniyle ve kalın HSQ desenleri (Şekil 5 gösterildiği gibi silikon etch içinÖrneğin, gravür maskesi olarak kullanmak için gerekli çünkü HSQ işlemek için kritik olmak bulundu ).
Şekil 4 pozitif tonlu PMMA desenleri Karşıtlık görüntüleme sırasında artırmak için ince bir metal film ile kaplı. Manfrinato ve arkçalışmalarını destekleyici bilgileri. 1 bu metalik kaplama Metroloji desen üzerinde etkisi önemsiz olduğunu gösterir. Benzer şekilde, biz HSQ karşı koymak için Şekil 5 ' te gösterilen sonuçları büyük ölçüde TEM pencere yapısı üzerinde temel Si tabakasının kalınlığı Ultra-ince dayalı belirli seçimi üzerinde bağımlı olmayan olduğunu düşünün.
Bilgimizin en iyi, pozitif ve negatif sesi PMMA1 (Şekil 4) temsilcisi sonuçlar bölümünde açıklanan tüm ölçümler1,7 bugüne kadar literatürde bildirilen en küçük özellikleri şunlardır. , 12 , 16 , 17. Manfrinato ve ark. 1 alt-5 nm desen aktarma, direnmek için geleneksel metal kalkış (pozitif tonlu PMMA) izni ve sıralı infiltrasyon sentez18 ZnO (için negatif tonlu PMMA) kullanarak bir hedef malzeme üzerinden de gösterdi. HSQ için Şekil 5 ' te gösterilen sonuçlar en küçük bildirilen özellikleri7değildir. Ancak, bu iletişim kuralını HSQ tekrarlanabilir özellikleri çözünürlüklerinde 10'dan daha iyi almak için yararlıdır nm ve tek basamaklı desenlendirme silikon yapıları gösterir.
Burada sunulan protokolünü geleneksel elektron ışını direnir PMMA ve HSQ kullanarak tek haneli nanometre çözünürlük ile rasgele yapıları desenlendirme için bir işlem açıklar. Ayrıca, burada ve referans 1 gösterilen sonuçlar böyle desenler yüksek sadakat ile seçim için bir hedef malzeme transfer edilebilir gösterilmektedir.
Açıklamalar
Yazarlar ifşa gerek yok.
Teşekkürler
Bu araştırma merkezi kaynakları fonksiyonel Nanomalzemeler, bir ABD DOE Office, bilim tesisi, Sözleşme No altında Brookhaven Ulusal Laboratuvarı için kullanılan DE-SC0012704.
Malzemeler
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Referanslar
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Yeniden Basımlar ve İzinler
Bu JoVE makalesinin metnini veya resimlerini yeniden kullanma izni talebi
Izin talebiThis article has been published
Video Coming Soon
JoVE Hakkında
Telif Hakkı © 2020 MyJove Corporation. Tüm hakları saklıdır