Method Article
Einstelligen Nanometer Elektronenstrahl Lithographie mit einem Aberration korrigiert Scan Transmissions-Elektronenmikroskop
In diesem Artikel
Zusammenfassung
Wir verwenden eine Aberration korrigiert Scan Transmissions-Elektronenmikroskop zu einstelligen Nanometer Muster in zwei weit verbreitete Elektronenstrahl widersteht definieren: Poly (methylmethacrylat) und Wasserstoff-Silsesquioxane. Widerstehen, Muster können in Targetmaterialien Wahl mit einstelligen Nanometer Treue mit abheben, Plasma Ätzen, repliziert werden und Infiltration von Organometallics zu widerstehen.
Zusammenfassung
Wir zeigen Verlängerung der Elektronenstrahl Lithographie mit herkömmlichen widersteht und Muster Transfer zu einstelligen Nanometer-Dimensionen durch den Einsatz einer Aberration korrigiert Scan Transmissions-Elektronenmikroskop als Exposition Werkzeug. Hier präsentieren wir die Ergebnisse der einstelligen Nanometer Strukturierung von zwei weit verbreitete Elektronenstrahl widersteht: Poly (methylmethacrylat) und Wasserstoff-Silsesquioxane. Die Methode erreicht Sub-5 Nanometer Features in Poly (methylmethacrylat) und Sub-10 Nanometer Auflösung in Wasserstoff-Silsesquioxane. High-Fidelity-Transfer dieser Muster in Targetmaterialien Wahl durchgeführt werden kann, mit Metalldeckel, Plasma Ätzen und Infiltration mit Organometallics zu widerstehen.
Einleitung
Das Protokoll präsentiert in diesem Manuskript enthält Anleitungen für Muster mit einstelligen Nanometer Auflösung in Poly (methylmethacrylat) (PMMA) definieren und Wasserstoff Silsesquioxane (HSQ), die zwei gemeinsamen Elektronenstrahl Lacke sind in hochauflösende Musterung durch Elektronenstrahl Lithographie. Wir erreichen diese Ergebnisse mit einer Aberration korrigiert Scan Transmissions-Elektronenmikroskop (STEM) als die Exposition Werkzeug, ausgestattet mit einem Pattern-Generator für die Steuerung des Elektronenstrahls. Nach der Belichtung widerstehen können Nanoscale Muster zu einer Vielzahl von Ziel Materialien1, wodurch die Herstellung von neuartigen Geräten mit einer einstelligen Nanometer Auflösung übertragen werden.
Frühere Studien haben gezeigt, dass Elektronenstrahl Lithographie (EBL) Muster definieren kann im Resist Maßstab Materialien mit Abmessungen im Sub-10 nm2,3,4,5,6. Jedoch für Abmessungen ca. 4 nm, haben diese Demonstrationen nicht standardisierte Verfahren wie die Verwendung von Strukturen7 unterstützen oder langen Belichtungszeiten für selbst-Entwicklung widersteht8erforderlich. Ndere Nanopatterning erwiesen wie Elektronenstrahl Ablagerung9 induzierten oder scanning probe Lithographie10,11, Sub-4 nm Auflösung erreichen obwohl diese deutlich erfordern längere Belichtungszeiten im Vergleich zu EBL.
Moderne dedizierte EBL-Systeme produzieren Elektronenstrahlen mit Punktgrößen in der wenige Nanometer Längenskala (2-10 nm), die prägenden Muster mit Sub-10 nm Auflösung sehr schwer macht. Im Gegensatz dazu implementiert unser Protokoll EBL mit eine Aberration korrigiert Stamm, die eine hochoptimierte Instrument zur Materialcharakterisierung an Angstrom Längenskalen ist. Dieser Unterschied ermöglicht Routine Strukturierung von lithographischen Rekorde mit einzelnen Nanometer Auflösung1. Beim Stand der Technik kommerzielle Aberration korrigiert Stammzellen Systeme Kosten im Bereich von Millionen von Dollar, sie sind in mehrere nationale Benutzer Einrichtungen zur Verfügung, und einige sind ohne Kosten zugänglich.
Protokoll
(1) Probenvorbereitung für widerstehen Beschichtung
Hinweis: In diesem Werk sind Muster mit einstelligen Nanometer Auflösung in PMMA (positiv und negativ-Ton) definiert und HSQ widersteht, die sind Spin-Cast auf handelsüblichen TEM Fenster (ca. 50 µm X 50 µm) mit SündeX oder SiO2 Membranen mit dicken von 5 nm bis 50 nm. Ein oder mehrere TEM Fenster werden in einer 3 mm Durchmesser Silizium Umgang mit Rahmen (100 µm dick) hergestellt. In diesem Manuskript verweisen wir die ganze Einheit als der TEM-Chip und der Elektronenstrahl transparenten Membran als die TEM-Fenster.
- Entfernen Sie organische Rückstände aus der TEM-Chip durch Ausführen von O2 Plasma Reinigung für 30 s bei 100 W (Kammerdruck von 230 m bei ca. 5 Sccm O2 Flow).
- Cleave ein Stück Silizium-Wafer, ca. 2 cm x 2 cm in der Größe, als Halterung für die TEM-Chip während Resist Spinnen verwenden.
- Platz zwei Streifen Klebeband doppelseitig Kohlenstoff etwa gleich weit entfernt von der Mitte des Silizium-Halter und etwas weniger als der Durchmesser der TEM getrennt chip (siehe Abbildung 1). Spülen Sie die Streifen mit Isopropylalkohol (IPA), ihre Klebkraft zu reduzieren. Dies ist notwendig um zu vermeiden, brechen die zarten TEM-Chip bei der Entnahme aus der Si-Halter.
- Montieren Sie die TEM-Chip auf dem Silizium-Halter dafür sorgen, dass er zu den Kohlenstoff-Klebeband-Streifen nur an zwei gegenüberliegenden Kanten verbunden ist, wie in Abbildung 1dargestellt.

Abbildung 1 : TEM Chip Halter für Resist Spinnerei. Beachten Sie, dass der TEM-Chip wird an der Silizium-Inhaber nur an beiden Kanten, die Fläche Kontakt zu vermindern, und daher die Haftung Kraft. Bitte klicken Sie hier für eine größere Version dieser Figur.
(2) Spin Mantel Parameter für PMMA (positiven und negativen Ton) und HSQ widersteht
Hinweis: Resist Dicke wird nicht direkt auf dem Chip TEM gemessen, da es klein und in der Regel der Resist ist anschlagen andere dünnen Schichten (z. B. Si Film auf SiO2 Membran), die die Messung erschwert. Stattdessen widerstehen Dicke richtet sich nach der Schleuderdrehzahl kalibriert mit Reflectometry Messungen aus Filmen anschlagen einer Masse Si Probe. Reflectometry Ergebnisse wurden in der Regel mit einer Genauigkeit besser als 20 %, Stiel oben Bilder von eingestürzten Strukturen bestätigt.
- Befestigen Sie die Halterung von Silizium auf dem Spinner-Futter und richten Sie die Mitte des Fensters TEM ungefähr mit der Mitte des Rotors Spinner aus.
- Mit einer Pipette decken das gesamte TEM-Fenster mit einem Tropfen (ca. 0,05 mL) aus PMMA (A2 950K PMMA in Anisole auf 0,5-1,0 verdünnt %) oder HSQ (1 % Feststoffe XR-1541).
- Abhängig von der Resist verwendet folgen Sie den Spin coating und Backen in Tabelle 1dargestellten Parameter.
- Entfernen Sie vorsichtig die TEM-Chip aus dem Silizium-Halter. Überprüfen Sie die Resist-Einheitlichkeit über die TEM-Fenster mit einem optischen Mikroskop. Wenn der Film in der zentralen Region der Membran homogen ist, fahren Sie mit dem nächsten Schritt fort. Andernfalls wiederholen Sie widerstehen Beschichtung auf einem frischen TEM-Fenster.
| Resist | Schleuderdrehzahl (x g) | Film Dicke (nm) | Backtemperatur (° C) | Backzeit (min) |
| Positiv-Ton PMMA | 60 | 30 | 200ein | 2ein |
| Negativ-Ton PMMA | 60 | 15 | 200ein | 2ein |
| HSQ | 107 | 10 | Nicht benötigteb | Nicht benötigteb |
| einsee Ref.12; bSiehe Ref. 13 | ||||
Tabelle 1: Spin coating und Backen Parameter zu widerstehen. Spin-Geschwindigkeit-Einheiten in x g betrachten einen Durchmesser von 3 mm-TEM-Chip. Backen ist auf einer heißen Platte für PMMA durchgeführt. Kein Backen benötigt für HSQ13. HSQ Resist lagert gekühlt, so muss es vor dem Spinnen auf Raumtemperatur erwärmen.
3. Laden Sie Probe in Stamm, ordnen Sie Fensterkoordinaten zu und führen Sie hochauflösende Fokussierung
- Montieren Sie den Fotolack beschichtete TEM Chip auf der Stamm-Probenhalter, um sicherzustellen, dass die Resist-Vakuum-Schnittstelle eingehenden Strahls, Gesichter, da der Balken am oberen Rand der Probe optimal ausgerichtet ist. Stellen Sie außerdem sicher, dass die Seiten des Fensters TEM ungefähr mit der X - und y-Achse der Stamm Bühne ausgerichtet sind. Dies erleichtert die Navigation um die TEM-Fenster.
- Laden Sie die TEM-Chip in das Mikroskop und die Pumpe über Nacht, Verunreinigungen in der Probenkammer zu reduzieren.
- Bewegen Sie die Bühne (X, y) Koordinaten, so dass der Strahl mehr als 100 µm Weg von der Mitte des Fensters TEM ist (um unfallbedingte Strahlenexposition zu vermeiden). Festlegen der Stamm Sonde Strahlstrom und Energie 34 PA 200 keV, beziehungsweise.
- In Beugung Modus imaging (stationäre Strahl, Z-Kontrast-Modus und Mid Winkel ringförmigen dunkel-Feld-Detektor) voraussichtlich Vergrößerung 30 kX mit dem Strahl aus dem Fokus, wodurch es einfacher, eine Kante des Fensters TEM zu finden.
Hinweis: Die TEM Fenster Kanten auch in bildgebenden Modus finden. Wir verwenden Beugung Modus, weil es schneller ist, da der Strahl nicht gescannt werden, um ein Bild zu bilden muss. - Navigieren Sie nach dem TEM-Fenster, bis eine Kante des Fensters auf das Bild, Beugung beobachtet wird. Entlang der Kanten der Fenster und Datensatz navigieren (X, y) Koordinaten der vier Ecken des Fensters TEM.
- In der letzten Kurve der Fenster, Vergrößerung, 50 kX zu erhöhen und führen Sie grobe Fokussierung auf der Fenster-Membran durch Verschieben der Bühne Z-Koordinate (Z-Höhenverstellung) bis die Frequenzweiche der Beugung Muster Orientierung beobachtet. Anschließend führen Sie Feinfokussierung durch Anpassung der aktuellen Objektivlinse.
- Erhöhen Sie die Vergrößerung um 180 kX. Fokus einzustellen, Stigmation und Aberration Korrektureinstellungen um eine Aberration korrigiert Beugung Bild der Fenster Membran zu erhalten, wie in Abbildung 2 bdargestellt. Diese Fokussierung Methode bekannt als die Ronchigram Methode14.

Abbildung 2 : Beugung Bild TEM Fenster Membran. (A) fokussiert, sondern Blüthe Bild. Die Korrektur der Aberration Einstellungen für dieses Bild sind nicht optimal durch die eng beieinander liegender Beugung Fransen belegt. (B) Exposition-Ready nicht stigmated Bild zeigt eine glatte Plateau Beugungsmuster. Bitte klicken Sie hier für eine größere Version dieser Figur.
4. setzen Sie Muster mit einer Aberration korrigiert Stammzellen mit einem Muster-Generator-System ausgestattet.
Hinweis: Die Aberration korrigiert Stammzellen, die in dieser Arbeit verwendet verfügt über eine Muster-Generator-System (PGS), steuert die Position der Elektronenstrahl Muster definiert, mit Computer-aided Design (CAD) Software verfügbar zu machen. Dosis wird gesteuert, indem Sie den Abstand zwischen expositionspunkte (Schrittweite) und die Belichtungszeit pro Punkt definieren. Tabelle 2 fasst die Belichtungsparameter in dieses Protokoll verwendet. Muster sind ausgesetzt, in der Mitte des Fensters TEM im "Dauerbetrieb", da der Stamm in dieser Arbeit verwendeten einen blanker Strahl nicht enthalten ist. Vor und nach der Exposition Positionen PGS den Strahl zu beliebigen benutzerdefinierten in das Sichtfeld (FOV), vorzugsweise aus dem Muster-Bereich. Wir verwenden in diesem Protokoll der oberen rechten und unteren rechten Ecken des FOV als die erste und letzte Strahl Positionen bzw..
| Resist | Dot-Exposition | Linie-Exposition | Bereich Belichtung | ||
| Dosis (fC/Punkt) | Schrittweite (nm) | Dosis (nC/cm) | Schrittweite (nm) | Dosis (µC/cm2) | |
| Positiven Ton PMMA | 10-100 | 0,5 | 2 – 8 | 0,5 | 2.000 |
| Negativen Ton PMMA | 50-500 | 0,5 | 20 – 40 | 0,5 | 50.000 – 80.000 |
| HSQ | 10-100 | 0,5 | 10 – 20 | 0,5 | 20.000 – 30.000 |
Tabelle 2: Belichtungsparameter für PMMA (positiven und negativen Ton) und HSQ widersteht. Die angezeigten Werte sind generisch, da optimale Dosis Werte hängen von der spezifischen Musterdesign und KE-Bemaßungen gezielte.
- Schließen Sie Absperrschieber Strahl zur Vermeidung einer versehentlichen Exposition des Resists beim Verschieben von der Bühne. Stellen Sie sicher, dass der Strahlstrom 34 pA und Vergrößerung 180 kX ist.
- Verwenden Sie die bespielte Fensterkoordinaten Ecke auf um die Bühne zu bewegen, so dass die FOV-Center 5 µm Weg von der Mitte des Fensters ist. Öffnen Sie die Absperrschieber Strahl und Fokus zu diesem Zeitpunkt mit der Ronchigram-Methode im Schritt 3.6 beschrieben.
- Schließen Sie Strahl-Absperrschieber. Verschieben Sie die Bühne, um das Blickfeld in der Mitte des Fensters TEM zu platzieren. Ändern Sie die Vergrößerung in 18 kX (entsprechend einer 5 µm X 5 µm Musterung FOV). Der Strahl Übernahmesteuerung, PGS und positionieren Sie den Strahl überall abseits der Muster-Bereich (oben rechts verwenden wir in diesem Protokoll).
- Führen Sie die folgenden Aktionen in rascher Folge zu vermeiden, Überbelichtung der Resist an den ersten und letzten Balken stellen.
- Öffnen Sie den Schieber zu und zu überprüfen Sie, durch die Beobachtung der Strahl Beugung Muster Bild, ob der Lichtstrahl im Fokus bei der ersten Strahllage (wie in Abbildung 2 b) ist. Setzen Sie das Muster aus.
- Wenn die Belichtung abgeschlossen ist, überprüfen Sie, ob die Beugung Muster Bild im Fokus bei der endgültigen Strahllage bleibt. Zu guter Letzt schließen Sie Absperrschieber.
- Entfernen Sie den TEM-Chip aus dem Stamm.
5. Entwicklung und kritischer Punkt-Trocknung zu widerstehen
Hinweis: Der Entwicklungsprozess richtet sich nach der Resist verwendet. 5.1, 5.2 und 5.3 beschrieben, den Entwicklungsprozess für positiv-Ton PMMA, negativ-Ton PMMA und HSQ, beziehungsweise. Jedoch alle widersteht Anteil den gleichen kritischen Endpunkt Trocknung, die notwendig ist, Muster Zusammenbruch aufgrund der hohen Seitenverhältnis der Muster, die mit diesem Protokoll hergestellt zu vermeiden. Kritischer Punkt-Trocknung (CPD) verwendet flüssiges CO2 als Arbeitsmedium, das ist nicht mit Wasser mischbar. Infolgedessen Probe Dehydratation (Schritte 5.4-5,7) erfordern den Einsatz von ACS Reagenz Grade Isopropylalkohol (IPA).
- Entwicklung von positiv-Ton PMMA15: bereiten Sie einen 100-mL-Becherglas mit 3:1-Lösung von IPA:methyl Isobutyl-Keton (MIBK). Stellen Sie den Becher in ein Bad-Thermostat bei 0 ° C (Eisbad auf 0 ° C ist eine kostengünstige Alternative) und warten Sie, bis die Temperatur ausgeglichen ist. Greifen Sie die TEM-Chip mit einer Pinzette zu, und rühren Sie es leicht in die kalte Lösung für 30 S. fahren Sie mit Schritt 5.4.
- Entwicklung von negativ-Ton PMMA16: sanft umrühren den TEM-Chip in MIBK bei Raumtemperatur (24 ° C) für 2 min. Transfer der Probe zu einer Aceton-Lösung und rühren 3 Minuten fahren Sie mit Schritt 5.4.
- Entwicklung von HSQ13: rühren Sie die TEM-Chip in eine "salzige" deionisiertes Wasser-Lösung, mit 1 wt % NaOH und 4 Gew.-% NaCl, 4 min bei 24 ° C. Rühren Sie den Chip in reinem deionisiertes Wasser für 2 min (zu den salzigen Entwickler abspülen). Fahren Sie fort mit Schritt 5.4.
- Tauchen Sie die TEM-Chip in der ACS-Reagenz-Klasse IPA und rühren Sie es leicht für 30 s.
- Platzieren Sie schnell den TEM-Chip auf dem speziellen 2" Si Wafer, dargestellt in Abbildung 3A. Stellen Sie sicher, dass der TEM-Chip während der Übertragung immer nass mit IPA ist. Schließen Sie nach ca. 2-3 min die CPD Wafer Halter Baugruppe wie in Abbildung 3 bdargestellt. Lassen Sie das ganze Gerät Einweichen in ACS Reagenz Grade IPA für weitere 15 min völlig eingetaucht in IPA.
- Schnell übertragen Sie die CPD Wafer Halter-Komplettmontage auf ein zweites Gefäß mit frischem ACS Reagenz Grade IPA und lassen Sie es für 15 min völlig eingetaucht in IPA.
- Übertragen Sie die CPD Wafer Inhaber Versammlung auf der CPD Instrument Prozesskammer (zu allen Zeiten der TEM-Chip soll ganz eingetaucht in IPA). Führen Sie den CPD-Prozess nach Bedienungsanleitung des Instruments.
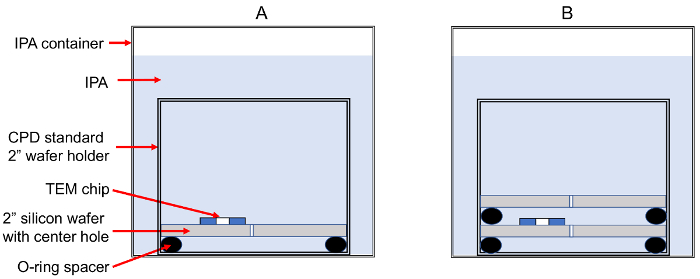
Abbildung 3 : Inhouse-Lösung für die Entwässerung der TEM-chips in einem CPD standard 2" Wafer Halter. (A) schematische Seitenansicht des TEM Chips auf einem besonderen 2" Si-Wafer mit einem kleinen Loch in der Mitte (ca. 500 μm Durchmesser) erlauben Flüssigkeitsstrom gebohrt. Die Wafer passt in einem CPD standard 2" Wafer Halter von der CPD-System-Hersteller geliefert. (B) ein zweiter besonderen Si-Wafer umschließt die TEM-Chip, wodurch turbulente Strömung während des CPD-Prozess. In A und B, die CPD-Wafer-Halter ist völlig eingetaucht in ACS Reagenz Klasse IPA. Bitte klicken Sie hier für eine größere Version dieser Figur.
Ergebnisse
Abbildung 4 zeigt lithographischen Muster auf positiv-Ton PMMA (Resist nach Entwicklung von exponierten Regionen entfernt) und negativ-Ton PMMA (Resist aus unbelichteten Bereichen entfernt). TEM Windows bestand aus etwa 30 nm Dicke PMMA widerstehen für positiv-Ton PMMA (15 nm dick für negativ-Ton PMMA) Spinning auf einer 5 nm Dicke SiNX Membran. Ein dünner Metallfilm (10 nm AuPd über 5 nm Ti) wurde nach der Entwicklung des positiv-Ton PMMA, Kontrast zu erhöhen, während der Stamm Bildgebung hinterlegt. Für positiv-Ton PMMA, die durchschnittliche kleinste isolierte Funktion ist 2,5 ± 0,7 nm (Abbildung 4, 4D), während die kleinste Steigung Muster 17,5 nm (Abbildung 4F). Für negativ-Ton PMMA, die durchschnittliche kleinste isolierte Funktion ist 1,7 ± 0,5 nm (Abbildung 4), während die kleinste Steigung Muster 10,7 nm (Abbildung 4J).

Abbildung 4 : Aberration korrigiert Elektronenstrahllithographie von positiv und negativ-Ton-PMMA. (Ein dünner Film von 10 nm AuPd über 5 nm Ti wurde auf alle positiven Ton PMMA Muster in dieser Abbildung dargestellten hinterlegt.) (A) SEM Bild von beliebigen Mustern in positiv-Ton PMMA. (B) TEM Bild beliebige Muster in negativ-Ton PMMA. (C, D) REM-Bilder der kleinsten gemustert Löcher in positiv-Ton PMMA, mit durchschnittlichen Lochdurchmesser von 2,5 ± 0,7 nm. (E, F) REM-Bilder von Loch Arrays definiert auf positiv-Ton PMMA mit einer Steigung von 21,5 nm (E) und 17,5 nm (F). (G, H) TEM Bilder von Säule-Arrays in negativ-Ton PMMA mit 20 nm Tonhöhe und mit durchschnittlichen Säule Durchmesser von 1,7 ± 0,5 nm (G) und 1,8 ± 0,5 nm (H). (I, J) TEM Bilder von negativ-Ton PMMA Säule bzw. Arrays von 15,2 und 10,7 nm-Teilung. Alle Maßstabsleisten sind 40 nm. Diese Zahl reproduziert wurde von Manfrinato, gerade, Stein, A., Zhang, L., Nam, C.-Y., Yager, schwarz, c.t. Aberration-Corrected Elektronenstrahllithographie bei einem Nanometer Länge Maßstab K.G, Stach und E.A. Nano Lett. 17 (8) 4562-4567 (2017). Bitte klicken Sie hier für eine größere Version dieser Figur.
Abbildung 5 zeigt Muster auf HSQ Resist definiert. Die TEM-Fenster für HSQ Lithographie verwendet bestand aus etwa 10 nm Dicke HSQ Resist Spinning auf einer 27 nm Dicke Si-Membran. Nach Exposition und widerstehen Entwicklung, 3-4 nm der Ultra-dünne Si Schicht in die HSQ-freien Regionen (unbelichteten Bereichen) des Fensters wurden entfernt, durch induktive gekoppelt mit einer Mischung aus 50 Sccm HBr und 20 Sccm Cl2 Gase bei einem Kammerdruck von Plasma (ICP)-Radierung 10 mT (Bias und ICP-Leistung von 60 W und 250 W, beziehungsweise). Abbildung 5A besteht aus vier Reihen mit kurzen vertikalen Linien. Die obere, die zwei Zeilen mit einer Linie Dosis ausgesetzt waren trat exponentiell von 2 bis 120 nC/cm (0 nm entwickelt Breite für diese Zeilen). Die unteren zwei Zeilen wurden mit einer Gegend Dosis trat exponentiell von 3.000 bis 60.000 μC/cm2 (5 nm breit und 200 nm entwickelt, lange Rechtecke) ausgesetzt. Abbildung 5 b ist ein gezoomten Bild von der Mittelbereich der unteren Zeile in Abbildung 5A. Die zwei am weitesten links stehende, die vier Center und die vier am weitesten rechts liegenden Linien wurden mit einer Portion Bereich 23.300, 27.300 und 32.000 μC/cm2, ausgesetzt. Die vier Mittellinien haben eine durchschnittliche gemessene Breite von 7 nm.

Abbildung 5 : Aberration korrigiert Elektronenstrahllithographie von HSQ widerstehen. (Fenster TEM verwendet in dieser Abbildung wurde von 27 nm Dicke Si gemacht. Nach HSQ Entwicklung induktiv gekoppelten Plasma Ätzen diente, 3-4 nm Si aus von HSQ nicht abgedeckten Bereichen zu entfernen.) (A) TEM-Bild aus vier Reihen mit vertikalen Linien mit Dosen exponentiell variiert von 2 bis 120 nC/cm (ersten zwei Zeilen) und 3.000 bis 60.000 μC/cm2 (unten zwei Zeilen) ausgesetzt. Die Strahl-Schrittweite betrug 0,5 nm für alle Linien. (B) hohe Vergrößerung TEM Bild des zentralen Bereichs der unteren Zeile in (A). Die Gruppe von 4 Linien in der Mitte haben im Durchschnitt gemessen Breite von 7 nm und mit einer Portion Bereich 27.300 μC/cm2ausgesetzt waren. Bitte klicken Sie hier für eine größere Version dieser Figur.
Diskussion
Der wichtigste Schritt im Protokoll konzentriert sich den Elektronenstrahl vor der Belichtung. Dies ist notwendig um höchstauflösende Musterung zu erreichen. Bei der Durchführung Mehrfachbelichtungen (z. B. wenn ein TEM-Chip verfügt über mehrere Fenster und jedes Muster), ist es wichtig, den Strahl vor jeder Belichtung in einem Abstand von 5 μm bei den meisten aus der Belichtungsbereich neu auszurichten. Das Protokoll enthält auch Schritte aus, um den Strahl Fokus zu überprüfen, vor und nach der Exposition auf zwei extreme Positionen des Bereichs Musterung (obere und untere Ecken), wodurch eine Bestimmung der ob einige Defokussierung Musterung, zum Beispiel wegen aufgetreten ein Membran wird lokal im Großraum Musterung gekippt.
Ein weiterer wichtiger Schritt in diesem Protokoll nutzt kritischer Punkt-Trocknung (CPD) Trocknen Proben nach der Entwicklung der exponierten widerstehen Muster. Ohne diesen Schritt werden Muster häufig durch die hohe Streckung der gemusterten Strukturen (z.B. gemusterte Resist seitlichen Abmessungen kleiner als die Dicke) zusammenbrechen. Die meisten CPD-Systeme liefern einen standard 2" Wafer-Halter. Allerdings könnte da TEM-Chips sehr klein sind und die gemusterten Strukturen sehr zart sind, sie während der CPD-Prozess, wenn in Haltern für größere Probenmengen entwickelt platziert beschädigt werden. Abbildung 3 zeigt eine Inhouse-Lösung für CPD von TEM-Chips mit einer standard-Wafer-Halter. Die beiden Wafer mit einem Flow-Aktivierung Loch in der Mitte umschließen die TEM-Chip und schützen sie vor turbulente Strömung während der CPD-Prozess.
Die Bestimmung der Schichtdicke optimal widerstehen versucht, konkurrierende in Einklang zu bringen. Auf der einen Seite sollte es so dünn wie möglich um die höchste Auflösung zu erzielen und Muster Zusammenbruch zu vermeiden, aber auf der anderen Seite sollte es dick genug für Muster-Transfer-Anwendungen wie Lift-Off und Radierung. Dieses Protokoll verwendet 1 % HSQ, das ist die niedrigste Verdünnung im Handel erhältlich und deren weitere Verdünnung im Labor wird nicht empfohlen (unsere Erfahrung zeigt, die verdünnten HSQ oft zu teilweise Vernetzung führt). Verdünnte PMMA reproduzierbare Ergebnisse können jedoch, dieses Protokoll verwendet jedoch 1 % für positiv-Ton PMMA (30 nm Dicke) und 0,5 % und 1 % bei negativen Ton (15 und 30 nm Dicke, beziehungsweise). Wir haben festgestellt, dass positiv-Ton PMMA widerstehen, leidet nicht Muster Zusammenbruch, wie negativ-Ton PMMA tut, damit die Verwendung dünner Stärke für negativen Ton, wie in gezeigt Tabelle 1. Darüber hinaus hat negativ-Ton PMMA ~ 50 % Dicke Verlust nach der Elektronenstrahl Exposition (und vor der Entwicklung), so ist die Enddicke für negativ-Ton PMMA ~ 7 bis 15 nm. (1,7 und 1,8 nm Features aus Abbildung 4 haben ca. 7 nm widerstehen Dicke, die an der Grenze der Muster Zusammenbruch ist.) Die PMMA-Muster in Abbildung 4 dargestellte benutzte keinen CPD-Schritt; Allerdings empfiehlt falls vorhanden, dieses Protokoll die Verwendung von CPD nach Entwicklung der PMMA-Muster. Im Gegensatz dazu fanden wir CPD kritisch für die HSQ Verarbeitung, da es weiter verdünnt werden kann nicht, (um dünner Stärke zu erreichen) und weil dicker HSQ Muster erforderlich sind, um als ein Ätzmaske (z. B. Silizium geätzt, wie in Abbildung 5 verwenden ).
Die positiv-Ton-PMMA-Muster in Abbildung 4 wurden mit einer dünnen metallischen, Kontrast erhöhen, während der Bildgebung beschichtet. Die unterstützenden Informationen in die Arbeit der Manfrinato Et Al. 1 zeigt, dass die Wirkung der metallischen Beschichtung auf die Messtechnik der Muster zu vernachlässigen ist. Ebenso halten wir die Ergebnisse in Abbildung 5 dargestellten für HSQ widerstehen nicht drastisch auf die besondere Auswahl der TEM-Window-Struktur basierend auf der Ultra-dünne Schichtdicke zugrunde liegenden Si abhängen.
Nach bestem Wissen und gewissen sind alle Messungen, die im Abschnitt Vertreter Ergebnisse für Positive und Negative Ton PMMA1 (Abbildung 4) beschrieben die kleinste Merkmale1,7 bisher in der Literatur beschrieben , 12 , 16 , 17. Manfrinato Et Al. 1 zeigten auch Sub-5 nm Muster Übertragung von Fotolack auf ein Target-Material, mit herkömmlichen Metalldeckel (für positiv-Ton PMMA) und sequentieller Infiltration Synthese18 von ZnO (für negativ-Ton PMMA). Für HSQ in Abbildung 5 dargestellten Ergebnisse sind nicht die kleinsten gemeldeten Funktionen7. Dieses Protokoll ist jedoch nützlich, um reproduzierbare Eigenschaften in HSQ bei Auflösungen besser als 10 nm, und zeigt ein einstelliges Strukturierung von siliziumstrukturen.
Die hier vorgestellten Protokoll beschreibt ein Verfahren zur Strukturierung beliebiger Strukturen mit einstelligen Nanometer Auflösung mit der konventionellen Elektronenstrahl widersteht PMMA und HSQ. Darüber hinaus zeigen die Ergebnisse hier und in Nr. 1 gezeigt, dass solche Muster mit hoher Wiedergabetreue auf ein Target-Material der Wahl übertragen werden können.
Offenlegungen
Die Autoren haben nichts preisgeben.
Danksagungen
Diese Forschung verwendeten Ressourcen des Zentrums für funktionale Nanomaterialien, die ein US-DOE Büro der wissenschaftlichen Einrichtung, am Brookhaven National Laboratory unter Vertragsnr. DE-SC0012704.
Materialien
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Referenzen
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten