Method Article
Cifra nanometri Litografia di fascio di elettroni con un microscopio elettronico di aberrazione-corretta scansione trasmissione
In questo articolo
Riepilogo
Usiamo un'aberrazione-rettificato microscopio elettronico a trasmissione scansione per definire modelli di cifra nanometri in due fascio di elettroni diffusi resiste: poli (metacrilato di metile) e silsesquioxane di idrogeno. Resistere a modelli può essere replicati in materiali bersaglio di scelta con fedeltà cifra nanometri utilizzando al lancio, incisione, al plasma e resistere l'infiltrazione di composti organometallici.
Abstract
Dimostriamo che resiste all'estensione del elettrone-fascio Litografia utilizzando convenzionali e processi di trasferimento del modello a dimensioni nanometriche cifra impiegando un'aberrazione-rettificato microscopio elettronico a trasmissione scansione come lo strumento dell'esposizione. Qui, presentiamo i risultati di cifra nanometri patterning di due fascio di elettroni diffuso resiste: poli (metacrilato di metile) e silsesquioxane di idrogeno. Il metodo raggiunge caratteristiche sub-5 nanometro in poli (metacrilato di metile) e risoluzione sub-10 nanometro in idrogeno silsesquioxane. Trasferimento ad alta fedeltà di questi modelli in materiali bersaglio di scelta può essere eseguita utilizzando a sollevamento metalliche, plasma etch e resistere l'infiltrazione con composti organometallici.
Introduzione
Il protocollo presentato in questo manoscritto fornisce indicazioni per la definizione di modelli con risoluzione nanometrica cifra in poli (metacrilato metilico) (PMMA) e idrogeno silsesquioxane (HSQ), che sono due comuni resiste a fascio di elettroni utilizzati in patterning ad alta risoluzione di Litografia a fascio di elettroni. Otteniamo questi risultati utilizzando un'aberrazione-corretta scansione microscopio elettronico a trasmissione (STEM) come lo strumento dell'esposizione, equipaggiato con un generatore di pattern per controllare il fascio di elettroni. Dopo l'esposizione di resistere, i modelli su scala nanometrica possono essere trasferiti ad una varietà di destinazione materiali1, permettendo così la realizzazione di nuovi dispositivi a risoluzione nanometrica di cifra.
Gli studi precedenti hanno dimostrato che la litografia a fascio di elettroni (EBL) è in grado di definire modelli a resistere materiali con dimensioni nel sub-10 nm scala2,3,4,5,6. Tuttavia, per le dimensioni circa 4 nm, queste dimostrazioni hanno richiesto le procedure non standard come uso di assistono strutture7 o8resiste a volte lunga esposizione per lo auto sviluppo di. Altre tecniche nanopatterning, come fascio di elettroni indotto deposizione9 o scansione sonda Litografia10,11, hanno dimostrato in grado di raggiungere risoluzione sub-4 nm, anche se questi richiedono significativamente tempi di esposizione più lunghi rispetto al EBL.
Moderni sistemi dedicati di EBL producono fasci di elettroni con bersagli in qualche lunghezza scala nanometrica (2-10 nm), che rende molto difficile la definizione modelli con risoluzione sub-10 nm. Al contrario, il nostro protocollo implementa EBL utilizzando un gambo rettificato aberrazione, che è uno strumento altamente ottimizzato per la caratterizzazione di materiali a scale di lunghezza di angstrom. Questa differenza permette patterning sistematica delle caratteristiche da record litografici con risoluzione nanometrica singolo1. Mentre state-of-the-art, sistemi commerciali del gambo di aberrazione-corretto costano nella gamma di milioni di dollari, sono disponibili per l'uso in diverse strutture nazionali utente e alcune sono accessibili senza alcun costo.
Protocollo
1. preparazione del campione per resistere rivestimento
Nota: In questo lavoro, i modelli con risoluzione nanometrica cifra sono definiti in PMMA (tono positivo e negativo) e HSQ resiste, che sono spin-cast su windows TEM commercialmente disponibile (circa 50 µm x 50 µm) con peccatox o SiO2 membrane con spessori che variano da 5 nm a 50 nm. Una o più finestre TEM sono fabbricate in un silicone di diametro 3 mm Gestione frame (dello spessore di 100 µm). In tutto questo manoscritto, ci riferiamo all'intera unità come il chip TEM e alla membrana trasparente del elettrone-fascio come finestra TEM.
- Rimuovere eventuali residui organici dal chip TEM eseguendo del plasma di2 O di pulizia per 30 s a 100 W (pressione in camera di 230 mT a circa 5 sccm O2 flow).
- Fendere un pezzo di wafer di silicio, circa 2 cm x 2 cm nel formato, da utilizzare come supporto per il chip TEM durante resistere filatura.
- Posto due strisce di nastro biadesivo carbonio circa equidistante dal centro della titolare del silicio e separato leggermente meno rispetto al diametro della popolazione TEM chip (Vedi Figura 1). Sciacquare le strisce con alcool isopropilico (IPA) per ridurre la loro forza adesiva. Ciò è necessario per evitare di rompere il chip TEM delicato durante la rimozione da parte del titolare di Si.
- Montare il chip TEM sul titolare del silicio assicurandosi che è attaccato per le strisce di nastro di carbonio solo a due bordi opposti come mostrato in Figura 1.

Figura 1 : Titolare di chip TEM per resistere filatura. Si noti che il chip TEM è collegato al titolare di silicio solo ai due bordi per diminuire il contatto di superficie, e quindi, forza di adesione. Clicca qui per visualizzare una versione più grande di questa figura.
2. spin cappotto parametri per PMMA (tono positivo e negativo) e HSQ resiste
Nota: Lo spessore di resistere non è misurato direttamente sul chip TEM, poiché è piccolo e solitamente il resist cast su altri strati sottili (ad es., Si film sulla membrana di SiO2 ), che complica la misurazione. Al contrario, resistere spessore è determinato dalla velocità di centrifuga tarata usando riflettometria misure dal film il cast su un grosso campione Si. Riflettometria risultati sono stati confermati, solitamente con una precisione superiore a 20%, di immagini dall'alto fusto di strutture crollate.
- Montare il supporto di silicio sul mandrino di spinner e allineare il centro della finestra TEM approssimativamente con il centro del rotore spinner.
- Utilizzando una pipetta, coprire l'intera finestra TEM con una goccia (0,05 mL circa) di PMMA (A2 950K PMMA diluito in anisolo a 0.5-1.0%) o HSQ (1% di solidi XR-1541).
- A seconda il resist utilizzato, seguire lo spin del rivestimento e cottura parametri riportati nella tabella 1.
- Rimuovere con cautela il chip TEM da titolare del silicio. Controllare l'uniformità di resistere sulla finestra TEM utilizzando un microscopio ottico. Se il film è omogeneo in tutta la regione centrale della membrana, procedere al passaggio successivo; in caso contrario, ripetere il processo di rivestimento di resistere su una finestra TEM fresco.
| Resistere | Velocità di rotazione (x g) | Film Spessore (nm) | Temperatura di cottura (° C) | Tempo di cottura (min) |
| Positivo-tono PMMA | 60 | 30 | 200un | 2un |
| Negativo-tono PMMA | 60 | 15 | 200un | 2un |
| HSQ | 107 | 10 | Non è necessariob | Non è necessariob |
| unVedi rif. 12; bVedi rif. 13 | ||||
Tabella 1: resistere spin coating e parametri di cottura. Unità di velocità di rotazione in x g considera un chip TEM del diametro di 3 mm. Cottura viene eseguita su una piastra calda per PMMA. Nessun tipo di cottura è necessario per HSQ13. Resist HSQ è memorizzato in frigorifero, quindi ha bisogno di riscaldare a temperatura ambiente prima della filatura.
3. caricare un esempio nel tronco, mappa coordinate della finestra ed eseguire la messa a fuoco ad alta risoluzione
- Montare il chip TEM rivestite con resistere sul supporto del campione di staminali, assicurandosi che l'interfaccia di resistere-vuoto affronta il fascio in ingresso, dal momento che il fascio è focalizzato in modo ottimale nella parte superiore del campione. Inoltre, assicurarsi che i lati della finestra TEM siano allineati approssimativamente con il x - e asse y della fase formativa. Questo faciliterà lo spostamento della finestra TEM.
- Caricare il chip TEM nel microscopio e la pompa durante la notte per ridurre i contaminanti nel pozzetto di misurazione.
- Spostare le coordinate (x, y) tale che il fascio è più di 100 µm lontano dal centro della finestra TEM (per evitare l'esposizione accidentale). Impostare il fascio sonda di staminali corrente ed energia alla pA 34 e 200 keV, rispettivamente.
- In modalità di diffrazione imaging (fascio stazionario, modalità z-contrasto e medio-angolo anulare campo scuro rivelatore), impostare ingrandimento su 30 kX con la trave fuori fuoco, che lo rende più facile trovare un bordo della finestra TEM.
Nota: I bordi di finestra TEM possono anche essere trovati in modalità di imaging. Usiamo la modalità diffrazione perché è più veloce, dato che il fascio non ha bisogno di essere analizzato per formare un'immagine. - Navigare verso la finestra TEM fino ad un bordo della finestra è osservare l'immagine di diffrazione. Navigare lungo i bordi della finestra e record (x, y) le coordinate dei quattro angoli della finestra TEM.
- Presso l'ultimo angolo della finestra, aumentare l'ingrandimento a 50 kX ed eseguire la messa a fuoco approssimativa sulla membrana finestra spostando la fase coordinata z (z-altezza regolabile) fino a quando il crossover di diffrazione è osservato orientamento del modello. Successivamente, eseguire la messa a fuoco fine regolando la lente dell'obiettivo attuale.
- Aumentare l'ingrandimento a 180 kX. Regolare messa a fuoco, stigmation e aberrazione impostazioni di correzione al fine di ottenere un'immagine di diffrazione correzione aberrazione della membrana finestra come mostrato in Figura 2B. Questo metodo di messa a fuoco è noto come i responsi metodo14.

Figura 2 : Immagine di diffrazione della membrana della finestra TEM. (A) Focused ma immagine dello stimma. Le impostazioni di correzione dell'aberrazione per questa immagine non sono ottimale, come testimoniano le frange di diffrazione ravvicinate. (B) pronto per l'esposizione non-stigmated immagine che mostra un modello di diffrazione altopiano liscio. Clicca qui per visualizzare una versione più grande di questa figura.
4. espongono pattern utilizzando uno stelo rettificato aberrazione dotato di un sistema di generatore di Pattern.
Nota: Il gambo rettificato aberrazione utilizzato in questo lavoro è dotato di un sistema di generatore di pattern (PGS), che controlla la posizione del fascio di elettroni per esporre modelli definiti usando software di computer-aided design (CAD). Dose è controllata definendo la spaziatura tra i punti di esposizione (dimensione del passaggio) e il tempo di esposizione per ogni punto. La tabella 2 riassume i parametri di esposizione utilizzati nel presente protocollo. Modelli sono esposti al centro della finestra TEM in modalità"continua", poiché il gambo utilizzato in questo lavoro non include un fascio blanker. Prima e dopo l'esposizione, PGS posiziona il fascio in qualsiasi punto definito dall'utente nel campo visivo (FOV), preferibilmente lontano dalla zona di modello. Usiamo in questo protocollo l'alto a destra e destra angoli inferiori del FOV come le posizioni iniziale e finale del fascio, rispettivamente.
| Resistere | Esposizione di dot | Linea esposizione | Esposizione di zona | ||
| Dose (fC/dot) | Dimensione del passo (nm) | Dose (nC/cm) | Dimensione del passo (nm) | Dose (µC/cm2) | |
| Tono positivo PMMA | 10-100 | 0,5 | 2 – 8 | 0,5 | 2.000 |
| Tono negativo PMMA | 50-500 | 0,5 | 20 – 40 | 0,5 | 50.000-80.000 |
| HSQ | 10-100 | 0,5 | 10 – 20 | 0,5 | 20.000 – 30.000 |
Tabella 2: parametri di esposizione per PMMA (tono positivo e negativo) e HSQ resiste. I valori indicati sono generici, poiché i valori di dose ottimale dipendono dal disegno di modello specifico e mirato quote della feature.
- Chiudere la saracinesca di larghezza per evitare qualsiasi esposizione accidentale del fotoresist durante lo spostamento di fase. Verificare che la corrente del fascio è pA 34 e l'ingrandimento è 180 kX.
- Utilizzare le coordinate degli angoli finestra pre-registrati per spostare il palco, affinché il centro FOV è 5 µm lontano dal centro della finestra. Aprire la valvola a saracinesca fascio e messa a fuoco a questo punto utilizzando il metodo di responsi descritto nel punto 3.6.
- Chiudere la saracinesca in larghezza. Spostare il palco per posizionare il campo visivo al centro della finestra di TEM. Cambiare l'ingrandimento al kX 18 (corrispondente a un µm 5 µm x 5 patterning FOV). Trasferire il controllo del fascio al PGS e posizionare in qualsiasi punto il fascio lontano dalla zona di reticolo (usiamo nell'angolo superiore destro in questo protocollo).
- Eseguire le operazioni seguenti in rapida successione per evitare di sovraesporre il resistere alle posizioni iniziale e finale del fascio.
- Aprire la valvola a saracinesca e verificare, osservando l'immagine del modello di diffrazione di larghezza, se il fascio è a fuoco nella posizione iniziale fascio (come in Figura 2B). Esporre il modello.
- Quando l'esposizione è completata, controllare se l'immagine del modello di diffrazione rimane a fuoco nella posizione finale della trave. Infine, chiudere la saracinesca.
- Rimuovere il chip TEM dal gambo.
5. resistere sviluppo e punto critico di essiccazione
Nota: Il processo di sviluppo dipende il resist utilizzato. Procedura 5.1, 5.2 e 5.3 descrive il processo di sviluppo per positivo-tono PMMA, negativo-tono PMMA e HSQ, rispettivamente. Tuttavia, tutti resiste Condividi lo stesso punto critico finale processo di secchezza, che è necessario per evitare il collasso del reticolo a causa delle alte proporzioni dei modelli fabbricati con questo protocollo. Punto critico essiccazione (CPD) utilizza liquido CO2 come fluido di lavoro, che non è miscibile con l'acqua. Di conseguenza, la disidratazione del campione (passaggi 5.4-5.7) richiedono l'utilizzo di ACS reagente grado alcool isopropilico (IPA).
- Lo sviluppo di positivo-tono PMMA15: preparare un becher da 100 mL con soluzione di 3:1 di IPA:methyl Chetone isobutilico (MIBK). Porre il becher in un circolatore vasca a 0 ° C (un bagno di ghiaccio a 0 ° C è un'alternativa di basso costo) e attendere che la temperatura è equalizzata. Afferrare il chip TEM con un paio di pinzette e mescolare delicatamente nella soluzione fredda per 30 s. proseguire con il punto 5.4.
- Lo sviluppo del negativo-tono PMMA16: delicatamente mescolare il chip TEM in MIBK a temperatura ambiente (24 ° C) per 2 min. trasferimento del campione a una soluzione di acetone e mescolare per 3 minuti procedere con passo 5.4.
- Lo sviluppo di HSQ13: mescolare il chip TEM in una soluzione di acqua deionizzata "salato", contenente 1 wt % NaOH e 4 wt % NaCl, per 4 min a 24 ° C. Mescolare il chip in acqua pura deionizzata per 2 min (lavare via lo sviluppatore salato). Passare al punto 5.4.
- Immergere il chip TEM in grado del reagente ACS IPA e mescolare delicatamente per 30 s.
- Inserire rapidamente il chip TEM sul wafer Si speciale 2" mostrato in Figura 3A. Assicurarsi che il chip TEM è sempre bagnato con IPA durante il trasferimento. Dopo circa 2-3 minuti, chiudere il gruppo di supporti wafer CPD come raffigurato nella Figura 3B. Lasciare l'intera unità ammollo in grado del reagente ACS IPA per ulteriori 15 minuti totalmente immersi in IPA.
- Rapidamente trasferimento del gruppo di supporto di wafer CPD completo di un secondo contenitore con grado di fresco ACS del reagente IPA e lasciarlo per 15 min totalmente immersi in IPA.
- Trasferimento del gruppo di supporto CPD wafer alla CPD strumento processo camera (in ogni momento che il chip TEM dovrebbe essere totalmente immerso in IPA). Eseguire il processo CPD seguendo le istruzioni per l'uso dello strumento.
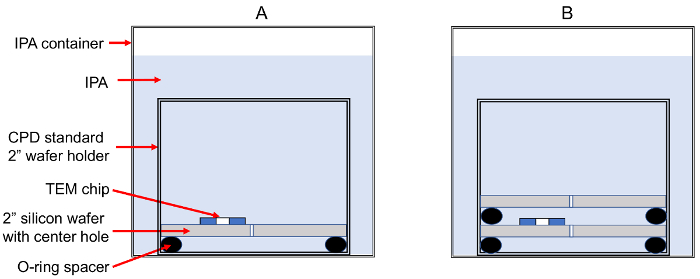
Figura 3 : Soluzione in-House per la disidratazione di TEM chip in un supporto di wafer CPD campione 2". (A) vista laterale schematica del chip TEM su un wafer Si speciale 2" con un piccolo foro perforato al centro (circa 500 μm di diametro) per consentire il flusso del liquido. La cialda si inserisce in un CPD standard 2" wafer supporto fornito dal produttore del sistema CPD. (B) un secondo wafer Si speciale racchiude il chip TEM, riducendo così il flusso turbolento durante il processo di CPD. In A e B, il titolare di wafer CPD è totalmente immerso in grado del reagente ACS IPA. Clicca qui per visualizzare una versione più grande di questa figura.
Risultati
La figura 4 Mostra modelli litografiche su PMMA positiva-tono (resiste a rimosso dalle regioni esposte dopo lo sviluppo) e negativo-tono PMMA (resiste a rimosso da settori non esposti). Windows TEM ha consistito di circa 30 nm Spessore PMMA resist per positivo-tono PMMA (15 nm di spessore per negativo-tono PMMA) spin cast su una membrana dix del peccato di spessore di 5 nm. Una sottile pellicola metallica (10 nm AuPd oltre 5 nm Ti) è stato depositato dopo sviluppo positivo-tono PMMA per aumentare il contrasto durante la formazione immagine di staminali. Per PMMA positiva-tono, la media caratteristica isolata in più piccola è 2,5 ± 0,7 nm (Figura 4, 4D), mentre il più piccolo modello di piazzola è 17.5 nm (Figura 4F). Per PMMA negativo-tono, la media più piccola caratteristica isolata è 1,7 ± 0,5 nm (Figura 4), mentre il più piccolo modello di piazzola è di 10.7 nm (Figura 4J).

Figura 4 : Litografia a fascio di elettroni correzione aberrazione di positivo-negativo-tono e PMMA. (Un film sottile di 10 nm AuPd oltre 5 nm Ti è stato depositato il tutto positivo-tono PMMA modelli mostrati in questa figura.) (A) immagine di SEM di pattern arbitrario in PMMA positiva-tono. (B) immagine TEM di pattern arbitrario in PMMA negativo-tono. (C, D) Immagini al SEM del più piccolo fantasia fori in tono positivo PMMA, con diametro del foro medio di 2,5 ± 0,7 nm. (E, F) Immagini di SEM di foro matrici definite su PMMA positiva-tono con un pitch di 21,5 nm (E) e 17,5 nm (F). (G, H) Immagini TEM di matrici di pilastro in PMMA negativo-tono con passo di 20 nm e con diametro di pilastro medio di 1,7 ± 0,5 nm (G) e 1,8 ± 0,5 nm (H). (I, J) Immagini TEM negativo-tono PMMA pilastro matrici di 15,2 e 10,7 passo nm, rispettivamente. Tutte le barre della scala sono 40 nm. Questa figura è stato riprodotto da Manfrinato, Varagnolo, Stein, A., Zhang, L., Nam, C.-Y., Yager, K.G., Stach, Elena e nero, Litografia a fascio di elettroni Aberration-Corrected C.T. una lunghezza su scala nanometrica. Nano Lett. 17 (8), 4562-4567 (2017). Clicca qui per visualizzare una versione più grande di questa figura.
Figura 5 consente di visualizzare schemi definiti su resist HSQ. La finestra TEM utilizzata per la litografia HSQ consisteva di circa 10 nm spessore HSQ resistere spin cast su una membrana di Si spessore di 27 nm. Dopo l'esposizione e resistere sviluppo, 3-4 nm dello strato ultra-sottile Si nelle regioni HSQ-libero (aree non esposte) della finestra sono stati rimossi da induttivo accoppiato acquaforte del plasma (ICP) usando una miscela di 50 sccm HBr e 20 sccm Cl2 gas ad una pressione in camera di 10 mT (bias e ICP potenza di 60 W e 250 W, rispettivamente). Figura 5A è costituito da quattro righe di brevi linee verticali. La tomaia due righe sono stati esposti con una dose di linea ha fatto un passo in modo esponenziale da 2 a nC/120cm (0 larghezza nm progettato per queste righe). Le due righe inferiori sono stati esposti con una dose di zona ha fatto un passo in modo esponenziale da 3.000 a 60.000 μC/cm2 (rettangoli ampia e 200 nm a lungo progettato di 5 nm). Figura 5B è un'immagine ingrandita della regione centro della riga in basso nella Figura 5A. I due più a sinistra, al centro di quattro e le quattro righe a destra sono stati esposti con una dose di zona di 23.300, 27.300 e 32.000 μC/cm2, rispettivamente. Le linee d' quattro asse hanno una larghezza media misurata di 7 nm.

Figura 5 : Litografia a fascio di elettroni correzione aberrazione di resist HSQ. (La finestra TEM utilizzata in questa figura è stata effettuata di 27 nm di spessore Si. Dopo lo sviluppo HSQ, acquaforte di plasma induttivo coppia utilizzato per rimuovere 3-4 nm di Si dalle aree non coperte da HSQ). (A) immagine TEM di quattro righe di linee verticali esposti con dosi variabili esponenzialmente da 2 a 120 nC/cm (prime due righe) e 3.000 a 60.000 μC/cm2 (due righe di fondo). Le dimensioni di passaggio fascio era 0,5 nm per tutte le linee. (B) immagine TEM di alto ingrandimento della zona centrale della riga in basso in (A). Il gruppo di 4 linee al centro hanno una media misurata larghezza di 7 nm e sono stati esposti con una dose di zona di 27.300 μC/cm2. Clicca qui per visualizzare una versione più grande di questa figura.
Discussione
La fase più critica nel protocollo si concentra il fascio di elettroni prima dell'esposizione. Ciò è necessario per raggiungere la più alta risoluzione patterning. Quando si esegue esposizioni multiple (ad esempio, quando un chip TEM ha più finestre e ciascuno è essere modellata), è importante rimettere a fuoco il fascio prima di ogni esposizione a distanza alle più a 5 μm dalla zona di esposizione. Il protocollo comprende anche passaggi per controllare il fuoco del fascio prima e dopo l'esposizione alle due posizioni estreme della zona di campitura (angoli superiore e inferiore), che permette di determinare se alcuni defocalizzazione si è verificato durante patterning, ad esempio dovuto a un membrana localmente essendo inclinata nella regione patterning.
Un altro passo importante in questo protocollo è utilizzando il punto critico essiccazione (CPD) per asciugare i campioni dopo aver sviluppato l'esposto resistono modelli. Senza questo passaggio, modelli crollerà frequentemente a causa delle elevate proporzioni delle strutture modellate (cioè, modellato resistere ingombro laterale inferiore allo spessore). Maggior parte dei sistemi CPD fornire un supporto di wafer di campione 2". Tuttavia, poiché TEM chip sono molto piccole e le strutture di fantasia sono piuttosto delicate, potrebbe essere danneggiati durante il processo di CPD, quando sono immessi in supporti progettati per i più grandi campioni. La figura 3 Mostra una soluzione in-House per i chip di CPD di TEM utilizzando un supporto di wafer standard. I due wafer, con un foro al centro, permettendo al flusso racchiudono il chip TEM e proteggono da flusso turbolento durante il processo di CPD.
La determinazione dello spessore del film di resistere ottimale tenta di bilanciare le richieste concorrenti. Da un lato, dovrebbe essere più sottile possibile per ottenere la massima risoluzione e per evitare il collasso del reticolo, ma d'altra parte, dovrebbe essere abbastanza spessa per applicazioni di trasferimento di modello come Lift-off e acquaforte. Questo protocollo utilizza 1% HSQ, che è la diluizione più bassa disponibile in commercio e la cui ulteriore diluizione in laboratorio non è raccomandato (la nostra esperienza dimostra che diluito HSQ conduce spesso a reticolazione parziale). Tuttavia, poiché PMMA diluito fornire risultati riproducibili, questo protocollo utilizza 1% per il tono positivo PMMA (spessore 30 nm) e 0,5% e 1% per tono negativo (spessore di 15 e 30 nm, rispettivamente). Abbiamo trovato quel resist PMMA positiva-tono non soffre di modello crollo come negativo-tono PMMA fa, così l'uso di spessore più sottile per tono negativo come mostrato nella tabella 1. Inoltre, negativo-tono PMMA ha ~ 50% perdita di spessore dopo l'esposizione del fascio elettronico (e prima di sviluppo), quindi lo spessore finale per negativo-tono PMMA è ~ 7 a 15 nm. (Le caratteristiche di nm 1,7 e 1,8 da Figura 4 hanno circa 7 spessore di resistere di nm, che è al limite del collasso del reticolo). I modelli PMMA illustrati nella Figura 4 non usato un passo CPD; Tuttavia, se disponibile, questo protocollo raccomanda l'uso di CPD dopo lo sviluppo di modelli di PMMA. Al contrario, abbiamo trovato CPD per essere critico per HSQ elaborazione dovuta al fatto che esso non può essere ulteriormente diluito (per ottenere lo spessore più sottile) e perché più spessi modelli HSQ sono necessari da utilizzare come maschera di acquaforte (ad es., per incidere il silicio come mostrato in figura 5 ).
I modelli PMMA positiva-tono nella Figura 4 sono stati rivestiti con un sottile strato metallico per aumentare il contrasto durante la formazione immagine. Le informazioni di supporto nel lavoro di Manfrinato et al. 1 dimostra che l'effetto di questo rivestimento metallico sulla metrologia dei modelli è trascurabile. Allo stesso modo, riteniamo che i risultati mostrati nella Figura 5 per HSQ resistere non dipendono drasticamente la particolare scelta di TEM finestra struttura basata sullo spessore ultra-sottile dello strato sottostante Si.
Al meglio della nostra conoscenza, tutte le misure descritte nella sezione risultati rappresentante per tono positivo e negativo PMMA1 (Figura 4) sono le caratteristiche più piccole segnalate nella letteratura fin qui1,7 , 12 , 16 , 17. Manfrinato et al. 1 inoltre ha dimostrato il trasferimento del modello sub-5 nm, da resistere ad un materiale di destinazione, utilizzando a sollevamento metalliche convenzionale (per positivo-tono PMMA) e infiltrazione sequenziale sintesi18 di ZnO (per PMMA negativo-tono). I risultati mostrati nella Figura 5 per HSQ non sono il più piccolo le caratteristiche segnalate7. Tuttavia, questo protocollo è utile per ottenere caratteristiche riproducibile in HSQ a risoluzioni meglio di 10 nm e dimostra la cifra patterning di strutture di silicio.
Il protocollo presentato qui descrive un processo per patterning strutture arbitrarie con risoluzione nanometrica singola cifra utilizzando il fascio di elettroni convenzionale resiste PMMA e HSQ. Inoltre, i risultati mostrati qui e in rif. 1 dimostrano che tali modelli possono essere trasferiti con alta fedeltà ad un materiale di destinazione di scelta.
Divulgazioni
Gli autori non hanno nulla a rivelare.
Riconoscimenti
Questa ricerca utilizzato le risorse del centro per i nanomateriali funzionali, che è un ufficio US DOE of Science Facility, al Brookhaven National Laboratory sotto contratto no. DE-SC0012704.
Materiali
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Riferimenti
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Ristampe e Autorizzazioni
Richiedi autorizzazione per utilizzare il testo o le figure di questo articolo JoVE
Richiedi AutorizzazioneThis article has been published
Video Coming Soon