Method Article
חד-ספרתיות ננומטר ליתוגרפיה קרינה עם תיקון סטייה סריקה הילוכים מיקרוסקופ אלקטרוני
In This Article
Summary
אנו משתמשים מתוקן-סטייה סריקה הילוכים מיקרוסקופ אלקטרוני להגדיר דפוסים חד-ספרתיות ננומטר מתנגד נפוץ קרינה שני: פולי (חומצתי) ו silsesquioxane מימן. להתנגד דפוסי ניתן לשכפל אותו בחומרים היעד של בחירה עם נאמנות ננומטר בעלי ספרה אחת באמצעות השיגור, פלזמה תצריב קו, ומתנגדים חדירה על-ידי organometallics.
Abstract
נדגים הרחבה של קרינה ליתוגרפיה באמצעות קונבנציונאלי יתנגד ומעבד דפוס העברה חד-ספרתיות ננומטר ממדים בהחלת מתוקן-סטייה סריקה הילוכים מיקרוסקופ אלקטרוני ככלי חשיפה. כאן, אנו מציגים את התוצאות של חד-ספרתיות ננומטר המתבנת של שני מתנגד קרינה בשימוש נרחב: פולי (חומצתי) ו silsesquioxane מימן. השיטה משיגה ננומטר sub-5 תכונות בפולי (חומצתי) ואת הרזולוציה sub-10 ננומטר מימן silsesquioxane. אמינות גבוהה העברה של הדפוסים הללו לתוך היעד חומרים הבחירה יכולה להתבצע באמצעות המראה מתכת, פלזמה לחרוט, להתנגד חדירה עם organometallics.
Introduction
פרוטוקול שהוצגו בכתב יד זה מספק הדרכה להגדרת תבניות עם רזולוציה חד-ספרתיות ננומטר, פוליפוני (חומצתי) (PMMA), מימן silsesquioxane (HSQ), אשר הם שני מתנגד קרינה נפוצות בשימוש . ברזולוציה גבוהה תכנים על ידי קרינה ליתוגרפיה נוכל להשיג את התוצאות הללו באמצעות תיקון סטייה סריקה הילוכים מיקרוסקופ אלקטרוני (גזע) כמו בכלי חשיפה, לבוש עם גנרטור דפוס לשליטה כשקרן האלקטרונים. לאחר החשיפה להתנגד, ניתן להעביר את הדפוסים ננו למגוון של היעד חומרים1, ובכך מאפשר ייצור של מכשירים חדשניים ברזולוציה ננומטר חד-ספרתיות.
מחקרים קודמים הראו כי קרינה ליתוגרפיה (EBL) הוא מסוגל להגדיר תבניות בלהתנגד חומרים עם מידות nm sub-10 גודל2,3,4,5,6. עם זאת, עבור מידות בסביבות 4 nm, הפגנות אלה נדרשים הליכים שאינם סטנדרטיים כגון שימוש לסייע מבנים7 או לונג-חשיפה פעמים לפיתוח עצמי יתנגד8. טכניקות nanopatterning אחרות, כגון קרינה המושרה התצהיר9 או סריקת בדיקה ליתוגרפיה10,11, הוכיחו ולתסכולים ברזולוציה תת-4 nm, למרות אלו דורשים באופן משמעותי פעמים חשיפה ארוכים יותר בהשוואה EBL.
מערכות EBL ייעודי מודרני לייצר קורות אלקטרון עם ספוט גדלים כמה ננומטר אורך בסולם (2-10 ננומטר), מה שהופך את הגדרת תבניות עם רזולוציה sub-10 ננומטר קשה מאוד. לעומת זאת, פרוטוקול שלנו מיישמת EBL באמצעות של גזע סטייה-מתוקן, אשר הוא מכשיר מאוד אופטימיזציה עבור אפיון חומרים-פיסיקליות אנגסטרום. ההבדל הזה מאפשר המתבנת שגרתית של תכונות ליטוגרפית שוברת שיאים עם רזולוציה ננומטר יחידה1. ואילו המדינה-of-the-art, מערכות גזע מסחריות מתוקן אברציה עלה בטווח של מיליוני דולרים, הם זמינים לשימוש מספר מתקני משתמש הלאומית, וחלקם נגיש ללא עלות.
Protocol
1. מדגם הכנה להתנגד ציפוי
הערה: בעבודה זו, דפוסים עם רזולוציה חד-ספרתיות ננומטר מוגדרים ב- PMMA (חיובי, שלילי-טון), HSQ המתנגד, אשר הם ספין-שחקנים על גבי חלונות TEM זמינים מסחרית (כ 50 מיקרומטר מיקרומטר x 50) עם חטאx או SiO2 ממברנות עם עוביים הנעים בין 5 nm ל- 50 ננומטר. אחד או יותר של windows TEM מיוצרים בסיליקון בקוטר 3 מ מ טיפול מסגרת (בעובי 100 מיקרומטר). לאורך כל כתב יד זה, אנחנו מתייחסים אל כל יחידה כמו השבב TEM קרום שקוף קרינה כמו החלון TEM.
- להסיר שאריות אורגניות מהשבב TEM על-ידי ביצוע פלזמה2 O ניקוי עבור 30 s ב- 100 W (קאמרית הלחץ של mT 230-כ 5 sccm O2 זרימה).
- קליב פיסת הסיליקון רקיק, כ 2 ס"מ על 2 ס"מ בגודל, לשימוש כמחזיק עבור השבב TEM במהלך להתנגד ספינינג.
- מקום שני פסים של פחמן דו-צידית הקלטת כ קו מקביל מהמרכז של בעל הסיליקון ואת מופרדות מעט פחות מאשר הקוטר של TEM צ'יפ (ראה איור 1). יש לשטוף את הפסים עם אלכוהול איזופרופיל (IPA) כדי להפחית את כוחם דבק. הדבר נחוץ למנוע שבירת השבב TEM עדין במהלך ההסרה ממחזיק סי.
- הר השבב TEM את המחזיק סיליקון מוודא כי היא מחוברת הפסים הקלטת פחמן רק על שני קצוות מנוגדים כמוצג באיור1.

איור 1 : TEM שבב מחזיק להתנגד ספינינג. שים לב כי השבב TEM מחובר למחזיק סיליקון רק על שני קצוות לצמצם את איש הקשר של פני השטח, ומכאן, ולאלץ הידבקות. אנא לחץ כאן כדי להציג גירסה גדולה יותר של הדמות הזאת.
2. לסובב את המעיל פרמטרים עבור PMMA (בטון חיובי ושלילי) ו- HSQ מתנגד
הערה: עובי להתנגד לא נמדד ישירות על השבב TEM, מאז הוא קטן, בדרך כלל להתנגד הוא יצוק בשכבות דק אחרות (למשל, הסרט סי על קרום2 SiO), אשר מסבך את המדידה. במקום זאת, להתנגד עובי נקבעת לפי מהירות סיבוב מכויל באמצעות מדידות reflectometry מהסרטים שיוטל בכמויות גדולות מדגם סי. Reflectometry התוצאות אומתו, בדרך כלל עם דיוק טוב יותר מאשר 20%, גזע תמונות מלמעלה למטה של מבנים קרסו.
- הר בעל סיליקון על צ'אק טווה ויישר למרכז החלון TEM עם המרכז של הרוטור טווה.
- באמצעות פיפטה של, לכסות את כל החלון TEM עם טיפה אחת (כ- 0.05 מ"ל) של PMMA (A2 K 950 PMMA מעורבבת עם anisole 0.5-1.0%) או HSQ (1% מוצקים XR-1541).
- בהתאם להתנגד בשימוש, בצע ספין ציפוי, אפייה הפרמטרים המוצגים בטבלה 1.
- הסר בזהירות את השבב TEM ממחזיק סיליקון. בדיקת אחידות להתנגד מעל החלון TEM נעזרת במיקרוסקופ אופטי. אם הסרט הוא הומוגני ברחבי האזור המרכזי של הקרום, המשך לשלב הבא; אחרת, חזור על תהליך ציפוי להתנגד על חלון TEM טריים.
| להתנגד | מהירות סיבוב (x גרם) | הסרט עובי (אן אם) | טמפרטורת האפייה (° C) | זמן אפיה (דקות) |
| הטון החיובי PMMA | 60 | 30 | 200 | 2 |
| שלילי-tone PMMA | 60 | 15 | 200 | 2 |
| HSQ | 107 | 10 | . לא נחוצהb | . לא נחוצהb |
| לראות Ref.12; bעיין הפניה למעורר 13 | ||||
טבלה 1: להתנגד ספין ציפוי, אפייה פרמטרים. ספין מהירות יחידות x g שקול שבב TEM בקוטר 3 מ מ. אפייה מתבצע על פלטה חמה עבור PMMA. אפייה לא נחוץ עבור HSQ13. HSQ להתנגד מאוחסן בקירור, אז הוא צריך להתחמם לטמפרטורת החדר לפני ספינינג.
3. לטעון מדגם בגזע, מפת קואורדינאטות החלון, ולבצע התמקדות ברזולוציה גבוהה
- הר השבב TEM מצופים להתנגד את המחזיק לדוגמה גזע, מוודא כי הממשק להתנגד-ואקום פונה הקרן נכנסות, מאז הקרן בצורה אופטימלית ממוקד בחלק העליון של המדגם. כמו כן, ודא כי צידי החלון TEM מיושרים עם x - ו y ציר של השלב גזע. זה יקל ניווט אל החלון TEM.
- לטעון את השבב TEM לתוך המיקרוסקופ, משאבת בן לילה להפחתת מזהמים בבית הבליעה הדגימה.
- הזז את הקואורדינטות הבמה (x, y) כגון הקרן הוא יותר מ-100 מיקרומטר מהמרכז של החלון TEM (כדי למנוע חשיפה מקרית). הגדר את קרן בדיקה גזע הנוכחי ואת האנרגיה הפלסטינית 34 ל- 200 קוו, בהתאמה.
- במצב עקיפה הדמיה (קרן נייח, במצב z-חדות, זווית אמצע טבעתי כהה-שדה גלאי), מוגדר ההגדלה kX 30 בעזרת קרן מחוץ לפוקוס, מה שהופך אותו קל יותר למצוא קצה של החלון TEM.
הערה: הקצוות חלון TEM ניתן למצוא גם במצב הדמיה. אנו משתמשים עקיפה מצב משום שהוא מהיר יותר, שכן הקרן אינו צריך לסרוק כדי ליצור תמונה. - לנווט לעבר החלון TEM עד קצה של החלון נצפית על התמונה עקיפה. לנווט לאורך קצוות חלון, רשומה (x, y) הקואורדינטות של ארבע הפינות של החלון TEM.
- בפינת החלון האחרון, הגברת ההגדלה כדי 50 kX ולבצע מיקוד קשה על קרום חלון על-ידי הזזת הבמה z הקואורדינטה (z-גובה ההתאמה) עד ההצלבה של עקיפה נוצרת תבנית התמצאות. לאחר מכן, לבצע מיקוד בסדר על-ידי התאמת העדשה המטרה הנוכחית.
- הגברת ההגדלה כדי 180 kX. כוונון פוקוס, stigmation והגדרות תיקון סטייה על מנת לקבל תמונה תיקון סטייה עקיפה של קרום חלון כמוצג באיור 2B. התמקדות שיטה זו נקראת שיטת Ronchigram14.

איור 2 : תמונת דיפרקציה של הממברנה חלון TEM. (א) Focused אבל התמונה stigmatic. הגדרות תיקון סטייה עבור תמונה זו אינם אופטימליים כפי שמעידים בשולי עקיפה המרווחות מקרוב. (B) החשיפה הלא-stigmated בתמונה מוכנה מציג תבנית עקיפה מישור החלקה. אנא לחץ כאן כדי להציג גירסה גדולה יותר של הדמות הזאת.
4. חושפים את דפוסי השימוש של גזע מתוקן-סטייה מצויד עם מערכת מחולל תבנית.
הערה: הגבעול מתוקן-סטייה להשתמש בעבודה זו הינו מצויד עם מערכת מחולל תבנית (PGS), אשר שולטת המיקום קרינה לחשוף דפוסים מוגדרים באמצעות תוכנת עיצוב (CAD) באמצעות מחשב. מינון נשלטת על-ידי הגדרת המרווח בין חשיפה נקודות (שלב גודל) וזמן חשיפה לכל נקודה. בטבלה 2 מסכמת את פרמטרי החשיפה נעשה שימוש בפרוטוקול זה. דפוסי חשופים במרכז החלון TEM ב- "מצב מתמשך," מאז הגבעול להשתמש בעבודה זו אינה כוללת קרן blanker. לפני ואחרי החשיפה, PGS עמדות הקורה בכל נקודה על-ידי המשתמש שדה הראיה (FOV), רצוי מאזור דפוס. אנו משתמשים בפרוטוקול זה את הימנית העליונה ואת בפינות השמאלית התחתונה של FOV כמו העמדות קרן התחלתי וסופי, בהתאמה.
| להתנגד | חשיפה נקודה | קו חשיפה | אזור חשיפה | ||
| מינון (fC/נקודה) | גודל צעד (אן אם) | מינון (nC/ס מ) | גודל צעד (אן אם) | מינון (µC/cm2) | |
| הטון החיובי PMMA | 10-100 | 0.5 | 2-8 | 0.5 | 2,000 |
| הטון השלילי PMMA | 50-500 | 0.5 | 20-40 | 0.5 | 50,000 – 80,000 |
| HSQ | 10-100 | 0.5 | 10 – 20 | 0.5 | 20,000-30,000 |
בטבלה 2: מתנגד חשיפה פרמטרים עבור PMMA (בטון חיובי ושלילי) ו- HSQ. הערכים המוצגים הם כלליים, מאז במינון אופטימלי תלויות בעיצוב דפוסים מסוימים וערכים ממוקד תכונה מידות.
- סגור את השסתום קרן להימנע מכל חשיפה מקרית של להתנגד כשעוברים על הבמה. לוודא הזרם קרן כ 34 הרשות הפלסטינית וכן הגדלה 180 kX.
- להשתמש את הקואורדינטות פינת החלון מוקלט מראש כדי לעבור השלב, כך המרכז FOV הוא 5 מיקרומטר מהמרכז של החלון. פתח את השסתום קרן מבטיחות בשלב זה באמצעות שיטת Ronchigram המתוארים שלב 3.6.
- סגור את השסתום קרן. הזז את הבמה כדי למקם את FOV במרכז החלון TEM. שינוי רמת ההגדלה kX 18 (תואם מיקרומטר 5 מיקרומטר x 5 תכנים FOV). להעביר את הפקד קרן PGS ומקם את הקורה בכל מקום מחוץ לאזור דפוס (אנו משתמשים בפינה הימנית העליונה של פרוטוקול זה).
- בצע את הפעולות הבאות ברצף מהיר כדי להימנע overexposing את להתנגד בכל התנוחות קרן התחלתי וסופי.
- פתח את השסתום, לאמת, על ידי התבוננות בתמונה תבנית עקיפה קרן, אם הקרן נמצא בפוקוס במיקום הראשוני קרן (כמו איור 2B). לחשוף את התבנית.
- כאשר החשיפה תושלם, בדוק אם התמונה תבנית עקיפה תישאר בפוקוס במיקום קרן הסופי. לבסוף, סגור את השסתום.
- הסר את השבב TEM הגבעול.
5. להתנגד פיתוח וייבוש נקודה קריטית
הערה: תהליך הפיתוח תלוי להתנגד בשימוש. שלבים 5.1, 5.2 ו 5.3 מתארים תהליך הפיתוח עבור חיובי-tone PMMA, שלילי-tone PMMA, HSQ, בהתאמה. עם זאת, כל מתנגד לשתף באותה נקודה קריטית הסופי ייבוש תהליך, אשר הכרחי למנוע התמוטטות דפוס עקב היחס גבוה-רוחב-גובה של הדפוסים מפוברק עם פרוטוקול זה. נקודה קריטית ייבוש (שיקגו) משתמש CO נוזלי2 הנוזל לעבוד, וזה לא miscible עם מים. כתוצאה מכך, דוגמת התייבשות (שלבים 5.4-5.7) דורשים שימוש ACS ריאגנט כיתה איזופרופיל אלכוהול (IPA).
- פיתוח של הטון החיובי PMMA15: להכין גביע 100-מ עם 3:1 פתרון של IPA:methyl איזובוטיל קטון (MIBK). הכנס את הספל סירקולטור אמבט ב-0 מעלות צלזיוס (אמבטיית קרח ב-0 מעלות צלזיוס הוא חלופה בעלות נמוכה יותר) והמתן עד הטמפרטורה היא אוזן. תפוס את השבב TEM עם זוג מספריים ומערבבים בעדינות זה בפתרון קר עבור 30 ס' להמשיך עם שלב 5.4.
- פיתוח שלילי-tone PMMA16: בעדינות ולערבב את השבב TEM ב MIBK בטמפרטורת החדר (24 ° C) במשך 2 דק העברת המדגם פתרון אצטון, ולערבב במשך 3 דקות להמשיך בצעד 5.4.
- פיתוח של HSQ13: מערבבים את השבב TEM פתרון מים יונים "מלוחים", המכיל wt 1% NaOH ו 4% wt NaCl, 4 דקות ב- 24 מעלות צלזיוס. מערבבים את השבב במים טהורים יונים למשך 2 דקות (לשטוף היזם מלוחות). להמשיך עם שלב 5.4.
- לטבול את הצ'יפס TEM בכיתה ריאגנט ACS IPA ומערבבים בעדינות ל 30 s.
- במקום במהירות את השבב TEM על מיוחד 2" סי כשהפחד שמוצג באיור 3 א. ודא כי השבב TEM תמיד רטוב עם IPA במהלך ההעברה. לאחר כ 2-3 דקות, סגור רופאות וופל מחזיק הרכבה כפי שהיא מתוארת דמות 3B. להשאיר את כל היחידה לספוג את כיתה ריאגנט ACS IPA למשך 15 דקות נוספות שקוע לגמרי IPA.
- במהירות להעביר את מכלול שלם של מחזיק וופל רופאות מיכל השני עם ACS טריים ריאגנט כיתה IPA ולהשאיר את זה למשך 15 דקות שקוע לגמרי IPA.
- העברת מכלול מחזיק וופל רופאות לתא תהליך כלי רופאות (בכל עת שהשבב TEM צריך להיות שקוע לגמרי ב- IPA). להפעיל את תהליך העברת בעקבות הוראות ההפעלה של המכשיר.
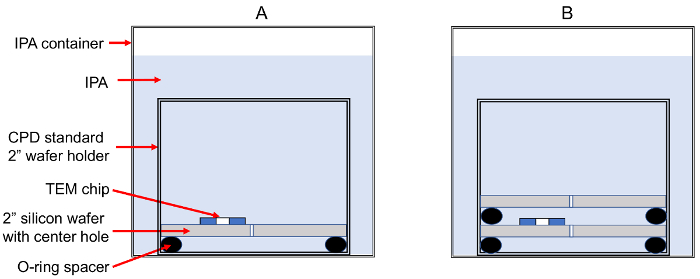
איור 3 : פתרון ללא צורך במיקור חוץ להתייבשות של TEM בשבבי רופאות תקן 2" וופל בעל. (א) להציג צד סכמטי של השבב TEM ב מיוחד 2" סי רקיק עם חור קטן קדח במרכז (כ-500 μm בקוטר) כדי לאפשר את זרימת הנוזל. כשהפחד מסדר רופאות תקן 2" וופל בעל שסופק על-ידי יצרן מערכת רופאות. (B) רקיק סי מיוחד השני יקיף את השבב TEM, ובכך להקטין את מערבולות זרימה במהלך תהליך רופאות. ב A ו- B, המחזיק וופל רופאות הוא שקוע לגמרי בכיתה ריאגנט ACS IPA. אנא לחץ כאן כדי להציג גירסה גדולה יותר של הדמות הזאת.
תוצאות
איור 4 מציג דפוסי ליטוגרפית חיובי-tone PMMA (להתנגד להסיר אזורים חשופים לאחר פיתוח) וגם שלילי-tone PMMA (להתנגד להסיר אזורים שלא נחשפו). TEM windows כללה כ 30 ננומטר בעובי PMMA להתנגד עבור חיובי-tone PMMA (15 ננומטר עבה על הטון השלילי PMMA) ספין על חטא 5 ננומטר בעוביx קרום. סרט מתכתי דק (10 nm AuPd מעל 5 nm Ti) ועליהן לאחר התפתחות חיובית-tone PMMA כדי לשפר את הניגודיות במהלך דימות גזע. עבור חיובי-tone PMMA, ממוצע הקטן מבודד התכונה היא 2.5 ננומטר ± 0.7 (איור 4C, 4 D), בעוד הדפוס המגרש הקטן ביותר הוא 17.5 nm (איור 4F). עבור שלילי-tone PMMA, ממוצע הקטן מבודד התכונה היא ± 0.5 1.7 nm (איור 4G), בעוד הדפוס המגרש הקטן ביותר הוא 10.7 nm (איור 4J).

איור 4 : ליתוגרפיה קרן אלקטרונים מתוקן-סטייה של חיובי ולא שלילי-הטון PMMA. (בשכבה דקיקה של 10 nm AuPd מעל 5 nm Ti היה מופקד על כל טון חיובי PMMA דפוסי המוצג באיור זה.) (א) תמונת SEM של דפוסים חיוביים-tone PMMA שרירותי. (B) תמונת TEM של דפוסים שליליים-tone PMMA שרירותי. (C, D) תמונות SEM של הקטן בדוגמת חורים חיובי-tone PMMA, עם ממוצע חור בקוטר של 2.5 ננומטר ± 0.7. (E, F) תמונות SEM של חור במערכים מוגדרים חיוביים-tone PMMA עם זריקה של 21.5 nm (ה) ו- 17.5 nm (נ). (G, H) תמונות TEM של עמוד מערכים ב PMMA שלילי-tone עם 20 ננומטר המגרש ועם ממוצע עמוד קוטר של ± 0.5 1.7 nm (G) ± 0.5 1.8 nm (H). (I, J) TEM תמונות של הטון השלילי PMMA עמוד מערכים של המגרש nm 15.2 ו- 10.7, בהתאמה. כל סולם ברים הם 40 ננומטר. איור זה שוחזר Manfrinato, V.R., שטיין, א, זאנג, ל., נאם, ג-י', Yager, ק"ג, Stach, E.A, שחור, הסי-טי Aberration-Corrected אלקטרון קרן הדפס אבן-ציר אורך אחד ננומטר. שמאלית ננו- 17 (8), 4562-4567 (2017). אנא לחץ כאן כדי להציג גירסה גדולה יותר של הדמות הזאת.
איור 5 מציג דפוסים מוגדרים HSQ להתנגד. החלון TEM משמש HSQ ליתוגרפיה כללה כ 10 ננומטר בעובי HSQ להתנגד ספין שיוטל nm 27 קרום עבה סי. לאחר חשיפה ופיתוח להתנגד, 3-4 nm של השכבה סי דק במיוחד באזורים ללא HSQ (אזורים שלא נחשפו) של החלון הוסרו על ידי אינדוקטיבית מצמידים איכול פלזמה (ICP) בעזרת תערובת 50 sccm HBr וגזים sccm Cl2 20, בלחץ הקאמרית של 10 mT (הטיה והכוח של ICP של 60 W ו 250 W, בהתאמה). איור 5A מורכב ארבע שורות קצרות קווים אנכיים. העליון נחשפו שתי שורות עם מנה קו דרך אקספוננציאלית 2 nC 120/ס מ (0 רוחב nm תוכנן עבור שורות אלה). שתי השורות התחתון נחשפו עם המינון אזור פסע אקספוננציאלית מ 3,000 ל- 60,000 μC/ס מ2 (5 nm מלבנים רחב ו-200 nm זמן מתוכנן). איור 5B היא תמונה מוגדלת של אזור מרכז השורה התחתונה של איור 5A. השניים הימנית, את מרכז ארבע, ואת ארבעת הקווים הימניות נחשפו עם מנה אזור של 23,300, 27,300 ו μC/ס מ 32,0002, בהתאמה. הקווים 4 מרכז יש של רוחב מדוד ממוצע של 7 ננומטר.

איור 5 : ליתוגרפיה קרן אלקטרונים מתוקן-סטייה של להתנגד HSQ. (החלון TEM בשימוש איור זה היה עשוי 27 ננומטר בעובי סי. לאחר פיתוח HSQ, איכול פלזמה בשילוב אינדוקטיבית שימש כדי להסיר האזורים שאינם מכוסים על ידי HSQ 3-4 nm של סי.) (א) תמונת TEM של ארבע שורות של קווים אנכיים חשוף עם מינונים שונים בצורה אקספוננציאלית, מ 2 nC/cm (העליון שתי שורות) 120 ו 3,000 ל 60,000 μC/ס מ2 (בשתי שורות). גודל צעד קרן היה 0.5 ננומטר עבור כל השורות. (B) תמונת TEM בהגדלה של האזור המרכזי של השורה התחתונה (לה). הקבוצה של 4 שורות במרכז יש ממוצע נמדד ברוחב של 7 nm נחשפו עם מנה באזור של μC/cm 27,3002. אנא לחץ כאן כדי להציג גירסה גדולה יותר של הדמות הזאת.
Discussion
השלב הקריטי ביותר בפרוטוקול היא התמקדות כשקרן האלקטרונים לפני החשיפה. הדבר נחוץ להשיג ברזולוציה הגבוהה ביותר המתבנת. בעת ביצוע חשיפות מרובות (לדוגמה, כאשר שבב TEM כולל חלונות מרובים, כל אחד הוא להיות בדוגמת), חשוב למקד את הקרן לפני כל חשיפה ממרחק של μm 5-ביותר מהאזור חשיפה. הפרוטוקול כוללת גם את הפעולות הבאות כדי לבדוק את מיקוד הקרן לפני ואחרי חשיפה-שתי עמדות קיצוניות של אזור המתבנת (פינות העליון והתחתון), אשר מאפשרת קביעה של אם קצת defocusing אירעה במהלך המתבנת, לדוגמה עקב ממברנה להיות מוטה באופן מקומי באזור המתבנת.
צעד חשוב נוסף של פרוטוקול זה משתמש נקודה קריטית ייבוש (שיקגו) להתייבש דגימות לאחר פיתוח החשופים להתנגד דפוסים. ללא שלב זה, דפוסי תתמוטט לעתים קרובות עקב יחס גבוה של המבנים בדוגמת (קרי, בדוגמת להתנגד לרוחב מידות קטנות יותר בעובי). רוב מערכות רופאות לספק סטנדרט 2" וופל בעל. עם זאת, כיוון TEM האסימונים הם קטנים מאוד המבנים בדוגמת עדינים למדי, הם עלול להינזק במהלך תהליך רופאות כאשר מחזיקי תוכנן עבור מדגמים גדולים יותר. איור 3 מראה פתרון ללא צורך במיקור חוץ עבור שבבי רופאות של TEM באמצעות בעל תקן וופל. מוצרי קונדיטוריה שני, עם חור המאפשר זרימה במרכז, הקף את השבב TEM, להגן עליו מפני מערבולות זרימה במהלך תהליך רופאות.
קביעת עובי הסרט להתנגד אופטימלית מנסה לאזן בין דרישות מתחרות. מצד אחד, זה צריך להיות דק ככל האפשר כדי להשיג את הרזולוציה הגבוהה ביותר וכדי למנוע התמוטטות דפוס, אך מצד שני, זה צריך להיות מספיק עבה עבור דפוס העברת יישומים כגון ההמראה תחריט. פרוטוקול זה משתמש 1% HSQ, אשר זמינים מסחרית דילול הנמוך, אשר דילול נוסף במעבדה לא מומלץ (מראה שלנו ניסיון כי HSQ מדולל מובילה לעיתים קרובות crosslinking חלקית). עם זאת, מאז PMMA מדולל לתת תוצאות לשחזור, פרוטוקול זה משתמש 1% עבור חיובי-tone PMMA (עובי 30 ננומטר) ו- 0.5%, 1% לצליל שלילי (15 ו 30 ננומטר עובי, בהתאמה). מצאנו להתנגד PMMA הטון החיובי הזה לא סובל התמוטטות דפוס כמו שלילי-tone PMMA, לכן השימוש עובי דק יותר לצליל שלילי כפי שמוצג טבלה 1- בנוסף, שלילי-tone PMMA יש אובדן עובי ~ 50% לאחר חשיפה e-קרן (לפני פיתוח), כך העובי הסופי עבור שלילי-tone PMMA ~ 7-15 ננומטר. (1.7 1.8 nm התכונות של איור 4 יש כ-7 עובי להתנגד ננומטר, שנמצא על גבול התמוטטות דפוס). הדפוסים PMMA המוצג באיור 4 לא השתמש צעד רופאות; עם זאת, אם הוא זמין, פרוטוקול זה ממליצה על השימוש רופאות לאחר פיתוח דפוסי PMMA. לעומת זאת, מצאנו רופאות להיות קריטי עבור HSQ עיבוד בשל העובדה כי זה לא יכול להיות מדולל יותר (כדי להשיג את עובי דק יותר), כי דפוסי HSQ עבה יותר יש צורך להשתמש במסכת איכול (למשל, לחרוט סיליקון כפי שמוצג איור 5 ).
הדפוסים PMMA חיובי-tone באיור 4 היו מצופה בשכבה דקיקה מתכתיים כדי להגדיל את החדות במהלך דימות. המידע לתמוך בעבודה של Manfrinato et al. 1 מראה ההשפעה של זה ציפוי מתכתי על מטרולוגיה הדפוס היא זניחה. בדומה לכך, אנו רואים כי התוצאות המוצגות באיור 5 עבור HSQ להתנגד אינם תלויים באופן דרסטי הבחירה מסוים של מבנה החלון TEM בהתבסס על עובי השכבה שמתחת סי דקים.
לפי מיטב ידיעתנו, כל המדידות המתוארות בסעיף התוצאות נציג עבור חיובי ולא שלילי-הטון PMMA1 (איור 4) הם המאפיינים הקטנים דיווחו בספרות עד כה1,7 , 12 , 16 , 17. Manfrinato et al. 1 הפגין גם תת-5 nm דפוס העברה, מ להתנגד כדי חומר היעד, באמצעות המראה מתכת קונבנציונאלי (עבור חיובי-tone PMMA) ו חדירה רציפים סינתזה18 ZnO (עבור שלילי-tone PMMA). התוצאות המוצג באיור 5 עבור HSQ הן לא הקטן ביותר שדווח תכונות7. עם זאת, פרוטוקול זה שימושי עבור קבלת תכונות לשחזור ב HSQ ברזולוציות יותר מ-10 ננומטר, ומדגים המתבנת חד-ספרתיים של מבנים סיליקון.
פרוטוקול המובאת כאן מתארת תהליך עבור תכנים מבנים שרירותי עם רזולוציה ננומטר ספרה בודדת באמצעות את מתנגד קרינה המקובלת PMMA, HSQ. בנוסף, התוצאות המוצגות כאן, הפניה למעורר 1 מדגימים כי תבניות כאלה ניתן להעביר עם דיוק גבוה חומר המטרה של בחירה.
Disclosures
המחברים אין לחשוף.
Acknowledgements
מחקר זה משמש משאבים של המרכז ננו פונקציונלי, אשר DOE ארה ב Office של מתקן מדעי, ב כשהמטרה תחת חוזה מס דה-SC0012704.
Materials
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
References
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved