Method Article
Однозначных нанометр электронно лучевая литография с исправления аберраций сканирования просвечивающий электронный микроскоп
В этой статье
Резюме
Мы используем аберрация исправлениями сканирования просвечивающий электронный микроскоп для определения шаблонов однозначным нанометров в двух широко используется электронно лучевые сопротивляется: поли (метилметакрилат) и водорода силсесквиоксанов. Противостоять шаблоны могут быть реплицированы в целевой материалы по выбору с верностью однозначным нанометр с помощью liftoff, плазменного травления и сопротивляться проникновению синтезированы.
Аннотация
Мы показываем, расширение использования электронно лучевая литография обычных сопротивляется и шаблон передачи процессы однозначным нанометра размеры, применяя аберрация исправлениями сканирования просвечивающий электронный микроскоп как средство воздействия. Здесь, мы представляем результаты однозначным нанометра патронирования два широко используемых электронно лучевые сопротивляется: поли (метилметакрилат) и водорода силсесквиоксанов. Этот метод достигает суб-5 нанометров в поли (метилметакрилат) и резолюции суб-10 нанометров в силсесквиоксанов водорода. Высококачественный перевод этих шаблонов в целевой материалы по выбору может производиться с использованием металлических старт, плазмы etch и противостоять проникновению с синтезированы.
Введение
Протокол, представленный в этой рукописи обеспечивает руководство для определения шаблонов с однозначным нанометра резолюции в поли (метилметакрилат) (PMMA) и водорода силсесквиоксанов (HSQ), которые являются два общих электронно лучевые сопротивляется используется в высоким разрешением патронирования, электронно лучевая литография. Мы достигаем этих результатов с помощью исправления аберраций сканирования просвечивающий электронный микроскоп (STEM) как средство воздействия, оснащен генератором шаблон для контроля электронного луча. После противостоять воздействия наноразмерных шаблоны могут быть переданы различные целевые материалы1, таким образом позволяя изготовление новых устройств в нанометровом однозначным резолюции.
Предыдущие исследования показали, что электронно лучевая литография (РПЗ) способен определения шаблонов в сопротивление материалов с размерами в суб-10 Нм масштаб2,3,4,5,6. Однако, для измерений около 4 Нм, эти демонстрации потребовали нестандартных процедур, таких как использование помочь структур7 или длинных выдержек для самостоятельной разработки сопротивляется8. Другие nanopatterning методы, такие как электронно лучевые индуцированной осаждения9 или сканирование зонд литографии10,11, оказались способны достичь резолюции суб-4 Нм, хотя они требуют значительно больше времени экспозиции раза по сравнению с EBL.
Современные системы выделенный EBL производят электронных пучков с пятно размером в несколько нанометров длина шкалы (2-10 Нм), что весьма затрудняет определение шаблонов с резолюцией суб-10 Нм. В противоположность этому наша протокол реализует EBL используя аберрация исправлениями СТЕБЕЛЬ, который является высоко оптимизированный инструмент для материала характеристика на Ангстрем длина шкалы. Это различие позволяет рутинной патронирования рекордные литографических функций с одного нанометра резолюция1. Хотя государство из искусства коммерческих аберрация исправлениями стволовых систем стоимости в диапазоне миллионы долларов, они доступны для использования в нескольких учреждениях национальных пользователей, и некоторые доступны без стоимости.
протокол
1. Пробоподготовка для сопротивляться покрытие
Примечание: В этой работе, шаблоны с однозначным нанометра резолюции определяются в PMMA (положительный и отрицательный тон) и HSQ сопротивляется, которые являются спин литой на коммерчески доступных ТЕА windows (примерно 50 мкм x 50 мкм) с SiNx или SiO2 мембраны толщиной от 5 Нм до 50 Нм. Одно или несколько окон ТЕА изготавливаются в 3 мм диаметр кремния, обработки кадра (толщиной 100 мкм). На протяжении этой рукописи мы ссылаемся целое как чип ТЕА и электронно лучевые прозрачной мембраны как окна ТЕА.
- Удалите остатки органических из чип ТЕА, выполняя O2 плазменной очистки для 30 s 100 W (давление в камере 230 тонн на приблизительно 5 sccm O2 потока).
- Расколоть кусок кремниевой пластины, примерно 2 см x 2 см в размер, чтобы использовать в качестве держателя для чипа ТЕА во время противостоять спиннинг.
- Место две полосы ленты двухсторонний углерода примерно одинаковом расстоянии от центра держателя кремния и разлученных немного меньше, чем диаметр ТЕА чип (см. Рисунок 1). Промойте полосы с изопропиловым спиртом (IPA), чтобы уменьшить их слипчивая прочность. Это необходимо избежать нарушения деликатного чип ТЕА во время удаления из держателя Si.
- Смонтируйте ТЕА чип на держателе кремния, убедившись, что он подключен к углерода ленты полосы только на двух противоположных краях, как показано на рисунке 1.

Рисунок 1 : ТЕА чип держатель для сопротивляться спиннинг. Обратите внимание, что ТЕА чип подключен к держателю кремния только на двух краях уменьшить площадь поверхности контакта, и следовательно, силы сцепления. Пожалуйста, нажмите здесь, чтобы посмотреть большую версию этой фигуры.
2. Спиновые пальто параметров для PMMA (положительный и отрицательный тон) и сопротивляется HSQ
Примечание: Противостоять толщина не измеряется непосредственно на чипе ТЕА, так как он мал и обычно противостоят приведен на других тонких слоев (например, Si фильм на SiO2 мембраны), что затрудняет измерение. Вместо этого, противостоять толщина определяется скорость отжима, калибруется с помощью рефлектометрии измерений из фильмов бросили на массовых Si образца. Рефлектометрии результаты были подтверждены, обычно с точностью лучше, чем на 20%, изображения сверху вниз стволовых рухнула структур.
- Смонтировать держатель кремния на Чак спиннер и выровнять по центру окна ТЕА примерно с центром спиннер ротора.
- С помощью пипетки, охватывают весь окно ТЕА с одной капли (примерно 0,05 мл) из PMMA (A2 950K ПММА разбавленный Анизол 0.5-1.0%) или HSQ (1% твердых XR-1541).
- В зависимости от сопротивления используется следуйте спин покрытие и выпечки параметры, показанные в таблице 1.
- Осторожно удалите ТЕА чип из держателя кремния. Проверьте сопротивление единообразия над окном ТЕА с помощью оптического микроскопа. Если фильм является однородной в центральном регионе мембраны, переходите к следующему шагу; в противном случае повторите процесс покрытия противостоять на свежий окно ТЕА.
| Сопротивление | Скорость вращения (в x г) | Фильм Толщина (Нм) | Температура выпечки (° C) | Время выпечки (мин) |
| Положительные тон PMMA | 60 | 30 | 200 | 2 |
| Отрицательные тон PMMA | 60 | 15 | 200 | 2 |
| HSQ | 107 | 10 | Не требуетсяb | Не требуетсяb |
| см Ref.12; bссылка 13 см | ||||
Таблица 1: противостоять спина покрытие и выпечки параметры. Спин скорость единиц в x g рассмотреть чип ТЕА диаметром 3 мм. Выпечка производится на горячей плите для ПММА. Для HSQ13требуется не выпечки. HSQ противостоять хранится в холодильнике, поэтому он должен нагреваться до комнатной температуры перед спиннинг.
3. загрузить образец в стволовых, Карта координаты окна и выполнения фокусировки с высоким разрешением
- Смонтируйте чип сопротивляться покрытием ТЕА на держателя образца стволовых, убедившись, что сопротивляться вакуумные интерфейс сталкивается входящего пучка, так как луч оптимально сосредоточены в верхней части образца. Кроме того убедитесь, что стороны окна ТЕА выровнены примерно с осей x и y - этапа стволовых. Это облегчит переход к окну ТЕА.
- Загрузите чип ТЕА в микроскоп и насос на ночь, для уменьшения примесей в образце камере.
- Переместите этап (x, y) координаты, таким образом, что луч является более чем 100 мкм от центра окна ТЕА (чтобы избежать случайного воздействия). Установите текущий пучок зонд стволовых и энергии 34 ПА и 200 кэВ, соответственно.
- В режиме дифракции изображений (стационарный пучок, z контраст режим и середину угла кольцевой детектор темно поля) Задать масштаб 30 kX с пучком вне фокуса, что делает его легче найти край окна ТЕА.
Примечание: ТЕА края окна можно также найти в режиме визуализации. Мы используем дифракции режим, потому что это быстрее, так как луч не нужно быть отсканированы для формирования изображения. - Перейдите к окну ТЕА до края окна наблюдается на изображении дифракции. Переход вдоль края окна и запись (x, y) координаты четырех углов окна ТЕА.
- В последний угол окна, увеличить масштаб до 50 kX и выполнять в грубая упором на мембране окна, перемещая этап-координата z (z высота регулировки) до кроссовер дифракции наблюдается картина ориентации. Впоследствии выполняют тонкой упором, регулируя текущего объектив.
- Увеличьте масштаб до 180 kX. Отрегулируйте фокус, отчаиваются и аберрации коррекции параметров для того, чтобы получить изображение аберрация исправлениями дифракции мембраны окно, как показано на рисунке 2B. Этот метод фокусировки известен как метод Ronchigram14.

Рисунок 2 : Дифракционного изображения ТЕА окна мембраны. (A) Focused но stigmatic изображения. Аберрация коррекция параметров для этого изображения не являются оптимальными, о чем свидетельствует близко расположенных дифракционных полос. (B) экспозиции не stigmated изображение показаны гладкой плато дифракционный рисунок. Пожалуйста, нажмите здесь, чтобы посмотреть большую версию этой фигуры.
4. предоставляют шаблоны, с помощью исправления аберраций стволовых, оснащены системой генератор шаблона.
Примечание: Аберрация исправлениями стволовых, используемые в этой работе оснащен системой генератор шаблон (PGS), который контролирует положение электронно лучевые подвергать шаблоны определяются с помощью программного обеспечения автоматизированного проектирования (САПР). Доза контролируется путем определения расстояния между точками воздействия (размер шага) и время воздействия на точку. В таблице 2 приводятся параметры экспозиции, используемые в настоящем Протоколе. Шаблоны доступны в центре окна ТЕА в «непрерывное» режиме, поскольку СТЕБЕЛЬ, используемые в этой работе не включает очистку луч. До и после воздействия ПГС позиций луча в любой точке определяемой пользователем в поле зрения (FOV), предпочтительно от области шаблона. Мы используем в этом протоколе верхней правый и нижний правый углы FOV как луч начальной и конечной позиции, соответственно.
| Сопротивление | Точка воздействия | Линия воздействия | Площадь экспозиции | ||
| Доза (ФК/точка) | Размер шага (Нм) | Доза (nC/см) | Размер шага (Нм) | Доза (µC/см2) | |
| Позитивный тон PMMA | 10-100 | 0.5 | 2-8 | 0.5 | 2,000 |
| Негативный тон PMMA | 50-500 | 0.5 | 20 – 40 | 0.5 | 50 000 – 80 000 |
| HSQ | 10-100 | 0.5 | 10 – 20 | 0.5 | 20000-30000 |
Таблица 2: параметры экспозиции для PMMA (положительный и отрицательный тон) и HSQ сопротивляется. Показанные значения являются универсальными, так как оптимальная доза значения зависят от конкретной шаблон дизайна и целевые функции измерения.
- Закройте клапан ворот пучка во избежание любого случайного воздействия сопротивление при движении на стадии. Убедитесь, что ток пучка составляет 34 ПА и увеличение 180 kX.
- Используйте угловой координаты предварительно записанные окна для перемещения стадии, так что центр ПЗ — 5 мкм от центра окна. Откройте луч задвижки и сосредоточиться на этом этапе с помощью Ronchigram метода, описанного в шаге 3.6.
- Закройте запорный клапан луча. Перейти на сцену, чтобы поместить ПЗ в центре окна ТЕА. Изменение масштаба 18 КХ (что соответствует 5 мкм x 5 мкм, кучность ПЗ). Передача управления лучом ПГС и положение луча везде вне области шаблона (мы используем правом верхнем углу в этом протоколе).
- Выполните следующие действия в быстрой последовательности, чтобы избежать излишний сопротивляться на начальный и конечный луч позиций.
- Открыть заслонку и проверить, наблюдая луч дифракции шаблон изображение, ли луч находится в фокусе в первоначальный луч позиции (например, Рисунок 2B). Предоставляйте модель.
- При завершении экспозиции, проверьте если дифракционный шаблон изображения остается в фокус на последний луч позиции. Наконец Закройте запорный клапан.
- Фишки ТЕА из ствола.
5. противостоять развитию и критической точки сушки
Примечание: Процесс развития зависит от используемых сопротивляться. 5.1, 5.2 и 5.3 описывается процесс разработки позитивный тон ПММА, отрицательные тон PMMA и HSQ, соответственно. Однако все сопротивляется доля же окончательный критической точки, сушки, которая необходима во избежание краха шаблон из-за высокой пропорции моделей, изготовленных с настоящим Протоколом. Критическая точка, сушка (CPD)) использует жидкие CO2 в качестве рабочей жидкости, которая не смешивается с водой. Следовательно образец обезвоживания (шаги 5.4-5,7) требуют использования ACS реагент марки изопропиловый спирт (IPA).
- Развитие позитивных тон ПММА15: подготовить 100 мл стакан с раствором IPA:methyl изобутил кетон (MIBK) 3:1. Поместите стакан в термостат при 0 ° C (ледяной ванне при 0 ° C-это нижняя стоимость альтернативного) и подождите, пока температура уравниваются. Grab ТЕА чип с парой пинцетом и осторожно размешать в холодный раствор для 30 s. продолжить с шага 5.4.
- Разработка отрицательной тон ПММА16: осторожно перемешать ТЕА чип в MIBK при комнатной температуре (24 ° C) 2 мин передачи образца раствор ацетона и перемешать на 3 мин продолжить с шага 5.4.
- Разработка HSQ13: перемешать чип ТЕА в «соленое» дейонизированной водный раствор, содержащий 1 wt % NaOH и 4 wt % NaCl, по 4 мин на 24 ° C. Перемешайте чип в чистой деионизированной воды на 2 мин (смыть соленый разработчик). Перейдите к шагу 5.4.
- DIP ТЕА чип в ACS реагент марки IPA и осторожно размешать 30 s.
- Быстро место ТЕА чип на специальные 2" Si пластин показано на рисунке 3A. Убедитесь, что чип ТЕА всегда влажный с IPA во время передачи. После приблизительно 2-3 мин закройте ДСП пластины держателя Ассамблеи как показано на рисунке 3B. Оставьте весь блок замачивания в ACS реагент класс АПИ для дополнительных 15 мин, полностью погружаются в МФА.
- Быстро передавать полный ДСП пластины держателя Ассамблеи второй контейнер с свежими ACS реагент класса IPA и оставить на 15 мин, полностью погружаются в МФА.
- Передача сборки держателей пластин ДСП в палату процесса инструмента ДСП (во все времена ТЕА чип должен быть полностью погружен в IPA). Запустите процесс ДСП после инструкции по эксплуатации инструмента.
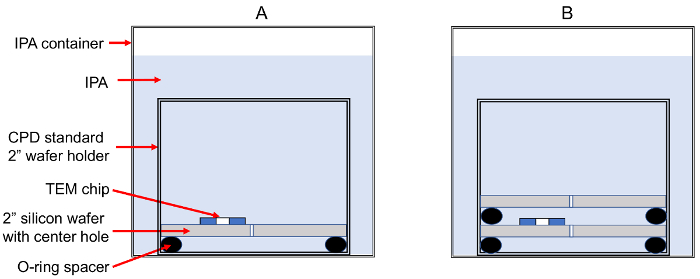
Рисунок 3 : Собственных решений для обезвоживания ТЕА фишки в ДСП Стандартный 2" пластин держатель. (A) схема сбоку ТЕА чипа на Специальный 2" Si пластин с небольшим отверстием просверлил в центре (около 500 мкм в диаметре) чтобы разрешить потока жидкости. Вафля вписывается в ДСП Стандартный 2" пластин держатель поставляемые производителем системы ППР. (B) второй специальный Si пластин прилагается ТЕА чип, тем самым уменьшая турбулентный поток в процессе ДСП. В A и B, ДСП пластины держателя полностью погружается в ACS реагент марки IPA. Пожалуйста, нажмите здесь, чтобы посмотреть большую версию этой фигуры.
Результаты
Рисунок 4 показывает литографических узоры на позитивный тон PMMA (сопротивление удалены из регионов подвергаются после развития) и отрицательной тон PMMA (сопротивление удалены из неэкспонированные районов). ТЕА windows состоит из около 30 Нм толщиной ПММА сопротивляться для положительных тон PMMA (15 Нм толщиной для отрицательных тон ПММА) спина, бросили на 5 Нм толщиной SiNx мембраны. Тонкой металлической пленки (10 Нм AuPd более 5 Нм Ti) был сдан на хранение после разработки позитивный тон ПММА для повышения контраста в стволовых изображений. Для позитивный тон ПММА, средняя маленьких изолированных особенностью является 2,5 ± 0,7 Нм (рис. 4 c, 4 D), в то время как маленький шаг шаблон — 17,5 Нм (Рисунок 4F). Для отрицательных тон ПММА, средняя маленьких изолированных особенностью является 1.7 ± 0,5 Нм (рис. 4 g), в то время как маленький шаг шаблон — 10,7 Нм (Рисунок 4J).

Рисунок 4 : Исправления аберраций Электронная литография из положительных и отрицательной тон ПММА. (Тонкая пленка 10 Нм AuPd более 5 Нм, Ti был сдан на всех позитивный тон ПММА модели показано на этом рисунке.) (A) SEM изображение произвольных шаблонов в позитивный тон ПММА. (B) ТЕА изображение произвольных шаблонов в отрицательной тон ПММА. (C, D) SEM изображения из самых маленьких узорный отверстия в позитивный тон ПММА, среднее отверстие диаметром 2,5 ± 0,7 Нм. (E, F) SEM изображения отверстие массивов определены на позитивный тон ПММА с шагом 21,5 Нм (E) и 17,5 Нм (F). (G, H) ТЕА изображения столба массивов в отрицательной тон ПММА смолой 20 Нм и средняя столба диаметром 1.7 ± 0,5 Нм (G) и 1.8 ± 0,5 Нм (H). (I, J) ТЕА изображения отрицательной тон ПММА столба массивы 15.2 и 10,7 Нм тангажа, соответственно. Все бары масштаба являются 40 Нм. Эта цифра была воспроизведена Manfrinato, в.р., Штайн, а., Чжан, л., ДН, ю. C., Ягер, к.г., стах, E.A и черный, КТ Aberration-Corrected Электронная литография на одной нанометровом масштабе длины. Nano латыш. 17 (8), 4562-4567 (2017). Пожалуйста, нажмите здесь, чтобы посмотреть большую версию этой фигуры.
Рисунок 5 показывает шаблоны, определенные на HSQ сопротивляться. ТЕА окно, используемое для литографии HSQ состояла из примерно 10 Нм толщиной HSQ противостоять спина бросили на 27 Нм толщиной Si мембраны. После экспозиции и противостоять развитию, 3-4 Нм ультра-тонкий слой Si в HSQ-бесплатно регионах (неэкспонированные участки) окна были удалены индуктивный сочетании травления плазмы (ПМС), используя смесь из 50 sccm HBr и 20 sccm Cl2 газов на давление в камере 10 тонн (предвзятости и ICP мощности 60 Вт и 250 Вт, соответственно). Рисунок 5A состоит из четырех рядов коротких вертикальных линий. Верхний, что две строки подвергаются с дозой линии шагнуло экспоненциально от 2 до 120 НК/см (ширина 0 Нм предназначен для этих линий). Две нижние ряды подвергаются области дозой, экспоненциально шагнуло от 3000 до 60000 μC/см2 (5 Нм прямоугольники давно разработан широкий и 200 Нм). Рисунок 5B это увеличенное изображение центр региона в нижней строке Рисунок 5A. Два слева, четыре центра и четыре правой линии подвергаются с дозой области 23 300, 27,300 и 32.000 μC/см2, соответственно. Четыре центра линии имеют средний измеренная ширина 7 Нм.

Рисунок 5 : Исправления аберраций Электронная литография противостоять HSQ. (Окна ТЕА, используемые на этом рисунке был сделан из 27 Нм толщиной Si. После разработки HSQ индуктивно спаренной плазмы травления использовался для удаления 3-4 Нм Си из районов, не охваченных HSQ.) (A) ТЕА изображение четырех строк вертикальных линий воздействию с дозами, экспоненциально варьируется от 2 до 120 НК/см (верхних двух строк) и 3000 до 60000 μC/см2 (две строки снизу). Размер шага луч был 0,5 Нм для всех строк. (B) высокое увеличение изображений ТЕА центрального района в нижней строке (A). Группа 4 линии в центре имеют в среднем измеряется ширина 7 Нм и подвергаются области доза 27,300 μC/см2. Пожалуйста, нажмите здесь, чтобы посмотреть большую версию этой фигуры.
Обсуждение
Наиболее важным этапом в протоколе концентрирует электронного луча до облучения. Это необходимо для достижения высокого разрешения кучность. При выполнении нескольких экспозиций (например, когда ТЕА чип имеет несколько окон и каждый будучи образцу), важно переориентировать пучка перед каждой экспозиции на расстоянии 5 мкм по большинство из области воздействия. Протокол также включает в себя шаги, чтобы проверить фокус пучка до и после воздействия на двух крайних позициях области патронирования (верхние и нижние углы), которая позволяет определить некоторые расфокусировке произошло ли во время структурирования, например из-за мембрана локально наклонена в регионе кучность.
Еще один важный шаг в этот протокол использует критической точки, сушка (ДСП) для просушки образцов после разработки подвергаются противостоять шаблонов. Без этого шага шаблоны будут часто крах из-за высокой пропорции узорной структур (т.е., узорные противостоять боковое размеры меньше, чем толщина). Большинство систем ППР поставляем пластины держателя Стандартный 2». Однако поскольку ТЕА чипов очень малы и узорные структуры довольно деликатная, они может быть поврежден во время процесса ДСП, помещенный в держатели, предназначенные для больших образцов. Рисунок 3 показывает собственных решений для ДСП ТЕА фишки, используя стандартные пластины держателя. Две пластины, с отверстием в центре, поток включение заключите чип ТЕА и защитить его от турбулентного потока во время процесса ДСП.
Определение толщины пленки оптимальное сопротивление пытается сбалансировать конкурирующие требования. С одной стороны, она должна быть тонкой, как можно обеспечить самое высокое разрешение и избежать шаблона развал, но с другой стороны, она должна быть достаточно толстым для шаблон передачи приложений, таких как старт и травления. Этот протокол использует 1% HSQ, который является низкая разрежения коммерчески доступных и чьи дальнейшего разбавления в лаборатории не рекомендуется (наш опыт показывает, что разбавленный HSQ часто приводит к частичной сшивки). Однако, поскольку разреженных ПММА воспроизводимые результаты, этот протокол использует 1% для положительных тон PMMA (толщина 30 Нм) и 0,5% и 1% для негативный тон (толщина 15 и 30 Нм, соответственно). Мы обнаружили, что позитивный тон ПММА сопротивляться не страдают от шаблона развал как отрицательный тон ПММА, таким образом использование тоньше толщины для негативный тон как показано в Таблица 1. Кроме того, отрицательные тон ПММА имеет ~ 50% толщины потери после облучения электронным пучком (и до развития), так что конечная толщина для отрицательных тон ПММА ~ 7-15 Нм. (1.7 и 1.8 Нм функции из рисунка 4 имеют около 7 Нм противостоять толщины, которая находится на пределе шаблона развал). ПММА шаблоны, показанный на рисунке 4 не использовать шаг ДСП; Однако если таковые имеются, этот протокол рекомендует использовать ДСП после развития ПММА шаблонов. Напротив мы нашли ДСП имеет чрезвычайно важное значение для HSQ обработки с тем, что он не может далее разводят (для достижения тоньше толщина) и потому что толще HSQ модели необходимы для использования в качестве маски травления (например, для etch кремния, как показано на рисунке 5 ).
Шаблоны ПММА позитивный тон на рисунке 4 были покрыты тонкой металлической пленкой для увеличения контрастности во время визуализации. Сведения о поддержке в работе Manfrinato и др. 1 показывает, что эффект этой металлического покрытия по метрологии шаблонов является незначительным. Аналогичным образом мы считаем, что результаты, показанные на рисунке 5 на HSQ сопротивляться не зависят от резко конкретного выбора ТЕА окно структуры на основе сверхтонкая толщина подстилающего слоя Si.
В меру наших знаний все измерения, описанной в разделе результаты представитель положительный и отрицательный тон ПММА1 (рис. 4) есть маленький сообщили в литературе на сегодняшний день1,7 , 12 , 16 , 17. Manfrinato и др. 1 также продемонстрировал суб-5 Нм шаблон передачи, от сопротивляться на целевой материал, с помощью обычных металлических старт (для положительных тон ПММА) и последовательных инфильтрации синтеза18 ZnO (для отрицательных тон ПММА). Результаты, показанные на рисунке 5 на HSQ являются не наименьшее сообщил особенности7. Однако, этот протокол является полезной для получения воспроизводимых функций в HSQ с разрешением лучше, чем 10 Нм и демонстрирует однозначным патронирования структур кремния.
Протокол, представленные здесь описывается процесс структурирования произвольных структур с цифрой резолюции нанометр с использованием обычных электронно лучевые сопротивляется PMMA и HSQ. Кроме того результаты, показанные здесь и в ссылка 1 показывают, что такие шаблоны могут быть переданы с высокой точностью целевой материал выбора.
Раскрытие информации
Авторы не имеют ничего сообщать.
Благодарности
Это исследование использовать ресурсы центра для функциональных наноматериалов, который является US DOE отделение объекта от науки, в Брукхейвенской национальной лаборатории по контракту № ДЕ SC0012704.
Материалы
| Name | Company | Catalog Number | Comments |
| Plasma asher | Plasma Etch | PE-75 | Located in class 100 cleanroom |
| Silicon Nitride 5 nm thick TEM Windows (9 SMALL Windows) | TEM windows.com | SN100-A05Q33A | |
| TEM chip holder for resist coating | Home made | ||
| 27 nm thick c-Si TEM Windows | TEMwindows.com | Custom order | |
| A2 950K PMMA diluted in anisole to 0.5-1.0% by weight | MicroChem | M230002 | |
| HSQ (1% solids XR-1541) e-beam resist in MIBK | Dow Corning | XR-1541-001 | |
| Spinner | Reynolds Tech | ReynoldsTech Flo-Spin system | Located in class 100 cleanroom |
| Hot plate | Brewer Science | CEE 1300X | Located in class 100 cleanroom |
| Spectral reflectometer | Filmetrics | F20 | Located in class 1000 cleanroom |
| Bath circulator | Thermo Scientific | Neslab RTE 740 | Located in class 100 cleanroom |
| Optical microscope | Nikon | Eclipse L200N | Located in class 1000 cleanroom |
| MIBK/IPA 1:3 developer | MicroChem | M089025 | |
| Sodium hydroxide | Sigma-Aldrich | 221465 | |
| Sodium chloride | Sigma-Aldrich | 31434 | |
| Isopropyl Alcohol, ACS Reagent Grade | Fisher Scientific | MK303202 | |
| TEM chip holder for critical point drying | Home made | ||
| Critical point drying system | Tousimis | Autosamdri-815B, Series C | Located in class 100 cleanroom |
| Aberration-corrected STEM | Hitachi | HD 2700C | |
| Pattern generation system | JC Nabity Lithography Systems | NPGS v9 | |
| Scanning Electron Microscope (SEM) | Hitachi | S-4800 | |
| Reactive ion etcher | Oxford Instruments | Plasmalab 100 | Located in class 1000 cleanroom |
Ссылки
- Manfrinato, V. R., Stein, A., Zhang, L., Nam, C. Y., Yager, K. G., Stach, E. A., Black, C. T. Aberration-Corrected Electron Beam Lithography at the One Nanometer Length Scale. Nano Letters. 17 (8), 4562-4567 (2017).
- Chen, W., Ahmed, H. Fabrication of 5-7 nm wide etched lines in silicon using 100 keV electron-beam lithography and polymethylmethacrylate resist. Applied Physics Letters. 62 (13), 1499-1501 (1993).
- Vieu, C., Carcenac, F., Pepin, A., Chen, Y., Mejias, M., Lebib, A., Manin-Ferlazzo, L., Couraud, L., Launois, H. Electron beam lithography: resolution limits and applications. Applied Surface Science. 164, 111-117 (2000).
- Hu, W., Sarveswaran, K., Lieberman, M., Bernsteina, G. H. Sub-10 nm electron beam lithography using cold development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 22 (4), 1711-1716 (2004).
- Chen, Y. Nanofabrication by electron beam lithography and its applications: A review. Microelectronic Engineering. 135, 57-72 (2015).
- Jiang, N. On the spatial resolution limit of direct-write electron beam lithography. Microelectronic Engineering. 168, 41-44 (2017).
- Manfrinato, V. R., Zhang, L., Su, D., Duan, H., Hobbs, R. G., Stach, E. A., Berggren, K. K. Resolution Limits of Electron-Beam Lithography toward the Atomic Scale. Nano Letters. 13 (4), 1555-1558 (2013).
- Isaacson, M., Muray, A. In situ vaporization of very low molecular weight resists using 1/2 nm diameter electron beams. Journal of Vacuum Science & Technology B. 19 (4), 1117-1120 (1981).
- van Dorp, W. F., van Someren, B., Hagen, C. W., Kruit, P. Approaching the Resolution Limit of Nanometer-Scale Electron Beam-Induced Deposition. Nano Letters. 5 (7), 1303-1307 (2005).
- Fuechsle, M., Miwa, J. A., Mahapatra, S., Ryu, H., Lee, S., Warschkow, O., Hollenberg, L. C. L., Klimeck, G., Simmons, M. Y. A single-atom transistor. Nature Nanotechnology. 7 (4), 242-246 (2012).
- Randall, J. N., Lyding, J. W., Schmucker, S., Von Ehr, J. R., Ballard, J., Saini, R., Xu, H., Ding, Y. Atomic precision lithography on Si. Journal of Vacuum Science & Technology B. 27 (6), 2764-2768 (2009).
- Arjmandi, N., Lagae, L., Borghs, G. Enhanced resolution of poly(methyl methacrylate) electron resist by thermal processing. Journal of Vacuum Science & Technology B. 27 (4), 1915-1918 (2009).
- Yang, J. K. W., Berggren, K. K. Using high-contrast salty development of hydrogen silsesquioxane for sub-10-nm half-pitch lithography. Journal of Vacuum Science & Technology B. 25 (6), 2025-2029 (2007).
- Lin, J. A., Cowley, J. M. Calibration of the operating parameters for an HB5 STEM instrument. Ultramicroscopy. 19 (1), 31-42 (1986).
- Cord, B., Lutkenhaus, J., Berggren, K. K. Optimal temperature for development of poly(methylmethacrylate). Journal of Vacuum Science & Technology B. 25 (6), 2013-2016 (2007).
- Duan, H. G., Winston, D., Yang, J. K. W., Cord, B. M., Manfrinato, V. R., Berggren, K. K. Sub-10-nm half-pitch electron-beam lithography by using poly(methyl methacrylate) as a negative resist. Journal of Vacuum Science & Technology B. 28 (6), C6C58-C6C62 (2010).
- Dial, O., Cheng, C. C., Scherer, A. Fabrication of high-density nanostructures by electron beam lithography. Journal of Vacuum Science & Technology B. 16 (6), 3887-3890 (1998).
- Kamcev, J., Germack, D. S., Nykypanchuk, D., Grubbs, R. B., Nam, C. Y., Black, C. T. Chemically Enhancing Block Copolymers for Block-Selective Synthesis of Self-Assembled Metal Oxide Nanostructures. ACS Nano. 7 (1), 339-346 (2013).
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеThis article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены