Method Article
Real-Time DC-динамичный Смещение Метод коммутации Улучшение времени в строго Underdamped окантовкой поля электростатических MEMS приводов
В этой статье
Резюме
Прочная конструкция устройства окантовка-полевых электростатических MEMS приводы результатов в своей сути низких сжатие пленок условиях затухания и долго времени установления при выполнении переключений с помощью обычной стадии смещения. Переключение улучшение времени с DC-динамических сигналов в реальном времени уменьшает осаждения время окантовки поля МЭМС приводов при переходе между до-до-вниз и вниз-к-до государств.
Аннотация
Механически underdamped MEMS электростатического окантовка-полевые приводы, хорошо известны за их операцией быстрого переключения в ответ на блок напряжения ступени ввода смещения. Тем не менее, компромисс для повышения производительности коммутации это время относительно долго урегулирования для достижения каждой высоту зазора в ответ на различные напряжениях. Переходный применяются сигналы смещения используются для облегчения сократить время переключения для электростатических окантовка-полевые MEMS приводов с высокими механическими показателями качества. Удаление нижележащей подложки привода окантовка поля создает низкий среда механических потерь необходимо эффективно протестировать концепцию. Удаление основного субстрата также имеет существенное улучшение на производительность надежности устройства в отношении отказа в связи с клейкости. Хотя DC-динамичный смещения полезно в улучшении время установления, необходимые темпы нарастания для типичных MEMS устройств может разместить агрессивные требования к заряда рUMPS для полностью интегрированной на кристалле конструкций. Кроме того, могут быть проблемы интеграции стадию удаления подложки в обратно-истекшим линии коммерческие CMOS этапов обработки. Экспериментальная проверка готовых приводов демонстрирует улучшение в 50 раз время переключения по сравнению с обычной стадии смещения результатов. По сравнению с теоретическими расчетами, экспериментальные результаты находятся в хорошем согласии.
Введение
Микроэлектромеханические системы (MEMS) используют несколько исполнительных механизмов для достижения механического перемещения. Наиболее популярными являются тепловые, пьезоэлектрический, магнитостатическая, и электростатическое. За короткое время переключения, электростатического привода является наиболее популярным методом 1, 2. На практике, критически-затухающие механические конструкции доставить наилучший компромисс между первоначальной временем нарастания и время установления. После приложения напряжения смещения постоянного тока и приведения в мембрану вниз к ниспадающей электрода, время установления не является серьезной проблемой, как мембраны будет оснастку и придерживаться электрода диэлектрической покрытием срабатывания. Несколько приложений воспользовались вышеупомянутой конструкции электростатического привода 3 - 8. Тем не менее, присутствие диэлектрической покрытием со спуском электрода привод восприимчивы к диэлектрической зарядки и клейкости.
MEMS мембраны могут использовать в Underdamped механическая конструкция для достижения быстрой начальной время нарастания. Пример underdamped механической конструкции является электростатическое поле окантовка управления (Effa) МЭМС. Эта топология демонстрирует гораздо меньше уязвимость к типичным механизмов отказа, которые мешают электростатические конструкции основанные 9-20. Отсутствие параллельной противоположного электрода и, следовательно, параллельно электрическому полю, почему эти МЭМС уместно назвать "окантовка поле" приводом (рисунок 1). Для проектирования Effa, выпадающее электрод разделен на два отдельных электродов, которые расположены горизонтально смещенных к движущейся мембраны, полностью исключив перекрытия между подвижной и неподвижной частями устройства. Тем не менее, удаление подложки снизу подвижной мембраны значительно снижает сжатия пленки составляющей амортизации тем самым увеличивая время установления. Фиг.2В показан пример осадительной времени в ответ на Standarд шаг смещения. Переходный или постоянного тока смещения динамического применяется в режиме реального времени могут быть использованы для улучшения время установления 20-26. На рис 2С и 2D иллюстрируют, как качественно изменяющихся во времени сигнала может эффективно отмены звон. Предыдущие попытки исследовательских использовать численные методы для расчета точного напряжения и таймингов входного смещения улучшить время переключения. Метод в этой работе использует компактные выражения замкнутой форме для расчета параметров сигнала входного смещения. Кроме того, предыдущая работа была сосредоточена на параллельных пластин срабатывания. В то время как структуры предназначены для underdamped, сжатие-фильм затухание по-прежнему доступен в этой конфигурации. Метод срабатывания представлены в этой работе является окантовка поля срабатывания. В этой конфигурации сжатие пленки затухания эффективно устранены. Это представляет собой крайний случай, когда механическое затухание луча MEMS является очень низким. Эта статья описывает, как изготовить Dev Effa MEMSльды и выполнить измерение экспериментально проверки концепции сигнала.
протокол
1 Изготовление Effa MEMS фиксированной фиксированной Балки (рисунок 3 для обобщены процесса)
- УФ литографии и химического мокрый травления диоксида кремния с буферной фтористоводородной кислоты (ВНИМАНИЕ 27).
- Используйте окисленный, низкий сопротивления кремниевой подложки.
- Заполните стеклянный стакан с ацетоном 28 (достаточно, чтобы погрузить образец), поместить образец в ацетон заполнено стакане, и разрушать ультразвуком в течение 5 мин на водяной бане ультразвуком.
- Без сушки, непосредственно перенести образец из ацетона химическом стакане в химический стакан, наполненный изопропилового спирта 29 и разрушать ультразвуком в течение 5 мин в водяной бане обработки ультразвуком.
- Высушите образец с азотом (не позволяют изопропиловый спирт испаряется с поверхности).
- Сухой (обезвоживание выпекать) образец на плите, установленной на 150 ° С в течение 10 мин. Разрешить образец, чтобы достичь комнатной температуры после того, как обезвоживание выпекать завершена.
- Поместите образец на патроне фоторезиста центрифуги.Внесите и обойтись 1 мл гексаметилдисилазана (HMDS) на каждые 25 мм диаметра (Внимание 30). Spincoat в 3500 оборотах в минуту в течение 30 сек. Внесите и обойтись 1 мл позитивного фоторезиста на 25 мм в диаметре (Внимание 31). Spincoat образца при 3500 оборотах в минуту в течение 30 сек. Softbake фоторезиста в течение 90 сек при 105 ° C на электрической плитке.
- Используйте маски выпрямитель подвергать образец к УФ-излучению с длиной волны 350-450 нм. Используйте энергию экспозиции 391 мДж / см 2 (ОСТОРОЖНО 32).
- Заполните стеклянный стакан с девелопера ТМАГ (ВНИМАНИЕ 33) и использовать достаточно, чтобы погрузить весь образец.
- Заполните стеклянном стакане деионизированной водой, чтобы быстро прекратить развитие, чтобы избежать чрезмерное.
- Разработка образец для 12-20 сек. Аккуратно агитировать подводную образец.
- Аккуратно и быстро удалить образец из стакана развития и погрузить его в воду стакан, полоскания в течение 10 сек.
- Промыть образец в раковине под проточной деионизированной воды в течение 1-2 мин.
- Тщательно сушите образца с азотом (Не позволяйте деионизированной воде испаряться с поверхности).
- Осмотрите образец под микроскопом.
- При необходимости повторите процедуру разработки с корректировками во времени, чтобы избежать чрезмерное.
- С помощью плазменного реактивного ионного травления (RIE) для придания шероховатости поверхности, чтобы улучшить смачивание поверхности. РИТ настройки 34: 100 SCCM АР, 100 Вт ВЧ-мощность, 50 мТл барокамере, 1 мин.
- Заполните тефлоновую стакан с достаточным количеством оксида буферный травления (БОЭ) для покрытия образца.
- Заполните другую тефлоновую стакан с деионизированной воды для полоскания промежуточного образца.
- Погрузите образец в BOE. Скорость травления составляет 90-100 нм / мин.
- Когда травление будет завершена, промыть в тефлоновой химический стакан, который деионизированной воды в течение 10 сек. Затем промыть образец в раковине под проточной деионизированной воде в течение 1-2 мв.
- Высушите образец с азотом (Не позволяйте деионизированной воде испаряться с поверхности).
- Осмотрите образец под микроскопом.
- Повторите травления и промыть шаги по мере необходимости с учетом корректировок в то время для того, чтобы избежать чрезмерного травление и подрезания фоторезиста.
- Удалить фоторезиста маску.
- Заполните стеклянный стакан с ацетоном (достаточно, чтобы погрузить образец), поместить образец в ацетон заполнено стакане и разрушать ультразвуком в водяной бане для обработки ультразвуком в течение 5 мин.
- Непосредственно взять пробу из ацетона стакан и поместите его в изопропилового спирта заполнено стакане и разрушать ультразвуком в течение 5 мин на водяной бане ультразвуком.
- Высушите образец с азотом (Не позволяйте изопропиловый спирт испаряется с поверхности).
- Химическое травление мокрой кремния с гидроксида тетраметиламмония (ТМАГ) 25% по весу (ОСТОРОЖНО 35).
- Используйте чистую 4 L стакан.
- Используйте конфорку с thermocouple. Использование корзины тефлоновую, который имеет крюк на конце рукоятки для удержания образцов. Используйте магнитную перемешайте стержень для правильного агитации, чтобы облегчить кремния поверхность пузырьков водорода, которые выделяются в процессе объемной травления.
ПРИМЕЧАНИЕ: обратная связь между термопарой и плиты обеспечивает соответствующая температура остается постоянной в течение всего травления. Если освобожден водород не удаляется с поверхности, он может маскировать лежащую в основе кремния с ТМАН. - Налейте ТМАН 25% по массе до 2 л отметки в стакан.
- Поместите термопару в растворе и предварительного нагрева до 80 ° С. Если это возможно, использовать пользовательский приспособление или зажим для удержания термопары для предотвращения помех с вращением магнитной мешалкой.
- Как только раствор достигает необходимой температуры, поместите образцы в корзине тефлоновой и поместить корзину в решении через повешение его от губы стакана. Убедитесь, что корзина не дает покояна дне стакана для того, чтобы оставить место для магнитной мешалки, чтобы повернуть шток.
- Установите скорость вращения магнитной мешалки до 400 оборотов в минуту.
- Скорость травления в растворе составляет 300-350 нм / мин. Необходимая глубина травления 4-5 мкм.
- При необходимости время истекло, чтобы завершить травления, удаления образца из раствора и промыть деионизированной водой в течение 1-2 мин.
- Высушите образец с азотом (Не позволяйте деионизированной воде испаряться с поверхности).
- Используйте профилометра для измерения высотой ступеней.
- Если высота ступени не было достигнуто, разместить образцов в раствор снова для того, чтобы достичь желаемого шага высоту.
- Химическое травление мокрой всего SiO 2 от подложки и термически расти еще 500 нм SiO 2.
- Заполните тефлоновую стакан с плавиковой кислоты 49% по объему (ВНИМАНИЕ 36). Используйте сумму, достаточную для покрытия образца.
- Заполните тефлоновую стакан с деионизированной водой для полоскания образца. Используйте сумму, достаточную для покрытия образца.
- Etch образца с плавиковой кислотой. Оставьте образец в растворе, пока все SiO 2 удаляется. Так как раствор имеет высокую концентрацию, травление будет происходить относительно быстро.
- Промыть в течение 10-20 сек в тефлоновой химический стакан, наполненный деионизированной воды.
- Промыть образец под струей проточной деионизированной воды в раковине в течение 1-2 мин.
- Соединение решение H 2 SO 4: H 2 O 2 (серная кислота: перекиси водорода, пираньи чистый) в соотношении 1: 1 в тефлоновой стакане (ВНИМАНИЕ 37). Используйте достаточно, чтобы покрыть образец.
- Заполните тефлоновую стакан с деионизированной водой для полоскания образца.
- Погрузите образец в H 2 SO 4: H 2 O 2 на 7-10 мин.
- Вкратце, 10 сек, промыть образец в воды на отмывку стакан.
- Тщательно промойте образца в раковине под проточной деионизированной воды в течение 1-2 мин.
- Высушите образец с азотом (Не позволяйте воде испариться с поверхности).
- Выполните влажную термического окисления для роста 500 нм из SiO 2.
- УФ литографии и химического мокрый травления для формирования рисунка SiO 2, чтобы разоблачить кремний, который служит в качестве временного слоя для окончательного освобождения фиксированной фиксированных лучей.
- Заполните стеклянный стакан с ацетоном (достаточно, чтобы погрузить образец), поместить образец в ацетон заполнено стакане и разрушать ультразвуком в водяной бане для обработки ультразвуком в течение 5 мин.
- Непосредственно взять пробу из ацетона стакан и поместите его в изопропилового спирта заполнено стакане и разрушать ультразвуком в водяной бане для обработки ультразвуком в течение 5 мин.
- Высушите образец с азотом (Не позволяйте изопропиловый спирт испаряется с поверхности).
- Сухой (обезвоживание выпекать) образец на плите, установленной на 150 ° С в течение 10 мин. Разрешить тон попробовать достичь RT раз обезвоживание пекут завершена.
- Использование фоторезиста spincoater, spincoat HMDS на образце при 3500 оборотах в минуту в течение 30 сек. Использование фоторезиста spincoater, spincoat позитивного фоторезиста на образце при 3500 оборотах в минуту в течение 30 сек. Softbake фоторезиста в течение 90 сек при 105 ° С на электрической плитке.
ПРИМЕЧАНИЕ: Используйте 1 мл на каждые 25 мм диаметра образца. - Используйте маски выпрямитель подвергать образец к УФ-излучению с длиной волны 350-450 нм. Используйте энергию экспозиции 391 мДж / см 2.
- Заполните стеклянный стакан с разработчиком основе ТМАГ и использовать достаточно, чтобы погрузить весь образец.
- Заполните стеклянном стакане деионизированной водой, чтобы быстро прекратить развитие, чтобы предотвратить чрезмерное.
- Разработка образец для 12-20 сек.
- Аккуратно и быстро удалить образец из стакана развития и погрузить его в воду стакан, полоскания в течение 10 сек.
- Промыть образец в раковине под струей деионизируют жВодный в течение 1-2 мин.
- Тщательно сухой азотом (Не позволяйте воде испариться с поверхности).
- Осмотрите образец под микроскопом.
- При необходимости повторите процедуру разработки с корректировками во времени, чтобы избежать чрезмерное.
- С помощью плазменного RIE для придания шероховатости поверхности, чтобы улучшить смачивание поверхности. RIE настройки: 100 SCCM из Ar, 100 Вт ВЧ мощности, 50 мТл барокамера, 1 мин.
- Заполните тефлоновую стакан с достаточным количеством БОЭ для покрытия образца.
- Наполните стакан с тефлоновым деионизированной воды для полоскания промежуточного образца.
- Погрузите образец в BOE. Скорость травления составляет 90-100 нм / мин.
- Когда травление будет завершена, промыть в тефлоновой химический стакан, который деионизированной воды в течение 10 сек. Затем смойте образца под проточной деионизированной воды в раковине в течение 1-2 мин.
- Высушите образец с азотом (Не позволяйте воде испариться с поверхности).
- Осмотрите образец под microscopэ.
- Повторите травления и промыть шаги по мере необходимости с учетом корректировок в то время для того, чтобы избежать чрезмерного травление и подрезания фоторезиста.
- Заполните стеклянный стакан с ацетоном (достаточно, чтобы погрузить образец), поместить образец в ацетон заполнено стакане, и обрабатывают ультразвуком в водяной бане для обработки ультразвуком в течение 5 мин.
- Непосредственно взять пробу из ацетона стакан и поместите его в изопропилового спирта заполнено стакане и разрушать ультразвуком в водяной бане для обработки ультразвуком в течение 5 мин.
- Высушите образец с азотом (Не позволяйте изопропиловый спирт испаряется с поверхности).
- Sputter депозит 20 нм Ti и 100 нм Аи. Эта пленка служит в качестве слоя гальванического семян на последующей стадии процесса гальванического. Распыление параметры: DC мощность 100 Вт, давление осаждения из 8 мТл, 100 кубических сантиметров в минуту из Ar, базовое давление 3 х 10 -6 Т.
- Удалить воздух из камеры процесса или блокировку нагрузки на атмосферу.
- Загрузите образец вРабочая камера или замок нагрузки.
- Насос в производственную камеру или блокировку нагрузки на вакууме.
- Подождите, пока камера процесс не достигает базовый давление 3 х 10 -6 Т.
- Расположите образец в соответствующее место для осаждения.
- Установите давление в камере до 8 мТл на токе аргона в систему. Точный расход, необходимый для достижения 8 мТл в значительной степени зависит от типа используемой системы. Распыление инструмент, используемый для этой работы используется скорость потока 100 SCCM.
- Включите источник с титановой мишени.
- Presputter титана при 300 Вт в течение 20 мин.
- Плазменным напылением 20 нм титана при 100 W. Точное время осаждения сильно зависит от типа использования системы. Для распыления инструмент, используемый в этой работе, 5 мин необходимо для достижения 20 нм.
- Отключите источник с мишенью титанового напыления.
- Включите источник с золотой цели.
- Presputter золото на 100 Вт в течение 2 мин.
- Sputter100 нм золота на 100 Вт точное время осаждения в значительной степени зависит от распыления инструмент, который используется. Для распыления инструмент, используемый в этой работе, 10 мин достаточно, чтобы обеспечить 100 нм золота.
- Отключите источник с мишенью золотым напылением.
- Закрыть кран подачи газа Ar.
- Удалить воздух из камеры процесса или блокировку нагрузки.
- Выгрузка образец, как только камера процесс или замок нагрузка достигает атмосферу.
- Насос замок нагрузки или технологическую камеру до высокого вакуума.
- УФ литографии, чтобы создать форму фоторезиста, который определяет геометрию фиксированной фиксированной балки.
- Заполните стеклянный стакан с ацетоном (достаточно, чтобы погрузить образец), поместить образец в ацетон, заполненной стакане в течение 5 мин.
- Непосредственно взять пробу из ацетона стакан и поместите его в изопропиловый спирт, заполненной стакане в течение 5 мин.
- Высушите образец с азотом (Не позволяйте изопропиловый спирт испаряется с поверхности).
- Сухой (обезвоживание выпекать) образец на плите, установленной на 150 ° С в течение 10 мин. Разрешить образец, чтобы достичь комнатной температуры после того, как обезвоживание выпекать завершена.
- Использование фоторезиста spincoater, spincoat HMDS на образце при 3500 оборотах в минуту в течение 30 сек. Использование фоторезиста spincoater, spincoat позитивного фоторезиста на образце при 2000 оборотах в минуту в течение 30 сек. Softbake фоторезиста в течение 90 сек при 105 ° С на электрической плитке.
ПРИМЕЧАНИЕ: Используйте 1 мл на каждые 25 мм диаметра образца. - Используйте маски выпрямитель для выравнивания и подвергать образец к УФ-излучению с длиной волны 350-450 нм. Используйте энергию экспозиции 483 мДж / см 2.
- Заполните стеклянный стакан с ТМАГ разработчика основе и использовать достаточно, чтобы погрузить весь образец.
- Заполните стеклянном стакане деионизированной водой, чтобы быстро прекратить развитие того, чтобы предотвратить чрезмерное.
- Разработка образец для 12-20 сек.
- Аккуратно и быстро удалить образец из стакана развития и корпусов погружныхОбъединить его в воде стакане полоскания в течение 10 сек.
- Промыть образец в раковине под проточной деионизированной воды в течение 1-2 мин.
- Высушите образец с азотом (Не позволяйте воде испариться с поверхности).
- Осмотрите образец под микроскопом.
- При необходимости повторите процедуру разработки с корректировками во времени, чтобы избежать чрезмерное.
- Electroplate золотые MEMS луч.
- Используйте 1 л стакан стеклянный стакан.
- Заполните стакан с 700 мл коммерчески доступного, готовый к использованию золота гальванического раствора (ВНИМАНИЕ 38) .Установить заполненной стакане на электрической плитке.
- Установите конфорку до 60 ° C. С помощью термопары, чтобы гарантировать, что решение остается при желаемой температуре. После того, как раствор достигнет желаемой температуры, приложите образец к арматуре, которая держит анод, заготовку (образец) и термопары.
- Установите подачу тока к соответствующей амплитуды, основанного на выставкеSED металлизированной площадь образца. Постоянной плотности тока 2 мА / см 2 используется.
- Анод из нержавеющей стали используется.
- Подключение эфире с анодом и землей к образцу.
- Скорость осаждения 250-300 нм / мин. Конечная толщина фиксированной фиксированной балки 0,5 мкм. Учитывая, что приблизительная 4: существует соотношение 1 в стоимость травления гальванического для распыленного золота (при снятии распыленных семян слой), пучок гальваническим до 1 мкм.
- Когда необходимая пауза, отключить подачу тока, отсоедините провода от анода и заготовки, удалить образец, и промыть под проточной деионизированной воды в раковине в течение 1 мин.
- Сушите образца с азотом (Не позволяйте воде испариться с поверхности).
- Используйте микроскоп и профилометром чтобы убедиться, что гальванических завершена.
- Etch фоторезиста плесень.
- Разогреть гдевушка химический стакан с выделенным фоторезиста стриппер на электрической плитке до 110 ° С (Внимание 39). Погружение образца в растворе в течение 1 часа.
- Снимите стакан с плитой и позволяют решение и попробовать достичь RT.
- Промыть образец под струей проточной воды в раковине в течение 1-2 мин.
- Погружение образца в химический стакан, наполненный ацетоне в течение 5 мин.
- Погружение образца в химический стакан, наполненный изопропилового спирта в течение 5 мин.
- Высушите образец с азотом (Не позволяйте изопропиловый спирт испаряется с поверхности).
- Осмотрите образец под микроскопом и измеряют высотой ступеней с гальваническим Au с профилометром. Повторите шаги очистки при необходимости.
- Химическая влажная травление семян слой Ti / Au.
- Место образец в плазме РИТ и использовать следующие параметры: 100 SCCM АР, 100 Вт, 50 м на 30 сек.
- Заполните тефлоновое или стеклянный стакан с Au травителя (ВНИМАНИЕ 40). Используйте enougч, чтобы покрыть весь образец.
- Заполните тефлоновое или стеклянный стакан с деионизированной водой. Это стакан будет служить в качестве промежуточного стакане полоскания быстро прекратить травления Au.
- Погрузите образец в травителя Au. Etch параметры - RT, 7-8 нм / с, волнение. После завершения травления, погрузить образец в промывочной воды химический стакан и осторожно перемешивать в течение 10-20 сек.
- Промыть образец под струей проточной деионизированной воды в раковине в течение 1-2 мин.
- Азот удар сухой (Не позволяйте воде испариться с поверхности).
- Проверьте травления под микроскопом и, если необходимо, повторить, пока все АС не будет удален из открытых участках.
- Выполните плазменный RIE снова на образец со следующими параметрами: 100 SCCM АР, 100 Вт, 50 м на 30 сек.
- Заполните тефлоновую стакан с BOE (достаточно, чтобы погрузить образец).
- Заполните тефлон деионизированной водой для полоскания образца.
- Погрузите образец в BOE при комнатной температуре.травления скорость будет 15-18 нм / min.When травление время завершена, извлеките пробу из стакана и погрузить его в полоскания стакане в течение 10-20 сек.
- Промыть образец под струей проточной деионизированной воды в раковине в течение 1-2 мин.
- Азот удар сухой (Не позволяйте воде испариться с поверхности).
- Проверьте травления и, при необходимости, повторить, пока все титан не будет удален из открытых участках. Сокращение времени травления, чтобы избежать значительного подрезку.
- Выполните сухой изотропное XEF 2 травления (Внимание 41), которые селективно удаляет кремний и отпускает Au фиксированной фиксированных лучей.
- Удалить воздух из технологическую камеру в атмосферу.
- Загрузить образец в технологической камере.
- Насос системы до вакуума.
- Время травления сильно зависит от открытой площади и типа используемой системы травления. Для этого образца давление 3 T с циклом 30 сек используется. Используются 10 циклов. Скорость травления 110-120 нм / мин извлекается.
- После того, как параметр травление установлены в системе, травления временного слоя кремния.
- Когда травление полное выполнить необходимые шаги продувки для обеспечения токсичные газы удаляются перед удаление воздуха в атмосферу. Система в этом исследовании есть процесс, который автоматически выполняет эту продувки шаг.
- Удалить воздух из технологическую камеру в атмосферу.
- Осторожно снимите образцы.
- Насос в производственную камеру до вакуума.
2 Экспериментальная проверка динамической Waveform
- Образец Нагрузка на зонда станции постоянного тока.
- Поместите образец на патроне зонда станции постоянного тока.
- Активируйте вакуум патрона провести пробу вниз.
- Используйте DC наконечник зонда манипуляторы позиционировать советы вольфрамового зонда на смещающая подушками мостов MEMS.
- Используйте микроскоп зонда станции постоянного тока, чтобы просмотреть точное позиционирование кончика вольфрама зондас по ДК смещения колодки устройства. Фиксированной фиксированный луч зондируют кончике сигнал зонда живой в то время как в выпадающем электроды зондируют кончике земля зонда.
- Программа динамического смещения сигнала на генератор функции.
- Использование расчетных значений для первой волны параметров 20.
- Выберите произвольную функцию сигнала на генератор функции для создания динамического сигнала.
- Введите время параметры сигнала. В зависимости от типа функционального генератора, первый параметр времени начинается после того, как несколько микросекунд (в отличие от 0 мкс). Интервал между первой и второй параметр времени будет расчетное время это займет луч достичь разрыв перерегулирования. Интервал между второй и третий параметр времени должно быть достаточно длинным, чтобы луч полностью достичь равновесия с минимальным колебанием. При вводе параметров времени для работы в обратном направлении (от выдвижной делWN выпустить), Время задержки разрыв будет определить временной интервал между третьим параметром времени и выключения. Там будет пятый интервал времени нужно, чтобы перезапустить волну. Для этого интервала разрешения достаточного времени для лучу достичь равновесия перед перезапуском цикла.
- Ввод параметров напряжения сигнала. Напряжения будет фракцию фактического напряжения, приложенного к балке, так как этот сигнал будет проходить через линейный усилитель. Значения, запрограммированные в функции генератора для этого исследования были 1/20 фактического напряжения.
- Подключите выход функционального генератора на высокой скорости линейного усилителя высокого напряжения.
- Подключение выход линейного усилителя с цифровым осциллографом с частотой дискретизации 300 МГц. Осциллограф используется для проверки сигнала с выхода генератора сигналов произвольной формы.
- Подключите выход линейного усилителя для манипуляторов постоянного тока. Убедитесь, что генератор функцияот при выполнении этого шага.
- Настройка и измерить с лазерной доплеровской виброметра (LDV)
- Расположите головку, которая держит LDV по образцу.
- Включение лазера.
- Используйте микроскоп, который интегрирован с LDV, чтобы найти нужную луч для измерения.
- Фокусировки лазерного по центру моста МЭМС. Это точка максимального отклонения.
- Убедитесь, что интенсивность отражения лазерного луча достаточно для точного измерения.
- Установите время выборки в соответствующий частоте дискретизации. Это измерение использует частоту дискретизации 5,1 МГц.
- Выберите выход смещения от времени для LDV.
- Выберите режим непрерывного измерения.
- Применить сигнал смещения на мостах MEMS. LDV захватит звонка эффект в реальном времени.
- Настройтесь сроки и напряжения параметры на функции генератора для достижения минимального колебания луча на выпадающем и выпускаоперации.
- После того, как оптимальные значения находятся выключить сигнал смещения.
- Выключите режим измерения LDV непрерывный.
- Поднимите советы DC датчиков по сравнению с смещающая колодки.
- Подключите запуска ввода функционального генератора к пусковым выходом интерфейса LDV оборудования. Для этого исследования кабель BNC используется для связи.
- Установите функцию генератора признать внешний триггер из системы LDV.
- Установите программное обеспечение LDV, чтобы вызвать функцию генератора, когда начинается режим сканирования измерений.
- Установите LDV программное обеспечение в режим одного сканирования. Время одного сканирования будет длительность сигнала.
- Бросьте советы DC зонда обратно на смещающим колодки моста MEMS.
- Захват сигнала сканирования путем активации режима измерения LDV.
- Сохранить смещение против временных данных.
Результаты
Установка на рисунке 4 используется для захвата прогиб против временных характеристик мостов MEMS. С помощью лазерного доплеровского виброметра в его непрерывном режиме измерения, точные напряжения и временные параметры могут быть найдены, чтобы привести к минимальной колебаний пучка на нужную высоту зазора. Рисунок 5 иллюстрирует пример отклонение луча в соответствии с высотой 60 V зазора. Видно, что практически все колебаний будет удален. Мало того, что динамический сигнал полезно для одной высоте зазора, но и для всех высотах зазора можно. Это показано на рисунке 6 и рисунке 7 для обоих выпадающих и высвобождения операций, соответственно. Расчетные и измеренные формы динамической волны используются для достижения результатов измерения в предыдущих фигур представлены на рисунках 8 и 9, соответственно.
Alt = "Рисунок 1" SRC = "/ файлы / ftp_upload / 51251 / 51251fig1highres.jpg" />
Рис.1 2D эскиз и СЭМ-изображение MEMS мостов, используемых в данном исследовании. () 2D профиль. (B) Вид сверху MEMS мостов. (C) SEM фактического изготовленного устройства. Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.

Рисунок 2 Эскиз underdamped MEMS моста в ответ на входной шаг и изменяющихся во времени ответа. (A) Блок шаг применяется уклон. (B) Реакция underdamped MEMS моста к блок пошагового ввода. (C) Время изменения / динамический уклон ввода. (D) Реакция MEMS моста переменного входного времени.rget = "_blank"> Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.

Рисунок 3 Обобщенная последовательность технологических операций для MEMS мостов. (А) Окисленный кремниевую подложку. (В) Насыпная травления кремниевой подложки. (С) повторное окисление кремниевой подложке. (D), кремния диоксид травление подвергать жертвенный кремний. (E) Gold осаждение и кучность стрельбы. (F) травления жертвенный слой кремния выпустить MEMS мост. Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.
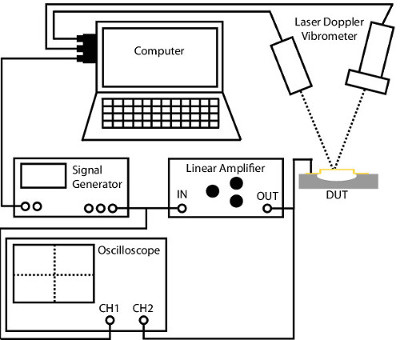
Рисунок 4 Блок-схема экспериментальной себетуп используется для применения сигнал смещения и захватить отклонение MEMS моста. Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.

Рисунок 5 Измеряется прижимные и отпустите состояния моста MEMS в ответ на входной уклоном 60 V. Черная кривая является ответ от пошагового ввода. Красная кривая является ответом на входе динамической.

Рисунок 6 Измеренные промежуточные высоты выпадающее разрыв моста MEMS в ответ на динамического ввода. Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную Версионный этой фигуры.

Рисунок 7 Измеренная промежуточных высот срабатыванием моста MEMS в ответ на динамического ввода.

Рисунок 8. Расчетные сигнала для входного смещения.

На рисунке 9 Фактический сигнал используется для достижения минимального колебание MEMS моста.
Обсуждение
Низкое остаточное напряжение Au пленку осаждением и сухой выпуск с XeF 2 являются критически компоненты в успешном изготовлении устройства. Электростатические приводы окантовка поля обеспечивают относительно низкие силы по сравнению с приводами полевых плоскопараллельных. Типичные MEMS тонкопленочные стрессы> 60 МПа приведет к чрезмерно высоким напряжением привода, который может потенциально сказаться на надежности Effa MEMS. По этой причине гальванического рецепт тщательно характеризуется чтобы получить тонкую пленку с низким би-осевой среднего напряжения. Кроме того, это исследование использует кремний в качестве расходуемого типа слоя вследствие его относительной отсутствие расширения и сжатия (по сравнению с фоторезистом) во время стадий процесса, которые требуют тепловых циклов. Наконец, сухой шаг релиз с ХеР 2 облегчает обработку высоким выходом практически исключает прилипание.
Желаемый высота зазора луч соответствует высоте превышение зазора (Рисунок 2B ) в ответ на первый шаг смещения 20. После того, как луч достигает перерегулирование / желаемой высоты зазора второй этап смещения (фиг.2С) применяется для удержания луча в этом положении. Зная механическую добротность MEMS моста (который может быть измерено или рассчитано), процент перерегулирование и время, чтобы достичь высоты превышение зазора может быть вычислена. Эти параметры используются для определения амплитуды и времени входного напряжения.
DC-динамические сигналы привода, используемые в этом исследовании улучшили время установления от ~ 2 мс до ~ 35 мкс для обоих до-до-вниз и вниз-к-до государств. Расчетное время переключения с помощью эвристического модель 20 является 28 мкс для пучка с шириной W = 10 мкм, длина L = 400 мкм, толщина т = 0,45 мкм, боковая выпадающее разрыв с = 8 мкм, и остаточную прочность на разрыв среднее напряжение σ = 5 МПа. Время переключения имеет σ -1 / 2 отношения 20. Тон следствием этих отношений является то, что относительно небольшие изменения в остаточных напряжений может иметь не-незначительное влияние на расчет времени переключения. Относительно небольшое различие 2 МПа, в остаточных напряжений может привести к изменению времени переключения на 20%. Поэтому существует потребность в оптимизации в реальном времени с методом, изложенным в этой статье в связи с неизбежностью вариации процесса через пластины.
Метод, представленный в этой работе демонстрирует значительные улучшения в время переключения для электростатических приводов окантовка полевых где подложка удаляется. Детали для изготовления тюнеров Effa МЭМС и электрических испытаний описаны подробно. Экспериментальный метод, в частности динамической техники смещения, найдут применение в практически любой механически underdamped MEMS дизайна в отношении повышения эффективности времени переключения.
Раскрытие информации
Авторы не имеют ничего раскрывать.
Благодарности
Авторы хотели бы поблагодарить Райан Танга за помощь и полезные обсуждения технических вопросов.
Авторы также хотели бы поблагодарить за помощь и поддержку технического персонала Бирка Нанотехнологии Center. Эта работа была поддержана обороны перспективных исследований Проекты агентства по Пердью СВЧ Reconfigurable Evanescent-моды резонатора Фильтры исследование. А также НАЯБ Центра прогнозирования надежности, целостности и живучести Microsystems и Министерством энергетики под Award Число DE-FC5208NA28617. Взгляды, мнения и / или выводы, содержащиеся в этой статье / презентации, принадлежат авторов / докладчиков и не должны интерпретироваться как представляющие официальную позицию или политику, явно выраженных или подразумеваемых, из передовых оборонных исследований Проекты агентства или отдела обороны.
Материалы
| Name | Company | Catalog Number | Comments |
| Chemicals | |||
| Buffered oxide etchant | Mallinckrodt Baker | 1178 | Silicon dioxide etch, Ti etch |
| Acetone | Mallinckrodt Baker | 5356 | Wafer clean |
| Isopropyl alcohol | Honeywell | BDH-140 | Wafer clean |
| Hexamethyldisilizane | Mallinckrodt Baker | 5797 | Adhesion promoter |
| Microposit SC 1827 Positive Photoresist | Shipley Europe Ltd | 44090 | Pattern, electroplating |
| Microposit MF-26A developer | Shipley Europe Ltd | 31200 | Develop SC 1827 |
| Tetramethylammonium hydroxide | Sigma-Aldrich | 334901 | Bulk Si etch |
| Sulfuric acid | Sciencelab.com | SLS2539 | Wafer clean |
| Hydrogen peroxide | Sciencelab.com | SLH1552 | Wafer clean |
| Transene Sulfite Gold TSG-250 | Transense | 110-TSG-250 | Au electroplating solution |
| Baker PRS-3000 Positive Resist Stripper | Mallinckrodt Baker | 6403 | Photoresist stripper |
| Gold etchant type TFA | Transense | 060-0015000 | Au etch |
| Equipment | |||
| Mask aligner | Karl Suss MJB-3 | Pattern photoresist | |
| Sputter coater | Perkin Elmer 2400 Sputterer | Deposit metal | |
| Thermal oxidation furnace | Pyrogenic Oxidation Furnace | Grow silicon dioxide | |
| Reactive Ion Etch | Plasmatech RIE | Plasma ash | |
| Xenon difluoride dry etcher | Xactix Xenon Difluoride Etcher | Selective dry isotropic silicon etch | |
| Surface profilometer | Alpha-Step IQ | Step height measurement | |
| Probe ring | Signatone | Holds DC probe manipulators | |
| DC manipulators | Signatone S-900 Series Micropositioner | Applies potential difference to device | |
| Laser doppler vibrometer | Polytec OFV-551/MSA-500 Micro System Analyzer | Switching time measurement | |
| Digital function generator | Agilent E4408B Function Generator | Creates the DC-dynamic waveform | |
| High voltage linear amplifier | Single channel high voltage linear amplifier A400 | Facilitates high voltage | |
| Digital oscilloscope | Agilent DS05034A Digital Oscilloscope | Verify the dynamic waveform parameters | |
Ссылки
- Rebeiz, G. RF MEMS: Theory, Design, and Technology. , John Wiley and Sons. (2003).
- Senturia, S. D. Microsystem Design. , Springer. (2001).
- Bouchaud, J. Propelled by HP Inkjet Sales, STMicroelectronics Remains Top MEMS Foundry. , Available from: http://www.isuppli.com/MEMS-and-Sensors/News/Pages/Propelled-by-HP-Inkjet-Sales-STMicroelectronics-Remains-Top-MEMS-Foundry.aspx (2011).
- Lantowski, K. G. D. The Future of Cinema Has Arrived: More Than 50,000. Theatre Screens Worldwide Feature The Brightest, 2D/3D Digital Cinema Experience With DLP Cinema. , Available from: http://www.dlp.com/technology/dlp-press-releases/press-release.aspx?id=1510 (2011).
- Bosch-Wachtel, T. Knowles Ships 2 Billionth SiSonic MEMS Microphone. , Available from: http://pressrelease.smartoman.com/?p=2810 (2011).
- Burke, J. Mirasol Display Capabilities Add Color and Interactivity to Improve User Experience for Renowned Jin Yong Branded Device. , Available from: http://www.mirasoldisplays.com/press-center/pressreleases/2012/01/koobe-taiwan%E2%80%99s-leading-e-reader-manufacturer-and-qualcommbring (2012).
- Bettler, D. MEMStronics Captures Prestigious R & D 100 Award. , Available from: http://www.memtronics.com/files/MEMtronics_Press_Release7_1_2011.pdf (2011).
- Marsh, C. Omron Releases New RF MEMS Switch with Superior High Frequency Characteristics rated to 100 Million Operations. , Available from: http://www.components.omron.com/components/web/pdflib.nsf/0/. D69D5B6BCBE68DC2862574FD005B5141/$file/Omron 2MES-1 PR final.pdf (2008).
- Rosa, M. A., Bruyker, D. D., Volkel, A. R., Peeters, E., Dunec, J. A novel external electrode configuration for the electrostatic actuation of MEMS based devices. J. Micromech. Microeng. 14, 446-451 (2004).
- Rottenberg, X., et al. Electrostatic fringing-field actuator (EFFA): application towards a low-complexity thin film RF-MEMS technology. J. Micromech. Microeng. 17, S204-S210 (2007).
- Allen, W. N., Small, J., Liu, X., Peroulis, D. Bandwidth-optimal single shunt-capacitor matching networks for parallel RC loads of Q >> 1. Asia-Pacific Microw. Conf (Singapore). , 2128-2131 (2009).
- Small, J., Liu, X., Garg, A., Peroulis, D. Electrostatically tunable analog single crystal silicon fringing-field MEMS varactor. Asia-Pacific Microw Conf (Singapore). , 575-578 (2009).
- Liu, X., Small, J., Berdy, D., Katehi, L. P. B., Chappell, W. J., Peroulis, D. Impact of mechanical vibration on the performance of RF MEMS evanescent-mode tunable resonators. IEEE Microw. Wireless Compon. Lett. 21, 406-408 (2011).
- Small, J., et al. Electrostatic fringing field actuation for pull-in free RF-MEMS analog tunable resonators. J. Micromech. Microeng. 22, 095004(2012).
- Su, J. A lateral-drive method to address pull-in failure in MEMS. , Dept. Elect. Comput. Eng., University of Notre Dame. (2008).
- Scott, S., Peroulis, D. A capacitively-loaded MEMS slot element for wireless temperature sensing of up to 300°C . IEEE MTT-S Int. Microwave Symp. Dig, Boston, MA, USA, , 1161-1164 (2009).
- Scott, S., Sadeghi, F., Peroulis, D. Inherently-robust 300C MEMS sensor for wireless health monitoring of ball and rolling element bearings. IEEE Sensors, Christchurch, New Zealand, , 975-978 (2009).
- Lee, K. B. Non-contact electrostatic microactuator using slit structures: theory and a preliminary test. J. Micromech. Microeng. 17, 2186-2196 (2007).
- Su, J., Yang, H., Fay, P., Porod, W., Berstein, G. H. A surface micromachined offset-drive method to extend the electrostatic travel range. J. Micromech. Microeng. 20, 015004(2010).
- Small, J., Fruehling, A., Garg, A., Liu, X., Peroulis, D. DC-dynamic biasing for >50x switching time improvement in severely underdamped fringing-field electrostatic MEMS actuators. J. Micromech. Microeng. 22, (2012).
- Borovic, B., Liu, A. Q., Popa, D., Cai, H., Lewis, F. L. Open-loop versus closed-loop control of MEMS devices: Choices and issues. J. Micromech. Microeng. 15, 1917-1924 (2005).
- Pons-Nin, J., Rodriquez, A., Castaner, L. M. Voltage and pull-in time in current drive of electrostatic actuators. J. Microelectromech. Syst. 11, 196-205 (2002).
- Czaplewski, D. A., et al. A Soft Landing Waveform for Actuation of a Single-Pole Single-Throw Ohmic RF MEMS Switch. J. Microelectromech. Syst. 15, 1586-1594 (2006).
- Elata, D., Bamberger, H. On the dynamic pull-in of electrostatic actuators with multiple degrees of freedom and multiple voltage sources. J. Microelectromech. Syst. 15, 131-140 (2006).
- Chen, K. S., Ou, K. S. Fast positioning and impact minimizing of MEMS devices by suppression motion-induced vibration by command shaping method. Proc. IEEE 22nd Int. Conf. Micro Electro Mech. Syst, Sorrento, Italy, , 1103-1106 (2009).
- Chen, K. S., Yang, T. S., Yin, J. F. Residual vibration suppression for duffing nonlinear systems with electromagnetical actuation using nonlinear command shaping techniques. ASME J. Vibration and Acoustics. 128, 778-789 (2006).
- Buffered oxide etchant; MSDS No. B5636 [Online]; . , Mallinckrodt Baker, Inc. Phillipsburg, NJ. Available from: http://nrf.aux.eng.ufl.edu/_files/msds/299.pdf (2009).
- Acetone; MSDS No. A0446 [Online]. , Mallinckrodt Baker, Inc.. Phillipsburg, NJ. Available from: http://www.clean.cise.columbia.edu/msds/acetone.pdf (2001).
- Isopropyl alcohol. MSDS No. BDH-140 [Online]. , Honeywell. Muskegon, MI. Available from: http://grice.cofc.edu/pdf/MSDS/Rm205/Plante/Isopropyl%20Alcohol%2099%25.pdf (2005).
- Hexamethyldisilazane. MSDS No. H2066 [Online]. , Mallinckrodt Baker, Inc. Phillipsburg, NJ. Available from: http://kni.caltech.edu/facilities/msds/hmds.pdf (2007).
- Microposit SC 1827 Positive Photoresist. [Online]. , Rohm and Haas Electronic Materials LLC. Marlborough, MA. Available from: http://mfc.engr.arizona.edu/safety/MSDS%20FOLDER/Microposit%20SC%201827%20Photoresist.pdf (2004).
- SUSS MJB 3 mask aligner operator’s reference manual rev A. [Online]. , Karl Suss. Available from: http://www.acsu.buffalo.edu/~btvu/doc/cr/Suss%20MJB-3%20Operator's%20Manual.pdf (2013).
- Microposit MF-26A developer. [Online]. , Shipley Europe Ltd. Coventry, UK. Available from: http://www.nanotech.wisc.edu/CNT_LABS/MSDS/Developers/MSDS%20MF26A.pdf (2000).
- Technics 800 Micro RIE Operating Manual. [Online]. , Available from: http://research.engineering.ucdavis.edu/cnm2/wp-content/uploads/sites/11/2013/05/Technics800RIE.pdf (2008).
- Tetramethylammonium hydroxide. MSDS No. 334901 [Online]. , Sigma-Aldrich. Saint Loius, MO. Available from: http://www.sigmaaldrich.com/MSDS/MSDS/DisplayMSDSPage.do?country=US&language=en&productNumber=334901&brand=SIAL&PageToGoToURL=http%3A%2F%2Fwww.sigmaaldrich.com%2Fcatalog%2Fproduct%2Fsial%2F334901%3Flang%3Den (2012).
- Hydrofluoric acid. [Online]. , Sciencelab.com, Inc. Houston, TX. Available from: http://www.sciencelab.com/msds.php?msdsId=9924296 (2012).
- Piranha clean. [Online]. , Tufts University Standard Operating Procedure. Available from: http://engineering.tufts.edu/microfab/index_files/SOP/PiranhaClean_SOP.pdf (2007).
- Transene Sulfite Gold TSG-250. Product Number: 110-TSG-250. , Transene Company. Danvers, MA. (2012).
- Baker PRS-3000™ Positive Resist Stripper. MSDS No. B0203 [Online]. , Mallinckrodt Baker, Inc. Phillipsburg, NJ. Available from: http://mcf.tamu.edu/docs/msds-pdfs/BAKER-PRS-3000.pdf (2001).
- Gold etchant type TFA. Product Number: 060-0015000. , Transene Company. Danvers, MA. (2012).
- Xenon Difluoride Etching System. Lab manual Chapter 7.5 [Online]. , Marvell Nanofabrication Laboratory. Berkeley, CA. Available from: http://nanolab.berkeley.edu/labmanual/chap7/7.5xetch.pdf (2003).
- Garg, A., Small, J., Mahapatro, A., Liu, X., Peroulis, D. Impact of sacrificial layer type on thin film metal residual stress. IEEE Sensors, Christchurch, New Zealand, , 1052-1055 (2009).
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеСмотреть дополнительные статьи
This article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены