Method Article
Real-Time DC-דינמית הטיית שיטה להחלפת זמן שיפור בשולים בשדה קשות Underdamped תנעי MEMS אלקטרוסטטית
In This Article
Summary
עיצוב המכשיר חזק של תוצאות מפעילי MEMS אלקטרוסטטי fringing שדה בתנאי מיסוד נמוכים לסחוט סרט דעיכת ופעמים רבות יישוב בעת ביצוע פעולות מיתוג באמצעות הטיית צעד קונבנציונלית. בזמן אמת מיתוג שיפור זמן עם צורות גל DC-דינמיים מקטין את הזמן ליישב של שולים בשדה MEMS מפעילים כאשר מעבר בין up-to-למטה ולמטה אל את המדינות.
Abstract
מכאני מפעילי MEMS fringing השדה אלקטרוסטטי underdamped ידועים, בנוסף לפעולת המיתוג המהיר שלהם בתגובה למתח הטיה קלט צעד יחידה. עם זאת, הפשרה לביצוע המיתוג המשופר היא זמן ארוך יחסית יישוב כדי להגיע לכל גובה פער בתגובה לעם מתח שונים. חלוף להחיל צורות גל הטיה מועסקות כדי להקל פעמים מיתוג מופחתות למפעילי MEMS fringing השדה אלקטרוסטטי עם גורמי איכות מכאניים גבוהים. הסרת המצע הבסיסי של מפעיל fringing השדה יוצר סביבת דעיכת המכנית הנמוכה נחוצה כדי לבדוק בצורה יעילה את הרעיון. ההסרה של המצע הבסיסי גם יש שיפור משמעותי בביצועים אמינים של המכשיר בכל הקשור לכישלון בשל stiction. למרות הטיית DC-דינמית היא שימושית בשיפור זמן שיקוע, שיעורי שורה ארוכה הנדרשים להתקני MEMS טיפוסיים עשויים להציב דרישות אגרסיביות בעמ 'תשלוםumps למלוא משולב עיצובים על השבב. בנוסף, ייתכן שיש אתגרי שילוב צעד הסרת המצע למדרגות עיבוד CMOS המסחרי העורפי של-אונליין. אימות ניסיוני של מפעילים מפוברקים מדגימה שיפור של 50x בזמן מעבר בהשוואה לתוצאות שלב הטיית קונבנציונליות. בהשוואה לחישובים תיאורטיים, תוצאות הניסוי הן בהסכם טוב.
Introduction
מערכות מייקרו (MEMS) לנצל כמה מנגנוני actuation להשיג עקירה מכאנית. הפופולרי ביותר הם תרמית, פיזואלקטריים, magnetostatic, ואלקטרוסטטית. לזמן מיתוג קצר, actuation אלקטרוסטטי הוא הטכניקה הפופולרית ביותר 1, 2. בפועל, עיצובים מכאניים ביקורתי דכאו לספק את הפשרה הטובה ביותר בין זמן עלייה הראשוני וזמן להתיישב. עם החלת ההטיה DC וactuating הקרום מטה לכיוון הנפתח אלקטרודה, זמן השקיעה הוא לא סוגיה משמעותית כקרום יהיה הצמד מטה ולדבוק באלקטרודה actuation המצופה דיאלקטרי. מספר יישומים נהנו מעיצוב actuation אלקטרוסטטי האמור 3 - 8. עם זאת, הנוכחות של האלקטרודה הנפתחת המצופה דיאלקטרי הופכת את המפעיל רגיש לטעינה וstiction דיאלקטרי.
קרומי MEMS יכולים לנצל uתכנון מכאני nderdamped כדי להשיג זמן עלייה ראשוני מהיר. דוגמא של תכנון מכאני underdamped היא שולים בשדה אלקטרוסטטי ומונע (EFFA) MEMS. טופולוגיה זו הציגה הרבה פחות פגיעות למנגנוני כשל אופייניים כי המגפה תכנונים מבוססים אלקטרוסטטי 9-20. ההיעדרות של האלקטרודה הדלפק המקבילה וכתוצאה מכך השדה החשמלי המקביל היא מדוע MEMS אלה נקראים "שולים בשדה" ומונע (איור 1) כראוי. לעיצוב EFFA, הנפתחת אלקטרודה מחולקת לשתי אלקטרודות נפרדות הממוקמים בקיזוז רוחבי בקרום המרגש, ומבטל את החפיפה בין החלקים הניידים ונייחים של המכשיר לחלוטין. עם זאת, ההסרה של המצע מתחת קרום מטלטלין מפחיתה באופן משמעותי את הסרט לסחוט דעיכת רכיב ובכך להגדיל את הזמן להתיישב. איור 2 היא דוגמא לזמן והתיישב בתגובה לstandarהטיית צעד ד. חלוף, או DC-דינמי מיושם הטיית בזמן אמת יכול לשמש כדי לשפר את הזמן ההתייצבות 20-26. איורים 2C ו2D להמחיש איכותי איך צורת גל משתנה זמן בצורה יעילה יכול לבטל את הצלצול. מאמצי מחקר קודם לנצל שיטות מספריות כדי לחשב את המתח ותזמונים המדויקים של ההטיה הקלט כדי לשפר את זמן המיתוג. השיטה בעבודה זו משתמשת בביטויי צורה סגורה קומפקטיים כדי לחשב את הפרמטרים צורת גל ההטיה קלט. בנוסף, עבודה קודמת התמקדה בactuation צלחת המקביל. בעוד המבנים שנועדו לunderdamped, דעיכת לסחוט סרט עדיין זמינה בתצורה זו. השיטה להפעלה ללא שהוצגה בעבודה זו היא actuation fringing השדה. בתצורה זו דעיכת לסחוט סרט מסולקת ביעילות. זה מייצג מקרה קיצוני שבו דעיכת המכנית של קורה MEMS היא נמוכה מאוד. מאמר זה מתאר כיצד לפברק dev EFFA MEMSגלידות ולבצע מדידה כדי לאמת את מושג צורת הגל בניסוי.
Protocol
1 ייצור של MEMS EFFA קבוע קבוע קורות (ראו איור 3 לתהליך תמצית)
- ליתוגרפיה UV ולחרוט רטובים כימי של דו תחמוצת הצורן עם חומצה שנאגרו הידרופלואורית (זהירות 27).
- השתמש ב, מצע סיליקון התנגדות נמוכה מחומצן.
- מלא כוס זכוכית עם אצטון 28 (מספיק כדי להטביע את המדגם), הצב את המדגם בכוס אצטון מולא, וsonicate למשך 5 דקות באמבט המים sonicator.
- ללא ייבוש, ישירות להעביר את המדגם מכוס אצטון לכוס מלאה באלכוהול רפואי 29 sonicate במשך 5 דקות בsonicator מים אמבטיה.
- ייבש את המדגם עם חנקן (לא מאפשר באלכוהול רפואי להתאדות מפני השטח).
- (לאפות התייבשות) יבש המדגם על פלטה חמה שנקבעה ל150 מעלות צלזיוס למשך 10 דקות. לאפשר את המדגם כדי להגיע RT פעם לאפות ההתייבשות הוא מלא.
- מניחים את המדגם על צ'אק של טווה photoresist.פיפטה ולוותר 1 מ"ל של hexamethyldisilazane (HMDS) ל25 מ"מ של קוטר (זהירות 30). Spincoat ב3,500 סל"ד 30 שניות. פיפטה ולוותר 1 מ"ל של photoresist החיובי ל25 מ"מ של קוטר (זהירות ביום 31 ב). Spincoat המדגם ב 3,500 סל"ד 30 שניות. Softbake photoresist ל90 שניות ב105 ° C על פלטה חמה.
- השתמש aligner מסכה כדי לחשוף את המדגם לקרינת UV באורך גל של 350-450 ננומטר. להשתמש באנרגית חשיפה של 391 mJ / 2 סנטימטר (זהירות 32).
- מלא כוס זכוכית עם מפתח TMAH מבוסס (זהירות 33) ולהשתמש מספיק כדי להטביע את המדגם כולו.
- מלא כוס זכוכית עם מים ללא יונים לסיים במהירות את הפיתוח, כדי למנוע התפתחות יתר.
- לפתח את המדגם עבור 12-20 שניות. בעדינות להתסיס את המדגם השקוע.
- בזהירות ובמהירות להסיר את המדגם מכוס הפיתוח ולהשקיע אותה בכוס המים ולשטוף עבור 10 שניות.
- יש לשטוף את המדגם בכיור תחת זרם מים ללא יונים ל1-2 דק '.
- לפוצץ בזהירות לייבש את המדגם עם חנקן (אל תאפשר המים ללא יונים להתאדות מפני השטח).
- בדוק המדגם תחת מיקרוסקופ.
- אם יש צורך, חזור על תהליך הפיתוח עם התאמות בזמן כדי להימנע מפיתוח יתר.
- השתמש לחרוט יון תגובתי פלזמה (ורי) כדי לחספס את פני השטח כדי לשפר את הרטבת פני השטח. רי הגדרות 34: של Ar 100 SCCM, 100 כוח W RF, 50 לחץ קאמרי MT, 1 דקות.
- מלא כוס טפלון עם כמות מספקת של לחרוט תחמוצת שנאגרו (BOE) כדי לכסות את המדגם.
- מלא כוס טפלון נוספת עם מים ללא יונים לשטיפת ביניים של המדגם.
- להטביע את המדגם בבנק המרכזי של אנגליה. השיעור לחרוט הוא 90-100 ננומטר / דקה.
- כאשר לחרוט הוא מלא, לשטוף בכוס הטפלון שdeionized מים ל10 שניות. לאחר מכן לשטוף את המדגם בכיור מתחת למי deionized פועלים ל1-2 מ 'ב.
- ייבש את המדגם עם חנקן (אל תאפשר המים ללא יונים להתאדות מפני השטח).
- בדוק המדגם תחת מיקרוסקופ.
- חזור על לחרוט ולשטוף צעדים לפי צורך בהתאמות בזמן על מנת למנוע יתר תחריט וundercutting של photoresist.
- להסיר את מסכת photoresist.
- מלא כוס זכוכית עם אצטון (מספיק כדי להטביע את המדגם), הצב את המדגם בכוס אצטון המלא וsonicate בsonicator מים אמבט למשך 5 דקות.
- ישירות לקחת הדגימה מכוס אצטון ולמקם אותו בכוס אלכוהול מילא איזופרופיל sonicate במשך 5 דקות בsonicator מים אמבטיה.
- ייבש את המדגם עם חנקן (אל תאפשר באלכוהול רפואי להתאדות מפני השטח).
- לחרוט כימי רטוב של סיליקון עם הידרוקסיד tetramethylammonium (TMAH) 25% לפי משקל (זהירות 35).
- השתמש בכוס 4 L נקייה.
- השתמש בפלטה חמה עם thermocouple. השתמש סל טפלון שיש לו וו בקצה של הידית להחזקת הדגימות. השתמש במוט ומערבבים מגנטי לתסיסה נכונה כדי להקל על משטח סיליקון של בועות מימן שפורסמו במהלך תהליך התחריט בתפזורת.
הערה: המשוב בין תרמי והפלטה החשמלי מבטיח הטמפרטורה המתאימה נשארת קבועה לאורך לחרוט. אם המימן שוחרר לא הוסר מפני השטח, זה עלול להסוות סיליקון שבבסיס מTMAH. - יוצקים את 25% TMAH לפי משקל עומד על גובה 2 L של הכוס.
- הנח את הצמד התרמי בפתרון ומחמם ל80 מעלות צלזיוס. במידת האפשר, להשתמש באבזר מותאם אישית או מהדק להחזיק התרמי כדי למנוע הפרעה לסיבוב של בר והמערבב המגנטי.
- ברגע שהפתרון מגיע לטמפרטורה הדרושה, מניח את הדגימות בסל הטפלון ומניח את הסל בפתרון בתלייה אותו מהשפה של הכוס. ודא שהסל לא נחבתחתית הכוס כדי להשאיר מקום למוט מערבבים המגנטי כדי לסובב.
- הגדר את קצב הסיבוב של בר והמערבב המגנטי ל400 סל"ד.
- השיעור לחרוט של הפתרון הוא 300-350 ננומטר / דקה. העומק לחרוט הדרוש הוא 4-5 מיקרומטר.
- כאשר את הזמן הדרוש שחלף כדי להשלים את לחרוט, להסיר את המדגם מהפתרון ולשטוף עם מים ללא יונים ל1-2 דק '.
- ייבש את המדגם עם חנקן (אל תאפשר המים ללא יונים להתאדות מפני השטח).
- השתמש profilometer כדי למדוד את גובה הצעד.
- אם לא הגיע לשיא הצעד, למקם את הדגימות בפתרון שוב על מנת להשיג את גובה הצעד הרצוי.
- לחרוט רטוב כימי של כל SiO 2 מן המצע והתרמית לגדול 500 ננומטר נוסף של SiO 2.
- מלא כוס טפלון עם 49% חומצה הידרופלואורית לפי נפח (זהירות 36). השתמש בכמות שמספיקה כדי לכסות את המדגם.
- מלא כוס טפלון עם מים ללא יונים לשטיפת המדגם. השתמש בכמות שמספיקה כדי לכסות את המדגם.
- לחרוט את המדגם עם חומצה הידרופלואורית. השאר את המדגם בפתרון עד שכל SiO 2 מוסר. מאז הפתרון מרוכז מאוד, לחרוט יתרחש במהירות יחסית.
- יש לשטוף ל10-20 שניות בכוס הטפלון המלא במים ללא יונים.
- יש לשטוף את המדגם ביסודיות תחת זרם מים ללא יונים בכיור ל1-2 דק '.
- מערבבים פתרון של H 2 SO 4: H 2 O 2 (חומצה גופרתית: מי חמצן, פיראניה נקייה) ב1: 1 בכוס טפלון (זהירות 37). השתמש מספיק כדי לכסות את המדגם.
- מלא כוס טפלון עם מים ללא יונים לשטיפת המדגם.
- להטביע את המדגם בH 2 SO 4: H 2 O 2 ל7-10 דקות.
- בקצרה, 10 שניות, לשטוף את המדגם בכוס מים ולשטוף.
- לשטוף ביסודיות המדגם בכיור תחת זרם מים ללא יונים ל1-2 דק '.
- ייבש את המדגם עם חנקן (אל תאפשר למים להתאדות מפני השטח).
- לבצע חמצון תרמי רטוב לגדול 500 ננומטר של SiO 2.
- ליתוגרפיה UV ולחרוט רטובים כימי לדפוס SiO 2 לחשוף סיליקון המשמש כשכבת ההקרבה לשחרור הסופי של הקורות קבועים קבועות.
- מלא כוס זכוכית עם אצטון (מספיק כדי להטביע את המדגם), הצב את המדגם בכוס אצטון המלא וsonicate בsonicator מים אמבט למשך 5 דקות.
- ישירות לקחת הדגימה מכוס אצטון ולמקם אותו בכוס אלכוהול מילא איזופרופיל וsonicate בsonicator מים אמבט למשך 5 דקות.
- ייבש את המדגם עם חנקן (אל תאפשר באלכוהול רפואי להתאדות מפני השטח).
- (לאפות התייבשות) יבש המדגם על פלטה חמה שנקבעה ל150 מעלות צלזיוס למשך 10 דקות. לאפשר tהוא לדגום להגיע RT פעם לאפות ההתייבשות הוא מלא.
- באמצעות spincoater photoresist, HMDS spincoat על המדגם ב3,500 סל"ד 30 שניות. באמצעות spincoater photoresist, spincoat photoresist החיובי על המדגם ב3,500 סל"ד 30 שניות. Softbake photoresist ל90 שניות ב105 ° C על פלטה חמה.
הערה: השתמש 1 מ"ל לכל 25 מ"מ של קוטר מדגם. - השתמש aligner מסכה כדי לחשוף את המדגם לקרינת UV באורך גל של 350-450 ננומטר. להשתמש באנרגית חשיפה של 391 mJ / 2 סנטימטר.
- מלא כוס זכוכית עם מפתח מבוסס TMAH ולהשתמש מספיק כדי להטביע את המדגם כולו.
- מלא כוס זכוכית עם מים ללא יונים לסיים את הפיתוח על מנת למנוע התפתחות יתר במהירות.
- לפתח את המדגם עבור 12-20 שניות.
- בזהירות ובמהירות להסיר את המדגם מכוס הפיתוח ולהשקיע אותה בכוס המים ולשטוף עבור 10 שניות.
- יש לשטוף את המדגם בכיור תחת זרם deionized wאטר ל1-2 דק '.
- זהירות יבשה עם חנקן (אל תאפשר למים להתאדות מפני השטח).
- בדוק המדגם תחת מיקרוסקופ.
- אם יש צורך, חזור על תהליך הפיתוח עם התאמות בזמן כדי להימנע מפיתוח יתר.
- השתמש רי פלזמה כדי לחספס את פני השטח כדי לשפר את הרטבת פני השטח. הגדרות ורי: של Ar 100 SCCM, 100 כוח W RF, 50 לחץ קאמרי MT, 1 דקות.
- מלא כוס טפלון עם כמות מספקת של הבנק המרכזי של אנגליה כדי לכסות את המדגם.
- מלא כוס טפלון עם מים ללא יונים לשטיפת ביניים של המדגם.
- להטביע את המדגם בבנק המרכזי של אנגליה. השיעור לחרוט הוא 90-100 ננומטר / דקה.
- כאשר לחרוט הוא מלא, לשטוף בכוס הטפלון שdeionized מים ל10 שניות. לאחר מכן לשטוף את הדגימה תחת מים זורמים ללא יונים בכיור ל1-2 דק '.
- ייבש את המדגם עם חנקן (אל תאפשר למים להתאדות מפני השטח).
- בדוק מדגם תחת microscopדואר.
- חזור על לחרוט ולשטוף צעדים לפי צורך בהתאמות בזמן על מנת למנוע יתר תחריט וundercutting של photoresist.
- מלא כוס זכוכית עם אצטון (מספיק כדי להטביע את המדגם), הצב את המדגם בכוס אצטון מולא, וsonicate בsonicator מים אמבט למשך 5 דקות.
- ישירות לקחת הדגימה מכוס אצטון ולמקם אותו בכוס אלכוהול מילא איזופרופיל וsonicate בsonicator מים אמבט למשך 5 דקות.
- ייבש את המדגם עם חנקן (אל תאפשר באלכוהול רפואי להתאדות מפני השטח).
- גמגום הפקדה 20 ננומטר של טי ושל Au 100 ננומטר. הסרט הזה משמש כשכבת זרע אלקטרוליטי לצעד תהליך אלקטרוליטי שלאחר מכן. הפרמטרים המקרטעת הם: כוח DC של 100 W, לחץ בתצהיר של 8 MT, של Ar 100 SCCM, לחץ בסיס 3 x 10 -6 ט
- Vent קאמרי תהליך או מנעול עומס לאווירה.
- טען את המדגם לתוךקאמרי תהליך או מנעול עומס.
- לשאוב את תא התהליך או מנעול עומס לואקום.
- חכה עד שתא התהליך משיג לחץ בסיס של 3 x 10 -6 ט
- מקם את המדגם למקום המתאים לתצהיר.
- הגדר את הלחץ קאמרי ל8 mT על ידי זורם ארגון למערכת. קצב הזרימה המדויק נחוץ כדי להשיג 8 mT תלויה מאוד בסוג של מערכת בשימוש. הכלי המקרטעת המשמש לעבודה זו השתמש בקצב זרימה של 100 SCCM.
- הפעל את המקור ליעד טיטניום.
- טיטניום Presputter ב300 W עבור 20 דקות.
- גמגום 20 ננומטר של טיטניום ב100 W. הזמן של התצהיר המדויק תלוי מאוד בסוג של שימוש במערכת. לכלי המקרטעת משמש בעבודה זו, 5 דק 'הוא הכרחי כדי להשיג 20 ננומטר.
- לבטל את המקור ליעד המקרטעת טיטניום.
- הפעל את המקור ליעד הזהב.
- זהב Presputter בלמשך 2 דקות 100 W.
- גמגוםשל זהב ב100 W. הזמן בתצהיר המדויק 100 ננומטר תלוי מאוד בכלי המקרטעת המשמש. לכלי המקרטעת משמש בעבודה זו, 10 דקות היא מספיק כדי לספק של זהב 100 ננומטר.
- לבטל את המקור ליעד המקרטעת זהב.
- סגור את שסתום גז Ar.
- Vent קאמרי תהליך או מנעול עומס.
- לפרוק את המדגם פעם אחת קאמרי התהליך או מנעול עומס מגיע אווירה.
- לשאוב את מנעול העומס או תא תהליך עד לואקום גבוה.
- ליתוגרפיה UV כדי ליצור תבנית photoresist המגדירה את הגיאומטריה של הקורה הקבוע הקבוע.
- מלא כוס זכוכית עם אצטון (מספיק כדי להטביע את המדגם), הצב את המדגם בכוס המלא אצטון למשך 5 דקות.
- ישירות לקחת הדגימה מכוס אצטון ולמקם אותו בכוס מלאה באלכוהול רפואי למשך 5 דקות.
- ייבש את המדגם עם חנקן (אל תאפשר באלכוהול רפואי להתאדות מפני השטח).
- יבש (לאפות התייבשות) המדגם על פלטה חמה שנקבעה ל150 מעלות צלזיוס למשך 10 דקות. לאפשר את המדגם כדי להגיע RT פעם לאפות ההתייבשות הוא מלא.
- באמצעות spincoater photoresist, HMDS spincoat על המדגם ב3,500 סל"ד 30 שניות. באמצעות spincoater photoresist, spincoat photoresist החיובי על המדגם ב2,000 סל"ד 30 שניות. Softbake photoresist ל90 שניות ב105 ° C על פלטה חמה.
הערה: השתמש 1 מ"ל לכל 25 מ"מ של קוטר מדגם. - השתמש aligner מסכה כדי ליישר ולחשוף את המדגם לקרינת UV באורך גל של 350-450 ננומטר. השתמש אנרגיית חשיפה של 483 mJ / 2 סנטימטר.
- מלא כוס זכוכית עם מפתח מבוסס TMAH ולהשתמש מספיק כדי להטביע את המדגם כולו.
- מלא כוס זכוכית עם מים ללא יונים לסיים במהירות את הפיתוח על מנת למנוע התפתחות יתר.
- לפתח את המדגם עבור 12-20 שניות.
- בזהירות ובמהירות להסיר את המדגם מכוס הפיתוח וsubmerge אותו בכוס המים ולשטוף עבור 10 שניות.
- יש לשטוף את המדגם בכיור תחת זרם מים ללא יונים ל1-2 דק '.
- ייבש את המדגם עם חנקן (אל תאפשר למים להתאדות מפני השטח).
- בדוק המדגם תחת מיקרוסקופ.
- אם יש צורך, חזור על תהליך הפיתוח עם התאמות בזמן כדי להימנע מפיתוח יתר.
- קרן MEMS זהב Electroplate.
- השתמש בכוס זכוכית כוס 1 ליטר.
- מלא כוס עם 700 מ"ל של פתרון מוכן לשימוש אלקטרוליטי זהב (זהירות 38) כוס, זמינה מסחרי, .Place מולא על פלטה חמה.
- הגדר את פלטה חשמלית ל60 C °. השתמש תרמי כדי להבטיח שהפתרון יישאר בטמפרטורה הרצויה. ברגע שהגיע לפתרון לטמפרטורה הרצויה, לצרף את המדגם למתקן שמחזיק את האנודה, לחומר (לדוגמא), וצמד תרמי.
- הגדר את האספקה השוטפת למשרעת המתאימה המבוסס על התערוכהאזור metalized SED של המדגם. צפיפות זרם קבועה של 2 mA / משמש סנטימטר 2.
- משמשת האנודה נירוסטה.
- חבר את החיה להאנודה והקרקע למדגם.
- השיעור בתצהיר הוא 250-300 ננומטר / דקה. העובי הסופי של הקרן קבועה הקבוע הוא 0.5 מיקרומטר. בהתחשב בכך ש4 משוער: 1 יחס קיים בשיעורים לחרוט של electroplated לזהב גמגם (בעת הסרת שכבת הזרע גמגם), שהקרן electroplated עד 1 מיקרומטר.
- כאשר את הזמן הדרוש שחלף, לכבות את האספקה הנוכחית, לנתק את המוביל מהאנודה והחומר, להסיר את המדגם, ולשטוף היטב תחת זרם מים ללא יונים בכיור דקות 1.
- מכה יבשה המדגם עם חנקן (אל תאפשר למים להתאדות מפני השטח).
- השתמש במיקרוסקופ וprofilometer כדי לוודא שאלקטרוליטי הוא מלא.
- לחרוט תבנית photoresist.
- גרם מחממיםכוס ילדה מלאה בחשפנית photoresist ייעודית על פלטה חמה לC 110 מעלות (זהירות 39). לצלול מדגם בפתרון עבור שעה 1.
- הסר את הכוס מהפלטה חשמלית ולאפשר הפתרון ולטעום להגיע RT.
- יש לשטוף ביסודיות מדגם תחת מים זורמים בכיור ל1-2 דק '.
- לצלול מדגם בכוס מלאה באצטון למשך 5 דקות.
- לצלול מדגם בכוס מלאה באלכוהול איזופרופיל למשך 5 דקות.
- ייבש את המדגם עם חנקן (אל תאפשר באלכוהול רפואי להתאדות מפני השטח).
- בדוק מדגם תחת מיקרוסקופ ולמדוד את גובה הצעד של Au electroplated עם profilometer. חזור על שלבי הניקוי במידת צורך.
- שכבה כימית לחרוט רטוב Ti / Au זרע.
- מדגם מקום בפלזמה ורי ולהשתמש בפרמטרים הבאים: של Ar 100 SCCM, 100 W, 50 mT ל30 שניות.
- מלא כוס טפלון או זכוכית עם etchant Au (זהירות 40). השתמש enough כדי לכסות את המדגם כולו.
- מלא כוס טפלון או זכוכית עם מים ללא יונים. כוס זה תשמש ככוס שטיפת ביניים לסיים את לחרוט Au במהירות.
- להטביע את המדגם בetchant Au. פרמטרים Etch - RT, 7-8 ננומטר / sec, נסער. ברגע שלחרוט הוא מלא, להטביע את המדגם בכוס מים ולשטוף בעדינות להתסיס במשך 10-20 שניות.
- יש לשטוף את המדגם ביסודיות תחת זרם מים ללא יונים בכיור ל1-2 דק '.
- מכת חנקן יבש (אל תאפשר למים להתאדות מפני השטח).
- בדוק את לחרוט תחת מיקרוסקופ ובמידת צורך, חזור עד שכל Au הוא להסיר את האזורים החשופים.
- בצע פלזמה ורי שוב על המדגם עם הפרמטרים הבאים: של Ar 100 SCCM, 100 W, 50 mT ל30 שניות.
- מלא כוס טפלון עם הבנק המרכזי של אנגליה (מספיק כדי להטביע את המדגם).
- מלא טפלון עם מים ללא יונים לשטיפת המדגם.
- להטביע את המדגם בבנק המרכזי של אנגליה ב RT.לחרוט שיעור הוא 15-18 ננומטר / min.When הזמן לחרוט הוא מלא, להסיר את המדגם מהכוס ולהטביע אותו לתוך כוס השטיפה ל10-20 שניות.
- יש לשטוף את המדגם ביסודיות תחת זרם מים ללא יונים בכיור ל1-2 דק '.
- מכת חנקן יבש (אל תאפשר למים להתאדות מפני השטח).
- בדוק לחרוט ואם יש צורך, חזור עד שכל טיטניום הוא להסיר את האזורים החשופים. לצמצם את הזמן לחרוט להימנע undercutting המשמעותי.
- בצע XeF 2 לחרוט יבש איזוטרופיים (זהירות 41) כי באופן סלקטיבי מסיר סיליקון ומשחרר את הקורות קבועים הקבועים Au.
- Vent תא התהליך לאווירה.
- טען את המדגם בתא התהליך.
- לשאוב את המערכת לואקום.
- הזמן לחרוט מאוד תלוי באזור החשוף והסוג של מערכת לחרוט בשימוש. עבור מדגם זה משמש לחץ של 3 T עם מחזור 30 שניות. 10 מחזורים משמשים. שיעור לחרוט של 110-120 ננומטר / דקה מופק.
- ברגע שהפרמטר לחרוט מוגדרים במערכת, לחרוט שכבת הקרבת סיליקון.
- כאשר לחרוט הוא מלא לבצע את הצעדים הדרושים כדי להבטיח טיהור גזים רעילים יוסרו לפני אוורור המערכת לאווירה. המערכת במחקר זה יש תהליך שמבצע באופן אוטומטי צעד טיהור זה.
- Vent תא התהליך לאווירה.
- מוציא בזהירות את הדגימות.
- לשאוב את תא התהליך עד לואקום.
.2 ניסויי תיקוף דינמי Waveform
- מדגם עומס על תחנת הבדיקה DC.
- מניחים את המדגם על צ'אק של תחנת הבדיקה DC.
- הפעל את הוואקום של צ'אק להחזיק את המדגם.
- השתמש מניפולטורים בדיקה קצה DC למצב את הטיפים הבדיקה טונגסטן על רפידות הטיית של גשרי MEMS.
- השתמש במיקרוסקופ של תחנת הבדיקה DC כדי להציג המיקום המדויק של הבדיקה הקצה טונגסטןנגמר DC הטיית רפידות של המכשיר. הקרן קבועה קבועה מששה עם הבדיקה קצה אות החי בזמן אלקטרודות לנתץ הם מששו עם הבדיקה קצה קרקע.
- אות הטיית דינמית תכנית על הגנרטור הפונקציה.
- להשתמש בערכים שמחושבים לגל הראשוני פרמטרי 20.
- בחר את פונקצית הגל השרירותית על הגנרטור הפונקציה כדי ליצור את צורת הגל הדינמית.
- קלט הפרמטרים הזמן של צורת הגל. בהתאם לסוג של מחולל פונקציה, פרמטר הפעם הראשון מתחיל אחרי כמה מיקרו (בניגוד ל0 μsec). המרווח בין הפרמטר הראשון והפעם השנייה יהיה הפעם המחושבת זה ייקח את הקרן כדי להגיע לפער להחטיא את המטרה. המרווח בין הפרמטר השני והפעם שלישית צריך להיות ארוך מספיק כדי לאפשר את הקורה כדי להגיע לשיווי משקל לחלוטין עם תנודה מינימאלית. כאשר מזינים את הפרמטרים הזמן לפעול בכיוון ההפוך (ממשיכת מטלותwn לשחרר), זמן הפער להחטיא את המטרה יקבע את מרווח הזמן בין פרמטר הפעם השלישי וכיבוי. יהיה מרווח הזמן חמישי צריך להפעיל מחדש את הגל. לזמן היתר מרווח זה מספיק לקורה כדי להגיע לשיווי משקל לפני ההפעלה מחדש של המחזור.
- קלט הפרמטרים המתח של צורת הגל. המתחים יהיו שבריר של המתח בפועל פנה לקרן, כי אות זו תעבור דרך מגבר ליניארי. הערכים שתוכנתו בגנרטור הפונקציה למחקר זה היו 1/20 של המתח בפועל.
- חבר את היציאה של מחולל הפונקציה למגבר ליניארי מתח גבוה במהירות הגבוהה.
- חבר את היציאה של המגבר ליניארי לאוסצילוסקופ דיגיטלי עם קצב דגימה של 300 MHz. אוסצילוסקופ משמש כדי לאמת את פלט אות ממחולל צורת הגל השרירותית.
- חבר את היציאה של המגבר ליניארי למניפולטורים DC. ודא גנרטור הפונקציה הואאת בעת ביצוע פעולה זו.
- התקנה ולמדוד עם רטט הלייזר דופלר (LDV)
- מקם את הראש שמחזיק את LDV על המדגם.
- הפעל את הלייזר.
- השתמש במיקרוסקופ כי היא משולבת עם LDV למצוא את הקורה הרצוי למדוד.
- פוקוס הלייזר במרכז גשר MEMS. זוהי הנקודה של סטייה המרבית.
- להבטיח את עוצמת השתקפות קרן הלייזר היא מספיק למדידה מדויקת.
- קבע את זמן דגימה לקצב הדגימה המתאים. מדידה זו משתמשת בקצב דגימה של 5.1 MHz.
- בחר את פלט העקירה לעומת הזמן לLDV.
- בחר את מצב המדידה הרציף.
- החל אות הטיית על גשרי MEMS. LDV יהיה ללכוד את אפקט הצלצולים בזמן אמת.
- מנגינת הפרמטרים התזמון ומתח על הגנרטור הפונקציה כדי להשיג תנודת קורה מינימאלית על הנפתח ושחרורפעולות.
- ברגע האופטימלי הערכים נמצאים לכבות את אות הטיית.
- כבה את מצב מדידת LDV הרציף.
- הרם את הטיפים הבדיקה DC מרפידות הטיית.
- חבר את קלט מפעילה של מחולל הפונקציה לתפוקת מפעילה של ממשק חומרת LDV. למחקר זה כבל BNC משמש עבור חיבור זה.
- הגדר את מחולל הפונקציה להכיר טריגר החיצוני ממערכת LDV.
- הגדר את תוכנת LDV להפעיל את הגנרטור הפונקציה כאשר מצב סריקת המדידה מתחיל.
- הגדר את תוכנת LDV למצב סריקה בודד. אחת סריקת הזמן תהיה משך הזמן של צורת הגל.
- זרוק את הטיפים הבדיקה DC בחזרה למטה על כריות הטיית של גשר MEMS.
- ללכוד את האות לסרוק על ידי הפעלת מצב המדידה של LDV.
- שמור את העקירה לעומת נתונים בזמן.
תוצאות
ההתקנה באיור 4 משמשת כדי ללכוד את הסטייה לעומת מאפיינים של גשרי MEMS זמן. על ידי שימוש ברטט דופלר לייזר במצב המדידה הרציף שלה, ניתן למצוא הפרמטרים מתח והזמן המדויקים ללגרום לתנודת קרן מינימום לגובה הפער הרצוי. איור 5 מדגים סטיית דוגמא קורה המקבילה לגובה פער 60 V. זה נראה כי כמעט כל התנודה מוסרת. לא רק שצורת הגל הדינמית שימושית לגובה פער אחד, אבל לכל הגבהים הפער אפשרי. זו באה לידי ביטוי באיור 6 ו -7 איור לפעילות שני הנפתחת והשחרור, בהתאמה. צורת הגל דינמי מחושבת ונמדדת בשימוש כדי להשיג את המדידות בדמויות הקודמות מוצגת באיורים 8 ו -9, בהתאמה.
alt = "איור 1" src = "/ קבצים / ftp_upload / 51,251 / 51251fig1highres.jpg" />
איור 1 סקיצה 2D ותמונת SEM של גשרי MEMS שימשו במחקר זה. () פרופיל 2D. מבט לראש גשרי MEMS (B). (C) SEM של מכשיר מפוברק בפועל. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.

איור 2 סקיצה של גשר MEMS underdamped בתגובה לצעד קלט ומשתנה בזמן תגובה. () צעד יחידה מיושם הטיה. תגובה (B) של גשר MEMS underdamped לקלט צעד יחידה. זמן (C) משתנה / הטיה קלט דינמית. תגובה (D) של גשר MEMS לקלט משתנה זמן.r קבל = "_blank"> לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.

איור 3 תמצית זרימת תהליך לגשרי MEMS. (א) מצע חמצון סיליקון. לחרוט גורף של מצע סיליקון (B). (C) Re-חמצון של מצע סיליקון. (ד) לחרוט דו חמצני הסיליקון לחשוף סיליקון ההקרבה. (E) בתצהיר זהב ודפוסים. (F) Etch של שכבת סיליקון ההקרבה כדי לשחרר את גשר MEMS. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
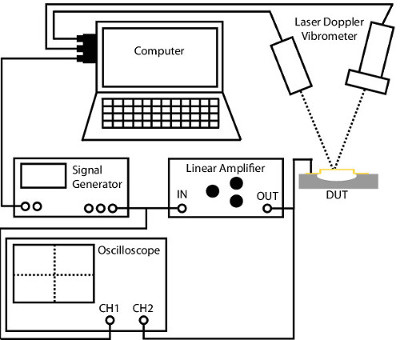
איור 4 תרשים בלוק של ניסוי seהאיל משמש להחיל אות ההטיה וללכוד את סטיית גשר MEMS. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.

איור 5 נמדד נפתחים ולשחרר מצבים של גשר MEMS בתגובה להטית קלט 60 V. העקומה השחורה היא התגובה מקלט צעד. העקומה האדומה היא התגובה לקלט דינמי.

איור 6 נמדד גבהים נפתחים פער ביניים של גשר MEMS בתגובה לקלט דינמי. אנא לחץ כאן לצפייה בvers גדול יותריון של נתון זה.

איור 7 נמדד גבהים פער שחרור ביניים של גשר MEMS בתגובה לקלט דינמי.

איור 8 גל שמחושב להטית הקלט.

איור 9 גל בפועל משמש להשגת תנודה מינימאלית של גשר MEMS.
Discussion
מתח שיורי בתצהיר נמוך Au סרט ושחרור יבש עם XeF 2 הם רכיבים קריטיים בייצור המוצלח של המכשיר. מפעילי fringing שדה אלקטרוסטטי לספק כוחות נמוכים יחסית בהשוואה למפעילי שדה לוחות מקבילים. MEMS אופייני לחצי סרט דקים של> 60 מגפ"ס יגרמו מתחי כונן גבוהים מדי שעלול לפגוע באמינות של EFFA MEMS. מסיבה זו מתכון אלקטרוליטי מאופיין בזהירות כדי להניב סרט דק עם דו צירי ממוצעת מתח נמוך. בנוסף, מחקר זה משתמש בסיליקון כסוג שכבת ההקרבה בשל חוסר היחסי של התרחבות והתכווצות (בהשוואה לphotoresist) במהלך שלבי תהליך שדורשים מחזורי חום. לבסוף, צעד השחרור היבש עם XeF 2 מאפשר עיבוד תשואה גבוהה על ידי כמעט ביטול stiction.
גובה פער קורה הרצוי תואם את גובה הפער להחטיא את המטרה (תרשים 2B ) בתגובה להטית הצעד הראשונה 20. ברגע שהקרן משיגה להחטיא את המטרה / גובה הפער רצוי ההטיה הצעד השנייה (איור 2 ג) על להחזיק את הקורה בתנוחה זו. אם אדע את גורם האיכות המכנית של גשר MEMS (שניתן למדוד או לחשב), ניתן לחשב את האחוז להחטיא את המטרה ואת הזמן כדי להגיע לגובה הפער להחטיא את המטרה. פרמטרים אלה משמשים כדי לקבוע את המשרעת ועיתוי של מתח הכניסה.
אותות כונן DC-דינמיים ששמשו במחקר זה שיפר את זמן ההתייצבות מ ~ 2 אלפיות שניים עד ~ 35 μsec עבור שניהם עד ללמטה ולמטה אל את המדינות. מחושב זמן המעבר תוך שימוש במודל היוריסטי 20 הוא 28 μsec לקורה עם w רוחב = 10 מיקרומטר, L אורך = 400 מיקרומטר t העובי, = 0.45 מיקרומטר, הנפתח לרוחב פער של = 8 מיקרומטר, ומתיחה שיורית אומר σ מתח = 5 MPa. יש מיתוג זמן σ יחסי -1 / 2 20. Tהוא הפועל היוצא של מערכת יחסים זו הוא ששינויים קטנים יחסית במתח שיורי יכולים להיות השפעה לא שולית על חישוב זמן מיתוג. הבדל קטן יחסית של 2 MPa במתח שיורי יכול לגרום וריאציה זמן מיתוג של 20%. לכן, יש צורך קיים לאופטימיזציה בזמן אמת עם השיטה המוצגת במאמר זה בשל הכורח של וריאציה תהליך על פני רקיק.
השיטה המוצגת בעבודה זו מדגימה שיפורים משמעותיים במיתוג זמן למפעילי שדה fringing אלקטרוסטטי בי המצע מוסר. הפרטים עבור ייצור של מקלטי EFFA MEMS והבדיקות חשמליות מתוארים בפירוט. השיטה הניסיונית, בפרט טכניקת הטיית הדינמית, תמצא תועלת בכמעט כל עיצוב MEMS מכאני underdamped בכל הקשור לשיפור הביצועים בזמן מיתוג.
Disclosures
יש לי המחברים אין לחשוף.
Acknowledgements
המחברים מבקשים להודות ריאן טונג לעזרתו ודיונים טכניים שימושיים.
המחברים גם מבקשים לציין את הסיוע ותמיכה של צוות הטכני Birck המרכז לננוטכנולוגיה. עבודה זו נתמכה על ידי המחקר מתקדם פרויקטים סוכנות הביטחון תחת Purdue מיקרוגל Reconfigurable החלוף-Mode חלול מסנני מחקר. וגם על ידי מרכז NNSA של חיזוי של אמינות, יושרה ושרידות של מיקרוסיסטמס ומשרד אנרגיה תחת מספר פרס DE-FC5208NA28617. הנופים, חוות דעת, ו / או הממצאים כלולים בנייר / מצגת זו הן אלה של מחברים / מגישים ואין לפרש כמייצג את הדעות או מדיניות הרשמיות, מפורש או משתמעים, של למחקר ההגנה מתקדמות סוכנות פרויקטים או המחלקה ביטחון.
Materials
| Name | Company | Catalog Number | Comments |
| Chemicals | |||
| Buffered oxide etchant | Mallinckrodt Baker | 1178 | Silicon dioxide etch, Ti etch |
| Acetone | Mallinckrodt Baker | 5356 | Wafer clean |
| Isopropyl alcohol | Honeywell | BDH-140 | Wafer clean |
| Hexamethyldisilizane | Mallinckrodt Baker | 5797 | Adhesion promoter |
| Microposit SC 1827 Positive Photoresist | Shipley Europe Ltd | 44090 | Pattern, electroplating |
| Microposit MF-26A developer | Shipley Europe Ltd | 31200 | Develop SC 1827 |
| Tetramethylammonium hydroxide | Sigma-Aldrich | 334901 | Bulk Si etch |
| Sulfuric acid | Sciencelab.com | SLS2539 | Wafer clean |
| Hydrogen peroxide | Sciencelab.com | SLH1552 | Wafer clean |
| Transene Sulfite Gold TSG-250 | Transense | 110-TSG-250 | Au electroplating solution |
| Baker PRS-3000 Positive Resist Stripper | Mallinckrodt Baker | 6403 | Photoresist stripper |
| Gold etchant type TFA | Transense | 060-0015000 | Au etch |
| Equipment | |||
| Mask aligner | Karl Suss MJB-3 | Pattern photoresist | |
| Sputter coater | Perkin Elmer 2400 Sputterer | Deposit metal | |
| Thermal oxidation furnace | Pyrogenic Oxidation Furnace | Grow silicon dioxide | |
| Reactive Ion Etch | Plasmatech RIE | Plasma ash | |
| Xenon difluoride dry etcher | Xactix Xenon Difluoride Etcher | Selective dry isotropic silicon etch | |
| Surface profilometer | Alpha-Step IQ | Step height measurement | |
| Probe ring | Signatone | Holds DC probe manipulators | |
| DC manipulators | Signatone S-900 Series Micropositioner | Applies potential difference to device | |
| Laser doppler vibrometer | Polytec OFV-551/MSA-500 Micro System Analyzer | Switching time measurement | |
| Digital function generator | Agilent E4408B Function Generator | Creates the DC-dynamic waveform | |
| High voltage linear amplifier | Single channel high voltage linear amplifier A400 | Facilitates high voltage | |
| Digital oscilloscope | Agilent DS05034A Digital Oscilloscope | Verify the dynamic waveform parameters | |
References
- Rebeiz, G. . RF MEMS: Theory, Design, and Technology. , (2003).
- Senturia, S. D. . Microsystem Design. , (2001).
- Bouchaud, J. . Propelled by HP Inkjet Sales, STMicroelectronics Remains Top MEMS Foundry. , (2011).
- Lantowski, K. G. D. The Future of Cinema Has Arrived: More Than 50,000. Theatre Screens Worldwide Feature The Brightest, 2D/3D Digital Cinema Experience With DLP Cinema. , (2011).
- Bosch-Wachtel, T. . Knowles Ships 2 Billionth SiSonic MEMS Microphone. , (2011).
- Burke, J. . Mirasol Display Capabilities Add Color and Interactivity to Improve User Experience for Renowned Jin Yong Branded Device. , (2012).
- Bettler, D. . MEMStronics Captures Prestigious R & D 100 Award. , (2011).
- Marsh, C. . Omron Releases New RF MEMS Switch with Superior High Frequency Characteristics rated to 100 Million Operations. , (2008).
- Rosa, M. A., Bruyker, D. D., Volkel, A. R., Peeters, E., Dunec, J. A novel external electrode configuration for the electrostatic actuation of MEMS based devices. J. Micromech. Microeng. 14, 446-451 (2004).
- Rottenberg, X., et al. Electrostatic fringing-field actuator (EFFA): application towards a low-complexity thin film RF-MEMS technology. J. Micromech. Microeng. 17, S204-S210 (2007).
- Allen, W. N., Small, J., Liu, X., Peroulis, D. Bandwidth-optimal single shunt-capacitor matching networks for parallel RC loads of Q >> 1. Asia-Pacific Microw. Conf (Singapore). , 2128-2131 (2009).
- Small, J., Liu, X., Garg, A., Peroulis, D. Electrostatically tunable analog single crystal silicon fringing-field MEMS varactor. Asia-Pacific Microw Conf (Singapore). , 575-578 (2009).
- Liu, X., Small, J., Berdy, D., Katehi, L. P. B., Chappell, W. J., Peroulis, D. Impact of mechanical vibration on the performance of RF MEMS evanescent-mode tunable resonators. IEEE Microw. Wireless Compon. Lett. 21, 406-408 (2011).
- Small, J., et al. Electrostatic fringing field actuation for pull-in free RF-MEMS analog tunable resonators. J. Micromech. Microeng. 22, 095004 (2012).
- Su, J. . A lateral-drive method to address pull-in failure in MEMS. , (2008).
- Scott, S., Peroulis, D. A capacitively-loaded MEMS slot element for wireless temperature sensing of up to 300°C . , 1161-1164 (2009).
- Scott, S., Sadeghi, F., Peroulis, D. Inherently-robust 300C MEMS sensor for wireless health monitoring of ball and rolling element bearings. , 975-978 (2009).
- Lee, K. B. Non-contact electrostatic microactuator using slit structures: theory and a preliminary test. J. Micromech. Microeng. 17, 2186-2196 (2007).
- Su, J., Yang, H., Fay, P., Porod, W., Berstein, G. H. A surface micromachined offset-drive method to extend the electrostatic travel range. J. Micromech. Microeng. 20, 015004 (2010).
- Small, J., Fruehling, A., Garg, A., Liu, X., Peroulis, D. DC-dynamic biasing for >50x switching time improvement in severely underdamped fringing-field electrostatic MEMS actuators. J. Micromech. Microeng. 22, (2012).
- Borovic, B., Liu, A. Q., Popa, D., Cai, H., Lewis, F. L. Open-loop versus closed-loop control of MEMS devices: Choices and issues. J. Micromech. Microeng. 15, 1917-1924 (2005).
- Pons-Nin, J., Rodriquez, A., Castaner, L. M. Voltage and pull-in time in current drive of electrostatic actuators. J. Microelectromech. Syst. 11, 196-205 (2002).
- Czaplewski, D. A., et al. A Soft Landing Waveform for Actuation of a Single-Pole Single-Throw Ohmic RF MEMS Switch. J. Microelectromech. Syst. 15, 1586-1594 (2006).
- Elata, D., Bamberger, H. On the dynamic pull-in of electrostatic actuators with multiple degrees of freedom and multiple voltage sources. J. Microelectromech. Syst. 15, 131-140 (2006).
- Chen, K. S., Ou, K. S. Fast positioning and impact minimizing of MEMS devices by suppression motion-induced vibration by command shaping method. , 1103-1106 (2009).
- Chen, K. S., Yang, T. S., Yin, J. F. Residual vibration suppression for duffing nonlinear systems with electromagnetical actuation using nonlinear command shaping techniques. ASME J. Vibration and Acoustics. 128, 778-789 (2006).
- . . Transene Sulfite Gold TSG-250. Product Number: 110-TSG-250. , (2012).
- . . Gold etchant type TFA. Product Number: 060-0015000. , (2012).
- Garg, A., Small, J., Mahapatro, A., Liu, X., Peroulis, D. Impact of sacrificial layer type on thin film metal residual stress. , 1052-1055 (2009).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved
We use cookies to enhance your experience on our website.
By continuing to use our website or clicking “Continue”, you are agreeing to accept our cookies.
