Method Article
重度不足減衰フリンジフィールド静電MEMSアクチュエータに時間改善スイッチング用リアルタイムDC-ダイナミックバイアス方式
要約
本質的に低いスクイーズフィルムダンピング条件と長いセトリング時間のフリンジフィールド静電MEMSアクチュエータ結果の堅牢なデバイス設計は、従来のステップバイアスを使用してスイッチング動作を行うとき。 DC-ダイナミック波形によるリアルタイムスイッチング時間の改善はにダウンアップと状態へアップダウンの間で移行フリンジ場のMEMSアクチュエータのセトリング時間が短縮されます。
要約
機械的に減衰しにくい静フリンジフィールドMEMSアクチュエータはよく単位ステップ入力バイアス電圧に応答して、その高速スイッチング動作のために知られている。しかし、改善されたスイッチング性能のためのトレードオフは、さまざまな印加電圧に応じて、各ギャップ高さに到達するために比較的長いセトリング時間である。過渡バイアス波形は、高い機械的品質係数を有する静フリンジフィールドMEMSアクチュエータの低減スイッチング時間を容易にするために使用されて適用した。フリンジフィールドアクチュエータの下にある基板を除去することは、効果的な概念をテストするために必要な低機械的減衰環境を作成します。下にある基板の除去は、スティクションによる故障に関して、デバイスの信頼性·パフォーマンスに実質的な改善を持っています。 DC-ダイナミックバイアスがセトリング時間を改善するのに有用であるが、典型的なMEMSデバイスのために必要なスルーレートは、電荷pに積極的な要件を置くことができる完全に統合されたオンチップ設計にumps。さらに、バックエンドオブライン商業CMOS処理工程中に基板除去工程を統合する課題が存在してもよい。従来のステップ付勢の結果と比較した場合、製造されたアクチュエータの実験的検証は、スイッチング時間の50倍の改善を示している。理論計算と比較して、実験結果はよく一致している。
概要
微小電気機械システム(MEMS)の機械的変位を達成するために、いくつかの作動機構を利用する。最も人気のある、熱、圧電、静磁気、静電である。短いスイッチング時間のために、静電駆動は、最も人気のある手法1、2である。実際には、批判的に減衰機械的なデザインは、最初の立ち上がり時間と整定時間の間で最良の妥協点を提供します。膜はスナップダウンと誘電被覆された作動電極に付着するようにDCバイアスを印加し、ダウンプルダウン電極に向かって膜を作動させる際に、セトリング時間が重要な問題ではない。 8 -いくつかのアプリケーションは、上記の静電駆動設計3の恩恵を受けている。しかし、誘電体コーティングされたプルダウン電極の存在は誘電充スティクションにアクチュエータが受けやすくなります。
MEMS膜はuと利用することができる高速の立ち上がり時間を達成するために機械設計をnderdamped。減衰しにくい機械設計の例としては、(EFFA)MEMS作動の静フリンジ·フィールドです。このトポロジでは、静電ベースの設計9-20を悩ませ、一般的な故障メカニズムにはるかに少ない脆弱性を出品しています。これらのMEMSは、適切に( 図1)が作動「フリンジ場」と呼ばれる理由平行対向電極と、結果として平行電場が存在しないことである。 EFFA設計では、プルダウン電極が位置する横方向に完全に装置の可動部品と静止部品との間の重複を排除し、可動膜にオフセットされた2つの別個の電極に分割される。しかし、可動膜の下からの基板の除去が著しく、それによってセトリング時間を増加させる成分を減衰させるスクイズフィルムを低下させる。 図2Bは standarに応答におけるセトリング時間の一例であるd個のステップバイアス。一過性の、またはDC-ダイナミックリアルタイムで付勢適用セトリング時間20-26を改善するために使用することができる。 図2Cおよび2Dは 、定性的に時間的に変化する波形を効果的にリンギングをキャンセルする方法を説明する。以前の研究努力は、スイッチング時間を改善するために、入力バイアスの正確な電圧およびタイミングを計算するために数値的方法を利用する。この作品での方法は、入力バイアス波形パラメータを計算するために、コンパクトな閉じた形の式を使用しています。さらに、以前の研究では、平行板作動に焦点を当てた。構造は不足制動されるように設計されていますが、スクイーズフィルムダンピングはまだこの構成で利用可能です。この作品で提示作動方法は、フリンジフィールド駆動である。この構成では、スクイーズフィルムダンピングを効果的に排除される。これは、MEMSビームの機械的減衰が非常に低い極端な場合を表す。本稿ではEFFA MEMS DEVを作製する方法について説明します氷と実験的に波形のコンセプトを検証するための測定を行います。
プロトコル
EFFA MEMS固定の固定ビーム(集計プロセスについては、図3を参照してください)1。試作
- UVリソグラフィー及びバッファードフッ酸(CAUTION 27)と二酸化ケイ素の化学ウェットエッチング。
- 酸化され、低抵抗シリコン基板を用いる。
- (サンプルを沈めるのに十分)をアセトン28とガラスビーカーを満たし、水浴ソニケーター中で5分間アセトン満たしたビーカー内の試料、超音波処理を配置します。
- 乾燥せずに、直接、水浴超音波処理器中で5分間イソプロピルアルコール29と超音波処理を満たしたビーカーに、アセトンのビーカーからサ ンプルを移す。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発することはできません)。
- 乾燥(脱水ベーク)10分間150℃に設定したホットプレート上のサンプル。脱水ベークが完了すると、サンプルが室温に到達させます。
- フォトレジストスピナーのチャックに載せてください。直径25ミリメートル(注意30)当たりのヘキサメチルジシラザンの1ミリリットル(HMDS)をピペットと分注する。 30秒間3,500 rpmでスピンコート。ピペットとは、直径25ミリメートル(注意31)あたりのポジ型フォトレジストの1ミリリットルを分注する。 30秒間3,500 rpmでサンプルをスピンコート。 105で90秒間フォトレジストをソフトベーク ホットプレート上で、℃。
- 350〜450ナノメートルの波長を有するUV放射線にサンプルを露出するマスクアライナを使用する。 391 MJ / cm 2程度(注意32)の露光エネルギーを使用してください。
- TMAH系現像液(注意33)でガラスビーカーを記入し、サンプル全体を沈めるには十分を使用しています。
- すぐに過現像を回避するために開発を終了する脱イオン水でガラスビーカーを埋める。
- 12-20秒のためのサンプルを開発する。静かに沈め、サンプルを攪拌する。
- 慎重にかつ迅速に開発ビーカーからサンプルを除去し、10秒間すすぎ水のビーカー中に沈める。
- は1〜2分間、脱イオン流水で流しにサンプルをすすぐ。
- 慎重に窒素でサンプルを乾燥吹く(脱イオン水が表面から蒸発させないようにしてください)。
- 顕微鏡下でサンプルを調べます。
- 必要な場合には、乱開発を避けるために、時間内に調整を開発手順を繰り返します。
- 表面の濡れを改善するために表面を粗くするためにプラズマ反応性イオンエッチング(RIE)を使用する。 Arを100sccmの、100WのRFパワー、50mTのチャンバ圧力、1分:RIEを34の設定。
- サンプルをカバーする緩衝酸化物エッチング(BOE)十分な量のテフロンビーカーを埋める。
- サンプルの中間すすぎ、脱イオン水で、別のテフロンビーカーを埋める。
- BOE内のサンプルを水没。エッチング速度は、90〜100ナノメートル/分である。
- エッチングが完了すると、10秒間脱イオン水でいるテフロンビーカー中ですすぐ。その後、1〜2メートル脱イオン流水で流し、試料をすすぎインチ
- 窒素でサンプルを乾燥(脱イオン水が表面から蒸発させないようにしてください)。
- 顕微鏡下でサンプルを調べます。
- エッチを繰り返し、フォトレジストのオーバーエッチングやアンダーカットを回避するために、時間の調整を必要に応じてステップをすすいでください。
- フォトレジストマスクを除去します。
- (サンプルを沈めるのに十分)アセトンでガラスビーカーを満たし、5分間水浴ソニケーター中のアセトン満たしたビーカー超音波処理中のサンプルを配置します。
- 直接アセトンビーカーからサンプルを取り、水浴超音波処理器中で5分間イソプロピルアルコール満たしたビーカー超音波処理に配置します。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発させないようにしてください)。
- 重量%水酸化テトラメチルアンモニウム(TMAH)25%のシリコンの化学的ウェットエッチング(注意35)。
- クリーン4リットルのビーカーを使用してください。
- thermocでホットプレートを使用してくださいouple。サンプルを保持するためのハンドルの端にフックを持つテフロンバスケットを使用してください。バルクエッチングプロセスの間に放出される水素の泡のシリコン表面を軽減するために、適切な攪拌、磁気攪拌棒を使用する。
注:熱電対とホットプレートの間のフィードバックは、適切な温度は、エッチングを通して一定のままで保証されます。放出された水素が表面から除去されない場合、それはTMAHの下にあるシリコンをマスクすることができる。 - ビーカーの2Lのマークまで重量TMAH 25%を注ぐ。
- 溶液中の熱電対を配置し、80℃に予熱する。可能であれば、カスタム治具を使用するか、磁気攪拌棒の回転との干渉を防止するために熱電対を保持するクランプ。
- ソリューションは、必要な温度に達すると、テフロンバスケットにサンプルを置き、ビーカーのリップからそれを掛けて、溶液中のバスケットを置く。バスケットは休むしないことを確認してください磁気撹拌棒が回転するための余地を残すために、ビーカーの底部にある。
- 400 rpmまで磁気撹拌棒の回転速度を設定します。
- 溶液のエッチング速度は、300〜350(nm / min)である。必要なエッチング深さは4〜5程度である。
- 必要な時間は、エッチングを完了するために経過すると、溶液からサンプルを除去し、1〜2分間、脱イオン水ですすぐ。
- 窒素でサンプルを乾燥(脱イオン水が表面から蒸発させないようにしてください)。
- ステップ高さを測定するためにプロフィルを使用してください。
- ステップ高さに達していない場合、所望のステップ高さを達成するために、再び溶液中に試料を置き。
- 熱的に全ての基板からSiO 2との化学ウェットエッチングは、SiO 2の別の500ナノメートルに成長。
- ボリューム(注意36)でフッ酸で49%のテフロンビーカーを埋める。サンプルをカバーするのに十分な量を使用してください。
- サンプルを洗浄するための脱イオン水でテフロンビーカーを埋める。サンプルをカバーするのに十分な量を使用してください。
- フッ酸でサンプルをエッチングする。 SiO のすべてが除去されるまで、溶液中の試料のままにしておきます。溶液が高度に濃縮されているので、エッチングは、比較的迅速に行われます。
- 脱イオン水で満たされたテフロンビーカー内で10〜20秒間すすぐ。
- 1〜2分間流しに脱イオン流水で十分にサンプルをすすぐ。
- H 2 O 2(硫酸:過酸化水素、ピラニア洗浄)1:1の比テフロンビーカー(注意37)中のH 2 SO 4の溶液を混合する。サンプルをカバーするために十分なを使用してください。
- サンプルを洗浄するための脱イオン水でテフロンビーカーを埋める。
- H 2 SO 4中に試料を沈める7-10分間、H 2 O 2。
- 簡単に述べると、10秒、すすぎ水のビーカー中の試料をすすぐ。
- 徹底的に1-2分間、脱イオン流水で流しにサンプルをすすぐ。
- 窒素でサンプルを乾燥(水が表面から蒸発させないようにしてください)。
- SiO 2を 500nmのを成長させるためのウェット熱酸化を行ってください。
- UVリソグラフィと固定の固定ビームの最終リリースのための犠牲層としてのシリコンを露出させたパターンへの化学ウェットエッチングはSiO 2。
- (サンプルを沈めるのに十分)アセトンでガラスビーカーを満たし、5分間水浴ソニケーター中のアセトン満たしたビーカー超音波処理中のサンプルを配置します。
- 直接アセトンビーカーからサンプルを採取し、5分間水浴ソニケーターでビーカー超音波処理を充填したイソプロピルアルコールに入れてください。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発させないようにしてください)。
- 乾燥(脱水ベーク)10分間150℃に設定したホットプレート上のサンプル。 tの許可彼は脱水ベークが完了すると、RTに到達するためにサンプリングする。
- 30秒間3,500 rpmで試料上のフォトレジストスピンコーター、スピンコートHMDSを使用した。フォトレジストスピンコーターを使用して、30秒間3,500 rpmでサンプル上にポジ型フォトレジストをスピンコート。ホットプレート上で105℃で90秒間、フォトレジストをソフトベーク。
注:サンプルの直径のすべての25ミリメートル当たり1mlを使用してください。 - 350〜450ナノメートルの波長を有するUV放射線にサンプルを露出するマスクアライナを使用する。 391 MJ / cm 2の露光エネルギーを使用する。
- TMAHベースの現像液でガラスビーカーを記入し、サンプル全体を水没するのに十分な使用。
- すぐに乱開発を防ぐために開発を終了する脱イオン水でガラスビーカーを埋める。
- 12-20秒のためのサンプルを開発する。
- 慎重にかつ迅速に開発ビーカーからサンプルを除去し、10秒間すすぎ水のビーカー中に沈める。
- 純W流水で流しにサンプルをすすぐ1〜2分間試合開始。
- 慎重に乾燥窒素で(水が表面から蒸発させないようにしてください)。
- 顕微鏡下でサンプルを調べます。
- 必要な場合には、乱開発を避けるために、時間内に調整を開発手順を繰り返します。
- 表面の濡れ性を改善するために表面を粗くするためにプラズマRIEを使用してください。 RIE設定:Arを100sccmの、100 WのRF電力、50mTのチャンバ圧力で1分間。
- サンプルをカバーするためにBOEのに十分な量のテフロンビーカーを埋める。
- サンプルの中間のすすぎのための脱イオン水でテフロンビーカーを埋める。
- BOE内のサンプルを水没。エッチング速度は、90〜100ナノメートル/分である。
- エッチングが完了すると、10秒間脱イオン水でいるテフロンビーカー中ですすぐ。その後、1〜2分間流しに脱イオン流水でサンプルをすすぐ。
- 窒素でサンプルを乾燥(水が表面から蒸発させないようにしてください)。
- microscop中のサンプルを検査しますメール。
- エッチを繰り返し、フォトレジストのオーバーエッチングやアンダーカットを回避するために、時間の調整を必要に応じてステップをすすいでください。
- (サンプルを沈めるのに十分)アセトンでガラスビーカーを満たし、5分間水浴超音波処理器でアセトン満たしたビーカー内の試料、超音波処理を配置します。
- 直接アセトンビーカーからサンプルを採取し、5分間水浴ソニケーターでビーカー超音波処理を充填したイソプロピルアルコールに入れてください。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発させないようにしてください)。
- 預金のTiを20nmとAuを100nmスパッタ。このフィルムは、後続の電気めっきプロセス工程のための電気メッキのシード層として機能する。スパッタリングパラメータは次のとおりです。100 WのDC電源、8 MT、Arを100sccmの堆積圧力、ベース圧力3×10 -6 T。
- 大気中にプロセスチャンバまたはロードロックベント。
- に試料をロードしますプロセスチャンバやロードロック。
- 真空プロセスチャンバまたはロードロックをポンプ。
- プロセスチャンバは、3×10 -6 Tのベース圧力に達するまで待つ
- 堆積のための適切な場所にサンプルを配置します。
- システムにアルゴンを流して8 MTにチャンバ圧力を設定してください。使用されるシステムのタイプに大きく依存8 mTのを達成するために必要な正確な流量。この研究のために用いられるスパッタリングツールは100sccmの流量を使用した。
- チタンターゲットとソースをアクティブにします。
- 20分間、300WでPresputterチタン。
- 100 W.沈着の正確な時刻にチタンを20nmスパッタは、システム使用のタイプに大きく依存している。この研究で用いられるスパッタリングツールの場合、5分、20ナノメートルを達成するために必要である。
- チタンスパッタリングターゲットとソースを無効にします。
- 金のターゲットとソースをアクティブにします。
- 2分間、100WでPresputter金。
- スパッタ100 W.正確な堆積時間での金の100nmで使用されているスパッタリングツールに大きく依存している。この研究で用いられるスパッタリングツールの場合、10分では、金を100nmを提供するのに十分である。
- 金のスパッタリングターゲットでソースを無効にします。
- Arガスのバルブを閉じてください。
- プロセスチャンバやロードロックベント。
- プロセスチャンバやロードロックが大気に到達すると、サンプルをアンロードします。
- 高真空までロードロック又は処理チャンバをポンピングする。
- UVリソグラフィは、固定、固定ビームの形状を定義するフォトレジストモールドを作成します。
- (サンプルを沈めるのに十分)アセトンでガラスビーカーを満たし、5分間アセトン満たしたビーカー内のサンプルを配置します。
- 直接アセトンビーカーからサンプルを取り、5分間イソプロピルアルコール満たしたビーカーに入れてください。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発させないようにしてください)。 <李>ドライ(脱水ベーク)10分間150℃に設定したホットプレート上のサンプル。脱水ベークが完了すると、サンプルが室温に到達させます。
- 30秒間3,500 rpmで試料上のフォトレジストスピンコーター、スピンコートHMDSを使用した。フォトレジストスピンコーターを用いて、30秒間、2000rpmでサンプル上にポジ型フォトレジストをスピンコート。ホットプレート上で105℃で90秒間、フォトレジストをソフトベーク。
注:サンプルの直径のすべての25ミリメートル当たり1mlを使用してください。 - 整列し、350〜450ナノメートルの波長を有するUV放射にサンプルを露出するマスクアライナを使用する。 483 MJ / cm 2の露光エネルギーを使用する。
- TMAHベースの現像液でガラスビーカーを記入し、サンプル全体を水没するのに十分な使用。
- すぐに過現像を防止するために開発を終了する脱イオン水でガラスビーカーを埋める。
- 12-20秒のためのサンプルを開発する。
- 慎重にかつ迅速に開発ビーカーやサブミッション成功率からサンプルを削除10秒間すすぎ水のビーカー中にERGE。
- 1-2分間、脱イオン流水で流しにサンプルをすすぐ。
- 窒素でサンプルを乾燥(水が表面から蒸発させないようにしてください)。
- 顕微鏡下でサンプルを調べます。
- 必要な場合には、乱開発を避けるために、時間内に調整を開発手順を繰り返します。
- 電気めっき金MEMSビーム。
- 1リットルのビーカーガラスビーカーを使用してください。
- ホットプレート上で市販の、すぐに使える金めっき液(注意38).Place満たしたビーカー700mlのビーカーを埋める。
- 60℃にホットプレートを設定します。解決策は、所望の温度にとどまることを保証するために熱電対を使用してください。溶液が所望の温度に達すると、アノードと、工作物(サンプル)、および熱電対を保持する固定具に試料を取り付ける。
- 博覧会に基づいて適切な振幅への電流供給を設定しますサンプルのsedの金属化領域です。 2ミリアンペア/ cm 2の定電流密度が使用されている。
- ステンレス鋼の陽極が使用される。
- サンプルへのアノードとグランドにライブを接続します。
- 堆積速度は250〜300ナノメートル/分である。両端固定梁の最終的な厚さは0.5μmである。おおよそ4を考慮すると:1比(スパッタされたシード層を除去する場合)、スパッタ金を電気めっきさのエッチング速度に存在し、ビームを1μmの電気めっきされる。
- 必要な時間が経過すると、陽極と工作物からのリード線を外して、電流供給をオフにするサンプルを削除し、1分間流しに脱イオン流水でよくすすぐ。
- (水が表面から蒸発させないようにしてください)、窒素でサンプルを乾燥さブロー。
- 電気メッキが完了したことを確認するために顕微鏡と側面計を使用してください。
- フォトレジストモールドをエッチングする。
- 予熱グラム少女ビーカーを110℃(注意39)へのホットプレート上に専用のフォトレジスト剥離でいっぱい。 1時間、溶液中の試料水没。
- ホットプレートからビーカーを取り出し、液とサンプルは、RTに到達させる。
- 1〜2分間流しに流水で十分にサンプルをすすぐ。
- 5分間アセトンで満たしたビーカー中に試料を浸す。
- 5分間イソプロピルアルコールで満たしたビーカー中に試料を浸す。
- 窒素でサンプルを乾燥させ(イソプロピルアルコールが表面から蒸発させないようにしてください)。
- 顕微鏡下でサンプルを検査し、プロフィルメータで電気メッキのAuの段差高さを測定する。必要に応じて洗浄工程を繰り返します。
- 化学的ウェットエッチングのTi / Auシード層。
- 置きプラズマRIEのサンプルと、次のパラメータを使用します。のArを100sccm、100W、30秒間50ミリテスラを。
- 金エッチング液(注意40)テフロンやガラスビーカーを埋める。 enoug使用サンプル全体をカバーする時間。
- 脱イオン水でテフロンやガラスビーカーを埋める。このビーカーを迅速にAuエッチングを終了させる中間すすぎビーカーとなる。
- 金エッチング液でサンプルを水没。エッチなパラメータ - RT、7-8 nmの/秒、攪拌した。エッチングが完了すると、すすぎ水のビーカーに試料を浸し、穏やかに10〜20秒間攪拌する。
- 1〜2分間流しに脱イオン流水で十分にサンプルをすすぐ。
- 窒素ブロードライ(水が表面から蒸発させないようにしてください)。
- 顕微鏡下でエッチングを点検し、必要に応じて、すべてのAuを露光領域から削除されるまで繰り返します。
- Arを100sccmの、100W、30秒間、50ミリテスラ:次のパラメータを使用して試料上に再びプラズマRIEを行います。
- BOE(サンプルを沈めるのに十分)でテフロンビーカーを埋める。
- サンプルを洗浄するための脱イオン水でテフロンを埋める。
- RTでBOE内のサンプルを水没。ザ·レートは15〜18ナノメートル/ min.Whenエッチング時間でエッチングが完了すると、ビーカーからサンプルを除去し、10〜20秒間のすすぎビーカーにそれを沈める。
- 1〜2分間流しに脱イオン流水で十分にサンプルをすすぐ。
- 窒素ブロードライ(水が表面から蒸発させないようにしてください)。
- エッチを点検し、必要に応じて、すべてのチタンが露出した領域から削除されるまで繰り返します。かなりのアンダーカットを回避するためのエッチング時間を削減します。
- 選択的にシリコンを除去し、Auの固定の固定ビームを放出する乾式の等方性のXeF 2エッチング(注意41)を実行。
- 大気中にプロセスチャンバベント。
- プロセスチャンバ内のサンプルをロードします。
- 真空システムをポンプダウン。
- エッチング時間を強く露光部と用いられるエッチングシステムのタイプによって異なります。このサンプルの30秒サイクルで3 Tの圧力が使用される。 10サイクルが使用される。 110-1のエッチング速度は20nm /分が抽出される。
- エッチングパラメータはシステムで設定されると、シリコンの犠牲層をエッチングする。
- エッチングは有毒ガスを確実にするために必要なパージステップを完了し実行すると大気中にシステムを排気する前に削除されます。この研究では、システムが自動的にこのパージ工程を実行するプロセスを持っています。
- 大気中にプロセスチャンバベント。
- 慎重にサンプルを削除します。
- 真空までのプロセスチャンバポンプ。
ダイナミック波形の2。実験検証
- DCプローブステーション上の負荷サンプル。
- DCプローブステーションのチャック上にサンプルを置きます。
- サンプルを押したままにチャックの真空をアクティブにします。
- MEMS橋の付パッド上にタングステンプローブチップを配置するDCプローブ先端マニピュレータを使用してください。
- タングステンプローブチップの正確な位置決めを表示するDCプローブステーションの顕微鏡を使用しデバイスのDCバイアスパッドの上の。プルダウン電極は、接地プローブ先端でプローブしている間に、固定の固定ビームは、ライブ信号プローブの先端でプローブする。
- ファンクション·ジェネレータのProgramダイナミックバイアス信号。
- 最初の波は20のパラメータに対して計算された値を使用します。
- 動的な波形を作成するために、ファンクション·ジェネレータ上の任意波形機能を選択します。
- 入力波形の時間パラメータを設定します。 (0秒とは対照的に)関数発生器のタイプに応じて、第一の時間パラメータは、数マイクロ秒後に開始する。第1および第2の時間パラメータとの間の間隔は、オーバーシュートギャップに到達するためにビームを取る算出された時間になる。第二及び第三の時間パラメータ間の間隔は、ビームが完全に最小限の振動と平衡に達することを可能にするのに十分長くなければならない。プル京畿から(逆方向に動作するように時間パラメータを入力する場合解放する茶)、オーバーシュートギャップ時間は、第3の時間パラメータの間の時間間隔を決定し、オフになる。波を再起動する5回目の間隔が必要があるでしょう。この間隔許可証のためにビームがサイクルを再起動する前に平衡に達するのに十分な時間。
- 入力波形の電圧パラメータ。この信号は、線形増幅器を通過することになるので、電圧がビームに印加される実際の電圧の一部となります。この研究のためのファンクション·ジェネレータにプログラムされた値は実際の電圧の20分の1だった。
- 高速高電圧の線形増幅器に関数発生器の出力を接続する。
- 300 MHzのサンプリングレートのデジタルオシロスコープにリニアアンプの出力を接続します。オシロスコープは、任意波形発生器から出力された信号を確認するために使用される。
- 直流マニピュレータにリニアアンプの出力を接続します。ファンクション·ジェネレータがあることを確認してくださいこの手順を実行している間オフ。
- レーザドップラ振動計(LDV)でセットアップと測定
- サンプルの上LDVを保持しているヘッドの位置を調整します。
- レーザーの電源をオンにします。
- 測定するための所望のビームを見つけるために、LDVと統合されて、顕微鏡を使用してください。
- MEMSブリッジの中央にレーザーフォーカス。これは、最大偏向点である。
- レーザービーム反射の強度が正確な測定のために十分であることを確認してください。
- 適切なサンプリングレート、サンプリング時間を設定します。この測定は、5.1 MHzのサンプリングレートを使用しています。
- LDVための変位対時間出力を選択します。
- 連続測定モードを選択します。
- MEMSブリッジにバイアス信号を適用します。 LDVは、リアルタイムでのリンギング効果をキャプチャします。
- チューンファンクション·ジェネレータ上でタイミングおよび電圧パラメータは、プルダウンとリリースに最小限の光線発振を達成するために操作。
- 発見された最適値はバイアス信号をオフにしたら。
- 連続LDV測定モードをオフにします。
- バイアスパッドからのDCプローブ先端を持ち上げます。
- LDVのハードウェアインタフェースのトリガ出力にファンクション·ジェネレータのトリガ入力に接続します。この研究のためにBNCケーブルは、この接続のために使用される。
- LDVシステムからの外部トリガを確認するために、ファンクション·ジェネレータを設定します。
- 測定スキャンモードの開始時に関数発生器をトリガするLDVソフトウェアを設定する。
- シングルスキャンモードにLDVソフトウェアを設定します。時間はシングルスキャンは、波形の期間となります。
- MEMSブリッジの付パッドの上に戻ってダウンDCプローブチップをドロップします。
- LDVの測定モードを活性化することにより、スキャンした信号をキャプチャします。
- 対時間のデータの変位を保存します。
結果
図4の設定は、MEMSブリッジの時間特性に対する偏向を捕捉するために使用される。その連続測定モードにおけるレーザードップラー振動計を使用することによって、正確な電圧と時間のパラメータは、所望のギャップ高さの最小光線発振をもたらすことが見られる。 図5は、60 Vギャップ高さに対応する実施例のビーム偏向を示している。これは、事実上すべての発振が除去されることが分かる。だけでなく、動的な波形が1ギャップ高さのために、しかし、ギャップの可能な高さのすべてのために有用である。これは、それぞれ、両方のプルダウンおよび解放動作については、図6及び図7に示されている。前の図での測定を達成するために使用する計算され、測定された動的波形はそれぞれ、 図8および図9に示されている。
ALT = "図1" SRC = "/ファイル/ ftp_upload / 51251 / 51251fig1highres.jpg" />
図1の2Dスケッチおよび本研究で用いたMEMSブリッジのSEM像。 (A)2次元プロファイル。(B)、MEMS橋の上から見た図。実際製造されるデバイスの(C)は 、SEM。 この図の拡大版をご覧になるにはこちらをクリックしてください。

応答を変化する入力ステップと時間に応じて減衰しにくいMEMSブリッジの図2。スケッチ。 (A)単位工程がバイアスを適用した。単位ステップ入力に対するアンダーダンピングMEMSブリッジの(B)応答。(C)の時間変化/動的入力バイアス入力時変のMEMSブリッジの(D)応答。目標= "_ブランク」>この図の拡大版をご覧になるにはこちらをクリックしてください。

図3は、MEMSブリッジするためのプロセス·フローを要約する。 (A)酸化されたシリコン基板、シリコン基板の(B)バルクエッチング、シリコン基板の(C)の再酸化。犠牲シリコンを露出させる(D)二酸化ケイ素のエッチ。(E)金堆積およびパターニング。の(F)エッチングMEMSブリッジを解放するために犠牲シリコン層を形成する。 この図の拡大版をご覧になるにはこちらをクリックしてください。
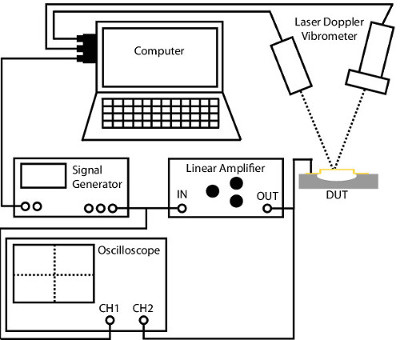
実験的なSEの図4のブロック図TUPは、バイアス信号を印加するとMEMS橋のたわみをキャプチャするために使用。 この図の拡大版をご覧になるにはこちらをクリックしてください。

図5は、プルダウンを測定し、60 Vの入力バイアスに応じて、MEMSブリッジの状態を解除する。黒い曲線は、ステップ入力からの応答である。赤い曲線は、ダイナミック入力に対する応答である。

図6は、動的な入力に応答して、MEMSブリッジの中間プルダウンギャップの高さを測定した。 大きな輸出自主規制を表示するには、ここをクリックしてくださいこの図のイオン。

図7は、動的入力に応答してMEMSブリッジの中間放出ギャップ高さを測定した。

入力バイアス用の8計算波形図。

MEMSブリッジの最小発振を達成するために使用される9実際の波形図。
ディスカッション
低残留応力Au膜堆積およびXeF 2を用いたドライリリースは、デバイスが正常に製造において極めて重要なコンポーネントです。平行平板フィールドアクチュエータと比較した場合、静フリンジフィールドアクチュエータは、比較的低い力を提供する。 > 60MPaでの典型的なMEMS薄膜の応力は、潜在的にEFFA MEMSの信頼性が損なわれる可能性が過度に高い駆動電圧になります。この理由のために電気めっきレシピを注意深く低二軸平均応力の薄膜を得ることを特徴としている。さらに、この研究では、熱サイクルを必要とするプロセス工程の間に(フォトレジストと比較して)の膨張および収縮の相対的な不足による犠牲層型としてシリコンを使用する。最後に、XeF 2を用いたドライ解放ステップは、事実上静止摩擦をなくすことにより、高収率処理を容易にします。
所望のビームギャップ高さはオーバーシュートギャップ高さに相当する( 図2B 20に対応して強い>)。ビームがオーバーシュート/所望のギャップ高さを達成したら第二段階のバイアス( 図2C)は、この位置にビームを保持するために適用される。 MEMSブリッジ(測定または計算することができる)の機械的品質係数を知ることにより、オーバーシュート率およびオーバーシュートギャップ高さに到達するまでの時間を算出することができる。これらのパラメータは、入力電圧の振幅とタイミングを決定するために使用される。
本研究で用いたDC-ダイナミック駆動信号がまで〜2ミリ秒からセトリング時間を改善し〜35秒にダウンアップとダウン·トゥ·アップ状態の両方のために。ヒューリスティックモデル20を使用して計算されたスイッチング時間は、幅w =10μmで、長さL =400μmで、厚さはt =0.45μmで、横のプルダウンギャップS =8μmであり、残留引張のビームのための28秒は、応力σを意味している= 5 MPaの。時間の切り替えはσ-1/2関係20を有している。 T彼はこの関係の結果、残留応力が比較的小さな変化は、スイッチング時間の計算上の非限界的な影響を与えることができることである。残留応力は2MPaの比較的小さな差は、20%のスイッチング時間変化をもたらすことができる。したがって必要性に起因ウェーハ全体プロセス変動の必然に本論文で提示された方法でリアルタイムの最適化のために存在しています。
この研究で提示した方法は、基板が除去されている静電漏れ磁場アクチュエータのスイッチング時間の大幅な改善を示している。 EFFA MEMSチューナの製造及び電気的試験の詳細は詳細に記載されている。実験方法は、特定の動的バイアス技術では、スイッチング時間のパフォーマンスを改善することに関しての実質的にいかなる機械的に減衰しにくいMEMS設計の有用性を見出すであろう。
開示事項
著者らは、開示することは何もない。
謝辞
著者は、彼の支援と便利な技術的な議論のためにライアン桐に感謝したい。
著者はまた、Birckナノテクノロジーセンターの技術スタッフの協力と支援を承認したいと思います。この作品は、パーデュー電子レンジリコンエバネッセントモード空洞の下で国防高等研究計画局によってサポートされていましたが研究をフィルタリングします。また、受賞数DE-FC5208NA28617下の信頼性、整合性とマイクロシステムの耐障害性とエネルギー省の予測のNNSAセンター。この論文/プレゼンテーションに含まれているビュー、意見、および/または所見は、著者/発表者のものであり、米国防総省の国防高等研究計画局や課の、明示または黙示の公式見解や政策を代表するものと解釈すべきではない国防。
資料
| Name | Company | Catalog Number | Comments |
| Chemicals | |||
| Buffered oxide etchant | Mallinckrodt Baker | 1178 | Silicon dioxide etch, Ti etch |
| Acetone | Mallinckrodt Baker | 5356 | Wafer clean |
| Isopropyl alcohol | Honeywell | BDH-140 | Wafer clean |
| Hexamethyldisilizane | Mallinckrodt Baker | 5797 | Adhesion promoter |
| Microposit SC 1827 Positive Photoresist | Shipley Europe Ltd | 44090 | Pattern, electroplating |
| Microposit MF-26A developer | Shipley Europe Ltd | 31200 | Develop SC 1827 |
| Tetramethylammonium hydroxide | Sigma-Aldrich | 334901 | Bulk Si etch |
| Sulfuric acid | Sciencelab.com | SLS2539 | Wafer clean |
| Hydrogen peroxide | Sciencelab.com | SLH1552 | Wafer clean |
| Transene Sulfite Gold TSG-250 | Transense | 110-TSG-250 | Au electroplating solution |
| Baker PRS-3000 Positive Resist Stripper | Mallinckrodt Baker | 6403 | Photoresist stripper |
| Gold etchant type TFA | Transense | 060-0015000 | Au etch |
| Equipment | |||
| Mask aligner | Karl Suss MJB-3 | Pattern photoresist | |
| Sputter coater | Perkin Elmer 2400 Sputterer | Deposit metal | |
| Thermal oxidation furnace | Pyrogenic Oxidation Furnace | Grow silicon dioxide | |
| Reactive Ion Etch | Plasmatech RIE | Plasma ash | |
| Xenon difluoride dry etcher | Xactix Xenon Difluoride Etcher | Selective dry isotropic silicon etch | |
| Surface profilometer | Alpha-Step IQ | Step height measurement | |
| Probe ring | Signatone | Holds DC probe manipulators | |
| DC manipulators | Signatone S-900 Series Micropositioner | Applies potential difference to device | |
| Laser doppler vibrometer | Polytec OFV-551/MSA-500 Micro System Analyzer | Switching time measurement | |
| Digital function generator | Agilent E4408B Function Generator | Creates the DC-dynamic waveform | |
| High voltage linear amplifier | Single channel high voltage linear amplifier A400 | Facilitates high voltage | |
| Digital oscilloscope | Agilent DS05034A Digital Oscilloscope | Verify the dynamic waveform parameters | |
参考文献
- Rebeiz, G. . RF MEMS: Theory, Design, and Technology. , (2003).
- Senturia, S. D. . Microsystem Design. , (2001).
- Bouchaud, J. . Propelled by HP Inkjet Sales, STMicroelectronics Remains Top MEMS Foundry. , (2011).
- Lantowski, K. G. D. The Future of Cinema Has Arrived: More Than 50,000. Theatre Screens Worldwide Feature The Brightest, 2D/3D Digital Cinema Experience With DLP Cinema. , (2011).
- Bosch-Wachtel, T. . Knowles Ships 2 Billionth SiSonic MEMS Microphone. , (2011).
- Burke, J. . Mirasol Display Capabilities Add Color and Interactivity to Improve User Experience for Renowned Jin Yong Branded Device. , (2012).
- Bettler, D. . MEMStronics Captures Prestigious R & D 100 Award. , (2011).
- Marsh, C. . Omron Releases New RF MEMS Switch with Superior High Frequency Characteristics rated to 100 Million Operations. , (2008).
- Rosa, M. A., Bruyker, D. D., Volkel, A. R., Peeters, E., Dunec, J. A novel external electrode configuration for the electrostatic actuation of MEMS based devices. J. Micromech. Microeng. 14, 446-451 (2004).
- Rottenberg, X., et al. Electrostatic fringing-field actuator (EFFA): application towards a low-complexity thin film RF-MEMS technology. J. Micromech. Microeng. 17, S204-S210 (2007).
- Allen, W. N., Small, J., Liu, X., Peroulis, D. Bandwidth-optimal single shunt-capacitor matching networks for parallel RC loads of Q >> 1. Asia-Pacific Microw. Conf (Singapore). , 2128-2131 (2009).
- Small, J., Liu, X., Garg, A., Peroulis, D. Electrostatically tunable analog single crystal silicon fringing-field MEMS varactor. Asia-Pacific Microw Conf (Singapore). , 575-578 (2009).
- Liu, X., Small, J., Berdy, D., Katehi, L. P. B., Chappell, W. J., Peroulis, D. Impact of mechanical vibration on the performance of RF MEMS evanescent-mode tunable resonators. IEEE Microw. Wireless Compon. Lett. 21, 406-408 (2011).
- Small, J., et al. Electrostatic fringing field actuation for pull-in free RF-MEMS analog tunable resonators. J. Micromech. Microeng. 22, 095004 (2012).
- Su, J. . A lateral-drive method to address pull-in failure in MEMS. , (2008).
- Scott, S., Peroulis, D. A capacitively-loaded MEMS slot element for wireless temperature sensing of up to 300°C . , 1161-1164 (2009).
- Scott, S., Sadeghi, F., Peroulis, D. Inherently-robust 300C MEMS sensor for wireless health monitoring of ball and rolling element bearings. , 975-978 (2009).
- Lee, K. B. Non-contact electrostatic microactuator using slit structures: theory and a preliminary test. J. Micromech. Microeng. 17, 2186-2196 (2007).
- Su, J., Yang, H., Fay, P., Porod, W., Berstein, G. H. A surface micromachined offset-drive method to extend the electrostatic travel range. J. Micromech. Microeng. 20, 015004 (2010).
- Small, J., Fruehling, A., Garg, A., Liu, X., Peroulis, D. DC-dynamic biasing for >50x switching time improvement in severely underdamped fringing-field electrostatic MEMS actuators. J. Micromech. Microeng. 22, (2012).
- Borovic, B., Liu, A. Q., Popa, D., Cai, H., Lewis, F. L. Open-loop versus closed-loop control of MEMS devices: Choices and issues. J. Micromech. Microeng. 15, 1917-1924 (2005).
- Pons-Nin, J., Rodriquez, A., Castaner, L. M. Voltage and pull-in time in current drive of electrostatic actuators. J. Microelectromech. Syst. 11, 196-205 (2002).
- Czaplewski, D. A., et al. A Soft Landing Waveform for Actuation of a Single-Pole Single-Throw Ohmic RF MEMS Switch. J. Microelectromech. Syst. 15, 1586-1594 (2006).
- Elata, D., Bamberger, H. On the dynamic pull-in of electrostatic actuators with multiple degrees of freedom and multiple voltage sources. J. Microelectromech. Syst. 15, 131-140 (2006).
- Chen, K. S., Ou, K. S. Fast positioning and impact minimizing of MEMS devices by suppression motion-induced vibration by command shaping method. , 1103-1106 (2009).
- Chen, K. S., Yang, T. S., Yin, J. F. Residual vibration suppression for duffing nonlinear systems with electromagnetical actuation using nonlinear command shaping techniques. ASME J. Vibration and Acoustics. 128, 778-789 (2006).
- . . Transene Sulfite Gold TSG-250. Product Number: 110-TSG-250. , (2012).
- . . Gold etchant type TFA. Product Number: 060-0015000. , (2012).
- Garg, A., Small, J., Mahapatro, A., Liu, X., Peroulis, D. Impact of sacrificial layer type on thin film metal residual stress. , 1052-1055 (2009).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved