Method Article
Real-Time DC-dinámico Método de polarización de conmutación Tiempo Mejoras en Severamente Subamortiguado Fleco campo electrostático MEMS actuadores
En este artículo
Resumen
El diseño robusto dispositivo de franja de campos electrostáticos actuadores MEMS resultados en condiciones de amortiguación de compresión de película inherentemente bajos y largos tiempos de sedimentación cuando se realizan operaciones de conmutación que utilizan polarización paso convencional. Conmutación mejora el tiempo con formas de onda DC-dinámicos en tiempo real reduce el tiempo de establecimiento de franjas de campo MEMS actuadores de paso de una puesta al abajo y abajo-a-arriba estados.
Resumen
Mecánicamente MEMS electrostático franja de campo Subamortiguado actuadores son bien conocidos por su operación de conmutación rápida en respuesta a una tensión de polarización de entrada escalón unitario. Sin embargo, la desventaja para el rendimiento de la conmutación mejorado es un tiempo relativamente largo para llegar a la solución de cada altura de vacío en respuesta a diversos voltajes aplicados. Transitoria aplicada se emplean ondas de polarización para facilitar tiempos de conmutación reducidas para electrostáticas MEMS franja de campo actuadores con factores mecánicos de alta calidad. Extracción del sustrato subyacente del actuador franja de campo crea el entorno de baja amortiguación mecánica necesaria para probar de manera efectiva el concepto. La eliminación del sustrato subyacente también tiene una mejora sustancial en el rendimiento de fiabilidad del dispositivo en cuanto a fallo debido a la fricción estática. Aunque polarización DC-dinámico es útil para mejorar el tiempo de asentamiento, las velocidades de respuesta requeridos para los dispositivos típicos de MEMS pueden colocar requisitos agresivos en el cargo pumps para totalmente integrados diseños en el chip. Además, puede haber desafíos que integran la etapa de eliminación del sustrato en los pasos de procesamiento CMOS comerciales back-end de línea. Validación experimental de actuadores fabricados demuestra una mejora de 50x en tiempo de conmutación cuando se compara a los resultados del paso de desviación convencionales. En comparación con los cálculos teóricos, los resultados experimentales están en buen acuerdo.
Introducción
Sistemas microelectromecánicos (MEMS) utilizan varios mecanismos de actuación para lograr el desplazamiento mecánico. Los más populares son térmico, piezoeléctrico, magnetostática y electrostática. Por corto tiempo de conmutación, activación electrostática es la técnica más popular 1, 2. En la práctica, los diseños mecánicos críticamente amortiguados-ofrecen el mejor compromiso entre tiempo de subida inicial y el tiempo de establecimiento. Al aplicar la polarización de CC y el accionamiento de la membrana hacia el electrodo desplegable, el tiempo de establecimiento no es un problema importante ya que la membrana se ajustará hacia abajo y se adhieren al electrodo de accionamiento recubierto dieléctrico. Varias aplicaciones se han beneficiado con el diseño de actuación electrostática mencionado 3-8. Sin embargo, la presencia del electrodo desplegable revestida dieléctrico hace que el actuador susceptible a la carga dieléctrica y la fricción estática.
Membranas MEMS pueden utilizar una underdamped diseño mecánico para lograr un tiempo de subida inicial rápida. Un ejemplo de un diseño mecánico subamortiguado es el halo-campo electrostático accionado (EFFA) MEMS. Esta topología ha mostrado mucho menos vulnerabilidad a los mecanismos de falla típicos que afectan a los diseños basados electrostáticas 9-20. La ausencia del electrodo contador en paralelo y en consecuencia el campo eléctrico paralelo es por qué estos MEMS están apropiadamente llamados "halo-campo" accionado (Figura 1). Para el diseño EFFA, el electrodo desplegable se divide en dos electrodos separados que se colocan desplazado lateralmente a la membrana en movimiento, eliminando por completo el solapamiento entre las partes móviles y estacionarias del dispositivo. Sin embargo, la eliminación del sustrato de debajo de la membrana móvil reduce significativamente la película de compresión de amortiguación componente que aumenta el tiempo de establecimiento. Figura 2B es un ejemplo de el tiempo de establecimiento en respuesta a standard paso de desviación. Transitorio, o DC-dinámico de empuje aplicadas en tiempo real se puede utilizar para mejorar el tiempo de establecimiento 20-26. Figuras 2C y 2D ilustran cualitativamente cómo una forma de onda variando el tiempo puede cancelar eficazmente el zumbido. Los esfuerzos de investigación anteriores utilizan métodos numéricos para calcular la tensión precisa y tiempos de la polarización de entrada para mejorar el tiempo de conmutación. El método en este trabajo utiliza expresiones de forma cerrada compactos para calcular los parámetros de forma de onda de polarización de entrada. Además, el trabajo previo se centró en la placa de accionamiento paralelo. Mientras que las estructuras están diseñadas para ser subamortiguado, amortiguación de compresión de película está disponible en esta configuración. El método de actuación se presenta en este trabajo es que franja campo de actuación. En esta configuración de amortiguación de compresión de película se elimina de manera efectiva. Esto representa un caso extremo en que la amortiguación mecánica del haz de MEMS es muy bajo. Este artículo describe cómo fabricar el dev EFFA MEMShielos y realizar la medición para validar experimentalmente el concepto de forma de onda.
Protocolo
1. Fabricación de EFFA MEMS fijo-fijo Vigas (Ver Figura 3 para el proceso Resumido)
- Litografía UV y grabado químico húmedo de dióxido de silicio con ácido fluorhídrico tamponado (PRECAUCIÓN 27).
- Utilice un sustrato de silicio de baja resistividad oxidado.
- Llene un vaso de vidrio con acetona 28 (suficiente para sumergir la muestra), colocar la muestra en el vaso de precipitados lleno de acetona, y se somete a ultrasonidos durante 5 minutos en un baño de ultrasonido agua.
- Sin secado, transferir directamente la muestra desde el vaso de precipitados de acetona a un vaso de precipitados lleno con alcohol isopropílico 29 y se somete a ultrasonidos durante 5 minutos en un sonicador de baño de agua.
- Secar la muestra con nitrógeno (no permita que el alcohol isopropílico se evapore de la superficie).
- En seco (hornear deshidratación) la muestra sobre una placa caliente ajustado a 150 ° C durante 10 min. Permitir que la muestra para llegar a RT una vez que el hornear la deshidratación es completa.
- Colocar la muestra en el plato de un spinner fotoprotector.Pipeta y dispensar 1 ml de hexametildisilazano (HMDS) por 25 mm de diámetro (precaución) 30. Spincoat a 3.500 rpm durante 30 segundos. Pipeta y dispensar 1 ml de resina fotosensible positivo por 25 mm de diámetro (precaución) 31. Spincoat la muestra a 3500 rpm durante 30 segundos. Softbake la fotoprotección durante 90 segundos a 105 ° C sobre una placa calefactora.
- Utilice un alineador de máscara para exponer la muestra a la radiación UV con una longitud de onda de 350-450 nm. Utilizar la energía de exposición de 391 mJ / cm 2 (PRECAUCIÓN 32).
- Llenar un vaso de precipitados de vidrio con programador basado TMAH (PRECAUCIÓN 33) y usar suficiente para sumergir la totalidad de la muestra.
- Llenar un vaso de precipitados de vidrio con agua desionizada para terminar rápidamente el desarrollo para evitar el desarrollo excesivo.
- Desarrollar la muestra de 12 a 20 seg. Agitar suavemente la muestra sumergida.
- Cuidadosa y rápidamente retirar la muestra del vaso de precipitados desarrollo y sumergirlo en el vaso de precipitados de agua de enjuague durante 10 segundos.
- Enjuagar la muestra en un fregadero bajo el chorro de agua desionizada durante 1-2 min.
- Cuidadosamente seque la muestra con nitrógeno (No permita que el agua desionizada se evapore de la superficie).
- Inspeccionar la muestra bajo un microscopio.
- Si es necesario, repita el procedimiento de desarrollo con los ajustes en el tiempo para evitar el desarrollo excesivo.
- Utilice un plasma reactivo de grabado de iones (RIE) para hacer rugosa la superficie para mejorar la humectación de la superficie. RIE Configuración 34: 100 sccm de Ar, 100 W de potencia de RF, presión de la cámara 50 mT, 1 min.
- Llenar un vaso de precipitados de teflón con una cantidad suficiente de óxido de etch tamponada (BOE) para cubrir la muestra.
- Llene otro vaso de precipitados de teflón con agua desionizada para un aclarado intermedio de la muestra.
- Sumerja la muestra en el BOE. La velocidad de ataque es de 90-100 nm / min.
- Cuando el grabado es completa, enjuague en el vaso de precipitados de teflón que ha de agua desionizada durante 10 s. Luego enjuague la muestra en un fregadero bajo el chorro de agua desionizada para 1-2 men.
- Secar la muestra con nitrógeno (No permita que el agua desionizada se evapore de la superficie).
- Inspeccionar la muestra bajo un microscopio.
- Repita el grabado y enjuague medidas que sean necesarias con los ajustes en el tiempo a fin de evitar la sobre-grabado y la subvaloración de la fotoprotección.
- Retire la máscara fotoprotector.
- Llene un vaso de vidrio con acetona (suficiente para sumergir la muestra), colocar la muestra en el vaso de precipitados lleno de acetona y se somete a ultrasonidos en un aparato de ultrasonidos baño María durante 5 min.
- Directamente tomar la muestra del vaso de precipitados de acetona y colocarlo en un vaso lleno de alcohol isopropílico y déjelos en remojo durante 5 minutos en un baño de ultrasonidos al baño de María.
- Secar la muestra con nitrógeno (No permita que el alcohol isopropílico se evapore de la superficie).
- Grabado químico húmedo de silicio con hidróxido de tetrametilamonio (TMAH) 25% en peso (PRECAUCIÓN 35).
- Use un limpia 4 L vaso de precipitados.
- Utilice una placa con un thermocouple. Utilice una cesta de teflón que tiene un gancho en el extremo del mango para la celebración de las muestras. Utilice una barra de agitación magnética para la agitación adecuada para aliviar la superficie de silicio de burbujas de hidrógeno que se liberan durante el proceso de ataque mayor.
NOTA: La retroalimentación entre el termopar y la placa de cocción asegura la temperatura adecuada se mantiene constante durante todo el grabado. Si el hidrógeno liberado no se elimina de la superficie, se puede enmascarar el silicio subyacente de la TMAH. - Verter la TMAH 25% en peso hasta la marca de 2 L del vaso de precipitados.
- Coloque el termopar en la solución y precalentar a 80 ° C. Si es posible, utilice un accesorio personalizado o abrazadera para sujetar el termopar para evitar la interferencia con la rotación de la barra de agitación magnética.
- Una vez que la solución alcance la temperatura necesaria, colocar las muestras en la cesta de teflón y colocar la cesta en la solución colgando desde el borde del vaso de precipitados. Asegúrese de que la cesta no descansaen la parte inferior del vaso de precipitados a fin de dejar espacio para la varilla de agitación magnética para girar.
- Ajuste la velocidad de rotación de la barra de agitación magnética a 400 rpm.
- La velocidad de grabado de la solución es de 300-350 nm / min. La profundidad de ataque necesaria es de 4-5 m.
- Cuando ha transcurrido el tiempo necesario para completar el grabado, retire la muestra de la solución y enjuagar con agua desionizada durante 1-2 min.
- Secar la muestra con nitrógeno (No permita que el agua desionizada se evapore de la superficie).
- Use un perfilómetro para medir la altura de los escalones.
- Si no se ha alcanzado la altura del escalón, colocar las muestras en la solución de nuevo con el fin de alcanzar la altura de paso deseado.
- Grabado húmedo química de todo SiO2 del sustrato y térmicamente crecer otros 500 nm de SiO2.
- Llenar un vaso de precipitados de teflón con ácido fluorhídrico 49% en volumen (PRECAUCIÓN 36). Use una cantidad que es suficiente para cubrir la muestra.
- Llenar un vaso de precipitados de teflón con agua desionizada para enjuagar la muestra. Use una cantidad que es suficiente para cubrir la muestra.
- Etch la muestra con ácido fluorhídrico. Dejar la muestra en la solución hasta que todo el SiO 2 se retira. Dado que la solución está muy concentrada, el grabado se producirá de forma relativamente rápida.
- Enjuague durante 10-20 segundos en el vaso de precipitados de teflón lleno de agua desionizada.
- Enjuague perfectamente la muestra bajo el chorro de agua desionizada en un sumidero de 1-2 min.
- Mezcle una solución de H 2 SO 4: H 2 O 2 (ácido sulfúrico: el peróxido de hidrógeno, piraña limpio) en una proporción de 1: 1 en un vaso de precipitados de teflón (PRECAUCIÓN 37). Use suficiente para cubrir la muestra.
- Llenar un vaso de precipitados de teflón con agua desionizada para enjuagar la muestra.
- Sumerja la muestra en el H 2 SO 4: H 2 O 2 durante 7-10 min.
- Brevemente, 10 segundos, lavar la muestra en el vaso de precipitados de agua de enjuague.
- Enjuague bien la muestra en un fregadero bajo el chorro de agua desionizada durante 1-2 min.
- Secar la muestra con nitrógeno (No permita que el agua se evapore de la superficie).
- Realizar la oxidación térmica en húmedo para crecer 500 nm de SiO 2.
- Litografía UV y grabado químico húmedo al patrón del SiO2 para exponer el silicio que sirve como capa de sacrificio para la versión final de las vigas fijo-fijo.
- Llene un vaso de vidrio con acetona (suficiente para sumergir la muestra), colocar la muestra en el vaso de precipitados lleno de acetona y se somete a ultrasonidos en un aparato de ultrasonidos baño María durante 5 min.
- Directamente tomar la muestra del vaso de precipitados de acetona y colocarlo en un vaso lleno de alcohol isopropílico y se somete a ultrasonidos en un aparato de ultrasonidos baño María durante 5 min.
- Secar la muestra con nitrógeno (No permita que el alcohol isopropílico se evapore de la superficie).
- En seco (hornear deshidratación) la muestra sobre una placa caliente ajustado a 150 ° C durante 10 min. Permitir tque las muestras a temperatura ambiente una vez que el hornear deshidratación es completa.
- El uso de un spincoater fotorresistente, HMDS spincoat en la muestra a 3500 rpm durante 30 segundos. El uso de un spincoater fotorresistente, spincoat fotoprotector positivo sobre la muestra a 3500 rpm durante 30 segundos. Softbake la fotoprotección durante 90 segundos a 105 ° C en una placa calefactora.
NOTA: Utilice 1 ml por cada 25 mm de diámetro de la muestra. - Utilice un alineador de máscara para exponer la muestra a la radiación UV con una longitud de onda de 350-450 nm. Usar energía de exposición de 391 mJ / cm 2.
- Llenar un vaso de precipitados de vidrio con un revelador basado TMAH y usar suficiente para sumergir la totalidad de la muestra.
- Llenar un vaso de precipitados de vidrio con agua desionizada para terminar rápidamente el desarrollo para prevenir el desarrollo excesivo.
- Desarrollar la muestra de 12 a 20 seg.
- Cuidadosa y rápidamente retirar la muestra del vaso de precipitados desarrollo y sumergirlo en el vaso de precipitados de agua de enjuague durante 10 segundos.
- Enjuagar la muestra en un fregadero bajo el chorro de agua desionizada water por 1-2 min.
- Cuidadosamente seco con nitrógeno (No deje que el agua se evapore de la superficie).
- Inspeccionar la muestra bajo un microscopio.
- Si es necesario, repita el procedimiento de desarrollo con los ajustes en el tiempo para evitar el desarrollo excesivo.
- Utilice RIE plasma para hacer rugosa la superficie para mejorar la humectación de la superficie. Ajustes RIE: 100 sccm de Ar, 100 W de potencia de RF, presión de la cámara 50 mT, 1 min.
- Llenar un vaso de precipitados de teflón con una cantidad suficiente de BOE para cubrir la muestra.
- Llenar un vaso de precipitados de teflón con agua desionizada para un aclarado intermedio de la muestra.
- Sumerja la muestra en el BOE. La velocidad de ataque es de 90-100 nm / min.
- Cuando el grabado es completa, enjuague en el vaso de precipitados de teflón que ha de agua desionizada durante 10 s. Luego enjuague la muestra bajo el chorro de agua desionizada en un sumidero de 1-2 min.
- Secar la muestra con nitrógeno (No permita que el agua se evapore de la superficie).
- Inspeccione muestra bajo un microscope.
- Repita el grabado y enjuague medidas que sean necesarias con los ajustes en el tiempo a fin de evitar la sobre-grabado y la subvaloración de la fotoprotección.
- Llene un vaso de vidrio con acetona (suficiente para sumergir la muestra), colocar la muestra en el vaso de precipitados lleno de acetona, y se somete a ultrasonidos en un aparato de ultrasonidos baño María durante 5 min.
- Directamente tomar la muestra del vaso de precipitados de acetona y colocarlo en un vaso lleno de alcohol isopropílico y se somete a ultrasonidos en un aparato de ultrasonidos baño María durante 5 min.
- Secar la muestra con nitrógeno (No permita que el alcohol isopropílico se evapore de la superficie).
- Pulverización catódica depósito de 20 nm de Ti y 100 nm de Au. Esta película sirve como la capa de semilla de galvanoplastia para la etapa de proceso de galvanoplastia posterior. Los parámetros de pulverización son: alimentación de CC de 100 W, la presión de deposición de 8 mT, 100 sccm de Ar, presión de base 3 x 10 -6 T.
- Purgar la cámara de proceso o de bloqueo de carga a la atmósfera.
- Cargar la muestra en elcámara de proceso o de bloqueo de carga.
- Bombear la cámara de proceso o de bloqueo de carga a vacío.
- Espere hasta que la cámara de proceso alcanza una presión base de 3 x 10 -6 T.
- Coloque la muestra en el lugar adecuado para la deposición.
- Ajuste la presión de la cámara de 8 mT haciendo fluir argón en el sistema. La velocidad de flujo exacta necesaria para lograr 8 mT depende en gran medida del tipo de sistema utilizado. La herramienta de pulverización catódica utilizado para este trabajo utilizó una velocidad de flujo de 100 sccm.
- Active la fuente con el blanco de titanio.
- Presputter de titanio a 300 W durante 20 min.
- Pulverización catódica 20 nm de titanio a 100 W. La hora exacta de la deposición depende en gran medida del tipo de uso del sistema. Para la herramienta de pulverización catódica utilizado en este trabajo, 5 min es necesaria para lograr 20 nm.
- Desactive la fuente con el blanco de pulverización catódica de titanio.
- Active la fuente con el objetivo de oro.
- Oro Presputter a 100 W durante 2 min.
- Catódica100 nm de oro a 100 W. El tiempo exacto de deposición es altamente dependiente de la herramienta de pulverización catódica que se utiliza. Para la herramienta de pulverización catódica utilizado en este trabajo, 10 min es suficiente para proporcionar 100 nm de oro.
- Desactive la fuente con el blanco de la farfulla de oro.
- Cierre la válvula de gas Ar.
- Purgar la cámara de proceso o de bloqueo de carga.
- Descargue la muestra una vez que la cámara de proceso o de bloqueo de carga llega a la atmósfera.
- Bombear el bloqueo de carga o cámara de proceso a alto vacío.
- Litografía UV para crear un molde de resina fotosensible que define la geometría del haz fijo-fijo.
- Llene un vaso de vidrio con acetona (suficiente para sumergir la muestra), colocar la muestra en el vaso lleno de acetona durante 5 min.
- Directamente tomar la muestra del vaso de precipitados de acetona y colocarlo en un vaso lleno de alcohol isopropílico durante 5 min.
- Secar la muestra con nitrógeno (No permita que el alcohol isopropílico se evapore de la superficie).
- Dry (hornear deshidratación) la muestra sobre una placa caliente ajustado a 150 ° C durante 10 min. Permitir que la muestra para llegar a RT una vez que el hornear la deshidratación es completa.
- El uso de un spincoater fotorresistente, HMDS spincoat en la muestra a 3500 rpm durante 30 segundos. El uso de un spincoater fotorresistente, spincoat fotoprotector positivo sobre la muestra a 2.000 rpm durante 30 seg. Softbake la fotoprotección durante 90 segundos a 105 ° C en una placa calefactora.
NOTA: Utilice 1 ml por cada 25 mm de diámetro de la muestra. - Utilice un alineador de máscara para alinear y exponer la muestra a la radiación UV con una longitud de onda de 350-450 nm. Utilice una energía de exposición de 483 mJ / cm 2.
- Llenar un vaso de precipitados de vidrio con programador basado TMAH y usar suficiente para sumergir la totalidad de la muestra.
- Llenar un vaso de precipitados de vidrio con agua desionizada para terminar rápidamente el desarrollo con el fin de evitar el desarrollo excesivo.
- Desarrollar la muestra de 12 a 20 seg.
- Cuidadosa y rápidamente retirar la muestra del vaso de precipitados desarrollo y Submerge en el vaso de precipitados de agua de enjuague durante 10 segundos.
- Enjuague la muestra en un fregadero bajo el chorro de agua desionizada durante 1-2 min.
- Secar la muestra con nitrógeno (No permita que el agua se evapore de la superficie).
- Inspeccionar la muestra bajo un microscopio.
- Si es necesario, repita el procedimiento de desarrollo con los ajustes en el tiempo para evitar el desarrollo excesivo.
- Electrochapa haz MEMS oro.
- Use un 1 L vaso de vidrio vaso de precipitados.
- Llenar vaso de precipitados con 700 ml de una comercialmente disponible, solución de galvanoplastia de oro listo para el uso (PRECAUCIÓN 38) .Colocar vaso de precipitados lleno sobre una placa caliente.
- Ajuste la placa caliente a 60 ° C. Utilice un termopar para asegurar que la solución se mantiene a la temperatura deseada. Una vez que la solución ha alcanzado la temperatura deseada, coloque la muestra a un aparato que mantiene el ánodo, la pieza de trabajo (la muestra), y el termopar.
- Ajuste el suministro de corriente a la amplitud apropiada basada en la Expoárea metalizada sed de la muestra. Se utiliza una densidad de corriente constante de 2 mA / cm 2.
- Se utiliza un ánodo de acero inoxidable.
- Conectar el vivo al ánodo y el suelo para la muestra.
- La velocidad de deposición es de 250-300 nm / min. El espesor final de la viga fijo-fijo es de 0,5 m. Teniendo en cuenta que un aproximado de 4: 1 relación existe en las velocidades de ataque de electrodepositadas al oro pulverizado (cuando la eliminación de la capa de pulverizado de semillas), el haz se electrochapado a 1 m.
- Cuando ha transcurrido el tiempo necesario, cierre el suministro de corriente, desconecte los cables del ánodo y la pieza de trabajo, extraer la muestra, y enjuagar bien bajo el chorro de agua desionizada en un sumidero de 1 min.
- Secar la muestra con nitrógeno (No permita que el agua se evapore de la superficie).
- Utilice un microscopio y perfilómetro para verificar que la galvanoplastia es completa.
- Grabar el molde de resina fotosensible.
- G Precalientevaso de precipitados lleno de lass una stripper dedicado fotorresistente sobre una placa caliente a 110 ° C (PRECAUCIÓN 39). Sumergir la muestra en la solución durante 1 hr.
- Retirar el vaso de placa calefactora y mantener la solución y las muestras a temperatura ambiente.
- Enjuagar la muestra con agua corriente en un fregadero para 1-2 min.
- Sumergir la muestra en un vaso de precipitados lleno con acetona durante 5 min.
- Sumergir la muestra en un vaso de precipitados lleno con alcohol isopropílico durante 5 min.
- Secar la muestra con nitrógeno (No permita que el alcohol isopropílico se evapore de la superficie).
- Inspeccionar la muestra bajo un microscopio y medir la altura del escalón del galvanizado Au con un perfilómetro. Repita los pasos de limpieza si es necesario.
- Grabado húmeda capa química de semillas de Ti / Au.
- Colocar la muestra en el plasma RIE y utilizar los siguientes parámetros: 100 sccm de Ar, 100 W, 50 mT durante 30 segundos.
- Llene un teflón o vidrio vaso con Au grabador (PRECAUCIÓN 40). Utilice enough para cubrir toda la muestra.
- Llenar un vaso de precipitados de teflón o vidrio con agua desionizada. Este vaso de precipitados servirá como un vaso de precipitados de aclarado intermedio para terminar rápidamente el Au etch.
- Sumerja la muestra en el Au grabador. Parámetros Etch - RT, 7-8 nm / seg, agitado. Una vez etch es completa, sumergir la muestra en el vaso de precipitados de agua de enjuague y agitar suavemente durante 10-20 seg.
- Enjuague perfectamente la muestra bajo el chorro de agua desionizada en un sumidero de 1-2 min.
- Golpe de nitrógeno seco (No permita que el agua se evapore de la superficie).
- Inspeccione el grabado bajo el microscopio y, si es necesario, repetir hasta que todo el Au se elimina de las áreas expuestas.
- Realizar plasma RIE otra vez en la muestra con los siguientes parámetros: 100 sccm de Ar, 100 W, 50 mT durante 30 segundos.
- Llene un vaso de teflón con BOE (suficiente para sumergir la muestra).
- Llenar un teflón con agua desionizada para enjuagar la muestra.
- Sumerja la muestra en el BOE a RT. Elvelocidad de ataque está 15-18 nm / min.When el tiempo de grabado, retire la muestra del vaso y se sumerja en el vaso de enjuague de 10-20 seg.
- Enjuague perfectamente la muestra bajo el chorro de agua desionizada en un sumidero de 1-2 min.
- Golpe de nitrógeno seco (No permita que el agua se evapore de la superficie).
- Inspeccione grabado y, si es necesario, repetir hasta eliminar todo el titanio a partir de las áreas expuestas. Reducir el tiempo de grabado para evitar la subvaloración significativa.
- Realizar una isotrópica XeF2 grabado en seco (PRECAUCIÓN 41) que elimina selectivamente el silicio y libera las vigas fijo-fijo Au.
- Purgar la cámara de proceso a la atmósfera.
- Cargar la muestra en la cámara de proceso.
- Bombear el sistema a vacío.
- El tiempo de grabado depende fuertemente de la zona expuesta y el tipo de sistema de grabado usado. Para este ejemplo se utiliza una presión de 3 T con un ciclo de 30 seg. Se utilizan 10 ciclos. Una velocidad de grabado de 110-120 nm min se extrae /.
- Una vez que el parámetro de grabado se encuentra en el sistema, grabar la capa de sacrificio de silicio.
- Cuando el grabado se completa realice los pasos de purga necesarias para garantizar los gases tóxicos se eliminan antes de ventilar el sistema a la atmósfera. El sistema en este estudio tiene un proceso que realiza automáticamente esta etapa de purga.
- Purgar la cámara de proceso a la atmósfera.
- Retire con cuidado las muestras.
- Bombear la cámara de proceso a vacío.
2. Experimental Validación de forma de onda dinámico
- Cargue la muestra en la estación de la sonda DC.
- Coloque la muestra en el plato de la estación de sonda DC.
- Activar el vacío del mandril para sujetar la muestra hacia abajo.
- Utilice DC manipuladores punta de la sonda en la posición de las puntas de tungsteno en los pads de polarización de los puentes de MEMS.
- Utilice el microscopio de sonda de la estación de DC para ver la localización precisa de la punta de la sonda de tungstenos más de la polarización DC almohadillas del dispositivo. El haz fijo-fijo se sondea con la punta de la sonda de la señal en vivo mientras los electrodos desplegables se probaron con la punta de la sonda de tierra.
- Programa de señal de polarización dinámica sobre el generador de funciones.
- Usar valores calculados para la ola inicial de parámetros 20.
- Elija la función de forma de onda arbitraria en el generador de funciones para crear la forma de onda dinámico.
- Entrada de los parámetros de tiempo de la forma de onda. Dependiendo del tipo de generador de función, el primer parámetro comienza después de unos pocos microsegundos (en oposición a 0 microsegundos). El intervalo entre el primer y segundo parámetro de tiempo será el tiempo calculado que se necesita el haz para llegar a la brecha de rebasamiento. El intervalo entre el segundo y el tercer parámetro de tiempo debe ser lo suficientemente largo para permitir que el haz para alcanzar por completo equilibrio con oscilación mínima. Al introducir los parámetros de tiempo para operar en sentido inverso (de tirón-down para liberar), el tiempo de separación exceso determinará el intervalo de tiempo entre el tercer parámetro de tiempo y apagando la. Habrá un intervalo de tiempo quinta necesidad de reiniciar la ola. Para este permiso intervalo de tiempo suficiente para que el haz alcance el equilibrio antes de reiniciar el ciclo.
- Introduzca los parámetros de tensión de la forma de onda. Las tensiones serán una fracción de la tensión real aplicada a la viga, porque esta señal pasará a través de un amplificador lineal. Los valores programados en el generador de funciones para este estudio fueron 1/20 de la tensión real.
- Conectar la salida del generador de función para el amplificador lineal de alta velocidad de alta tensión.
- Conecte la salida del amplificador lineal para un osciloscopio digital con velocidad de muestreo de 300 MHz. El osciloscopio se utiliza para verificar la salida de señal desde el generador de forma de onda arbitraria.
- Conectar la salida del amplificador lineal a los manipuladores de CC. Asegúrese de que el generador de funciones esoff mientras realiza este paso.
- Configuración y medir con el vibrómetro láser Doppler (LDV)
- Coloque la cabeza que sostiene el LDV sobre la muestra.
- Encienda el láser.
- Utilice el microscopio que está integrado con el LDV para encontrar el haz deseado de medir.
- Enfoque el láser en el centro del puente MEMS. Este es el punto de máxima deformación.
- Asegúrese de que la intensidad de la reflexión del rayo láser es suficiente para una medición precisa.
- Establezca el tiempo de muestreo a la velocidad de muestreo apropiado. Esta medición utiliza una velocidad de muestreo de 5,1 MHz.
- Seleccione la salida de desplazamiento frente al tiempo para el LDV.
- Seleccione el modo de medición continua.
- Aplique la señal de polarización en los puentes de MEMS. El LDV capturará el efecto de llamada en tiempo real.
- Tune los parámetros de tiempo y voltaje en el generador de funciones para lograr una mínima oscilación del haz en el desplegable y liberaciónoperaciones.
- Una vez que los valores óptimos se encuentran apagar la señal de polarización.
- Apague el modo de medición continua LDV.
- Levante las puntas de las sondas DC desde los pads de polarización.
- Conectar la entrada de disparo del generador de funciones a la salida de activación de la interfaz de hardware LDV. Para este estudio un cable BNC se utiliza para esta conexión.
- Ajuste el generador de funciones para reconocer el disparador externo del sistema LDV.
- Configure el software de LDV para activar el generador de funciones, cuando comienza el modo de exploración de medición.
- Configure el software de LDV a modo de barrido único. La exploración sola vez será la duración de la forma de onda.
- La caída de las puntas de las sondas de corriente continua de nuevo sobre las almohadillas de empuje del puente MEMS.
- Captura de la señal de escanear mediante la activación del modo de medición de la LDV.
- Guarde el desplazamiento frente a los datos de tiempo.
Resultados
La configuración en la Figura 4 se utiliza para capturar la deflexión frente a las características de tiempo de los puentes MEMS. Al utilizar el vibrómetro de láser Doppler en su modo de medición continua, los parámetros precisos de tensión y de tiempo se pueden encontrar para dar lugar a la oscilación del haz mínimo para la altura de separación deseada. Figura 5 ilustra un ejemplo de deflexión de haz que corresponde a la altura de la rendija 60 V. Se observa que prácticamente la totalidad de la oscilación se retira. No sólo es la forma de onda dinámica útil para una altura de hueco, pero para todas las alturas brecha posible. Esto se demuestra en la Figura 6 y la Figura 7 para las operaciones tanto de la desplegables y liberación, respectivamente. La forma de la onda dinámica calculada y medida utilizados para lograr las mediciones en las figuras anteriores se presenta en las figuras 8 y 9, respectivamente.
alt = "Figura 1" src = "/ files / ftp_upload / 51251 / 51251fig1highres.jpg" />
Figura 1. boceto 2D y la imagen SEM de puentes MEMS utilizados en este estudio. (A) el perfil 2D. (B) Vista superior de los puentes de MEMS. (C) SEM de dispositivo fabricado real. Haga clic aquí para ver una versión más grande de esta figura.

Figura 2. Bosquejo del puente de MEMS subamortiguada en respuesta a un paso de entrada y variables en el tiempo de respuesta. (A) Unidad paso sesgo aplicado. (B) Respuesta de MEMS subamortiguada puente de entrada escalón unitario. (C) Tiempo variable / polarización de entrada dinámica. (D) Respuesta de puente MEMS de entrada variable tiempo.rget = "_blank"> Haga clic aquí para ver una versión más grande de esta figura.

Figura 3. Resumido flujo de proceso para los MEMS puentes. (A) sustrato oxidado silicio. (B) de grabado a granel de sustrato de silicio. (C) Re-oxidación del sustrato de silicio. (D) de dióxido de grabado de silicio para exponer silicio sacrificial. (E) deposición de oro y el patrón. (F) de Etch capa de silicio de sacrificio para liberar el puente MEMS. Haga clic aquí para ver una versión más grande de esta figura.
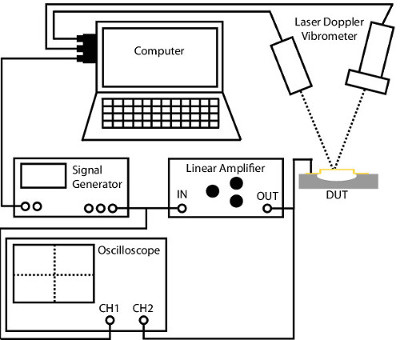
Figura 4 Diagrama de bloques del experimental sítup utiliza para aplicar la señal de polarización y capturar la deflexión MEMS puente. Haga clic aquí para ver una versión más grande de esta figura.

Figura 5. Medido desplegable y exime a los Estados de un puente MEMS en respuesta a una polarización de entrada de 60 V. La curva de negro es la respuesta de una entrada escalonada. La curva roja es la respuesta a una entrada dinámica.

Figura 6. Medido alturas brecha desplegable intermedias del puente de MEMS en respuesta a una entrada dinámica. Haga clic aquí para conocer el vers grandesion de esta figura.

Figura 7. Medido alturas Gap liberación intermedios del puente MEMS en respuesta a una entrada dinámica.

Figura 8. forma de onda calculada para la polarización de entrada.

Figura 9. forma de onda real utilizado para lograr la oscilación mínima del puente MEMS.
Discusión
Baja tensión residual Au deposición de la película y una liberación en seco con XeF 2 son componentes críticos en la fabricación exitosa del dispositivo. Actuadores franja de campos electrostáticos proporcionan fuerzas relativamente bajas en comparación con los impulsores de campo de placas paralelas. MEMS típicas tensiones de película delgada de> 60 MPa darán lugar a tensiones de activación excesivamente altos que potencialmente pueden poner en peligro la fiabilidad de EFFA MEMS. Por esta razón la receta de galvanoplastia se caracteriza cuidadosamente para producir una película delgada con baja-media axial bi estrés. Además, este estudio utiliza silicio como el tipo de capa de sacrificio debido a su relativa falta de expansión y contracción (en comparación con fotorresistencia) durante los pasos de proceso que requieren ciclos de calor. Por último, la etapa de liberación seca con XeF2 facilita el procesamiento de alto rendimiento eliminando virtualmente la fricción estática.
La altura de la rendija de haz deseada corresponde a la altura de la rendija de rebasamiento (Figura 2B ) en respuesta a la primera etapa de polarización 20. Una vez que el haz alcanza el sobreimpulso / altura de separación deseada se aplica el sesgo segundo paso (Figura 2C) para sostener la viga en esta posición. Al conocer el factor de calidad mecánica del puente MEMS (que puede ser medido o calculado), el porcentaje de rebasamiento y el tiempo para alcanzar la altura brecha rebasamiento se pueden calcular. Estos parámetros se utilizan para determinar la amplitud y el tiempo de la tensión de entrada.
Señales de accionamiento DC-dinámicos utilizados en este estudio mejoraron el tiempo de establecimiento de ~ 2 ms hasta ~ 35 microsegundos para ambos hasta a abajo y abajo-a-arriba estados. El tiempo de conmutación calculado utilizando el modelo heurístico 20 es de 28 microsegundos para una viga con una anchura w = 10 m, longitud L = 400 m, espesor t = 0,45 m, distancia lateral desplegable s = 8 m, y la tracción residual significa σ estrés = 5 MPa. Tiempo de conmutación tiene una relación σ -1 / 2 20. Tque consecuencia de esta relación es que relativamente pequeñas variaciones en la tensión residual puede tener un impacto no marginal en el cálculo del tiempo de conmutación. A diferencia relativamente pequeña de 2 MPa en la tensión residual puede resultar en una variación de tiempo de conmutación de 20%. Por lo tanto existe la necesidad de optimización en tiempo real con el método presentado en este trabajo debido a la inevitabilidad de la variación del proceso a través de una oblea.
El método presentado en este trabajo demuestra mejoras significativas en el tiempo de conmutación para actuadores electrostáticos campo marginal en donde se retira el sustrato. Los detalles para la fabricación de los sintonizadores EFFA MEMS y la prueba eléctrica se describen en detalle. El método experimental, en particular, la técnica de polarización dinámica, encontrará utilidad en prácticamente cualquier diseño MEMS mecánicamente subamortiguado en cuanto a mejorar el rendimiento tiempo de conmutación.
Divulgaciones
Los autores no tienen nada que revelar.
Agradecimientos
Los autores desean agradecer a Ryan Tung por su asistencia y discusiones técnicas útiles.
Los autores también desean agradecer la ayuda y el apoyo del personal técnico Birck Centro de Nanotecnología. Este trabajo fue apoyado por la Agencia de Proyectos de Investigación Avanzada de Defensa bajo la Purdue Microondas Reconfigurable evanescente-Mode Cavidad Filtros Estudio. Y también por el Centro de Predicción de la NNSA fiabilidad, integridad y supervivencia de Microsystems y el Departamento de Energía bajo Premio número DE-FC5208NA28617. Los puntos de vista, opiniones y / o conclusiones contenidas en este documento / presentación son las de los autores / presentadores y no deben interpretarse como representación de los puntos de vista ni las políticas oficiales, ya sea expresa o implícita, de la Agencia de Proyectos de Investigación Avanzada de Defensa o el Departamento de Defensa.
Materiales
| Name | Company | Catalog Number | Comments |
| Chemicals | |||
| Buffered oxide etchant | Mallinckrodt Baker | 1178 | Silicon dioxide etch, Ti etch |
| Acetone | Mallinckrodt Baker | 5356 | Wafer clean |
| Isopropyl alcohol | Honeywell | BDH-140 | Wafer clean |
| Hexamethyldisilizane | Mallinckrodt Baker | 5797 | Adhesion promoter |
| Microposit SC 1827 Positive Photoresist | Shipley Europe Ltd | 44090 | Pattern, electroplating |
| Microposit MF-26A developer | Shipley Europe Ltd | 31200 | Develop SC 1827 |
| Tetramethylammonium hydroxide | Sigma-Aldrich | 334901 | Bulk Si etch |
| Sulfuric acid | Sciencelab.com | SLS2539 | Wafer clean |
| Hydrogen peroxide | Sciencelab.com | SLH1552 | Wafer clean |
| Transene Sulfite Gold TSG-250 | Transense | 110-TSG-250 | Au electroplating solution |
| Baker PRS-3000 Positive Resist Stripper | Mallinckrodt Baker | 6403 | Photoresist stripper |
| Gold etchant type TFA | Transense | 060-0015000 | Au etch |
| Equipment | |||
| Mask aligner | Karl Suss MJB-3 | Pattern photoresist | |
| Sputter coater | Perkin Elmer 2400 Sputterer | Deposit metal | |
| Thermal oxidation furnace | Pyrogenic Oxidation Furnace | Grow silicon dioxide | |
| Reactive Ion Etch | Plasmatech RIE | Plasma ash | |
| Xenon difluoride dry etcher | Xactix Xenon Difluoride Etcher | Selective dry isotropic silicon etch | |
| Surface profilometer | Alpha-Step IQ | Step height measurement | |
| Probe ring | Signatone | Holds DC probe manipulators | |
| DC manipulators | Signatone S-900 Series Micropositioner | Applies potential difference to device | |
| Laser doppler vibrometer | Polytec OFV-551/MSA-500 Micro System Analyzer | Switching time measurement | |
| Digital function generator | Agilent E4408B Function Generator | Creates the DC-dynamic waveform | |
| High voltage linear amplifier | Single channel high voltage linear amplifier A400 | Facilitates high voltage | |
| Digital oscilloscope | Agilent DS05034A Digital Oscilloscope | Verify the dynamic waveform parameters | |
Referencias
- Rebeiz, G. . RF MEMS: Theory, Design, and Technology. , (2003).
- Senturia, S. D. . Microsystem Design. , (2001).
- Bouchaud, J. . Propelled by HP Inkjet Sales, STMicroelectronics Remains Top MEMS Foundry. , (2011).
- Lantowski, K. G. D. The Future of Cinema Has Arrived: More Than 50,000. Theatre Screens Worldwide Feature The Brightest, 2D/3D Digital Cinema Experience With DLP Cinema. , (2011).
- Bosch-Wachtel, T. . Knowles Ships 2 Billionth SiSonic MEMS Microphone. , (2011).
- Burke, J. . Mirasol Display Capabilities Add Color and Interactivity to Improve User Experience for Renowned Jin Yong Branded Device. , (2012).
- Bettler, D. . MEMStronics Captures Prestigious R & D 100 Award. , (2011).
- Marsh, C. . Omron Releases New RF MEMS Switch with Superior High Frequency Characteristics rated to 100 Million Operations. , (2008).
- Rosa, M. A., Bruyker, D. D., Volkel, A. R., Peeters, E., Dunec, J. A novel external electrode configuration for the electrostatic actuation of MEMS based devices. J. Micromech. Microeng. 14, 446-451 (2004).
- Rottenberg, X., et al. Electrostatic fringing-field actuator (EFFA): application towards a low-complexity thin film RF-MEMS technology. J. Micromech. Microeng. 17, S204-S210 (2007).
- Allen, W. N., Small, J., Liu, X., Peroulis, D. Bandwidth-optimal single shunt-capacitor matching networks for parallel RC loads of Q >> 1. Asia-Pacific Microw. Conf (Singapore). , 2128-2131 (2009).
- Small, J., Liu, X., Garg, A., Peroulis, D. Electrostatically tunable analog single crystal silicon fringing-field MEMS varactor. Asia-Pacific Microw Conf (Singapore). , 575-578 (2009).
- Liu, X., Small, J., Berdy, D., Katehi, L. P. B., Chappell, W. J., Peroulis, D. Impact of mechanical vibration on the performance of RF MEMS evanescent-mode tunable resonators. IEEE Microw. Wireless Compon. Lett. 21, 406-408 (2011).
- Small, J., et al. Electrostatic fringing field actuation for pull-in free RF-MEMS analog tunable resonators. J. Micromech. Microeng. 22, 095004 (2012).
- Su, J. . A lateral-drive method to address pull-in failure in MEMS. , (2008).
- Scott, S., Peroulis, D. A capacitively-loaded MEMS slot element for wireless temperature sensing of up to 300°C . , 1161-1164 (2009).
- Scott, S., Sadeghi, F., Peroulis, D. Inherently-robust 300C MEMS sensor for wireless health monitoring of ball and rolling element bearings. , 975-978 (2009).
- Lee, K. B. Non-contact electrostatic microactuator using slit structures: theory and a preliminary test. J. Micromech. Microeng. 17, 2186-2196 (2007).
- Su, J., Yang, H., Fay, P., Porod, W., Berstein, G. H. A surface micromachined offset-drive method to extend the electrostatic travel range. J. Micromech. Microeng. 20, 015004 (2010).
- Small, J., Fruehling, A., Garg, A., Liu, X., Peroulis, D. DC-dynamic biasing for >50x switching time improvement in severely underdamped fringing-field electrostatic MEMS actuators. J. Micromech. Microeng. 22, (2012).
- Borovic, B., Liu, A. Q., Popa, D., Cai, H., Lewis, F. L. Open-loop versus closed-loop control of MEMS devices: Choices and issues. J. Micromech. Microeng. 15, 1917-1924 (2005).
- Pons-Nin, J., Rodriquez, A., Castaner, L. M. Voltage and pull-in time in current drive of electrostatic actuators. J. Microelectromech. Syst. 11, 196-205 (2002).
- Czaplewski, D. A., et al. A Soft Landing Waveform for Actuation of a Single-Pole Single-Throw Ohmic RF MEMS Switch. J. Microelectromech. Syst. 15, 1586-1594 (2006).
- Elata, D., Bamberger, H. On the dynamic pull-in of electrostatic actuators with multiple degrees of freedom and multiple voltage sources. J. Microelectromech. Syst. 15, 131-140 (2006).
- Chen, K. S., Ou, K. S. Fast positioning and impact minimizing of MEMS devices by suppression motion-induced vibration by command shaping method. , 1103-1106 (2009).
- Chen, K. S., Yang, T. S., Yin, J. F. Residual vibration suppression for duffing nonlinear systems with electromagnetical actuation using nonlinear command shaping techniques. ASME J. Vibration and Acoustics. 128, 778-789 (2006).
- . . Transene Sulfite Gold TSG-250. Product Number: 110-TSG-250. , (2012).
- . . Gold etchant type TFA. Product Number: 060-0015000. , (2012).
- Garg, A., Small, J., Mahapatro, A., Liu, X., Peroulis, D. Impact of sacrificial layer type on thin film metal residual stress. , 1052-1055 (2009).
Reimpresiones y Permisos
Solicitar permiso para reutilizar el texto o las figuras de este JoVE artículos
Solicitar permisoThis article has been published
Video Coming Soon
ACERCA DE JoVE
Copyright © 2025 MyJoVE Corporation. Todos los derechos reservados