Method Article
Uso de sacrificiais nanopartículas para eliminar os efeitos do Plano de ruído em contato Buracos fabricada por E-beam litografia
Neste Artigo
Resumo
Uniformemente nanopartículas porte pode remover flutuações nas dimensões Contacto Furo estampados em poli (metacrilato de metila) filmes (PMMA) fotossensíveis por feixe de elétrons (E-beam) litografia. O processo envolve afunilamento eletrostática para centro e depósito de nanopartículas em furos de contacto, seguido por refluxo fotorresiste e passos plasma e wet-gravura.
Resumo
Nano-padrões fabricados com ultravioleta extremo (EUV) ou por feixe de elétrons (E-beam) variações inesperadas litografia exibição em tamanho. Esta variação tem sido atribuída a flutuações estatísticas no número de fotões / electrões que chegam num dado nano-região resultantes de tiro-ruído (SN). O SN varia inversamente com a raiz quadrada de um número de fótons / elétrons. Para uma dose fixa, o SN é maior em EUV e e-beam litografias do que para tradicional (193 nm) a litografia óptica. Bottom-up e padronização de cima para baixo abordagens são combinadas para minimizar os efeitos do ruído tiro na padronização nano-buraco. Especificamente, um amino-silano auto-monta surfactante sobre uma bolacha de silício que é subsequentemente spin-revestidos com um filme de 100 nm de um foto-resistente de feixe de electrões com base em PMMA. A exposição ao E-feixe e o desenvolvimento subsequente descobrir a película surfactante subjacente aos fundos dos furos. Mergulhando a bolacha numa suspensão de carga negativa, que se tapou-citrato, 20 nm gnanopartículas de idade (PNB) Depósitos uma partícula por furo. O filme tensioactivo carregado positivamente exposta no orifício electrostaticamente funis a nanopartícula carregada negativamente para o centro de um furo exposto, que fixa permanentemente a posição de registo. Em seguida, por aquecimento perto da temperatura de transição vítrea do polímero fotossensível, o filme fotorresistente reflui e engole as nanopartículas. Esse processo apaga os buracos afetadas pela SN, mas deixa os PNB depositados bloqueado no local por uma forte ligação eletrostática. O tratamento com plasma de oxigénio expõe as PNB por decapagem uma camada fina do material fotosensitivo. Wet-condicionamento dos PNB expostos com uma solução de I2 / KI produz buracos uniformes localizados no centro de entalhes estampados por litografia de feixe de electrões. As experiências apresentadas mostram que a abordagem reduz a variação do tamanho dos furos causados por SN de 35% para menos de 10%. O método estende os limites de padrões de orifícios de contacto transistor para abaixo de 20 nm.
Introdução
O crescimento exponencial do poder computacional, como quantificada pela lei de Moore 1, 2 (1), é o resultado de avanços progressivos em litografia óptica. Nesta técnica de modelação de cima para baixo, a resolução alcançável, R, é dada pela bem conhecida Raleigh teorema 3:

Aqui, λ e NA são o comprimento de onda da luz e abertura numérica, respectivamente. Note-se que NA = η · sinθ, onde η é o índice de refracção do meio entre a lente e a bolacha; θ = tan-1 (d / 2l) para o diâmetro, d, da lente, e a distância, L, entre o centro da lente e a bolacha. Durante os últimos cinquenta anos, a resolução litográfica tem melhorado através da utilização de (a) fonte de luzs, incluindo lasers excimer, com comprimentos de onda UV progressivamente menores; (b) modelos ópticos inteligentes que utilizam máscaras do turno da fase 4; e (c) mais elevada NA. Por exposição ao ar (η = 1), NA é sempre menor que a unidade, mas através da introdução de um líquido com η> 1, 5, tal como água, entre a lente e a bolacha, NA pode ser elevado acima de um, melhorando assim a resolução da litografia de imersão. Atualmente os caminhos viáveis para um nó de 20 nm e além incluem fontes de UV extremos (λ = 13 nm) ou técnicas de padronização através do processamento duplos e quádruplos complexo de um fotorresiste várias camadas 6, 7.
Em escalas nanômetros de comprimento, flutuações estatísticas, causadas por shot-ruído (SN), no número de fótons chegam dentro de uma causa variação nano-região nas dimensões de lithogra padrões diográficas. Estes efeitos são mais pronunciados com a exposição à luz EUV de alta energia e E-feixes, sistemas que necessitam de ordens de grandeza menos fotões / partículas em comparação com o normal oito litografia óptica. Supersensíveis amplificado quimicamente (com uma eficiência quântica> 1) fotorresistentes também introduzir um SN química provocada por uma variação do número de moléculas em fotorreactivos nanoregions expostas 9, 10. Fotorresistentes inferiores sensibilidade que necessitam de exposições mais longas suprimir estes efeitos, mas também reduzem o rendimento.
Na escala molecular, a contribuição para a linha de ponta de rugosidade a partir da distribuição de tamanho molecular inerente aos polímeros fotossensíveis pode ser reduzido pelo uso de resinas fotossensíveis moleculares 11. Uma abordagem que é complementar a este processamento de cima para baixo de nano-padronização é a utilização de métodos de baixo para cima 12,s = "xref"> 13 que dependem especificamente sobre a auto-montagem dirigida (DSA) de polímeros dibloco 14. A capacidade desses processos para dirigir a nucleação e para criar espaçamento não uniforme entre os padrões desejados, tais como furos ou linhas, permanece um desafio. A distribuição de tamanho dos componentes moleculares 15, 16, também limita a escala e produtividade de fabricação de 17, 18. Problemas semelhantes limitar impressão microcontact de nanopartículas em litografia macia 19.
Este artigo apresenta estudos de uma nova abordagem híbrida (Figura 1), que combina o clássico de cima para baixo projeção de litografia com a automontagem eletrostática direcionado para reduzir o efeito da SN rugosidade / line-edge (LER) 20. Carregado positivamente grupos amina em monocamadas auto-montadas (SAM) de N - (2-aminoetil)-11-Amino-undecil-metoxi-silano (AATMS) subjacente à película de PMMA são expostas após o desenvolvimento. O filme fotorresistente carregada negativamente de PMMA electrostaticamente funis de carga negativa nanopartículas de ouro (PNB), tampado com citrato, 21-24 em buracos afetados-SN 25. Re-fluxo do fotorresistente PMMA engole nanopartículas predeposited no filme.
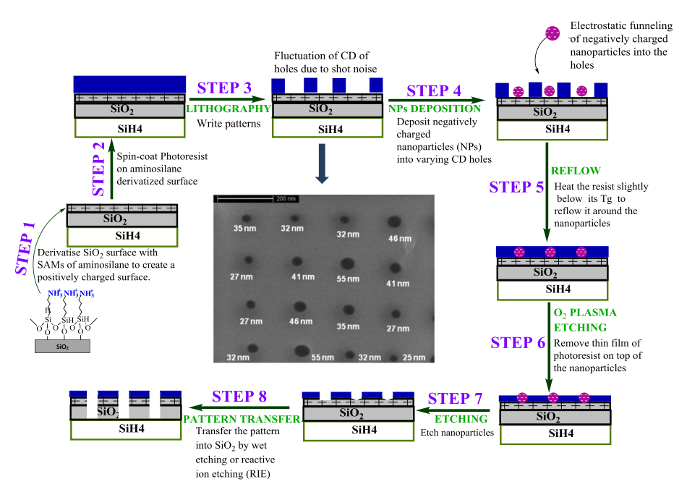
Figura 1: Representação esquemática da estratégia para eliminar os efeitos do shot-ruído e aspereza linha de ponta para o padrão de furos de contato usando NPs de tamanho preciso. Aqui, a dimensão crítica (CD) é o diâmetro desejado dos orifícios. A abordagem (passo 1) começa com a deposição de uma monocamada auto-montada (SAM) da molécula de silano tendo grupos amina carregados positivamente sobre o óxido de surfás de uma pastilha de silício. Em seguida, a litografia de feixe de electrões é usado para padrão de orifícios (Passos 2 e 3) em PMMA filme foto-resistente, a camada de azul, que gera tiro-ruído, tal como ilustrado na Imagem SEM inserir. Litografia expõe grupos amina na parte inferior dos orifícios. Passo 4 implica a deposição em fase aquosa de tamanho controlado, (carga negativa) nanopartículas de ouro cobertas de citrato (PNB) em buracos lithographically estampados utilizando afunilamento eletrostática (EF). No passo 5, o aquecimento da bolacha a 100 ° C, abaixo da temperatura de transição vítrea do PMMA, 110 ° C, faz com que o refluxo do fotorresistente em torno de nanopartículas pré-depositados. Etching sobreposta PMMA com plasma de oxigénio (passo 6) expõe as PNB, e subsequente molhado-condicionante (iodo) das partículas expostas (passo 7) cria orifícios correspondentes ao tamanho das PNB. Quando acoplada com Reactive-ião / molhado-gravar, é possível transferir o padrão de furos no fotorresistente de SiO 2 (passo 8) 31. Réimpresso com a permissão de referência 20. Por favor clique aqui para ver uma versão maior desta figura.
A interacção electrostática entre as cargas opostas e PNB grupos amina sobre o substrato impede o deslocamento das PNB do local de ligação. A etapa de refusão mantém a posição relativa dos PNB, mas apaga os buracos e os efeitos da SN / LER. Plasma / etapas corrosão úmida regenerar buracos que têm o tamanho do PIB. Gravura reativa-ion transfere o seu padrão de SiO 2 camadas hard-máscara. O método baseia-se na utilização de mais uniformemente do que um tamanho nanopartículas nanohole modelado (NH), expressa como o desvio padrão, σ, de tal modo que σ PNB <σ NH. Este relatório centra-se em etapas (4 e 5 descritos na Figura 1), envolvendo a deposição de nanopartículas de dispersão e darefluxo do fotorresistente em torno deles para avaliar as vantagens e limitações do método. Ambos os passos são, em princípio, adaptar a substratos maiores, sem necessidade de grande modificação do fluxo de corrente de produção modernos circuitos integrados em batatas fritas.
Protocolo
1. derivatizar e caracterização da superfície das bolachas de silício
- Limpe a superfície de pastilhas usando Radio Corporation of America (RCA) de limpeza soluções SC1 e SC2.
- Prepare SC1 e SC2 por volumetricamente misturando os seguintes produtos químicos:
SC1: H2O 2: NH4OH: H2O = 1: 1: 5 v / v e SC2: H2O 2: HCI: H2O = 1: 1: 5 v / v.- Imergir a bolacha em SC1 durante 10 min a 70 ° C, e, em seguida, executar uma lavagem com água desionizada.
- Seguir um protocolo semelhante para SC2 (10 min a 70 ° C, seguido por uma lavagem).
NOTA: O procedimento de limpeza remove impurezas orgânicas e iónicos e gera grupos silanol na superfície de óxido de silício das bolachas de silício.
- Derivatizar as superfícies das bolachas de silício com AATMS
- Incubar a placa de silício limpos em 0,05 M AATMS (preparado em dRY tolueno) a 80 ° C durante 20 min. Sonicar durante 5 min num sonicador de 100 W a temperatura ambiente no seio de tolueno puro durante 5 minutos e seco numa corrente de azoto gasoso.
- Caracterizar as superfícies das bolachas de silício derivatizados
- Medir o ângulo de contato usando um goniômetro e ImageJ software 25.
- Determinar a espessura das películas utilizando um elipsómetro (fonte de luz laser He-Ne, λ = 632,8 nm, fixa o ângulo de incidência de 70 °) 25.
- Estimar a composição elementar de superfície por espectroscopia de fotoelétrons de raios-X (XPS) 25.
Padronização 2. E-beam
- fotorresistente spin-revestimento (2% de poli (metacrilato de metilo (PMMA) em anisole) em wafers derivatizados AATMS- a 4.000 rpm durante 60 s.
- Prebake do filme a 180 ° C durante 120 segundos para secar a película de material fotosensitivo.
- Medir a espessura da película fotorresistenteutilizando um elipsómetro. Certifique-se de que a fonte de luz laser He-Ne, λ = 632,8 nm, é fixado a um ângulo de incidência de 70 °. Optimizar a fase de amostra para maximizar o sinal do detector utilizando uma superfície reflectora, tal como pastilha de silício. Use o programa de medição elipsometria (GEMP) no PC ligado ao medir a espessura de filme fotorresistente; ele deve ser de cerca de 100 nm.
- Exposição E-beam:
- Transferir a bolacha para uma câmara de alto vácuo de um alinhador de feixe de electrões.
- Criar um padrão de furos de ponto de poker usando um feixe de electrões (30 kV tensão de aceleração, a corrente do feixe 37 pA) que passa através de uma abertura 10 mícrons e proporcionando uma dose de 24 uC / cm3.
- Ajustar o tom padrão e dosagem conforme necessário para produzir um buraco-padrão de poker do tipo ponto do diâmetro desejado orifício (80 nm) e arremesso (200 nm).
- Remover a bolacha a partir da câmara de feixe de electrões.
- Desenvolver o padrão litográfica:
- Iníciodesenvolvimento padrão em uma solução de metil-isobutil-cetona / álcool isopropílico (MIBK / IPA, 1: 3 (v: v)) durante 70 s.
- Continuar a desenvolver ainda mais por imersão em IPA por 30 s. Concluir o desenvolvimento por lavagem em água deionizada por 30 s. Seca-se a bolacha em uma corrente de azoto gasoso.
3. A deposição de PNB em buracos-E-feixe modelado
NOTA: Deposição de PNB em furos estampados emprega dois métodos diferentes.
- Mergulhe wafers pré-modeladas em soluções PNB (método 1).
- Deixar a amostra no meio de suspensão PNB durante 24-48 horas, dependendo do tamanho do PNB e os diâmetros dos orifícios. Use a 20 nm, suspensão PNB cobertas de citrato contendo 7,0 x 10 11 PN / ml.
NOTA: Pode-se utilizar um tamanho PNB 10-100 nm e uma faixa de concentração de 5,7 x 10 12-5,7 x 10 9 PN / mL, conforme previsto por Ted Pella. Note-se que a densidade de deposição obedecea lei de difusão ̴ (dT) 1/2, em que D e T são os coeficientes de difusão do tempo de nanopartículas e deposição, respectivamente (ou seja, as partículas mais pequenas levar um tempo mais curto para a deposição, como discutido na referência 20, Figura 2c).
- Deixar a amostra no meio de suspensão PNB durante 24-48 horas, dependendo do tamanho do PNB e os diâmetros dos orifícios. Use a 20 nm, suspensão PNB cobertas de citrato contendo 7,0 x 10 11 PN / ml.
- PNB Spray-Depósito À wafers padronizadas (método 2)
- Para depositar PNB por evaporação, pulverizar uma solução de PNB modelado sobre o substrato, colocado na horizontal. Orientar o pulverizador de mão (Método 2) de modo que a pulverização é dirigida perpendicularmente à superfície do substrato.
- Pulverizar um volume suficiente da solução de suspensão, para molhar a superfície do substrato inteiro.
NOTA: Pode ser necessário diluir a suspensão PNB por 10x para evitar forçando várias nanopartículas em um grande buraco. - Incubar as amostras numa placa quente mantida a 30-35 ° C para produzir a evaporação controlada durante 10 min.
- Após a deposição (por qualquer dos métodosMétodo 1 ou 2), ligeiramente ultrasonicate (100 W) as amostras em água desionizada durante 50 s e secos numa corrente de azoto gasoso.
4. Microscopia Eletrônica de Varredura de imagem
NOTA: Existem dois tipos de estudos envolvidos convencional de cima para baixo e de imagem SEM transversal.
- Para top-down imagens SEM, use um E-beam tensão de aceleração de 5 kV com uma corrente de ~ 300 mA para evitar danos ao filme fotorresistente.
Atenção: A tensão mais baixa possível e configuração atual são necessárias para reduzir as reacções em cadeia de cisão no fotorresiste. Estas reacções de cisão de cadeia reduzir a temperatura de transição vítrea do polímero, o que por sua vez afecta a temperatura operacional para o passo de resistir refluxo descrito abaixo. - Secção transversal de imagem:
- Sputter-coat 10 nm da película de ouro grossa sobre PMMA fotorresiste para evitar danos ion-beam. Use um feixe de iões Ga focado operado a 30 kV e 93pA para cortar através dos furos. Obter secção transversal imagens SEM pela inclinação da bolacha a partir da sua posição horizontal normal.
5. Refluxo de PMMA Photoresist torno PNB nos orifícios modelados
- Aquecer os substratos modelado sobre uma placa quente a T refluxo (100 ° C) durante 3 min, o que é abaixo da temperatura de transição de vidro pré-determinado, Tg (110 ° C), de 950.000 g / mol PMMA; a taxa de refluxo para o polímero foi 1,7 ± 0,1 nm / s.
Cuidado: refluxo significativamente mais rápida ocorreu para as áreas modelado que anteriormente tinham sido expostas ao de feixe de electrões durante o exame com microscopia electrónica de varrimento (SEM), talvez devido à clivagem da cadeia principal polimérica, durante a exposição ao feixe de electrões, que conduz a uma redução de Tg. Esta observação é apoiada pelos estudos de Keymeulen e colegas de trabalho, que observou que a exposição à radiação de raios-X reduziu a Tg de PMMA 26.
6. seco e Wet-etch
- Dry-etch para a duração suficiente (55 s) com o oxigênio-plasma para expor PNB coberto com uma fina película de PMMA após refluxo. monitorizar cuidadosamente a taxa de decapagem de PMMA filme como uma função do tempo utilizando um elipsómetro ou monitor de espessura da película fina.
NOTA: A duração de gravação muito curto pode não expor os PNB, enquanto a gravura por muito tempo seria remover completamente o filme PMMA. Para 950 kDa PMMA, a taxa de corrosão foi de 1,5 nm / s, necessitando de 55 s de tempo de ataque. - PNB molhada por corrosão na parte inferior dos orifícios de contacto depois do refluxo, utilizando uma solução de iodo contendo 1,0 g de cristal de iodo (I 2), 4,0 g de iodeto de potássio (KI), e 40 mL de água desionizada, durante 10 min.
NOTA: iodeto de potássio aumenta a solubilidade do iodo em solução e facilita gravura ouro. A reação de ouro com iodo (2AU + I 2 → 2 AUI) produz ouroiodeto, que é ligeiramente solúvel em solução aquosa à temperatura ambiente.
7. Cálculo da Particle Deslocamento, densidade, e Fill Fraction
- Localizando o centro do furo e do PNB deslocamento:
- Ao lado, desenhar linhas retas melhor ajuste horizontal e vertical através das linhas e colunas de furos, respectivamente, para centros de furos estabelecidos nas intersecções destas linhas (Figura 2A e 2B). Incluir pelo menos mais de 500 buracos nos cálculos.
- Determinar a posição manualmente, R, de cada nanopartículas em relação ao centro do nanohole (isto é, o deslocamento) onde foi depositada (Figura 2b).
- Determinar a contagem de partículas contra histogramas de deslocamento usando um programa de planilha padrão.
- O cálculo da densidade de partículas: ρ = N (número de partículas) / unidade de área (| iM 2):
- Em primeiro lugar, determinar a área anelar de um anel com uma largura fixa (≈R / 10, em que R é o raio do furo) e delimitada por dois raios (R1, R2), com um deslocamento de R (= (R 1 + R2) / 2);
 .
. - Soma o número de partículas, N, na área a partir do histograma construído no passo 7.2, acima.
- Repetir o procedimento como uma função de r para gerar cerca de 10 passos iguais que terminam no R = R, o raio do furo.
- Em primeiro lugar, determinar a área anelar de um anel com uma largura fixa (≈R / 10, em que R é o raio do furo) e delimitada por dois raios (R1, R2), com um deslocamento de R (= (R 1 + R2) / 2);
- Montar a densidade de partículas contra os dados de deslocamento a uma curva de Gauss usando um procedimento de mínimos quadrados não linear (Figura 2a, inserir) 20. Extrai-se a desvio padrão de deslocamento (deposição σ) para a deposição e da incerteza da sua montagem.
- Repita o procedimento acimaprocedimento para os padrões obtidos SEM após a refluxo fotorresistente usando uma imagem SEM mostrado na Figura 2c.
NOTA: Após os buracos de refluxo desaparecer, desenhar linhas horizontais e verticais melhor ajuste em posições PNB para determinar os valores de melhor ajuste para os centros de furos. Calcular os deslocamentos de partículas como no passo 7.1 e extrai-se o combinado σ total seguindo o protocolo delineado nos passos 7,2-7,4.
NOTA: Aqui, combinada ou total refere-se ao deslocamento total do PIB devido às etapas de deposição e refluxo. - Determinar a fracção de enchimento por meio da estimativa da relação entre o número de orifícios preenchidos com o número total de orifícios, a Figura 2b.
Resultados
A Figura 2 mostra uma imagem SEM de PNB 20 nm depositados em furos de diâmetro de 80 nm modelado numa película de PMMA 60-100 nm de espessura impulsionado por afunilamento electrostática. Tal como observado por outros 22, o processo resultou em cerca de uma partícula por furo. A distribuição das partículas em torno do centro dos orifícios era Gaussiana (margem interna superior direito). A maior parte dos furos (93%) continha uma PNB, e 95% destas partículas ocorreu dentro de 20 nm do centro. Maior otimização, discutido em outro lugar, é necessário para melhorar o preenchimento fração ea centralização do PNB 20, 25. A Figura 2B e 2C mostra imagens SEM do PNB depositados a partir de maiores regiões da bolacha, antes e depois do refluxo do fotorresistente. A sessão de discussão apresenta análise quantitativa.

Figura 2: (a) PNB diâmetro de 20 nm depositada em 80 furos nm de diâmetro separados por um passo, P, de 200 nm (margem interna superior esquerda). 93% dos furos conter uma nanopartícula, e 95% das nanopartículas estão dentro de 18 nm a partir do centro (azul círculo). A inserção superior direito mostra uma distribuição de Gauss do deslocamento das partículas do centro, com σ = 9,0 ± 0,1 nm. Imagem (b) SEM de uma grande área após a deposição, σ = 9 ± 1 nm. (C) O mesmo que b) após o refluxo do fotorresiste, σ = 11 ± 2 nm. Modificado com a permissão de referência 20. Por favor clique aqui para ver uma versão maior desta figura.
A deposição por evaporação poderia reduziras 24-48 h necessária para a deposição de 25. Quando as dispersões de nanopartículas foram deixadas a evaporar na superfície padronizada, PNB depositado sobre a película de PMMA, bem como em furos. ultra-som leve numa solução tamponada removido fracamente ligada PNB na PMMA, deixando apenas as partículas fortemente ligadas nos furos. A Figura 3 ilustra a forma como as partículas múltiplas podem ser forçadas em buracos usando este método devido à reduzida repulsão entre partículas na dispersão iónico progressivamente concentrada. Tais efeitos de rastreio iónico deve ser evitado, uma vez que permitem ocupação multiparticle reduzido e a eficiência do afunilamento electrostática que dirige a partícula para o centro do furo. A redução da concentração de PNB na dispersão depósito, juntamente com ultra-sons, para o potencial de permitir a deposição de uma partícula por furo mais rapidamente do que a deposição de grandes quantidades solução-fase. Neste trabalho, nós não otimizar ocondições necessárias.

Figura 3: Deposição de PNB durante uma evaporação que durou mais de 20 min. As micrografias de fundo mostram vistas de cima para baixo e transversais de furos estampados por E-feixe. Modificado com a permissão de referência 25. Por favor clique aqui para ver uma versão maior desta figura.
O perfil da secção transversal SEM apresentado as paredes laterais do furo inclinado em relação aos seus centros. O ângulo da parede lateral era menor do que o óptimo de 90 °, criando um aumento da área de secção transversal no poço ao aproximar-se da interface fotorresistente-bolacha. Esta configuração explica o padrão de embalagem observada (esquerda) da partiCiclos, indicando a sua deslocação para longe do centro do furo. Melhor focalização do E-feixe, abaixo da interface entre o ar eo filme fotorresistente, eliminaria tal artefato.
Filmes finos, sólidos de PMMA fotorresistivo 27-30 liquefazer e fluxo perto da transição vítrea, Tg, de 110 ºC. Uma temperatura de 10 ° abaixo da Tg do polímero fotossensível, PMMA, iniciou um refluxo lento do fotorresistente. No, estado vítreo amolecida, do tipo líquido, a tensão superficial do filme fotorresistente reduzida a curvatura de ponta e de rugosidade, o que resulta numa supressão de efeitos LER. A frente fotorresistência líquida avançando nano buracos apresentaram completamente engolido, juntamente com os PNB depositados, tal como ilustrado na Figura 4, onde o número de PNB por buraco foi alta. Note como o refluxo fotorresistivo a partir das fronteiras buracos apagados the padrão de nano buracos apresentaram no filme. No entanto, PNB trancadas no registro de posição do padrão fortemente ligado. Notavelmente, estes estudos fotorresistivo-refluxo revelou um forte eletrostática ligação dos PNB cobertas de citrato de amina-terminados silanos. A similaridade do padrão de deposição dos PNB antes e depois de refluxo apoiou esta conclusão; veja a Figura 4c (vide infra).
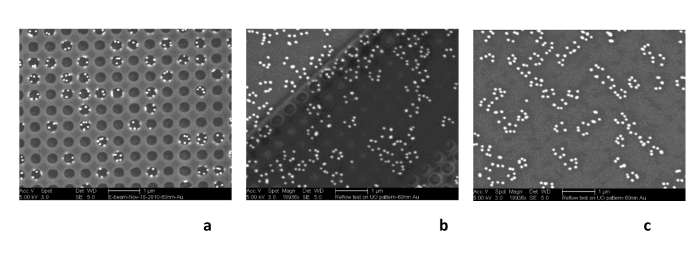
Figura 4: As posições dos PNB depositados são relativamente insensíveis ao refluxo do fotorresistente (ver o texto). Padrões dos depositados em 60 nm PNB furos 250 nm: (a) antes de refluxo, (b) depois do refluxo parcial, e (c) depois do refluxo total. Por favor clique aqui para ver uma versão maior desta figure.
A sequência geral de etapas e as alterações que ocorram nas imagens SEM correspondentes estão apresentados na Figura 5. Na Figura 5b, os orifícios na película durante o refluxo diminuiu fotorresistente, enquanto o processo envolverá foi concluída em menos de 3 minutos (Figura 5c). plasma de oxigênio gravado o filme mais espessa de fotorresiste que sobreposto em cima do PNB, expondo-os ao ar. Uma vez exposto, estes foram PNB usando solução de gravação de ouro com base em Kl / I2 (Figura 5D) gravado húmido. O coeficiente de variação para os diâmetros era de 9% para o buraco formado pelo processo PNB-assistida. Note-se que nestes estudos, o diâmetro a partir dos furos encolheu 80-20 nm, o que ilustra a força da abordagem. A principal limitação do método é a introdução de incerteza na posição de um orifício central recriado devido a uma combinação de incertezas intr oduced durante a deposição PNB e ao refluxo resistir. trabalhos em curso atual tenta abordar esses efeitos. Para além do ouro, outras nanopartículas de materiais diferentes, tais como a sílica (que pode ser entalhado em HF diluído), pode ser utilizado para reduzir os materiais e os custos de processamento. A exigência principal é que a nanopartícula / nanoestrutura deve ser selectivamente que pode ser entalhado, sem afectar o material resistir.

Figura 5: SEM. Imagens recolhidas durante as etapas empregues para minimizar a variação de tamanhos de buracos. (A) A deposição (24 h). (B e c) Refluxo do fotorresistente (20 s, 3 min). (d) Etching PMMA (O2 do plasma: 55 s) e PNB (wet-etch com uma solução de I2 / KI: 10 min)."> Por favor clique aqui para ver uma versão maior desta figura.
Discussão
Shot-ruído (SN) em litografia é uma simples consequência de flutuações estatísticas no número de fótons ou partículas (N) que chegam em um determinado nano-região; é inversamente proporcional à raiz quadrada de um número de fotões / partículas:

em que A e R são a área e o tamanho da região exposta, respectivamente. Por exemplo, quando se utiliza um ArF 193 nm (6,4-eV) de laser de excímero para padrão furos 50 nm, o número de fótons recebidos é de aproximadamente 1 x 10 6 na exposição à dose de 52 mJ / cm 2. Para obter uma fonte de feixe de electrões de 50 keV, o número de electrões que entregam a 50 mJ / cm 2 seria de cerca de 128, o que implica que o efeito de SN seria 100 vezes maior para a litografia de feixe de electrões. Além disso, o número de fotões / electrões que chegam de uma dada região diminui directamente com a área do padrão. Consequentemente, alarge variação no tamanho dos orifícios que recebeu os resultados de exposição "idênticos" ocorre como a dimensão do orifício a ser trabalhada diminui. Para os furos 35 nm mostrados na Figura 1 com a 30 keV de feixe de electrões, a cerca de 1440 electrões entregar a dose requerida de 24 uC / cm 2. Para padrão de 20 buracos nm em condições idênticas, seria necessário cerca de 400 elétrons, que é perto do limite SN teórica (200 elétrons) dada por Moreau 32. Actualmente, a única maneira para suprimir o efeito de SN é através do uso de um fotorresistente baixa sensibilidade que necessita de uma dose mais elevada de electrões / fotões. Ele vem à custa de menor rendimento e custos mais elevados para nano-padronização. O nosso método reduz o efeito da variação do tamanho, utilizando nanoestruturas monodispersas de redefinir o tamanho dos furos estampados litograficamente mantendo ao mesmo tempo o registo de posição inicial. O registro é fixado pelo forte eletrostática ligação de nanoestruturaspara a superfície, guiada por afunilamento electrostática.
O sucesso da padronização no presente método depende de dois efeitos. A primeira é a variação dos tamanhos dos orifícios, e o segundo é a centralização das nanopartículas dentro dos orifícios que afectam o registo posicional. O coeficiente de variação do diâmetro de orifícios estampados utilizando esta abordagem (9%, ou 19 ± 2 nm) é comparável ao coeficiente do tamanho (8%) do PNB 20. Por outro lado, como revelado na Figura 1, o E-beam-modelado de 35 nm (35 ± 9) furos, feitos sem usar esta abordagem, tinha um CV de 35%. O CV correspondente de padronização-E-beam por si só, tornar-se ainda pior quando fabricando 20 buracos nm. O SN pode ser configurado para ser proporcional ao CV, com estimativas aproximadas de CV para 20 nm e 80 buracos Nm a 61% e 15%, respectivamente. O método aqui apresentado fornece pelo menos uma melhoria de seis vezes (~ 61% / 9%) no CV sobre E-beam-alone padronização de 20 buracos nm. Mesmo com furos de partida de 80-nm, melhoria de quase 60% no resultado de CV (~ 15% / 9%) ocorre após esta abordagem.
O segundo efeito de deposição de partículas preocupações de distância a partir do centro geométrico dos furos (registo). Dois factores que contribuem para este efeito foram extraídos a partir de dados recolhidos SEM após a deposição de PNB em furos (Figura 2b) e depois fotorresistente-refluxo (Figura 2c). A análise estatística do deslocamento dos PNB do centro dos nano buracos apresentaram em que residiam (Figura 2a) revelou que, durante a deposição em fase de solução, a distribuição dos PNB sobre o centro do furo era Gaussiana, com um desvio-padrão (σ deposição) de 9 nm, ou cerca de metade do diâmetro dos PNB. O procedimento de análise foi equivalente a assumir que as partículas, em média, permanecer no centro de orifícios, apesar de, individualmente, podem ser deslocados randomly devido à difusão durante a deposição.
O segundo fator que afeta o deslocamento é devido ao movimento do PNB durante o refluxo fotorresiste. Os resultados, apresentados na Figura 4, indicam que a carga positiva AATMS SAM se liga tão fortemente ao PNB que eles não se movem durante o refluxo do fotorresiste. Uma análise semelhante das imagens de SEM (vide supra) recolhidas após a refluxo fotorresistente (Figura 2c) passo, desde que o desvio padrão global (σ total) no posicionamento das partículas (isto é, registo) após a deposição e refluxo. Para extrair a contribuição de resistir a refluxo, assumiu-se que os processos de deposição e fotorresistente-reflow produzir efeitos independentes no deslocamento de partículas a partir do centro de orifícios, de tal modo que:

Usando os valores ajustados de σ; Deposição (9 ± 1 nm) e σ total (11 ± 2 nm), extraiu-se o valor de σ-Resist refluxo foi estimado em 6 nm, o que é comparável a três vezes o desvio padrão nos 20 nm PNB. Tal desvio padrão baixo implica um efeito muito insignificante sobre o deslocamento de partículas ligadas durante o processo de foto-resistente refluxo. No entanto, a deposição σ parece variar directamente com o tamanho da PNB; Assim, necessita de melhoramentos significativos. Um modelo apresentado noutro local 20 sugere a optimização da taxa de densidade do filme fotorresistente e SAM para melhorar o registo posicional. Vários métodos, incluindo o uso de polarização eletrostática e carga em PNB, estão actualmente a ser explorado. Note-se, como discutido acima, de que uma análise de imagem SEM proporciona um método simples para o processo de optimização acima.
O avai comerciallabilidade de partículas PNB quase monodispersas ditou a escolha de nanopartículas de ouro. Em princípio, outros nanomateriais de baixo custo, tais como nanopartículas de sílica derivados com quelante carregada apropriadamente, também são candidatos adequados. O principal critério para a selecção de nanopartículas é o seu monodispersity e a sua susceptibilidade ao ataque químico. Para afunilamento eletrostática, encargos complementares apropriados no SAM e NP deve estar presente. A carga sobre NPs depende do seu potencial zeta, cujo sinal e a magnitude pode ser ajustado, quer através do pH da solução ou a carga em agentes quelantes. Do mesmo modo, seleccionando grupos extremidade terminal catiónicos ou aniónicos permite a modificação de carga de superfície no SAM. Se aperfeiçoado, o método estende prontamente a padrão linhas de trincheiras com nanofios 33 - 35. O sucesso global do método dependerá otimizar a colocação e enchimento nanoestruturas em photore pré-modeladofilmes sist, explorando eletrostáticas, interações magnéticas, ou ligando de ligação.
Divulgações
Os autores não têm nada a revelar.
Agradecimentos
Intel Corporation financiado este trabalho através de número de concessão 414305, e da Iniciativa Oregon Nanotecnologia e Microtecnologia (ONAMI) forneceu fundos correspondentes. Agradecemos o apoio e aconselhamento de Dr. James Blackwell em todas as fases deste trabalho. Agradecimentos especiais com Drew Beasau e Chelsea Bento de análise das estatísticas de posicionamento de partículas. Agradecemos ao professor Hall para uma leitura cuidadosa do manuscrito e Dr. Kurt Langworthy, da Universidade de Oregon, Eugene, OR, por sua ajuda com litografia de feixe de electrões.
Materiais
| Name | Company | Catalog Number | Comments |
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8%) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4% in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer (LSE Stokes model L116A) | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referências
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114(1965).
- Moore, G. E. Lithography and the future of Moore's law. SPIE Proc.: Advances in Resist Technology and Processing XII. Allen, R. D. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. Complementary Lithography - Stochastics Suppression and EUV, Electronics, Proc. Semicon. West, June 12, San Franscisco, , (2012).
- Reiser, A. Photoreactive Polymers: the Science and Technology of Resists. , John Wiley & Sons. (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. Nanotechnology (IEEE-NANO), 2011 11th IEEE Conference, , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. Henderson, C. L. 7273, 72732N(2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501(2013).
- Tsai, H. Y., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. Zhang, Y., Oehrlein, G. S., Lin, Q. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. Tong, W. . 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. Nanotechnology (IEEE-NANO), 2011 11th IEEE Conference, , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528(2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502(2009).
- Montgomery, P. K., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. Fedynyshyn, T. H. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304(2013).
- Moreau, W. M. Semiconductor Lithography: Principles, Practices, and Materials. , Springer Science & Business Media. 419(2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. (IEEE-NANO), 2011 11th IEEE Conference on Nanotechnology, , (2011).
- Tran, H. A., Rananavare, S. B. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . Morris, J. E., Iniewski, K. , CRC Press. (2013).
Reimpressões e Permissões
Solicitar permissão para reutilizar o texto ou figuras deste artigo JoVE
Solicitar PermissãoThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Todos os direitos reservados