Method Article
Die Verwendung von Aufopferungs Nanopartikel zu entfernen, die Auswirkungen von Shot-Rauschen in Kontaktlöchern Vorgefertigte durch Elektronenstrahl-Lithografie
In diesem Artikel
Zusammenfassung
Einheitlicher Größe Nanopartikel können in Poly (methylmethacrylat) (PMMA) Photoresistfilme durch Elektronenstrahl (E-Strahl) Lithographie gemustert Schwankungen in Kontaktlochabmessungen entfernen. Das Verfahren beinhaltet die elektrostatische funnelling zum Zentrum und Ablagerung Nanopartikel in Kontaktlöchern, gefolgt von Photoresist-Reflow-und plasma- und Nassätzen Schritte.
Zusammenfassung
Nano-Muster hergestellt mit extrem ultravioletten (EUV) oder Elektronenstrahl (E-Strahl) Lithografie zeigen unerwartete Variationen in der Größe. Diese Variation wurde auf statistische Schwankungen in der Anzahl der Photonen / Elektronen bei einer bestimmten Nanobereich vom Schrotrauschen (SN) auftretenden ankommen zurückzuführen. Die SN variiert invers mit der Quadratwurzel aus einer Anzahl von Photonen / Elektronen. Bei einer festen Dosierung ist die SN größer in der EUV-und E-Beam-Lithografien als bei herkömmlichen (193 nm) optische Lithographie. Bottom-up und Top-down-Musterbildungsverfahren kombiniert werden, um die Effekte von Schrotrauschen in Nano-Lochmusterbildung zu minimieren. Insbesondere wird ein Amino-Silan-Tensid durch Selbstorganisation auf einem Siliziumwafer, die anschließend aufgeschleudert wird mit einem 100 nm-Film aus einem PMMA-basierten E-beam Photoresist. Exposition gegenüber dem E-Strahl und der nachfolgenden Entwicklung enthüllen die zugrunde liegende Tensidfilm an den Böden der Löcher. Eintauchen des Wafers in einer Suspension von negativ geladenen, Citrat-capped, 20 nm galte Nanopartikel (BSP) Einlagen ein Teilchen pro Loch. Der belichtete positiv geladenen oberflächenaktiven Folie in das Loch elektrostatisch Trichtern der negativ geladenen Nanoteilchen an der Mitte eines belichteten Lochs, die permanent die Positionsregistrierungs fixiert. Als nächstes wird durch Erhitzen in der Nähe der Glasübergangstemperatur des Photoresistpolymer, verfließt der Photoresistfilm und verschlingt die Nanopartikel. Dieser Vorgang löscht die von SN betroffen Löcher lässt aber die eingerastet abgelagert GNPs durch starke elektrostatische Bindung. Die Behandlung mit Sauerstoffplasma macht die GNPs durch eine dünne Schicht des Photolacks geätzt wird. Naß-Ätzen der freigelegten GNPs mit einer Lösung von I 2 / KI ergibt in der Mitte der Vertiefungen durch E-Strahl - Lithographie gemustert angeordnet einheitliche Löcher. Die Experimente zeigen, dargestellt, dass der Ansatz die Variation in der Größe der Löcher reduziert, die durch SN von 35% auf unter 10%. Das Verfahren verlängert die Strukturierungsgrenzen des Transistors Kontaktlöcher auf unter 20 nm.
Einleitung
Das exponentielle Wachstum in Rechenleistung, als 1 von Moores Gesetz quantifiziert, 2 (1), ist ein Ergebnis der fortschreitenden Fortschritte in der optischen Lithographie. In diesem Top-down - Strukturierungstechnik, die erreichbare Auflösung R wird von dem bekannten Raleigh Satz 3 gegeben:

Hier λ und NA sind die Lichtwellenlänge und der numerischen Apertur, respectively. Man beachte , daß NA = sin & theta; · η, wobei η der Brechungsindex des Mediums zwischen der Linse und dem Wafer; θ = tan -1 (d / 2 l) für den Durchmesser, d, der Linse und der Abstand L zwischen der Mitte der Linse und dem Wafer. In den letzten fünfzig Jahren hat die lithographische Auflösung durch die Verwendung von verbesserten (a) Lichtquelles, einschließlich Excimer-Lasern, mit zunehmend kleineren UV-Wellenlängen; (b) geschickte optische Designs unter Verwendung von Phasenverschiebungsmasken 4; und (c) höhere NA. Für die Belichtung in Luft (η = 1), ist NA immer kleiner als eins, aber durch Einführen einer Flüssigkeit mit η> 1, beispielsweise Wasser 5, zwischen der Linse und dem Wafer kann NA über 1 erhöht werden, wodurch die Auflösung des Eintauchens Lithographie zu verbessern. Derzeit tragfähige Wege zu einem 20-nm - Knoten und darüber hinaus sind extreme UV - Quellen (λ = 13 nm) oder Strukturierungsverfahren unter Verwendung komplexer Doppel- und Vierer Verarbeitung eines mehrschichtigen Photoresist 6, 7.
In Nanometer-Längenskalen, statistischen Schwankungen, hervorgerufen durch Schrotrauschen (SN), in der Anzahl von Photonen innerhalb einer Nanobereich Ursache Variation in den Dimensionen des lithogra ankommen phische Muster. Diese Effekte sind noch ausgeprägter bei Exposition gegenüber hochenergetischer EUV Licht und E-Strahlen, Systemen , die 8 Grßenordnungen weniger Photonen / Teilchen im Vergleich zu normalen optischen Lithographie benötigen. Supersensitive chemisch verstärkte (mit einem Quantenwirkungsgrad> 1) Photoresists einzuführen auch eine SN chemischen durch eine Variation in der Anzahl der photoreaktiven Moleküle in exponierten nanoregions verursacht 9, 10. Niedrigere Empfindlichkeit Photolacke, die längere Belichtungszeiten benötigen unterdrücken diese Effekte, sondern sie reduzieren auch den Durchsatz.
Auf molekularer Ebene zu der Beitrag Line-Kantenrauigkeit von der molekularen Größenverteilung , die zu den Photoresist - Polymere , die durch Verwendung von Molekular Resists 11 reduziert werden kann. Ein Ansatz, der zu diesem Top-down - Verarbeitung von Nanostrukturierung ist die Verwendung von Bottom-up - Verfahren komplementäres 12,s = "xref"> 13 , die 14 speziell auf die Selbstorganisation (DSA) von Diblockpolymeren verlassen. Die Fähigkeit dieser Verfahren Nukleation zu lenken und zu ungleichmäßigen Abstand zwischen gewünschten Mustern, wie Bohrungen oder Leitungen zu schaffen, bleibt eine Herausforderung. Die Größenverteilung der molekularen Komponenten 15, 16 begrenzt auch das Ausmaß und die Ausbeute der Herstellung 17, 18. Ähnliche Probleme begrenzen Mikrokontaktdruck von Nanopartikeln in Weich - Lithographie 19.
Dieser Beitrag stellt Untersuchungen eines neuen Hybrid - Ansatz (Abbildung 1), die die klassischen Top-Down - Projektionslithografie mit elektrostatisch Selbstorganisation kombiniert die Wirkung von SN / Line-Kantenrauigkeit (LER) 20 zu reduzieren. Positiv Amingruppen auf selbstorganisierte Monoschichten (SAMs) von N berechnet - (2-aminoethyl)-11-Amino-Undecyl-methoxy-Silan (AATMS), um die PMMA-Film zugrunde liegen, sind nach der Entwicklung ausgesetzt. Die negativ geladenen Photoresist - Film aus PMMA elektrostatisch Trichter negativ Goldnanopartikel (GNPs), mit einer Kappe bedeckt mit Citrat geladen, 21-24 in SN betroffenen Löcher 25. Re-flow des PMMA Photoresist verschlingt zuvor abgeschiedenen Nanopartikel in dem Film.
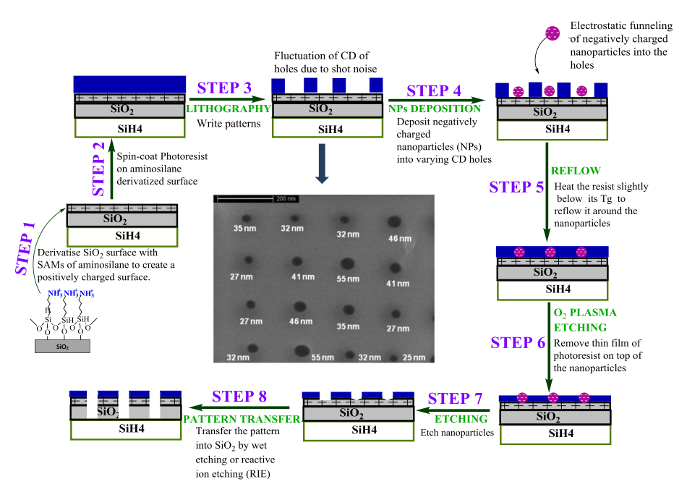
Abbildung 1: Schematische Darstellung der Strategie , um die Auswirkungen von Schrotrauschen und Linien Kantenrauigkeit für die Strukturierung von Kontaktlöchern mit NPs genaue Größe zu entfernen. Hier ist die kritische Dimension (CD) ist der gewünschte Durchmesser der Löcher. Der Ansatz (Schritt 1) beginnt mit einer selbstorganisierten Monoschicht (SAM) von Silan-Molekül Ablagern positiv geladene Aminogruppen auf dem Oxid Surflagerace eines Silizium-Wafers. Als nächstes wird die Löcher Muster Elektronenstrahllithographie verwendet (Schritte 2 und 3) in PMMA Photoresistfilm, der blauen Schicht, die Schrotrauschen erzeugt, wie in der eingesetzten SEM-Bild dargestellt. Lithographie belichtet Amingruppen an der Unterseite der Löcher. Schritt 4 beinhaltet die wässrige Phasenabscheidung von kontrollierter Größe, Citrat-capped (negativ geladene) Goldnanopartikel (GNPs) in lithographisch gemusterten Löcher unter Verwendung elektrostatischer funnelling (EF). In Schritt 5 Erwärmen des Wafers auf 100 ° C, unterhalb der Glasübergangstemperatur des PMMA, 110 ° C, bewirkt, daß das Aufschmelzen des Photoresist rund vorher entnommenes Nanopartikeln. Ätzen überlagert PMMA mit Sauerstoffplasma (Schritt 6) macht die GNPs und anschließende Nassätzen (Iod) der freigelegten Partikel (Schritt 7) erzeugt Löcher zu der Größe der GNPs entspricht. Gekoppelt mit reaktiven Ionen / Nassätzen, ist es möglich , die Lochmuster in dem Photoresist zu SiO 2 (Schritt 8) 31 zu übertragen. Regedruckt mit Genehmigung aus Lit. 20. Bitte klicken Sie hier , um eine größere Version dieser Figur zu sehen.
Die elektrostatische Wechselwirkung zwischen den entgegengesetzt geladenen GNPs und Amingruppen auf dem Substrat verhindert, dass die Verschiebung der GNPs von der Bindungsstelle. Der Reflow-Schritt hält die relative Anordnung der GNPs sondern löscht die Löcher und die Auswirkungen von SN / LER. Plasma- / Nassätzen Schritte regenerieren Löcher, die die Größe des BSP haben. Reaktives Ionenätzen überträgt ihr Muster zu SiO 2 Hartmaskenschichten. Das Verfahren beruht auf Verwendung von gleichmäßiger Größe Nanopartikel als eine gemusterte nanohole (NH), ausgedrückt als die Standardabweichung, σ, derart , daß σ GNP <σ NH. Dieser Bericht konzentriert sich auf die Schritte (4 und 5 in Abbildung 1 beschrieben) , um die Ablagerung von Nanopartikeln aus Dispersion beteiligt und dieAufschmelzen des Photoresist um sie herum die Vorteile und Grenzen des Verfahrens zu beurteilen. Beide Schritte sind im Prinzip skalierbar auf größeren Substraten, erfordern keine umfangreiche Änderung des Stromflusses von modernen integrierten Schaltungen auf Chips zu erzeugen.
Protokoll
1. derivatisieren und Charakterisieren der Oberfläche der Silizium-Wafer
- Reinigen Sie die Oberfläche von Wafern mit Radio Corporation of America (RCA) Reinigungslösungen SC1 und SC2.
- Bereiten Sie SC1 und SC2 durch volumetrisch folgende Mischen von Chemikalien:
SC1: H 2 O 2: NH 4 OH: H 2 O = 1: 1: 5 v / v und SC2: H 2 O 2: HCl: H 2 O = 1: 1: 5 v / v.- Tauchen Sie den Wafer in SC1 für 10 min bei 70 ° C, und führen Sie dann eine entsalztem Wasser zu waschen.
- Folgen einem ähnlichen Protokoll für SC2 (10 min bei 70 ° C, gefolgt von einem Waschen).
HINWEIS: Das Reinigungsverfahren entfernt organischen und ionischen Verunreinigungen und erzeugt Silanolgruppen auf der Siliziumoxid-Oberfläche der Siliciumscheiben.
- Derivatisierung der Oberflächen der Siliziumwafer mit AATMS
- Inkubieren des gereinigten Siliziumwafer in 0,05 M AATMS (in d vorbereitetry Toluol) bei 80 ° C für 20 min. Beschallen für 5 min in einem 100 W Beschallungsgerät bei Raumtemperatur in reinem Toluol für 5 min und trocken in einem Strom von Stickstoffgas.
- Charakterisierung der Oberflächen der Siliziumwafer derivatisiert
- Messen Sie den Kontaktwinkel mit Hilfe eines Goniometers und ImageJ Software 25.
- Bestimmen die Dicke der Filme unter Verwendung eines Ellipsometers (He-Ne - Laserlichtquelle, λ = 632,8 nm, Festeinfallswinkel von 70 °) 25.
- Schätzen Sie die Oberfläche elementare Zusammensetzung durch Röntgen-Photoelektronenspektroskopie (XPS) 25.
2. E-Beam-Patterning
- Spin-coat Photoresist (2% Poly (methyl-Methacrylat (PMMA) in Anisol) auf AATMS- derivatisierten Wafer bei 4000 Upm für 60 s.
- Vorbacken des Films bei 180 ° C für 120 s des Photoresistfilms zu trocknen.
- Messen Sie die Photoresistfilmdickeunter Verwendung eines Ellipsometers. Sicherzustellen, dass der He-Ne-Laserlichtquelle, λ = 632,8 nm bei einem Einfallswinkel von 70 ° festgelegt ist. Optimieren Sie die Probenstufe des Detektorsignals mit einer reflektierenden Oberfläche, wie zB Silizium-Wafer zu maximieren. Verwenden Sie das Ellipsometer Messprogramm (GEMP) auf dem angeschlossenen PC des Photolacks Filmdicke zu messen; es sollte etwa 100 nm sein.
- E-Strahl - Exposition:
- Übertragen, um den Wafer zu einer Hochvakuumkammer eines E-beam Ausrichters.
- Erstellen Sie ein Poker - Punktlochmuster eines Elektronenstrahls (30 kV Beschleunigungsspannung, 37 pA Strahlstrom) , die durch eine 10-um - Apertur und eine 24 & mgr; C / cm 3 Dosierung bereitstellt.
- Stellen Sie die Musterteilung und Dosierung nach Bedarf ein Poker-Punkt-Typ-Loch-Muster des gewünschten Lochdurchmesser (80 nm) und Steigung (200 nm) zu erzeugen.
- Entfernen Sie die Wafer aus der E-Strahlkammer.
- Entwickeln Sie das lithographische Muster:
- StartMusterentwicklung in einer Lösung aus Methylisobutylketon / Isopropylalkohol (MIBK / IPA, 1: 3 (v: v)) für 70 s.
- Weiter weiter für 30 s in IPA durch Tauchen zu entwickeln. Füllen Sie die Entwicklung durch Waschen in entionisiertem Wasser für 30 s. Trocknen des Wafers in einem Strom von Stickstoffgas.
3. Abscheidung von GNPs in E-beam-gemusterten Holes
HINWEIS: Die Abscheidung von GNPs in gemusterten Löchern verwendet zwei verschiedene Methoden.
- Tauchen vorstrukturierten Wafer in BSP - Lösungen (Methode 1).
- Lassen Sie die Probe in der BSP Suspensionsmittel für 24-48 h, abhängig von der Größe des BSP und die Durchmesser der Löcher. Verwenden Sie ein 20-nm - Citrat-capped BSP - Suspension , die 7,0 x 10 11 NPs / mL.
HINWEIS: Man kann eine GNP Größe von 10 bis 100 nm eingesetzt werden und einen Konzentrationsbereich von 5,7 x 10 12 bis 5,7 x 10 9 NPs / ml, wie von Ted Pella vorgesehen. Man beachte, dass die Ablagerungsdichte gehorchtdie Diffusionsgesetz ̴ (Dt) 1/2, wobei D und t Diffusionskoeffizienten des Nanopartikels und Abscheidungszeit jeweils (dh kleinere Teilchen nehmen eine kürzere Zeit für die Abscheidung, wie in Referenz 20, Figur 2c beschrieben).
- Lassen Sie die Probe in der BSP Suspensionsmittel für 24-48 h, abhängig von der Größe des BSP und die Durchmesser der Löcher. Verwenden Sie ein 20-nm - Citrat-capped BSP - Suspension , die 7,0 x 10 11 NPs / mL.
- Spray-Ablagerung GNPs auf den strukturierten Wafer (Methode 2)
- Zur Abscheidung GNPs durch Verdampfen, sprühen eine Lösung von GNPs auf das strukturierte Substrat, horizontal platziert. Orientieren des Handsprüher (Methode 2), so dass das Spray gerichtet ist senkrecht zu der Substratoberfläche.
- Spray, ein ausreichendes Volumen der Suspensionslösung der gesamten Substratoberfläche zu benetzen.
Hinweis: Es kann notwendig sein, die BSP-Suspension von 10-fach zu verdünnen mehrere Nanopartikel in ein großes Loch zu vermeiden zwingen. - Inkubieren Proben auf einer heißen Platte bei 30-35 ° C gehalten, um kontrollierte Verdampfung für 10 min erzeugen.
- Nach der Ablagerung (oder der anderen Methode1 oder Methode 2), mild ultrasonicate (100 W) die Proben in entionisiertem Wasser für 50 s und trocken in einem Strom von Stickstoffgas.
4. Rasterelektronenmikroskopie Imaging
HINWEIS: Zwei Arten von Studien beteiligt herkömmlichen top-down und Querschnitts SEM-Bildgebung.
- Für Top-down SEM - Bilder, eine E-beam Beschleunigungsspannung von 5 kV bei einem Strom von ~ 300 & mgr; A verwenden Beschädigung des Photoresistfilms zu verhindern.
Achtung: Die niedrigste mögliche Spannungs- und Stromeinstellung sind notwendig, Kettenspaltungsreaktionen in dem Photoresist zu reduzieren. Diese Kettenspaltungsreaktionen reduzieren die Glasübergangstemperatur des Polymers, die wiederum wirkt sich auf die Betriebstemperatur für die unten beschriebenen Aufschmelzschritt widerstehen. - Querschnitt Bildgebung:
- Sputter-Schicht 10 nm dicken Goldfilm über PMMA Photoresist Ionenstrahlschäden zu verhindern. Verwenden Sie einen fokussierten Ionenstrahl Ga bei 30 kV betrieben und 93pA durch die Löcher zu schneiden. Erhalten Querschnitt REM-Aufnahmen durch den Wafer von seiner normalen horizontalen Position kippen.
5. Reflow von PMMA um Photoresist-GNPs in der gemusterten Löcher
- Erhitzen der gemusterten Substrate auf einer heißen Platte bei T Reflow (100 ° C) für 3 min, die unterhalb der vorbestimmten Glasübergangstemperatur, T g (110 ° C) von 950.000 g / mol PMMA; die Rate der Reflow für das Polymer betrug 1,7 ± 0,1 nm / s.
Vorsicht: Deutlich schneller Reflow für den gemusterten Bereichen auftrat, die eine während der Einwirkung des Elektronenstrahls, was wegen der Spaltung der Polymerhauptkette an die E-Strahl während der Bildgebung mit der Rasterelektronenmikroskopie (SEM) ausgesetzt waren, möglicherweise vorher Reduktion von T g. Diese Beobachtung wird durch die Studien von Keymeulen und Mitarbeiter unterstützt, der darauf hinweist, dass die Exposition an Röntgenstrahlung , die T reduziertg PMMA 26.
6. Trocken- und Nass ätzen
- Trocken-Ätzung für eine ausreichende Zeitdauer (55 s) mit sauerstoffhaltigem Plasma GNPs mit einem dünnen Film aus PMMA nach dem Reflow abgedeckt zu belichten. Sorgfältig überwachen eines Ellipsometers oder Dünnfilmdickenmonitor die Rate der PMMA-Film Ätzen als Funktion der Zeit verwenden.
HINWEIS: Eine zu kurze Ätzdauer die GNPs nicht aussetzen kann, während für das Ätzen zu lang vollständig die PMMA-Film entfernen würde. Für 950 kDa PMMA betrug die Ätzrate 1,5 nm / s, 55 s erforderlich macht der Ätzzeit. - Wet-etch GNPs am Boden der Kontaktlöcher nach dem Aufschmelzen mit einer Lösung von Jod, enthaltend 1,0 g Jod - Kristall (I 2), 4,0 g Kaliumiodid (KI) und 40 ml deionisiertem Wasser für 10 min verwendet wird .
HINWEIS: Kaliumiodid verbessert die Löslichkeit des Iods in Lösung und erleichtert Gold Ätzen. Die Reaktion von Gold mit Jod (2Au + I 2 → 2 AuI) produziert GoldIodid, die bei Raumtemperatur leicht löslich in wässriger Lösung ist.
7. Berechnung der Teilchenverschiebung, Dichte und Füllfraktion
- Die Anordnung des Lochmitte und BSP - Verschiebung:
- Mit der Hand, ziehen horizontale und vertikale Best-Fit - Geraden durch die Reihen und Spalten von Löchern jeweils mit gängigen Lochzentren an den Schnittstellen dieser Linien (Abbildung 2a und 2b). Fügen Sie mindestens 500 + Löcher in den Berechnungen.
- Bestimmen , manuell die Position, r, jedes Nanopartikel bezogen auf das Zentrum des nanohole (dh die Verschiebung) , wo es abgeschieden wurde (Abbildung 2b).
- Bestimmen Sie die Partikelzahl-Weg-Histogramme ein Standard-Tabellenkalkulationsprogramm.
- Die Berechnung der Partikeldichte: ρ = N (Anzahl der Teilchen) / Flächeneinheit (& mgr; m 2):
- Zuerst bestimmen die Ringfläche eines Ringes mit einer festen Breite (≈R / 10, wobei R der Radius des Lochs ist) und begrenzt durch zwei Radien (r 1, r 2) bei einer Verschiebung von r (= (r 1 + r 2) / 2);
 .
. - Addiere die Anzahl der Partikel, N, in dem Bereich von dem konstruierten Histogramm in Schritt 7.2 vor.
- Wiederholen Sie den Vorgang als eine Funktion von r etwa 10 gleichen Schritten zu erzeugen endet bei r = R, der Lochradius.
- Zuerst bestimmen die Ringfläche eines Ringes mit einer festen Breite (≈R / 10, wobei R der Radius des Lochs ist) und begrenzt durch zwei Radien (r 1, r 2) bei einer Verschiebung von r (= (r 1 + r 2) / 2);
- Setzen Sie die Partikeldichte im Vergleich zu den Verschiebungsdaten zu einer Gauß - Kurve unter Verwendung eines nichtlinearen kleinsten Quadrate Verfahren (Abbildung 2a, Einschub) 20. Extrahieren Sie die Standardabweichung der Verschiebung (σ deposition) für die Abscheidung und ihre passende Unsicherheit.
- Wiederholen Sie den obigenVerfahren für die SEM - Muster nach dem Photoresist - Reflow unter Verwendung eines SEM - Bildes in 2c gezeigt ist, erhalten.
Hinweis: Nach dem Reflow-Löcher verschwinden, ziehen am besten passende horizontalen und vertikalen Linien auf Positionen BSP die Best-Fit-Werte für die Lochabstände zu bestimmen. Berechnen Sie die Partikel Verschiebungen wie in Schritt 7.1 und extrahieren die kombinierte σ Summe nach dem Protokoll in Schritten abgegrenzt 7,2-7,4.
HINWEIS: Hier kombiniert oder insgesamt bezieht sich auf die gesamte Verschiebung des BSP aufgrund der Ablagerung und Reflow-Schritten. - Bestimmen die fill Fraktion durch das Verhältnis der Anzahl der gefüllten Löcher auf die Gesamtzahl der Löcher, 2b abzuschätzen.
Ergebnisse
Abbildung 2 zeigt eine REM - Aufnahme von 20-nm GNPs abgeschieden in 80-nm Durchmesser Löchern gemustert in einer 60-100 nm dicken PMMA - Films durch elektrostatische funnelling angetrieben. Wie in 22 von anderen beobachtet, führte der Prozess etwa ein Teilchen pro Loch in. Die Verteilung der Partikel um die Mitte der Löcher war Gaussian (oben rechts im Bild). Die meisten Löcher (93%) enthielt ein BSP, und 95% dieser Teilchen innerhalb von 20 nm von der Mitte aufgetreten. Eine weitere Optimierung, an anderer Stelle diskutiert, wird benötigt , um die Fill-Fraktion und die Zentrierung des GNPs 20, 25 zu verbessern. Figur 2b und Figur 2c zeigt SEM - Bilder der abgeschiedenen GNPs von größeren Bereichen des Wafers vor und nach dem Aufschmelzen des Photolacks. Die Diskussion Abschnitt stellt eine weitere quantitative Analyse.

Abbildung 2: (a) 20-nm Durchmesser GNPs abgeschieden in 80 nm Durchmesser Löcher , die durch einen Abstand getrennt, P, von 200 nm (oben links kleines Bild). 93% der Löcher enthalten ein Nanopartikel, und 95% der Nanopartikel sind innerhalb von 18 nm von der Mitte (blauer Kreis). Die oben rechts im Bild zeigt eine Gaußsche Verteilung der Partikel Verschiebung von der Mitte, mit σ = 9,0 ± 0,1 nm. (B) SEM - Bild eines großen Fläche nach der Abscheidung, σ = 9 ± 1 nm. (C) Wie b) nach dem Aufschmelzen des Photolacks, σ = 11 ± 2 nm. Geändert mit Genehmigung aus Lit. 20. Bitte klicken Sie hier , um eine größere Version dieser Figur zu sehen.
Die Verdampfungsabscheidung könnte reduzierendie 24 bis 48 h für die Ablagerung 25 erforderlich. Wenn Dispersionen von Nanoteilchen erlaubt wurde auf der strukturierten Oberfläche zu verdampfen, abgeschieden GNPs auf dem Film PMMA, sowie in Löchern. Milde Ultraschallbehandlung in einer gepufferten Lösung entfernt schwach gebundenen BSP auf der PMMA, nur die stark gebundenen Teilchen in die Löcher zu verlassen. 3 veranschaulicht , wie mehrere Partikel gezwungen in Löcher werden könnte unter Verwendung dieses Verfahrens aufgrund der reduzierten zwischen den Teilchen Abstoßung in dem progressiv konzentrierte ionische Dispersion. Solche ionischen Screening Effekte vermieden werden sollte, da sie multipartikuläre Belegung erlaubt und senkbar Wirkungsgrad der elektrostatischen funneling daß das Teilchen zum Zentrum des Loches lenkt. Absenken der Konzentration an BSP in der Ablege Dispersion, zusammen mit Ultraschall, erlauben würde, möglicherweise für die Abscheidung von einem Teilchen pro Loch schneller als die Bulk-Lösungsphasenabscheidung. In dieser Arbeit habe optimieren wir nicht dienotwendigen Voraussetzungen.

Abbildung 3: Abscheidung von GNPs während einer Verdampfungs mehr als 20 min dauert. Die unteren REM-Aufnahmen zeigen von oben nach unten und Querschnittsansichten von Löchern, die durch E-Strahl strukturiert. Geändert mit Genehmigung aus Lit. 25. Bitte klicken Sie hier , um eine größere Version dieser Figur zu sehen.
Die Querschnitts SEM Profil angezeigt, um die Lochseitenwände in Richtung ihrer Mitte gekippt. Der Winkel der Seitenwand geringer als die optimale 90 °, eine zunehmende Querschnittsfläche in der Vertiefung zu schaffen, auf den Photoresist-Wafer-Grenzfläche annähert. Diese Konfiguration erklärt die beobachtete Packungsmuster (links) von partikeln, was anzeigt, von der Mitte des Lochs ihre Verschiebung weg. Bessere Fokussierung des E-Strahls unterhalb der Grenzfläche zwischen Luft und dem Photoresistfilm, beseitigen würde ein solches Artefakt.
Dünne, feste Filme aus PMMA Photoresist - 27-30 verflüssigen und fließen in der Nähe der Glasübergang, T g, von 110 ºC. Eine Temperatur 10 ° unterhalb der T g des Photoresistpolymer, PMMA, initiiert eine langsame Reflow des Photolacks. Im erweichten, flüssigkeitsartigen, glasigen Zustand, verringert die Oberflächenspannung des Photoresistfilms die Kante Krümmung und Rauhigkeit in einer Suppression von LER Wirkungen resultieren. Die fort flüssigen Photoresist vorderen Nanolöcher vollständig verschlungen, zusammen mit den abgeschiedenen GNPs, wie in Figur 4 dargestellt ist , wo die Anzahl der GNPs pro Loch war hoch. Beachten Sie, wie der Photoresist-Reflow von den Loch Grenzen gelöscht the Muster von Nanolöcher in dem Film. Dennoch stark GNPs in das Positionsregister des Musters gesperrt gebunden. Bemerkenswert ist, offenbart diese Photoresist-Reflow-Studien starke elektrostatische der Citrat-capped GNPs Bindung an Amin-terminierte Silane. Die Ähnlichkeit des Abscheidungsmusters GNPs vor und nach der Reflow diese Schlussfolgerung unterstützt; siehe Abbildung 4c (siehe unten).
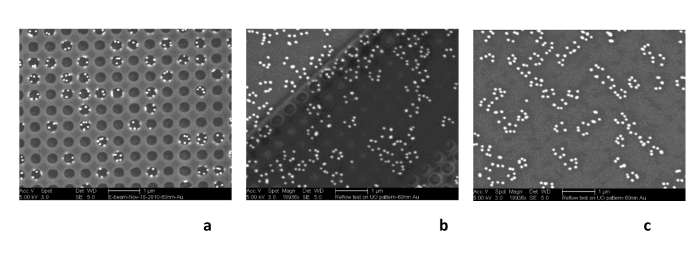
Figur 4: Die Positionen der abgeschiedenen GNPs sind relativ unempfindlich gegenüber dem Aufschmelzen des Photoresist (siehe Text). Muster der abgeschiedenen 60 nm GNPs in 250-nm - Löcher: (a) vor dem Reflow, (b) nach einer teilweisen Reflow, und (c) nach dem vollständigen Aufschmelzen. Bitte klicken Sie hier , um eine größere Version dieses figur anzuzeigene.
Die Gesamtsequenz von Schritten und die Veränderungen auftreten in den entsprechenden SEM - Bilder werden in 5 gezeigt. In 5b schrumpfte die Löcher in dem Film während der Photoresist - Reflow, während der verschlingt Verfahren in weniger als 3 min (Abbildung 5c) vollendet wurde. Sauerstoffplasma geätzt, um die dickere Schicht aus Photoresist, die auf der Oberseite GNPs überlagert, so dass sie der Luft ausgesetzt wird. Einmal ausgesetzt waren diese GNPs naßgeätzt Lösung unter Verwendung von Gold Ätzen basierend auf KI / I 2 (Abbildung 5d). Der Variationskoeffizient für die Durchmesser betrug 9% für das Loch durch die BSP-unterstützten Prozess gebildet. Man beachte, dass in diesen Studien der Anfangsdurchmesser der Löcher 80 bis 20 nm schrumpfte, was die Festigkeit des Ansatzes veranschaulicht. Die primäre Beschränkung des Verfahrens ist die Einführung von Unsicherheit in der Position eines Zentrums neu erstellt Loch aufgrund einer Kombination von Unsicherheiten intr während der BSP Ablagerung und der Resist Reflow oduced. Aktuelle laufenden Arbeiten versucht, diese Effekte zu adressieren. Neben Gold, andere Nanopartikel aus verschiedenen Materialien, wie Siliciumdioxid (ätzbaren in verdünnter HF) kann verwendet werden, um Materialien zu verringern und die Verarbeitungskosten. Die primäre Voraussetzung ist, dass das Nanopartikel / Nanostruktur selektiv ätzbar sein muss, ohne das Material zu widerstehen zu beeinflussen.

Abbildung 5: SEM. Bilder während der Schritte gesammelt verwendet, um die Variation der Lochgrößen zu minimieren. (A) Deposition (24 h). (B und c) Reflow des Photolacks (20 s, 3 min). (d) Ätzen PMMA (O 2 Plasma: 55 s) und BSP (Nassätzschritten mit I 2 / KI - Lösung: 10 min)."> Bitte hier klicken, um eine größere Version dieser Figur zu sehen.
Diskussion
Schrotrauschen (SN) in der Lithographie ist eine einfache Folge von statistischen Schwankungen in der Anzahl der Photonen oder Partikel (N) in einem gegebenen Nanobereich ankommen; Sie ist umgekehrt proportional zur Quadratwurzel aus einer Anzahl von Photonen / Teilchen:

wobei A und r sind der Bereich und die Größe des belichteten Bereiches, respectively. Beispielsweise bei Verwendung eines ArF-193 nm (6,4 eV) Excimerlaser Muster 50-nm Löcher erhielt die Anzahl von Photonen , beträgt etwa 1 x 10 6 in der Belichtungsdosis von 52 mJ / cm 2. Für ein 50 keV E-Strahlquelle, die Anzahl der Elektronen liefert 50 mJ / cm 2 wäre etwa 128, was bedeutet , dass die Wirkung von SN 100 - mal größer wäre für E-Strahl - Lithographie. Darüber hinaus nimmt die Anzahl der Photonen / Elektronen in einem gegebenen Bereich ankommen direkt mit der Fläche des Musters. Folglich alarge Schwankung in der Größe der Löcher, die "identischen" exposure Ergebnisse erhalten tritt als die Abmessung des Lochs abnimmt gefertigt werden. Für die 35 nm Löcher in Figur 1 mit dem 30 keV E-beam gezeigt, etwa 1.440 Elektronen liefern die erforderliche Dosis von 24 & mgr; C / cm 2. Um Muster 20 nm Löcher unter identischen Bedingungen, müsste man etwa 400 Elektronen, die auf die theoretische SN Grenze nahe (200 Elektronen) , die durch Moreau 32. Derzeit ist die einzige Möglichkeit, die Wirkung von SN zu unterdrücken, ist die Verwendung einer niedrigempfindlichen Photoresist, das eine höhere Elektronen / Photonen-Dosis benötigt. Es kommt auf Kosten der geringeren Durchsatz und höhere Kosten für die Nanostrukturierung. Unsere Methode reduziert den Effekt von Größenschwankungen von monodispersen Nanostrukturen unter Verwendung der Größe der lithographisch gemustert, um Löcher zu definieren, während die ursprüngliche Positionsregister beibehalten wird. Die Registrierung wird durch die starke elektrostatische feste Bindung von Nanostrukturenan der Oberfläche, durch elektrostatische funneling geführt.
Der Erfolg der Strukturierung in dieser Methode hängt von zwei Effekten. Die erste ist die Variation in der Größe der Löcher, und die zweite ist die Zentrierung der Nanopartikel innerhalb der Löcher, die die Positionsregistrierungs beeinflussen. Der Variationskoeffizient für den Durchmesser von Löchern durch diesen Ansatz (9% bzw. 19 ± 2 nm) strukturiert ist vergleichbar mit dem Koeffizienten der Größe (8%) des GNPs 20. Auf der anderen Seite, wie in Figur 1 offenbart, die E-Strahl-Muster 35 nm (35 ± 9) Löcher, die ohne diesen Ansatz verwenden, einen CV von 35% aufwies. Der entsprechende CV von E-Beam-alone Strukturierung würde noch schlimmer, wenn 20 nm Löcher hergestellt wird. Die SN kann so eingestellt werden, um den CV proportional zu sein, mit groben Schätzungen von CVs für 20 nm und 80 nm Löcher bei 61% und 15% betragen. Das hier vorgestellte Verfahren bietet mindestens eine sechsfache (~ 61% / 9%) Verbesserung der CV über E-Beam-Alone Strukturieren von 20 nm Löchern. Selbst bei 80-nm-Löcher beginnen, fast 60% ige Verbesserung der CV Ergebnisse (~ 15% / 9%) tritt nach diesem Ansatz.
Der zweite Effekt betrifft Partikelablagerung weg von der geometrischen Mitte der Löcher (Registry). Zwei Faktoren zu diesem Zweck wurden aus SEM - Daten extrahiert gesammelt nach der Abscheidung GNPs in Löchern (2b) und nach der Photoresist-Reflow (Abbildung 2c). Die statistische Analyse der Verdrängung von GNPs vom Zentrum der Nanolöcher in dem sie (Abbildung 2a) residiert ergab , dass während der Lösungsphasenabscheidung, die Verteilung von BSP über die Mitte des Lochs war Gaussian, mit einer Standardabweichung (σ Deposition) von 9 nm oder etwa die Hälfte des Durchmessers des GNPs. Das Analyseverfahren war äquivalent zu der Annahme, dass die Teilchen im Durchschnitt in der Mitte der Löcher verbleiben, obwohl sie können einzeln ra verschoben werdenndomly aufgrund während der Abscheidung auf Diffusion.
Der zweite Faktor Verschiebung beeinflusst, ist aufgrund der Bewegung der GNPs während der Photoresist-Reflow. Ergebnisse, in Abbildung 4 dargestellt, zeigen , dass die positiv geladenen AATMS SAM so stark an GNPs bindet , dass sie während des Reflow des Photolacks nicht bewege. Eine ähnliche Analyse von REM - Aufnahmen (siehe oben) nach dem Photoresist - Reflow gesammelt (Abbildung 2c) Schritt die Gesamtstandardabweichung (σ gesamt) in der Partikel Positionierung (dh Registry) nach der Abscheidung und Reflow zur Verfügung gestellt. Um den Beitrag extrahieren Reflow widerstehen, gingen wir davon aus, dass die Prozesse der Abscheidung und Photoresist-Reflow produzieren unabhängige Effekte in Partikel von der Mitte der Löcher verdrängt, so dass:

Mit Hilfe der angepassten Werte von σ; Deposition (9 ± 1 nm) und σ gesamt (11 ± 2 nm), der extrahierte Wert von σ resist Reflow wurde geschätzt 6 nm zu sein, die auf das Dreifache der Standardabweichung in den 20 nm GNPs vergleichbar ist. Eine solche geringe Standardabweichung bedeutet eine sehr vernachlässigbaren Effekt auf die Verschiebung der gebundenen Teilchen während der Photoresist-Reflow-Prozess. Dennoch scheint die σ Abscheidung direkt mit der Größe des BSP zu variieren; Somit braucht es signifikante Verbesserungen. Ein Modell präsentiert an anderer Stelle 20 schlägt vor , die Optimierung der Ladungsdichte des Photoresistfilms und SAM die Positionsregister zu verbessern. Verschiedene Methoden, einschließlich der Verwendung von elektrostatischen Vorspannung und Ladung auf GNPs, werden derzeit erforscht. Beachten Sie, wie oben diskutiert, dass eine SEM-Bildanalyse für die obige Optimierungsprozess eine einfache Methode zur Verfügung stellt.
Die kommerzielle avaiLabilität von fast monodisperse BSP Teilchen diktiert die Wahl von Gold-Nanopartikeln. Prinzipiell sind auch andere kostengünstige Nanomaterialien wie Siliciumdioxid-Nanoteilchen mit entsprechend geladenen Chelatbildners derivatisiert, sind geeignete Kandidaten. Das primäre Kriterium für die Auswahl von Nanoteilchen ist ihre Monodispersität und ihre Anfälligkeit gegenüber Ätzen. Für elektrostatische funnelling geeignete komplementäre Ladungen auf dem SAM und NP müssen vorhanden sein. Die Ladung auf NPs hängt von dessen Zeta-Potential, dessen Vorzeichen und Größe kann entweder durch den pH-Wert der Lösung oder der Ladung auf Chelatbildnern abgestimmt werden. In ähnlicher Weise können auf dem SAM für die Modifizierung von Oberflächenladung kationischen oder anionischen Endgruppen ausgewählt wird. Wenn perfektioniert, erstreckt sich das Verfahren leicht zu Muster Grabenlinien mit Nanodrähten 33-35. Der Gesamterfolg des Verfahrens hängt die Platzierung an der Optimierung und Füllung Nanostrukturen auf vorstrukturierten photoresist Folien Ausnutzung elektrostatisch, magnetisch oder Liganden-Ligation-Wechselwirkungen.
Offenlegungen
Die Autoren haben nichts zu offenbaren.
Danksagungen
Intel Corporation finanziert diese Arbeit durch Grant-Nummer 414305 und der Oregon Nano- und Mikro Initiative (ONAMI) vorgesehen entsprechende Mittel. Wir danken für die Unterstützung und Beratung von Dr. James Blackwell in allen Phasen dieser Arbeit. Besonderer Dank geht an Drew Beasau und Chelsea Benedikt für die Analyse von Partikel Positionierung Statistiken. Wir danken Professor Halle für eine sorgfältige Lektüre des Manuskripts und Dr. Kurt Langworthy, an der University of Oregon, Eugene, OR, für seine Hilfe bei E-Strahl-Lithographie.
Materialien
| Name | Company | Catalog Number | Comments |
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8%) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4% in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer (LSE Stokes model L116A) | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referenzen
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore's law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).
Nachdrucke und Genehmigungen
Genehmigung beantragen, um den Text oder die Abbildungen dieses JoVE-Artikels zu verwenden
Genehmigung beantragenWeitere Artikel entdecken
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. Alle Rechte vorbehalten