Method Article
שימוש של חלקיקים של הקורבן להסיר את ההשפעות של Shot-רעש חורים לתקשר מפוברק על ידי E-הקורה ליתוגרפיה
In This Article
Summary
באופן אחיד חלקיקים בגודל יכולים להסיר תנודות בממדי קשר חור בדוגמת פולי (methacrylate מתיל) (PMMA) סרטי photoresist על ידי קרן אלקטרונים (E-beam) ליתוגרפיה. התהליך כרוך תיעול אלקטרוסטטית חלקיקים במרכז הפקדה חורה קשר, ואחריו הזרמה מחדש photoresist ו פלזמה וצעדים רטוב-תחריט.
Abstract
ננו-תבניות מפוברקות עם אולטרה סגול קיצוני (EUV) או קרן אלקטרונים (E-beam) וריאציות בלתי צפויות תערוכה ליתוגרפיה בגודל. וריאציה זו יוחסה תנודות סטטיסטיות במספר פוטונים / אלקטרוני הגעתו א-באזור ננו נתון נובע ירה לרעש (SN). את המספר הסידורי משתנה ביחס הפוך לשורש הריבועי של מספר הפוטונים / אלקטרונים. עבור במינון קבוע, SN הוא גדול lithographies EUV ו- E-הקרן מאשר מסורתית (193 ננומטר) ליתוגרפיה אופטית. מלמטה למעלה וגישות דפוסים מלמעלה למטה משולבות כדי למזער את ההשפעות של רעש נורה דפוסי ננו-חור. באופן ספציפי, א-מרכיבה עצמית פעילה שטח אמינו-silane על פרוסות סיליקון כי הוא לאחר מכן ספין מצופה עם סרט 100 ננומטר של photoresist E-קרן PMMA מבוססת. חשיפת E-קורה ואת ההתפתחות שלאחר מכן לחשוף את הסרט פעיל שטח הבסיסי בתחתיות החורות. טובלים את פרוסות להשעיית, ציטרט הכתיר טעונים שלילית, 20 ננומטר gחלקיקים ישנים (תל"ג) פיקדונות חלקיק אחד לכל חור. הסרט הפעיל השטח הטעון החשוף באופן חיובי החור אלקטרוסטטי מתעל את ננו-החלקיקים הטעונים השלילית למרכז חור חשוף, אשר לצמיתות מתקן את הרישום מיקומית. לאחר מכן, על ידי חימום ליד מעבר זכוכית הטמפרטורה של פולימר photoresist, סרט photoresist reflows ואת בולעת החלקיקים. תהליך זה מוחק את החורים מושפעים SN אבל משאיר את GNPs שהופקד נעול במקום על ידי אלקטרוסטטית חזקה מחייבת. טיפול עם פלזמה חמצן חושף את GNPs ידי חריטה של שכבה דקה של photoresist. Wet-תחריט GNPs החשוף עם תמיסה של לי 2 / KI מניב חורים אחידים הממוקמים במרכז החריצים בדוגמת ידי ליתוגרפיה-אלומת E. הניסויים שהוצגו עולה כי הגישה מפחיתה את השוני בין גודל חורים שנגרמו על ידי SN מ -35% אל מתחת ל 10%. השיטה מרחיבה את גבולות דפוסים של חורי קשר טרנזיסטור אל מתחת ל 20 ננומטר.
Introduction
הגידול המעריכי בשלטון חישובית, כמו לכימות על ידי חוק מור 1, 2 (1), היא תוצאה של התקדמות הדרגתית ליתוגרפיה אופטית. בטכניקת דפוסים מלמעלה למטה זה, החלטת השגה, R, ניתן על ידי משפט ראלי ידוע 3:

הנה, λ ו NA הם גל אור צמצם מספרי, בהתאמה. שים לב NA = η · sinθ, שבו η הוא מקדם השבירה של התווך בין העדשה ואת פרוסות; θ = tan -1 (ד / 2L) עבור הקוטר, ד, של העדשה, ואת המרחק, l, בין מרכז העדשה ואת הפרוסות. במהלך חמישים השנים האחרונות, ההחלטה ליתוגרפיות השתפרה באמצעות (א) מקור אורs, כולל לייזרים excimer, עם אורכי גל UV קטנים יותר ויותר; (ב) עיצובים אופטיים חכמים העסקת שלב משמרת מסכות 4; ו- (ג) גבוה NA. להשגת חשיפה באוויר (η = 1), אנ-איי היא תמיד פחות אחדים, אלא על ידי החדרת נוזל עם η> 1, כגון מים 5, בין העדשה ואת פרוסות, יכול להיות מורם NA מעל 1, ובכך לשפר את הרזולוציה של ליתוגרפיה טבילה. נכון לעכשיו נתיבי קיימא צומת 20 ננומטר ומעבר כוללים מקורות UV קיצוניים (λ = 13 ננומטר) או טכניקות דפוסים באמצעות עיבוד כפול מרובע מורכב של photoresist רב שכבתי 6, 7.
בקני מידה באורך ננומטר, תנודות סטטיסטיות, הנגרמת על ידי זריקה לרעש (SN), במספר הפוטונים המגיעים בתוך וריאציה הגורם ננו באזור בממדי lithogra דפוסי phic. תופעות אלה בולטות יותר עם חשיפה לאור EUV אנרגיה גבוהה ו- E-קורות, מערכות שצריכות הזמנות של פוטונים פחות גודל / חלקיקים לעומת ליתוגרפיה 8 אופטית רגילה. רגיש במיוחד מוגבר כימי (עם יעילות קוונטית> 1) photoresists גם להציג SN כימי שגרם וריאציה במספר מולקולות photoreactive ב nanoregions החשוף 9, 10. photoresists רגישות נמוכה שצריכים חשיפות כבר לדכא את ההשפעות הללו, אבל הם גם להפחית את התפוקה.
על בקנה מידה מולקולרי, התרומה קו קצה חיספוס מהפצת גודל מולקולרי אינהרנטי פולימרים photoresist עשוי להיות מופחת על ידי שימוש מתנגד מולקולרית 11. הלך מחשבה זה, הוא משלים עיבוד מלמעלה למטה של דפוסי ננו היא השימוש בשיטות מלמטה למעלה 12,s = "Xref"> 13 המסתמכים באופן ספציפי על הרכבה עצמית מכוונת (DSA) של פולימרים diblock 14. היכולת של תהליכים אלה לכוון נוקלאציה ליצור ריווח לא אחיד בין דפוסים רצויים, כגון חורים או קווים, נותרת מאתגרת. התפלגות הגודל של רכיבים מולקולריים 15, 16 גם מגבילה את היקף תשואה של ייצור 17, 18. בעיות דומות להגביל הדפסת microcontact של חלקיקים ליתוגרפיה רך 19.
מאמר זה מציג מחקרים של גישה היברידית חדשה (איור 1), המשלבת את ליתוגרפיה ההקרנה מלמעלה למטה הקלסית עם הרכבה עצמית מכוון אלקטרוסטטי כדי לצמצם את ההשפעה של חספוס SN / קו-קצה (הימלר) 20. מטען חשמלי חיובי קבוצות האמינו על משטחים עצמיים התאסף (Sams) של N - (2-aminoethyl)-11-אמינו-undecyl-methoxy-silane (AATMS) שבבסיס הסרט PMMA נחשפים לאחר פיתוח. סרט photoresist הטעון השלילי של PMMA אלקטרוסטטי משפכי טעונת חלקיקי זהב שלילי (GNPs), כתרים עם ציטרט, 21 - 24 לחורים SN-מושפע 25. Re-זרימה של photoresist PMMA בולעת חלקיקים predeposited בסרט.
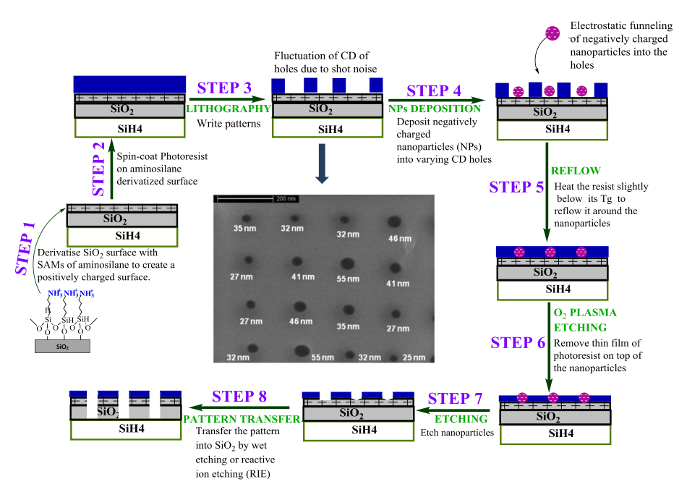
איור 1: ייצוג סכמטי של האסטרטגיה להסיר את ההשפעות של רעש ירייה וחספוס קו-קצה עבור הדפוסים של חורי קשר באמצעות צירופים של גודל מדויק. הנה, את הממד הביקורתי (CD) הוא בקוטר הרצוי של החורים. הגישה (שלב 1) מתחילה עם הפקדה בשכבה עצמית התאסף (SAM) של מולקולת silane נושאה קבוצות אמין בעלי מטען חשמלי חיובי על גלי התחמוצתאס של פרוסות סיליקון. לאחר מכן, ליתוגרפיה E-הקרן משמשת תבנית החורה (שלבי 2 ו -3) בסרטו photoresist PMMA, השכבה הכחולה, אשר מייצר רעש ירייה, כפי שמודגם תמונת שיבוץ SEM. ליתוגרפיה חושפת קבוצות אמינות בתחתית החורה. שלב 4 כרוך בתצהיר השלב המימי של גודל-נשלט, כתרים-ציטראט חלקיקי זהב (מטען שלילי) (GNPs) חורים בדוגמת lithographically באמצעות תיעול אלקטרוסטטית (EF). בשלב 5, חימום רקיק 100 ° C, מתחת לטמפרטורה מעבר הזכוכית של PMMA, 110 ° C, גורם הזרמה מחדש של photoresist סביב חלקיקים מראש שהופקד. תחריט מעולף PMMA עם פלזמת חמצן (שלב 6) חושף את GNPs, ורטוב תחריט עקב (יוד) של החלקיקים החשופים (שלב 7) יוצר חורים המתאים לגודל של GNPs. כאשר מצמידים עם תגובתי-ion / רטוב-תחריט, אפשר להעביר את דפוס חור photoresist כדי SiO 2 (שלב 8) 31. מִחָדָשׁמודפס באישור התייחסות 20. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
האינטראקציה אלקטרוסטטית בין GNPs ו"חורים וקבוצות אמינות על פני המצע מונעת התזוזה של GNPs מאתר המחייב. צעד ההזרמה מחדש שומר על המיקום היחסי של GNPs אבל מוחק את החורים ואת ההשפעות של SN / הימלר. פלזמה / צעדי תחריט רטובים להתחדש חורים שיש להם את הגודל של התל"ג. תחריט תגובתי יון מעביר הדפוס שלהם SiO 2 שכבות קשה מסכה. השיטה מסתמכת על שימוש יותר אחיד חלקיקים בגודל מאשר nanohole בדוגמת (NH), כפי שבאה לידי ביטוי בסטיית התקן, σ, כך σ התל"ג <σ NH. דוח זה מתמקד צעדים (4 ו -5 המתוארים באיור 1) מעורבים בתצהיר של חלקיקים מן הפיזור ואתהזרמה מחדש של photoresist סביבם להעריך את היתרונות והמגבלות של השיטה. שני השלבים הללו, באופן עקרוני, ניתן להרחבה עד מצעים גדולים, אין צורך שינוי נרחב של הזרימה הנוכחית של ייצור מעגלים משולבים מודרניים על שבבי.
Protocol
1. Derivatize ולאפיין את פני השטח של פרוסות סיליקון
- נקו את המשטח של פרוסות באמצעות רדיו Corporation of America SC1 פתרונות ניקוי (RCA) ו SC2.
- כן SC1 ו SC2 ידי volumetrically ערבוב הכימיקלים הבאים:
SC1: H 2 O 2: NH 4 OH: H 2 O = 1: 1: 5 V / V ו SC2: H 2 O 2: HCl: H 2 O = 1: 1: 5 V / V.- לטבול את פרוסות סיליקון ב SC1 במשך 10 דקות ב 70 מעלות צלזיוס, ולאחר מכן לבצע שטיפה במים ללא יונים.
- עקוב פרוטוקול דומה SC2 (10 דקות ב 70 מעלות צלזיוס, ואחריו לשטוף).
הערה: תהליך הניקוי מסיר זיהומים אורגניים יוניים ומייצר קבוצות silanol על משטח תחמוצת סיליקון של פרוסות סיליקון.
- Derivatize משטחים של פרוסות סיליקון עם AATMS
- דגירה פרוסות סיליקון לנקות 0.05 M AATMS (שהוכנו דטולואן ר"י) על 80 מעלות צלזיוס למשך 20 דקות. Sonicate במשך 5 דקות בתוך sonicator W 100 בטמפרטורת חדר טולואן טהור למשך 5 דקות ויבשות זרם של גז חנקן.
- לאפיין את פני השטח של פרוסות סיליקון derivatized
- מדוד את זווית המגע באמצעות תוכנת goniometer ו ImageJ 25.
- קבע את עובי של סרטים באמצעות ellipsometer (מקור אור לייזר הוא Ne-, λ = 632.8 nm, זווית שכיחות קבוע של 70 °) 25.
- להעריך את הרכב פני השטח היסודות על ידי ספקטרוסקופיה photoelectron רנטגן (XPS) 25.
E-קרן 2. דפוסים
- ספין-מעיל photoresist (2% פולי (methacrylate מתיל (PMMA) ב anisole) על פרוסות derivatized AATMS- ב 4000 סל"ד במשך 60 שניות.
- Prebake הסרט ב 180 מעלות צלזיוס למשך 120 שניות לייבוש פילם photoresist.
- מדוד את עובי הסרט photoresistבאמצעות ellipsometer. ודא שמקור אור לייזר הוא Ne-, λ = 632.8 nm, הוא קבוע בזווית שכיחות של 70 מעלות. מטב את הבמה מדגם על מנת למקסם את אות הגלאי באמצעות משטח רפלקטיבי כגון פרוסות סיליקון. השתמש בתוכנית המדידה ellipsometer (GEMP) במחשב המחובר למדוד את עובי הסרט photoresist; זה צריך להיות בערך 100 ננומטר.
- E-קרן חשיפה:
- מעבירים את רקיק בתא ואקום גבוה של aligner E-הקורה.
- צור דפוס חור נקודה פוקר באמצעות קרן אלקטרונים (30 kV מתח מאיץ, 37 הנוכחי קרן PA) עובר דרך פתח של 10 מיקרומטר ומתן במינון 24 μC / ס"מ 3.
- התאם את התבנית המגרש ואת המינון לפי הצורך לייצר פוקר נקודה מסוג חור-דפוס של חור בקוטר הרצוי (80 ננומטר) ועל המגרש (200 ננומטר).
- הסר את רקיק מהאולם E-הקורה.
- לפתח את דפוס ליטוגרפי:
- התחלפיתוח דפוס בתמיסה של קטון isobutyl מתיל / אלכוהול איזופרופיל (MIBK / IPA, 1: 3 (v: v)) במשך 70 שניות.
- להמשיך ולפתח עוד יותר על ידי טבילת IPA למשך 30 שניות. להשלמת הפיתוח על ידי שטיפה במים deionized למשך 30 שניות. לייבש את פרוסות סיליקון בזרם של גז חנקן.
הפקדת 3. GNPs לתוך חורים בדוגמת E-קרן
הערה: הפקדה של GNPs בחורים בדוגמת מעסיקה שתי שיטות שונות.
- לטבול ופלים טרום בדוגמת בפתרונות התל"ג (שיטה 1).
- השאר המדגם במדיום השעית התל"ג במשך 24-48 שעות, תלוי בגודל של התל"ג ואת בקטרים של החורים. השתמש השעיה של 20 ננומטר, ציטרט הכתיר תל"ג המכילה 7.0 x 10 11 צירופים / מיליליטר.
הערה: אפשר להעסיק גודל תל"ג מ 10-100 ננומטר ומגוון ריכוז מ -5.7 x 10 12 - 5.7 x 10 9 צירופים / מיליליטר, כפי שנמסר על ידי טד פלה. ראוי לציין, כי הצפיפות בתצהיר מצייתתהחוק דיפוזיה ̴ (DT) 1/2, כאשר D ו- T הם מקדמי דיפוזיה של זמן nanoparticle בתצהיר, בהתאמה (כלומר, חלקיקים קטנים להימשך זמן קצר לצורך מתן עדות, כפי שפורט התייחסות 20, איור 2 ג).
- השאר המדגם במדיום השעית התל"ג במשך 24-48 שעות, תלוי בגודל של התל"ג ואת בקטרים של החורים. השתמש השעיה של 20 ננומטר, ציטרט הכתיר תל"ג המכילה 7.0 x 10 11 צירופים / מיליליטר.
- GNPs ריסוס-הפקדה על ופלים בדוגמת (שיטה 2)
- להפקיד GNPs ידי אידוי, לרסס פתרון של GNPs על גבי המצע בדוגמת, בצורה אופקית. אוריינט המרסס הידני (השיטה 2), כך ספריי מופנים בניצב למשטח המצע.
- תרסיס נפח מספיק של פתרון ההשעיה להרטיב את פני מצע כולו.
הערה: ייתכן שיהיה צורך לדלל את ההשעיה התל"ג ידי 10x להימנע מכריח חלקיקים מרובים לתוך חור גדול. - דגירת דגימות על פלטה חשמלית נשמרה C 30-35 מעלות לייצר אידוי מבוקר למשך 10 דקות.
- לאחר בתצהיר (או על ידי שיטה1 או שיטה 2), במתינות ultrasonicate (100 W) דגימות מים ללא יונים עבור 50 s ויבש זרם של גז חנקן.
4. הדמיה במיקרוסקופ אלקטרונים סורק
הערה: ישנם שני סוגים של המחקרים כללו מלמעלה למטה קונבנציונאלי חתך הדמיה SEM.
- לקבלת תמונות SEM מלמעלה למטה, להשתמש E-קרן מאיץ מתח של 5 קילו וולט בזרם של ~ 300 מיקרו-אמפר כדי למנוע נזק הסרט photoresist.
זהירות: מתח האפשר הגדרה נוכחית הנמוך ביותר הנדרשת להפחתת תגובות scission שרשרת photoresist. תגובות scission שרשרת אלה מפחיתות את טמפרטורת מעבר זכוכית של הפולימר, אשר בתורו משפיע על הטמפרטורה המבצעית עבור שלב ההזרמה מחדש להתנגד כמתואר להלן. - הדמית חתך:
- גמגום מעיל 10 ננומטר של הסרט זהב עבה על photoresist PMMA כדי למנוע נזק הקורה-יון. השתמש אלומת יונים ממוקדת Ga פעלו 30 ק ו -93הרשות לחתוך דרך החורים. להשיג תמונות SEM חתך ידי הטיית אפיפית במצב אופקי הרגיל שלו.
5. הזרמה מחדש של photoresist PMMA סביב GNPs בתוך החורים Patterned
- מחממים את המצעים בדוגמת על צלחת חמה ב הזרמה מחדש T (100 מעלות צלזיוס) במשך 3 דקות, שהוא מתחת לטמפרטורת מעבר זכוכית שנקבעה מראש, גרם T (110 מעלות צלזיוס), של 950,000 g / mol PMMA; שיעור הזרמה מחדש עבור הפולימר היה 1.7 ± 0.1 nm / s.
זהירות: הזרמה מחדש מהר יותר באופן משמעותי התרחש על האזורים בדוגמת שנחשפו בעבר הדמיה E-הקורה במהלך עם מיקרוסקופ אלקטרונים סורק (SEM), אולי בגלל המחשוף של שרשרת עמוד השדרה פולימריים במהלך החשיפה אלומת אלקטרונים, שמוביל הפחתה של g T. תצפית זו נתמכת על ידי המחקרים מן Keymeulen ועמיתים לעבודה, אשר ציינו כי חשיפה לקרינת רנטגן הפחיתה את Tגרם של PMMA 26.
6. תחריטים-לחרוט רטוב
- יבש-לחרוט על זמן מספק (55 שניות) עם פלזמה חמצן לחשוף GNPs מכוסה שכבה דקה של PMMA לאחר הזרמה מחדש. בזהירות לפקח על שיעור של תחריט הסרט PMMA כפונקציה של הזמן באמצעות ellipsometer או צג עובי סרט דק.
הערה: משך תחריט קצר מדי לא יכול לחשוף את GNPs, תוך תחריט במשך זמן רב מדי היה להסיר לחלוטין את סרט PMMA. עבור 950 kDa PMMA, שיעור לחרוט היה של 1.5 ננומטר /, דבר המחייב 55 של זמן תחריט. - GNPs Wet-לחרוט בתחתית החורים קשר לאחר הזרמה מחדש באמצעות פתרון של יוד, המכיל 1.0 גרם של קריסטל יוד (I 2), 4.0 גרם של אשלגן יודיד (KI), ו -40 מ"ל מים ללא יונים, במשך 10 דקות.
הערה: אשלגן יודיד משפר את המסיסות של יוד בתמיסה ומקל תחריט זהב. התגובה של זהב עם יוד (2Au + I 2 → 2 AUI) מייצרת זהביודיד, אשר מסיסה מעט בתמיסה מימית בטמפרטורת החדר.
7. חישוב חלקיקי תזוזה, הצפיפות, שברים מלאים
- איתור במרכז החור ועקירת תל"ג:
- ביד, לצייר אופקיים ואנכיים ביותר בכושר בקווים ישרים דרך שורות ועמודות של חורים, בהתאמה, למרכזי חור הוקמה בצמתים שורות אלה (איור 2 א ו -2 ב). לכלול לפחות 500 + חורים בחישובים.
- ידני לקבוע את המיקום, r, של כל היחסי nanoparticle למרכז של nanohole (כלומר, תזוזה) שבו הופקד (איור 2b).
- לדעת את כמות החלקיקים לעומת היסטוגרמות תזוזה באמצעות תוכנית גיליון אלקטרוני רגיל.
- חישוב צפיפות החלקיקים: ρ = N (מספר החלקיקים) / Area היחידה (מיקרומטר 2):
- ראשית, לקבוע את האזור הטבעתי של טבעת עם רוחב קבוע (≈R / 10, כאשר R הוא הרדיוס של החור) ומוגבל על ידי שני רדיוסים (r 1, r 2) בכל תזוזה של r (= (r 1 + r 2) / 2);
 .
. - לסכם את מספר החלקיקים, N, באזור מן היסטוגרמה נבנתה בשלב 7.2 לעיל.
- חזור על התהליך כפונקציה של r לייצר כ -10 צעדים שווים סיום ב r = R, רדיוס החור.
- ראשית, לקבוע את האזור הטבעתי של טבעת עם רוחב קבוע (≈R / 10, כאשר R הוא הרדיוס של החור) ומוגבל על ידי שני רדיוסים (r 1, r 2) בכל תזוזה של r (= (r 1 + r 2) / 2);
- התאם את צפיפות החלקיקים מול נתוני העקירה עקומה גאוס באמצעות 20 קוי לפחות ריבועי הליך (איור 2 א, הבלעה). חלץ את סטיית ההתקן של (בתצהיר σ) עקירה להפקדה וחוסר הוודאות ההולמת שלה.
- חזור על האמור לעילנוהל דפוסי SEM שהושג לאחר הזרמה מחדש photoresist באמצעות תמונה SEM שמוצג איור 2 ג.
הערה: לאחר חורי ההזרמה מחדש להיעלם, לצייר ביותר בכושר קווים אופקיים ואנכיים על עמדות תל"ג כדי לקבוע את הערכים-ההתאמה הטובה ביותר עבור מרכזי החור. חשב את התקות חלקיק כמו בשלב 7.1 ולחלץ את הסיכום המשולב σ בעקבות פרוטוקול המותווה צעדים 7.2-7.4.
הערה: כאן, משולב או הכוללים מתייחס התזוזה הכוללת של תל"ג בשל בתצהיר וצעדי הזרמה מחדש. - לקבוע את החלק היחסי המילוי על ידי אומדן היחס בין מספר חורים מלאים עד המספר הכולל של חורים, איור 2b.
תוצאות
תרשים 2 מציג תמונה SEM של GNPs 20 ננומטר שהופקדו חורים בקוטר 80 ננומטר בדוגמת סרט PMMA 60-100 ננומטר בעובי מונע על ידי תיעול אלקטרוסטטי. כפי שנצפה על ידי אחרים 22, התהליך הביא על אחד חלקיקים לכל חור. התפלגות חלקיקים סביב מרכז החורים היה גאוס (מימין למעלה הבלעה). רוב חורים (93%) הכיל תל"ג אחד, ו -95% של חלקיקים אלה התרחשו בתוך 20 ננומטר של המרכז. אופטימיזציה נוספת, נדון במקום אחר, יש צורך לשפר את-השבר המילוי ואת המרכוז של GNPs 20, 25. 2b ו איור 2 ג מראה תמונות SEM של GNPs שהופקדו מאזורים גדולים של פרוסות סיליקון, לפני ואחרי הזרמה מחדש של photoresist. בפרק הדיון מציג ניתוח כמותית נוספת.

איור 2: (א) 20 ננומטר GNPs בקוטר שהופקדו 80 חורים ננומטר בקוטר מופרדים על ידי המגרש, P, של 200 ננומטר (השמאלית העליונה הבלעה). 93% של החורים מכילים ננו-חלקיקים אחד, ו -95% של החלקיקים נמצאים במרחק 18 ננומטר מהמרכז (העיגול הכחול). ההבלעה הימנית העליונה מציגה הפצה גאוס של עקירת החלקיקים מהמרכז, עם σ = 9.0 ± 0.1 ננומטר. (ב) תמונת SEM של שטח גדול לאחר בתצהיר, σ = 9 ± 1 ננומטר. (ג) זהה ב) לאחר הזרמה מחדש של photoresist, σ = 11 ± 2 ננומטר. השתנה באישור התייחסות 20. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
בתצהיר באידוי יכול להפחית24-48 המימן הנדרש להפקדה 25. כאשר תפוצות של חלקיקים הורשו להתאדות על פני השטח בדוגמת, GNPs שהופקד על סרט PMMA, כמו גם חורים. ultrasonication הקלה בתמיסה שנאגרה הוסרה כבול GNPs חלושה על PMMA, עוזבת חלקיקים לגבולו בתוקף רק החורים. איור 3 מדגים כיצד מספר חלקיקים יכולים להיות שהיא תיאלץ לתוך חורים בשיטה זו בגלל הדחייה בין החלקיקים המופחתים בפיזור היוני המרוכז בהדרגה. כאלה תופעות הקרנה יוניות יש להימנע, שכן הם מותר תפוסת multiparticle והורידו יעילות של התיעול אלקטרוסטטית שמנתב את החלקיקים למרכז החור. הוריד ריכוז GNPs בפיזור ההפקדה, יחד עם ultrasonication, היה פוטנציאל לאפשר להפקדה של חלקיק אחד לכל חור במהירות רבה יותר מאשר בתצהיר פתרון פאזיים בתפזורת. בעבודה זו, אנו לא לייעל אתתנאים דרושים.

איור 3: הפקדה של GNPs במהלך אידוי שנמשך יותר מ -20 דקות. Micrographs SEM התחתון להראות מלמעלה למטה ואת חתך נוף של חורים בדוגמת ידי E-קורה. השתנה באישור התייחסות 25. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
חתך פרופיל SEM מוצג צדדי החור מוטה כלפי במרכזן. הזווית של הדפנות הייתה פחות מאשר 90 אופטימלית °, יצירת חתך באזור גובר הבאר על מתקרב ממשק רקיק photoresist. תצורה זו מסבירה את דפוס אריזה הנצפה (משמאל) של PartiCles, מציין ועקירתם ממרכז החור. עדיף להתמקד של קורה E, מתחת הממשק בין אוויר וסרט photoresist, יחסל חפץ כזה.
סרטים דקים, מוצקים של photoresist PMMA 27 - 30 לנזל וזרימה ליד מעבר הזכוכית, g T, של 110 ºC. טמפרטורה 10 ° מתחת g T של הפולימר photoresist, PMMA, יזם הזרמה מחדש איטי של photoresist. בשנות ה התרככו, כמו-נוזלי, המדינה מזוגגות, מתח הפנים של הסרט photoresist הפחית את עקמומיות קצה וחספוס, וכתוצאה מכך דיכוי תופעות הימלר. החזית photoresist נוזלי לקידום נבלע לחלוטין nanoholes, יחד עם GNPs שהופקדו, כפי שמודגם באיור 4, שבה מספר GNPs לכל חור היה גבוה. שימו לב איך ההזרמה מחדש photoresist מגבולות החור נמחקה הדפוס דואר של nanoholes בסרט. אף על פי כן, מחויב בתוקף GNPs נעול לתוך הרישום מיקומית של הדפוס. למרבה הפלא, מחקרים photoresist-הזרמה מחדש אלה חשף אלקטרוסטטי חזק המחייב של GNPs הכתיר ציטראט כדי אמינים הסתיים silanes. הדמיון של דפוס בתצהיר של GNPs לפני ואחרי הזרמה מחדש נתמך למסקנה זו; לראות איור 4C (אינפרא vide).
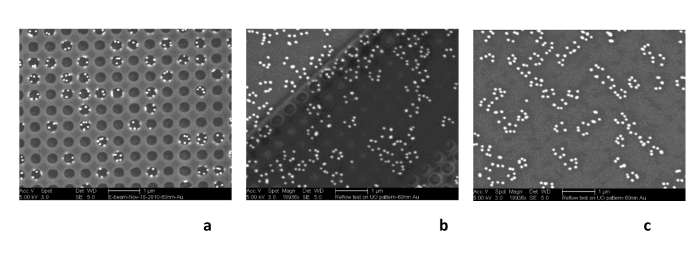
איור 4: העמדות של GNPs שהופקד הם רגישים יחסית אל ההזרמה מחדש של photoresist (ראה טקסט). דפוסים של GNPs 60 ננומטר שהופקד חורי 250 ננומטר: (א) לפני ההזרמה מחדש, (ב) לאחר הזרמה מחדש חלקית, ו- (ג) לאחר הזרמה מחדש מלאה. אנא לחץ כאן כדי להציג גרסה גדולה יותר של Figur זהדואר.
הרצף הכולל של צעדים והשינויים המתרחשים תמונות SEM המקבילות מוצג באיור 5. בשנת 5b איור, החורים בסרט התכווצו במהלך ההזרמה מחדש photoresist, בעוד התהליך האופף הושלם בתוך פחות מ -3 דקות (5c איור). פלזמת חמצן וחרט הסרט העבה של photoresist כי מעולף על גבי GNPs, חשיפה אותם לאוויר. לאחר שנחשפו, GNPs אלה היו רטובים חרוט באמצעות פתרון תחריט זהב מבוסס על KI / לי 2 (איור 5D). מקדם שונה עבור בקטרים היו 9% עבור החור נוצר על ידי התהליך בסיוע תל"ג. שים לב במחקרים אלה, הקוטר ההתחלתי של החורים התכווץ מ 80 כדי 20 ננומטר, אשר ממחיש את כוחה של הגישה. המגבלה העיקרית של השיטה היא כניסתה של חוסר ודאות בעמדת מרכז חור מחדש עקב שילוב של חוסר ודאות Intr oduced במהלך בתצהיר התל"ג ואת הזרמה מחדש להתנגד. עבודה שוטפת נוכחית מנסה מתייחסת להשפעות אלה. מלבד זהב, חלקיקים אחרים של חומרים שונים, כגון סיליקה (etchable ב HF לדלל), שניתן להשתמש בהם כדי להפחית חומרים ועלויות העיבוד. הדרישה העיקרית היא כי ננו-חלקיקים / ננו-מבנה חייב להיות etchable סלקטיבי מבלי להשפיע על החומר להתנגד.

איור 5: SEM. תמונות שנאספו במהלך השלבים מועסקים שמטרתן לצמצם את השוני בגדלי חור. (א) הפקדה (24 שעות). (B ו- C) הזרמה מחדש של photoresist (20 שניות, 3 דקות). (ד) תחריט PMMA (O 2 פלזמה: 55 ים) ו התל"ג (רטוב-לחרוט עם לי פתרון 2 / KI: 10 דק ')."> לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
Discussion
Shot-רעש (SN) ליתוגרפיה הוא תוצאה פשוטה של תנודות סטטיסטיות במספר הפוטונים או חלקיקים (N) המגיעים בתוך ננו-אזור נתון; זה עומד ביחס הפוך לשורש הריבועי של מספר הפוטונים / חלקיקים:

כאשר A ו- R באזור ואת גודל האזור החשוף, בהתאמה. לדוגמה, כאשר באמצעות לייזר excimer ARF 193 ננומטר (6.4-eV) לחורים 50 ננומטר דפוס, מספר הפוטונים קיבלו הוא כ 1 x 10 6 במינון החשיפה של 52 mJ / 2 ס"מ. לקבלת מקור E-קרן 50 keV, מספר האלקטרונים ומספקים 50 mJ / 2 סנטימטר יהיה כ -128, רומז כי השפעת SN תהיה 100 פעמים יותר עבור ליטוגרפיה E-הקורה. יתר על כן, מספר הפוטונים / אלקטרונים המגיעים באזור נתון מקטין ישירות עם השטח של התבנית. כתוצאה מכך, אלתנודות arge בגודל של חורים כי קבלו תוצאות חשיפה "זהות" מתרחשות כמאפיין של החור להיות מעוצבים ירידות. במשך 35 החורים ננומטר שמוצג באיור 1 עם E-קרן 30 keV, על 1,440 אלקטרונים לספק את המינון הנדרש של 24 μc / 2 ס"מ. כדי דפוס 20 חורי ננומטר בתנאים זהים, אחד יזדקק לכ -400 אלקטרונים, אשר הם קרוב לגבול SN התיאורטי (200 אלקטרונים) ניתן על ידי מורו 32. נכון לעכשיו, הדרך היחידה להעלים את השפעת SN היא באמצעות השימוש של photoresist נמוכה רגישות שצריכה מנת אלקטרון / פוטון גבוהה. זה בא במחיר של תפוקה נמוכה יותר ועלויות גבוהות יותר עבור דפוסי ננו. השיטה שלנו מפחיתה את ההשפעה של תנודות גודל באמצעות ננו monodisperse להגדיר מחדש את גודל החורים בדוגמת lithographically תוך שמירה על הרישום מיקומית המקורי. הרישום הוא קבוע על ידי אלקטרוסטטית החזקה מחייב של ננואל פני השטח, מונחה על ידי תיעול אלקטרוסטטי.
ההצלחה של הדפוסים בשיטה זו תלויה בשני אפקטים. הראשון הוא וריאציה בגדלים של חורים, ואת השני הוא המרכוז של חלקיקים בתוך החורים המשפיעים על הרישום מיקומית. מקדם שונה עבור הקוטר של חורים בדוגמת באמצעות גישה זו (9%, או 19 ± 2 ננומטר) ניתן להשוות את המקדם של הגודל (8%) של GNPs 20. מצד השני, כפי שהיא מתגלה באיור 1, E-הקרן בדוגמת 35 ננומטר (35 ± 9) חורים, נעשה ללא שימוש בגישה זו, היו קורות חיים של 35%. קורות החיים המקבילים של דפוסי E-קרן-לבד יהפכו אפילו יותר גרועים כאשר בודים 20 חורים ננומטר. את המספר הסידורי יכול להיות מוגדר להיות פרופורציונלי CV, עם הערכות גסות של קו"ח עבור 20 ננומטר ו -80 ננומטר חורים ב 61% ו -15%, בהתאמה. השיטה המוצגת כאן מספקת לפחות שיפור פי שישה (~ 61% / 9%) ב CV מעל הקורה אלקטרוני-אלוןדפוסי דואר של 20 חורי ננומטר. אפילו מתחיל עם חורי 80 ננומטר, כמעט 60% שיפור בתוצאות CV (~ 15% / 9%) מתרחש לאחר גישה זו.
בתצהיר חלקיקי חששות השפעה השני מהמרכז הגיאומטרי של החורים (רישום). שני גורמי תורמי האפקט הזה חולצו מנתוני SEM שנאספו לאחר בתצהיר של GNPs בחורים (איור 2b) ואחרי photoresist-הזרמה מחדש (איור 2 ג). הניתוח הסטטיסטי של העקירה של GNPs מהמרכז של nanoholes שבו התגורר (איור 2 א) עולה כי במהלך בתצהיר הפתרון פאזיים, חלוקת GNPs סביב מרכז החור הייתה גאוס, עם סטיית תקן (σ הפקדה) של 9 ננומטר, או בערך מחצית הקוטר של GNPs. הליך הניתוח שקולה בעצם להנחה כי החלקיקים, בממוצע, להישאר במרכז חורה, אם כי בנפרד הם עשויים להיות עקורים randomly עקב דיפוזיה במהלך בתצהיר.
הגורם השני המשפיע עקירה בשל התנועה של GNPs במהלך ההזרמה מחדש photoresist. תוצאות, המוצג באיור 4, עולה כי בעלי מטען חשמלי חיובי AATMS SAM נקשר כל כך חזק כדי GNPs כי הם לא זזים במהלך הזרמה מחדש של photoresist. ניתוח דומה של תמונות SEM (vide לעיל) שנאספו לאחר הזרמה מחדש photoresist (איור 2 ג) שלב סיפק את סטיית התקן הכולל (σ סה"כ) במיצוב החלקיקים (כלומר, הרישום) לאחר בתצהיר הזרמה מחדש. כדי לחלץ את התרומה להתנגד הזרמה מחדש, הנחנו כי התהליכים בתצהיר-הזרמה מחדש photoresist לייצר אפקטים עצמאיים לעקירתם חלקיקים מהמרכז החורה, כך ש:

באמצעות הערכים המצוידים של σ; בתצהיר (9 ± 1 ננומטר) σ סה"כ (11 ± 2 ננומטר), הערך חילוץ של σ להתנגד-הזרמה מחדש נאמד 6 ננומטר, אשר ניתן להשוות בשילוש סטיית התקן ב -20 GNPs ננומטר. כזה סטייה תקן נמוכה מרמזת השפעה מאוד זניחה על העקירה של חלקיקים כבולים במהלך תהליך reflow photoresist. אף על פי כן, ההורדה מהצלב σ נראה להשתנות ישירות עם גודל של התל"ג; וכך, הוא צריך שיפורים משמעותיים. מודל המוצג בשום מקום אחר 20 מצביע על אופטימיזציה של צפיפות המטען של סרט photoresist ו SAM כדי לשפר את הרישום מיקומית. מספר שיטות, כולל שימוש הטיה מטען אלקטרוסטטי על GNPs, הן נבדקות כיום. שים לב, כפי שפורט לעיל, כי מניתוח תמונת SEM מספק שיטה פשוטה עבור התהליך הנ"ל של אופטימיזציה.
Avai המסחרילביליון של חלקיקי תל"ג monodisperse כמעט הכתיבו את הבחירה של חלקיקי זהב. באופן עקרוני, ננו זול אחר, כגון חלקיקי סיליקה derivatized עם chelant טעונה כראוי, הם גם מועמדים מתאימים. הקריטריון העיקרי לבחירת חלקיקים הוא monodispersity שלהם הרגישות שלהם תחריט. מבחינת התקדמות אלקטרוסטטית, חיובי משלימים מתאימים על SAM ו- NP חייבים להיות נוכחים. המטען על צירופים תלוי פוטנציאל זטה שלה, אשר סימן ואת העוצמה יכול להיות מכוון או דרך ה- pH של התמיסה או תשלום על chelants. בדומה לכך, בחירת קבוצות סוף המסוף קטיוני או anionic מאפשרת שינוי תשלום משטח על SAM. אם שלמות, השיטה מרחיבה בקלות לקווים יעלו דפוס עם nanowires 33 - 35. ההצלחה הכוללת של השיטה תהיה תלויה אופטימיזציה של המיקום ומילוי ננו על photore טרום בדוגמתסרטים לחיינו, ניצול אלקטרוסטטית, מגנטית, או אינטראקציות קשירה ליגנד.
Disclosures
החוקרים אין לי מה לחשוף.
Acknowledgements
אינטל מימנה את העבודה הזאת דרך מספר מענק 414,305, ויוזמת ננוטכנולוגיה מיקרוטכנולוגיה אורגון (אונמי) העמידה משאבים תואמים. אנו בתודה להכיר תמיכה וייעוץ של ד"ר ג'יימס בלקוול בכל שלבי העבודה הזאת. תודה מיוחדת הדרים Beasau וצ'לסי בנדיקטוס לניתוח נתונים סטטיסטיים מיצוב חלקיקים. אנו מודים פרופ 'הול עבור קריאה זהירה של כתב היד וד"ר קורט Langworthy, באוניברסיטת אורגון, יוג'ין, OR, על עזרתו עם ליתוגרפיה E-הקורה.
Materials
| Name | Company | Catalog Number | Comments |
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8%) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4% in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer (LSE Stokes model L116A) | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114(1965).
- Moore, G. E. Lithography and the future of Moore's law. SPIE Proc.: Advances in Resist Technology and Processing XII. Allen, R. D. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. Complementary Lithography - Stochastics Suppression and EUV, Electronics, Proc. Semicon. West, June 12, San Franscisco, , (2012).
- Reiser, A. Photoreactive Polymers: the Science and Technology of Resists. , John Wiley & Sons. (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. Nanotechnology (IEEE-NANO), 2011 11th IEEE Conference, , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. Henderson, C. L. 7273, 72732N(2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501(2013).
- Tsai, H. Y., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. Zhang, Y., Oehrlein, G. S., Lin, Q. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. Tong, W. . 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. Nanotechnology (IEEE-NANO), 2011 11th IEEE Conference, , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528(2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502(2009).
- Montgomery, P. K., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. Fedynyshyn, T. H. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304(2013).
- Moreau, W. M. Semiconductor Lithography: Principles, Practices, and Materials. , Springer Science & Business Media. 419(2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. (IEEE-NANO), 2011 11th IEEE Conference on Nanotechnology, , (2011).
- Tran, H. A., Rananavare, S. B. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . Morris, J. E., Iniewski, K. , CRC Press. (2013).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved