Method Article
シリコン上に半円筒空隙を有するゲルマニウムエピタキシャル層の転位低減に関する理論計算と実験的検証
要約
シリコン上に半円筒空隙を有するゲルマニウムエピタキシャル層におけるねじ切り転位(TD)密度の低減について、理論計算と実験的検証が提案されています。像力によるTDと表面の相互作用に基づく計算、TD測定、TDの透過型電子顕微鏡観察を示します。
要約
シリコン(Si)上のエピタキシャルゲルマニウム(Ge)のねじ切り転位密度(TDD)の低減は、モノリシックに統合されたフォトニクス回路の実現にとって最も重要な課題の1つです。本稿では,TDD低減のための新規モデルの理論計算方法と実験的検証の手法について述べる.理論計算方法は、転位像力の観点から、選択的エピタキシャル成長(SEG)のTDと非平面成長面の相互作用に基づくねじ切り転位(TD)の曲げを記述します。計算は、SiO2 マスク上のボイドの存在がTDDの減少に役立つことを明らかにしています。実験的検証は、超高真空化学気相成長法を用いたゲルマニウム(Ge)SEGによる、エッチングおよび断面透過型電子顕微鏡(TEM)による成長したGeのTD観察によって記述される。TDDの減少は、SiO2 SEGマスク上の半円筒空隙の存在と成長温度によるものであることが強く示唆されています。実験的検証のために、半円筒形のボイドを有するエピタキシャルGe層が、Ge層のSEGおよびそれらの合体の結果として形成される。実験的に得られたTDDは、理論モデルに基づいて計算されたTDDを再現します。断面TEM観察により、TDの終端と生成の両方が半円筒形の空隙で発生することが明らかになりました。平面図TEM観察により、半円筒形のボイドを持つGe中のTDのユニークな挙動が明らかになりました(つまり、TDはSEGマスクとSi基板に平行になるように曲がっています)。
概要
Si上のエピタキシャルGeは、光通信範囲(1.3〜1.6μm)の光を検出/放出でき、Si CMOS(相補型金属酸化膜半導体)処理技術に適合するため、アクティブフォトニックデバイスプラットフォームとして大きな関心を集めています。しかし、GeとSiの格子不整合は4.2%と大きいため、Si上のGeエピタキシャル層では~109/cm2の密度でねじ切り転位(TD)が形成されます。Geフォトニックデバイスは、TDがGe光検出器(PD)や変調器(MOD)のキャリア生成センターとして、レーザーダイオード(LD)のキャリア再結合センターとして機能するため、TDによって性能が低下します。次に、PDおよびMOD1,2,3の逆リーク電流(Jリーク)とLD4,5,6のスレッショルド電流(Jth)を増加させます。
Si上のGeのTD密度(TDD)を低下させるための様々な試みが報告されている(補足図1)。熱アニーリングはTDの動きを刺激し、TDDを典型的には2 x 107 / cm2に減少させます。欠点は、SiとGeの混合と、リン7,8,9などのGe中のドーパントのアウトディフュージョンの可能性です(補足図1a)。SiGe傾斜バッファ層10,11,12は、臨界厚さを増加させ、TDDの生成を抑制し、TDDを典型的には2 x 106/cm2に減少させる。ここでの欠点は、バッファが厚いため、Geデバイスとその下のSi導波路との間の光結合効率が低下することです(補足図1b)。アスペクト比トラップ(ART)13,14,15は選択的エピタキシャル成長(SEG)法であり、厚いSiO 2トレンチの側壁にTDをトラップすることにより、TDを通常<1 x 10 6 / cm2に低減します。ART法では、厚いSiO 2マスクを使用して、Siのはるか上に位置し、同じ欠点を持つSiO2マスクよりもGeのTDDを低減します(補足図1b、1c)。Siピラーシード上のGe成長とアニーリング16,17,18はART法と同様であり、高アスペクト比Ge成長によるTDトラップを可能にし、<1 x 105 / cm2になります。しかしながら、Ge合一のための高温アニールは、補足図1a〜c(補足図1d)において同じ欠点を有する。
上記の方法の欠点のないSi上で低TDDのGeエピタキシャル成長を達成するために、これまでにSEGGe成長7,15,21,22,23で報告された次の2つの重要な観察結果に基づいて、合体誘起TDD低減19,20を提案しました。:1)TDは成長面に垂直になるように曲げられ(断面透過型電子顕微鏡(TEM)によって観察され)、2)SEG Ge層の合体により、SiO2マスク上に半円筒形の空隙が形成されます。
TDは成長面からのイメージ力によって曲がっていると仮定しました。Si上のGeの場合、イメージ力は、自由表面から1nm離れた距離でのねじ転位とエッジ転位に対してそれぞれ1.38GPaと1.86GPaのせん断応力を生成します19。計算されたせん断応力は、Ge24の60°転位について報告された0.5GPaのパイエルス応力よりも大幅に大きい。この計算は、定量的にGe SEG層のTDD減少を予測し、SEG Geの成長19とよく一致しています。TDのTEM観測は、Si20上で提示されたSEG Ge成長におけるTD挙動を理解するために行われる。画像力誘起TDD低減は、熱アニーリングや厚いバッファ層がないため、フォトニックデバイスアプリケーションに適しています。
本稿では、TDD低減法の提案に採用されている理論計算と実験的検証の具体的手法について述べる。
プロトコル
1. 理論計算手順
- TDの軌道を計算します。計算では、SEGマスクがTDD低減に対するART効果を無視するのに十分なほど薄いと仮定します。
- 成長面を決定し、方程式で表します。たとえば、補足ビデオ1aおよび式(1)に示すように、SEG Ge層の丸い断面の時間発展を、時間発展パラメータn = i、SEG Geの高さ(hi)、およびSEG Ge半径(ri)で表します。

- 成長サーフェス上の任意の位置の法線方向を決定します。丸型断面SEG Geについては、補足動画1bに赤線で示す(xi,yi)
 の法線を次のように記述する。次に、次の連立方程式を解いて、点(xi、y i)からTDのエッジ(x i + 1、y i + 1)を取得します。
の法線を次のように記述する。次に、次の連立方程式を解いて、点(xi、y i)からTDのエッジ(x i + 1、y i + 1)を取得します。 
- 補足ビデオ 1c に示すように、TD 生成の場所 (x 0, 0) に応じて 1 TD の軌道を計算します。つまり、任意のTDの軌跡は、上述の方法により算出することができる。
- TDが底面に浸透し、TDDの減少に寄与すると仮定してTDDを計算します(つまり、SEG Ge層が合体するポイントより下のTDは半円筒形のボイドに閉じ込められ、上面に現れません)。
- 成長面を決定し、方程式で表します。たとえば、補足ビデオ1aおよび式(1)に示すように、SEG Ge層の丸い断面の時間発展を、時間発展パラメータn = i、SEG Geの高さ(hi)、およびSEG Ge半径(ri)で表します。
2. 実験検証手順
- SEGマスクの準備
- SEGマスクを作製する前に、設計ファイルを準備してGe成長領域を定義します。本研究では、市販のソフトウェア(AutoCADなど)を用いて、[110]方向と幅4mmの正方形状のSi窓領域に整列したラインアンドスペースパターンを準備します。
- ソフトウェアを使用してSEGマスク(特にWウィンドウとWマスク)の設計を決定します。Wウィンドウはウィンドウ幅(Siシード幅)、WマスクはSiO2マスク幅であり、SEG Ge層が隣接する層と合体できるようにします。WウィンドウとWマスクを決定するには、[ファイル→構造を開く]をクリックして長方形を描画し→長方形またはポリラインをクリックします。
注:長方形の幅はWウィンドウになり、長方形の間隔はWマスクになります。本研究では、Wウィンドウ とWマスク の最小値はそれぞれ0.5 μmと0.3 μmであり、採用しているEBリソグラフィシステムの分解能によって制限されています。 - 参考として、ブランケット領域とみなす幅D4mmの正方形のSi窓領域を描く。[ ファイル→構造を四角形またはポリライン→開く ]をクリックして、正方形のSiウィンドウを描画します。図1に示す回路 図 を使用して、ラインアンドスペースパターンと4mm四方のブランケット領域を準備します。
- 抵抗率が1〜100 Ω・cmのBドープp-Si(001)基板を準備します。本研究では、4インチのSi基板を使用します。必要に応じて、ピラニア溶液(20mLの30%H 2 O 2と80 mLの96%H 2SO4の混合物)で基板表面を洗浄します。
- 管状炉の蓋を開け、ガラス棒を使用してSi基板を炉に装填します。本研究では、一度に10枚のSi基板を酸化します。
- ガスバルブを開いて乾燥N2 ガスを炉内に吹き込み始める。次に、バルブを制御してガス流量を0.5 L / mに設定します。
- プログラムを変更して焼鈍温度を設定します。本作業では、「パターン工程(モード2)」を使用し、工程温度を900°Cに設定する。 次に、関数を押してプログラムを実行し →実行します。
- 温度が900°Cに達したら、ドライN 2バルブを閉じ、ドライO 2バルブ(O 2フロー= 1 L / m)を開き、2時間保持します。
注意: 黄色の部屋で手順2.1.9〜2.1.16を実行します。 - 酸化したSi基板をスピンコーターを用いて界面活性剤(OAP)でコーティングし、ホットプレート上で110°Cで90秒間ベークします。
- 界面活性剤塗布後、スピンコーターを用いてSi基板をフォトレジスト(ZEP520Aなど)で塗布し、ホットプレート上で180°Cで5分間ベークします。
- 界面活性剤とフォトレジストを含むSi基板を電子ビーム(EB)ライターにロードします。
- EBライターで設計ファイル(手順2.1.2で用意)を読み込み、オペレーションファイル(WECファイル)を作成します。WECファイルで線量量を120μC/cm2 に設定します。基板の装填が終了したら、 単回 露光ボタンをクリックしてEB露光を行います。
- 露光が終了したら、 ウェーハキャリー→アンロード をクリックして、EBライターから基板をアンロードします。
- ドラフトチャンバーでフォトレジスト現像液(ZED)と現像液用リンス液(ZMD)を準備します。露出したSi基板を現像液に室温で60秒間浸します。
- 現像液からSi基板を取り出し、N2 ガスで基板を乾燥させます。
- 現像したSi基板をホットプレートに載せ、110°Cで90秒間ベークします。
- Si基板を緩衝フッ化水素酸(BHF-63SE)に1分間浸して、EB曝露および現像の結果として空気にさらされたSiO2 層の一部を除去します。
- 有機フォトレジスト除去剤(Hakuri-104など)に15分間浸漬して、Si基板からフォトレジストを除去します。
- Si基板を0.5%希フッ化水素酸に4分間浸して、窓領域の薄い自然酸化物を除去しますが、SiO2 マスクを保持します。次に、超高真空化学気相成長(UHV-CVD)チャンバーにロードしてGeを成長させます。 図2 に本研究で用いたUHV-CVDシステムを示す。
- エピタキシャルGe成長
- SEGマスク(ステップ2.1のように作製)を備えたSi基板をロードロックチャンバーにロードします。
- バッファー/主成長温度は、オペレーションコンピュータに表示される レシピ タブで設定します。SEG Ge層が隣接する層と合体するように、Geの主な成長の期間を決定します。主な成長の期間を決定するために、面内/横方向の成長を決定する{113}面上のGeの成長率を考慮してください26。本研究では、主成長の持続時間を650°Cと700°Cでそれぞれ270分と150分に設定します。
- メインウィンドウで 開始 をクリックすると、Si基板が自動的に成長チャンバーに転送されます。
注:エピタキシャルGe成長に関するプロトコル(ステップ2.2.4-2.2.7)は自動的に処理されます。 - 装填したSi基板上にGeバッファーを低温(≈380°C)で成長させる。原料ガスとしてArで9%に希釈したGeH4を使用し、バッファー成長中はGeH4の分圧を0.5Paに保つ。
- 高温でGeメイン層を成長させます。主成長中はGeH4 の分圧を0.8 Paに保ちます。本研究では、SEG Geを円形の断面と{113}面の断面25と比較するために、主成長温度に650°Cと700°Cの2つの異なる温度を使用します。
注:(001)面でのGeの成長速度は、温度とは無関係に11.7 nm / minでした。 - SEG Geの進化とその合体を可視化するために、別のSi基板上に厚さ10nmのSi0.3Ge0.7境界層を周期的に挿入しながらGe成長を行います。Si0.3 Ge 0.7層は、Si2H6およびGeH4ガスを用いて形成した。Si0.3Ge0.7層成長中は、Si2H6ガスの分圧を0.02Pa、GeH4ガスの分圧を0.8Paとする。
- Si基板は成長チャンバーからロードロックチャンバーに自動的に転送されるため、ロードロックチャンバーをベントし、Si基板を手動でアンロードします。
- エッチングピット密度(EPD)測定
- 超音波洗浄機を用いて、32mgのI2 を67mLのCH3COOHに溶解する。
- I2-溶解したCH3COOH、20mLのHNO3、および10mLのHFを混合する。
- Ge成長したSi基板をCH3COOH / HNO3 / HF / I2 溶液に5〜7秒間浸して、エッチングピットを形成します。
- エッチングされたGe表面を光学顕微鏡(通常は100倍)で観察し、エッチングされたピットが正常に形成されていることを確認します。
- 原子間力顕微鏡(AFM)を使用して、エッチングされたピットをカウントします。エッチングしたGeサンプルをAFMステージに置き、自動 アプローチをクリックしてプローブに近づきます。
- AFMと一体化した光学顕微鏡で観察エリアを決め、10μm×10μmの5つのエリアをスキャンします。振幅減衰係数は自動的に決定されます。
- 電子顕微鏡観察
- 集束Geイオンビーム(FIBマイクロサンプリング法)を使用して、合体/ブランケットGe層からTEM試料をピックアップします27。
- TeM試料をArイオンを用いたイオンミリングシステムで研磨します。本研究では、断面観察では[110]方向に150-500 nm、平面観察では[001]方向に200 nmとするTEM試料を薄くする。
- 平面TEM試料の場合は、Ge層の上面をアモルファス層で保護し、Ge層の下(基板)側から薄くします。
- 加速電圧200kVでTEM観察を行います。厚い(500 nm)TEM試料を観察するために、断面明視野走査TEM(STEM)観察を実行します。
- Si0.3 Ge 0.7境界層と合体したGeの場合、加速電圧200 kVで断面高角環状暗視野(HAADF)STEM観測を行います。
結果
理論計算
図3は、6種類の合体Ge層におけるTDの計算軌跡を示しています。 ここでは、開口率(APR)をWウィンドウ/(Wウィンドウ+Wマスク)と定義します。図3aは、APR=0.8のGeが合体した丸型SEG原点を示す。ここでは、2/6TDがトラップされています。図3bは、APR = 0.8の{113}面のSEG原点合体Geを示しています。ここでは、0/6 TDがトラップされます。図3cは、APR=0.1のGeを合体させた丸型SEG原点を示す。ここでは、5/6TDがトラップされています。図3dは、APR=0.1の合体Geの{113}面SEG原点を示す。ここでは、6/6TDがトラップされています。図3eは、GeがSiO2マスク上で成長する場合のAPR=0.1のGeを合体させた円形のSEG原点を示す。ここでは、0/6 TDがトラップされます。図3fは、GeがSiO2マスク上で成長する場合のAPR=0.1の{113}面SEG起源合体Geを示す。ここでは、0/6 TDがトラップされます。
(x 0, 0) で生成された 6 TD の軌道 (x 0 = 0.04, 0.1, 0.2, 0.4, 0.6, および 0.8 倍の Wwindow/2) は、各図に赤い線で示されています。これら2つのSEG Ge層の合体点の上に位置するTDは上面に伝播し、点の下のTDは下向きに伝播してSiO2マスク上のボイド表面に留まる。
図3a-3dでは、Seg GeはSiO2上では成長しないと仮定している。このように、{113}面SEG Geの側壁は、SiO2マスク領域に触れないようにするために丸型であるものとする。丸い形のSEGとその後合体したGeは、{113}面の場合よりもAPR0.8でTDDを減らすのに効果的であり、{113}面と合体したGeは、APR0.1の丸い形のものよりも効果的であることが明確に示されています。この「交差」は、SEGトップ付近に{113}ファセットが存在することに起因します:{113}ファセットは、円形の表面よりも[001]方向から大きくずれています。
図3eおよび図3fは、GeがSiO2上で核形成されていないと仮定して、0.1の開口率で合体したGeを示すが、以前に報告されたGe合体13、15、22、28、29、30、31で広く報告されている。図3eおよび図3fに示すように、2つのSEGの間に半円筒形の空隙がないため、表面にTDがトラップされません。
図4は、合体Geで計算されたTDDを示しています。 図4において、赤い線は丸型SEG Geに由来する合体Geの計算されたTDDを示し、青い線は{113}面SEG Geに由来する合体Geの計算されたTDDを示しています。Si上のGeのTDはGeとSiの格子不整合に由来するため、TD生成はGeとSiの界面でのみ発生すると仮定される。言い換えれば、TDDはAPRで減らす必要があります。
APRが0.11より大きい場合、丸い形のSEG Geは{113}面セットのものよりも効果的です(図3aおよび図3b)。一方、APRが0.11より小さい場合、{113}面のSEG Geは丸い形のSEG Geよりも効果的になります(図3cおよび図3d)。図3のように、このような交差は、SEGトップ(x 0≈ 0)付近に{113}ファセットが存在することに起因する。なお、図3eおよび図3fは図4の黒線に対応し、APRの低下からTDDの減少を示すが、合体には示さない(すなわち、SiO2とのSEG Ge湿潤はTDD還元に対して負の効果を有する)。
実験的検証
図5は、典型的な断面走査型電子顕微鏡(SEM)画像(図5b-5d、5f)と、合体が起こるかどうかを示す分布マップ(図5a、5e)を示す。 図5b-5d、5fは、非合体SEG Ge層の断面SEM画像を示す(図5b、700°Cで成長;図5f、650°Cで成長)、平坦でない上面を有する合体SEG Ge層(図5c、700°Cで成長)、および平坦な上面を有する合体SEG Ge層(図5d;700°Cで成長)を有するSEG Ge層を合体させた。図5bおよび図5dに示すSEM画像は、Pt保護層の堆積後に集束イオンビームによって研磨されています。合体は、現在の成長条件に対してWウィンドウとWマスクが1μmより小さい場合に発生します。Wマスクが1μm以上のSEGマスクは、横方向のGe成長量が少ないため、Geの合体を防止する26。Wウィンドウが2μm以上のSEGマスクもGeの合体を防ぎますが、Wウィンドウが1μmより小さいときに合体が起こりました。これは、SiO2に対するGeの横方向の成長速度がW窓30に依存するためである。マスクとウィンドウパターンの依存性を図7a(700°C)と図7e(650°C)にまとめます。
非合体SEG Ge層(図4bおよび図4f)を比較すると、700°Cで成長したSEG Ge層は断面が丸いのに対し、650°Cで成長したSEG Ge層は断面{113}であることが明確に示されています。図5bのように、700°Cでの成長は、SiO2上でのGe成長のない(すなわち、SiO2マスクとの濡れがない)円形のSEG Geを示す。したがって、図3aおよび図3cのように成長が進行する。一方、図5fのように、650°Cで{113}面のSEG Geが現れます。 GeがSiO2マスクで濡れを示すことを強く示唆しています。対照的に、エッジは丸い形です(すなわち、濡れていません)。したがって、650°Cでの成長は、図3b(濡れなし)と図3f(完全濡れ)の間にあります。これは、TDDの削減が図3bと図3fの間にある必要があることを示しています。図6に示す理論結果を考慮すると、SEG Ge断面のこれらの違いは、合体したGe層のTDDに強く影響するはずです。
SiO2上での濡れ成長の違いは以下のように理解できる。GeとSiO2の接触角(θ)は、ヤングの式で決まります。

ここで、γSiO2、γGe、γintは、それぞれSiO2表面自由エネルギー、Ge表面自由エネルギー、Ge/SiO2界面自由エネルギーである。Seg Ge側壁の角度は、Ge成長が進むにつれて大きくなる。SEG Ge側壁の角度が接触角θに達すると、SEG Geは垂直方向([001])または横方向([ ])に成長する必要があります。650°Cの成長の場合、垂直方向の成長は{113}面によって厳しく制限されるため、SEG Geは横方向の成長(すなわち、湿潤成長)を好みます。濡れはGeとSiO2の界面で転位を発生させる可能性がありますが、最終的には半円筒形の空隙表面で終端されます。700°C成長の場合、Geは垂直方向に成長することができ、γintが大きいため、接触角は650°Cの場合よりも大きくなります。これが、650°C成長GeがSiO2上で濡れを示すのに対し、700°C成長Geは湿潤しない理由です。
])に成長する必要があります。650°Cの成長の場合、垂直方向の成長は{113}面によって厳しく制限されるため、SEG Geは横方向の成長(すなわち、湿潤成長)を好みます。濡れはGeとSiO2の界面で転位を発生させる可能性がありますが、最終的には半円筒形の空隙表面で終端されます。700°C成長の場合、Geは垂直方向に成長することができ、γintが大きいため、接触角は650°Cの場合よりも大きくなります。これが、650°C成長GeがSiO2上で濡れを示すのに対し、700°C成長Geは湿潤しない理由です。
合体後のGeについては、断面構造は成長温度の影響を受けず、650°Cで成長した合体Ge層と700°Cで成長したGe層は断面SEM観察で区別できなかった。
なお、作製したパターンは、マスクの作製に等方性ウェットエッチングプロセスを採用したため、Wウィンドウ 値が大きく、Wマスク 値が設計値よりも小さくなった。W窓 及びWマスク の実測値は、Ge成長後の断面SEM観察により得られた。
それに加えて、マスクSiO2 層の厚さは、断面SEM観察および分光エリプソメトリー測定によれば30nmであった。このような薄いSiO2 層を用いて、図 3 および 図4で説明したTDD低減を調べ、ARTに対するエピタキシャルネッキングの影響を除去した。本研究では、アスペクト比は0.05未満であり、ARTに対するエピタキシャルネッキングの影響を無視するのに十分小さい。
図6aは、Si0.3 Ge 0.7境界層を有するSEGの断面HAADF STEMを示し、図6aの概略図を図6bに示す(Wウィンドウ= 0.66μm、Wマスク= 0.84μm)。Si0.3 Ge 0.7の境界層は、700°Cでの成長時の表面形状をはっきりと示しています。 STEM画像は、円形のSEGから合体後に形成された平らなエピタキシャル層までの各成長ステップのGe表面を示しています。合体直後の成長速度は、合体した領域で大幅に向上します。この急速な成長はおそらくGeエピレイヤーによって誘発され、エネルギー的に安定するためにその表面積を最小限に抑えます。
純粋なGe SEGとは対照的に、提示されたSi0.3 Ge 0.7境界層を有するGe SEGは、SiO2マスクによる湿潤を示す(図8a)。濡れの違いは、おそらくSi0.3Ge 0.7境界層の挿入によるものであり、その核生成はGeのありそうもないSiO2層で増強されています。
フラットトップ合体Ge(図5aおよび図5eの青い丸の領域)は、EPD測定に使用されます。Ge層は平均200nmエッチングされた。エッチング後の代表的なAFM像を図7aと図7bに示し、700°Cで成長させた厚さ1.15 μmの合体Ge(Wウィンドウ=0.66 μm、Wマスク=0.44 μm)と、650°Cで成長させた厚さ2.67 μmの合体Ge(Wウィンドウ=0.66 μm、Wマスク=0.34 μm)について撮影したものです。参考として、厚さ1.89μmのブランケットGeを700°Cで成長させた画像を図7cに示します。AFM画像の暗い点は、TDの存在を示すエッチングされたピットです。図7a-7cのEPD値は、それぞれ7.0 x 10 7 / cm 2、7.9 x 10 7 / cm 2、および8.7 x 107 / cm 2であることがわかりました。これまでの報告では、このエッチング条件で得られたEPDは、平面透過型電子顕微鏡(TEM)4,32,33,34によって決定されたTDDと等しいことが示されました。ブランケットGe層の測定EPD(7.9 ± 0.8 x 10 7/cm2)は、6 x 8 μm2(8.7 ± 0.2 x 107/cm2)の比較的広い面積の平面TEM観察から得られたTDDとよく一致し、EPDがTDDと等しいことを示しています。
実験的に得られたTDDを計算と比較するには、TDDに対する厚さの影響を考慮に入れてください。TDのペア消滅の可能性が高くなるため、Geの厚さが増加するにつれてTDDが減少する傾向があります。したがって、ブランケットGeよりも薄い合体Geについて観察されたTDDの減少は、図3および図4で説明されているメカニズムに起因するはずです(つまり、実験的に得られたTDDを図4の計算されたものと比較するために正規化されたTDDを計算する必要があります)。正規化の前に、TDDの厚さと成長温度を考慮して、ブランケットGe(ρブランケット)のTDDの補正を行った。以前の報告35,36と同様に、UHV-CVDを用いて530-650°Cの温度範囲で成長させたGe層について、ρブランケット[/cm2]は2.52 x 1013 x [d(nm)]-1.57と近似的に表されます。ここで、dはブランケットGe層の厚さである。ρブランケット[/cm2]は、700°Cで成長したGe層について還元され、2.67 x 1012 x [d(nm)]-1.37と近似的に表されます。
図7dは、正規化されたTDDをAPR、Wウィンドウ/(Wウィンドウ+ Wマスク)の関数として示しています。650°Cで成長させた合体GeのTDDを青い三角形で示し、700°Cで成長させたTDDを赤いひし形で示しています。650°CのSEG GeはSiO2マスクとの濡れを示すため、成長データは黒と青の線の間に収まるはずです。700°CでのSEG Geは赤い線上にあるはずです。実験結果は、断面形状と濡れ条件に基づく計算とよく一致しています。
以上のように、TDの挙動は、TD上の成長面のイメージ力に基づくモデルによって十分に説明されると結論付けられる。TDと表面との相互作用を理解するために、明視野断面STEMでTDを観察しました。 図8aの半円筒形のボイドの表面で曲げられて終端されている欠陥が観察されます。TDのこの動作は、 図3に示すTDの計算軌道と非常によく似ています。ただし、観測されたTDの軌道は、 図3で予測したものを正確に再現するものではありません。この違いは、成長中または成長後のエネルギーを最小限に抑えるためのTD変換の結果として説明されます(たとえば、成長温度から室温への温度低下)。 図8b は、Si上の合体Geエピ層におけるひずみのシミュレーションを示しています。 引張ひずみは、GeとSiの間の熱膨張係数の不一致のためにSi上のGe層に誘発されます。シミュレーションは、半円筒空隙の上部でひずみの蓄積が発生し、半円筒空隙の表面下層でひずみ緩和が発生し、TDが変換する動機となることを示しています。
一方、 図8c は、TEM試験片の準備中に発生点が除去されるものの、ボイドの上部での欠陥発生を示しています。 図8c の欠陥は直線に近いですが、欠陥と(001)面の角度(≈78.3°)は{111}面(54.7°)の角度と一致しません。
図8dに示す電子回折パターンは、図8cの欠陥付近で得られた。ストリークライトがないことは、2D構造があってはならないことを示します(つまり、欠陥は転位です)。既報28,29,30,31,37では、電子回折パターンに明確な筋光を示す2次元欠陥が形成されており、これは本研究で観察されたものに反している。観察結果(2D欠陥がないこと)は、ボイドとその自由表面がSi上のGeのひずみを放出するか、隣接するSEG Ge層間の結晶配向のずれを引き起こすという予測を支持しています。これは、SiO2マスク38上にボイドを有する合体SEG Ge層において2D欠陥の形成が防止されることを簡潔に示唆する以前の報告と一致する。
図10cに示すTD生成の候補には、ひずみ分布とSEG Ge層間の配向差の2つがあります。Si上のエピタキシャルGeでは、GeとSi39の間の熱膨張係数の不整合により、Geに引張ひずみが誘起されます。図8bに示すシミュレーション結果は、前述のようにボイドの上部に引張ひずみ(~0.5%)が蓄積していることを示しています。ボイドトップでのこのようなひずみの蓄積は、図8cに示すTD生成をもたらす可能性があります。別の候補は、SEG Ge層間の配向ずれが、SEG Ge層28、29、30、31、37の合体を示す以前の報告で観察されたように2D欠陥を生成すると仮定されている。しかし、本研究では、以前の報告38で簡単に述べたように、ボイドの存在により2次元欠陥の発生が抑制されますが、不完全な抑制によりTDが生成されます。方向ずれによる転位のより詳細な議論は、後の部分で概略図とともに説明されます(図12)。
図9aおよび図9bは、合体したGe層(Wウィンドウ= 0.82 μm、Wマスク= 0.68 μm)とブランケットGe層をそれぞれ同じ基板上に成長させた明視野平面図TEM画像を示しています。平面図TEM観察では、手順2.4.3で説明したように、Ge層の上部200 nm領域を使用してTEM試料を形成し、図9の上部の概略断面に赤い破線の四角で示されています。SiO2マスクストライプは、図9aの合体Geについて[110]方向に整列している。図9aに示す平面図TEM画像は、6 μm x 8 μmの領域について撮影されました。このTEM画像には5対のSiO2マスクとSi窓領域がありますが、SiO2マスクとSi窓の上の領域はTEM画像では区別できません。これは、観測された領域(上部200 nm)が半円筒形の空隙が位置する場所のはるか上(下部150 nm)であるためです。
図9aおよび図9bから得られたTDDは、それぞれ4.8 x 10 7/cm2および8.8 x 107/cm2であることがわかった。図7dに示すように、EPD測定により、合体したGe層(Wウィンドウ= 0.82 μm、Wマスク= 0.68 μm)のTDDは4 x 107 cm−2であることが明らかになりました。したがって、図9aのTDDは、図7に示すEPDと良好な一致を示しています。また、EPD測定もTEM観測もTDDの再増加を示さず、これはSEG Ge層が合体するときに頻繁に示されます(つまり、TDの生成によるTDDの再増加(図8b)は、現在のTDD範囲(107 / cm2のオーダー)でTDDの再増加が無視できる程度に抑制されます)。
図9aのように、合体Geでは4μm x 4μmのTDフリー領域が実現されていることに注意してください。図9bのブランケットGeは比較的均一な分布を持つTDを示していますが、合体したGeには高いTDD領域と低いTDD領域があります。このようなTD分布の違いは、合体したGeでさらなるTDD低減が達成可能であることを示唆しています。図9aで観察される4 μm x 4 μm領域の1 TDは、6.25 x 106 / cm2のTDDに相当します。
合体Ge(図9a)とブランケットGe(図9b)を比較すると、合体Geの欠陥線の長さはブランケットGeの欠陥線の長さよりも長いことがわかります。合体Geでは、通常1μmの長さの欠陥線があり、[110]方向に整列しています。なお、[110]方向とは、SiO2 ストライプの長さ方向である。このような長い欠陥線には、(i)2D欠陥が観察され、(ii)転位が[110]方向に傾いているという2つの説明が考えられます。ただし、観察された長い欠陥の幅のために、2D欠陥はすぐに否定されます(つまり、{111}平面上の2D欠陥はより広い欠陥線を示すはずです)。幾何学的には、{111}面上の2D欠陥は、TEM試験片の厚さ(200 nm)と(001)平面との{111}角度(54.7°)を考慮して、140nm幅の欠陥線を示すはずです。平面図TEM画像は、欠陥線の幅が10〜20 nmであり、140 nmよりもはるかに狭いことを示しています。したがって、長い線として示されている欠陥は、(ii)[110]方向に傾斜した転位に起因するはずです。単純な幾何学的計算により、傾斜転位と(001)平面の間の角度が得られます:tan−1(200 nm / 1 μm)= 11.3°。なお、図 8bに示すように、ブランケットGe中のTDsは、成長後のアニーリングを行わない場合、基板に対してほぼ垂直に向けられる傾向があり、平面図TEM像では小さな黒い点が示されている。
傾斜TDのより詳細な解析のために、 図10のようにTDDが高い小さな領域を任意に観察します。TEM試料は、上記の平面図TEM観察と同様に、合体Ge層の上部200nmから作製した。
図10aと図10bは、同じ領域で撮影された暗視野(図12aの場合はg = [220]、図12bの場合は[ ])の平面図TEM画像を示しています。図12では、4 μm x 4 μmの領域に4つの傾斜転位が観察されました。図10bは、回折ベクトルg = []のときに1つの傾斜転位(赤丸で囲んだ転位)が消えることを明らかにしており、これは、赤丸で囲んだ転位に対してバーガーズベクトルが[110]または[
])の平面図TEM画像を示しています。図12では、4 μm x 4 μmの領域に4つの傾斜転位が観察されました。図10bは、回折ベクトルg = []のときに1つの傾斜転位(赤丸で囲んだ転位)が消えることを明らかにしており、これは、赤丸で囲んだ転位に対してバーガーズベクトルが[110]または[
 ]であると決定されたことを示しています。欠陥線が[110]方向にあることから、転位はねじ転位であることがわかる。他の3つの傾斜転位(緑色の丸で囲んだ転位)は、選択された回折ベクトルgに関係なく消えなかったため、混合転位に起因します。
]であると決定されたことを示しています。欠陥線が[110]方向にあることから、転位はねじ転位であることがわかる。他の3つの傾斜転位(緑色の丸で囲んだ転位)は、選択された回折ベクトルgに関係なく消えなかったため、混合転位に起因します。
合体したGe層におけるTDの傾きには、(i)[110]方向のGe成長、および(ii)SEG Ge層が合体する際の欠陥生成の2つの説明が考えられます。
[110]方向のGe成長
図11は、非平面SEG表面から平坦なエピタキシャル層を形成する平面SEM像及び成長過程を模式動画として示す。EBリソグラフィとウェットケミカルエッチングによって形成されたSiO2ストライプパターンのエッジうねりを反映して、合体はいくつかの点で優先的に開始され、次にSiO2マスクの上の[110]および[ ]方向に進みます。図11bおよび図11cは、SEG Ge層が部分的に合体したときの鳥瞰図および(
]方向に進みます。図11bおよび図11cは、SEG Ge層が部分的に合体したときの鳥瞰図および( )断面図を模式的に示す。図3に示すように、成長ウィンドウで生成されたTDがボイドの上に現れ、その後、TDはイメージ力によって[110]または[
)断面図を模式的に示す。図3に示すように、成長ウィンドウで生成されたTDがボイドの上に現れ、その後、TDはイメージ力によって[110]または[ ]方向に伝播し始めます。これにより、TDは[110]方向に傾きます(図9aのように)。図11cの赤い実線は、上記のモデルに従って[110]方向に曲がったTDを示しており、図9aと図10で観察された傾斜TDの存在を定性的に説明しています。
]方向に伝播し始めます。これにより、TDは[110]方向に傾きます(図9aのように)。図11cの赤い実線は、上記のモデルに従って[110]方向に曲がったTDを示しており、図9aと図10で観察された傾斜TDの存在を定性的に説明しています。
このメカニズムは、Ge/Si界面40で生成されたTDのバーガーベクトルを考慮して、エッジTDとスクリューTDの両方を説明することができます。Si基板上にGeを成長させると、エッジミスフィット転位(MD)が形成されてひずみが解放され、MDが[110]または[ ]方向に整列します。MDはスレッドセグメント(すなわちTD)を形成し、[110]方向(MD110)に整列したMDから生じるTDのバーガーベクトルはa / 2[]またはa / 2[
]方向に整列します。MDはスレッドセグメント(すなわちTD)を形成し、[110]方向(MD110)に整列したMDから生じるTDのバーガーベクトルはa / 2[]またはa / 2[
 ](a:格子定数)です。一方、バーガーズベクトルは、[]方向に整列
](a:格子定数)です。一方、バーガーズベクトルは、[]方向に整列 したMDから発信されたTDに対してa/2[110]またはa/2[
したMDから発信されたTDに対してa/2[110]またはa/2[ ]です(
]です( )。MD 110からのTDが[110]方向に傾いている場合、平面図TEM観測はTDをエッジ転位として示しています。同様に、からのTDが
)。MD 110からのTDが[110]方向に傾いている場合、平面図TEM観測はTDをエッジ転位として示しています。同様に、からのTDが [110]方向に傾斜している場合、それらはスクリュー転位として観察される。
[110]方向に傾斜している場合、それらはスクリュー転位として観察される。
SEG Ge層合体時の欠陥発生
図12は、SEG Ge層が小さな回転(すなわち、方向ずれ)で合体した場合の欠陥の発生を説明する概略図を示しています。 図12に概略的に示すように、方向ずれは合体界面でエッジ/スクリュー/混合転位を生成するはずです。 図12では、[110]方向の2つのSEG Ge層間の方位差が3種類の回転に分解されている。 図12a〜12cは、[110]軸、[001]軸、[ ]軸を中心とした回転をそれぞれ示しています。
]軸を中心とした回転をそれぞれ示しています。
図12の合体は、厳密にエピタキシャルなGe層(Ge(001))と配向がずれた隣接するSEG Ge層(m-Ge)との間で生じると仮定される。[110]軸を中心とした回転(図12a)により、破線で示された境界で[110]方向に平行なエッジ転位が生成されます。同様に、図12bのように、[001]軸を中心とした回転の結果として、[001]方向に平行なエッジ転位が生成されます。一方、図12cに示す[]軸周りの回転は、b=[110]およびb=[ 001]の転位で構成されるスクリュー転位ネットワークを生成し、スクリュー転位ネットワーク41を示すSi(001)面の直接結合の場合と同様である。図10で観察されたスクリューTDは、[]軸を中心とした
001]の転位で構成されるスクリュー転位ネットワークを生成し、スクリュー転位ネットワーク41を示すSi(001)面の直接結合の場合と同様である。図10で観察されたスクリューTDは、[]軸を中心とした 回転の方向ずれを伴う合体に起因する可能性があります。[110]軸周りの回転(図12a)と[
回転の方向ずれを伴う合体に起因する可能性があります。[110]軸周りの回転(図12a)と[ ]軸周りの回転(図12c)の組み合わせは、図12に示す混合TDを説明できます。図9bに示す混合転位は、[001]軸周りの回転(図12b)と[
]軸周りの回転(図12c)の組み合わせは、図12に示す混合TDを説明できます。図9bに示す混合転位は、[001]軸周りの回転(図12b)と[ ]軸上の回転(図12c)の組み合わせによっても説明されます。
]軸上の回転(図12c)の組み合わせによっても説明されます。
方位のずれに起因する転位が1 x 107/cm2の密度で発生すると仮定すると、[]軸周りの 回転の平均角度は0.034°42と推定されます。 この推定と比較して、我々はすでに、マイクロビームX線回折観測を用いて、100秒角(=0.028°)の間、線状のSEG Ge層に方位のゆらぎがあることを報告している43。報告された方位の変動と推定回転角度はよく一致しており、これは方向のずれに基づくTD生成メカニズムを支持しています。
回転の平均角度は0.034°42と推定されます。 この推定と比較して、我々はすでに、マイクロビームX線回折観測を用いて、100秒角(=0.028°)の間、線状のSEG Ge層に方位のゆらぎがあることを報告している43。報告された方位の変動と推定回転角度はよく一致しており、これは方向のずれに基づくTD生成メカニズムを支持しています。

図1:Si(001)基板上のラインアンドスペース形状の4mm角SEGマスクの概略図。 この図の拡大版を表示するには、ここをクリックしてください。

図2:UHV-CVD装置、ガスキャビネット、プロセスチャンバー、ロードロックチャンバー、および操作コンピューターの部品の写真。 この図の拡大版を表示するには、ここをクリックしてください。
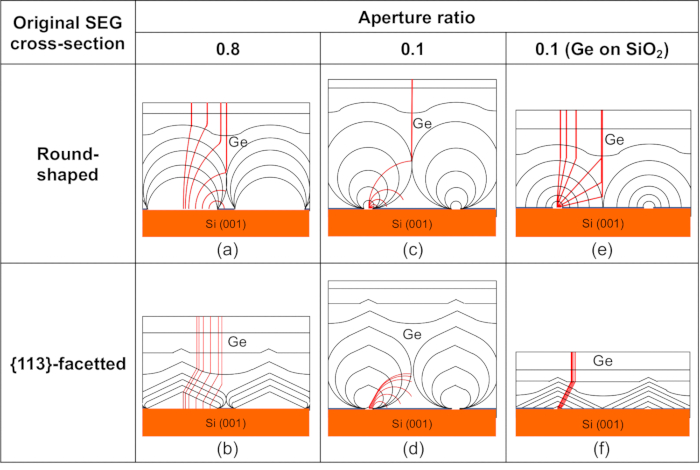
図3:(a)丸型SEG原点、開口率=0.8、(b)丸型SEG原点、開口率=0.1、(c){113}面SEG原点、開口率=0.8、(d){113}面SEG原点、開口率=0.1の4TDの軌跡を計算した図。 この図の拡大版を表示するには、ここをクリックしてください。
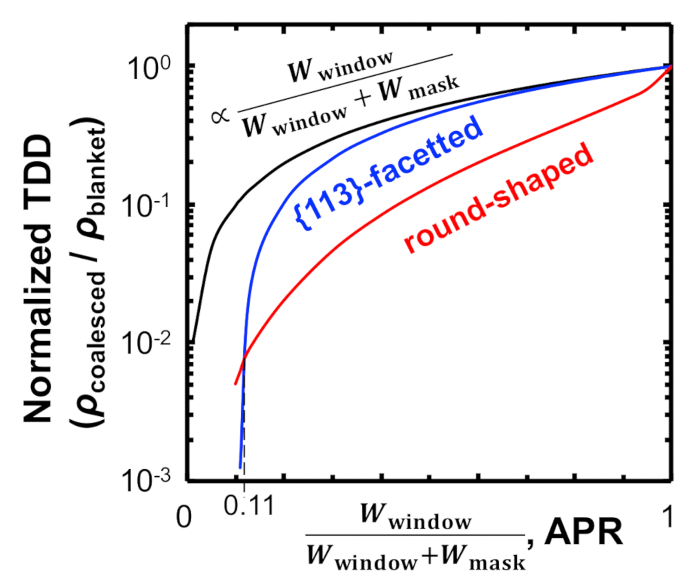
図4:合体Geの計算されたTDDは、{113}面のSEG Ge(青い線)と丸い形のSEG Ge(赤い線)に由来します。 この図の拡大版を表示するには、ここをクリックしてください。

図5:合体/非合体Ge層の分布図とSEM画像。 この図の拡大版を表示するには、ここをクリックしてください。

図6:(a)厚さ10nmのSi0.3Ge0.7境界層を用いて700°Cで成長させた合体Ge(Wウィンドウ=0.66μm、Wマスク=0.84μm)の断面HAADF STEM画像、および(b)(a)に示す条件に対応する模式図。 この図の拡大版を表示するには、ここをクリックしてください。

図7:(a)700°Cで成長させた厚さ1.15μmの合体Ge(Wウィンドウ=0.66μm、Wマスク=0.44μm)、(b)650°Cで成長させた厚さ2.67μmの合体Ge(Wウィンドウ=0.86μm、Wマスク=0.34μm)、(c)700°Cで成長させた厚さ1.89μmのブランケットGeのEPDを測定するための代表的なAFM画像、 (d)にEPD測定結果の要約とする。 この図の拡大版を表示するには、ここをクリックしてください。
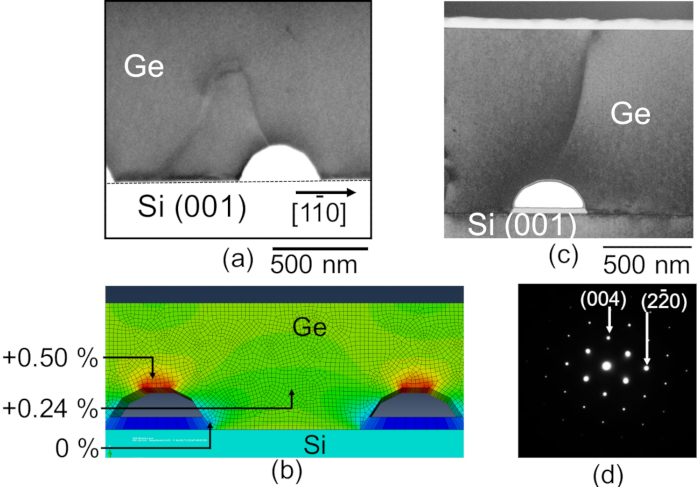
図8:(110)合体Ge層の断面(a)STEM像と(b)TEM像(Wウィンドウ=0.66μm、Wマスク=0.44μm)、(c)欠陥近傍で得られた電子回折パターン(b)、(d)有限要素法合体Geのひずみ分布シミュレーション結果。 図9(a)、(c)、および(d)は20から変更されています。この図の拡大版を表示するには、ここをクリックしてください。
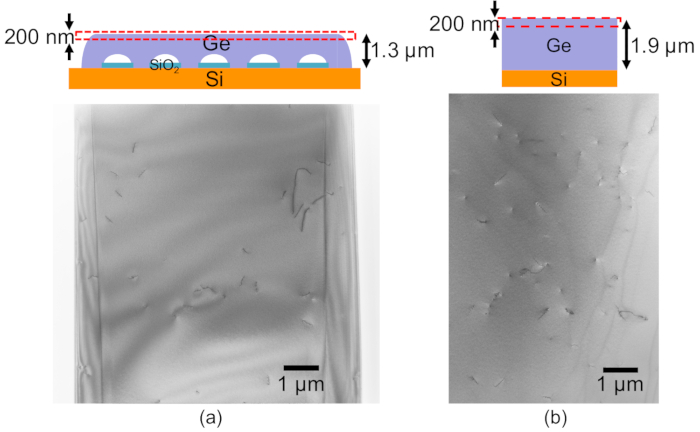
図9:(a)合体したGe層(Wウィンドウ=0.82μm、Wマスク=0.68μm)と(b)ブランケットGe層の明視野平面図TEM画像。 この図の拡大版を表示するには、ここをクリックしてください。
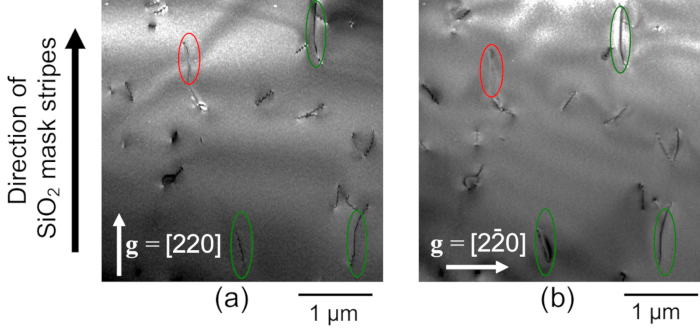
図10:gベクトルが(a)[220]と(b)[]の高TDD小領域の平面図TEM画像。  この数値は20から変更されました。この図の拡大版を表示するには、ここをクリックしてください。
この数値は20から変更されました。この図の拡大版を表示するには、ここをクリックしてください。
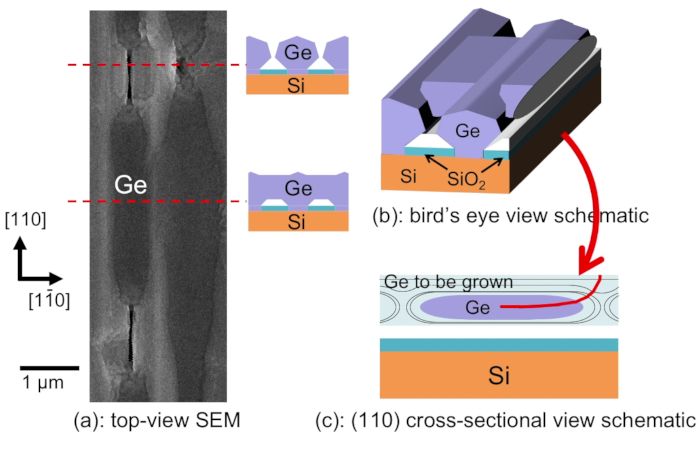
図11:(a)平面図SEM画像、(b)鳥瞰図画像、および( c)部分的に合体したSEG Geの断面模式図。この数値は20から変更されました。このビデオをダウンロードするには、ここをクリックしてください。
c)部分的に合体したSEG Geの断面模式図。この数値は20から変更されました。このビデオをダウンロードするには、ここをクリックしてください。
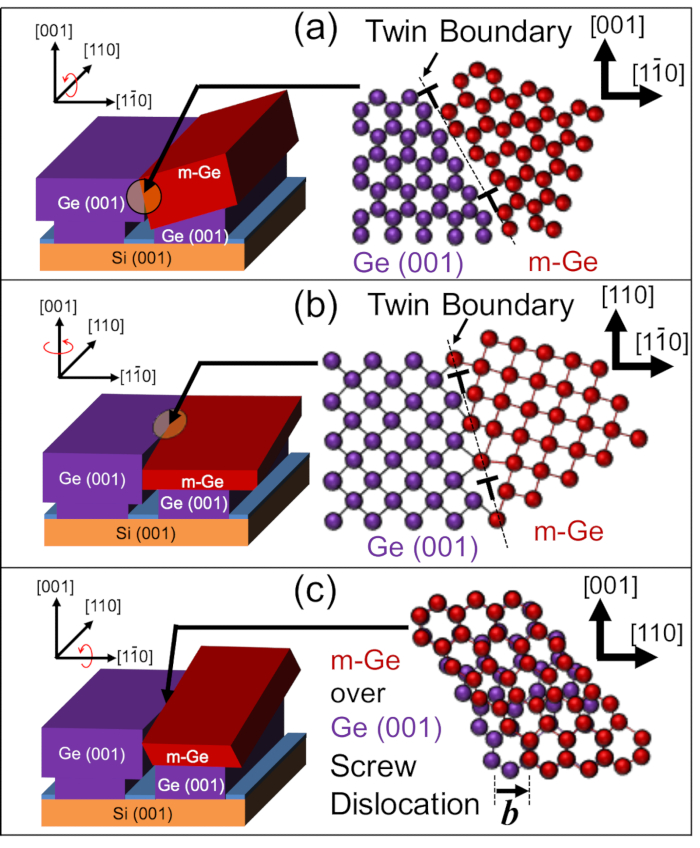
図12:SEG Ge層が(a)[110]、(b)[001]、(c)[]方位を中心に結晶回転と合体する際の欠陥発生の模式図。 この数値は20から変更されました。この図の拡大版を表示するには、ここをクリックしてください。
この数値は20から変更されました。この図の拡大版を表示するには、ここをクリックしてください。
| 方式 | TDD達成(cm-2) | 気温(°C) | バッファー層の厚さ |
| 熱アニーリング | 2e7 | ≈900 °C | ≈100 nm (低温バッファー) |
| SiGe グレードバッファ | 1e6 | 成長温度(600〜700°C) | 2–3 μm |
| 芸術 | 1e6 | 成長温度(600〜700°C) | 500〜1000 nm |
| Siピラーシード | 1e5 | ≈800 °C | ≈5ミクロン |
| この作品 | 4e7 | 成長温度 (700°C) | ≈150 nm |
表1:従来型/提示されたTDD低減法に対するフォトニックデバイス応用の観点から見たTDD達成と欠点の要約。
補足 図1:Si上のエピタキシャルGeのTDDを低減するために広く採用されている4つの典型的な方法:(a)熱アニーリング、(b)SiGe傾斜バッファー、(c)アスペクト比トラップ(ART)、および(d)Siピラーシード。 この図をダウンロードするには、ここをクリックしてください。
補足動画1:丸型SEG Geのイメージ力によりTDが曲がった模式図。 このビデオをダウンロードするには、ここをクリックしてください。
ディスカッション
本研究では、4 x 107 / cm2 のTDDが実験的に示されました。さらなるTDD低減のために、プロトコル内には主にSEGマスク調製とエピタキシャルGe成長の2つの重要なステップがあります。
図4に示す我々のモデルは、APR、Wウィンドウ/(Wウィンドウ+ Wマスク)が0.1と小さい場合、合体GeでTDDを107/cm2未満に減らすことができることを示しています。さらなるTDD低減に向けて、APRの小さいSEGマスクを用意する必要があります。ステップ2.1.2で述べたように、WウィンドウとWマスクの最小値はそれぞれ0.5μmと0.3μmであり、採用されたEBリソグラフィシステムの分解能によって制限されました。APRを低減する簡単な方法の1つは、リソグラフィおよびエッチングプロセスを変更することである(例えば、別のフォトレジストを使用する、より良好なリソグラフィシステムを使用する、より浅いBHFエッチングを有するより薄いSiO2層を使用するなど)。成熟したリソグラフィとエッチングプロセスにより、100nmよりも狭いSEGマスクが可能になります。本研究では、Wマスク≤1μmのときに平坦な上面を有する合体Geが得られた。したがって、100 nmのWウィンドウと900 nmのWマスク(APR = 0.1)は、現在の成長条件で平坦な上面を持つ合体Geを与えるでしょう。
それに加えて、SEGマスク調製の変更により、SEGマスクのエッジうねりが少なくなり、GeSEG層間の配向ミスが抑制されるはずです。SEG Ge層が合体したときのTD生成(図11)は、SEGマスク調製の変更の結果として抑制されます。
計算結果(図3)で明らかになったように、TDDを低減するためにはSiO2上でのGe成長の抑制が必要である。SiO2上でのGe成長の抑制は、Ge成長段階の修正(すなわち、成長温度の上昇、SEGマスクの回転、H2ガスの導入、およびGeH4ガスの圧力の低下)によってもたらされる44,45。
本研究で提案・検証したTDD還元法は、Geフォトニックデバイスへの応用において既存の手法よりも優れている(熱アニールや厚いバッファ層を一切使用せずにTDDを低減できる)。最高プロセス温度は成長温度である700°Cであり、ボイドの高さは≈150nmであった。既存の方法と比較して、最高温度はアニール温度(通常900°C)7よりも低く、ボイドの高さはSiGe傾斜バッファ層(通常数μm)10、ART用のSiO2トレンチ(通常0.5-1μm)13、Siピラー上のGe成長用のバッファ層(通常≈5μm)よりも浅い18。従来型/提示された方法の比較を表1にまとめた。
典型的なGeフォトニックデバイス(≈100μm2)のフットプリントを考慮すると、TDDは106 / cm2未満であり、TD < 1 /デバイスが最終目標になります。この方法のTDDの理論限界は0であるため、106 /cm2未満のTDDが達成できる可能性があります。目標に向けて、より最適化されたリソグラフィとエッチングが調査されます。
開示事項
著者は開示するものは何もありません。
謝辞
本研究は、文部科学省の日本学術振興会(JSPS)科研費(17J10044)の助成を受けて行われました。製造プロセスは、文部科学省の「ナノテクノロジープラットフォーム」(プロジェクト番号12024046)によってサポートされました。著者らは、東京大学の山下和彦氏と平田聡氏のTEM観測に協力してくださったことに感謝する。
資料
| Name | Company | Catalog Number | Comments |
| AFM | SII NanoTechnology | SPI-3800N | |
| BHF | DAIKIN | BHF-63U | |
| CAD design | AUTODESK | AutoCAD 2013 | Software |
| CH3COOH | Kanto-Kagaku | Acetic Acid | for Electronics |
| CVD | Canon ANELVA | I-2100 SRE | |
| Developer | ZEON | ZED | |
| Developer rinse | ZEON | ZMD | |
| EB writer | ADVANTEST | F5112+VD01 | |
| Furnace | Koyo Thermo System | KTF-050N-PA | |
| HF, 0.5 % | Kanto-Kagaku | 0.5 % HF | |
| HF, 50 % | Kanto-Kagaku | 50 % HF | |
| HNO3, 61 % | Kanto-Kagaku | HNO3 1.38 | for Electronics |
| I2 | Kanto-Kagaku | Iodine 100g | |
| Photoresist | ZEON | ZEP520A | |
| Photoresist remover | Tokyo Ohka | Hakuri-104 | |
| Surfactant | Tokyo Ohka | OAP | |
| TEM | JEOL | JEM-2010HC |
参考文献
- Giovane, L. M., Luan, H. C., Agarwal, A. M., Kimerling, L. C. Correlation between leakage current density and threading dislocation density in SiGe p-i-n diodes grown on relaxed graded buffer layers. Applied Physics Letters. 78 (4), 541-543 (2001).
- Wang, J., Lee, S. Ge-photodetectors for Si-based optoelectronic integration. Sensors. 11, 696-718 (2011).
- Ishikawa, Y., Saito, S. Ge-on-Si photonic devices for photonic-electronic integration on a Si platform. IEICE Electronics Express. 11 (24), 1-17 (2014).
- Cai, Y. Materials science and design for germanium monolithic light source on silicon, Ph.D. dissertation. , Dept. Mater. Sci. Eng., Massachusetts Inst. Technol. Cambridge, MA, USA. (2009).
- Wada, K., Kimerling, L. C. Photonics and Electronics with Germanium. , Wiley. Hoboken, NJ, USA. 294(2015).
- Higashitarumizu, N., Ishikawa, Y. Enhanced direct-gap light emission from Si-capped n+-Ge epitaxial layers on Si after post-growth rapid cyclic annealing: Impact of non-radiative interface recombination toward Ge/Si double heterostructure lasers. Optics Express. 25 (18), 21286-21300 (2017).
- Luan, H. C., et al. High-quality Ge epilayers on Si with low threading-dislocation densities. Applied Physics. Letters. 75 (19), 2909-2911 (1999).
- Nayfeha, A., Chui, C. O., Saraswat, K. C. Effects of hydrogen annealing on heteroepitaxial-Ge layers on Si: Surface roughness and electrical quality. Applied Physics Letters. 85 (14), 2815-2817 (2004).
- Choi, D., Ge, Y., Harris, J. S., Cagnon, J., Stemmer, S. Low surface roughness and threading dislocation density Ge growth on Si (001). Journal of Crystal Growth. 310 (18), 4273-4279 (2008).
- Currie, M. T., Samavedam, S. B., Langdo, T. A., Leitz, C. W., Fitzgerald, E. A. Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing. Applied Physics Letters. 72 (14), 1718-1720 (1998).
- Liu, J. L., Tong, S., Luo, Y. H., Wan, J., Wang, K. L. High-quality Ge films on Si substrates using Sb surfactant-mediated graded SiGe buffers. Applied Physics Letters. 79 (21), 3431-3433 (2001).
- Yoon, T. S., Liu, J., Noori, A. M., Goorsky, M. S., Xie, Y. H. Surface roughness and dislocation distribution in compositionally graded relaxed SiGe buffer layer with inserted-strained Si layers. Applied Physics Letters. 87 (1), 012014(2005).
- Langdo, T. A., Leitz, C. W., Currie, M. T., Fitzgerald, E. A., Lochtefeld, A., Antoniadis, D. A. High quality Ge on Si by epitaxial necking. Applied Physics Letters. 76 (25), 3700-3702 (2000).
- Park, J. S., Bai, J., Curtin, M., Adekore, B., Carroll, M., Lochtefeld, A. Defect reduction of selective Ge epitaxy in trenches on Si(001) substrates using aspect ratio trapping. Applied Physics Letters. 90 (5), 052113(2007).
- Fiorenza, J. G., et al. Aspect ratio trapping: A unique technology for integrating Ge and III-Vs with silicon CMOS. ECS Transactions. 33 (6), 963-976 (2010).
- Salvalaglio, M., et al. Engineered Coalescence by Annealing 3D Ge Microstructures into High-Quality Suspended Layers on Si. Applied Materials & Interfaces. 7 (34), 19219-19225 (2015).
- Bergamaschini, R., et al. Self-aligned Ge and SiGe three-dimensional epitaxy on dense Si pillar arrays. Surface Science Reports. 68 (3), 390-417 (2013).
- Isa, F., et al. Highly Mismatched, Dislocation-Free SiGe/Si Heterostructures. Advanced Materials. 28 (5), 884-888 (2016).
- Yako, M., Ishikawa, Y., Wada, K. Coalescence induced dislocation reduction in selectively grown lattice-mismatched heteroepitaxy: Theoretical prediction and experimental verification. Journal of Applied Physics. 123 (18), 185304(2018).
- Yako, M., Ishikawa, Y., Abe, E., Wada, K. Defects and Their Reduction in Ge Selective Epitaxy and Coalescence Layer on Si With Semicylindrical Voids on SiO2 Masks. IEEE Journal of Selected Topics in Quantum Electronics. 24 (6), 8201007(2018).
- Park, J. S., Bai, J., Curtin, M., Carroll, M., Lochtefeld, A. Facet formation and lateral overgrowth of selective Ge epitaxy on SiO2-patterned Si(001) substrates. Journal of Vacuum Science & Technology B. 26 (1), 117-121 (2008).
- Bai, J., et al. Study of the defect elimination mechanisms in aspect ratio t.rapping Ge growth. Applied Physics Letters. 90 (10), 101902(2007).
- Montalenti, F., et al. Dislocation-Free SiGe/Si Heterostructures. Crystals. 8 (6), 257(2018).
- Zhang, H. L. Calculation of shuffle 60° dislocation width and Peierls barrier and stress for semiconductors silicon and germanium. European Physical Journal B. 81 (2), 179-183 (2011).
- Kim, M., Olubuyide, O. O., Yoon, J. U., Hoyt, J. L. Selective Epitaxial Growth of Ge-on-Si for Photodiode Applications. ECS Transactions. 16 (10), 837-847 (2008).
- Yako, M., Kawai, N. J., Mizuno, Y., Wada, K. The kinetics of Ge lateral overgrowth on SiO2. Proceedings of MRS Fall Meeting. , (2015).
- Kamino, T., Yaguchi, T., Hashimoto, T., Ohnishi, T., Umemura, K. A FIB Micro-Sampling Technique and a Site Specific TEM Specimen Preparation Method. Introduction to Focused Ion Beams. , Springer. Boston, MA. (2005).
- Park, J. S., et al. Low-defect-density Ge epitaxy on Si(001) using aspect ratio trapping and epitaxial lateral overgrowth. Electrochemical and Solid-State Letters. 12 (4), H142-H144 (2009).
- Li, Q., Jiang, Y. B., Xu, H., Hersee, S., Han, S. M. Heteroepitaxy of high-quality Ge on Si by nanoscale Ge seeds grown through a thin layer of SiO2. Applied Physics Letters. 85 (11), 1928-1930 (2004).
- Halbwax, M., et al. Epitaxial growth of Ge on a thin SiO2 layer by ultrahigh vacuum chemical vapor deposition. Journal of Crystal Growth. 308 (1), 26-29 (2007).
- Leonhardt, D., Ghosh, S., Han, S. M. Origin and removal of stacking faults in Ge islands nucleated on Si within nanoscale openings in SiO2. Journal of Applied Physics. 10 (7), 073516(2011).
- Takada, Y., Osaka, J., Ishikawa, Y., Wada, K. Effect of Mesa Shape on Threading Dislocation Density in Ge Epitaxial Layers on Si after Post-Growth Annealing. Japanese Journal of Applied Physics. 49 (4S), 04DG23(2010).
- Ishikawa, Y., Wada, K. Germanium for silicon photonics. Thin Solid Films. 518 (6), S83-S87 (2010).
- Nagatomo, S., Ishikawa, Y., Hoshino, S. Near-infrared laser annealing of Ge layers epitaxially grown on Si for high-performance photonic devices. Journal of Vacuum Science & Technology B. 35 (5), 051206(2017).
- Ayers, J. E., Schowalter, L. J., Ghandhi, S. K. Post-growth thermal annealing of GaAs on Si(001) grown by organometallic vapor phase epitaxy. Journal of Crystal Growth. 125 (1), 329-335 (1992).
- Wang, G., et al. A model of threading dislocation density in strain-relaxed Ge and GaAs epitaxial films on Si (100). Applied Physics Letters. 94 (10), 102115(2009).
- Leonhardt, D., Ghosh, S., Han, S. M. Defects in Ge epitaxy in trench patterned SiO2 on Si and Ge substrates. Journal of Crystal Growth. 335 (1), 62-65 (2011).
- Sammak, A., Boer, W. B., Nanver, L. K. Ge-on-Si: Single-crystal selective epitaxial growth in a CVD reactor. ECS Transactions. 50 (9), 507-512 (2012).
- Ishikawa, Y., Wada, K., Cannon, D. D., Liu, J., Luan, H. C., Kimerling, L. C. Strain-induced band gap shrinkage in Ge grown on Si substrate. Applied Physics Letters. 82 (13), 2044-2046 (2003).
- Bolkhovityanov, Y. B., Gutakovskii, A. K., Deryabin, A. S., Sokolov, L. V. Edge Misfit Dislocations in GexSi1–x/Si(001) (x~1) Heterostructures: Role of Buffer GeySi1–y (y < x) Interlayer in Their Formation. Physics of the Solid State. 53 (9), 1791-1797 (2011).
- Bourret, A. How to control the self-organization of nanoparticles by bonded thin layers. Surface Science. 432 (1), 37-53 (1999).
- Hirth, J. P., Lothe, J. Grain boundaries. Theory of Dislocations, 2nd ed. 19, Wiley. New York, NY, USA. 697-750 (1982).
- Mizuno, Y., Yako, M., Luan, N. M., Wada, K. Strain tuning of Ge bandgap by selective epigrowth for electro-absorption modulators. Proceedings of SPIE Photonics West, San Francisco, CA, USA. 9367, 1-6 (2015).
- Nam, J. H., et al. Lateral overgrowth of germanium for monolithic integration of germanium-on-insulator on silicon. Journal of Crystal Growth. 416 (15), 21-27 (2015).
- Fitch, J. T. Selectivity Mechanisms in Low Pressure Selective Epitaxial Silicon Growth. Journal of The Electrochemical Society. 141 (4), 1046-1055 (1994).
- Ye, H., Yu, J. Germanium epitaxy on silicon. Science and Technology of Advanced Materials. 15 (2), 1-9 (2014).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved