Method Article
Calcul théorique et vérification expérimentale pour la réduction de la dislocation dans les couches épitaxiales de germanium avec vides semi-cylindriques sur silicium
Dans cet article
Résumé
Le calcul théorique et la vérification expérimentale sont proposés pour une réduction de la densité de dislocation du filetage (TD) dans les couches épitaxiales de germanium avec des vides semi-cylindriques sur silicium. Les calculs basés sur l’interaction des TD et de la surface via la force d’image, les mesures TD et les observations de TD au microscope électronique à transmission sont présentés.
Résumé
La réduction de la densité de dislocation du filetage (TDD) dans le germanium épitaxial (Ge) sur silicium (Si) a été l’un des défis les plus importants pour la réalisation de circuits photoniques intégrés monolithiquement. Le présent document décrit les méthodes de calcul théorique et de vérification expérimentale d’un nouveau modèle de réduction du TDD. La méthode de calcul théorique décrit la flexion des dislocations de filetage (TD) basée sur l’interaction des TD et des surfaces de croissance non planaires de croissance épitaxiale sélective (SEG) en termes de force d’image de dislocation. Le calcul révèle que la présence de vides sur les masques SiO2 aide à réduire les TDD. La vérification expérimentale est décrite par le germanium (Ge) SEG, à l’aide d’une méthode de dépôt chimique en phase vapeur sous ultravide et d’observations TD du Ge cultivé par gravure et microscope électronique à transmission transversale (MET). Il est fortement suggéré que la réduction du TDD serait due à la présence de vides semi-cylindriques sur les masques SEG SiO2 et à la température de croissance. Pour la vérification expérimentale, des couches épitaxiales de Ge avec des vides semi-cylindriques sont formées à la suite du SEG des couches de Ge et de leur coalescence. Les TDD obtenus expérimentalement reproduisent les TDD calculés sur la base du modèle théorique. Les observations transversales de la TEM révèlent que la terminaison et la génération de TD se produisent à des vides semi-cylindriques. Les observations de TEM en plan révèlent un comportement unique des TD dans Ge avec des vides semi-cylindriques (c’est-à-dire que les TD sont pliés pour être parallèles aux masques SEG et au substrat Si).
Introduction
Epitaxial Ge on Si a suscité un intérêt substantiel en tant que plate-forme de dispositifs photoniques actifs puisque Ge peut détecter / émettre de la lumière dans la gamme de communication optique (1,3-1,6 μm) et est compatible avec les techniques de traitement CMOS (semi-conducteur à oxyde métallique complémentaire). Cependant, comme l’inadéquation du réseau entre Ge et Si est aussi grande que 4,2%, des dislocations de filetage (TD) se forment dans les couches épitaxiales Ge sur Si à une densité de ~109/cm2. Les performances des dispositifs photoniques Ge sont détériorées par les TD parce que les TD fonctionnent comme des centres de génération de porteurs dans les photodétecteurs Ge () et les modulateurs (MOD), et comme des centres de recombinaison de porteuses dans les diodes laser (LD). À leur tour, ils augmenteraient le courant de fuite inverse (fuite J) dans les et les MOD 1,2,3, et le courant de seuil (Jth) dans les LD 4,5,6.
Diverses tentatives ont été signalées pour réduire la densité de TD (TDD) dans Ge on Si (figure supplémentaire 1). Le recuit thermique stimule le mouvement des TD conduisant à la réduction de TDD, généralement à 2 x 107/cm2. L’inconvénient est le mélange possible de Si et de Ge et la diffusion de dopants dans Ge tels que le phosphore 7,8,9 (figure supplémentaire 1a). La couche tampon graduée SiGe 10,11,12 augmente les épaisseurs critiques et supprime la génération de TD conduisant à la réduction des TDD, généralement à 2 x 10 6/cm2. L’inconvénient ici est que le tampon épais réduit l’efficacité du couplage de lumière entre les dispositifs Ge et les guides d’ondes Si en dessous (Figure supplémentaire 1b). Le piégeage au format d’image (ART)13,14,15 est une méthode de croissance épitaxiale sélective (SEG) qui réduit les DT en piégeant les TD sur les parois latérales des tranchées épaisses de SiO 2, généralement à <1 x 10 6/cm 2. La méthode ART utilise un masque SiO 2 épais pour réduire le TDD dans Ge par rapport aux masques SiO2, qui se situe bien au-dessus du Si et présente le même inconvénient (Figure supplémentaire 1b,1c). La croissance de Ge sur les graines du pilier Si et le recuit 16,17,18 sont similaires à la méthode ART, permettant le piégeage TD par rapport d’aspect élevé Croissance Ge, à <1 x 10 5/cm2. Cependant, le recuit à haute température pour la coalescence Ge présente les mêmes inconvénients dans la figure supplémentaire 1a-c (figure supplémentaire 1d).
Pour obtenir une croissance épitaxiale Ge TDD faible sur Si qui est exempte des inconvénients des méthodes mentionnées ci-dessus, nous avons proposé une réduction TDD induite par coalescence 19,20 sur la base des deux observations clés suivantes rapportées jusqu’à présent dans la croissance SEG Ge 7,15,21,22,23 : 1) les TD sont pliés pour être perpendiculaires aux surfaces de croissance (observés par le microscope électronique à transmission transversale (MET)), et 2) la coalescence des couches de SEG Ge entraîne la formation de vides semi-cylindriques sur les masques SiO2.
Nous avons supposé que les TD sont pliés en raison de la force d’image de la surface de croissance. Dans le cas de Ge sur Si, la force d’image génère des contraintes de cisaillement de 1,38 GPa et 1,86 GPa pour les dislocations de vis et les luxations de bord à des distances de 1 nm des surfaces libres, respectivement19. Les contraintes de cisaillement calculées sont significativement plus grandes que la contrainte de Peierls de 0,5 GPa rapportée pour des dislocations de 60° dans Ge24. Le calcul prévoit la réduction TDD des couches de GES SEG sur une base quantitative et est en bon accord avec la croissance du SEG Ge19. Les observations TEM des TD sont effectuées pour comprendre les comportements de la TD dans la croissance SEG Ge présentée sur Si20. La réduction TDD induite par la force d’image est exempte de tout recuit thermique ou couche tampon épaisse, et est donc plus adaptée à l’application de dispositifs photoniques.
Dans cet article, nous décrivons des méthodes spécifiques pour le calcul théorique et la vérification expérimentale utilisés dans la méthode de réduction TDD proposée.
Protocole
1. Procédure de calcul théorique
- Calculer les trajectoires des TD. Dans le calcul, supposons que les masques SEG sont suffisamment minces pour ignorer l’effet TAR sur la réduction du TDD.
- Déterminer les surfaces de croissance et les exprimer par équation(s). Par exemple, exprimez l’évolution temporelle d’une section transversale de forme ronde d’une couche SEG Ge avec le paramètre d’évolution temporelle n = i, les hauteurs SEG Ge (h i) et les rayons SEG Ge (r i), comme indiqué dans la vidéo supplémentaire 1a et Eq. (1):

- Déterminez les directions normales d’un emplacement arbitraire sur les surfaces de croissance. Pour la section transversale de forme ronde SEG Ge, décrire la ligne normale à (x i , yi) comme
 , représentée dans la vidéo supplémentaire 1b par une ligne rouge. Ensuite, obtenez le bord de la TD (x i+1, y i+1) à partir du point (x i , y i) en résolvant les équations simultanées suivantes:
, représentée dans la vidéo supplémentaire 1b par une ligne rouge. Ensuite, obtenez le bord de la TD (x i+1, y i+1) à partir du point (x i , y i) en résolvant les équations simultanées suivantes:
- Calculez une trajectoire d’un TD en fonction de l’emplacement de la génération de TD (x 0, 0), comme illustré dans la vidéo supplémentaire 1c. En d’autres termes, une trajectoire pour une TD arbitraire peut être calculée par la méthode décrite ci-dessus.
- Calculer le TDD en supposant que les TD pénètrent jusqu’à la surface inférieure et contribuent à la réduction du TDD (c.-à-d. que les TD en dessous du point où les couches SEG Ge fusionnent sont piégées par des vides semi-cylindriques et n’apparaissent jamais sur la surface supérieure).
- Déterminer les surfaces de croissance et les exprimer par équation(s). Par exemple, exprimez l’évolution temporelle d’une section transversale de forme ronde d’une couche SEG Ge avec le paramètre d’évolution temporelle n = i, les hauteurs SEG Ge (h i) et les rayons SEG Ge (r i), comme indiqué dans la vidéo supplémentaire 1a et Eq. (1):
2. Procédure de vérification expérimentale
- Préparation du masque SEG
- Avant la fabrication des masques SEG, définissez les zones de croissance Ge en préparant un fichier de conception. Dans le présent travail, préparer des motifs de ligne et d’espace alignés sur la direction [110] et des zones de fenêtre Si de forme carrée de 4 mm de largeur à l’aide d’un logiciel commercial (par exemple, AutoCAD).
- Déterminez la conception des masques SEG (en particulier Wwindow et Wmask) à l’aide du logiciel. La fenêtre W est la largeur de lafenêtre (largeur de la graine Si) et le masque W est la largeur dumasque SiO2 , de sorte que les couches SEG Ge peuvent fusionner avec leurs couches adjacentes. Déterminez lafenêtre W et lemasque W en dessinant des rectangles en cliquant sur ouvrir le fichier → la structure → rectangle ou polyligne.
Remarque : La largeur des rectangles devient lafenêtre W et l’intervalle des rectangles devient Wmask. Dans le présent travail, les valeurs minimales de lafenêtre W et dumasque W sont respectivement de 0,5 μm et 0,3 μm, qui sont limitées par la résolution dans le système de lithographie EB utilisé. - À titre de référence, dessinez des zones de fenêtre Si de forme carrée de 4 mm de largeur D, considérées comme les zones de couverture. Cliquez sur Ouvrir le fichier → la structure → rectangle ou polyligne pour dessiner la fenêtre Si de forme carrée. Utilisez les schémas illustrés à la figure 1 pour préparer les motifs de ligne et d’espace et la zone de couverture carrée de 4 mm.
- Préparer des substrats p-Si (001) dopés au B avec une résistivité de 1-100 Ω∙cm. Dans le présent travail, utilisez des substrats Si de 4 pouces. Nettoyez les surfaces du substrat avec une solution de Piranha (un mélange de 20 mL de 30% H 2 O 2 et 80 mL de 96% H2 SO4) au besoin.
- Ouvrez le couvercle d’un four tubulaire et chargez les substrats de Si dans le four à l’aide d’une tige de verre. Dans le présent travail, oxyder les substrats de 10 Si à la fois.
- Commencez à sécher le gazN2 dans le four en ouvrant la vanne de gaz. Ensuite, réglez le débit de gaz à 0,5 L/m en contrôlant la vanne.
- Réglez la température de recuit en changeant le programme. Dans le présent travail, utiliser « pas de modèle (mode 2) » et régler la température du procédé à 900 °C. Ensuite, exécutez le programme en poussant la fonction → exécutez.
- Lorsque la température atteint 900 °C, fermer la vanne N 2 sèche, ouvrir la vanne sèche O 2 (débit O 2 = 1 L/m) et conserver pendant2 h.
REMARQUE : Effectuez les étapes 2.1.9 à 2.1.16 dans une pièce jaune. - Enduire les substrats de Si oxydés d’un tensioactif (OAP) à l’aide d’un enrobage d’essorage, puis cuire au four à 110 °C pendant 90 s sur une plaque chauffante.
- Après l’enrobage du tensioactif, enduire les substrats de Si d’une résine photosensible (par exemple, ZEP520A) à l’aide d’un enrobage de spin, puis cuire à 180 °C pendant 5 minutes sur une plaque chauffante.
- Chargez les substrats de Si avec le tensioactif et la résine photosensible dans un émetteur à faisceau d’électrons (EB).
- Lisez le fichier de conception (préparé à l’étape 2.1.2) dans le graveur EB et créez un fichier d’opération (fichier WEC). Fixer la quantité de dose à 120 μC/cm2 dans le fichier WEC. Lorsque le chargement du substrat se termine, effectuez l’exposition EB en cliquant sur le bouton d’exposition unique .
- Déchargez le substrat de l’émetteur EB en cliquant sur la plaquette transporter → décharger à la fin de l’exposition.
- Préparez un révélateur de résine photosensible (ZED) et un rinçage pour le révélateur (ZMD) dans une chambre de tirage. Trempez les substrats de Si exposés dans le révélateur pendant 60 s à température ambiante.
- Retirez les substrats de Si du révélateur, puis séchez le substrat avec du gazN2 .
- Placer les substrats de Si développés sur une plaque chauffante pour cuire à 110 °C pendant 90 s.
- Trempez les substrats de Si dans un acide fluorhydrique tamponné (BHF-63SE) pendant 1 min afin d’éliminer une partie des couches deSiO2 exposées à l’air à la suite de l’exposition et du développement de l’EB.
- Retirer la résine photosensible des substrats de Si en plongeant dans un dissolvant de résine photosensible organique (par exemple, Hakuri-104) pendant 15 min.
- Trempez les substrats de Si dans de l’acide fluorhydrique dilué à 0,5% pendant 4 min pour éliminer le mince oxyde natif dans les zones vitrées mais pour conserver les masques SiO2 . Ensuite, chargez sur une chambre de dépôt chimique en phase vapeur sous ultravide (UHV-CVD) pour développer du Ge. La figure 2 montre le système UHV-CVD utilisé dans le présent travail.
- Croissance épitaxiale de GE
- Chargez le substrat Si avec des masques SEG (fabriqués comme à l’étape 2.1) dans une chambre de verrouillage de charge.
- Réglez la température de croissance de la mémoire tampon/principale dans l’onglet Recette affiché sur l’ordinateur d’exploitation. Déterminer les durées de croissance principale de Ge afin que les couches SEG Ge fusionnent avec les couches adjacentes. Pour décider des durées de la croissance principale, considérons le taux de croissance de Ge sur les plans {113}, qui détermine la croissance dans la direction dans le plan / latéral26. Dans le présent travail, fixer les durées de la croissance principale à 270 min et 150 min pour 650 °C et 700 °C, respectivement.
- Cliquez sur Démarrer dans la fenêtre principale, puis le substrat Si est automatiquement transféré dans la chambre de croissance.
NOTE: Le protocole sur la croissance épitaxiale de Ge (étapes 2.2.4-2.2.7) est automatiquement traité. - Cultiver le tampon Ge sur le substrat de Si chargé à basse température (≈380 °C). Utiliser GeH 4 dilué à 9% dans Ar comme gaz source et maintenir la pression partielle de GeH4 pendant 0,5 Pa pendant la croissance tampon.
- Cultiver la couche principale de Ge à une température élevée. Maintenir la pression partielle de GeH4 pendant 0,8 Pa pendant la croissance principale. Dans le présent travail, utiliser deux températures différentes de 650 et 700 °C pour la température de croissance principale afin de comparer SEG Ge avec une section transversale de forme ronde et avec une section transversale à {113} facettes25.
NOTE: Le taux de croissance de Ge sur le plan (001) était de 11,7 nm/min indépendamment de la température. - Afin de visualiser l’évolution du SEG Ge et leur coalescence, effectuer la croissance de Ge avec insertion périodique de couches de démarcation Si 0,3 Ge0,7de 10 nm d’épaisseur sur un autre substrat Si. Des couches de Si0,3 Ge 0,7ont été formées à l’aide de gaz Si2H6 et GeH4. Au cours de la croissance de la couche de Si0,3Ge 0,7, régler la pression partielle du gaz Si2H6 à 0,02 Pa et la pression partielle du gaz GeH4 à0,8 Pa.
- Comme le substrat de Si est automatiquement transféré de la chambre de croissance à la chambre de verrouillage de charge, évacuez la chambre de verrouillage de charge et déchargez le substrat Si manuellement.
- Mesures de densité de fosse de gravure (EPD)
- Dissoudre 32 mg deI2 dans 67 mL deCH3COOH à l’aide d’une machine de nettoyage à ultrasons.
- Mélanger le COOHCH3dissous I2, 20 mL de HNO3 et 10 mL de HF.
- Trempez les substrats de Si cultivés en Ge-S dans la solutionCH3COOH/HNO3/HF/I2 pendant 5-7 s afin de former des noyaux gravés.
- Observez les surfaces Ge gravées avec un microscope optique (généralement 100x) pour vous assurer que les fosses gravées sont formées avec succès.
- Utilisez un microscope à force atomique (AFM) pour compter les fosses gravées. Placez l’échantillon Ge gravé sur une platine AFM, puis approchez la sonde en cliquant sur l’approche automatique.
- Décidez de la zone d’observation à l’aide d’un microscope optique intégré à un AFM et balayez cinq zones différentes de 10 μm x 10 μm. Le facteur d’amortissement d’amplitude est déterminé automatiquement.
- Observations TEM
- Prélever des échantillons TEM dans les couches de Ge coalescées/matelassées à l’aide d’un faisceau d’ions Ge focalisé (méthode de microéchantillonnage FIB)27.
- Polir les échantillons TEM dans un système de broyage ionique à l’aide d’ions Ar. Dans le présent travail, éclaircir les échantillons TEM pour que les observations en coupe transversale soient de 150 à 500 nm dans la direction [110] et pour les observations en vue en plan à 200 nm dans la direction [001].
- Pour les spécimens TEM en plan, protéger les surfaces supérieures des couches Ge avec des couches amorphes, puis amincir du côté inférieur (substrat) des couches Ge.
- Effectuer des observations TEM sous une tension d’accélération de 200 kV. Effectuer des observations transversales de TEM à balayage en champ clair (STEM) afin d’observer des échantillons TEM épais (500 nm).
- Pour un Ge fusionné avec des couches de démarcation Si0,3 Ge0,7, effectuer des observations STEM en champ noir annulaire à angle élevé (HAADF) en coupe transversale sous une tension d’accélération de 200 kV.
Résultats
Calcul théorique
La figure 3 montre les trajectoires calculées des TD dans 6 types de couches Ge coalescées : ici, nous définissons le rapport d’ouverture (APR) comme étant W fenêtre/(Wfenêtre +W masque). La figure 3a montre un GE de forme ronde d’origine SEG coalescé Ge de TAEG = 0,8. Ici, 2/6 TDs sont piégés. La figure 3b montre un GE fusionné d’origine SEG à {113} facettes de l’APR = 0,8. Ici, 0/6 TDs sont piégés. La figure 3c montre un GE de forme ronde d’origine SEG coalescé de TAEG = 0,1. Ici, 5/6 TDs sont piégés. La figure 3d montre un Ge fusionné d’origine SEG à {113} facettes de TAEG = 0,1. Ici, 6/6 TDs sont piégés. La figure 3e montre un Ge fusionné d’origine SEG de forme ronde de TAEG = 0,1, au cas où Ge se développerait sur des masques SiO2. Ici, 0/6 TDs sont piégés. La figure 3f montre un Ge fusionné d’origine SEG à facettes {113} de l’APR = 0,1, au cas où Ge se développerait sur des masques SiO2. Ici, 0/6 TDs sont piégés.
Les trajectoires de 6 TD générées à (x 0, 0), où x 0 = 0,04, 0,1, 0,2, 0,4, 0,6 et 0,8 fois Wfenêtre/2, sont indiquées par des lignes rouges dans chaque figure. Les TD situés au-dessus des points de coalescence de ces deux couches SEG Ge se propagent vers le haut vers la surface supérieure, tandis que les TD situés au-dessous des points se propagent vers le bas pour rester à la surface du vide sur le masque SiO2.
Dans la figure 3a-3d, on suppose que SEG Ge ne croît pas sur SiO2. Ainsi, les parois latérales du SEG Ge à {113} facettes sont supposées être de forme ronde afin de ne pas toucher la zone masquée SiO2. Il est clairement démontré que le SEG de forme ronde puis le Ge coalescé sont plus efficaces pour réduire le TDD à un TAEG de 0,8 que le cas à facettes {113}, tandis que le Ge à facettes {113} puis coalescé sont plus efficaces qu’un Ge de forme ronde à un TAEG de 0,1. Ce « croisement » est attribué à la présence de {113} facettes près du sommet du SEG : {113} facettes sont plus déviées de la direction [001] que les surfaces de forme ronde.
La figure 3e et la figure 3f montrent le Ge fusionné à un rapport d’ouverture de 0,1, en supposant que Ge n’est pas nucléé sur SiO 2 mais montre un mouillage avec le masque SiO2, largement rapporté dans la coalescenceGe 13,15,22,28,29,30,31. Comme le montrent les figures 3e et 3f, il n’y a pas de vide semi-cylindrique entre deux SEG et donc aucun TD n’est piégé à la surface.
La figure 4 montre les DJT calculées en Ge coalescé. Dans la figure 4, la ligne rouge montre les DJT calculées dans le Ge coalescé provenant du SEG Ge de forme ronde, et la ligne bleue montre les DTS calculés dans le Ge coalescé provenant du SEG Ge à facettes {113}. Étant donné que les TD dans Ge sur Si proviennent de l’inadéquation du réseau entre Ge et Si, on suppose que la génération de TD ne se produit qu’aux interfaces entre Ge et Si. En d’autres termes, le TDD devrait être réduit avec APR.
Lorsque le TAEG est supérieur à 0,11, le SEG Ge de forme ronde est plus efficace que le SEG à facettes {113} (Figure 3a et Figure 3b). En revanche, lorsque le TAEG est inférieur à 0,11, le SEG Ge à {113} facettes devient plus efficace que le SEG de forme ronde (Figure 3c et Figure 3d). Comme sur la figure 3, un tel croisement est attribué à la présence de facettes {113} près du sommet du SEG (x 0≈ 0). Notez que la figure 3e et la figure 3f correspondent à la ligne noire de la figure 4, montrant la réduction du TDD par rapport à la réduction du TAEG, mais pas à la coalescence (c.-à-d. que le mouillage SEG Ge avec SiO2 a un effet négatif sur la réduction du DTS).
Vérification expérimentale
La figure 5 montre des images typiques de microscopie électronique à balayage (MEB) en coupe transversale (figure 5b-5d, 5f) et les cartes de distribution (figures 5a, 5e) montrant si la coalescence se produit ou non. Les figures 5b-5d, 5f montrent des images SEM en coupe transversale de couches GE SEG non coalescées (figure 5b, cultivées à 700 °C; Figure 5f, cultivée à 650 °C), couches de SEG Ge coalisées avec une surface supérieure non plane (figure 5c, cultivée à 700 °C) et couches de SEG Ge coalisées avec une surface supérieure plane (figure 5d; cultivée à 700 °C). Les images MEB illustrées à la figure 5b et à la figure 5d sont polies par un faisceau d’ions focalisés après dépôt des couches de protection du Pt. La coalescence se produit lorsque lafenêtre W et lemasque W sont inférieurs à 1 μm pour les conditions de croissance actuelles. Les masques SEG avecmasque W de 1 μm ou plus empêchent la coalescence de Ge en raison de la faible quantité de croissance de Ge dans le sens latéral26. Les masques SEG avec une fenêtre W de 2 μm ou plus empêchent également la coalescence de Ge, bien que la coalescence ait eu lieu lorsque lafenêtre W est inférieure à 1 μm. En effet, le taux de croissance latérale de Ge sur SiO2 dépend de lafenêtre W 30. La dépendance du masque et de la fenêtre est résumée à la figure 7a (700 °C) et à la figure 7e (650 °C).
En comparant les couches de SEG Ge non coalescées (Figure 4b et Figure 4f), on montre clairement que la couche de SEG Ge cultivée à 700 °C a une section transversale de forme ronde tandis que la couche de SEG Ge cultivée à 650 °C a une section transversale à {113} facettes. Comme dans la figure 5b, la croissance à 700 °C montre un SEG Ge de forme ronde sans croissance de Ge sur SiO 2 (c’est-à-dire pas de mouillage avec le masque SiO2). Par conséquent, la croissance se déroule comme Figure 3a et Figure 3c. D’autre part, comme sur la figure 5f, un SEG Ge à {113} facettes apparaît à 650 °C. Il est fortement suggéré que le Ge montrerait du mouillage avec le masque SiO2. En revanche, le bord est de forme ronde (c’est-à-dire qu’il ne mouille pas). Par conséquent, la croissance à 650 °C se situe entre la figure 3b (pas de mouillage) et la figure 3f (mouillage parfait). Cela indique que la réduction du TDD devrait se situer entre la figure 3b et la figure 3f. Compte tenu des résultats théoriques présentés à la figure 6, ces différences dans les sections efficaces SEG Ge devraient fortement influencer les TDD dans les couches de Ge coalescentes.
La différence de croissance mouillante sur SiO2 peut être comprise comme suit. L’angle de contact entre Ge etSiO2 (θ) est déterminé par l’équation de Young :

Ici, γ SiO2, γ Ge et γint sont respectivement l’énergie de surface SiO 2, l’énergie libre de surface Ge et l’énergie libre interfaciale Ge/SiO2. L’angle de la paroi latérale SEG Ge devient plus grand à mesure que la croissance de Ge se poursuit. Lorsque l’angle de la paroi latérale SEG Ge atteint l’angle de contact θ, le SEG Ge doit croître dans le sens vertical ([001]) ou latéral ([ ]). Dans le cas d’une croissance à 650 °C, la croissance verticale est sévèrement limitée par les facettes {113}, et SEG Ge préfère donc croître dans le sens latéral (c’est-à-dire la croissance mouillante). Même si le mouillage pourrait générer des dislocations à l’interface Ge et SiO2, il doit finalement être terminé à la surface du vide semi-cylindrique. Dans le cas d’une croissance de 700 °C, Ge peut croître verticalement, et l’angle de contact est plus grand que celui de 650 °C en raison d’une γ int plus grande. Ce serait la raison pour laquelle le Ge cultivé à 650 °C montre un mouillage sur SiO2 alors que le Ge cultivé à 700 °C ne le fait pas.
]). Dans le cas d’une croissance à 650 °C, la croissance verticale est sévèrement limitée par les facettes {113}, et SEG Ge préfère donc croître dans le sens latéral (c’est-à-dire la croissance mouillante). Même si le mouillage pourrait générer des dislocations à l’interface Ge et SiO2, il doit finalement être terminé à la surface du vide semi-cylindrique. Dans le cas d’une croissance de 700 °C, Ge peut croître verticalement, et l’angle de contact est plus grand que celui de 650 °C en raison d’une γ int plus grande. Ce serait la raison pour laquelle le Ge cultivé à 650 °C montre un mouillage sur SiO2 alors que le Ge cultivé à 700 °C ne le fait pas.
Pour le Ge après coalescence, la structure transversale n’est pas influencée par la température de croissance: les couches de Ge coalescentes cultivées à 650 °C et celles cultivées à 700 °C n’ont pas pu être différenciées par des observations SEM transversales.
Notez que pour les motifs fabriqués, les valeurs defenêtre W étaient plus grandes et les valeurs de masque W étaient plus petites que celles conçues parce qu’un processus de gravure humide isotrope a été utilisé pour fabriquer lemasque . Les valeurs réelles de lafenêtre W et dumasque W ont été obtenues par observations SEM transversales après croissance de Ge.
En plus de cela, l’épaisseur des couches de masque SiO2 était de 30 nm selon les observations SEM transversales et les mesures d’ellipsométrie spectroscopique. Ces couches minces de SiO2 ont été utilisées pour examiner la réduction de la DJT expliquée à la figure 3 et à la figure 4, éliminant ainsi l’effet du cou épitaxial sur le TAR. Dans le présent travail, les rapports d’aspect sont inférieurs à 0,05, ce qui est suffisamment faible pour ignorer l’effet du cou épitaxial sur le TAR.
La figure 6a montre une section transversale de la tige HAADF pour un SEG avec des couches de démarcation Si 0,3 Ge 0,7, et une illustration schématique de la figure 6a est présentée à la figure 6b (fenêtre W = 0,66 μm,masque W = 0,84μm). Les couches de démarcation Si0,3 Ge 0,7montrent clairement les formes de surface pendant la croissance à 700 °C. L’image STEM montre les surfaces Ge de chaque étape de croissance, du SEG de forme ronde à une couche épitaxiale plate formée après la coalescence. Le taux de croissance juste après coalescence est fortement amélioré dans les zones coalescentes. Cette croissance rapide est probablement induite par l’épicouche de Ge, minimisant sa surface pour se stabiliser énergétiquement.
Contrairement au Ge SEG pur, le Ge SEG présenté avec les couches de démarcation Si0,3 Ge 0,7montre un mouillage avec les masques SiO2 (Figure 8a). La différence de mouillage est peut-être due à l’insertion de couches de démarcation Si0,3 Ge0,7, dont la nucléation est renforcée sur les couchesSiO2 peu probable que celle de Ge.
Des Ge coalescents à sommet plat (zones encerclées en bleu sur les figures 5a et 5e) sont utilisés pour les mesures EPD. Les couches Ge ont été gravées en moyenne de 200 nm. Les images AFM typiques après gravure sont montrées à la figure 7a et à la figure 7b, prises pour le Ge coalescé de 1,15 μm d’épaisseur cultivé à 700 °C (fenêtre W = 0,66 μm etmasque W = 0,44 μm) et le Ge coalescé de 2,67 μm d’épaisseur cultivé à 650 °C (fenêtre W = 0,66 μm etmasque W = 0,34 μm). À titre de référence, l’image de la couverture Ge de 1,89 μm d’épaisseur cultivée à 700 °C est représentée à la figure 7c. Les points sombres dans les images AFM sont des fosses gravées indiquant la présence de TD. Les valeurs EPD de la figure 7a-7c ont été obtenues pour être de 7,0 x 10 7/cm 2, 7,9 x 10 7/cm 2 et 8,7 x 10 7/cm 2, respectivement. Nos rapports précédents ont montré que les EPD obtenues dans cette condition de gravure sont égales aux TDD déterminées par microscopie électronique à transmission en vue en plan (MET)4,32,33,34. L’EPD mesurée de la couche Ge de couverture (7,9 ± 0,8 x 10 7/cm 2) concorde bien avec la DJT obtenue à partir de l’observation TEM en vue en plan avec une surface relativement grande de 6 x 8 μm 2 (8,7 ± 0,2 x 107/cm 2), indiquant que la DEP est égale à la DJT.
Afin de comparer les DJT obtenus expérimentalement avec les calculs, prendre en compte l’effet de l’épaisseur sur les TDD. Il y a une tendance selon laquelle le TDD diminue à mesure que l’épaisseur de Ge augmente en raison des risques accrus d’annihilation de la paire de TD. Par conséquent, la réduction de la DJT observée pour le Ge coalescé, plus mince que le Ge global, doit être attribuée au mécanisme décrit à la figure 3 et à la figure 4 (c.-à-d. que nous devons calculer le TDD normalisé pour comparer les TDD obtenus expérimentalement avec ceux calculés à la figure 4). Avant la normalisation, une correction de la DJT pour la couverture Ge (couverturep) a été effectuée, en tenant compte de l’épaisseur et de la température de croissance sur la DJT. Comme dans les rapports précédents35,36, ρcouverture [/cm 2] est approximativement exprimée comme suit :2,52 x 1013 x [d (nm)]-1,57 pour les couches de Ge cultivées dans la plage de température comprise entre 530 et 650 °C à l’aide d’un CVD-UHV. Ici, d est l’épaisseur de la couche Ge de couverture. ρcouverture [/cm2] est réduite pour les couches Ge cultivées à 700 °C et approximativement exprimée en 2,67 x10 12 x [d (nm)]-1,37.
La figure 7d montre le TDD normalisé en fonction de APR, W fenêtre/(Wfenêtre +W masque). Les DTS dans les GE coalescés cultivés à 650 °C sont représentés par des triangles bleus et ceux cultivés à 700 °C par des diamants rouges. Étant donné que le SEG Ge à 650 °C montre un certain mouillage avec le masque SiO2, les données de croissance devraient se situer entre les lignes noires et bleues. SEG Ge à 700 °C devrait être sur la ligne rouge. Les résultats expérimentaux sont en bon accord avec le calcul basé sur la forme transversale et les conditions de mouillage.
Comme décrit ci-dessus, il est conclu que le comportement des TD est bien expliqué par le modèle basé sur la force d’image des surfaces de croissance sur les TD. Afin de comprendre l’interaction de la TD avec la surface, nous avons observé des TD avec un STEM transversal en champ clair. Un défaut est observé courbé et terminé sur une surface d’un vide semi-cylindrique sur la figure 8a. Ce comportement du TD est assez similaire aux trajectoires calculées des TD illustrées à la figure 3. Cependant, la trajectoire observée de la diarrhée du voyageur ne reproduit pas exactement celle que nous avions prédite à la figure 3. La différence s’expliquerait comme le résultat d’une transformation TD afin de minimiser son énergie pendant ou après la croissance (p. ex., diminution de la température de la température de croissance à la température ambiante). La figure 8b montre une simulation de déformation dans l’épicouche Ge coalescée sur Si. Une déformation de traction est induite dans la couche Ge sur Si en raison de l’inadéquation du coefficient de dilatation thermique entre Ge et Si. La simulation indique que l’accumulation de déformation se produit au sommet des vides semi-cylindriques et la relaxation de la déformation à la couche souterraine des vides semi-cylindriques, ce qui motiverait les TD à se transformer.
D’autre part, la figure 8c montre la génération de défauts au sommet d’un vide, bien que le point de génération soit supprimé lors de la préparation de l’échantillon TEM. Le défaut de la figure 8c est proche d’une ligne droite, mais l’angle entre le défaut et le plan (001) (≈78,3°) ne correspond pas à celui du plan {111} (54,7°).
Le diagramme de diffraction électronique représenté à la figure 8d a été obtenu près du défaut de la figure 8c. L’absence de lumière traînée indique qu’il ne devrait pas y avoir de structure 2D (c.-à-d. que le défaut est une luxation). Dans les rapports précédents 28,29,30,31,37, des défauts 2D ont été formés montrant clairement une lumière de traînée dans les diagrammes de diffraction électronique, ce qui est contraire à celui observé dans le présent travail. Les résultats de l’observation (l’absence de défauts 2D) soutiennent la prédiction que les vides et leurs surfaces libres contribuent à libérer la déformation dans Ge sur Si, ou causent autrement les désorientations cristallines entre les couches SEG Ge adjacentes. Ceci est cohérent avec un rapport précédent suggérant brièvement que la formation de défauts 2D est empêchée dans les couches SEG Ge coalescées avec des vides sur les masques SiO2 38.
Il y a deux candidats pour la génération TD illustrée à la figure 10c : la distribution de la déformation et la désorientation entre les couches SEG Ge. Dans le Ge épitaxial sur Si, la déformation de traction est induite dans Ge en raison de l’inadéquation du coefficient de dilatation thermique entre Ge et Si39. Le résultat de la simulation illustré à la figure 8b indique une accumulation de déformation de traction (~0,5%) au sommet du vide comme mentionné ci-dessus. Une telle accumulation de déformation au sommet du vide pourrait entraîner la génération de TD illustrée à la figure 8c. Un autre candidat, la désorientation entre les couches de SEG Ge, a été supposé générer des défauts 2D comme observé dans les rapports précédents montrant la coalescence des couches SEG Ge 28,29,30,31,37. Dans le présent travail, cependant, la génération de défauts 2D serait supprimée en raison de la présence de vides comme brièvement mentionné dans un rapport précédent38, mais entraînerait la génération de TD en raison d’une suppression imparfaite. Une discussion plus détaillée de la dislocation induite par la désorientation sera décrite dans une partie ultérieure avec des illustrations schématiques (figure 12).
La figure 9a et la figure 9b montrent des images TEM en plan en champ clair d’une couche de Ge coalescée (fenêtre W = 0,82 μm,masque W = 0,68 μm) et d’une couche de Ge de couverture, respectivement, cultivées sur le même substrat. Pour les observations TEM en plan, les spécimens TEM ont été formés en utilisant les régions supérieures de 200 nm des couches Ge décrites à l’étape 2.4.3 et sont indiquées par des carrés pointillés rouges dans les coupes transversales schématiques au sommet de la figure 9. Les bandes de masque SiO2 sont alignées sur la direction [110] pour le Ge fusionné de la figure 9a. L’image TEM en plan illustrée à la figure 9a a été prise pour une zone de 6 μm x 8 μm. Bien qu’il y ait cinq paires de masques SiO 2 et de zones de fenêtre Si dans cette image TEM, les zones au-dessus des masques SiO2 et des fenêtres Si ne sont pas distinguables dans l’image TEM. En effet, la zone observée (200 nm supérieurs) est bien au-dessus de l’endroit où se trouvent les vides semi-cylindriques (150 nm inférieurs).
On constate que les DJT obtenus à partir de la figure 9a et de la figure 9b sont respectivement de 4,8 x 10 7/cm 2 et de 8,8 x 107/cm2. Comme le montre la figure 7d, les mesures EPD révèlent que le TDD dans la couche de Ge coalescée (fenêtre W = 0,82 μm etmasque W = 0,68 μm) est de 4 x 107 cm−2. Ainsi, le TDD de la figure 9a montre un bon accord avec l’EPD illustré à la figure 7. Il convient également de noter que ni les mesures EPD ni les observations TEM ne montrent de réaugmentation de la DJT, ce qui est fréquemment démontré lorsque les couches de GE SEG fusionnent (c’est-à-dire que la réaugmentation de la DJT due à la génération de DT (figure 8b) est supprimée à un point tel que la réaugmentation de la DJT est ignorable dans la plage actuelle de DJT (de l’ordre de 107/cm2)).
Il convient de noter qu’une surface exempte de TD aussi grande que 4 μm x 4 μm est réalisée dans le Ge coalescé, comme sur la figure 9a. Bien que la couverture Ge de la figure 9b montre des DT avec une distribution relativement uniforme, le Ge coalescé a des zones TDD élevées et faibles. De telles différences dans la distribution de la diarrhée du voyageur donnent à penser qu’une réduction supplémentaire de la DJT serait possible dans le GE coalescé. 1 TD dans une zone de 4 μm x 4 μm, ce qui est observé sur la figure 9a, correspond à un TDD de 6,25 x 106/cm2.
Si l’on compare le Ge coalescé (figure 9a) et le Ge de couverture (figure 9b), il est clair que les longueurs des droites de défaut dans le Ge coalescé sont plus longues que celles du Ge de couverture. Dans le Ge coalescé, il existe généralement des lignes de défaut de 1 μm de long, et elles sont alignées sur la direction [110]. Notez que la direction [110] est la direction de longueur des bandes SiO2. Il y a deux explications possibles à ces longues lignes de défauts: (i) des défauts 2D sont observés et (ii) des dislocations sont inclinées dans la direction [110]. Cependant, les défauts 2D sont immédiatement refusés en raison de la largeur des défauts longs observés (c’est-à-dire que les défauts 2D sur {111} plans doivent montrer des lignes de défaut plus larges). Géométriquement, les défauts 2D sur les plans {111} doivent montrer des lignes de défaut de 140 nm de large, en tenant compte de l’épaisseur de l’échantillon TEM (200 nm) et de l’angle de la {111} avec les plans (001) (54,7°). L’image TEM en plan-vue montre que les lignes de défaut ont une largeur de 10 à 20 nm, ce qui est beaucoup plus étroit que 140 nm. Ainsi, les défauts représentés comme de longues lignes doivent être attribués à (ii) des dislocations inclinées dans la direction [110]. Un calcul géométrique simple donne l’angle entre les dislocations inclinées et les plans (001) : tan−1(200 nm/1 μm) = 11,3°. Il convient de noter que, comme le montre la figure 8b, les TD de la couverture Ge ont tendance à être dirigés presque verticalement vers le substrat si aucun recuit post-croissance n’est effectué, montrant de petits points noirs dans les images TEM en plan.
Pour une analyse plus détaillée des TD inclinées, une petite zone avec un TDD élevé est observée arbitrairement comme dans la figure 10. Le spécimen TEM a été préparé à partir des 200 nm supérieurs de la couche de Ge coalescée, comme les observations TEM en plan ci-dessus.
La figure 10a et la figure 10b montrent des images TEM en champ noir (g = [220] pour la figure 12a et [] pour la figure 12b) prises à la même zone. Dans la figure 12, quatre dislocations inclinées ont été observées dans une zone de 4 μm x 4 μm. La figure 10b révèle qu’une dislocation inclinée (la luxation entourée de rouge) disparaît lorsque le vecteur de diffraction g = [], ce qui indique que le vecteur de Burgers est déterminé comme étant [110] ou [
figure 12b) prises à la même zone. Dans la figure 12, quatre dislocations inclinées ont été observées dans une zone de 4 μm x 4 μm. La figure 10b révèle qu’une dislocation inclinée (la luxation entourée de rouge) disparaît lorsque le vecteur de diffraction g = [], ce qui indique que le vecteur de Burgers est déterminé comme étant [110] ou [
 ] pour la dislocation entourée de rouge. Étant donné que la ligne de défaut est dans la direction [110], la dislocation est considérée comme une luxation de vis. Les trois autres dislocations inclinées (entourées de vert) sont attribuées aux dislocations mixtes parce qu’elles n’ont pas disparu quel que soit le vecteur de diffraction g choisi.
] pour la dislocation entourée de rouge. Étant donné que la ligne de défaut est dans la direction [110], la dislocation est considérée comme une luxation de vis. Les trois autres dislocations inclinées (entourées de vert) sont attribuées aux dislocations mixtes parce qu’elles n’ont pas disparu quel que soit le vecteur de diffraction g choisi.
Il y a deux explications possibles à l’inclinaison des TD dans les couches de Ge coalescées: (i) la croissance de Ge dans la direction [110] et (ii) la génération de défauts lorsque les couches de GE SEG fusionnent.
Croissance de Ge dans le sens [110]
La figure 11 montre une image SEM en plan-vue et le processus de croissance pour former une couche épitaxiale plate à partir d’une surface SEG non plane sous forme de film schématique. Reflétant l’ondulation des bords des motifs de bandes SiO 2 formés par la lithographie EB et la gravure chimique humide, la coalescence commence préférentiellement en certains points, puis se poursuit dans les directions [110] et [ ] au-dessus des masques SiO2. Les figures 11b et 11c montrent schématiquement la vue à vol d’oiseau et la vue en coupe transversale (
] au-dessus des masques SiO2. Les figures 11b et 11c montrent schématiquement la vue à vol d’oiseau et la vue en coupe transversale ( ) lorsque les couches SEG Ge sont partiellement fusionnées. Un TD généré à une fenêtre de croissance apparaît au-dessus du vide comme illustré à la figure 3, puis les TD commencent à se propager dans la direction [110] ou [
) lorsque les couches SEG Ge sont partiellement fusionnées. Un TD généré à une fenêtre de croissance apparaît au-dessus du vide comme illustré à la figure 3, puis les TD commencent à se propager dans la direction [110] ou [ ] en raison de la force de l’image. Cela conduit à des TD inclinés dans la direction [110] (comme dans la figure 9a). La ligne continue rouge de la figure 11c montre une TD courbée dans la direction [110] selon le modèle ci-dessus, ce qui explique la présence des TD inclinées observées sur une base qualitative sur la figure 9a et la figure 10.
] en raison de la force de l’image. Cela conduit à des TD inclinés dans la direction [110] (comme dans la figure 9a). La ligne continue rouge de la figure 11c montre une TD courbée dans la direction [110] selon le modèle ci-dessus, ce qui explique la présence des TD inclinées observées sur une base qualitative sur la figure 9a et la figure 10.
Le mécanisme peut expliquer à la fois les TD de bord et de vis, en tenant compte des vecteurs Burgers des TD générés aux interfaces Ge/Si40. Lorsque Ge est cultivé sur un substrat Si, des luxations d’ajustement des bords (DM) se forment pour libérer la déformation, et les DM sont alignés dans la direction [110] ou [ ]. Les MD forment des segments de filetage (c.-à-d. TD), et les vecteurs de Burgers pour les TD provenant de MD alignés dans la direction [110] (MD110) sont a/2[] ou a/2[
]. Les MD forment des segments de filetage (c.-à-d. TD), et les vecteurs de Burgers pour les TD provenant de MD alignés dans la direction [110] (MD110) sont a/2[] ou a/2[
 ] (a : la constante de réseau). D’autre part, les vecteurs de Burgers sont a/2[110] ou a/2[] pour les TD provenant de MDs alignés dans la direction [
] (a : la constante de réseau). D’autre part, les vecteurs de Burgers sont a/2[110] ou a/2[] pour les TD provenant de MDs alignés dans la direction [
 ] (
] ( ). Dans le cas où les TD de MD 110 sont inclinées dans la direction [110], les observations TEM en plan-vue montrent que les TD sont des dislocations de bord. De même, lorsque les TD de
). Dans le cas où les TD de MD 110 sont inclinées dans la direction [110], les observations TEM en plan-vue montrent que les TD sont des dislocations de bord. De même, lorsque les TD de  sont inclinés vers la direction [110], ils sont observés comme des luxations de vis.
sont inclinés vers la direction [110], ils sont observés comme des luxations de vis.
Génération de défauts lorsque les couches SEG Ge fusionnent
La figure 12 montre des schémas expliquant la génération de défauts lorsque les couches SEG Ge fusionnent avec une petite rotation (c.-à-d. une mauvaise orientation). Comme l’illustre schématiquement la figure 12, la désorientation devrait générer des dislocations bord/vis/mélange à l’interface de coalescence. Sur la figure 12, la désorientation entre deux couches SEG Ge dans la direction [110] est décomposée en trois types de rotations. La figure 12a-12c montre la rotation autour de l’axe [110], de l’axe [001] et de l’axe [ ].
].
La coalescence de la figure 12 est supposée se produire entre une couche de Ge strictement épitaxiale (Ge (001)) et une couche de GE SEG adjacente avec une désorientation (m-Ge). La rotation autour de l’axe [110] (figure 12a) entraîne la génération de dislocations de bords parallèles à la direction [110] à la limite indiquée par une ligne pointillée. De même, comme sur la figure 12b, les dislocations d’arêtes parallèles à la direction [001] sont générées par la rotation autour de l’axe [001]. D’autre part, la rotation autour de l’axe [], illustrée à la figure 12c, génère un réseau de dislocation de vis, qui est composé de dislocations de b = [110 ] et b = [ 001], étant similaire au cas de la liaison directe des surfaces Si (001) montrant le réseau de dislocationde vis 41. La vis TD observée à la figure 10 pourrait être attribuée à la coalescence avec désorientation d’une rotation autour de l’axe [
001], étant similaire au cas de la liaison directe des surfaces Si (001) montrant le réseau de dislocationde vis 41. La vis TD observée à la figure 10 pourrait être attribuée à la coalescence avec désorientation d’une rotation autour de l’axe [ ]. La combinaison des rotations autour de l’axe [110] (figure 12a) et autour de l’axe [
]. La combinaison des rotations autour de l’axe [110] (figure 12a) et autour de l’axe [ ] (figure 12c) peut expliquer les TD mixtes illustrés à la figure 12. La dislocation mixte illustrée à la figure 9b s’explique également par la combinaison de la rotation autour de l’axe [001] (figure 12b) et de la rotation sur l’axe [
] (figure 12c) peut expliquer les TD mixtes illustrés à la figure 12. La dislocation mixte illustrée à la figure 9b s’explique également par la combinaison de la rotation autour de l’axe [001] (figure 12b) et de la rotation sur l’axe [ ] (figure 12c).
] (figure 12c).
En supposant que les dislocations provenant de la désorientation sont générées à une densité de 1 x 107/cm2, l’angle moyen de rotation autour de l’axe [ ] est estimé à 0,034° 42. Par rapport à l’estimation, nous avons déjà signalé des fluctuations d’orientation dans une couche SEG Ge en forme de ligne pour 100 secondes d’arc (= 0,028°), en utilisant des observations de diffraction des rayons X par microfaisceau43. Les fluctuations signalées de l’orientation et de l’angle de rotation estimé montrent une bonne concordance, ce qui soutient le mécanisme de génération TD basé sur les désorientations.
] est estimé à 0,034° 42. Par rapport à l’estimation, nous avons déjà signalé des fluctuations d’orientation dans une couche SEG Ge en forme de ligne pour 100 secondes d’arc (= 0,028°), en utilisant des observations de diffraction des rayons X par microfaisceau43. Les fluctuations signalées de l’orientation et de l’angle de rotation estimé montrent une bonne concordance, ce qui soutient le mécanisme de génération TD basé sur les désorientations.

Figure 1 : Illustrations schématiques de masques SEG carrés de ligne et d’espace de 4 mm sur un substrat Si(001). Veuillez cliquer ici pour voir une version agrandie de cette figure.

Figure 2 : Images des pièces d’une machine UHV-CVD ; armoire à gaz, chambre de traitement, chambre de verrouillage de charge et ordinateur de fonctionnement. Veuillez cliquer ici pour voir une version agrandie de cette figure.
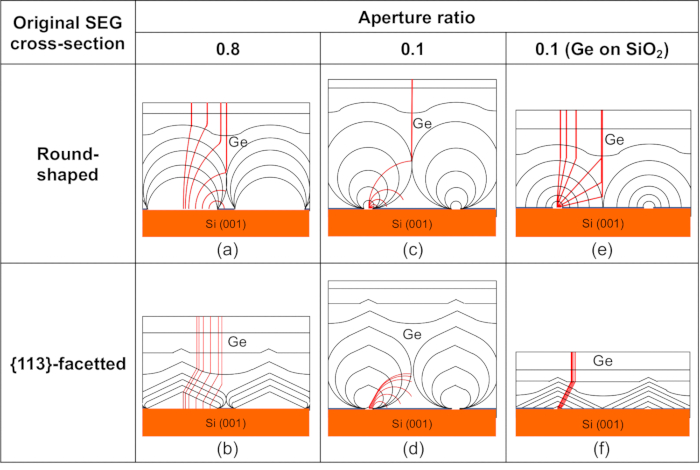
Figure 3 : Trajectoires calculées de 4 TD en (a) origine SEG de forme ronde, rapport d’ouverture = 0,8, (b) origine SEG de forme ronde, rapport d’ouverture = 0,1, (c) origine SEG à facettes {113}, rapport d’ouverture = 0,8, et (d) origine SEG à facettes {113}, rapport d’ouverture = 0,1. Veuillez cliquer ici pour voir une version agrandie de cette figure.
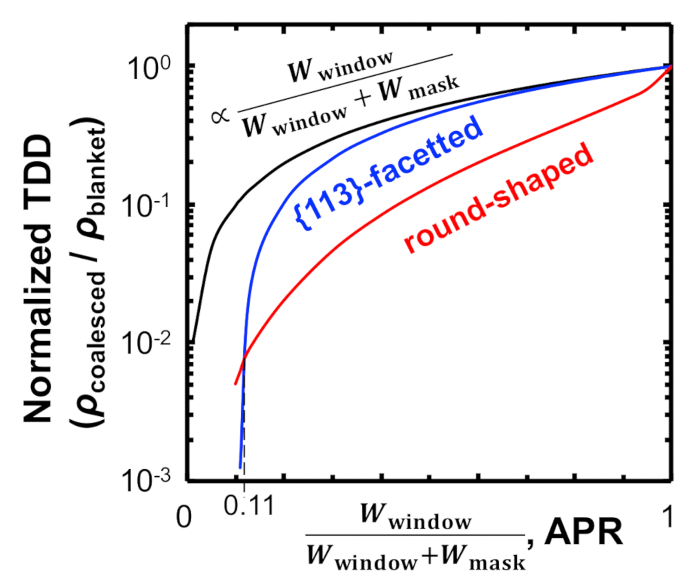
Figure 4 : Les DJT calculées dans le Ge coalescé proviennent du SEG Ge à {113} facettes (ligne bleue) et du SEG Ge de forme ronde (ligne rouge). Veuillez cliquer ici pour voir une version agrandie de cette figure.

Figure 5 : Cartes de distribution et images MEB des couches de GE coalescées/non coalisées. Veuillez cliquer ici pour voir une version agrandie de cette figure.

Figure 6 : a) Une image transversale HAADF STEM de Ge coalescé (fenêtre W = 0,66 μm, masque W = 0,84 μm) cultivé à 700 °C avec des couches de démarcation Si 0,3 Ge0,7 de 10 nm d’épaisseur , et (b) une illustration schématique correspondant aux conditions indiquées en a). Veuillez cliquer ici pour voir une version agrandie de cette figure.

Figure 7: Images AFM typiques pour mesurer les EPD pour (a) Ge coalescé de 1,15 μm d’épaisseur cultivé à 700 °C (fenêtre W = 0,66 μm et masque W = 0,44 μm), (b) Ge coalescé de 2,67 μm d’épaisseur cultivé à 650 °C (fenêtre W = 0,86 μm et masque W = 0,34 μm), et (c) couverture Ge de 1,89 μm d’épaisseur cultivée à 700 °C, et résumé des résultats de mesure EPD en d). Veuillez cliquer ici pour voir une version agrandie de cette figure.
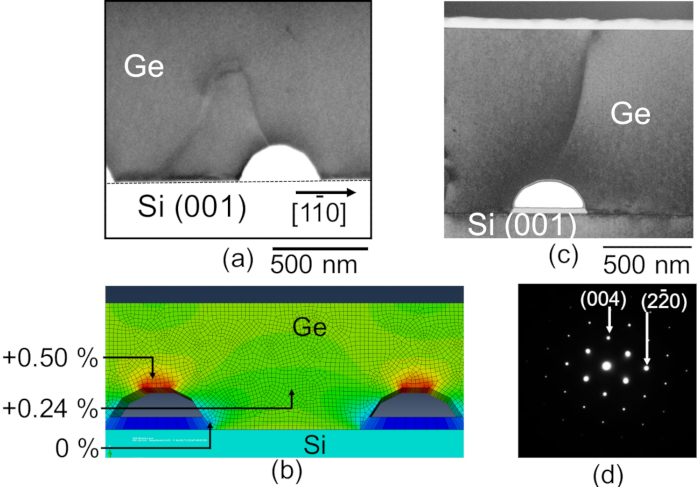
Figure 8:(110) images transversales (a) STEM et (b) TEM de couches Ge coalescées (fenêtre W = 0,66 μm et masque W = 0,44 μm), (c) diagramme de diffraction électronique obtenu près du défaut représenté en (b), et (d) résultat de simulation de la méthode des éléments finis d’une distribution de déformation dans le Ge. Les figures 9 a), c) et d) ont été modifiées par rapport à 20. Veuillez cliquer ici pour voir une version agrandie de cette figure.
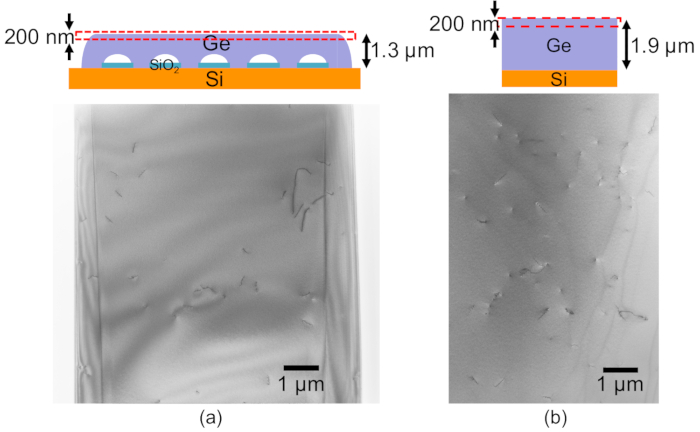
Figure 9 : Images TEM en plan en champ clair (a) d’une couche de Ge fusionnée (fenêtre W = 0,82 μm, masque W = 0,68 μm) et (b) d’une couche Ge de couverture. Veuillez cliquer ici pour voir une version agrandie de cette figure.
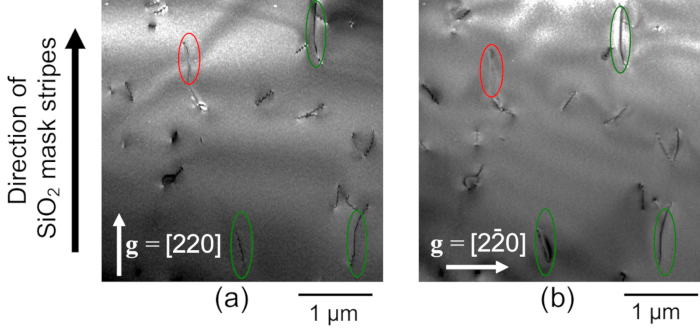
Figure 10: Images TEM en plan d’une petite zone à DRT élevé avec g vecteurs (a) [220] et (b) [ ]. Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour voir une version agrandie de cette figure.
]. Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour voir une version agrandie de cette figure.
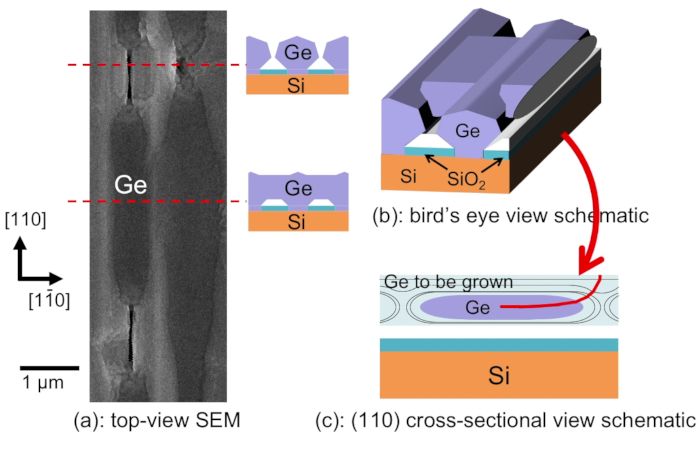
Figure 11 : (a) une image SEM en plan, (b) une image schématique à vol d’oiseau, et (c) une () image schématique en coupe transversale d’un SEG Ge partiellement fusionné. Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour télécharger cette vidéo.
Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour télécharger cette vidéo.
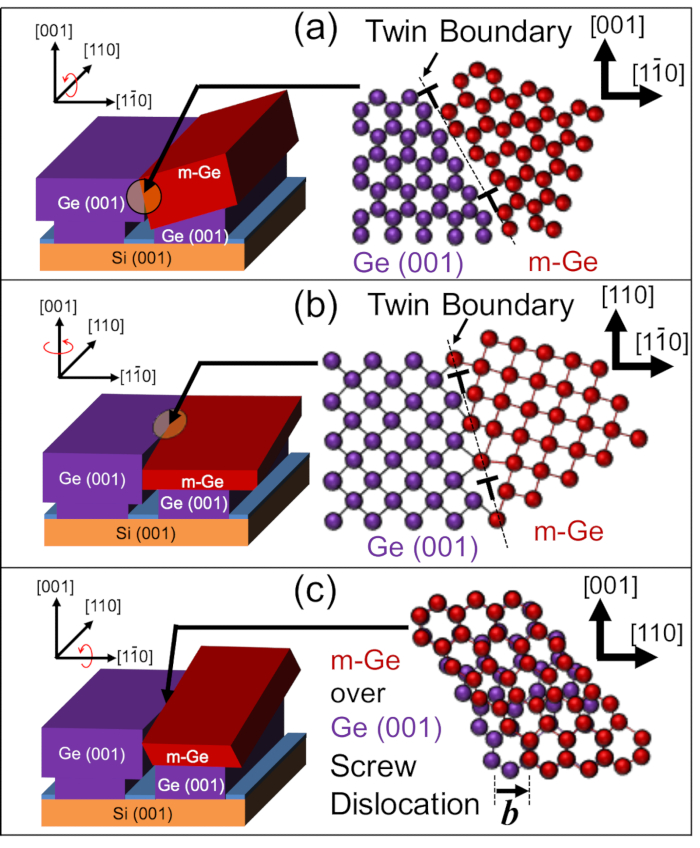
Figure 12 : Schémas de la génération de défauts lorsque les couches SEG Ge fusionnent avec la rotation des cristaux autour de l’orientation (a) [110], (b) [001] et (c) [ ]. Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour voir une version agrandie de cette figure.
]. Ce chiffre a été modifié par rapport à 20. Veuillez cliquer ici pour voir une version agrandie de cette figure.
| Méthode | ATS atteint (cm-2) | Température (°C) | Épaisseur de la couche tampon |
| Recuit thermique | 2e7 | ≈900 °C | ≈100 nm (tampon basse température) |
| Tampon gradué SiGe | 1e6 | température de croissance (600–700 °C) | 2–3 μm |
| ART | 1e6 | température de croissance (600–700 °C) | 500–1000 nm |
| Graines de pilier Si | 1e5 | ≈800 °C | ≈5 μm |
| Ce travail | 4e7 | température de croissance (700 °C) | ≈150 nm |
Tableau 1 : Résumé des ATS obtenus et des inconvénients en vue de l’application des dispositifs photoniques pour les méthodes de réduction des DJT conventionnelles/présentées.
Figure supplémentaire 1 : Quatre méthodes typiques largement utilisées pour réduire la DJT dans le Ge épitaxial sur le Si : (a) le recuit thermique, (b) le tampon classé SiGe, (c) le piégeage du rapport d’aspect (ART) et (d) les semences piliers Si. Veuillez cliquer ici pour télécharger cette figure.
Vidéo supplémentaire 1: Illustrations schématiques d’un TD courbé en raison de la force de l’image dans un SEG Ge de forme ronde. Veuillez cliquer ici pour télécharger cette vidéo.
Discussion
Dans le présent travail, des TDD de 4 x 107/cm2 ont été montrés expérimentalement. Pour une réduction supplémentaire du TDD, il y a principalement 2 étapes critiques dans le protocole: la préparation du masque SEG et la croissance épitaxiale de GE.
Notre modèle illustré à la figure 4 indique que le TDD peut être réduit en dessous de 107/cm2 dans le Ge coalescé lorsque le TAEG, Wfenêtre/(Wfenêtre +W masque), est aussi petit que 0,1. Pour réduire davantage le TDD, des masques SEG avec un APR plus petit doivent être préparés. Comme mentionné à l’étape 2.1.2, les valeurs minimales de lafenêtre W et dumasque W étaient respectivement de 0,5 μm et 0,3 μm, limitées par la résolution dans le système de lithographie EB utilisé. Une méthode simple pour réduire l’APR consiste à modifier les processus de lithographie et de gravure (par exemple, utiliser une autre résine photosensible, utiliser un meilleur système de lithographie, utiliser des couches SiO2 plus minces avec une gravure BHF moins profonde, etc.). Le processus de lithographie et de gravure mature permettra d’obtenir des masques SEG plus étroits que 100 nm. Dans le présent travail, des Ge fusionnés avec une surface supérieure plane ont été obtenus lorsque Wmasque≤1 μm. Ainsi, unefenêtre W de 100 nm et unmasque W de 900 nm (APR = 0,1) nous donneront Ge fusionné avec une surface supérieure plane dans les conditions de croissance actuelles.
En plus de cela, la modification de la préparation des masques SEG devrait réduire l’ondulation des bords des masques SEG, ce qui entraînerait la suppression de la désorientation entre les couches SEG Ge. La génération TD lorsque les couches SEG Ge fusionnent (Figure 11) sera supprimée à la suite de la modification de la préparation du masque SEG.
Comme le révèlent les résultats des calculs (figure 3), la suppression de la croissance du Ge sur SiO2 est nécessaire pour réduire le TDD. La suppression de la croissance de Ge sur SiO2 est apportée par modification de l’étape de croissance de Ge (c’est-à-dire élévation de la température de croissance, rotation du masque SEG, introduction de gazH2 et réduction de la pression du gaz GeH 44,45).
La méthode de réduction du DRT proposée/vérifiée dans le présent travail est supérieure aux méthodes existantes en termes d’application pour les dispositifs photoniques Ge (c.-à-d. que la DJT est réduite sans recuit thermique ni couches tampons épaisses). La température maximale du procédé était de 700 °C, qui est la température de croissance, et la hauteur du vide était de ≈ 150 nm. Par rapport aux méthodes existantes, la température maximale est inférieure à la température de recuit (généralement 900 °C)7, et la hauteur du vide est moins profonde que les couches tampons de SiGe (généralement plusieurs μm)10, les tranchées SiO2 pour le TAR (généralement 0,5-1 μm)13 et la couche tampon pour la croissance de Ge sur les piliers de Si (généralement ≈5 μm)18. La comparaison des méthodes conventionnelles/présentées est résumée dans le tableau 1.
Compte tenu de l’empreinte d’un dispositif photonique Ge typique (≈100 μm 2), un TDD inférieur à 106/cm2 et un nombre de TD < 1/dispositif seront l’objectif final. Étant donné que la limite théorique de la DJT pour cette méthode est de 0, une DJT inférieure à 106/cm2 est potentiellement réalisable. Pour atteindre cet objectif, une lithographie et une gravure plus optimisées seront étudiées.
Déclarations de divulgation
Les auteurs n’ont rien à divulguer.
Remerciements
Ce travail a été soutenu financièrement par la Société japonaise pour la promotion de la science (JSPS) KAKENHI (17J10044) du ministère de l’Éducation, de la Culture, des Sports, de la Science et de la Technologie (MEXT), Japon. Les procédés de fabrication ont été soutenus par « Nanotechnology Platform » (projet n° 12024046), MEXT, Japon. Les auteurs tiennent à remercier M. K. Yamashita et Mme S. Hirata, de l’Université de Tokyo, de leur aide concernant les observations TEM.
matériels
| Name | Company | Catalog Number | Comments |
| AFM | SII NanoTechnology | SPI-3800N | |
| BHF | DAIKIN | BHF-63U | |
| CAD design | AUTODESK | AutoCAD 2013 | Software |
| CH3COOH | Kanto-Kagaku | Acetic Acid | for Electronics |
| CVD | Canon ANELVA | I-2100 SRE | |
| Developer | ZEON | ZED | |
| Developer rinse | ZEON | ZMD | |
| EB writer | ADVANTEST | F5112+VD01 | |
| Furnace | Koyo Thermo System | KTF-050N-PA | |
| HF, 0.5 % | Kanto-Kagaku | 0.5 % HF | |
| HF, 50 % | Kanto-Kagaku | 50 % HF | |
| HNO3, 61 % | Kanto-Kagaku | HNO3 1.38 | for Electronics |
| I2 | Kanto-Kagaku | Iodine 100g | |
| Photoresist | ZEON | ZEP520A | |
| Photoresist remover | Tokyo Ohka | Hakuri-104 | |
| Surfactant | Tokyo Ohka | OAP | |
| TEM | JEOL | JEM-2010HC |
Références
- Giovane, L. M., Luan, H. C., Agarwal, A. M., Kimerling, L. C. Correlation between leakage current density and threading dislocation density in SiGe p-i-n diodes grown on relaxed graded buffer layers. Applied Physics Letters. 78 (4), 541-543 (2001).
- Wang, J., Lee, S. Ge-photodetectors for Si-based optoelectronic integration. Sensors. 11, 696-718 (2011).
- Ishikawa, Y., Saito, S. Ge-on-Si photonic devices for photonic-electronic integration on a Si platform. IEICE Electronics Express. 11 (24), 1-17 (2014).
- Cai, Y. Materials science and design for germanium monolithic light source on silicon, Ph.D. dissertation. , Dept. Mater. Sci. Eng., Massachusetts Inst. Technol. Cambridge, MA, USA. (2009).
- Wada, K., Kimerling, L. C. Photonics and Electronics with Germanium. , Wiley. Hoboken, NJ, USA. 294(2015).
- Higashitarumizu, N., Ishikawa, Y. Enhanced direct-gap light emission from Si-capped n+-Ge epitaxial layers on Si after post-growth rapid cyclic annealing: Impact of non-radiative interface recombination toward Ge/Si double heterostructure lasers. Optics Express. 25 (18), 21286-21300 (2017).
- Luan, H. C., et al. High-quality Ge epilayers on Si with low threading-dislocation densities. Applied Physics. Letters. 75 (19), 2909-2911 (1999).
- Nayfeha, A., Chui, C. O., Saraswat, K. C. Effects of hydrogen annealing on heteroepitaxial-Ge layers on Si: Surface roughness and electrical quality. Applied Physics Letters. 85 (14), 2815-2817 (2004).
- Choi, D., Ge, Y., Harris, J. S., Cagnon, J., Stemmer, S. Low surface roughness and threading dislocation density Ge growth on Si (001). Journal of Crystal Growth. 310 (18), 4273-4279 (2008).
- Currie, M. T., Samavedam, S. B., Langdo, T. A., Leitz, C. W., Fitzgerald, E. A. Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing. Applied Physics Letters. 72 (14), 1718-1720 (1998).
- Liu, J. L., Tong, S., Luo, Y. H., Wan, J., Wang, K. L. High-quality Ge films on Si substrates using Sb surfactant-mediated graded SiGe buffers. Applied Physics Letters. 79 (21), 3431-3433 (2001).
- Yoon, T. S., Liu, J., Noori, A. M., Goorsky, M. S., Xie, Y. H. Surface roughness and dislocation distribution in compositionally graded relaxed SiGe buffer layer with inserted-strained Si layers. Applied Physics Letters. 87 (1), 012014(2005).
- Langdo, T. A., Leitz, C. W., Currie, M. T., Fitzgerald, E. A., Lochtefeld, A., Antoniadis, D. A. High quality Ge on Si by epitaxial necking. Applied Physics Letters. 76 (25), 3700-3702 (2000).
- Park, J. S., Bai, J., Curtin, M., Adekore, B., Carroll, M., Lochtefeld, A. Defect reduction of selective Ge epitaxy in trenches on Si(001) substrates using aspect ratio trapping. Applied Physics Letters. 90 (5), 052113(2007).
- Fiorenza, J. G., et al. Aspect ratio trapping: A unique technology for integrating Ge and III-Vs with silicon CMOS. ECS Transactions. 33 (6), 963-976 (2010).
- Salvalaglio, M., et al. Engineered Coalescence by Annealing 3D Ge Microstructures into High-Quality Suspended Layers on Si. Applied Materials & Interfaces. 7 (34), 19219-19225 (2015).
- Bergamaschini, R., et al. Self-aligned Ge and SiGe three-dimensional epitaxy on dense Si pillar arrays. Surface Science Reports. 68 (3), 390-417 (2013).
- Isa, F., et al. Highly Mismatched, Dislocation-Free SiGe/Si Heterostructures. Advanced Materials. 28 (5), 884-888 (2016).
- Yako, M., Ishikawa, Y., Wada, K. Coalescence induced dislocation reduction in selectively grown lattice-mismatched heteroepitaxy: Theoretical prediction and experimental verification. Journal of Applied Physics. 123 (18), 185304(2018).
- Yako, M., Ishikawa, Y., Abe, E., Wada, K. Defects and Their Reduction in Ge Selective Epitaxy and Coalescence Layer on Si With Semicylindrical Voids on SiO2 Masks. IEEE Journal of Selected Topics in Quantum Electronics. 24 (6), 8201007(2018).
- Park, J. S., Bai, J., Curtin, M., Carroll, M., Lochtefeld, A. Facet formation and lateral overgrowth of selective Ge epitaxy on SiO2-patterned Si(001) substrates. Journal of Vacuum Science & Technology B. 26 (1), 117-121 (2008).
- Bai, J., et al. Study of the defect elimination mechanisms in aspect ratio t.rapping Ge growth. Applied Physics Letters. 90 (10), 101902(2007).
- Montalenti, F., et al. Dislocation-Free SiGe/Si Heterostructures. Crystals. 8 (6), 257(2018).
- Zhang, H. L. Calculation of shuffle 60° dislocation width and Peierls barrier and stress for semiconductors silicon and germanium. European Physical Journal B. 81 (2), 179-183 (2011).
- Kim, M., Olubuyide, O. O., Yoon, J. U., Hoyt, J. L. Selective Epitaxial Growth of Ge-on-Si for Photodiode Applications. ECS Transactions. 16 (10), 837-847 (2008).
- Yako, M., Kawai, N. J., Mizuno, Y., Wada, K. The kinetics of Ge lateral overgrowth on SiO2. Proceedings of MRS Fall Meeting. , (2015).
- Kamino, T., Yaguchi, T., Hashimoto, T., Ohnishi, T., Umemura, K. A FIB Micro-Sampling Technique and a Site Specific TEM Specimen Preparation Method. Introduction to Focused Ion Beams. , Springer. Boston, MA. (2005).
- Park, J. S., et al. Low-defect-density Ge epitaxy on Si(001) using aspect ratio trapping and epitaxial lateral overgrowth. Electrochemical and Solid-State Letters. 12 (4), H142-H144 (2009).
- Li, Q., Jiang, Y. B., Xu, H., Hersee, S., Han, S. M. Heteroepitaxy of high-quality Ge on Si by nanoscale Ge seeds grown through a thin layer of SiO2. Applied Physics Letters. 85 (11), 1928-1930 (2004).
- Halbwax, M., et al. Epitaxial growth of Ge on a thin SiO2 layer by ultrahigh vacuum chemical vapor deposition. Journal of Crystal Growth. 308 (1), 26-29 (2007).
- Leonhardt, D., Ghosh, S., Han, S. M. Origin and removal of stacking faults in Ge islands nucleated on Si within nanoscale openings in SiO2. Journal of Applied Physics. 10 (7), 073516(2011).
- Takada, Y., Osaka, J., Ishikawa, Y., Wada, K. Effect of Mesa Shape on Threading Dislocation Density in Ge Epitaxial Layers on Si after Post-Growth Annealing. Japanese Journal of Applied Physics. 49 (4S), 04DG23(2010).
- Ishikawa, Y., Wada, K. Germanium for silicon photonics. Thin Solid Films. 518 (6), S83-S87 (2010).
- Nagatomo, S., Ishikawa, Y., Hoshino, S. Near-infrared laser annealing of Ge layers epitaxially grown on Si for high-performance photonic devices. Journal of Vacuum Science & Technology B. 35 (5), 051206(2017).
- Ayers, J. E., Schowalter, L. J., Ghandhi, S. K. Post-growth thermal annealing of GaAs on Si(001) grown by organometallic vapor phase epitaxy. Journal of Crystal Growth. 125 (1), 329-335 (1992).
- Wang, G., et al. A model of threading dislocation density in strain-relaxed Ge and GaAs epitaxial films on Si (100). Applied Physics Letters. 94 (10), 102115(2009).
- Leonhardt, D., Ghosh, S., Han, S. M. Defects in Ge epitaxy in trench patterned SiO2 on Si and Ge substrates. Journal of Crystal Growth. 335 (1), 62-65 (2011).
- Sammak, A., Boer, W. B., Nanver, L. K. Ge-on-Si: Single-crystal selective epitaxial growth in a CVD reactor. ECS Transactions. 50 (9), 507-512 (2012).
- Ishikawa, Y., Wada, K., Cannon, D. D., Liu, J., Luan, H. C., Kimerling, L. C. Strain-induced band gap shrinkage in Ge grown on Si substrate. Applied Physics Letters. 82 (13), 2044-2046 (2003).
- Bolkhovityanov, Y. B., Gutakovskii, A. K., Deryabin, A. S., Sokolov, L. V. Edge Misfit Dislocations in GexSi1–x/Si(001) (x~1) Heterostructures: Role of Buffer GeySi1–y (y < x) Interlayer in Their Formation. Physics of the Solid State. 53 (9), 1791-1797 (2011).
- Bourret, A. How to control the self-organization of nanoparticles by bonded thin layers. Surface Science. 432 (1), 37-53 (1999).
- Hirth, J. P., Lothe, J. Grain boundaries. Theory of Dislocations, 2nd ed. 19, Wiley. New York, NY, USA. 697-750 (1982).
- Mizuno, Y., Yako, M., Luan, N. M., Wada, K. Strain tuning of Ge bandgap by selective epigrowth for electro-absorption modulators. Proceedings of SPIE Photonics West, San Francisco, CA, USA. 9367, 1-6 (2015).
- Nam, J. H., et al. Lateral overgrowth of germanium for monolithic integration of germanium-on-insulator on silicon. Journal of Crystal Growth. 416 (15), 21-27 (2015).
- Fitch, J. T. Selectivity Mechanisms in Low Pressure Selective Epitaxial Silicon Growth. Journal of The Electrochemical Society. 141 (4), 1046-1055 (1994).
- Ye, H., Yu, J. Germanium epitaxy on silicon. Science and Technology of Advanced Materials. 15 (2), 1-9 (2014).
Réimpressions et Autorisations
Demande d’autorisation pour utiliser le texte ou les figures de cet article JoVE
Demande d’autorisationThis article has been published
Video Coming Soon