Method Article
الحساب النظري والتحقق التجريبي لتقليل الخلع في طبقات الجرمانيوم فوق المحورية مع فراغات نصف أسطوانية على السيليكون
In This Article
Summary
تم اقتراح الحساب النظري والتحقق التجريبي لتقليل كثافة خلع الخيوط (TD) في طبقات الجرمانيوم الفوقية مع فراغات نصف أسطوانية على السيليكون. يتم تقديم الحسابات القائمة على تفاعل TDs والسطح عبر قوة الصورة وقياسات TD وملاحظات المجهر الإلكتروني النافذ ل TDs.
Abstract
كان تقليل كثافة خلع الخيوط (TDD) في الجرمانيوم الفوقي (Ge) على السيليكون (Si) أحد أهم التحديات لتحقيق دوائر ضوئية متكاملة متجانسة. تصف هذه الورقة طرق الحساب النظري والتحقق التجريبي لنموذج جديد للحد من TDD. تصف طريقة الحساب النظري انحناء خلع الخيوط (TDs) بناء على تفاعل TDs وأسطح النمو غير المستوية للنمو الفوقي الانتقائي (SEG) من حيث قوة صورة الخلع. يكشف الحساب أن وجود فراغات على أقنعة SiO2 يساعد على تقليل TDD. يتم وصف التحقق التجريبي بواسطة الجرمانيوم (Ge) SEG ، باستخدام طريقة ترسيب بخار كيميائي عالي الفراغ وملاحظات TD ل Ge المزروع عن طريق النقش والمجهر الإلكتروني المقطعي (TEM). يقترح بشدة أن تخفيض TDD سيكون بسبب وجود فراغات شبه أسطوانية فوق أقنعة SiO2 SEG ودرجة حرارة النمو. للتحقق التجريبي ، تتشكل طبقات Ge الفوقية مع الفراغات شبه الأسطوانية نتيجة لطبقات SEG من Ge واندماجها. تقوم TDDs التي تم الحصول عليها تجريبيا بإعادة إنتاج TDDs المحسوبة بناء على النموذج النظري. تكشف ملاحظات TEM المستعرضة أن كلا من إنهاء وتوليد TDs يحدث في فراغات شبه أسطوانية. تكشف ملاحظات TEM لعرض الخطة عن سلوك فريد من نوعه ل TDs في Ge مع فراغات نصف أسطوانية (على سبيل المثال ، يتم ثني TDs لتكون موازية لأقنعة SEG والركيزة Si).
Introduction
اجتذب Epitaxial Ge on Si اهتمامات كبيرة كمنصة جهاز فوتوني نشطة حيث يمكن ل Ge اكتشاف / إصدار الضوء في نطاق الاتصالات الضوئية (1.3-1.6 ميكرومتر) وهو متوافق مع تقنيات معالجة Si CMOS (أشباه الموصلات المعدنية التكميلية). ومع ذلك ، نظرا لأن عدم تطابق الشبكة بين Ge و Si يصل إلى 4.2٪ ، تتشكل خلع الخيوط (TDs) في طبقات Ge الفوقية على Si بكثافة ~ 109 / سم2. يتدهور أداء الأجهزة الضوئية Ge بواسطة TDs لأن TDs تعمل كمراكز توليد حاملة في أجهزة الكشف الضوئي Ge (PDs) والمعدلات (MODs) ، وكمراكز إعادة تركيب الناقل في ثنائيات الليزر (LDs). في المقابل ، سيزيدون تيار التسرب العكسي (تسرب J) في PDs و MODs1،2،3 ، وتيار العتبة (Jth) في LDs4،5،6.
تم الإبلاغ عن محاولات مختلفة لتقليل كثافة TD (TDD) في Ge on Si (الشكل التكميلي 1). يحفز التلدين الحراري حركة TDs مما يؤدي إلى تقليل TDD ، عادة إلى 2 × 107 / سم2. العيب هو الاختلاط المحتمل بين Si و Ge وانتشار المنشطات في Ge مثل الفوسفور7،8،9 (الشكل التكميلي 1 أ). تزيد الطبقة العازلة المتدرجة SiGe 10،11،12 من السماكات الحرجة وتمنع توليد المواد الصلبة الذائبة مما يؤدي إلى تقليل TDD ، عادة إلى 2 × 10 6 / سم2. العيب هنا هو أن المخزن المؤقت السميك يقلل من كفاءة اقتران الضوء بين أجهزة Ge وأدلة موجات Si تحتها (الشكل التكميلي 1 ب). ملائمة نسبة العرض إلى الارتفاع (ART) 13،14،15 هي طريقة نمو فوقي انتقائي (SEG) وتقلل من TDs عن طريق محاصرة TDs في الجدران الجانبية لخنادق SiO 2 السميكة ، عادة إلى <1 × 10 6 / سم 2. تستخدم طريقة ART قناع SiO 2 سميك لتقليل TDD في Ge على أقنعة SiO2 ، والتي تقع أعلى بكثير من Si ولها نفس العيب (الشكل التكميلي 1b ، 1c). يشبه نمو Ge على بذور عمود Si والتلدين16،17،18 طريقة ART ، مما يتيح محاصرة TD بنسبة عرض إلى ارتفاع عالية نمو Ge ، إلى <1 × 10 5 / سم2. ومع ذلك ، فإن التلدين بدرجة حرارة عالية للاندماج Ge له نفس العيوب في الشكل التكميلي 1a-c (الشكل التكميلي 1 د).
لتحقيق نمو فوقي منخفض TDD Ge على Si خال من عيوب الطرق المذكورة أعلاه ، اقترحنا تخفيض TDD الناجم عن الالتحام 19,20 بناء على الملاحظتين الرئيسيتين التاليتين اللتين تم الإبلاغ عنهما حتى الآن في نمو SEG Ge7،15،21،22،23 : 1) تنحني TDs لتكون طبيعية لأسطح النمو (يتم ملاحظتها بواسطة المجهر الإلكتروني النافذ المستعرض (TEM)) ، و 2) يؤدي اندماج طبقات SEG Ge إلى تكوين فراغات نصف أسطوانية فوق أقنعة SiO2.
لقد افترضنا أن TDs عازمة بسبب قوة الصورة من سطح النمو. في حالة Ge على Si ، تولد قوة الصورة 1.38 GPa و 1.86 GPa إجهادات القص للخلع اللولبي وخلع الحواف على مسافات 1 نانومتر بعيدا عن الأسطح الحرة ،على التوالي 19. إجهادات القص المحسوبة أكبر بكثير من إجهاد بيرلز البالغ 0.5 جيجا باسكال المبلغ عنه لخلع 60 درجة في Ge24. يتنبأ الحساب بانخفاض TDD في طبقات Ge SEG على أساس كمي وهو يتفق جيدا مع نمو SEGGe 19. يتم إجراء ملاحظات TEM ل TDs لفهم سلوكيات TD في نمو SEG Ge المقدم على Si20. إن تقليل TDD الناجم عن قوة الصورة خال من أي تلدين حراري أو طبقات عازلة سميكة ، وبالتالي فهو أكثر ملاءمة لتطبيق الجهاز الضوئي.
في هذه المقالة ، نصف طرقا محددة للحساب النظري والتحقق التجريبي المستخدم في طريقة تخفيض TDD المقترحة.
Protocol
1. إجراء الحساب النظري
- حساب مسارات TD. في الحساب ، افترض أن أقنعة SEG رقيقة بما يكفي لتجاهل تأثير ART على تقليل TDD.
- تحديد أسطح النمو والتعبير عنها بالمعادلة (المعادلات). على سبيل المثال ، عبر عن التطور الزمني لمقطع عرضي دائري الشكل لطبقة SEG Ge باستخدام معلمة تطور الوقت n = i ، ارتفاعات SEG Ge (h i) ونصف قطر SEG Ge (ri) ، كما هو موضح في الفيديو التكميلي 1a و Eq. (1):

- حدد الاتجاهات الطبيعية لموقع تعسفي على أسطح النمو. بالنسبة للمقطع العرضي المستدير الشكل SEG Ge ، صف الخط الطبيعي عند (x i ، yi) ك
 ، كما هو موضح في الفيديو التكميلي 1b كخط أحمر. بعد ذلك ، احصل على حافة TD (x i + 1 ، y i + 1) من النقطة (x i ، y i) عن طريق حل المعادلات الآنية التالية:
، كما هو موضح في الفيديو التكميلي 1b كخط أحمر. بعد ذلك ، احصل على حافة TD (x i + 1 ، y i + 1) من النقطة (x i ، y i) عن طريق حل المعادلات الآنية التالية:
- احسب مسار TD واحد اعتمادا على موقع إنشاء TD (x 0 ، 0) ، كما هو موضح في الفيديو التكميلي 1c. بمعنى آخر ، يمكن حساب مسار TD التعسفي بالطريقة الموضحة أعلاه.
- احسب TDD بافتراض أن TDs تخترق السطح السفلي وتساهم في تقليل TDD (أي أن TDs أسفل النقطة التي تتجمع فيها طبقات SEG Ge محاصرة بواسطة فراغات نصف أسطوانية ولا تظهر أبدا على السطح العلوي).
- تحديد أسطح النمو والتعبير عنها بالمعادلة (المعادلات). على سبيل المثال ، عبر عن التطور الزمني لمقطع عرضي دائري الشكل لطبقة SEG Ge باستخدام معلمة تطور الوقت n = i ، ارتفاعات SEG Ge (h i) ونصف قطر SEG Ge (ri) ، كما هو موضح في الفيديو التكميلي 1a و Eq. (1):
2. إجراء التحقق التجريبي
- إعداد قناع SEG
- قبل تصنيع أقنعة SEG ، حدد مناطق نمو Ge من خلال إعداد ملف تصميم. في العمل الحالي ، قم بإعداد أنماط الخط والفضاء المحاذاة إلى [110] الاتجاه ومناطق نافذة Si ذات الشكل المربع بعرض 4 مم باستخدام برنامج تجاري (على سبيل المثال ، AutoCAD).
- تحديد تصميم أقنعة SEG (على وجه الخصوصنافذة Wوقناع W) باستخدام البرنامج. نافذة W هي عرض النافذة (عرض البذور Si)وقناع W هو عرض قناع SiO2 ، بحيث يمكن أن تتحد طبقات SEG Ge مع الطبقات المجاورة لها. حددنافذة Wوقناع W عن طريق رسم مستطيلات بالنقر فوق فتح بنية → ملف → مستطيل أو خط متعدد.
ملاحظة: يصبح عرض المستطيلاتنافذة W ، ويصبح الفاصل الزمني للمستطيلاتقناع W. في العمل الحالي ، القيم الدنيالنافذة Wوقناع W هي 0.5 ميكرومتر و 0.3 ميكرومتر ، على التوالي ، والتي تقيدها الدقة في نظام الطباعة الحجرية EB المستخدم. - كمراجع ، ارسم مناطق نافذة Si مربعة الشكل بعرض 4 مم D ، وتعتبر مناطق البطانية. انقر فوق فتح بنية → الملف → مستطيل أو متعدد الخطوط لرسم نافذة Si ذات الشكل المربع. استخدم المخططات الموضحة في الشكل 1 لإعداد أنماط الخط والمسافة ومنطقة البطانية المربعة 4 مم.
- تحضير ركائز B-doped p-Si (001) بمقاومة 1-100 Ω∙cm. في العمل الحالي ، استخدم ركائز Si مقاس 4 بوصات. نظف أسطح الركيزة بمحلول سمكة البيرانا (خليط من 20 مل من 30٪ H 2 O2 و 80 مل من 96٪ H2 SO4) حسب الضرورة.
- افتح الغطاء على فرن الأنبوب وقم بتحميل ركائز Si في الفرن باستخدام قضيب زجاجي. في العمل الحالي ، أكسدة 10 ركائز سي في وقت واحد.
- ابدأ في نفخ غاز N2 الجاف في الفرن عن طريق فتح صمام الغاز. بعد ذلك ، اضبط معدل تدفق الغاز على 0.5 لتر / م عن طريق التحكم في الصمام.
- اضبط درجة حرارة التلدين عن طريق تغيير البرنامج. في العمل الحالي ، استخدم "خطوة النمط (الوضع 2)" واضبط درجة حرارة العملية على 900 درجة مئوية. ثم قم بتشغيل البرنامج عن طريق الضغط على الوظيفة → التشغيل.
- عندما تصل درجة الحرارة إلى 900 درجة مئوية ، أغلق صمام N 2 الجاف ، وافتح صمام O 2 الجاف (تدفق O2 = 1 لتر / م) ، واحتفظ به لمدة ساعتين.
ملاحظة: قم بتنفيذ الخطوات 2.1.9-2.1.16 في غرفة صفراء. - قم بتغطية ركائز Si المؤكسدة بخافض للتوتر السطحي (OAP) باستخدام طبقة دوارة ثم اخبزها على حرارة 110 درجة مئوية لمدة 90 ثانية على لوح تسخين.
- بعد طلاء الفاعل بالسطح ، قم بتغطية ركائز Si بمقاومة للضوء (على سبيل المثال ، ZEP520A) باستخدام طبقة دوارة ثم اخبزيها على حرارة 180 درجة مئوية لمدة 5 دقائق على لوح تسخين.
- قم بتحميل ركائز Si بالسطح ومقاومة الضوء في كاتب شعاع الإلكترون (EB).
- اقرأ ملف التصميم (المعد في الخطوة 2.1.2) في كاتب EB وقم بعمل ملف عملية (ملف WEC). اضبط كمية الجرعة على 120 μC / سم2 في ملف WEC. عند انتهاء تحميل الركيزة ، قم بإجراء التعرض EB بالنقر فوق زر التعرض الفردي .
- قم بتفريغ الركيزة من كاتب EB بالنقر فوق حمل الرقاقة → تفريغها عند انتهاء التعرض.
- قم بإعداد مطور مقاوم للضوء (ZED) وشطف للمطور (ZMD) في غرفة المسودة. اغمس ركائز Si المكشوفة في المطور لمدة 60 ثانية في درجة حرارة الغرفة.
- قم بإزالة ركائز Si من المطور ، ثم جفف الركيزة بغاز N2 .
- ضع ركائز Si المطورة على لوح تسخين لتخبز على حرارة 110 درجة مئوية لمدة 90 ثانية.
- اغمس ركائز Si في حمض الهيدروفلوريك المخزن (BHF-63SE) لمدة 1 دقيقة لإزالة جزء من طبقات SiO2 المعرضة للهواء نتيجة التعرض ل EB وتطوره.
- قم بإزالة المقاومة الضوئية من ركائز Si عن طريق غمسها في مزيل عضوي مقاوم للضوء (على سبيل المثال ، Hakuri-104) لمدة 15 دقيقة.
- اغمس ركائز Si في حمض الهيدروفلوريك المخفف بنسبة 0.5٪ لمدة 4 دقائق لإزالة الأكسيد الأصلي الرقيق في مناطق النافذة ولكن للاحتفاظ بأقنعة SiO2 . ثم قم بالتحميل على غرفة ترسيب البخار الكيميائي فائقة الفراغ (UHV-CVD) لتنمو Ge. ويبين الشكل 2 نظام UHV-CVD المستخدم في هذا العمل.
- نمو Ge الفوقي
- قم بتحميل ركيزة Si بأقنعة SEG (ملفقة كما في الخطوة 2.1) في غرفة قفل التحميل.
- اضبط درجة حرارة المخزن المؤقت / درجة النمو الرئيسية في علامة التبويب الوصفة المعروضة على كمبيوتر التشغيل. حدد مدد النمو الرئيسي ل Ge بحيث تتحد طبقات SEG Ge مع الطبقات المجاورة. لتحديد فترات النمو الرئيسي ، ضع في اعتبارك معدل نمو Ge على مستويات {113} ، والذي يحدد النمو في الاتجاه داخل الطائرة / الجانبي26. في العمل الحالي ، حدد مدد النمو الرئيسي على أنها 270 دقيقة و 150 دقيقة ل 650 درجة مئوية و 700 درجة مئوية ، على التوالي.
- انقر فوق ابدأ في النافذة الرئيسية ، ثم يتم نقل الركيزة Si تلقائيا إلى غرفة النمو.
ملاحظة: تتم معالجة البروتوكول الخاص بنمو Ge الفوقي (الخطوات 2.2.4-2.2.7) تلقائيا. - تنمو Ge buffer على ركيزة Si المحملة عند درجة حرارة منخفضة (≈380 درجة مئوية). استخدم GeH 4 المخفف عند 9٪ في Ar كمصدر للغاز وحافظ على الضغط الجزئي ل GeH4 لمدة 0.5 باسكال أثناء نمو المخزن المؤقت.
- تنمو الطبقة الرئيسية Ge عند درجة حرارة مرتفعة. حافظ على الضغط الجزئي ل GeH4 لمدة 0.8 باسكال أثناء النمو الرئيسي. في العمل الحالي ، استخدم درجتي حرارة مختلفتين من 650 و 700 درجة مئوية لدرجة حرارة النمو الرئيسية من أجل مقارنة SEG Ge مع مقطع عرضي دائري الشكل ومع مقطع عرضي {113} الأوجه25.
ملاحظة: كان معدل نمو Ge على المستوى (001) 11.7 نانومتر / دقيقة بغض النظر عن درجة الحرارة. - من أجل تصور تطور SEG Ge واندماجها ، قم بإجراء نمو Ge مع الإدخال الدوري لطبقات ترسيم Si0.3Ge0.7 بسمك 10 نانومتر على ركيزة Si أخرى. تم تشكيل طبقات Si0.3Ge0.7 باستخدام غازات Si2H6 و GeH4. أثناء نمو طبقة Si0.3Ge 0.7 ، اضبط الضغط الجزئي لغاز Si2H6 عند 0.02 باسكال والضغط الجزئي لغاز GeH4 عند0.8 باسكال.
- نظرا لأن ركيزة Si يتم نقلها تلقائيا من غرفة النمو إلى غرفة قفل الحمل ، قم بتهوية غرفة قفل الحمل وتفريغ ركيزة Si يدويا.
- قياسات كثافة حفرة الحفر (EPD)
- حل 32 ملغ من I2 في 67 مل من CH3COOH باستخدام آلة التنظيف بالموجات فوق الصوتية.
- امزج I2-إذابة CH 3 COOH ، و 20 مل من HNO3، و 10 مل من HF.
- اغمس ركائز Si المزروعة Ge في محلول CH 3 COOH/ HNO3 / HF / I2 لمدة 5-7 ثوان من أجل تشكيل حفر محفورة.
- راقب أسطح Ge المحفورة باستخدام مجهر بصري (عادة 100x) لضمان تشكيل الحفر المحفورة بنجاح.
- استخدم مجهر القوة الذرية (AFM) لحساب الحفر المحفورة. ضع عينة Ge المحفورة على مرحلة AFM ، ثم اقترب من المسبار بالنقر فوق نهج تلقائي.
- حدد منطقة المراقبة باستخدام مجهر بصري مدمج مع AFM ، وقم بمسح خمس مناطق مختلفة 10 ميكرومتر × 10 ميكرومتر. يتم تحديد عامل التخميد السعة تلقائيا.
- ملاحظات TEM
- التقط عينات TEM من طبقات Ge المدمجة / البطانية باستخدام شعاع أيون Ge مركز (طريقة أخذ العينات الدقيقة FIB)27.
- تلميع عينات TEM في نظام طحن أيون باستخدام أيونات Ar. في العمل الحالي ، عينات TEM رقيقة للملاحظات المقطعية لتكون 150-500 نانومتر في الاتجاه [110] ، ولملاحظات عرض الخطة 200 نانومتر في الاتجاه [001].
- بالنسبة لعينات TEM ذات العرض المخطط ، قم بحماية الأسطح العلوية لطبقات Ge بطبقات غير متبلورة ، ثم قم بالتخفيف من الجانب السفلي (الركيزة) لطبقات Ge.
- قم بإجراء ملاحظات TEM تحت جهد تسارع يبلغ 200 كيلو فولت. قم بإجراء ملاحظات TEM (STEM) للمسح المقطعي الساطع من أجل مراقبة عينات TEM السميكة (500 نانومتر).
- بالنسبة ل Ge المدمجة مع طبقات ترسيم Si 0.3 Ge0.7 ، قم بإجراء ملاحظات STEM للحقل المظلم الحلقي عالي الزاوية (HAADF) تحت جهد تسارع يبلغ 200 كيلو فولت.
النتائج
الحساب النظري
يوضح الشكل 3 المسارات المحسوبة ل TDs في 6 أنواع من طبقات Ge المدمجة: هنا ، نحدد نسبة الفتحة (APR) لتكوننافذة W / (نافذة W +قناع W). يوضح الشكل 3 أ أصل SEG مستدير الشكل مدمج Ge من APR = 0.8. هنا ، 2/6 TDs محاصرة. يوضح الشكل 3 ب أصل SEG {113} الأوجه المندمج Ge ل APR = 0.8. هنا ، 0/6 TDs محاصرة. يوضح الشكل 3 ج أصل SEG دائري الشكل مدمج Ge ل APR = 0.1. هنا ، 5/6 TDs محاصرة. يوضح الشكل 3d أصل SEG {113} الأوجه المندمج Ge ل APR = 0.1. هنا ، 6/6 TDs محاصرة. يوضح الشكل 3e أصل SEG مستدير الشكل مدمج Ge من APR = 0.1 ، في حالة نمو Ge على أقنعة SiO2. هنا ، 0/6 TDs محاصرة. يوضح الشكل 3f أصل SEG {113} الأوجه المندمج Ge من APR = 0.1 ، في حالة نمو Ge على أقنعة SiO2. هنا ، 0/6 TDs محاصرة.
تظهر مسارات 6 TDs التي تم إنشاؤها عند (x 0 ، 0) ، حيث x 0 = 0.04 و 0.1 و 0.2 و 0.4 و 0.6 و 0.8 مرةW window / 2 ، كخطوط حمراء في كل شكل. تنتشر TDs الموجودة فوق نقاط الالتحام لطبقتي SEG Ge لأعلى إلى السطح العلوي ، بينما تنتشر TDs الموجودة أسفل النقاط لأسفل لتبقى على سطح الفراغ فوق قناع SiO2.
في الشكل 3a-3d ، من المفترض أن SEG Ge لا ينمو على SiO2. وبالتالي ، من المفترض أن تكون الجدران الجانبية ل SEG Ge ذات {113} الأوجه مستديرة الشكل حتى لا تلمس المنطقة المقنعة SiO2. يظهر بوضوح أن SEG المستدير الشكل ثم Ge المندمج أكثر فعالية في تقليل TDD عند معدل فائدة سنوية يبلغ 0.8 ، من الحالة ذات الأوجه {113} ، في حين أن Ge ذات الأوجه {113} ثم المدمجة، أكثر فعالية من الحالة المستديرة الشكل عند معدل الفائدة السنوية 0.1. يعزى هذا "العبور" إلى وجود {113} جوانب بالقرب من قمة SEG: {113} تنحرف الجوانب عن الاتجاه [001] أكثر من الأسطح المستديرة الشكل.
يوضح الشكل 3e والشكل 3f اندماج Ge بنسبة فتحة 0.1 ، بافتراض أن Ge ليس نواة على SiO 2 ولكنه يظهر ترطيبا باستخدام قناع SiO2 ، الذي تم الإبلاغ عنه على نطاق واسع في اندماج Ge المبلغ عنه سابقا13،15،22،28،29،30،31. كما هو موضح في الشكل 3e والشكل 3f ، لا يوجد فراغ شبه أسطواني بين اثنين من SEG وبالتالي لا يوجد TD محاصر على السطح.
يوضح الشكل 4 TDDs المحسوبة في Ge المدمجة. في الشكل 4 ، يظهر الخط الأحمر TDDs المحسوبة في Ge المندمجة الناشئة من SEG Ge المستدير الشكل ، ويظهر الخط الأزرق TDDs المحسوبة في Ge المندمجة الناشئة من SEG Ge {113} الأوجه. نظرا لأن TDs في Ge على Si تنشأ من عدم تطابق الشبكة بين Ge و Si ، فمن المفترض أن توليد TD يحدث فقط في الواجهات بين Ge و Si. بمعنى آخر ، يجب تخفيض TDD مع APR.
عندما يكون معدل الفائدة السنوية أكبر من 0.11 ، يكون SEG Ge المستدير الشكل أكثر فعالية من {113} الأوجه (الشكل 3 أ والشكل 3 ب). عندما يكون معدل الفائدة السنوية أصغر من 0.11 ، من ناحية أخرى ، يصبح SEG Ge ذو {113} الأوجه أكثر فعالية من الشكل الدائري (الشكل 3 ج والشكل 3 د). كما في الشكل 3 ، يعزى هذا العبور إلى وجود {113} جوانب بالقرب من قمة SEG (x 0≈ 0). لاحظ أن الشكل 3e والشكل 3f يتوافقان مع الخط الأسود في الشكل 4 ، مما يدل على انخفاض TDD من تقليل APR ، ولكن ليس إلى الالتحام (أي أن ترطيب SEG Ge مع SiO2 له تأثير سلبي ضد انخفاض TDD).
التحقق التجريبي
يوضح الشكل 5 صورا نموذجية للمجهر الإلكتروني الماسح المستعرض (SEM) (الشكل 5b-5d ، 5f) وخرائط التوزيع (الشكل 5 أ ، 5 ه) توضح ما إذا كان الاندماج يحدث أم لا. يوضح الشكل 5b-5d ، 5f صورا مقطعية لطبقات SEG Ge غير المدمجة (الشكل 5 ب ، نمت عند 700 درجة مئوية ؛ الشكل 5f ، نمت عند 650 درجة مئوية) ، طبقات SEG Ge المدمجة مع سطح علوي غير مسطح (الشكل 5 ج ، نمت عند 700 درجة مئوية) ، وطبقات SEG Ge المدمجة مع سطح علوي مسطح (الشكل 5 د ؛ نمت عند 700 درجة مئوية). يتم تلميع صور SEM الموضحة في الشكل 5 ب والشكل 5 د بواسطة حزمة أيونية مركزة بعد ترسب طبقات حماية Pt. يحدث الالتحام عندما تكوننافذة Wوقناع W أصغر من 1 ميكرومتر لظروف النمو الحالية. تمنع أقنعة SEG المزودةبقناع W بحجم 1 ميكرومتر أو أكبر اندماج Ge بسبب الكمية الصغيرة من نمو Ge في الاتجاه الجانبي26. تمنع أقنعة SEG ذاتالنافذة W التي تبلغ 2 ميكرومتر أو أكبر أيضا اندماج Ge ، على الرغم من حدوث الالتحام عندما تكوننافذة W أصغر من 1 ميكرومتر. وذلك لأن معدل النمو الجانبي ل Ge على SiO2 يعتمد علىنافذة W 30. يتم تلخيص اعتماد القناع ونمط النافذة في الشكل 7 أ (700 درجة مئوية) والشكل 7 ه (650 درجة مئوية).
بمقارنة طبقات SEG Ge غير المدمجة (الشكل 4 ب والشكل 4 و) ، يتضح بوضوح أن طبقة SEG Ge المزروعة عند 700 درجة مئوية لها مقطع عرضي دائري الشكل بينما طبقة SEG Ge التي تنمو عند 650 درجة مئوية لها مقطع عرضي {113} الأوجه. كما في الشكل 5 ب ، يظهر النمو عند 700 درجة مئوية SEG Ge على شكل دائري بدون نمو Ge على SiO 2 (أي عدم ترطيب قناع SiO2). لذلك ، يستمر النمو مثل الشكل 3 أ والشكل 3 ج. من ناحية أخرى ، كما في الشكل 5f ، يظهر SEG Ge ذو {113} الأوجه عند 650 درجة مئوية. من الواضح بقوة أن Ge سيظهر ترطيبا بقناع SiO2. في المقابل ، تكون الحافة مستديرة الشكل (أي غير مرطبة). لذلك ، فإن النمو عند 650 درجة مئوية يقع بين الشكل 3 ب (بدون ترطيب) والشكل 3 و (ترطيب مثالي). يشير هذا إلى أن تخفيض TDD يجب أن يكون بين الشكل 3 ب والشكل 3 و. بالنظر إلى النتائج النظرية الموضحة في الشكل 6 ، يجب أن تؤثر هذه الاختلافات في المقاطع العرضية SEG Ge بشدة على TDDs في طبقات Ge المندمجة.
يمكن فهم الفرق في نمو الترطيب على SiO2 على النحو التالي. يتم تحديد زاوية الاتصال بين Ge و SiO2 (θ) بواسطة معادلة يونغ:

هنا ، γ SiO2 و γ Ge و γint هي الطاقة الخالية من السطح SiO2 ، والطاقة الخالية من السطح Ge ، والطاقة الخالية من السطح Ge / SiO2 ، على التوالي. تصبح زاوية الجدار الجانبي SEG Ge أكبر مع استمرار نمو Ge. عندما تصل زاوية الجدار الجانبي SEG Ge إلى زاوية التلامس θ ، يحتاج SEG Ge إلى النمو في الاتجاه الرأسي ([001]) أو الجانبي ([] ). في حالة نمو 650 درجة مئوية ، يكون النمو الرأسي محدودا للغاية بسبب الجوانب {113} ، وبالتالي يفضل SEG Ge النمو في الاتجاه الجانبي (أي ترطيب النمو). على الرغم من أن الترطيب يمكن أن يولد خلعا في واجهة Ge و SiO2 ، إلا أنه سيتم إنهاؤه أخيرا عند سطح الفراغ شبه الأسطواني. في حالة نمو 700 درجة مئوية ، يمكن أن تنمو Ge في اتجاه رأسي ، وتكون زاوية التلامس أكبر من زاوية 650 درجة مئوية بسبب γint الأكبر. سيكون هذا هو السبب في أن Ge المزروع في 650 درجة مئوية يظهر ترطيبا على SiO2 بينما لا يظهر 700 درجة مئوية من Ge.
). في حالة نمو 650 درجة مئوية ، يكون النمو الرأسي محدودا للغاية بسبب الجوانب {113} ، وبالتالي يفضل SEG Ge النمو في الاتجاه الجانبي (أي ترطيب النمو). على الرغم من أن الترطيب يمكن أن يولد خلعا في واجهة Ge و SiO2 ، إلا أنه سيتم إنهاؤه أخيرا عند سطح الفراغ شبه الأسطواني. في حالة نمو 700 درجة مئوية ، يمكن أن تنمو Ge في اتجاه رأسي ، وتكون زاوية التلامس أكبر من زاوية 650 درجة مئوية بسبب γint الأكبر. سيكون هذا هو السبب في أن Ge المزروع في 650 درجة مئوية يظهر ترطيبا على SiO2 بينما لا يظهر 700 درجة مئوية من Ge.
بالنسبة ل Ge بعد الالتحام ، لا يتأثر هيكل المقطع العرضي بدرجة حرارة النمو: لا يمكن تمييز طبقات Ge المدمجة التي تنمو عند 650 درجة مئوية وتلك التي تنمو عند 700 درجة مئوية من خلال ملاحظات SEM المستعرضة.
لاحظ أنه بالنسبة للأنماط المصنعة ، كانت قيمنافذة W أكبر وكانت قيمقناع W أصغر من القيم المصممة لأنه تم استخدام عملية حفر رطب الخواص لتصنيع القناع. تم الحصول على القيم الفعليةلنافذة Wوقناع W من خلال ملاحظات SEM المقطعية بعد نمو Ge.
بالإضافة إلى ذلك ، كان سمك طبقات SiO2 للقناع 30 نانومتر وفقا لملاحظات SEM المقطعية وقياسات القياس الإهليلجي الطيفي. تم استخدام طبقات SiO2 الرقيقة هذه لفحص تقليل TDD الموضح في الشكل 3 والشكل 4 ، مما أدى إلى إزالة تأثير العنق فوق المحوري على ART. في العمل الحالي ، تكون نسب العرض إلى الارتفاع أقل من 0.05 ، وهي صغيرة بما يكفي لتجاهل تأثير العنق فوق المحوري على ART.
يوضح الشكل 6 أ جذع HAADF مقطعي عرضي ل SEG مع طبقات ترسيم Si 0.3 Ge 0.7 ، ويظهر رسم تخطيطي للشكل 6 أ في الشكل 6 ب (نافذة W = 0.66 ميكرومتر ،قناع W = 0.84ميكرومتر). تظهر طبقات ترسيم Si0.3Ge0.7 بوضوح أشكال السطح أثناء النمو عند 700 درجة مئوية. تظهر صورة STEM أسطح Ge لكل خطوة نمو من SEG مستديرة الشكل إلى طبقة فوقية مسطحة تشكلت بعد الاندماج. يتم تعزيز معدل النمو بعد الالتحام مباشرة بقوة في المناطق المجمعة. من المحتمل أن يكون هذا النمو السريع ناتجا عن طبقة Ge epilayer ، مما يقلل من مساحة سطحها لتستقر بقوة.
على عكس Ge SEG النقي ، تظهر طبقات ترسيم Ge SEG المقدمة مع طبقات ترسيم Si0.3 Ge 0.7ترطيبا باستخدام أقنعة SiO2 (الشكل 8 أ). ربما يرجع الاختلاف في التبول إلى إدخال طبقات ترسيم Si0.3Ge0.7 ، والتي يتم تعزيز نواتها على طبقات SiO2 غير المحتملة من Ge.
يتم استخدام Ge المندمجة ذات القمة المسطحة (المناطق ذات الدوائر الزرقاء في الشكل 5 أ والشكل 5 ه) لقياسات EPD. تم حفر طبقات Ge في المتوسط بمقدار 200 نانومتر. يتم عرض صور AFM النموذجية بعد النقش في الشكل 7 أ والشكل 7 ب ، والتي تم التقاطها ل Ge المندمج بسمك 1.15 ميكرومتر نمت عند 700 درجة مئوية (نافذة W = 0.66 ميكرومتر وقناع W = 0.44 ميكرومتر) و 2.67 ميكرومتر بسمك Ge المندمج نمت عند 650 درجة مئوية (نافذة W = 0.66 ميكرومتر وقناع W = 0.34 ميكرومتر). كمرجع ، تظهر صورة البطانية Ge التي يبلغ سمكها 1.89 ميكرومتر والتي نمت عند 700 درجة مئوية في الشكل 7 ج. النقاط الداكنة في صور AFM عبارة عن حفر محفورة تشير إلى وجود TD. تم الحصول على قيم EPD من الشكل 7a-7c لتكون 7.0 × 10 7 / سم 2 و 7.9 × 10 7 / سم 2 و8.7 × 107 / سم 2 ، على التوالي. أظهرت تقاريرنا السابقة أن EPDs التي تم الحصول عليها في حالة النقش هذه تساوي TDDs المحددة بواسطة المجهر الإلكتروني للانتقال (TEM) 4،32،33،34. يتوافق EPD المقاس لطبقة Ge البطانية (7.9 ± 0.8 × 10 7 / سم 2) جيدا مع TDD الذي تم الحصول عليه من مراقبة TEM لعرض المخطط بمساحة كبيرة نسبيا تبلغ 6 × 8 ميكرومتر 2 (8.7 ± 0.2 × 107 / سم 2) ، مما يشير إلى أن EPD يساوي TDD.
من أجل مقارنة TDDs التي تم الحصول عليها تجريبيا مع الحسابات ، تأخذ في الاعتبار تأثير سمك على TDD. هناك اتجاه يتناقص فيه TDD مع زيادة سمك Ge بسبب زيادة فرص إبادة الزوج ل TD. لذلك ، يجب أن يعزى انخفاض TDD الملاحظ ل Ge المندمج ، أرق من Ge البطانية ، إلى الآلية الموضحة في الشكل 3 والشكل 4 (أي أننا بحاجة إلى حساب TDD الطبيعي لمقارنة TDDs التي تم الحصول عليها تجريبيا مع تلك المحسوبة في الشكل 4). قبل التطبيع ، تم إجراء تصحيح ل TDD للبطانية Ge (ρ بطانية) ، مع الأخذ في الاعتبار سمك ودرجة حرارة النمو على TDD. على غرار التقارير السابقة35,36 ، يتم التعبير عنبطانية ρ [/ cm 2] تقريبا على أنها2.52 × 1013 × [d (نانومتر)] -1.57 لطبقات Ge المزروعة في نطاق درجة حرارة 530-650 درجة مئوية باستخدام UHV-CVD. هنا ، d هو سمك طبقة Ge البطانية. ρيتم تقليل البطانية [/ cm 2] لطبقات Ge المزروعة عند 700 درجة مئوية ، ويتم التعبير عنها تقريبا على أنها2.67 × 1012 × [d (نانومتر)] -1.37.
يوضح الشكل 7d TDD الطبيعي كدالة ل APR ، نافذة W / (نافذة W +قناع W). تظهر TDDs في Ge المندمجة المزروعة عند 650 درجة مئوية كمثلثات زرقاء وتلك التي تزرع عند 700 درجة مئوية كماس أحمر. نظرا لأن SEG Ge عند 650 درجة مئوية يظهر بعض الترطيب باستخدام قناع SiO2 ، يجب أن تقع بيانات النمو بين الخطين الأسود والأزرق. يجب أن يكون SEG Ge عند 700 درجة مئوية على الخط الأحمر. النتائج التجريبية تتفق بشكل جيد مع الحساب بناء على شكل المقطع العرضي وظروف الترطيب.
كما هو موضح أعلاه ، استنتج أن سلوك TDs يتم تفسيره جيدا من خلال النموذج القائم على قوة الصورة لأسطح النمو على TDD. من أجل فهم تفاعل TD مع السطح ، لاحظنا TDs مع STEM مقطعي مشرق المجال. لوحظ وجود عيب يتم ثنيه وإنهاؤه على سطح فراغ شبه أسطواني في الشكل 8 أ. يشبه سلوك TD هذا إلى حد كبير المسارات المحسوبة لل TDs الموضحة في الشكل 3. ومع ذلك ، فإن المسار المرصود ل TD لا يعيد إنتاج المسار الذي توقعناه في الشكل 3. سيتم تفسير الفرق على أنه نتيجة لتحويل TD من أجل تقليل طاقته أثناء أو بعد النمو (على سبيل المثال ، انخفاض درجة الحرارة من درجة حرارة النمو إلى درجة حرارة الغرفة). يوضح الشكل 8 ب محاكاة للإجهاد في طبقة Ge الفائقة المندمجة على Si. يتم تحفيز إجهاد الشد في طبقة Ge على Si بسبب عدم تطابق معامل التمدد الحراري بين Ge و Si. تشير المحاكاة إلى أن تراكم الإجهاد يحدث في الجزء العلوي من الفراغات شبه الأسطوانية واسترخاء الإجهاد في الطبقة تحت السطحية للفراغات شبه الأسطوانية ، مما يحفز TDs على التحول.
من ناحية أخرى ، يوضح الشكل 8 ج توليد العيوب في الجزء العلوي من الفراغ ، على الرغم من إزالة نقطة التوليد أثناء تحضير عينة TEM. العيب في الشكل 8 ج قريب من خط مستقيم ، لكن الزاوية بين العيب و (001) المستوى (≈78.3 درجة) لا تتفق مع تلك الخاصة بمستوى {111} (54.7 درجة).
تم الحصول على نمط حيود الإلكترون الموضح في الشكل 8d بالقرب من العيب في الشكل 8 ج. يشير عدم وجود ضوء خط إلى أنه لا ينبغي أن يكون هناك هيكل 2D (أي أن العيب هو خلع). في التقارير السابقة28،29،30،31،37 ، تم تشكيل عيوب ثنائية الأبعاد تظهر ضوءا واضحا في أنماط حيود الإلكترون ، وهو ضد تلك التي لوحظت في العمل الحالي. تدعم نتائج الملاحظة (عدم وجود عيوب 2D) التنبؤ بأن الفراغات وأسطحها الحرة تساهم في إطلاق إجهاد في Ge على Si ، أو تسبب بطريقة أخرى في تضليل البلورة بين طبقات SEG Ge المجاورة. وهذا يتفق مع تقرير سابق يشير بإيجاز إلى أن تشكيل عيوب ثنائية الأبعاد يتم منعه في طبقات SEG Ge المدمجة مع وجود فراغات على أقنعة SiO2 38.
هناك مرشحان لجيل TD كما هو موضح في الشكل 10 ج: توزيع الإجهاد والتوجيه الخاطئ بين طبقات SEG Ge. في Ge فوق المحوري على Si ، يتم تحفيز إجهاد الشد في Ge بسبب عدم تطابق معامل التمدد الحراري بين Ge و Si39. تشير نتيجة المحاكاة الموضحة في الشكل 8 ب إلى تراكم إجهاد الشد (~ 0.5٪) في الجزء العلوي من الفراغ كما ذكر أعلاه. يمكن أن يؤدي تراكم الإجهاد هذا في الجزء العلوي الفارغ إلى توليد TD الموضح في الشكل 8 ج. مرشح آخر ، وهو التضليل بين طبقات SEG Ge ، يفترض أنه يولد عيوبا ثنائية الأبعاد كما لوحظ في التقارير السابقة التي تظهر اندماج طبقات SEG Ge28،29،30،31،37. ومع ذلك ، في العمل الحالي ، سيتم قمع توليد عيوب 2D بسبب وجود فراغات كما ذكر بإيجاز في تقرير سابق38 ، ولكن يؤدي إلى توليد TD بسبب قمع غير كامل. سيتم وصف مناقشة أكثر تفصيلا للخلع الناجم عن سوء التوجيه في جزء لاحق مع الرسوم التوضيحية التخطيطية (الشكل 12).
يوضح الشكل 9 أ والشكل 9 ب صور TEM لعرض مخطط المجال الساطع لطبقة Ge مدمجة (نافذة W = 0.82 ميكرومتر ،قناع W = 0.68 ميكرومتر) وطبقة Ge بطانية ، على التوالي ، نمت على نفس الركيزة. بالنسبة لملاحظات TEM لعرض الخطة ، تم تشكيل عينات TEM باستخدام مناطق 200 نانومتر العليا من طبقات Ge كما هو موضح في الخطوة 2.4.3 ويشار إليها بمربعات حمراء متقطعة في المقاطع العرضية التخطيطية في الجزء العلوي من الشكل 9. تتم محاذاة خطوط قناع SiO2 مع الاتجاه [110] للاندماج Ge في الشكل 9 أ. تم التقاط صورة TEM لعرض المخطط الموضحة في الشكل 9 أ لمنطقة 6 ميكرومتر × 8 ميكرومتر. على الرغم من وجود خمسة أزواج من أقنعة SiO 2 ومناطق نافذة Si في صورة TEM هذه ، إلا أن المناطق الموجودة فوق أقنعة SiO2 ونوافذ Si لا يمكن تمييزها في صورة TEM. وذلك لأن المنطقة المرصودة (أعلى 200 نانومتر) أعلى بكثير من مكان وجود الفراغات شبه الأسطوانية (أسفل 150 نانومتر).
وجد أن TDDs التي تم الحصول عليها من الشكل 9 أ والشكل 9 ب هي 4.8 × 107 / سم 2 و 8.8 × 107 / سم2 ، على التوالي. كما هو موضح في الشكل 7 د ، تكشف قياسات EPD أن TDD في طبقة Ge المدمجة (نافذة W = 0.82 ميكرومتروقناع W = 0.68 ميكرومتر) هي 4 × 107 سم −2. وبالتالي ، فإن TDD في الشكل 9 أ يظهر اتفاقا جيدا مع EPD الموضح في الشكل 7. ومن الجدير بالذكر أيضا أنه لا قياسات EPD ولا ملاحظات TEM تظهر إعادة زيادة TDD ، والتي تظهر بشكل متكرر عندما تتجمع طبقات SEG Ge (أي أن إعادة زيادة TDD بسبب توليد TDs (الشكل 8 ب) يتم قمعها إلى حد يمكن تجاهل إعادة زيادة TDD في نطاق TDD الحالي (بترتيب 107 / سم2)).
تجدر الإشارة إلى أن مساحة خالية من TD بحجم 4 ميكرومتر × 4 ميكرومتر تتحقق في Ge المندمجة ، كما في الشكل 9 أ. على الرغم من أن البطانية Ge في الشكل 9b تظهر TDs بتوزيع موحد نسبيا ، إلا أن Ge المندمجة بها مناطق TDD عالية ومنخفضة. وتشير هذه الاختلافات في توزيع TD إلى أنه يمكن تحقيق المزيد من التخفيض في TDD في Ge المجمعة. 1 TD في منطقة 4 ميكرومتر × 4 ميكرومتر ، والتي لوحظت في الشكل 9 أ ، يتوافق مع TDD من 6.25 × 106 / سم2.
بمقارنة Ge المدمجة (الشكل 9 أ) والبطانية Ge (الشكل 9 ب) ، من الواضح أن أطوال خطوط العيب في Ge المدمجة أطول من تلك الموجودة في بطانية Ge. في Ge المدمجة ، توجد عادة خطوط عيب بطول 1 ميكرومتر ، وهي محاذاة إلى الاتجاه [110]. لاحظ أن الاتجاه [110] هو اتجاه طول خطوط SiO2. هناك تفسيران محتملان لخطوط العيوب الطويلة هذه: (i) يتم ملاحظة عيوب 2D و (ii) تميل الاضطرابات في الاتجاه [110]. ومع ذلك ، يتم رفض عيوب 2D على الفور بسبب عرض العيوب الطويلة المرصودة (على سبيل المثال ، يجب أن تظهر عيوب 2D على {111} الطائرات خطوط عيب أوسع). هندسيا ، يجب أن تظهر عيوب 2D على الطائرات {111} خطوط عيب بعرض 140 نانومتر ، مع مراعاة سمك عينة TEM (200 نانومتر) وزاوية {111} مع (001) طائرة (54.7 درجة). تظهر صورة TEM لعرض المخطط أن خطوط العيب يتراوح عرضها بين 10 و 20 نانومتر ، وهو أضيق بكثير من 140 نانومتر. وبالتالي ، يجب أن تعزى العيوب الموضحة كخطوط طويلة إلى (ii) الاضطرابات المائلة في الاتجاه [110]. يعطي الحساب الهندسي البسيط الزاوية بين الخلع المائل و (001) طائرة: tan−1 (200 nm / 1 μm) = 11.3 درجة. لاحظ أنه ، كما هو موضح في الشكل 8 ب ، تميل TDs في بطانية Ge إلى توجيهها عموديا تقريبا إلى الركيزة إذا لم يتم إجراء التلدين بعد النمو ، مما يظهر نقاطا سوداء صغيرة في صور TEM لعرض المخطط.
لمزيد من التحليل التفصيلي ل TDs المائلة ، يتم ملاحظة منطقة صغيرة ذات TDD عالية بشكل تعسفي كما في الشكل 10. تم تحضير عينة TEM من أعلى 200 نانومتر من طبقة Ge المدمجة ، مثل ملاحظات TEM لعرض الخطة أعلاه.
يظهر الشكل 10 أ والشكل 10 ب الحقل المظلم (g = [220] للشكل 12 أ و [ ] للشكل 12 ب) صور TEM لعرض الخطة تم التقاطها في نفس المنطقة. في الشكل 12 ، لوحظت أربعة خلع مائل في منطقة 4 ميكرومتر × 4 ميكرومتر. يكشف الشكل 10 ب أن خلعا مائلا واحدا (الخلع ذو الدائرة الحمراء) يختفي عندما يختفي متجه الحيود g = [] ، مما يشير إلى أن متجه البرغر محدد على أنه [110] أو [
] للشكل 12 ب) صور TEM لعرض الخطة تم التقاطها في نفس المنطقة. في الشكل 12 ، لوحظت أربعة خلع مائل في منطقة 4 ميكرومتر × 4 ميكرومتر. يكشف الشكل 10 ب أن خلعا مائلا واحدا (الخلع ذو الدائرة الحمراء) يختفي عندما يختفي متجه الحيود g = [] ، مما يشير إلى أن متجه البرغر محدد على أنه [110] أو [
 ] للخلع ذي الدائرة الحمراء. نظرا لأن خط العيب في الاتجاه [110] ، فقد وجد أن الخلع هو خلع لولبي. تعزى الاختلالات الثلاثة الأخرى المائلة (تلك ذات الدائرة الخضراء) إلى الخلع المختلط لأنها لم تختف أيا كان ناقل الحيود g الذي تم اختياره.
] للخلع ذي الدائرة الحمراء. نظرا لأن خط العيب في الاتجاه [110] ، فقد وجد أن الخلع هو خلع لولبي. تعزى الاختلالات الثلاثة الأخرى المائلة (تلك ذات الدائرة الخضراء) إلى الخلع المختلط لأنها لم تختف أيا كان ناقل الحيود g الذي تم اختياره.
هناك تفسيران محتملان لميل TDs في طبقات Ge المدمجة: (i) نمو Ge في [110] الاتجاه ، و (ii) توليد العيوب عندما تتجمع طبقات SEG Ge.
نمو Ge في [110] الاتجاه
يوضح الشكل 11 صورة SEM لعرض المخطط وعملية النمو لتشكيل طبقة فوقية مسطحة من سطح SEG غير مستو كفيلم تخطيطي. يعكس تموج حافة أنماط شريط SiO 2 التي شكلتها الطباعة الحجرية EB والنقش الكيميائي الرطب ، يبدأ الالتحام بشكل تفضيلي في بعض النقاط ، ثم يستمر في الاتجاهين [110] و [ ] فوق أقنعة SiO2. يوضح الشكل 11 ب والشكل 11 ج بشكل تخطيطي منظر عين الطائر وعرض المقطع العرضي (
] فوق أقنعة SiO2. يوضح الشكل 11 ب والشكل 11 ج بشكل تخطيطي منظر عين الطائر وعرض المقطع العرضي ( ) عندما يتم دمج طبقات SEG Ge جزئيا. يظهر TD المتولد في نافذة النمو فوق الفراغ كما هو موضح في الشكل 3 ، ثم تبدأ TDs في الانتشار في الاتجاه [110] أو [
) عندما يتم دمج طبقات SEG Ge جزئيا. يظهر TD المتولد في نافذة النمو فوق الفراغ كما هو موضح في الشكل 3 ، ثم تبدأ TDs في الانتشار في الاتجاه [110] أو [ ] بسبب قوة الصورة. هذا يؤدي إلى TDs تميل في الاتجاه [110] (كما في الشكل 9 أ). يظهر الخط المتصل الأحمر في الشكل 11 ج انحناء TD في الاتجاه [110] وفقا للنموذج أعلاه ، وهو ما يفسر وجود TDs المائلة التي لوحظت في الشكل 9 أ والشكل 10 على أساس نوعي.
] بسبب قوة الصورة. هذا يؤدي إلى TDs تميل في الاتجاه [110] (كما في الشكل 9 أ). يظهر الخط المتصل الأحمر في الشكل 11 ج انحناء TD في الاتجاه [110] وفقا للنموذج أعلاه ، وهو ما يفسر وجود TDs المائلة التي لوحظت في الشكل 9 أ والشكل 10 على أساس نوعي.
يمكن للآلية أن تشرح كلا من TDs الحافة والمسمار ، مع مراعاة متجهات البرغر ل TDs المتولدة في واجهات Ge / Si40. عندما ينمو Ge على ركيزة Si ، يتم تشكيل خلع الحافة غير الملائمة (MDs) لتحرير الإجهاد ، ويتم محاذاة MDs في الاتجاه [110] أو [ ]. تشكل MDs مقاطع خيوط (أي TDs) ، ومتجهات البرغر ل TDs التي نشأت من MDs المحاذية في الاتجاه [110] (MD110) هي a / 2 [] أو a / 2 [
]. تشكل MDs مقاطع خيوط (أي TDs) ، ومتجهات البرغر ل TDs التي نشأت من MDs المحاذية في الاتجاه [110] (MD110) هي a / 2 [] أو a / 2 [
 ] (a: ثابت الشبكة). من ناحية أخرى ، فإن متجهات البرغر هي a / 2 [110] أو a / 2 [] ل TDs التي نشأت من MDs محاذاة في [
] (a: ثابت الشبكة). من ناحية أخرى ، فإن متجهات البرغر هي a / 2 [110] أو a / 2 [] ل TDs التي نشأت من MDs محاذاة في [
 ] الاتجاه (
] الاتجاه ( ). في حالة ميل TDs من MD 110 إلى الاتجاه [110] ، تظهر ملاحظات TEM لعرض الخطة أن TDs هي خلع الحافة. وبالمثل ، عندما تميل TDs من
). في حالة ميل TDs من MD 110 إلى الاتجاه [110] ، تظهر ملاحظات TEM لعرض الخطة أن TDs هي خلع الحافة. وبالمثل ، عندما تميل TDs من  الاتجاه [110] ، يتم ملاحظتها على أنها خلع لولبي.
الاتجاه [110] ، يتم ملاحظتها على أنها خلع لولبي.
توليد العيوب عندما تتجمع طبقات SEG Ge
يوضح الشكل 12 مخططات تشرح توليد العيوب عندما تتجمع طبقات SEG Ge مع دوران صغير (أي سوء التوجيه). كما هو موضح بشكل تخطيطي في الشكل 12 ، يجب أن يؤدي التوجيه الخاطئ إلى حدوث خلع في الحافة / المسمار / المختلط عند واجهة الاندماج. في الشكل 12 ، يتحلل التوجيه الخاطئ بين طبقتين SEG Ge في الاتجاه [110] إلى ثلاثة أنواع من الدوران. يوضح الشكل 12a-12c الدوران حول المحور [110] والمحور [001] والمحور [ ] ، على التوالي.
] ، على التوالي.
يفترض أن يحدث الالتحام في الشكل 12 بين طبقة Ge فوقية صارمة (Ge (001)) وطبقة SEG Ge مجاورة مع توجيه خاطئ (m-Ge). يؤدي الدوران حول المحور [110] (الشكل 12 أ) إلى توليد خلع الحافة الموازي للاتجاه [110] عند الحدود المشار إليه كخط متقطع. وبالمثل ، كما في الشكل 12 ب ، يتم إنشاء خلع الحافة الموازي للاتجاه [001] نتيجة الدوران حول المحور [001]. من ناحية أخرى ، فإن الدوران حول المحور [] ، الموضح في الشكل 12 ج ، يولد شبكة خلع لولبية ، والتي تتكون من خلع b = [110] و b = [ 001] ، على غرار حالة الترابط المباشر لأسطح Si (001) التي تظهر شبكة خلع المسمار41. يمكن أن يعزى المسمار TD الملاحظ في الشكل 10 إلى الالتحام مع سوء توجيه الدوران حول [
001] ، على غرار حالة الترابط المباشر لأسطح Si (001) التي تظهر شبكة خلع المسمار41. يمكن أن يعزى المسمار TD الملاحظ في الشكل 10 إلى الالتحام مع سوء توجيه الدوران حول [ ] المحور. يمكن أن يفسر الجمع بين الدورات حول المحور [110] (الشكل 12 أ) وحول المحور [
] المحور. يمكن أن يفسر الجمع بين الدورات حول المحور [110] (الشكل 12 أ) وحول المحور [ ] (الشكل 12 ج) TDs المختلطة الموضحة في الشكل 12. يتم تفسير الخلع المختلط الموضح في الشكل 9 ب أيضا من خلال الجمع بين الدوران حول المحور [001] (الشكل 12 ب) والدوران على المحور [
] (الشكل 12 ج) TDs المختلطة الموضحة في الشكل 12. يتم تفسير الخلع المختلط الموضح في الشكل 9 ب أيضا من خلال الجمع بين الدوران حول المحور [001] (الشكل 12 ب) والدوران على المحور [ ] (الشكل 12 ج).
] (الشكل 12 ج).
بافتراض أن الاضطرابات الناتجة عن التوجيه الخاطئ تتولد بكثافة 1 × 107 / سم2 ، يقدر متوسط زاوية الدوران حول المحور [ ] ب 0.034 درجة 42. مقارنة بالتقدير ، أبلغنا بالفعل أن هناك تقلبات في الاتجاه في طبقة SEG Ge على شكل خط ل 100 ثانية قوسية (= 0.028 درجة) ، باستخدام ملاحظات حيود الأشعة السينية ذات الحزمة الدقيقة43. تظهر التقلبات المبلغ عنها في الاتجاه وزاوية الدوران المقدرة اتفاقا جيدا ، مما يدعم آلية توليد TD القائمة على التوجيهات الخاطئة.
] ب 0.034 درجة 42. مقارنة بالتقدير ، أبلغنا بالفعل أن هناك تقلبات في الاتجاه في طبقة SEG Ge على شكل خط ل 100 ثانية قوسية (= 0.028 درجة) ، باستخدام ملاحظات حيود الأشعة السينية ذات الحزمة الدقيقة43. تظهر التقلبات المبلغ عنها في الاتجاه وزاوية الدوران المقدرة اتفاقا جيدا ، مما يدعم آلية توليد TD القائمة على التوجيهات الخاطئة.

الشكل 1: الرسوم التوضيحية التخطيطية لأقنعة SEG على شكل خط ومساحة و 4 مم مربعة على ركيزة Si (001). الرجاء الضغط هنا لعرض نسخة أكبر من هذا الشكل.

الشكل 2: صور لأجزاء من آلة UHV-CVD ؛ خزانة الغاز ، غرفة المعالجة ، غرفة قفل الحمل ، وكمبيوتر التشغيل. يرجى النقر هنا لعرض نسخة أكبر من هذا الشكل.
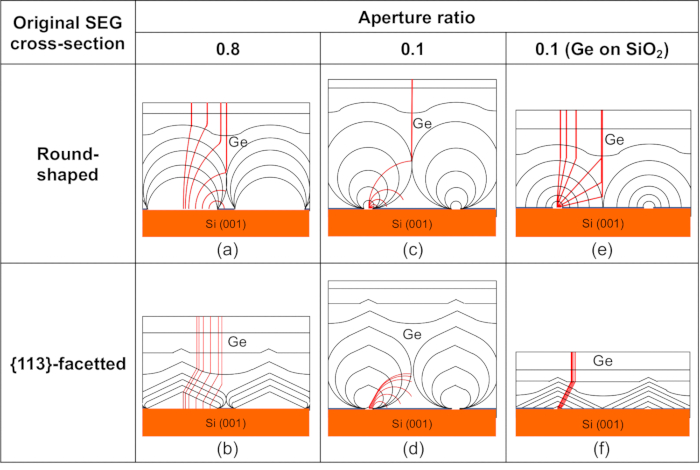
الشكل 3: المسارات المحسوبة ل 4 TDs في (أ) أصل SEG دائري الشكل ، نسبة الفتحة = 0.8 ، (ب) أصل SEG دائري الشكل ، نسبة الفتحة = 0.1 ، (ج) أصل SEG ذو {113} أوجه ، نسبة الفتحة = 0.8 ، و (د) أصل SEG ذو {113} أوجه ، نسبة الفتحة = 0.1. يرجى النقر هنا لعرض نسخة أكبر من هذا الشكل.
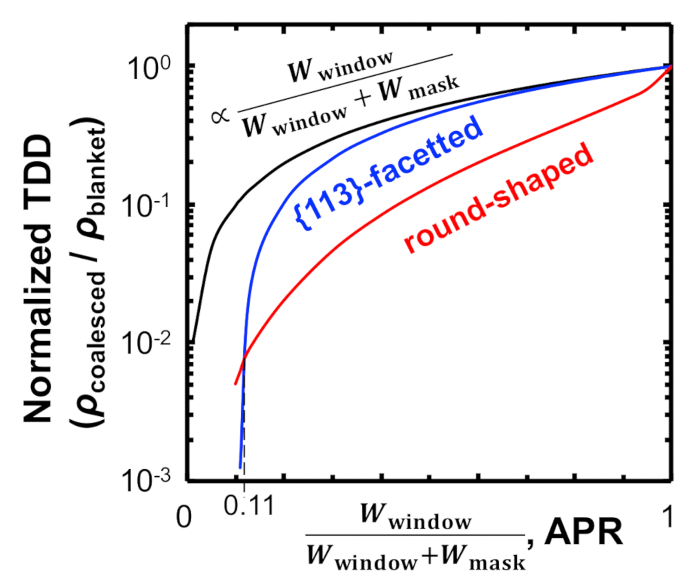
الشكل 4: نشأت TDDs المحسوبة في Ge المندمجة من SEG Ge ذو {113} الأوجه (الخط الأزرق) و SEG Ge المستدير الشكل (الخط الأحمر). يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.

الشكل 5: خرائط التوزيع وصور SEM لطبقات Ge المدمجة / غير المندمجة. الرجاء الضغط هنا لعرض نسخة أكبر من هذا الشكل.

الشكل 6: (أ) صورة HAADF STEM مقطعية مستعرضة ل Ge المندمجة (نافذة W = 0.66 ميكرومتر ، قناع W = 0.84 ميكرومتر) نمت عند 700 درجة مئوية مع طبقات ترسيم Si 0.3 Ge 0.7 بسمك 10 نانومتر ، و (ب) رسم تخطيطي يتوافق مع الشروط الموضحة في (أ). يرجى النقر هنا لعرض نسخة أكبر من هذا الشكل.

الشكل 7: صور AFM النموذجية من أجل قياس EPDs من أجل (أ) Ge الملتحم بسمك 1.15 ميكرومتر نمت عند 700 درجة مئوية (نافذة W = 0.66 ميكرومتر وقناع W = 0.44 ميكرومتر) ، (ب) Ge بسمك 2.67 ميكرومتر نمت عند 650 درجة مئوية (نافذة W = 0.86 ميكرومتر وقناع W = 0.34 ميكرومتر) ، و (ج) بطانية بسمك 1.89 ميكرومتر نمت Ge عند 700 درجة مئوية ، وملخص نتائج قياس EPD في (د). يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
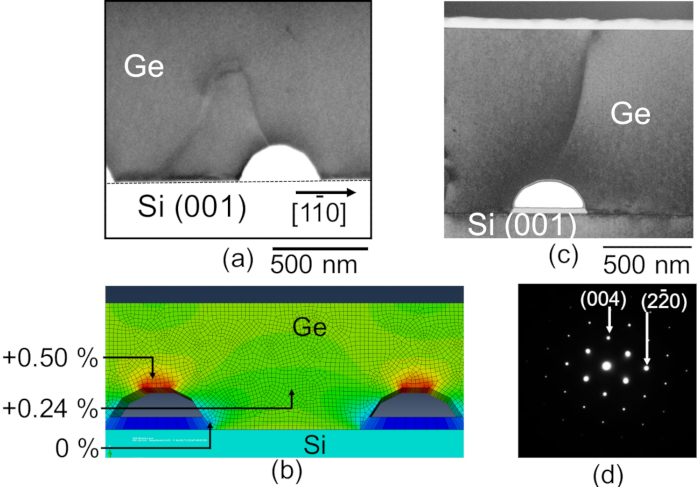
الشكل 8: (110) صور المقطع العرضي (أ) STEM و (ب) صور TEM لطبقات Ge المدمجة (نافذة W = 0.66 ميكرومتر وقناع W = 0.44 ميكرومتر) ، (ج) نمط حيود الإلكترون الذي تم الحصول عليه بالقرب من العيب الموضح في (ب) ، و (د) طريقة محاكاة العناصر المحدودة نتيجة توزيع الانفعال في Ge المدمج. تم تعديل الأشكال 9 (أ) و (ج) و (د) من 20. يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
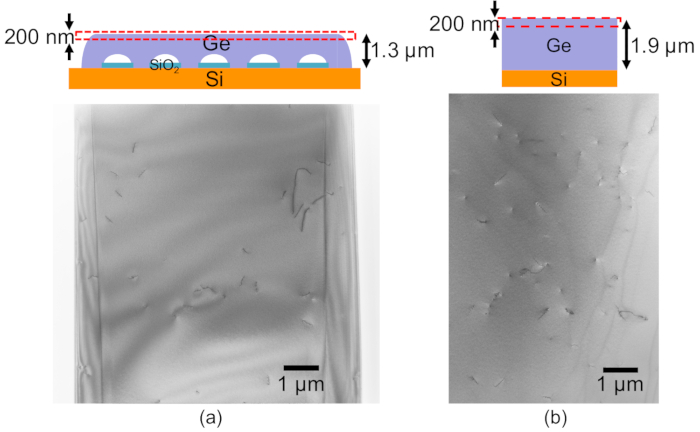
الشكل 9: صور TEM لعرض مخطط المجال الساطع ل (أ) طبقة Ge مدمجة (نافذة W = 0.82 ميكرومتر ، قناع W = 0.68 ميكرومتر) و (ب) طبقة Ge بطانية. يرجى النقر هنا لعرض نسخة أكبر من هذا الشكل.
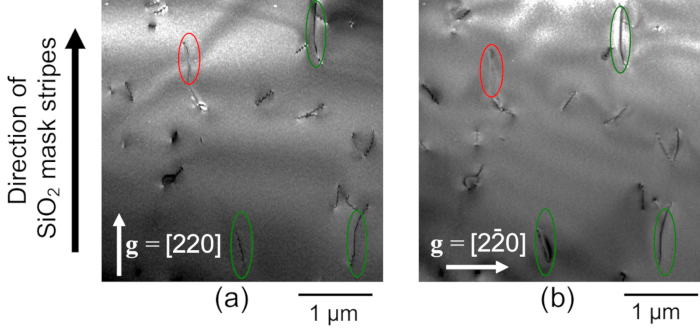
الشكل 10: صور TEM لعرض الخطة لمنطقة صغيرة عالية TDD مع متجهات g (أ) [220] و (ب) [ ]. تم تعديل هذا الرقم من 20. يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
]. تم تعديل هذا الرقم من 20. يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
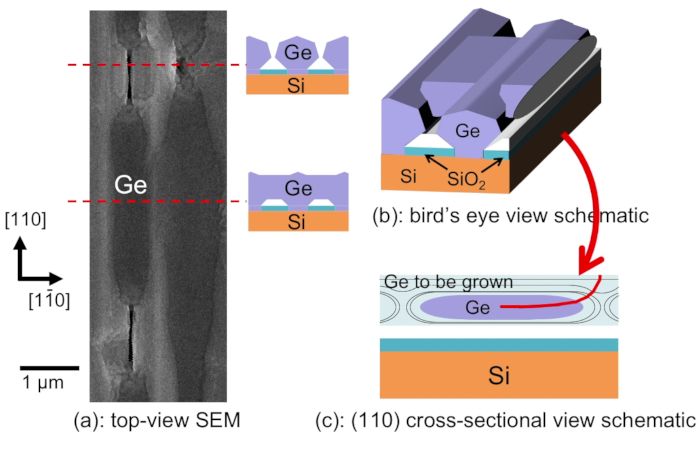
الشكل 11: (أ) صورة SEM لعرض المخطط ، (ب) صورة تخطيطية عين الطائر ، و (ج) صورة تخطيطية مقطعية مستعرضة ل SEG Ge مدمج جزئيا. تم تعديل هذا الرقم من 20. الرجاء الضغط هنا لتحميل هذا الفيديو.
صورة تخطيطية مقطعية مستعرضة ل SEG Ge مدمج جزئيا. تم تعديل هذا الرقم من 20. الرجاء الضغط هنا لتحميل هذا الفيديو.
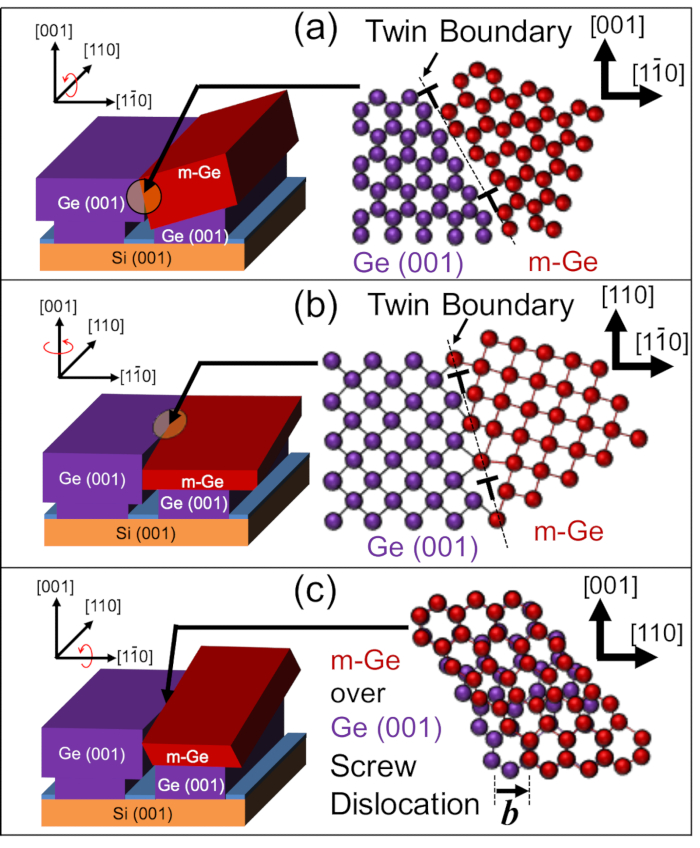
الشكل 12: مخططات توليد العيوب عندما تتحد طبقات SEG Ge مع دوران البلورة حول (أ) [110] و (ب) [001] و (ج) [ ] الاتجاه. تم تعديل هذا الرقم من 20. يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
] الاتجاه. تم تعديل هذا الرقم من 20. يرجى النقر هنا لعرض نسخة أكبر من هذا الرقم.
| أسلوب | تحقيق TDD (سم-2) | درجة الحرارة (°C) | سمك الطبقة العازلة |
| التلدين الحراري | 2e7 | ≈900 درجة مئوية | ≈100 نانومتر (عازلة درجة حرارة منخفضة) |
| SiGe المخزن المؤقت المتدرج | 1e6 | درجة حرارة النمو (600-700 درجة مئوية) | 2-3 ميكرومتر |
| فن | 1e6 | درجة حرارة النمو (600-700 درجة مئوية) | 500-1000 نانومتر |
| Si بذور العمود | 1e5 | ≈800 درجة مئوية | ≈5 ميكرومتر |
| هذا العمل | 4e7 | درجة حرارة النمو (700 درجة مئوية) | ≈150 نانومتر |
الجدول 1: ملخص ل TDD المحققة والعيوب في ضوء تطبيق الجهاز الضوئي لطرق تخفيض TDD التقليدية / المقدمة.
الشكل التكميلي 1: أربع طرق نموذجية تستخدم على نطاق واسع لتقليل TDD في Ge الفوقي على Si: (أ) التلدين الحراري ، (ب) المخزن المؤقت المتدرج SiGe ، (ج) محاصرة نسبة العرض إلى الارتفاع (ART) ، و (د) بذور عمود Si. الرجاء الضغط هنا لتنزيل هذا الرقم.
فيديو تكميلي 1: رسوم توضيحية تخطيطية لثني TD بسبب قوة الصورة في SEG Ge دائري الشكل. الرجاء الضغط هنا لتحميل هذا الفيديو.
Discussion
في العمل الحالي ، تم عرض TDD من 4 × 107 / سم2 تجريبيا. لمزيد من تخفيض TDD ، هناك أساسا 2 خطوات حاسمة داخل البروتوكول: إعداد قناع SEG ونمو Ge فوق المحوري.
يشير نموذجنا الموضح في الشكل 4 إلى أنه يمكن تقليل TDD أقل من 107 / سم2 في Ge المندمجة عندما يكون APR ،نافذة W / (نافذة W +قناع W) صغيرا مثل 0.1. نحو مزيد من الحد من TDD ، يجب تحضير أقنعة SEG ذات معدل الفائدة السنوية الأصغر. كما هو مذكور في الخطوة 2.1.2 ، كانت القيم الدنيالنافذة Wوقناع W 0.5 ميكرومتر و 0.3 ميكرومتر ، على التوالي ، محدودة بالدقة في نظام الطباعة الحجرية EB المستخدم. تتمثل إحدى الطرق البسيطة لتقليل معدل الفائدة السنوية في تعديل عمليات الطباعة الحجرية والنقش (على سبيل المثال ، استخدام مقاومة ضوئية أخرى ، واستخدام نظام طباعة حجرية أفضل ، واستخدام طبقات SiO2 أرق مع حفر BHF ضحل ، وما إلى ذلك). ستمكن عملية الطباعة الحجرية والنقش الناضجة أقنعة SEG الأضيق من 100 نانومتر. في العمل الحالي ، تم الحصول على Ge المدمج مع سطح علوي مسطح عندماW قناع≤1 ميكرومتر. وبالتالي ، فإننافذة W 100 نانومتروقناع W 900 نانومتر (APR = 0.1) ستعطينا Ge المدمجة مع سطح علوي مسطح في ظروف النمو الحالية.
بالإضافة إلى ذلك ، يجب أن يؤدي تعديل إعداد قناع SEG إلى تموج أقل لحواف أقنعة SEG ، مما يؤدي إلى قمع التوجيه الخاطئ بين طبقات Ge SEG. سيتم قمع توليد TD عندما تتجمع طبقات SEG Ge (الشكل 11) نتيجة لتعديل تحضير قناع SEG.
كما كشفت نتائج الحساب (الشكل 3) ، يلزم قمع نمو Ge على SiO2 لتقليل TDD. يتم قمع نمو Ge على SiO 2 عن طريق تعديل خطوة نمو Ge (أي ارتفاع درجة حرارة النمو ، ودوران قناع SEG ، وإدخال غاز H2 ، وتقليل ضغط غاز GeH4 44,45).
تتفوق طريقة اختزال TDD المقترحة / التي تم التحقق منها في العمل الحالي على الطرق الحالية من حيث التطبيق على الأجهزة الضوئية Ge (أي يتم تقليل TDD دون أي تلدين حراري أو طبقات عازلة سميكة). كانت درجة حرارة العملية القصوى 700 درجة مئوية ، وهي درجة حرارة النمو ، وكان ارتفاع الفراغ ≈150 نانومتر. بالمقارنة مع الطرق الحالية ، تكون درجة الحرارة القصوى أقل من درجة حرارة التلدين (عادة 900 درجة مئوية) 7 ، وارتفاع الفراغ أقل عمقا من الطبقات العازلة المتدرجة SiGe (عادة عدة ميكرومتر) 10 ، وخنادق SiO2 ل ART (عادة 0.5-1 ميكرومتر) 13 ، والطبقة العازلة لنمو Ge على أعمدة Si (عادة ≈5 ميكرومتر) 18. ويلخص الجدول 1 المقارنة بين الطرق التقليدية/المقدمة.
بالنظر إلى بصمة جهاز فوتوني Ge نموذجي (≈100 ميكرومتر 2) ، فإن TDD أقل من 106 / سم2 ، وعدد من TD < 1 / الجهاز سيكون الهدف النهائي. نظرا لأن الحد النظري ل TDD لهذه الطريقة هو 0 ، فمن المحتمل أن يكون TDD أقل من 106 / سم2 قابلا للتحقيق. نحو الهدف ، سيتم التحقيق في الطباعة الحجرية والنقش الأكثر تحسينا.
Disclosures
ليس لدى المؤلفين ما يكشفون عنه.
Acknowledgements
تم دعم هذا العمل ماليا من قبل الجمعية اليابانية لتعزيز العلوم (JSPS) KAKENHI (17J10044) من وزارة التعليم والثقافة والرياضة والعلوم والتكنولوجيا (MEXT) ، اليابان. تم دعم عمليات التصنيع من قبل "منصة تكنولوجيا النانو" (المشروع رقم 12024046) ، MEXT ، اليابان. ياماشيتا والسيدة س. هيراتا، من جامعة طوكيو، على مساعدتهما في ملاحظات فريق الخبراء التقني.
Materials
| Name | Company | Catalog Number | Comments |
| AFM | SII NanoTechnology | SPI-3800N | |
| BHF | DAIKIN | BHF-63U | |
| CAD design | AUTODESK | AutoCAD 2013 | Software |
| CH3COOH | Kanto-Kagaku | Acetic Acid | for Electronics |
| CVD | Canon ANELVA | I-2100 SRE | |
| Developer | ZEON | ZED | |
| Developer rinse | ZEON | ZMD | |
| EB writer | ADVANTEST | F5112+VD01 | |
| Furnace | Koyo Thermo System | KTF-050N-PA | |
| HF, 0.5 % | Kanto-Kagaku | 0.5 % HF | |
| HF, 50 % | Kanto-Kagaku | 50 % HF | |
| HNO3, 61 % | Kanto-Kagaku | HNO3 1.38 | for Electronics |
| I2 | Kanto-Kagaku | Iodine 100g | |
| Photoresist | ZEON | ZEP520A | |
| Photoresist remover | Tokyo Ohka | Hakuri-104 | |
| Surfactant | Tokyo Ohka | OAP | |
| TEM | JEOL | JEM-2010HC |
References
- Giovane, L. M., Luan, H. C., Agarwal, A. M., Kimerling, L. C. Correlation between leakage current density and threading dislocation density in SiGe p-i-n diodes grown on relaxed graded buffer layers. Applied Physics Letters. 78 (4), 541-543 (2001).
- Wang, J., Lee, S. Ge-photodetectors for Si-based optoelectronic integration. Sensors. 11, 696-718 (2011).
- Ishikawa, Y., Saito, S. Ge-on-Si photonic devices for photonic-electronic integration on a Si platform. IEICE Electronics Express. 11 (24), 1-17 (2014).
- Cai, Y. Materials science and design for germanium monolithic light source on silicon, Ph.D. dissertation. , Dept. Mater. Sci. Eng., Massachusetts Inst. Technol. Cambridge, MA, USA. (2009).
- Wada, K., Kimerling, L. C. Photonics and Electronics with Germanium. , Wiley. Hoboken, NJ, USA. 294(2015).
- Higashitarumizu, N., Ishikawa, Y. Enhanced direct-gap light emission from Si-capped n+-Ge epitaxial layers on Si after post-growth rapid cyclic annealing: Impact of non-radiative interface recombination toward Ge/Si double heterostructure lasers. Optics Express. 25 (18), 21286-21300 (2017).
- Luan, H. C., et al. High-quality Ge epilayers on Si with low threading-dislocation densities. Applied Physics. Letters. 75 (19), 2909-2911 (1999).
- Nayfeha, A., Chui, C. O., Saraswat, K. C. Effects of hydrogen annealing on heteroepitaxial-Ge layers on Si: Surface roughness and electrical quality. Applied Physics Letters. 85 (14), 2815-2817 (2004).
- Choi, D., Ge, Y., Harris, J. S., Cagnon, J., Stemmer, S. Low surface roughness and threading dislocation density Ge growth on Si (001). Journal of Crystal Growth. 310 (18), 4273-4279 (2008).
- Currie, M. T., Samavedam, S. B., Langdo, T. A., Leitz, C. W., Fitzgerald, E. A. Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing. Applied Physics Letters. 72 (14), 1718-1720 (1998).
- Liu, J. L., Tong, S., Luo, Y. H., Wan, J., Wang, K. L. High-quality Ge films on Si substrates using Sb surfactant-mediated graded SiGe buffers. Applied Physics Letters. 79 (21), 3431-3433 (2001).
- Yoon, T. S., Liu, J., Noori, A. M., Goorsky, M. S., Xie, Y. H. Surface roughness and dislocation distribution in compositionally graded relaxed SiGe buffer layer with inserted-strained Si layers. Applied Physics Letters. 87 (1), 012014(2005).
- Langdo, T. A., Leitz, C. W., Currie, M. T., Fitzgerald, E. A., Lochtefeld, A., Antoniadis, D. A. High quality Ge on Si by epitaxial necking. Applied Physics Letters. 76 (25), 3700-3702 (2000).
- Park, J. S., Bai, J., Curtin, M., Adekore, B., Carroll, M., Lochtefeld, A. Defect reduction of selective Ge epitaxy in trenches on Si(001) substrates using aspect ratio trapping. Applied Physics Letters. 90 (5), 052113(2007).
- Fiorenza, J. G., et al. Aspect ratio trapping: A unique technology for integrating Ge and III-Vs with silicon CMOS. ECS Transactions. 33 (6), 963-976 (2010).
- Salvalaglio, M., et al. Engineered Coalescence by Annealing 3D Ge Microstructures into High-Quality Suspended Layers on Si. Applied Materials & Interfaces. 7 (34), 19219-19225 (2015).
- Bergamaschini, R., et al. Self-aligned Ge and SiGe three-dimensional epitaxy on dense Si pillar arrays. Surface Science Reports. 68 (3), 390-417 (2013).
- Isa, F., et al. Highly Mismatched, Dislocation-Free SiGe/Si Heterostructures. Advanced Materials. 28 (5), 884-888 (2016).
- Yako, M., Ishikawa, Y., Wada, K. Coalescence induced dislocation reduction in selectively grown lattice-mismatched heteroepitaxy: Theoretical prediction and experimental verification. Journal of Applied Physics. 123 (18), 185304(2018).
- Yako, M., Ishikawa, Y., Abe, E., Wada, K. Defects and Their Reduction in Ge Selective Epitaxy and Coalescence Layer on Si With Semicylindrical Voids on SiO2 Masks. IEEE Journal of Selected Topics in Quantum Electronics. 24 (6), 8201007(2018).
- Park, J. S., Bai, J., Curtin, M., Carroll, M., Lochtefeld, A. Facet formation and lateral overgrowth of selective Ge epitaxy on SiO2-patterned Si(001) substrates. Journal of Vacuum Science & Technology B. 26 (1), 117-121 (2008).
- Bai, J., et al. Study of the defect elimination mechanisms in aspect ratio t.rapping Ge growth. Applied Physics Letters. 90 (10), 101902(2007).
- Montalenti, F., et al. Dislocation-Free SiGe/Si Heterostructures. Crystals. 8 (6), 257(2018).
- Zhang, H. L. Calculation of shuffle 60° dislocation width and Peierls barrier and stress for semiconductors silicon and germanium. European Physical Journal B. 81 (2), 179-183 (2011).
- Kim, M., Olubuyide, O. O., Yoon, J. U., Hoyt, J. L. Selective Epitaxial Growth of Ge-on-Si for Photodiode Applications. ECS Transactions. 16 (10), 837-847 (2008).
- Yako, M., Kawai, N. J., Mizuno, Y., Wada, K. The kinetics of Ge lateral overgrowth on SiO2. Proceedings of MRS Fall Meeting. , (2015).
- Kamino, T., Yaguchi, T., Hashimoto, T., Ohnishi, T., Umemura, K. A FIB Micro-Sampling Technique and a Site Specific TEM Specimen Preparation Method. Introduction to Focused Ion Beams. , Springer. Boston, MA. (2005).
- Park, J. S., et al. Low-defect-density Ge epitaxy on Si(001) using aspect ratio trapping and epitaxial lateral overgrowth. Electrochemical and Solid-State Letters. 12 (4), H142-H144 (2009).
- Li, Q., Jiang, Y. B., Xu, H., Hersee, S., Han, S. M. Heteroepitaxy of high-quality Ge on Si by nanoscale Ge seeds grown through a thin layer of SiO2. Applied Physics Letters. 85 (11), 1928-1930 (2004).
- Halbwax, M., et al. Epitaxial growth of Ge on a thin SiO2 layer by ultrahigh vacuum chemical vapor deposition. Journal of Crystal Growth. 308 (1), 26-29 (2007).
- Leonhardt, D., Ghosh, S., Han, S. M. Origin and removal of stacking faults in Ge islands nucleated on Si within nanoscale openings in SiO2. Journal of Applied Physics. 10 (7), 073516(2011).
- Takada, Y., Osaka, J., Ishikawa, Y., Wada, K. Effect of Mesa Shape on Threading Dislocation Density in Ge Epitaxial Layers on Si after Post-Growth Annealing. Japanese Journal of Applied Physics. 49 (4S), 04DG23(2010).
- Ishikawa, Y., Wada, K. Germanium for silicon photonics. Thin Solid Films. 518 (6), S83-S87 (2010).
- Nagatomo, S., Ishikawa, Y., Hoshino, S. Near-infrared laser annealing of Ge layers epitaxially grown on Si for high-performance photonic devices. Journal of Vacuum Science & Technology B. 35 (5), 051206(2017).
- Ayers, J. E., Schowalter, L. J., Ghandhi, S. K. Post-growth thermal annealing of GaAs on Si(001) grown by organometallic vapor phase epitaxy. Journal of Crystal Growth. 125 (1), 329-335 (1992).
- Wang, G., et al. A model of threading dislocation density in strain-relaxed Ge and GaAs epitaxial films on Si (100). Applied Physics Letters. 94 (10), 102115(2009).
- Leonhardt, D., Ghosh, S., Han, S. M. Defects in Ge epitaxy in trench patterned SiO2 on Si and Ge substrates. Journal of Crystal Growth. 335 (1), 62-65 (2011).
- Sammak, A., Boer, W. B., Nanver, L. K. Ge-on-Si: Single-crystal selective epitaxial growth in a CVD reactor. ECS Transactions. 50 (9), 507-512 (2012).
- Ishikawa, Y., Wada, K., Cannon, D. D., Liu, J., Luan, H. C., Kimerling, L. C. Strain-induced band gap shrinkage in Ge grown on Si substrate. Applied Physics Letters. 82 (13), 2044-2046 (2003).
- Bolkhovityanov, Y. B., Gutakovskii, A. K., Deryabin, A. S., Sokolov, L. V. Edge Misfit Dislocations in GexSi1–x/Si(001) (x~1) Heterostructures: Role of Buffer GeySi1–y (y < x) Interlayer in Their Formation. Physics of the Solid State. 53 (9), 1791-1797 (2011).
- Bourret, A. How to control the self-organization of nanoparticles by bonded thin layers. Surface Science. 432 (1), 37-53 (1999).
- Hirth, J. P., Lothe, J. Grain boundaries. Theory of Dislocations, 2nd ed. 19, Wiley. New York, NY, USA. 697-750 (1982).
- Mizuno, Y., Yako, M., Luan, N. M., Wada, K. Strain tuning of Ge bandgap by selective epigrowth for electro-absorption modulators. Proceedings of SPIE Photonics West, San Francisco, CA, USA. 9367, 1-6 (2015).
- Nam, J. H., et al. Lateral overgrowth of germanium for monolithic integration of germanium-on-insulator on silicon. Journal of Crystal Growth. 416 (15), 21-27 (2015).
- Fitch, J. T. Selectivity Mechanisms in Low Pressure Selective Epitaxial Silicon Growth. Journal of The Electrochemical Society. 141 (4), 1046-1055 (1994).
- Ye, H., Yu, J. Germanium epitaxy on silicon. Science and Technology of Advanced Materials. 15 (2), 1-9 (2014).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionExplore More Articles
This article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved