Method Article
חישוב תיאורטי ואימות ניסיוני להפחתת נקעים בשכבות גרמניום אפיטקסיאליות עם חללים סמי-גליליים על סיליקון
In This Article
Summary
חישוב תיאורטי ואימות ניסיוני מוצעים להפחתת צפיפות פריקת השחלה (TD) בשכבות גרמניום אפיטקסיאליות עם חללים גליליים למחצה על סיליקון. מוצגים חישובים המבוססים על האינטראקציה של TDs ופני השטח באמצעות כוח תמונה, מדידות TD ותצפיות במיקרוסקופ אלקטרונים תמסורת של TDs.
Abstract
הפחתת צפיפות פריקת השחלה (TDD) בגרמניום אפיטקסיאלי (Ge) על סיליקון (Si) הייתה אחד האתגרים החשובים ביותר למימוש מעגלים פוטוניים משולבים מונוליטית. המאמר הנוכחי מתאר שיטות חישוב תיאורטיות ואימות ניסיוני של מודל חדשני להפחתת TDD. שיטת החישוב התיאורטית מתארת את כיפוף נקעי השחלה (TDs) בהתבסס על אינטראקציה של TDs ומשטחי צמיחה לא מישוריים של צמיחה אפיטקסית סלקטיבית (SEG) במונחים של כוח תמונת נקע. החישוב מגלה כי נוכחות של חללים על מסכות SiO2 לעזור להפחית TDD. אימות ניסיוני מתואר על ידי גרמניום (Ge) SEG, באמצעות שיטת שיקוע אדים כימיים בוואקום גבוה במיוחד ותצפיות TD של Ge הגדל באמצעות תחריט ומיקרוסקופ אלקטרונים תמסורת חתך (TEM). מומלץ מאוד כי הפחתת TDD תהיה בשל נוכחותם של חללים גליליים למחצה מעל מסכות SiO2 SEG וטמפרטורת הצמיחה. לצורך אימות ניסיוני, שכבות Ge אפיטקסיאליות עם חללים גליליים למחצה נוצרות כתוצאה של SEG של שכבות Ge והתלכדותן . ה-TDDs שהתקבלו בניסוי משחזרים את ה-TDDs המחושבים בהתבסס על המודל התיאורטי. תצפיות TEM בחתך רוחב מגלות כי הן הסיום והן היצירה של TDs מתרחשים בחללים גליליים למחצה. תצפיות TEM במבט תוכניתי חושפות התנהגות ייחודית של TDs ב-Ge עם חללים סמי-גליליים (כלומר, TDs מכופפים להיות מקבילים למסכות SEG ולמצע Si).
Introduction
Epitaxial Ge on Si משכה תחומי עניין משמעותיים כפלטפורמת התקנים פוטוניים פעילה מכיוון ש- Ge יכולה לזהות/לפלוט אור בתחום התקשורת האופטית (1.3-1.6 מיקרומטר) והיא תואמת לטכניקות עיבוד Si CMOS (מוליכים למחצה משלימים של תחמוצת מתכת). עם זאת, מכיוון שאי ההתאמה בסריג בין Ge ו- Si היא גדולה כמו 4.2%, נקעי השחלה (TDs) נוצרים בשכבות Ge epitaxial על Si בצפיפות של ~ 109/cm2. הביצועים של התקנים פוטוניים Ge מתדרדרים על ידי TDs מכיוון ש- TDs פועלים כמרכזי ייצור נשאים בפוטו-גלאים Ge (PDs) ומודולטורים (MODs), וכמרכזי רקומבינציה נשאים בדיודות לייזר (LD). בתורו, הם יגדילו את זרם הדליפה ההפוכה (דליפת J) ב- PDs ו- MODs 1,2,3, ואת זרם הסף (Jth) ב- LDs 4,5,6.
דווח על ניסיונות שונים להפחית את צפיפות TD (TDD) ב-Ge on Si (איור משלים 1). חישול תרמי מגרה תנועה של TDs המוביל להפחתת TDD, בדרך כלל ל 2 x 107/cm2. החיסרון הוא הערבוב האפשרי של Si ו-Ge ודיפוזיה החוצה של דופנטים ב-Ge כמו זרחן 7,8,9 (איור משלים 1a). שכבת החיץ המדורגת SiGe 10,11,12 מגדילה את העוביים הקריטיים ומדכאת את יצירת ה- TD מה שמוביל להפחתת TDD, בדרך כלל ל 2 x 10 6/cm2. החיסרון כאן הוא שהמאגר העבה מפחית את יעילות צימוד האור בין מכשירי Ge ומדריכי גל Si שמתחתיהם (איור משלים 1b). לכידת יחס גובה-רוחב (ART)13,14,15 היא שיטת גידול אפיטקסיאלי סלקטיבי (SEG) ומפחיתה TDs על ידי לכידת TDs בדפנות של תעלות SiO 2 עבות, בדרך כלל ל <1 x 10 6/cm 2. שיטת ART משתמשת במסכת SiO 2 עבה כדי להפחית TDD ב-Ge על פני מסכות SiO2, אשר ממוקמות הרבה מעל Si ויש להן את אותו החיסרון (איור משלים 1b,1c). צמיחת Ge על זרעי עמוד Si וחישול 16,17,18 דומים לשיטת ART, ומאפשרים לכידת TD על ידי יחס גובה-רוחב גבוה צמיחת Ge, ל- <1 x 10 5/cm2. אולם לחישול בטמפרטורה גבוהה עבור התלכדות Ge יש את אותם חסרונות באיור המשלים 1a-c (איור משלים 1d).
כדי להשיג צמיחה אפיטקסיאלית נמוכה של TDD Ge על Si שאינה משוחררת מהחסרונות של השיטות הנ"ל, הצענו הפחתת TDD הנגרמת על ידי התלכדות 19,20 בהתבסס על שתי התצפיות העיקריות הבאות שדווחו עד כה בצמיחת SEG Ge 7,15,21,22,23 1) TDs מכופפים להיות נורמליים למשטחי הגידול (נצפו במיקרוסקופ אלקטרונים בחתך רוחב (TEM)), ו-2) התלכדות של שכבות SEG Ge גורמת להיווצרות חללים סמי-גליליים מעל מסכות SiO2.
הנחנו שה-TDs מכופפים בגלל כוח התמונה ממשטח הצמיחה. במקרה של Ge on Si, כוח התמונה מייצר לחצים של 1.38 GPa ו-1.86 GPa עבור נקעי בורג ונקעי קצה במרחקים של 1 ננומטר מהמשטחים החופשיים, בהתאמה19. לחצי הגזירה המחושבים גדולים משמעותית מלחץ פיירלס של 0.5 GPa שדווח עבור נקעים של 60° ב-Ge24. החישוב חוזה הפחתת TDD בשכבות Ge SEG על בסיס כמותי ותואם היטב את צמיחת SEG Ge19. תצפיות TEM של TDs מתבצעות כדי להבין התנהגויות TD בצמיחת SEG Ge המוצגת ב- Si20. הפחתת TDD הנגרמת על ידי כוח תמונה חופשית מכל חישול תרמי או שכבות חיץ עבות, ולכן מתאימה יותר ליישום התקנים פוטוניים.
במאמר זה, אנו מתארים שיטות ספציפיות לחישוב תיאורטי ואימות ניסיוני המשמשים בשיטת הפחתת TDD המוצעת.
Protocol
1. הליך חישוב תיאורטי
- חישוב מסלולים של TDs. בחישוב, נניח שמסכות SEG דקות מספיק כדי להתעלם מאפקט ART על הפחתת TDD.
- לקבוע משטחי צמיחה ולבטא אותם על ידי משוואה/ות. לדוגמה, בטאו את התפתחות הזמן של חתך בצורת חתך עגול של שכבת SEG Ge עם פרמטר התפתחות הזמן n = i, גבהים של SEG Ge (h i) ורדיסי SEG Ge (ri), כפי שמוצג בסרטון המשלים 1a ו-Eq. (1):

- קבע כיוונים נורמליים עבור מיקום שרירותי על משטחי הצמיחה. עבור חתך הרוחב העגול SEG Ge, תאר את הקו הנורמלי ב- (x i , yi) כ
 - , המוצג בסרטון המשלים 1b כקו אדום. לאחר מכן, קבל את קצה ה- TD (x i+1 , y i+1) מהנקודה (x i , y i) על ידי פתרון המשוואות הבאות בו זמנית:
- , המוצג בסרטון המשלים 1b כקו אדום. לאחר מכן, קבל את קצה ה- TD (x i+1 , y i+1) מהנקודה (x i , y i) על ידי פתרון המשוואות הבאות בו זמנית:
- חשב מסלול של TD אחד בהתאם למיקום של יצירת TD (x 0, 0), כפי שמוצג בסרטון משלים 1c. במילים אחרות, ניתן לחשב מסלול עבור TD שרירותי לפי השיטה שתוארה לעיל.
- חישוב TDD בהנחה ש-TDs חודרים למשטח התחתון ותורמים להפחתת TDD (כלומר, TDs מתחת לנקודה שבה שכבות SEG Ge מתלכדות נלכדות על ידי חללים חצי גליליים ולעולם לא מופיעות על פני השטח העליונים).
- לקבוע משטחי צמיחה ולבטא אותם על ידי משוואה/ות. לדוגמה, בטאו את התפתחות הזמן של חתך בצורת חתך עגול של שכבת SEG Ge עם פרמטר התפתחות הזמן n = i, גבהים של SEG Ge (h i) ורדיסי SEG Ge (ri), כפי שמוצג בסרטון המשלים 1a ו-Eq. (1):
2. הליך אימות ניסיוני
- הכנת מסכת SEG
- לפני ייצור מסכות SEG, הגדירו אזורי גידול Ge על ידי הכנת קובץ עיצוב. בעבודה הנוכחית, הכינו תבניות קו ורווח המיושרות לכיוון [110] ואזורי חלון Si בצורת ריבוע ברוחב 4 מ"מ באמצעות תוכנה מסחרית (למשל, AutoCAD).
- קבע את העיצוב של מסכות SEG (בפרטחלון Wומסיכת W) באמצעות התוכנה. חלון W הוא רוחב החלון (רוחב זרע Si)ומסיכת W היא רוחב מסיכת SiO2 , כך ששכבות SEG Ge יכולות להתמזג עם הסמוכות להן. קבעחלון Wומסיכת W על-ידי ציור מלבנים בלחיצה על Open File → מבנה → מלבן או polyline.
הערה: רוחב המלבנים הופךלחלון W, והמרווח בין המלבנים הופךלמסיכת W. בעבודה הנוכחית, ערכי המינימום שלחלון Wומסיכת W הם 0.5 מיקרומטר ו- 0.3 מיקרומטר, בהתאמה, המוגבלים על ידי הרזולוציה במערכת הליתוגרפיה EB המועסקת. - כסימוכין, ציירו אזורי חלון Si בצורת ריבוע ברוחב 4 מ"מ D, הנחשבים לאזורי השמיכה. לחץ על קובץ פתוח → מבנה → מלבן או פוליליין כדי לצייר את חלון Si בצורת ריבוע. השתמשו בסכמות המוצגות באיור 1 כדי להכין את תבניות הקו והרווח ואת שטח השמיכה המרובעת בגודל 4 מ"מ.
- הכינו מצעים מסוממים מסוג B-Si (001) עם התנגדות של 1-100 Ω∙cm. בעבודה הנוכחית, השתמש במצעי Si בגודל 4 אינץ '. נקו את משטחי המצע בתמיסת פיראנה (תערובת של 20 מ"ל של 30% H 2 O 2ו-80 מ"ל של 96% H2 SO4) לפי הצורך.
- פתחו את המכסה של תנור צינור והעמיסו את מצעי הסי לתוך הכבשן באמצעות מוט זכוכית. בעבודה הנוכחית, לחמצן 10 Si מצעים בו זמנית.
- התחל לנשוף גז N2 יבש לתוך הכבשן על ידי פתיחת שסתום הגז. לאחר מכן, הגדר את קצב זרימת הגז ל -0.5 ליטר / מטר על ידי שליטה בשסתום.
- הגדר את טמפרטורת החישול על-ידי שינוי התוכנית. בעבודה הנוכחית, השתמש ב"שלב תבנית (מצב 2)" והגדר את טמפרטורת התהליך ל -900 מעלות צלזיוס. לאחר מכן, הפעל את התוכנית על ידי דחיפת פונקציה → לרוץ.
- כאשר הטמפרטורה מגיעה ל -900 מעלות צלזיוס, סגור את שסתום N 2 היבש, פתח את שסתום O 2 היבש (זרימת O2 = 1 ליטר / מטר), ושמור למשך שעתיים.
הערה: בצע את שלבים 2.1.9-2.1.16 בחדר צהוב. - מצפים את מצעי Si המחומצנים בסורפקטנט (OAP) באמצעות ציפוי מסתובב ולאחר מכן אופים ב-110°C במשך 90 שניות על פלטה חשמלית.
- לאחר ציפוי פעילי השטח, מצפים את מצעי Si בפוטו-התנגדות (למשל, ZEP520A) באמצעות ציפוי מסתובב ולאחר מכן אופים בחום של 180°C במשך 5 דקות על פלטה חשמלית.
- לטעון את מצעי Si עם פעילי שטח photoresist לתוך סופר קרן אלקטרונים (EB).
- קרא את קובץ העיצוב (שהוכן בשלב 2.1.2) בכותב EB וצור קובץ פעולה (קובץ WEC). הגדר את כמות המינון כ- 120 μC/cm2 בקובץ WEC. עם סיום טעינת המצע, בצע חשיפת EB על-ידי לחיצה על לחצן החשיפה היחידה .
- פרוק את המצע מכותב EB על ידי לחיצה על רקיק נשיאה → פריקה עם סיום החשיפה.
- הכן מפתח photoresist (ZED) ושטיפה עבור המפתח (ZMD) בתא טיוטה. טבלו את מצעי Si החשופים לתוך המפתח במשך 60 שניות בטמפרטורת החדר.
- הסר את מצעי Si מהיזם, ולאחר מכן יבש את המצע עם גז N2 .
- הניחו את מצעי Si המפותחים על פלטה חמה לאפייה בטמפרטורה של 110°C למשך 90 שניות.
- טבלו את מצעי Si בחומצה הידרופלואורית חוצצת (BHF-63SE) למשך דקה אחת על מנת להסיר חלק משכבות SiO2 שנחשפו לאוויר כתוצאה מחשיפה והתפתחות EB.
- הסר את photoresist מן המצע Si על ידי טבילה לתוך מסיר photoresist אורגני (למשל, Hakuri-104) במשך 15 דקות.
- טבלו את מצעי Si בחומצה הידרופלואורית מדוללת 0.5% למשך 4 דקות כדי להסיר את התחמוצת הטבעית הדקה באזורי החלונות, אך כדי לשמור על מסכות SiO2 . לאחר מכן העמיסו על תא שיקוע אדים כימי בוואקום גבוה במיוחד (UHV-CVD) כדי לגדל Ge. איור 2 מראה את מערכת UHV-CVD ששימשה בעבודה הנוכחית.
- צמיחת Ge אפיטקסיאלית
- טען את מצע Si עם מסכות SEG (מיוצרות כמו בשלב 2.1) לתוך תא נעילת עומס.
- הגדר את המאגר/טמפרטורת הגידול הראשית בכרטיסיה מתכון המוצגת במחשב הפעולה. קבע את משכי הזמן לצמיחה העיקרית של Ge כך ששכבות SEG Ge יתמזגו עם שכבות סמוכות. כדי להחליט על משכי הזמן לצמיחה העיקרית, שקול את קצב הצמיחה של Ge במישורי {113}, הקובע את הצמיחה בכיוון המישורי/רוחבי26. בעבודה הנוכחית, הגדר את משכי הזמן לצמיחה העיקרית כ- 270 דקות ו- 150 דקות עבור 650 ° C ו- 700 ° C, בהתאמה.
- לחץ על התחל בחלון הראשי, ולאחר מכן מצע Si מועבר באופן אוטומטי לתוך תא הגידול.
הערה: פרוטוקול על צמיחת Ge אפיטקסיאלית (שלבים 2.2.4-2.2.7) מעובד באופן אוטומטי. - גדל חיץ Ge על מצע Si טעון בטמפרטורה נמוכה (≈380 ° C). השתמש ב- GeH 4 מדולל ב- 9% ב- Ar כגז המקור ושמור על הלחץ החלקי של GeH4 עבור 0.5 Pa במהלך צמיחת החיץ.
- לגדל את השכבה הראשית Ge בטמפרטורה גבוהה. שמור על הלחץ החלקי של GeH4 עבור 0.8 Pa במהלך הצמיחה העיקרית. בעבודה הנוכחית, השתמש בשתי טמפרטורות שונות של 650 ו 700 ° C עבור טמפרטורת הצמיחה העיקרית על מנת להשוות SEG Ge עם חתך בצורת עגול ועם חתך {113} פאות25.
הערה: קצב הצמיחה של Ge במישור (001) היה 11.7 ננומטר לדקה ללא תלות בטמפרטורה. - על מנת להמחיש את האבולוציה של SEG Ge ואת ההתלכדות שלהם, בצע צמיחת Ge עם החדרה תקופתית של שכבות תיחום Si0.3Ge0.7 בעובי 10 ננומטר על מצע Si אחר. שכבות Si0.3Ge0.7 נוצרו באמצעות גזים Si2H6 ו- GeH4. במהלך הגידול של Si0.3Ge 0.7 שכבות, הגדר את הלחץ החלקי של גז Si2H6 על 0.02 Pa ואת הלחץ החלקי של גז GeH4 על0.8 Pa.
- כאשר מצע Si מועבר באופן אוטומטי מתא הגידול לתא נעילת העומס, אווררו את תא נעילת העומס ופרקו את מצע Si באופן ידני.
- מדידות צפיפות בור תחריט (EPD)
- להמיס 32 מ"ג של I2 ב 67 מ"ל של CH3COOH באמצעות מכונת ניקוי קולי.
- ערבבואת I 2-dismsed CH 3COOH, 20 מ"ל של HNO3 ו-10 מ"ל של HF.
- טבלו את מצעי Si שגדלו ב-Ge בתמיסתCH 3 COOH/HNO3/HF/I2 למשך 5-7 שניות על מנת ליצור בורות חרוטים.
- התבונן במשטחי Ge החרוטים במיקרוסקופ אופטי (בדרך כלל 100x) כדי להבטיח שהבורות החרוטים נוצרו בהצלחה.
- השתמש במיקרוסקופ כוח אטומי (AFM) כדי לספור את הבורות החרוטים. הניחו את דגימת Ge החרוטה על במת AFM ולאחר מכן התקרבו לגשושית על ידי לחיצה על גישה אוטומטית.
- החליטו על אזור התצפית באמצעות מיקרוסקופ אופטי משולב עם AFM, וסרוקו חמישה אזורים שונים בגודל 10 מיקרומטר x 10 מיקרומטר. גורם דעיכת המשרעת נקבע באופן אוטומטי.
- תצפיות TEM
- איסוף דגימות TEM משכבות Ge המגובשות/שמיכות באמצעות קרן יון Ge ממוקדת (שיטת דגימת מיקרו FIB)27.
- לטש את דגימות TEM במערכת כרסום יונים באמצעות יוני Ar. בעבודה הנוכחית, יש לדלל את דגימות ה-TEM כך שתצפיות חתך יהיו 150-500 ננומטר בכיוון [110], ותצפיות תוכנית-מבט יהיו 200 ננומטר בכיוון [001].
- לדגימות TEM בתצוגת תוכנית, הגן על המשטחים העליונים של שכבות Ge באמצעות שכבות אמורפיות, ולאחר מכן דק כלפי מטה מהצד התחתון (המצע) של שכבות Ge.
- בצע תצפיות TEM תחת מתח תאוצה של 200 kV. בצע תצפיות TEM (STEM) של סריקת שדה בהיר בחתך רוחב על מנת לצפות בדגימות TEM עבות (500 ננומטר).
- עבור Ge מאוחד עם שכבות תיחום Si0.3Ge0.7 , בצע תצפיות STEM בשדה כהה טבעתי בעל זווית גבוהה (HAADF) תחת מתח תאוצה של 200 kV.
תוצאות
חישוב תיאורטי
איור 3 מראה מסלולים מחושבים של TD ב-6 סוגים של שכבות Ge מאוחדות: כאן אנו מגדירים את יחס הצמצם (APR)כחלון W/(חלון W +מסיכת W). איור 3a מראה מקור SEG בצורת עגול שהתלכד Ge של APR = 0.8. כאן, 2/6 TDs לכודים. איור 3b מראה מקור SEG בעל {113} פאות שהתלכד Ge של APR =0.8. כאן, 0/6 TDs לכודים. איור 3c מראה מקור SEG בצורת עגול שהתלכד Ge של APR = 0.1. כאן, 5/6 TDs לכודים. איור 3d מראה מקור SEG בעל {113} פאות מאוחד Ge של APR = 0.1. כאן, 6/6 TDs לכודים. איור 3e מראה מקור SEG בצורת עגול שהתלכד Ge של APR = 0.1, במקרה ש-Ge גדל על מסכות SiO2 . כאן, 0/6 TDs לכודים. איור 3f מראה מקור SEG בעל {113} פאות שהתלכד Ge של APR = 0.1, במקרה ש-Ge גדל על מסכות SiO2 . כאן, 0/6 TDs לכודים.
המסלולים של 6 TD הנוצרים ב- (x 0, 0), כאשר x 0 = 0.04, 0.1, 0.2, 0.4, 0.6 ו- 0.8 פעמיםחלון W/2, מוצגים כקווים אדומים בכל איור. TDs הממוקמים מעל נקודות ההתלכדות של שתי שכבות SEG Ge אלה מתפשטים כלפי מעלה אל פני השטח העליונים, בעוד TDs מתחת לנקודות מתפשטים כלפי מטה כדי להישאר במשטח הריק מעל מסיכת SiO2.
באיור 3a-3d מניחים ש-SEG Ge לא גדל ב-SiO 2. לפיכך, מניחים כי הדפנות של ה-SEG Ge בעל {113} הפאות הן עגולות כדי לא לגעת באזור המסכה SiO2. ניתן לראות בבירור כי SEG בצורת עגול ולאחר מכן Ge מאוחד יעילים יותר להפחתת TDD ב-APR של 0.8, מאשר במקרה בעל {113} פאות, בעוד ש-Ge בעל פאות {113} ולאחר מכן מאוחד יעילים יותר מ-Ge בצורת עגול ב-APR של 0.1. "חצייה" זו מיוחסת לנוכחותן של פאות {113} ליד ראש ה-SEG: פאות {113} סטיות יותר מהכיוון [001] מאשר משטחים עגולים.
איור 3e ואיור 3f מראים Ge מאוחד ביחס צמצם של 0.1, בהנחה ש-Ge אינו גרעיני ב-SiO 2 אלא מראה הרטבה עם מסכת SiO2, שדווחה באופן נרחב ב-Ge coalescence13,15,22,28,29,30,31 שדווח בעבר. כפי שניתן לראות באיור 3e ובאיור 3f, אין חלל גלילי למחצה בין שני SEG ולכן אף TD אינו לכוד על פני השטח.
איור 4 מראה TDDs מחושבים ב-Ge מאוחד. באיור 4, הקו האדום מראה TDDs מחושבים ב-Ge מאוחד שמקורו ב-SEG Ge העגול, והקו הכחול מראה TDDs מחושבים ב-Ge מאוחד שמקורו ב-SEG Ge בעל {113} הפאות. מכיוון ש-TD ב-Ge על Si מקורו באי-התאמה של הסריג בין Ge ל-Si, ההנחה היא שיצירת TD מתרחשת רק בממשקים בין Ge ו-Si. במילים אחרות, TDD צריך להיות מופחת עם APR.
כאשר APR גדול מ-0.11, ה-SEG Ge העגול יעיל יותר מה-SEG Ge בעל {113} הפאות (איור 3a ואיור 3b). לעומת זאת, כאשר APR קטן מ-0.11, ה-SEG Ge בעל {113} הפאות נעשה יעיל יותר מה-SEG העגול (איור 3c ואיור 3d). כמו באיור 3, מעבר כזה מיוחס לנוכחות של פאות {113} ליד ראש SEG (x 0≈ 0). שימו לב שאיור 3e ואיור 3f תואמים לקו השחור באיור 4, ומראים את ההפחתה של TDD מההפחתה של APR, אבל לא את ההתלכדות (כלומר, להרטבת SEG Ge עם SiO2 יש השפעה שלילית נגד הפחתת TDD).
אימות ניסיוני
איור 5 מראה תמונות טיפוסיות של מיקרוסקופ אלקטרונים סורק חתך (SEM) (איור 5b-5d, 5f) ואת מפות ההתפלגות (איור 5a, 5e) שמראות אם מתרחשת התלכדות או לא. איור 5b-5d, 5f מראה תמונות SEM חתך רוחב של שכבות SEG Ge לא מאוחדות (איור 5b, גדל ב-700°C; איור 5f, גדל ב-650°C), שכבות SEG Ge מאוחדות עם משטח עליון לא שטוח (איור 5c, גדל ב-700°C), ושכבות SEG Ge מאוחדות עם משטח עליון שטוח (איור 5d; גדל ב-700°C). תמונות SEM המוצגות באיור 5b ובאיור 5d מלוטשות על-ידי קרן יונים ממוקדת לאחר שקיעת שכבות הגנת Pt. ההתלכדות מתרחשת כאשרחלון Wומסיכת W קטנים מ- 1 מיקרומטר בתנאי הגידול הנוכחיים. מסכות SEG עםמסכת W של 1 מיקרומטר ומעלה מונעות את ההתלכדות של Ge בגלל הכמות הקטנה של צמיחת Ge בכיוון הצידי26. מסכות SEG עם חלון W של 2 מיקרומטר ומעלה מונעות גם הן את ההתלכדות של Ge, אם כי ההתלכדות התרחשה כאשרחלון W קטן מ-1 מיקרומטר. הסיבה לכך היא שקצב הצמיחה הרוחבי של Ge מעל SiO2 תלויבחלון W 30. התלות בדוגמת המסכה והחלונות מסוכמת באיור 7a (700°C) ובאיור 7e (650°C).
בהשוואה בין שכבות ה-SEG Ge הלא-מאוחדות (איור 4b ואיור 4f), ניתן לראות בבירור שלשכבת SEG Ge שגדלה ב-700°C יש חתך בצורת עגול, בעוד שלשכבת SEG Ge שגדלה ב-650°C יש חתך רוחב בעל {113} פאות. כמו באיור 5b, הצמיחה ב-700°C מראה SEG Ge בצורת עגול ללא צמיחת Ge ב-SiO 2 (כלומר, ללא הרטבה עם מסכת SiO2). לכן, הצמיחה מתקדמת כמו איור 3a ואיור 3c. מצד שני, כמו באיור 5f, SEG Ge בעל {113} פנים מופיע ב-650°C. זה מאוד מרמז כי Ge יראה הרטבה עם מסכת SiO2. לעומת זאת, הקצה הוא עגול (כלומר, לא מרטיב). לכן, הצמיחה ב-650°C נמצאת בין איור 3b (ללא הרטבה) לאיור 3f (הרטבה מושלמת). זה מצביע על כך שהפחתת TDD צריכה להיות בין איור 3b לאיור 3f. בהתחשב בתוצאות התיאורטיות המוצגות באיור 6, הבדלים אלה בחתכי SEG Ge אמורים להשפיע מאוד על TDDs בשכבות Ge המאוחדות.
ההבדל בצמיחת הרטבה ב- SiO2 ניתן להבין כדלקמן. זווית המגע בין Ge ל-SiO2 (θ) נקבעת על ידי משוואת יאנג:

כאן, γ SiO2, γ Ge ו- γint הם SiO 2 אנרגיה חופשית פני השטח, אנרגיה חופשית משטח Ge ואנרגיה חופשית הדדית Ge/SiO2, בהתאמה. הזווית של דופן הצד של SEG Ge הופכת גדולה יותר ככל שצמיחת Ge מתקדמת. כאשר הזווית של דופן הצד של SEG Ge מגיעה לזווית המגע θ, ה-SEG Ge צריך לגדול בכיוון האנכי ([001]) או הרוחבי ([ ]). במקרה של צמיחה של 650 מעלות צלזיוס, הצמיחה האנכית מוגבלת מאוד על ידי {113} הפנים, ולכן SEG Ge מעדיף לגדול בכיוון רוחבי (כלומר, גידול מרטיב). למרות שההרטבה עלולה ליצור נקעים בממשק Ge ו- SiO2, היא תסתיים לבסוף במשטח החלל החצי גלילי. במקרה של צמיחה של 700 מעלות צלזיוס, Ge יכול לגדול בכיוון אנכי, וזווית המגע גדולה מזו של 650 מעלות צלזיוס בגלל γגדול יותר. זו תהיה הסיבה מדוע 650 ° C גדל Ge מראה הרטבה מעל SiO2 בעוד 700 ° C גדל Ge לא.
]). במקרה של צמיחה של 650 מעלות צלזיוס, הצמיחה האנכית מוגבלת מאוד על ידי {113} הפנים, ולכן SEG Ge מעדיף לגדול בכיוון רוחבי (כלומר, גידול מרטיב). למרות שההרטבה עלולה ליצור נקעים בממשק Ge ו- SiO2, היא תסתיים לבסוף במשטח החלל החצי גלילי. במקרה של צמיחה של 700 מעלות צלזיוס, Ge יכול לגדול בכיוון אנכי, וזווית המגע גדולה מזו של 650 מעלות צלזיוס בגלל γגדול יותר. זו תהיה הסיבה מדוע 650 ° C גדל Ge מראה הרטבה מעל SiO2 בעוד 700 ° C גדל Ge לא.
עבור Ge לאחר התלכדות, מבנה החתך אינו מושפע מטמפרטורת הגידול: שכבות Ge מאוחדות שגדלו ב 650 ° C ואת אלה שגדלו ב 700 ° C לא ניתן היה להבדיל על ידי תצפיות SEM חתך.
שימו לב שעבור התבניות המפוברקות, ערכיחלונות W היו גדולים יותר וערכימסיכת W היו קטנים יותר מאלה שתוכננו מכיוון שנעשה שימוש בתהליך תחריט רטוב איזוטרופי כדי לייצר את המסכה. הערכים בפועל שלחלון Wומסיכת W התקבלו על ידי תצפיות SEM חתך לאחר צמיחת Ge.
בנוסף לכך, עובי שכבות המסכה SiO2 היה 30 ננומטר על פי תצפיות SEM חתך ומדידות אליפסומטריה ספקטרוסקופיות. שכבות SiO2 דקות כאלה שימשו כדי לבחון את הפחתת TDD שהוסברה באיור 3 ובאיור 4, והסירו את ההשפעה של צוואר אפיטקסיאלי על ART. בעבודה הנוכחית, יחסי הגובה-רוחב נמוכים מ-0.05, שהוא קטן מספיק כדי להתעלם מההשפעה של צוואר אפיטקסיאלי על ה-ART.
איור 6a מראה חתך HAADF STEM עבור SEG עם שכבות תיחום Si 0.3 Ge 0.7, ואיור סכמטי של איור 6a מוצג באיור 6b (חלון W = 0.66 מיקרומטר,מסיכת W =0.84מיקרומטר). שכבות התיחום Si0.3Ge0.7 מראות בבירור את צורות פני השטח במהלך הצמיחה ב- 700 מעלות צלזיוס. תמונת STEM מראה את משטחי Ge של כל שלב צמיחה מ-SEG בצורת עגול לשכבה אפיטקסיאלית שטוחה שנוצרה לאחר ההתמזגות. קצב הצמיחה מיד לאחר ההתלכדות משופר מאוד באזורים המאוחדים. צמיחה מהירה זו נגרמת ככל הנראה על ידי אפישכבת Ge, הממזערת את שטח הפנים שלה כדי להתייצב אנרגטית.
בניגוד ל-Ge SEG הטהור, שכבות התיחום של Ge SEG המוצגות עם Si 0.3 Ge0.7 מראות הרטבה עם מסכות SiO2 (איור 8a). ההבדל בהרטבה נובע אולי מהחדרת שכבות תיחום Si0.3Ge0.7, שהגרעין שלהן משופר בשכבות SiO2 שאינו סביר מזה של Ge.
Ge שטוח-עליון מאוחד (אזורים עם עיגול כחול באיור 5a ובאיור 5e) משמשים למדידות EPD. שכבות Ge נחרטו בממוצע ב-200 ננומטר. תמונות AFM טיפוסיות לאחר תחריט מוצגות באיור 7a ובאיור 7b, שצולמו עבור Ge מאוחד בעובי 1.15 מיקרומטר שגדל ב-700°C (חלון W = 0.66 מיקרומטר ומסיכת W = 0.44 מיקרומטר) ו-Ge מאוחד בעובי 2.67 מיקרומטר שגדל ב-650°C (חלון W = 0.66 מיקרומטרומסיכת W = 0.34 מיקרומטר). לשם השוואה, התמונה של שמיכת Ge בעובי 1.89 מיקרומטר שגדלה ב-700°C מוצגת באיור 7c. הנקודות הכהות בתמונות AFM הן בורות חרוטים המעידים על נוכחות TDs. ערכי ה-EPD מאיור 7a-7c התקבלו כ-7.0 x 10 7/cm 2, 7.9 x 10 7/cm 2 ו-8.7 x 107/cm 2, בהתאמה. הדוחות הקודמים שלנו הראו כי ה- EPDs המתקבלים במצב תחריט זה שווים ל- TDDs שנקבעו על ידי מיקרוסקופ אלקטרונים תמסורת (TEM) 4,32,33,34. ה-EPD הנמדד של שכבת Ge שמיכה (7.9 ± 0.8 x 10 7/cm 2) תואם היטב את TDD שהתקבל מתצפית TEM עם שטח גדול יחסית של 6 x 8 מיקרומטר 2 (8.7 ± 0.2 x 107/cm 2), מה שמצביע על כך שה-EPD שווה ל-TDD.
על מנת להשוות את TDDs שהתקבלו בניסוי עם חישובים, לקחת בחשבון את ההשפעה של עובי על TDD. יש מגמה ש-TDD יורד ככל שעובי ה-Ge עולה בגלל הגדלת הסיכויים להשמדת זוגות של TDs. לכן, יש לייחס את ההפחתה של TDD שנצפתה עבור Ge המאוחד, דק יותר משמיכת Ge, למנגנון המתואר באיור 3 ובאיור 4 (כלומר, עלינו לחשב את ה-TDD המנורמל כדי להשוות את ה-TDDs שהתקבלו בניסוי עם ה-TDDs המחושבים באיור 4). לפני הנורמליזציה, תיקון של TDD עבור שמיכה Ge (שמיכת ρ) בוצע, בהתחשב בעובי ובטמפרטורת הצמיחה על TDD. בדומה לדיווחים הקודמים35,36, שמיכת ρ [/cm 2] מבוטאת בקירוב כ-2.52 x 1013 x [d (nm)]-1.57 עבור שכבות Ge הגדלות בטווח טמפרטורות של 530-650 מעלות צלזיוס באמצעות UHV-CVD. כאן, d הוא עובי שכבת Ge השמיכה. שמיכת ρ [/cm 2] מופחתת עבור שכבות Ge הגדלות ב- 700 ° C, ומבוטאת בקירוב כ-2.67 x10 12 x [d (nm)]-1.37.
איור 7d מראה את ה-TDD המנורמל כפונקציה של APR, חלון W/(חלון W +מסיכת W). TDDs ב- Ge מאוחד הגדלים ב- 650 ° C מוצגים כמשולשים כחולים ואלה הגדלים ב- 700 ° C כיהלומים אדומים. מכיוון ש- SEG Ge ב 650 מעלות צלזיוס מראה הרטבה מסוימת עם מסיכת SiO2, נתוני הצמיחה צריכים ליפול בין הקווים השחורים והכחולים. SEG Ge ב 700 ° C צריך להיות על הקו האדום. תוצאות הניסוי תואמות היטב את החישוב המבוסס על צורת החתך ותנאי ההרטבה.
כפי שתואר לעיל, המסקנה היא כי ההתנהגות של TDs מוסבר היטב על ידי המודל המבוסס על כוח התמונה של משטחי צמיחה על TDs. על מנת להבין את האינטראקציה של TD עם פני השטח, ראינו TDs עם חתך שדה בהיר STEM. פגם נצפה כפוף ומסתיים על משטח של חלל גלילי למחצה באיור 8a. ההתנהגות הזו של ה-TD די דומה למסלולים המחושבים של TD שמוצגים באיור 3. אולם המסלול הנצפה של TD אינו משחזר בדיוק את זה שחזינו באיור 3. ההבדל יוסבר כתוצאה מטרנספורמציית TD על מנת למזער את האנרגיה שלו במהלך הצמיחה או אחריה (למשל, ירידת טמפרטורה מטמפרטורת הצמיחה לטמפרטורת החדר). איור 8b מראה סימולציה של זן בשכבת Ge המאוחדת על Si. זן מתיחה מושרה בשכבת Ge על Si בגלל חוסר התאמה של מקדם התפשטות תרמית בין Ge ו- Si. הסימולציה מצביעה על הצטברות מאמץ בחלק העליון של החללים הגליליים למחצה והרפיית מאמץ בשכבה התת-קרקעית של החללים הגליליים למחצה, מה שיניע TDs להשתנות.
מצד שני, איור 8c מראה יצירת פגם בראש חלל, אם כי נקודת הייצור תוסר במהלך הכנת דגימת TEM. הפגם באיור 8c קרוב לקו ישר, אך הזווית בין הפגם למישור (001) (≈78.3°) אינה תואמת את זו של מישור {111} (54.7°).
דפוס עקיפת האלקטרונים שמוצג באיור 8d התקבל ליד הפגם באיור 8c. היעדר אור פס מצביע על כך שלא צריך להיות מבנה דו-ממדי (כלומר, הפגם הוא נקע). בדיווחים קודמים 28,29,30,31,37, נוצרו פגמים דו-ממדיים המראים אור פס ברור בדפוסי עקיפה של אלקטרונים, בניגוד לזה שנצפה בעבודה הנוכחית. תוצאות התצפית (היעדר פגמים דו-ממדיים) תומכות בתחזית כי החללים והמשטחים החופשיים שלהם תורמים לשחרור מתח ב-Ge על Si, או גורמים בדרך אחרת לחוסר התמצאות גבישי בין שכבות SEG Ge סמוכות. זה עולה בקנה אחד עם דו"ח קודם שהציע בקצרה כי היווצרות פגמים דו-ממדיים נמנעת בשכבות SEG Ge מאוחדות עם חללים על מסכות SiO2 38.
ישנם שני מועמדים ליצירת TD המוצגים באיור 10c: התפלגות הזנים וחוסר ההתמצאות בין שכבות SEG Ge. ב- Ge אפיטקסיאלי על Si, זן המתיחה מושרה ב- Ge עקב חוסר התאמה של מקדם התפשטות תרמית בין Ge ו- Si39. תוצאת הסימולציה המוצגת באיור 8b מצביעה על הצטברות של מתח מתיחה (~0.5%) בחלק העליון של החלל כפי שהוזכר לעיל. הצטברות מאמץ כזו בחלק העליון של החלל יכולה לגרום ליצירת TD כפי שניתן לראות באיור 8c. מועמד נוסף, חוסר ההתמצאות בין שכבות SEG Ge, הניח כי הוא יוצר פגמים דו-ממדיים כפי שנצפה בדוחות קודמים שהראו התלכדות של שכבות SEG Ge 28,29,30,31,37. בעבודה הנוכחית, לעומת זאת, יצירת פגמים דו-ממדיים תדוכא בשל נוכחותם של חללים כפי שהוזכר בקצרה בדו"ח קודם38, אך התוצאה תהיה דור TD בשל דיכוי לא מושלם. דיון מפורט יותר על הנקע הנגרם כתוצאה מהתמצאות מוטעית יתואר בחלק מאוחר יותר עם איורים סכמטיים (איור 12).
איור 9a ואיור 9b מציגים תמונות TEM של תצוגת תוכנית שדה בהירה של שכבת Ge מאוחדת (חלון W = 0.82 מיקרומטר,מסיכת W = 0.68 מיקרומטר) ושכבת Ge שמיכה, בהתאמה, שגדלו על אותו מצע. עבור תצפיות TEM במבט תוכניתי, דגימות TEM נוצרו באמצעות האזורים העליונים של 200 ננומטר של שכבות Ge כמתואר בשלב 2.4.3, והן מסומנות על ידי ריבועים מקווקווים אדומים בחתכי הרוחב הסכמטיים בחלק העליון של איור 9. פסי מסיכה SiO2 מיושרים לכיוון [110] של Ge המאוחד באיור 9a. תמונת ה-TEM המוצגת באיור 9a צולמה עבור שטח של 6 מיקרומטר x 8 מיקרומטר. למרות שבתמונת TEM זו קיימים חמישה זוגות של מסיכות SiO 2 ואזורי חלונות Si, לא ניתן להבחין באזורים שמעל מסיכות SiO2 וחלונות Si בתמונת TEM. הסיבה לכך היא שהשטח הנצפה (200 ננומטר עליון) נמצא הרבה מעל המקום שבו נמצאים חללים גליליים למחצה (150 ננומטר תחתון).
נמצא כי TDDs שהתקבלו מאיור 9a ומאיור 9b הם 4.8 x 10 7/cm 2 ו- 8.8 x 107/cm2, בהתאמה. כפי שניתן לראות באיור 7d, מדידות EPD מגלות כי TDD בשכבת Ge המאוחדת (חלון W = 0.82 מיקרומטרומסיכת W = 0.68 מיקרומטר) הוא 4 x 107 ס"מ−2. לפיכך, ה-TDD באיור 9a מראה הסכמה טובה עם ה-EPD שמוצג באיור 7. ראוי גם לציין כי לא מדידות EPD ולא תצפיות TEM מראות עלייה מחדש של TDD, אשר מוצגת לעתים קרובות כאשר שכבות SEG Ge מתגבשות (כלומר, הגידול מחדש של TDD עקב יצירת TDs (איור 8b) מדוכא במידה כזו שלא ניתן להתעלם מהגידול מחדש של TDD בטווח TDD הנוכחי (בסדר גודל של 107/cm2)).
יש לציין כי שטח נטול TD בגודל של 4 מיקרומטר x 4 מיקרומטר מתממש ב-Ge המאוחד, כמו באיור 9a. אף על פי שהשמיכה Ge באיור 9b מראה TDs עם התפלגות אחידה יחסית, ל-Ge המאוחד יש אזורי TDD גבוהים ונמוכים. הבדלים כאלה בהתפלגות TD מצביעים על כך שהפחתת TDD נוספת תהיה ניתנת להשגה ב- Ge המאוחד. 1 TD באזור של 4 מיקרומטר x 4 מיקרומטר, שנצפה באיור 9a, מתאים ל-TDD של 6.25 x 106/cm2.
בהשוואה בין Ge מלוכד (איור 9a) לשמיכה Ge (איור 9b), ברור שאורכי קווי הפגמים בשמיכה Ge ארוכים יותר מאלה שבשמיכה Ge. ב-Ge מאוחד, ישנם בדרך כלל קווי פגמים באורך 1μm, והם מיושרים לכיוון [110]. שימו לב שכיוון [110] הוא כיוון האורך של פסי SiO2 . ישנם שני הסברים אפשריים לקווי פגמים ארוכים כאלה: (i) נצפים פגמים דו-ממדיים ו-(ii) נקעים נוטים לכיוון [110]. עם זאת, פגמים דו-ממדיים נדחים באופן מיידי בגלל רוחב הפגמים הארוכים שנצפו (כלומר, פגמים דו-ממדיים במישורים {111} צריכים להראות קווי פגמים רחבים יותר). מבחינה גיאומטרית, פגמים דו-ממדיים במישורי {111} צריכים להראות קווי פגמים ברוחב 140 ננומטר, תוך התחשבות בעובי דגימת TEM (200 ננומטר) ובזווית {111} עם (001) מישורים (54.7°). תמונת TEM בתצוגת תוכנית מראה כי קווי הפגמים הם 10-20 ננומטר רוחב, שהוא הרבה יותר צר מ 140 ננומטר. לפיכך, יש לייחס את הפגמים המוצגים כקווים ארוכים ל-(ii) נקעים הנוטים בכיוון [110]. חישוב גיאומטרי פשוט נותן את הזווית בין הנקעים הנוטים לבין (001) מישורים: tan−1(200 nm/1 μm) = 11.3°. שימו לב שכפי שניתן לראות באיור 8b, TDs בשמיכה Ge נוטים להיות מכוונים כמעט אנכית למצע אם לא מתבצע חישול לאחר הגידול, ומראים נקודות שחורות קטנות בתמונות TEM בתצוגת תוכנית.
לניתוח מפורט יותר של TDs נוטים, אזור קטן עם TDD גבוה נצפה באופן שרירותי כמו באיור 10. דגימת TEM הוכנה מ-200 ננומטר העליונים של שכבת Ge המאוחדת, זהה לתצפיות TEM שהוצגו לעיל.
איור 10a ואיור 10b מראים שדה כהה (g = [220] עבור איור 12a ו-[] עבור איור 12b) תמונות TEM בתצוגת תוכנית-תוכנית  שצולמו באותו אזור. באיור 12 נצפו ארבע נקעים משופעים באזור של 4 מיקרומטר x 4 מיקרומטר. איור 10b מגלה כי נקע נוטה אחד (העיגול האדום) נעלם כאשר וקטור העקיפה g = [], מה שמצביע על כך שווקטור בורגר נקבע להיות [110] או [
שצולמו באותו אזור. באיור 12 נצפו ארבע נקעים משופעים באזור של 4 מיקרומטר x 4 מיקרומטר. איור 10b מגלה כי נקע נוטה אחד (העיגול האדום) נעלם כאשר וקטור העקיפה g = [], מה שמצביע על כך שווקטור בורגר נקבע להיות [110] או [
 ] עבור הנקע בעיגול האדום. מכיוון שקו הפגם הוא בכיוון [110], נמצא שהנקע הוא נקע בורגי. שלושת הנקעים הנוטים האחרים (העיגולים הירוקים) מיוחסים לנקעים המעורבים מכיוון שהם לא נעלמו מכל וקטור עקיפה שנבחר.
] עבור הנקע בעיגול האדום. מכיוון שקו הפגם הוא בכיוון [110], נמצא שהנקע הוא נקע בורגי. שלושת הנקעים הנוטים האחרים (העיגולים הירוקים) מיוחסים לנקעים המעורבים מכיוון שהם לא נעלמו מכל וקטור עקיפה שנבחר.
ישנם שני הסברים אפשריים לנטייה של TDs בשכבות Ge מלוכדות: (i) צמיחת Ge בכיוון [110], ו-(ii) יצירת פגמים כאשר שכבות SEG Ge מתמזגות.
צמיחת Ge בכיוון [110]
איור 11 מראה תמונת SEM בתצוגת תוכנית ואת תהליך הצמיחה ליצירת שכבה אפיטקסית שטוחה ממשטח SEG לא מישורי כסרט סכמטי. בשיקוף גלי הקצה של תבניות הפסים SiO 2 שנוצרו על ידי הליתוגרפיה EB והתחריט הכימי הרטוב, ההתלכדות מתחילה בנקודות מסוימות, ולאחר מכן ממשיכה בכיוון [110] ו-[ ] מעל מסיכות SiO2. איור 11b ואיור 11c מראים באופן סכמטי את מבט ממעוף הציפור ואת מבט החתך (
] מעל מסיכות SiO2. איור 11b ואיור 11c מראים באופן סכמטי את מבט ממעוף הציפור ואת מבט החתך ( ) כאשר שכבות SEG Ge מאוחדות חלקית. TD שנוצר בחלון צמיחה מופיע מעל הריק כפי שמוצג באיור 3, ואז ה-TD מתחיל להתפשט בכיוון [110] או [
) כאשר שכבות SEG Ge מאוחדות חלקית. TD שנוצר בחלון צמיחה מופיע מעל הריק כפי שמוצג באיור 3, ואז ה-TD מתחיל להתפשט בכיוון [110] או [ ] עקב כוח התמונה. זה מוביל לכך ש-TDs נוטים לכיוון [110] (כמו באיור 9a). הקו האדום המוצק באיור 11c מראה TD כפוף בכיוון [110] לפי המודל לעיל, מה שמסביר את נוכחותם של TD נוטים שנצפו באיור 9a ובאיור 10 על בסיס איכותי.
] עקב כוח התמונה. זה מוביל לכך ש-TDs נוטים לכיוון [110] (כמו באיור 9a). הקו האדום המוצק באיור 11c מראה TD כפוף בכיוון [110] לפי המודל לעיל, מה שמסביר את נוכחותם של TD נוטים שנצפו באיור 9a ובאיור 10 על בסיס איכותי.
המנגנון יכול להסביר הן TD קצה והן בורג TDs, תוך התחשבות וקטורי בורגר של TDs שנוצרו בממשקי Ge/Si40. כאשר Ge גדל על מצע Si, נקעים לא מתאימים לקצה (MDs) נוצרים כדי לשחרר מתח, ו- MDs מיושרים בכיוון [110] או [ ] . ה-MDs יוצרים מקטעי השחלה (כלומר, TDs), ווקטורי בורגר עבור ה-TDs שמקורם ב-MDs המיושרים בכיוון [110] (MD110) הם a/2[] או a/2[
] . ה-MDs יוצרים מקטעי השחלה (כלומר, TDs), ווקטורי בורגר עבור ה-TDs שמקורם ב-MDs המיושרים בכיוון [110] (MD110) הם a/2[] או a/2[
 ] (a: קבוע הסריג). מצד שני, וקטורי בורגר הם a/2[110] או a/2[] עבור TDs שמקורם ב-MDs המיושרים בכיוון [
] (a: קבוע הסריג). מצד שני, וקטורי בורגר הם a/2[110] או a/2[] עבור TDs שמקורם ב-MDs המיושרים בכיוון [
 ] (
] ( ). במקרה שה-TDs מ-MD110 נוטים לכיוון [110], תצפיות TEM בתצוגת תוכנית מראות את ה-TDs כנקעי קצה. באופן דומה, כאשר ה-TDs מ
). במקרה שה-TDs מ-MD110 נוטים לכיוון [110], תצפיות TEM בתצוגת תוכנית מראות את ה-TDs כנקעי קצה. באופן דומה, כאשר ה-TDs מ  נוטים לכיוון [110], הם נצפים כנקעים בורגיים.
נוטים לכיוון [110], הם נצפים כנקעים בורגיים.
יצירת פגם כאשר שכבות SEG Ge מתלכדות
איור 12 מראה סכמות המסבירות יצירת פגמים כאשר שכבות SEG Ge מתמזגות עם סיבוב קטן (כלומר, התמצאות שגויה). כפי שמודגם באופן סכמטי באיור 12, הכיוון השגוי אמור ליצור נקעים בקצה/בורג/מעורב בממשק ההתלכדות. באיור 12, התמצאות שגויה בין שתי שכבות SEG Ge בכיוון [110] מתפרקת לשלושה סוגים של סיבובים. איור 12a-12c מראה את הסיבוב סביב ציר [110], ציר [001] וציר [ ] בהתאמה.
] בהתאמה.
מניחים שההתלכדות באיור 12 מתרחשת בין שכבת Ge אפיטקסיאלית לחלוטין (Ge (001)) לבין שכבת SEG Ge סמוכה עם כיוון שגוי (m-Ge). הסיבוב סביב ציר [110] (איור 12a) גורם ליצירת נקעי קצוות מקבילים לכיוון [110] בגבול המסומן כקו מקווקו. באופן דומה, כמו באיור 12b, נקעי הקצוות המקבילים לכיוון [001] נוצרים כתוצאה מהסיבוב סביב ציר [001]. מצד שני, הסיבוב סביב ציר [] המוצג באיור 12c, יוצר רשת פריקת בורג, המורכבת על ידי נקעים של b = [110] ו - b = [ 001], בדומה למקרה של מליטה ישירה של משטחי Si (001) המראים רשת פריקת בורג41. ניתן לייחס את TD הבורג שנצפה באיור 10 להתלכדות עם כיוון שגוי של סיבוב סביב ציר [
001], בדומה למקרה של מליטה ישירה של משטחי Si (001) המראים רשת פריקת בורג41. ניתן לייחס את TD הבורג שנצפה באיור 10 להתלכדות עם כיוון שגוי של סיבוב סביב ציר [ ]. השילוב של סיבובים סביב ציר [110] (איור 12a) וסביב ציר [
]. השילוב של סיבובים סביב ציר [110] (איור 12a) וסביב ציר [ ] (איור 12c) יכול להסביר את הסיבובים המעורבים שמוצגים באיור 12. הנקע המעורב המוצג באיור 9b מוסבר גם על ידי השילוב של הסיבוב סביב ציר [001] (איור 12b) והסיבוב על ציר [
] (איור 12c) יכול להסביר את הסיבובים המעורבים שמוצגים באיור 12. הנקע המעורב המוצג באיור 9b מוסבר גם על ידי השילוב של הסיבוב סביב ציר [001] (איור 12b) והסיבוב על ציר [ ] (איור 12c).
] (איור 12c).
בהנחה שהנקעים שמקורם בהתמצאות השגויה נוצרים בצפיפות של 1 x 107/cm2, הזווית הממוצעת של הסיבוב סביב ציר [ ] מוערכת ב-0.034° 42. בהשוואה לאומדן, כבר דיווחנו כי ישנן תנודות בכיוון בשכבת SEG Ge בצורת קו עבור 100 arcsec (= 0.028°), תוך שימוש בתצפיות עקיפה של קרני רנטגן מיקרו-קרן43. תנודות הכיוון המדווחות וזווית הסיבוב המשוערת מראות הסכמה טובה, התומכת במנגנון יצירת TD המבוסס על התמצאות שגויה.
] מוערכת ב-0.034° 42. בהשוואה לאומדן, כבר דיווחנו כי ישנן תנודות בכיוון בשכבת SEG Ge בצורת קו עבור 100 arcsec (= 0.028°), תוך שימוש בתצפיות עקיפה של קרני רנטגן מיקרו-קרן43. תנודות הכיוון המדווחות וזווית הסיבוב המשוערת מראות הסכמה טובה, התומכת במנגנון יצירת TD המבוסס על התמצאות שגויה.

איור 1: איורים סכמטיים של מסכות SEG מרובעות בצורת קו ורווח בגודל 4 מ"מ על מצע Si(001). לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.

איור 2: תמונות עבור חלקים של מכונת UHV-CVD; ארון גז, תא תהליך, תא נעילת עומס ומחשב הפעלה. לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
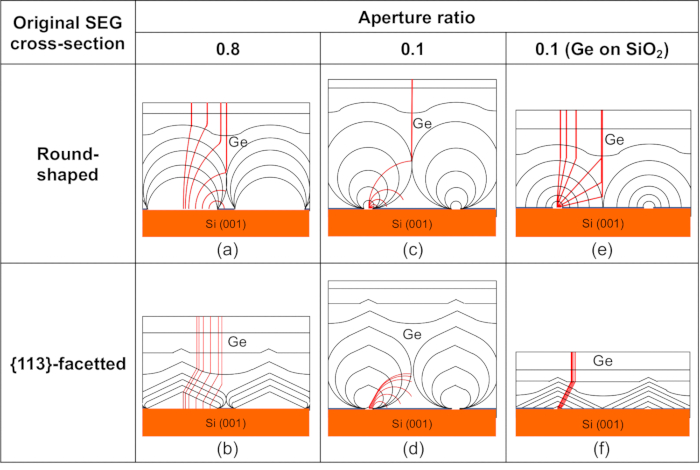
איור 3: מסלולים מחושבים של 4 TDs ב-(a) מקור SEG בצורת עגול, יחס צמצם = 0.8, (b) מקור SEG בצורת עגול, יחס צמצם = 0.1, (c) מקור SEG בעל פאות {113}, יחס צמצם = 0.8, ו-(d) מקור SEG בעל פאות {113}, יחס צמצם = 0.1. לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
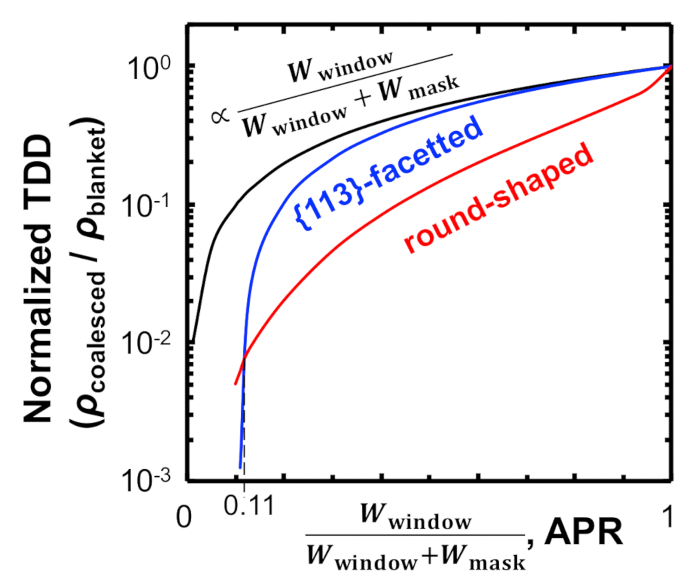
איור 4: TDDs מחושבים ב-Ge מאוחד מקורם ב-SEG Ge בעל {113} פאות (קו כחול) ו-SEG Ge בצורת עגול (קו אדום). אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.

איור 5: מפות תפוצה ותמונות SEM של שכבות Ge מאוחדות/לא מאוחדות. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.

איור 6: (a) תמונת חתך HAADF STEM של Ge מאוחד (חלון W = 0.66 מיקרומטר, מסיכת W = 0.84 מיקרומטר) גדל ב-700°C עם שכבות תיחום Si 0.3 Ge0.7 בעובי 10 ננומטר, ו-(ב) איור סכמטי המתאים לתנאים המוצגים ב-(a). לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.

איור 7: תמונות AFM טיפוסיות כדי למדוד EPDs עבור (א) Ge מאוחד בעובי 1.15 מיקרומטר שגדל ב-700°C (חלון W = 0.66 מיקרומטר ומסיכת W = 0.44 מיקרומטר), (ב) Ge מגובש בעובי 2.67 מיקרומטר שגדל ב-650°C (חלון W = 0.86 מיקרומטר ומסיכת W = 0.34 מיקרומטר), ו-(ג) שמיכה בעובי 1.89 מיקרומטר Ge שגדלה ב-700° C, וסיכום תוצאות מדידת EPD ב-(d). אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
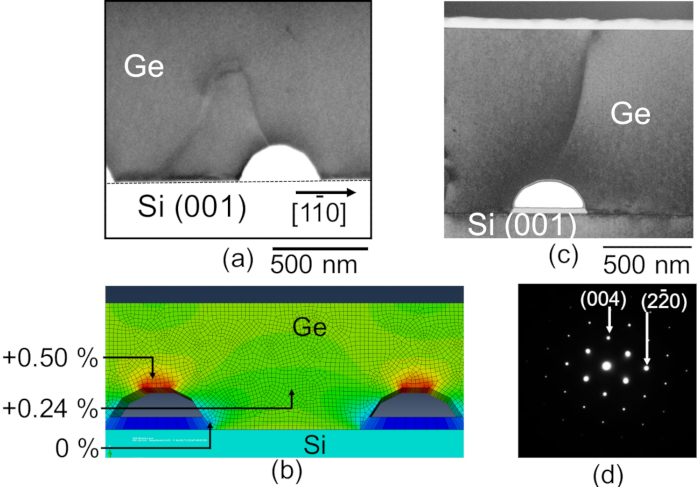
איור 8:(110) חתך רוחב (a) STEM ו-(b) תמונות TEM של שכבות Ge מאוחדות (חלון W = 0.66 מיקרומטר ומסיכת W = 0.44 מיקרומטר), (c) תבנית עקיפה של אלקטרונים המתקבלת ליד הפגם המוצג ב-(b), ו-(d) תוצאת סימולציה של שיטת אלמנטים סופיים של התפלגות זן ב-Ge המאוחד. איורים 9(א), (ג) ו-(ד) שונו מ-20. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
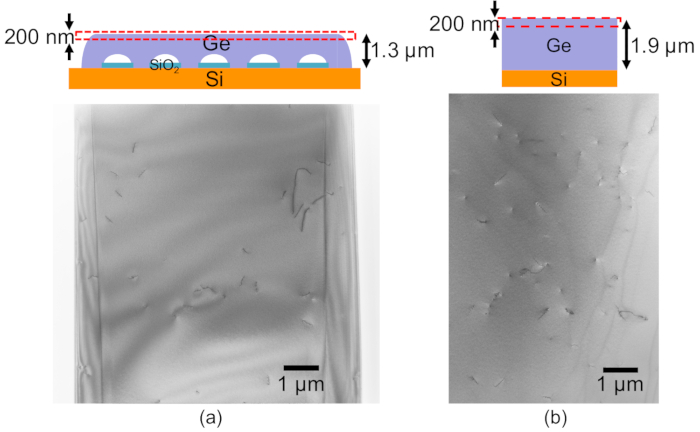
איור 9: תצוגת תוכנית שדה בהירה תמונות TEM של (א) שכבת Ge מאוחדת (חלון W = 0.82 מיקרומטר, מסיכת W = 0.68 מיקרומטר) ו-(ב) שכבת Ge שמיכה. לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
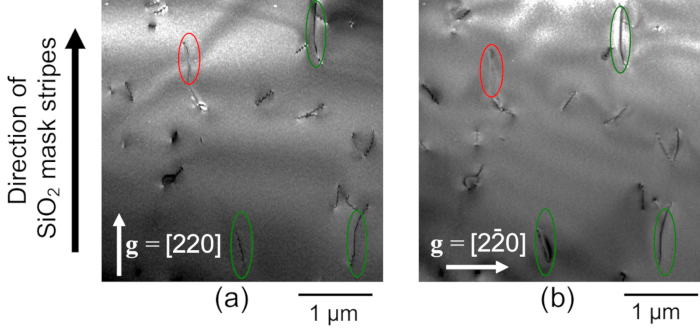
איור 10: תמונות TEM בתצוגת תוכנית של אזור קטן בעל TDD גבוה עם g וקטורים של (a) [220] ו-(b) [ ]. נתון זה שונה מ-20. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
]. נתון זה שונה מ-20. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
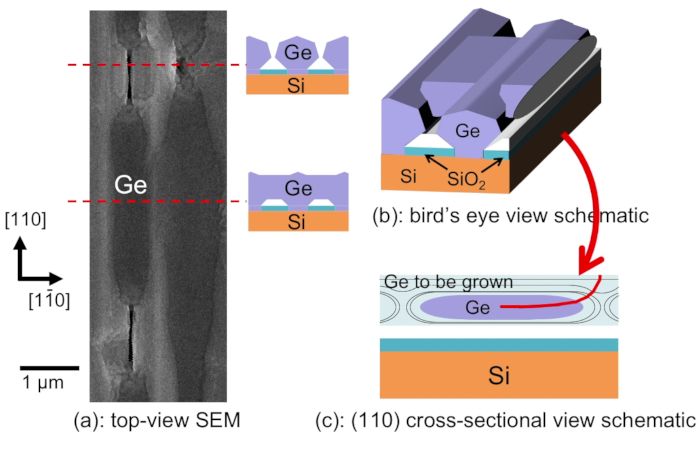
איור 11: (א) תמונת SEM של תצוגת תוכנית, (ב) תמונה סכמטית ממעוף הציפור, ו-(ג) תמונה סכמטית בחתך רוחב של SEG Ge מאוחד חלקית. נתון זה שונה מ-20. אנא לחץ כאן להורדת סרטון זה.
תמונה סכמטית בחתך רוחב של SEG Ge מאוחד חלקית. נתון זה שונה מ-20. אנא לחץ כאן להורדת סרטון זה.
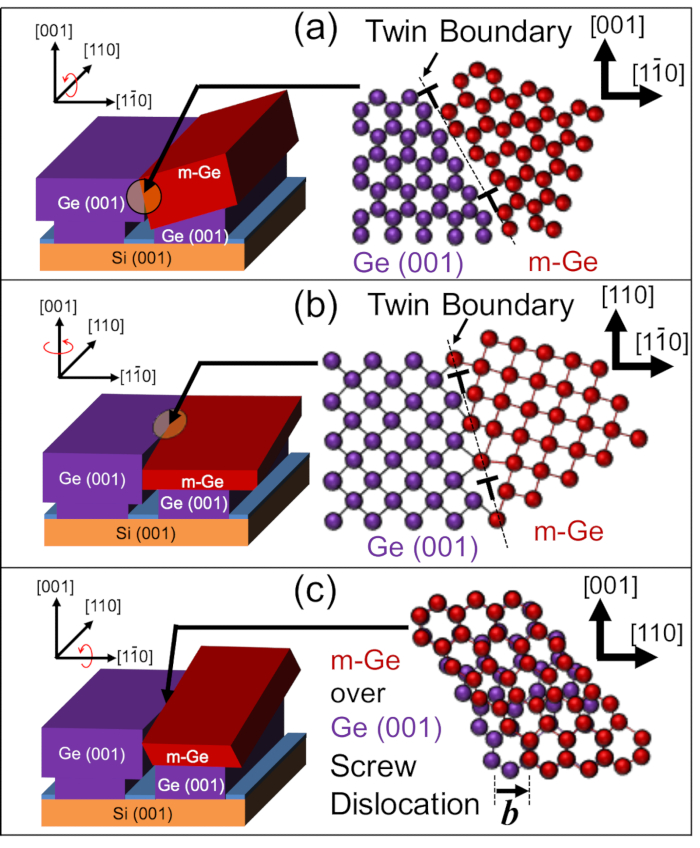
איור 12: סכמות של יצירת פגמים כאשר שכבות SEG Ge מתמזגות עם סיבוב גבישי סביב (a) [110], (b) [001] ו-(c) [ ] כיוון. נתון זה שונה מ-20. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
] כיוון. נתון זה שונה מ-20. אנא לחץ כאן כדי להציג גרסה גדולה יותר של איור זה.
| שיטת | TDD משיג (cm-2) | טמפרטורה (°C) | עובי שכבת חיץ |
| חישול תרמי | 2ה7 | ≈900 °C | ≈100 נאנומטר (מאגר בטמפרטורה נמוכה) |
| מאגר מדורג SiGe | 1ה6 | טמפרטורת גדילה (600–700 מעלות צלזיוס) | 2–3 מיקרומטר |
| אמנות | 1ה6 | טמפרטורת גדילה (600–700 מעלות צלזיוס) | 500–1000 ננומטר |
| זרעי עמוד Si | 1ה5 | ≈800 °C | ≈5 מיקרומטר |
| עבודה זו | 4ה7 | טמפרטורת גדילה (700 מעלות צלזיוס) | ≈150 נאנומטר |
טבלה 1: סיכום של TDD שהושג וחסרונותיו לאור יישום התקנים פוטוניים עבור שיטות הפחתת TDD קונבנציונליות/מוצגות.
איור משלים 1: ארבע שיטות אופייניות הנמצאות בשימוש נרחב להפחתת TDD ב-Ge אפיטקסיאלי ב-Si: (א) חישול תרמי, (ב) חיץ מדורג SiGe, (ג) לכידת יחס גובה-רוחב (ART) ו-(ד) זרעי עמוד Si. אנא לחץ כאן כדי להוריד נתון זה.
וידאו משלים 1: איורים סכמטיים של TD כפוף בגלל כוח תמונה ב-SEG Ge בצורת עגול. אנא לחץ כאן להורדת סרטון זה.
Discussion
בעבודה הנוכחית, TDD של 4 x 107/cm2 הוצגו באופן ניסיוני. להפחתת TDD נוספת, ישנם בעיקר 2 שלבים קריטיים בפרוטוקול: הכנת מסכת SEG וצמיחת Ge אפיטקסיאלית.
המודל שלנו המוצג באיור 4 מצביע על כך שניתן להפחית TDD מתחת ל-107/cm2 ב-Ge מאוחד כאשר APR,חלון W/(חלון W +מסיכת W), קטן כמו 0.1. לקראת הפחתה נוספת של TDD, יש להכין מסכות SEG עם APR קטן יותר. כפי שצוין בשלב 2.1.2, ערכי המינימום שלחלון Wומסיכת W היו 0.5 מיקרומטר ו- 0.3 מיקרומטר, בהתאמה, מוגבלים על ידי הרזולוציה במערכת הליתוגרפיה EB המועסקת. שיטה פשוטה אחת להפחתת APR היא לשנות תהליכי ליתוגרפיה וחריטה (למשל, להשתמש בפוטו-התנגדות אחרת, להשתמש במערכת ליתוגרפיה טובה יותר, להשתמש בשכבות SiO2 דקות יותר עם תחריט BHF רדוד יותר וכו'). ליתוגרפיה בוגרת ותהליך תחריט יאפשרו מסכות SEG צרות מ-100 ננומטר. בעבודה הנוכחית, Ge מאוחד עם משטח עליון שטוח התקבלו כאשרמסכת W ≤1 מיקרומטר. לפיכך,חלון W של 100 ננומטרומסיכת W של 900 ננומטר (APR = 0.1) יעניקו לנו Ge מאוחד עם משטח עליון שטוח בתנאי הגידול הנוכחיים.
בנוסף לכך, השינוי בהכנת מסכות SEG אמור להביא לפחות גלי קצה של מסכות SEG, וכתוצאה מכך דיכוי של התמצאות שגויה בין שכבות Ge SEG. דור ה-TD כאשר שכבות SEG Ge מתגבשות (איור 11) ידוכא כתוצאה משינוי הכנת מסכות SEG.
כפי שעולה מתוצאות החישוב (איור 3), דיכוי גדילת Ge ב-SiO2 נדרש כדי להפחית TDD. דיכוי צמיחת Ge ב- SiO 2 נגרם על ידי שינוי שלב הצמיחה של Ge (כלומר, העלאת טמפרטורת הצמיחה, סיבוב מסכת SEG, הכנסת גז H2 והפחתת הלחץ של גז GeH4 44,45).
שיטת הפחתת TDD המוצעת/מאומתת בעבודה הנוכחית עדיפה על השיטות הקיימות מבחינת היישום עבור התקנים פוטוניים Ge (כלומר, TDD מופחת ללא כל חישול תרמי או שכבות חיץ עבות). טמפרטורת התהליך המקסימלית הייתה 700 מעלות צלזיוס, שהיא טמפרטורת הצמיחה, וגובה החלל היה ≈150 ננומטר. בהשוואה לשיטות קיימות, הטמפרטורה המרבית נמוכה מטמפרטורת החישול (בדרך כלל 900°C)7, וגובה החלל רדוד יותר משכבות חיץ מדורגות SiGe (בדרך כלל כמה מיקרומטר)10, תעלות SiO2 עבור ART (בדרך כלל 0.5-1 מיקרומטר)13, ושכבת חיץ לצמיחת Ge על עמודי Si (בדרך כלל ≈5 מיקרומטר)18. השוואת השיטות הקונבנציונליות/המוצגות מסוכמת בטבלה 1.
בהתחשב בטביעת הרגל של מכשיר פוטוני טיפוסי Ge (≈100 מיקרומטר 2), TDD נמוך מ- 106/cm2, ומספר TD < 1/התקן יהיו המטרה הסופית. מכיוון שהגבול התיאורטי של TDD עבור שיטה זו הוא 0, TDD נמוך מ- 106/cm2 הוא בר השגה. לקראת המטרה ייחקרו ליתוגרפיה ותחריטים אופטימליים יותר.
Disclosures
למחברים אין מה לחשוף.
Acknowledgements
עבודה זו נתמכה כספית על ידי האגודה היפנית לקידום המדע (JSPS) KAKENHI (17J10044) ממשרד החינוך, התרבות, הספורט, המדע והטכנולוגיה (MEXT), יפן. תהליכי הייצור נתמכו על ידי "פלטפורמת ננוטכנולוגיה" (פרויקט מס '12024046), MEXT, יפן. המחברים רוצים להודות למר ק. ימאשיטה ולגב' ס. היראטה, מאוניברסיטת טוקיו, על עזרתם בתצפיות TEM.
Materials
| Name | Company | Catalog Number | Comments |
| AFM | SII NanoTechnology | SPI-3800N | |
| BHF | DAIKIN | BHF-63U | |
| CAD design | AUTODESK | AutoCAD 2013 | Software |
| CH3COOH | Kanto-Kagaku | Acetic Acid | for Electronics |
| CVD | Canon ANELVA | I-2100 SRE | |
| Developer | ZEON | ZED | |
| Developer rinse | ZEON | ZMD | |
| EB writer | ADVANTEST | F5112+VD01 | |
| Furnace | Koyo Thermo System | KTF-050N-PA | |
| HF, 0.5 % | Kanto-Kagaku | 0.5 % HF | |
| HF, 50 % | Kanto-Kagaku | 50 % HF | |
| HNO3, 61 % | Kanto-Kagaku | HNO3 1.38 | for Electronics |
| I2 | Kanto-Kagaku | Iodine 100g | |
| Photoresist | ZEON | ZEP520A | |
| Photoresist remover | Tokyo Ohka | Hakuri-104 | |
| Surfactant | Tokyo Ohka | OAP | |
| TEM | JEOL | JEM-2010HC |
References
- Giovane, L. M., Luan, H. C., Agarwal, A. M., Kimerling, L. C. Correlation between leakage current density and threading dislocation density in SiGe p-i-n diodes grown on relaxed graded buffer layers. Applied Physics Letters. 78 (4), 541-543 (2001).
- Wang, J., Lee, S. Ge-photodetectors for Si-based optoelectronic integration. Sensors. 11, 696-718 (2011).
- Ishikawa, Y., Saito, S. Ge-on-Si photonic devices for photonic-electronic integration on a Si platform. IEICE Electronics Express. 11 (24), 1-17 (2014).
- Cai, Y. Materials science and design for germanium monolithic light source on silicon, Ph.D. dissertation. , Dept. Mater. Sci. Eng., Massachusetts Inst. Technol. Cambridge, MA, USA. (2009).
- Wada, K., Kimerling, L. C. Photonics and Electronics with Germanium. , Wiley. Hoboken, NJ, USA. 294(2015).
- Higashitarumizu, N., Ishikawa, Y. Enhanced direct-gap light emission from Si-capped n+-Ge epitaxial layers on Si after post-growth rapid cyclic annealing: Impact of non-radiative interface recombination toward Ge/Si double heterostructure lasers. Optics Express. 25 (18), 21286-21300 (2017).
- Luan, H. C., et al. High-quality Ge epilayers on Si with low threading-dislocation densities. Applied Physics. Letters. 75 (19), 2909-2911 (1999).
- Nayfeha, A., Chui, C. O., Saraswat, K. C. Effects of hydrogen annealing on heteroepitaxial-Ge layers on Si: Surface roughness and electrical quality. Applied Physics Letters. 85 (14), 2815-2817 (2004).
- Choi, D., Ge, Y., Harris, J. S., Cagnon, J., Stemmer, S. Low surface roughness and threading dislocation density Ge growth on Si (001). Journal of Crystal Growth. 310 (18), 4273-4279 (2008).
- Currie, M. T., Samavedam, S. B., Langdo, T. A., Leitz, C. W., Fitzgerald, E. A. Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing. Applied Physics Letters. 72 (14), 1718-1720 (1998).
- Liu, J. L., Tong, S., Luo, Y. H., Wan, J., Wang, K. L. High-quality Ge films on Si substrates using Sb surfactant-mediated graded SiGe buffers. Applied Physics Letters. 79 (21), 3431-3433 (2001).
- Yoon, T. S., Liu, J., Noori, A. M., Goorsky, M. S., Xie, Y. H. Surface roughness and dislocation distribution in compositionally graded relaxed SiGe buffer layer with inserted-strained Si layers. Applied Physics Letters. 87 (1), 012014(2005).
- Langdo, T. A., Leitz, C. W., Currie, M. T., Fitzgerald, E. A., Lochtefeld, A., Antoniadis, D. A. High quality Ge on Si by epitaxial necking. Applied Physics Letters. 76 (25), 3700-3702 (2000).
- Park, J. S., Bai, J., Curtin, M., Adekore, B., Carroll, M., Lochtefeld, A. Defect reduction of selective Ge epitaxy in trenches on Si(001) substrates using aspect ratio trapping. Applied Physics Letters. 90 (5), 052113(2007).
- Fiorenza, J. G., et al. Aspect ratio trapping: A unique technology for integrating Ge and III-Vs with silicon CMOS. ECS Transactions. 33 (6), 963-976 (2010).
- Salvalaglio, M., et al. Engineered Coalescence by Annealing 3D Ge Microstructures into High-Quality Suspended Layers on Si. Applied Materials & Interfaces. 7 (34), 19219-19225 (2015).
- Bergamaschini, R., et al. Self-aligned Ge and SiGe three-dimensional epitaxy on dense Si pillar arrays. Surface Science Reports. 68 (3), 390-417 (2013).
- Isa, F., et al. Highly Mismatched, Dislocation-Free SiGe/Si Heterostructures. Advanced Materials. 28 (5), 884-888 (2016).
- Yako, M., Ishikawa, Y., Wada, K. Coalescence induced dislocation reduction in selectively grown lattice-mismatched heteroepitaxy: Theoretical prediction and experimental verification. Journal of Applied Physics. 123 (18), 185304(2018).
- Yako, M., Ishikawa, Y., Abe, E., Wada, K. Defects and Their Reduction in Ge Selective Epitaxy and Coalescence Layer on Si With Semicylindrical Voids on SiO2 Masks. IEEE Journal of Selected Topics in Quantum Electronics. 24 (6), 8201007(2018).
- Park, J. S., Bai, J., Curtin, M., Carroll, M., Lochtefeld, A. Facet formation and lateral overgrowth of selective Ge epitaxy on SiO2-patterned Si(001) substrates. Journal of Vacuum Science & Technology B. 26 (1), 117-121 (2008).
- Bai, J., et al. Study of the defect elimination mechanisms in aspect ratio t.rapping Ge growth. Applied Physics Letters. 90 (10), 101902(2007).
- Montalenti, F., et al. Dislocation-Free SiGe/Si Heterostructures. Crystals. 8 (6), 257(2018).
- Zhang, H. L. Calculation of shuffle 60° dislocation width and Peierls barrier and stress for semiconductors silicon and germanium. European Physical Journal B. 81 (2), 179-183 (2011).
- Kim, M., Olubuyide, O. O., Yoon, J. U., Hoyt, J. L. Selective Epitaxial Growth of Ge-on-Si for Photodiode Applications. ECS Transactions. 16 (10), 837-847 (2008).
- Yako, M., Kawai, N. J., Mizuno, Y., Wada, K. The kinetics of Ge lateral overgrowth on SiO2. Proceedings of MRS Fall Meeting. , (2015).
- Kamino, T., Yaguchi, T., Hashimoto, T., Ohnishi, T., Umemura, K. A FIB Micro-Sampling Technique and a Site Specific TEM Specimen Preparation Method. Introduction to Focused Ion Beams. , Springer. Boston, MA. (2005).
- Park, J. S., et al. Low-defect-density Ge epitaxy on Si(001) using aspect ratio trapping and epitaxial lateral overgrowth. Electrochemical and Solid-State Letters. 12 (4), H142-H144 (2009).
- Li, Q., Jiang, Y. B., Xu, H., Hersee, S., Han, S. M. Heteroepitaxy of high-quality Ge on Si by nanoscale Ge seeds grown through a thin layer of SiO2. Applied Physics Letters. 85 (11), 1928-1930 (2004).
- Halbwax, M., et al. Epitaxial growth of Ge on a thin SiO2 layer by ultrahigh vacuum chemical vapor deposition. Journal of Crystal Growth. 308 (1), 26-29 (2007).
- Leonhardt, D., Ghosh, S., Han, S. M. Origin and removal of stacking faults in Ge islands nucleated on Si within nanoscale openings in SiO2. Journal of Applied Physics. 10 (7), 073516(2011).
- Takada, Y., Osaka, J., Ishikawa, Y., Wada, K. Effect of Mesa Shape on Threading Dislocation Density in Ge Epitaxial Layers on Si after Post-Growth Annealing. Japanese Journal of Applied Physics. 49 (4S), 04DG23(2010).
- Ishikawa, Y., Wada, K. Germanium for silicon photonics. Thin Solid Films. 518 (6), S83-S87 (2010).
- Nagatomo, S., Ishikawa, Y., Hoshino, S. Near-infrared laser annealing of Ge layers epitaxially grown on Si for high-performance photonic devices. Journal of Vacuum Science & Technology B. 35 (5), 051206(2017).
- Ayers, J. E., Schowalter, L. J., Ghandhi, S. K. Post-growth thermal annealing of GaAs on Si(001) grown by organometallic vapor phase epitaxy. Journal of Crystal Growth. 125 (1), 329-335 (1992).
- Wang, G., et al. A model of threading dislocation density in strain-relaxed Ge and GaAs epitaxial films on Si (100). Applied Physics Letters. 94 (10), 102115(2009).
- Leonhardt, D., Ghosh, S., Han, S. M. Defects in Ge epitaxy in trench patterned SiO2 on Si and Ge substrates. Journal of Crystal Growth. 335 (1), 62-65 (2011).
- Sammak, A., Boer, W. B., Nanver, L. K. Ge-on-Si: Single-crystal selective epitaxial growth in a CVD reactor. ECS Transactions. 50 (9), 507-512 (2012).
- Ishikawa, Y., Wada, K., Cannon, D. D., Liu, J., Luan, H. C., Kimerling, L. C. Strain-induced band gap shrinkage in Ge grown on Si substrate. Applied Physics Letters. 82 (13), 2044-2046 (2003).
- Bolkhovityanov, Y. B., Gutakovskii, A. K., Deryabin, A. S., Sokolov, L. V. Edge Misfit Dislocations in GexSi1–x/Si(001) (x~1) Heterostructures: Role of Buffer GeySi1–y (y < x) Interlayer in Their Formation. Physics of the Solid State. 53 (9), 1791-1797 (2011).
- Bourret, A. How to control the self-organization of nanoparticles by bonded thin layers. Surface Science. 432 (1), 37-53 (1999).
- Hirth, J. P., Lothe, J. Grain boundaries. Theory of Dislocations, 2nd ed. 19, Wiley. New York, NY, USA. 697-750 (1982).
- Mizuno, Y., Yako, M., Luan, N. M., Wada, K. Strain tuning of Ge bandgap by selective epigrowth for electro-absorption modulators. Proceedings of SPIE Photonics West, San Francisco, CA, USA. 9367, 1-6 (2015).
- Nam, J. H., et al. Lateral overgrowth of germanium for monolithic integration of germanium-on-insulator on silicon. Journal of Crystal Growth. 416 (15), 21-27 (2015).
- Fitch, J. T. Selectivity Mechanisms in Low Pressure Selective Epitaxial Silicon Growth. Journal of The Electrochemical Society. 141 (4), 1046-1055 (1994).
- Ye, H., Yu, J. Germanium epitaxy on silicon. Science and Technology of Advanced Materials. 15 (2), 1-9 (2014).
Reprints and Permissions
Request permission to reuse the text or figures of this JoVE article
Request PermissionThis article has been published
Video Coming Soon
Copyright © 2025 MyJoVE Corporation. All rights reserved