Method Article
硅上半圆柱空隙锗外延层位错还原的理论计算和实验验证
摘要
提出了降低硅上半圆柱空隙的锗外延层螺纹位错(TD)密度的理论计算和实验验证。给出了基于TD与表面相互作用的计算方法,通过像力、TD测量和透射电子显微镜对TD的观测。
摘要
降低硅(Si)上外延锗(Ge)的螺纹位错密度(TDD)是实现单片集成光子电路的最重要挑战之一。本文介绍了一种降低TDD的新模型的理论计算和实验验证方法。理论计算方法描述了基于TDs与选择性外延生长(SEG)的非平面生长表面在位错成像力方面的相互作用的螺纹位错(TDs)的弯曲。计算表明,SiO2 掩模上空隙的存在有助于降低TDD。采用超高真空化学气相沉积法和TD观察生长的锗(Ge)SEG通过蚀刻和横截面透射电子显微镜(TEM)对生长的Ge进行实验验证。强烈建议TDD降低是由于SiO2 SEG掩模和生长温度上存在半圆柱形空隙。为了进行实验验证,由于Ge层的SEG及其聚结作用,形成了具有半圆柱形空隙的外延Ge层。实验得到的TDDs基于理论模型再现了计算出的TDD。横断面透射电镜观察表明,TD的终止和生成都发生在半圆柱形空隙处。平面透射电镜观测揭示了具有半圆柱形空隙的Ge中TD的独特行为(即TD弯曲以平行于SEG掩模和Si衬底)。
引言
Si上的外延锗作为有源光子器件平台引起了广泛兴趣,因为Ge可以检测/发射光通信范围(1.3-1.6μm)内的光,并且与Si CMOS(互补金属氧化物半导体)加工技术兼容。然而,由于Ge和Si之间的晶格失配高达4.2%,因此在Si上的Ge外延层中以~109 / cm2的密度形成螺纹位错(TDs)。由于TD在Ge光电探测器(PD)和调制器(MOD)中充当载流子生成中心,在激光二极管(LDs)中充当载流子复合中心,因此锗光子器件的性能会因TD而恶化。反过来,它们会增加PD和MOD1,2,3中的反向泄漏电流(J泄漏)和LDs4,5,6中的阈值电流(J th)。
据报道,已经有各种尝试来降低Si上Ge中的TD密度(TDD)(补充图1)。热退火刺激TD的运动,导致TDD降低,通常为2 x 107 / cm2。缺点是Si和Ge可能混合,并且掺杂剂在Ge中扩散,例如磷7,8,9(补充图1a)。SiGe分级缓冲层10,11,12增加了临界厚度并抑制了TD的产生,导致TDD降低,通常为2 x 106/cm2。这里的缺点是厚缓冲器会降低Ge器件和下方Si波导之间的光耦合效率(补充图1b)。纵横比捕获 (ART)13,14,15 是一种选择性外延生长 (SEG) 方法,通过将 TD 捕获在厚 SiO 2 沟槽的侧壁上来降低 TD,通常为 <1 x 10 6/cm 2。ART方法使用较厚的SiO 2掩模来降低Ge中的TDD,而不是SiO 2掩模,SiO2掩模远高于Si,并且具有相同的缺点(补充图1b,1c)。Si柱晶种上的Ge生长和退火16,17,18与ART方法相似,通过高纵横比Ge生长使TD捕获达到<1 x 105/cm2。然而,用于Ge聚结的高温退火在补充图1a-c(补充图1d)中具有相同的缺点。
为了在硅上实现低TDD的Ge外延生长,而不受上述方法的缺点,我们根据迄今为止在SEG Ge生长7,15,21,22,23中报告的以下两个关键观察结果,提出了聚结诱导的TDD还原19,20:1)TD弯曲成垂直于生长表面(通过横截面透射电子显微镜(TEM)观察),2)SEG Ge层的聚结导致在SiO2掩模上形成半圆柱形空隙。
我们假设TD由于生长表面的成像力而弯曲。在Si上的Ge的情况下,像像力分别在距离自由表面1 nm处产生1.38 GPa和1.86 GPa的螺杆位错和边缘位错的剪切应力19。计算出的剪切应力明显大于Ge24中报告的60°位错的Peierls应力0.5 GPa。该计算预测了Ge SEG层的TDD减少,并且与SEG Ge增长19非常吻合。对TD进行TEM观察以了解Si20上所呈现的SEG Ge生长中的TD行为。镜像力诱导的TDD还原没有任何热退火或厚缓冲层,因此更适合光子器件应用。
本文介绍了TDD还原方法的理论计算和实验验证的具体方法。
研究方案
1. 理论计算程序
- 计算TD的轨迹。在计算中,假设 SEG 掩码足够薄,可以忽略 ART 对 TDD 减少的影响。
- 确定生长表面并用方程表示。例如,使用时间演化参数 n = i、SEG Ge 高度 (h i) 和 SEG Ge 半径 (r i) 表示 SEG Ge 层圆形横截面的时间演变,如补充视频 1a 和等式 (1) 所示:

- 确定生长表面上任意位置的法线方向。对于圆形截面SEG Ge,将(x i,yi)处的法线描述为,如
 补充视频1b所示为红线。然后,通过求解以下联立方程组,从点(x i , y i)获得TD(x i + 1,yi + 1)的边:
补充视频1b所示为红线。然后,通过求解以下联立方程组,从点(x i , y i)获得TD(x i + 1,yi + 1)的边:
- 根据TD生成的位置(x 0,0)计算一个TD的轨迹,如补充视频1c所示。换句话说,可以通过上述方法计算任意TD的轨迹。
- 假设TD穿透底面并有助于TDD的减少(即,低于SEG Ge层聚结点的TD被半圆柱形空隙捕获并且永远不会出现在顶面)计算TDD。
- 确定生长表面并用方程表示。例如,使用时间演化参数 n = i、SEG Ge 高度 (h i) 和 SEG Ge 半径 (r i) 表示 SEG Ge 层圆形横截面的时间演变,如补充视频 1a 和等式 (1) 所示:
2. 实验验证程序
- 赛格面罩准备
- 在制造 SEG 掩模之前,通过准备设计文件来定义 Ge 生长区域。在本工作中,使用商业软件(例如AutoCAD)准备与[110]方向对齐的线和空间图案以及宽度为4毫米的方形Si窗口区域。
- 使用软件确定SEG掩模(特别是W窗口和W掩模)的设计。W 窗口是窗口宽度(Si 种子宽度),W 掩模是 SiO2 掩模宽度,使得 SEG Ge 层可以与其相邻层合并。通过单击打开的文件→结构→矩形或多段线来绘制矩形来确定 W窗口和 W蒙版。
注意: 矩形的宽度变为 W窗口,矩形的间隔变为 W掩码。在本工作中,W窗口 和W掩模 的最小值分别为0.5 μm和0.3 μm,这受到所采用的EB光刻系统中分辨率的限制。 - 作为参考,绘制宽度为 D 的 4 mm 的方形 Si 窗口区域,视为毯子区域。单击" 打开文件"→结构→矩形或折线 以绘制方形 Si 窗口。使用 图1 所示的原理图准备线和空间图案以及4 mm方形毯区域。
- 制备电阻率为1-100 Ω∙cm的B掺杂p-Si(001)衬底。在本工作中,使用4英寸Si基板。必要时用食人鱼溶液(20 mL 30% H 2 O 2 和 80 mL 96% H2SO4 的混合物)清洁基材表面。
- 打开管式炉的盖子,使用玻璃棒将硅基板装入炉中。在本工作中,一次氧化10个Si基底。
- 通过打开气阀开始将干燥的N2 气体吹入炉中。然后,通过控制阀门将气体流量设置为 0.5 L/m。
- 通过更改程序设置退火温度。在本工作中,使用"图案步骤(模式2)"并将工艺温度设置为900°C。 然后,通过推送 函数运行→程序。
- 当温度达到900°C时,关闭干燥的N2阀,打开干燥的O 2阀(O 2流量= 1L / m),并保持2小时。
注意:在黄色房间中执行步骤 2.1.9-2.1.16。 - 使用旋涂机用表面活性剂(OAP)涂覆氧化的Si基底,然后在110°C下在加热板上烘烤90秒。
- 表面活性剂涂覆后,使用旋涂机用光刻胶(例如ZEP520A)涂覆Si基底,然后在180°C下在加热板上烘烤5分钟。
- 将表面活性剂和光刻胶装入Si基底到电子束(EB)刻录机中。
- 在EB编写器中读取设计文件(在步骤2.1.2中准备)并制作操作文件(WEC文件)。在WEC文件中将剂量设置为120μC / cm2 。基板加载完成后,通过单击单个曝光按钮进行EB 曝光 。
- 通过单击 晶圆进位 从EB写入器卸载基板→在曝光结束时卸载。
- 在通风室中准备光刻胶显影剂(ZED)和冲洗剂(ZMD)。将暴露的Si基底在室温下浸入显影剂中60秒。
- 从显影剂上去除Si基底,然后用N2 气体干燥基板。
- 将显好的Si基板放在加热板上,在110°C下烘烤90秒。
- 将Si基底浸入缓冲氢氟酸(BHF-63SE)中1分钟,以去除由于EB暴露和发育而暴露在空气中的部分SiO2 层。
- 通过浸入有机光刻胶去除剂(例如Hakuri-104)中15分钟,从Si衬底上去除光刻胶。
- 将Si衬底浸入0.5%稀释的氢氟酸中4分钟,以去除窗口区域中的稀天然氧化物,但保留SiO2 掩膜。然后加载到超高真空化学气相沉积(UHV-CVD)室中以生长Ge。 图2 显示了本工作中使用的UHV-CVD系统。
- 外延锗生长
- 将带有SEG掩模的Si衬底(如步骤2.1中制造)装入负载锁定室。
- 在操作计算机上显示的 配方 选项卡中设置缓冲液/主生长温度。确定Ge主要生长的持续时间,以便SEG Ge层与相邻层合并。要确定主要增长的持续时间,请考虑 Ge 在{113}平面上的增长率,它决定了面内/横向方向的增长26。在本工作中,将650°C和700°C的主要生长持续时间分别设置为270分钟和150分钟。
- 在主窗口中单击 开始 ,然后将Si衬底自动转移到生长室中。
注意:外延锗生长方案(步骤2.2.4-2.2.7)将自动处理。 - 在低温(≈380°C)下在负载的Si衬底上生长Ge缓冲液。使用在Ar中稀释9%的GeH 4作为源气,并在缓冲液生长期间将GeH4的分压保持在0.5 Pa。
- 在高温下生长Ge主层。在主要生长期间将GeH4 的分压保持在0.8 Pa。在本工作中,使用650和700 °C两种不同的温度作为主要生长温度,以便将SEG Ge与圆形截面和{113}面截面25进行比较。
注意:(001)平面上Ge的生长速率为11.7nm/min,与温度无关。 - 为了可视化SEG Ge的演变及其聚结,通过在另一个Si衬底上定期插入10nm厚的Si 0.3 Ge0.7分界层来进行Ge生长。Si0.3 Ge 0.7层是使用Si2H6和GeH 4气体形成的。在Si 0.3 Ge 0.7层生长过程中,将Si2H6气体的分压设置为0.02 Pa,将GeH4气体的分压设置为0.8Pa。
- 当Si衬底自动从生长室转移到负载锁定室时,请排放负载锁定室并手动卸载Si衬底。
- 蚀刻坑密度 (EPD) 测量
- 使用超声波清洗机将 32 mg I2 溶解在 67 mL 的 CH3COOH 中。
- 混合I2溶解的CH 3 COOH,20 mL HNO3和10 mLHF。
- 将锗生长的硅基底浸入CH 3 COOH/ HNO3/ HF/ I 2溶液中5-7秒,以形成蚀刻凹坑。
- 用光学显微镜(通常为100倍)观察蚀刻的Ge表面,以确保蚀刻的凹坑成功形成。
- 使用原子力显微镜(AFM)来计数蚀刻的凹坑。将蚀刻的Ge样品放在AFM载物台上,然后单击自动接近 接近探针。
- 使用与AFM集成的光学显微镜确定观察区域,并扫描五个不同的10 μm x 10 μm区域。幅度阻尼因子是自动确定的。
- 透射电镜观测
- 使用聚焦的Ge离子束(FIB微采样方法)从聚结/毯状Ge层中拾取TEM样品27。
- 使用氩离子在离子研磨系统中抛光TEM试样。在本工作中,用于横截面观测的TEM试样在[110]方向上为150-500 nm,在[001]方向上将平面视图观测的透视图样品减薄为200 nm。
- 对于平面透射电镜试样,用非晶层保护Ge层的顶面,然后从Ge层的底部(基底)侧向下变薄。
- 在 200 kV 的加速电压下进行 TEM 观察。执行横截面明场扫描透射电镜 (STEM) 观察,以观察厚 (500 nm) 透射电镜标本。
- 对于具有Si0.3 Ge 0.7分界层的聚结Ge,在200 kV的加速电压下进行横截面高角度环形暗场(HAADF)STEM观测。
结果
理论计算
图3显示了6种聚结Ge层中TD的计算轨迹:在这里,我们将孔径比(APR)定义为W窗口/(W窗口+ W掩模)。图3a显示了APR = 0.8的圆形SEG原点聚结Ge。在这里,2/6 TD 被困住。图3b显示了APR = 0.8的{113}面SEG原点聚结Ge。在这里,0/6 TD被捕获。图3c显示了APR = 0.1的圆形SEG原点聚结Ge。在这里,5/6 TD 被困住。图 3d 显示了 APR = 0.1 的{113}面 SEG 原点合并 Ge。在这里,6/6 TD 被困住。图3e显示了APR = 0.1的圆形SEG原点聚结Ge,以防Ge生长在SiO2掩码上。在这里,0/6 TD被捕获。图3f显示了APR = 0.1的{113}面SEG原产地聚结Ge,以防Ge在SiO2掩码上生长。在这里,0/6 TD被捕获。
在 (x 0, 0) 处生成的 6 个 TD 的轨迹,其中 x 0 = 0.04、0.1、0.2、0.4、0.6 和 0.8 倍 Wwindow/2,在每个图中显示为红线。位于这两个SEG Ge层聚结点上方的TD向上传播到顶表面,而点下方的TD向下传播以保持在SiO2掩模上的空隙表面。
在图3a-3d中,假设SEG Ge不会在SiO2上生长。因此,假设{113}面SEG Ge的侧壁是圆形的,以便不接触SiO2掩蔽区域。结果表明,在APR为0.8时,圆形SEG和聚结Ge比{113}面情况更有效地降低TDD,而{113}面和聚结Ge在APR为0.1时比圆形Ge更有效。这种"交叉"归因于SEG顶部附近存在{113}刻面:{113}刻面比圆形表面更偏离[001]方向。
图3e和图3f显示了孔径比为0.1的聚结Ge,假设Ge在SiO 2上没有成核,但显示SiO 2掩膜润湿,在先前报道的Ge聚结13,15,22,28,29,30,31中广泛报道。如图3e和图3f所示,两个SEG之间没有半圆柱形空隙,因此没有TD被困在表面。
图 4 显示了合并 Ge 中计算的 TDD。 在图 4 中,红线显示了源自圆形 SEG Ge 的聚结 Ge 中计算的 TDD,蓝线显示了源自{113}面 SEG Ge 的聚结 Ge 中计算的 TDD。由于Si上Ge中的TD源于Ge和Si之间的晶格失配,因此假设TD的产生仅发生在Ge和Si之间的界面处。换句话说,TDD应该通过APR降低。
当APR大于0.11时,圆形SEG Ge比{113}面的SEG Ge更有效(图3a和图3b)。另一方面,当APR小于0.11时,{113}面SEG Ge比圆形SEG Ge更有效(图3c和图3d)。如图3所示,这种交叉归因于SEG顶部附近存在{113}刻面(x 0≈ 0)。请注意,图3e和图3f对应于图4中的黑线,显示了APR还原引起的TDD降低,而不是聚结(即,SEG Ge与SiO2润湿对TDD还原有负面影响)。
实验验证
图5显示了典型的横截面扫描电子显微镜(SEM)图像(图5b-5d,5f)和分布图(图5a,5e),显示了是否发生聚结。 图5b-5d,5f显示了非聚结SEG Ge层的横截面SEM图像(图5b,在700°C下生长;图5f,在650°C下生长),将SEG Ge层与非平坦的顶面聚结(图5c,在700°C下生长),以及具有平坦顶面的聚结SEG Ge层(图5d;在700°C下生长)。图5b和图5d所示的SEM图像在沉积Pt保护层后由聚焦离子束抛光。对于目前的生长条件,当W窗口和W掩模小于1μm时,就会发生聚结。W掩模为1μm或更大的SEG掩模可防止Ge由于在横向26上少量Ge生长而聚结。W窗口为2μm或更大的SEG掩模也可以防止Ge的聚结,尽管当W窗口小于1μm时会发生聚结。这是因为Ge在SiO2上的横向生长速率取决于W窗口30。掩模和窗口图案的依赖性总结在图7a(700°C)和图7e(650°C)中。
比较非聚结的SEG Ge层(图4b和图4f),可以清楚地看到,在700°C下生长的SEG Ge层具有圆形横截面,而在650°C下生长的SEG Ge层具有{113}面横截面。如图5b所示,在700°C下的生长显示出圆形的SEG Ge,在SiO 2上没有Ge生长(即,SiO2掩膜没有润湿)。因此,增长如图3a和图3c一样进行。另一方面,如图5f所示,{113}面SEG Ge在650°C时出现。 强烈暗示Ge会显示出SiO2面罩的润湿。相反,边缘是圆形的(即不润湿)。因此,650°C下的生长介于图3b(无润湿)和图3f(完全润湿)之间。这表明TDD降低值应该在图3b和图3f之间。考虑到图6所示的理论结果,SEG Ge横截面的这些差异应该会强烈影响聚结Ge层中的TDD。
SiO2 上润湿生长的差异可以理解如下。Ge和SiO2 (θ)之间的接触角由杨氏方程确定:

这里,SiO2、γGe和γint γ分别是SiO 2表面自由能、Ge表面自由能和Ge/SiO2界面自由能。随着锗生长的进行,赛格锗侧壁的角度变大。当SEG Ge侧壁的角度达到接触角θ时,SEG Ge需要沿垂直([001])或横向([] )方向生长。在650°C生长的情况下,垂直生长受到{113}面的严重限制,因此SEG Ge更喜欢横向生长(即湿润生长)。尽管润湿会在Ge和SiO2界面处产生位错,但它最终将在半圆柱形空隙表面终止。在700°C生长的情况下,Ge可以垂直方向生长,并且由于γ较大,接触角大于650°C。这就是为什么650°C生长的Ge在SiO2上显示润湿,而700°C生长的Ge则不然的原因。
)方向生长。在650°C生长的情况下,垂直生长受到{113}面的严重限制,因此SEG Ge更喜欢横向生长(即湿润生长)。尽管润湿会在Ge和SiO2界面处产生位错,但它最终将在半圆柱形空隙表面终止。在700°C生长的情况下,Ge可以垂直方向生长,并且由于γ较大,接触角大于650°C。这就是为什么650°C生长的Ge在SiO2上显示润湿,而700°C生长的Ge则不然的原因。
对于聚结后的Ge,横截面结构不受生长温度的影响:通过横截面SEM观察无法区分在650 °C下生长的聚结Ge层和在700 °C下生长的Ge层。
请注意,对于制造的图案,W窗口值大于设计值,W掩模值小于设计值,因为采用各向同性湿蚀工艺来制造掩模。通过Ge生长后横截面SEM观察获得W窗口和W掩模的实际值。
除此之外,根据横截面SEM观察和椭圆偏振光谱测量,掩模SiO2层的厚度为30 nm。采用如此薄的SiO2层来检查图3和图4中解释的TDD降低,消除了外延颈缩对ART的影响。在本工作中,长宽比低于0.05,这足以忽略外延颈缩对ART的影响。
图6a显示了具有Si0.3 Ge 0.7分界层的SEG的横截面HAADF阀干,图6a的示意图如图6b所示(W窗口= 0.66μm ,W掩模= 0.84μm)。Si0.3 Ge 0.7分界层清楚地显示了700 °C下生长过程中的表面形状。 STEM图像显示了从圆形SEG到聚结后形成的平坦外延层的每个生长步骤的Ge表面。聚结后刚开始的增长率在聚结区域显著提高。这种快速生长可能是由Ge外延层诱导的,使其表面积最小化以获得能量稳定。
与纯Ge SEG相比,带有Si0.3 Ge 0.7分界层的Ge SEG显示出SiO 2掩膜的润湿(图8a)。润湿的差异可能是由于插入了Si0.3 Ge 0.7分界层,其成核在SiO2层上增强,不太可能是Ge。
平顶聚结Ge(图5a和图5e中的蓝色圆圈区域)用于EPD测量。Ge层平均蚀刻200 nm。蚀刻后的典型AFM图像如图7a和图7b所示,用于在700°C(W窗口= 0.66μm和W掩模= 0.44μm)下生长的1.15μm厚的聚结Ge和在650°C下生长的2.67μm厚的聚结Ge(W窗口= 0.66μm和W掩模= 0.34μm)。作为参考,在700°C下生长的1.89μm厚的Ge毯的图像如图7c所示。AFM图像中的黑点是蚀刻的凹坑,表明TD的存在。图7a-7c的EPD值分别为7.0 x 10 7/cm 2、7.9 x 107/cm2和8.7 x 107/cm2。我们之前的报告表明,在该蚀刻条件下获得的EPD等于通过平面透射电子显微镜(TEM)确定的TDDs4,32,33,34。毯状锗层(7.9 ± 0.8 x 10 7/cm 2)的实测EPD与平面透射电镜观测得到的TDD非常吻合,面积相对较大,为6 x 8 μm 2(8.7 ± 0.2 x 107/cm 2),表明EPD等于TDD。
为了将实验获得的TDD与计算进行比较,请考虑厚度对TDD的影响。有一种趋势是,TDD随着Ge厚度的增加而降低,因为TD对湮灭的机会增加。因此,在聚结的Ge(比毯状Ge薄)观察到的TDD降低应归因于图3和图4中描述的机制(即,我们需要计算归一化TDD,以将实验获得的TDD与图4中计算的TDD进行比较)。归一化前,考虑TDD的厚度和生长温度,对毛毯Ge(ρ毯)进行TDD校正。与之前的报告35,36类似,对于使用UHV-CVD在530-650°C温度范围内生长的Ge层,ρ毯[/cm 2]近似表示为2.52 x 1013 x [d (nm)]-1.57。这里,d是毛毯Ge层的厚度。ρ毯 [/cm 2] 对于在 700 °C 下生长的 Ge 层进行还原,近似表示为2.67 x 1012 x [d (nm)]-1.37。
图 7d 显示了归一化 TDD 作为 APR、W 窗口/(W窗口 + W掩码)的函数。在650 °C下生长的聚结锗中的TDD显示为蓝色三角形,在700 °C下生长的TDD显示为红色菱形。由于SEG Ge在650°C时显示出SiO2掩膜的一些润湿,因此生长数据应介于黑线和蓝线之间。赛格·戈在700°C时应在红线上。实验结果与基于截面形状和润湿条件的计算结果吻合较好。
如上所述,结论是,基于TD上生长表面的成像力的模型很好地解释了TD的行为。为了了解TD与表面的相互作用,我们观察到了具有明场横截面STEM的TD。在 图8a中观察到缺陷在半圆柱形空隙的表面上弯曲和终止。TD的这种行为与 图3所示的TD的计算轨迹非常相似。然而,观察到的TD轨迹并不能完全再现我们在 图3中预测的轨迹。这种差异可以解释为TD变换的结果,以便在生长期间或之后最小化其能量(例如,温度从生长温度降低到室温)。 图8b 显示了Si上聚结Ge外延层中的应变模拟,由于Ge和Si之间的热膨胀系数不匹配,在Si上的Ge层中诱导了拉伸应变。模拟结果表明, 半圆柱空隙顶部发生应变积聚, 半圆柱空隙次表层发生应变松弛, 这将促使TDs发生转变.
另一方面, 图8c 显示了空隙顶部的缺陷生成,尽管在制备TEM试样期间会去除生成点。 图8c 中的缺陷接近直线,但缺陷与(001)平面(≈78.3°)之间的角度与{111}平面(54.7°)的夹角不一致。
图8d所示的电子衍射图是在图8c缺陷附近获得的。没有条纹光表明不应该有二维结构(即缺陷是脱位)。在先前的报告28,29,30,31,37中,形成了2D缺陷,在电子衍射图案中显示出清晰的条纹光,这与本工作中观察到的相反。观察结果(不存在二维缺陷)支持以下预测:空隙及其自由表面有助于释放Si上Ge中的应变,或以其他方式导致相邻SEG Ge层之间的晶体取向错误。这与之前的报告一致,该报告简要表明,在SiO2掩模38上具有空隙的聚结SEG Ge层中可以防止2D缺陷的形成。
图10c所示的TD生成有两个候选者:SEG Ge层之间的应变分布和取向误差。在Si上的外延Ge中,由于Ge与Si39之间的热膨胀系数不匹配,在Ge中诱导了拉伸应变。图8b所示的模拟结果表明,如上所述,在空隙顶部的拉伸应变(~0.5%)累积。空隙顶部的这种应变积累可能导致TD产生,如图8c所示。另一个候选者,即SEG Ge层之间的取向错误,已被假定会产生2D缺陷,如先前的报告所观察到的那样,显示SEG Ge层28,29,30,31,37的聚结。然而,在本工作中,由于存在空隙,2D缺陷的产生将被抑制,如上一份报告38中简要提到的,但由于抑制不完全,导致TD的产生。关于定向错位引起的错位的更详细讨论将在后面的部分中通过示意图进行描述(图12)。
图9a和图9b显示了分别在同一基板上生长的聚结Ge层(W窗口= 0.82μm,W掩模= 0.68μm)和毯状Ge层的明场平面透射电镜图像。对于平面透射电镜观察,如步骤2.4.3所述,使用Ge层的前200 nm区域形成TEM试样,并在图9顶部的示意图横截面中用红色虚线方块表示。SiO2 掩模条纹与图 9a 中聚结 Ge 的 [110] 方向对齐。图9a所示的平面透射电镜图像是在6 μm x 8 μm区域拍摄的。尽管此 TEM 图像中有五对 SiO 2 掩模和 Si 窗口区域,但在 TEM 图像中无法区分 SiO2 掩模和 Si 窗口上方的区域。这是因为观察到的区域(顶部200 nm)远高于半圆柱形空隙的位置(底部150 nm)。
发现从图9a和图9b获得的TDD分别为4.8 x 107/cm 2和8.8 x 107/cm2。如图7d所示,EPD测量显示聚结Ge层(W窗口= 0.82μm和W掩模= 0.68μm)中的TDD为4 x 107 cm−2。因此,图9a中的TDD与图7所示的EPD非常吻合。同样值得注意的是,EPD测量和TEM观测都没有显示TDD再增加,这在SEG Ge层聚结时经常显示(即,由于TD的产生而导致TDD再增加(图8b)被抑制到以至于TDD再增加在当前TDD范围内可以忽略的程度(大约107 / cm2))。
应该指出的是,在聚结的Ge中实现了大至4μm x 4μm的无TD区域,如图9a所示。尽管图9b中的毯状Ge显示了具有相对均匀分布的TD,但聚结的Ge具有高TDD和低TDD区域。TD分布的这种差异表明,在合并的Ge中可以实现TDD的进一步降低。如图9a所示,4 μm x 4 μm区域中的1 TD对应于6.25 x 106 / cm2的TDD。
比较聚结Ge(图9a)和毯状Ge(图9b),很明显,聚结Ge中的缺陷线长度比毯状Ge中的缺陷线长。在聚结的Ge中,通常有1μm长的缺陷线,并且它们与[110]方向对齐。请注意,[110] 方向是 SiO2 条纹的长度方向。对于如此长的缺陷线,有两种可能的解释:(i)观察到2D缺陷和(ii)位错在[110]方向上倾斜。但是,由于观察到的长缺陷的宽度,2D 缺陷会立即被拒绝(即,平面上的 2D 缺陷应显示更宽的缺陷线{111})。从几何上看,考虑到TEM试样的厚度(200 nm)和{111}与(001)平面(54.7°)的角度,{111}平面上的二维缺陷应显示140nm宽的缺陷线。平面透射电镜图像显示缺陷线宽度为10-20 nm,比140 nm窄得多。因此,显示为长线的缺陷应归因于(ii)在[110]方向上倾斜的位错。一个简单的几何计算给出了倾斜位错和(001)平面之间的角度:tan−1(200 nm/1 μm) = 11.3°。请注意,如图 8b所示,如果不进行生长后退火,毯状Ge中的TD倾向于几乎垂直于基板,在平面透射电镜图像中显示小黑点。
为了更详细地分析倾斜的TD,可以任意观察具有高TDD的小区域,如图 10所示。TEM试样是从聚结Ge层的顶部200 nm制备的,与上面的平面透射电镜观测相同。
图10a和图10b显示了在同一区域拍摄的暗场(图12a的g = [220]和图12b的[ ])平面透射电镜图像。在图12中,在4μm x 4 μm区域内观察到四个倾斜位错。图10b显示,当衍射矢量g = []时,一个倾斜位错(红色圆圈的位错)消失,这表明对于红圈位错,Burgers矢量被确定为[110]或[
])平面透射电镜图像。在图12中,在4μm x 4 μm区域内观察到四个倾斜位错。图10b显示,当衍射矢量g = []时,一个倾斜位错(红色圆圈的位错)消失,这表明对于红圈位错,Burgers矢量被确定为[110]或[
 ]。由于缺陷线在[110]方向上,因此发现该位错是螺钉位错。其他三种倾斜位错(绿色圆圈的)归因于混合位错,因为它们没有消失,无论选择什么衍射矢量g。
]。由于缺陷线在[110]方向上,因此发现该位错是螺钉位错。其他三种倾斜位错(绿色圆圈的)归因于混合位错,因为它们没有消失,无论选择什么衍射矢量g。
对于聚结Ge层中TD的倾斜有两种可能的解释:(i)Ge在[110]方向上的生长,以及(ii)SEG Ge层聚结时的缺陷产生。
Ge 在 [110] 方向上增长
图11显示了平面视图SEM图像以及从非平面SEG表面形成平坦外延层的生长过程,作为示意图。反射由EB光刻和湿化学蚀刻形成的SiO 2条纹图案的边缘起伏,聚结优先从某些点开始,然后在SiO2掩模上方的[110]和[ ]方向进行。图11b和图11c示意性地显示了SEG Ge层部分合并时的鸟瞰图和(
]方向进行。图11b和图11c示意性地显示了SEG Ge层部分合并时的鸟瞰图和( )横截面视图。如图3所示,在生长窗口产生的TD出现在空隙上方,然后由于成像力,TD开始沿[110]或[
)横截面视图。如图3所示,在生长窗口产生的TD出现在空隙上方,然后由于成像力,TD开始沿[110]或[ ]方向传播。这导致TD在[110]方向上倾斜(如图9a所示)。图11c中的红色实线显示了根据上述模型在[110]方向上弯曲的TD,这解释了在图9a和图10中观察到的倾斜TD在定性基础上的存在。
]方向传播。这导致TD在[110]方向上倾斜(如图9a所示)。图11c中的红色实线显示了根据上述模型在[110]方向上弯曲的TD,这解释了在图9a和图10中观察到的倾斜TD在定性基础上的存在。
该机制可以解释边缘和螺钉TD,同时考虑在Ge/Si界面40上生成的TD的汉堡矢量。当Ge在Si衬底上生长时,形成边缘失配位错(MDs)以释放应变,并且MDs在[110]或[ ]方向上对齐。MD形成螺纹段(即TD),源自在[110]方向(MD110)对齐的MD的TD的Burgers向量是a/2[]或a/2[
]方向上对齐。MD形成螺纹段(即TD),源自在[110]方向(MD110)对齐的MD的TD的Burgers向量是a/2[]或a/2[
 ](a:晶格常数)。另一方面,Burgers 向量是 a/2[110] 或 a/2[
](a:晶格常数)。另一方面,Burgers 向量是 a/2[110] 或 a/2[ ],表示源自 [
],表示源自 [ ] 方向
] 方向 对齐的 MD 的 TD。在MD 110的TD向[110]方向倾斜的情况下,平面透射电镜观测显示TD为边缘位错。类似地,当来自
对齐的 MD 的 TD。在MD 110的TD向[110]方向倾斜的情况下,平面透射电镜观测显示TD为边缘位错。类似地,当来自 的TD向[110]方向倾斜时,它们被观察到为螺钉位错。
的TD向[110]方向倾斜时,它们被观察到为螺钉位错。
SEG Ge层聚结时产生的缺陷
图12显示了解释SEG Ge层以小旋转(即定向错误)合并时产生的缺陷的原理图。如图 12所示,方向错误应在聚结界面处产生边缘/螺钉/混合位错。 在图 12 中,两个 SEG Ge 层在 [110] 方向上的定向误差分解为三种类型的旋转。 图12a-12c分别显示了围绕[110]轴、[001]轴和[ ]轴的旋转。
]轴的旋转。
假设图12中的聚结发生在严格的外延Ge层(Ge(001))和具有取向错误的相邻SEG Ge层(m-Ge)之间。围绕[110]轴的旋转(图12a)导致在以虚线表示的边界处产生平行于[110]方向的边缘位错。类似地,如图12b所示,平行于该方向的边缘位错是围绕[001]轴旋转的结果产生的。另一方面,围绕[ ]轴的旋转(如图12c所示)产生螺杆位错网络,该网络由b = [110]和b = [001]的位错组成,类似于显示螺钉位错网络41的Si(001)表面的直接粘合情况。图10中观察到的螺钉TD可归因于围绕[]
]轴的旋转(如图12c所示)产生螺杆位错网络,该网络由b = [110]和b = [001]的位错组成,类似于显示螺钉位错网络41的Si(001)表面的直接粘合情况。图10中观察到的螺钉TD可归因于围绕[] 轴旋转的定向错误。围绕[110]轴(图12a)和围绕[
轴旋转的定向错误。围绕[110]轴(图12a)和围绕[ ]轴(图12c)的旋转组合可以解释图12所示的混合TD。图9b所示的混合位错也可以通过围绕[001]轴的旋转(图12b)和在[
]轴(图12c)的旋转组合可以解释图12所示的混合TD。图9b所示的混合位错也可以通过围绕[001]轴的旋转(图12b)和在[ ]轴上的旋转(图12c)的组合来解释。
]轴上的旋转(图12c)的组合来解释。
假设由定向错误引起的位错以 1 x 107/cm2 的密度产生,则围绕 [ ] 轴旋转的平均角度估计为 0.034° 42。与估计相比,我们已经报道了线形SEG Ge层在100角秒(= 0.028°)内存在取向波动,采用微束X射线衍射观测43。所报道的定向波动和估计的旋转角度表现出较好的一致性,支持基于定向错误的TD生成机制。
] 轴旋转的平均角度估计为 0.034° 42。与估计相比,我们已经报道了线形SEG Ge层在100角秒(= 0.028°)内存在取向波动,采用微束X射线衍射观测43。所报道的定向波动和估计的旋转角度表现出较好的一致性,支持基于定向错误的TD生成机制。

图 1:Si(001) 衬底上的线间距形状和 4 mm 方形 SEG 掩模的示意图。 请点击此处查看此图的大图。

图 2:特高压-CVD 机器部件的图片;气柜、工艺室、负载锁室和操作计算机。 请点击此处查看此图的大图。
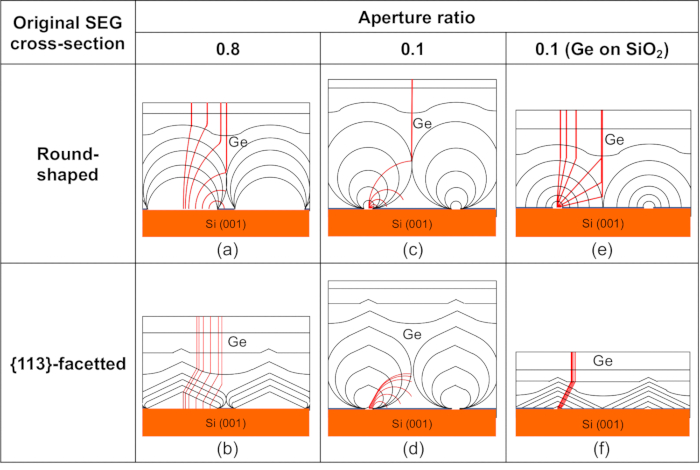
图 3:(a) 圆形 SEG 原点,孔径比 = 0.8,(b) 圆形 SEG 原点,孔径比 = 0.1,(c) {113} 刻面 SEG 原点,孔径比 = 0.8 和 (d) {113} 刻面 SEG 原点,孔径比 = 0.1 中 4 个 TD 的计算轨迹。 请点击此处查看此图的大图。
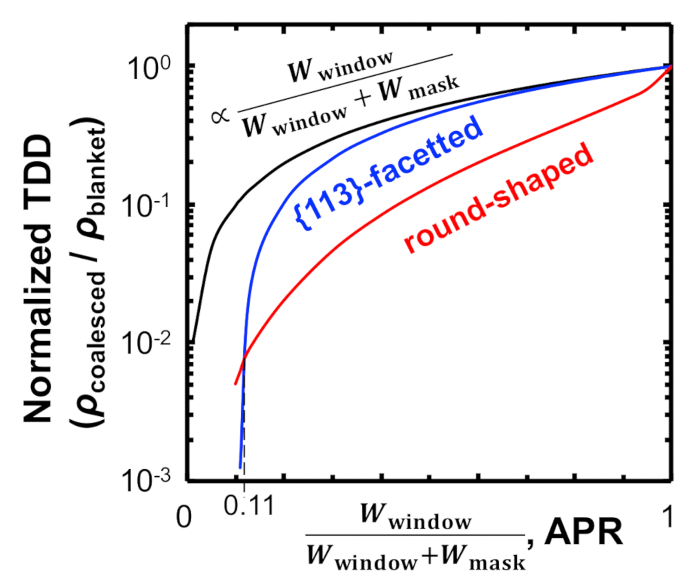
图 4:聚结 Ge 中计算出的 TDD 源自{113}面 SEG Ge(蓝线)和圆形 SEG Ge(红线)。 请点击此处查看此图的大图。

图 5:聚结/非聚结 Ge 层的分布图和 SEM 图像。 请单击此处查看此图的大图。

图 6:(a) 在 700 °C 下生长的聚结 Ge(W 窗口 = 0.66 μm,W 掩模 = 0.84 μm)的横截面 HAADF STEM 图像,具有 10 nm 厚的 Si 0.3 Ge0.7 分界层,以及 (b) 对应于 (a) 所示条件的示意图。 请点击此处查看此图的大图。

图 7:用于测量 (a) 在 700 °C 下生长的 1.15 μm 厚的聚结锗(W 窗口 = 0.66 μm 和 W 掩模 = 0.44 μm)、(b) 在 650 °C 下生长的 2.67 μm 厚的聚结锗的典型 AFM 图像(W 窗口 = 0.86 μm 和 W 掩模 = 0.34 μm)和 (c) 在 700 °C 下生长的 1.89 μm 厚的聚结锗, 以及(d)项中环保署的测量结果摘要。 请点击此处查看此图的大图。
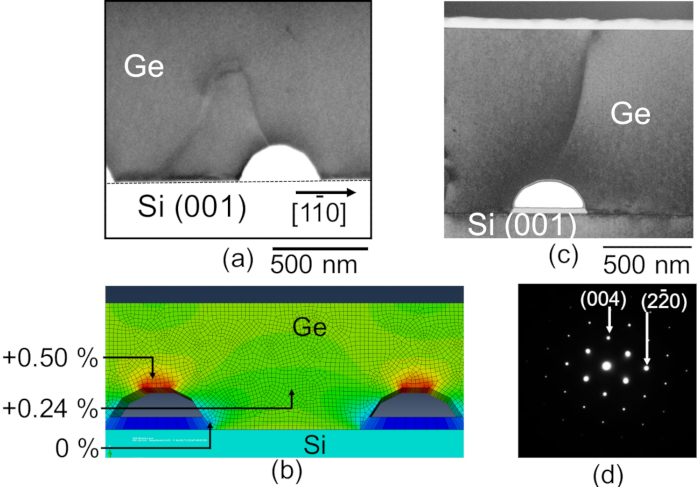
图 8:(110) 聚结 Ge 层的横截面 (a) STEM 和 (b) TEM 图像(W 窗口 = 0.66 μm 和 W 掩模 = 0.44 μm),(c) 在 (b) 所示缺陷附近获得的电子衍射图,以及 (d) 聚结 Ge 中应变分布的有限元方法模拟结果。 图9(a)、(c)和(d)已从20修改而来。请点击此处查看此图的大图。
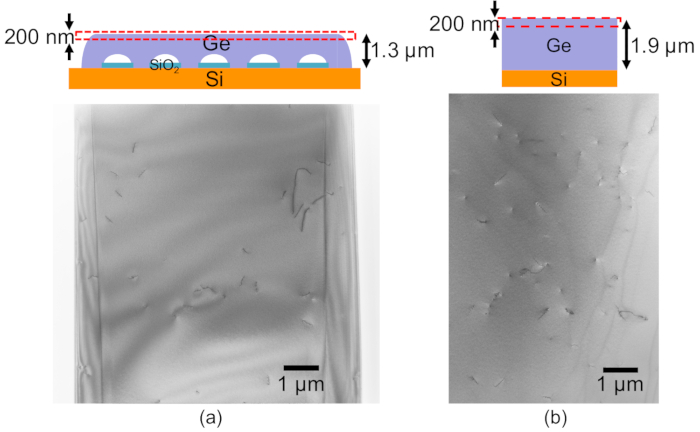
图 9:(a) 聚结的 Ge 层(W 窗口 = 0.82 μm,W掩模 = 0.68 μm)和 (b) 毯状 Ge 层的明场平面透射电镜图像。 请点击此处查看此图的大图。
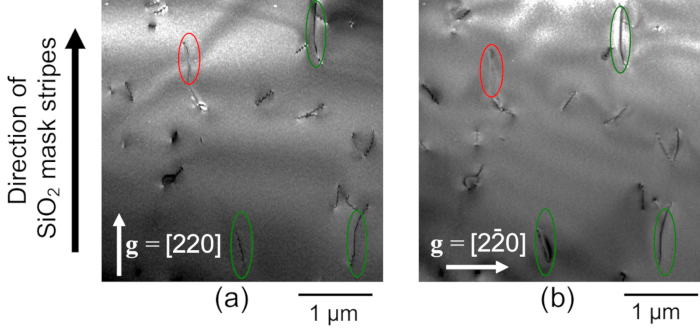
图 10: 高 TDD 小区域的平面透射电镜图像,g 矢量为 (a) [220] 和 (b) [ ]。 这个数字是从 20修改的。 请点击此处查看此图的大图。
]。 这个数字是从 20修改的。 请点击此处查看此图的大图。
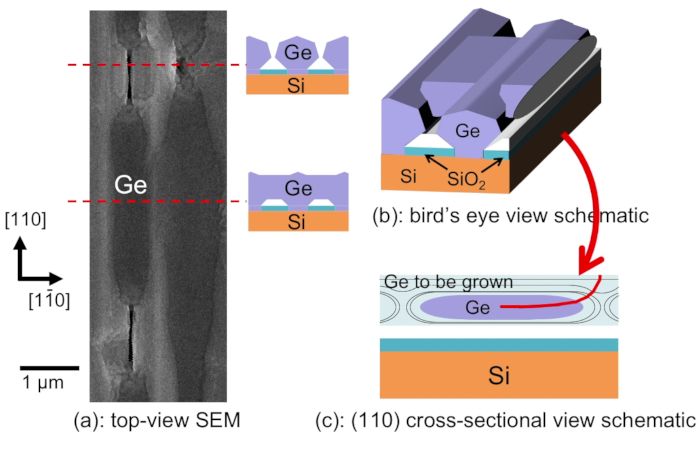
图11:(a)平面SEM图像,(b)鸟瞰图,(c) 部分合并的SEG Ge的横截面示意图。这个数字是从20修改的。请点击此处下载此视频。
部分合并的SEG Ge的横截面示意图。这个数字是从20修改的。请点击此处下载此视频。
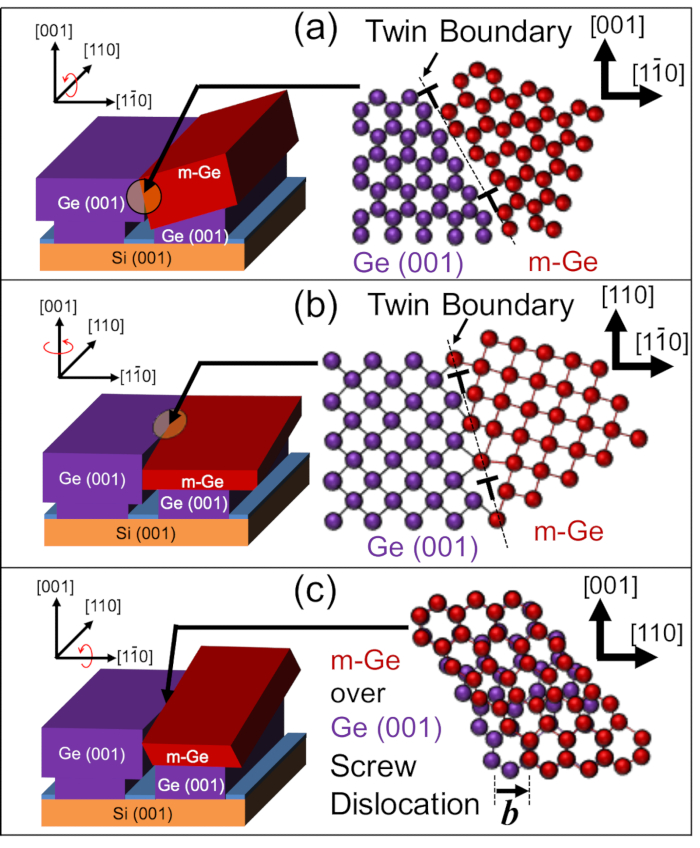
图 12:SEG Ge 层围绕 (a) [110]、(b) [001] 和 (c) [] 方向与晶体旋转聚结时产生的缺陷示意图。 这个数字是从20修改的。请点击此处查看此图的大图。
这个数字是从20修改的。请点击此处查看此图的大图。
| 方法 | 达到TDD (cm-2) | 温度(°C) | 缓冲层厚度 |
| 热退火 | 2e7 | ≈900 °C | ≈100 纳米 (低温缓冲液) |
| 硅锗分级缓冲液 | 1e6 | 生长温度 (600–700 °C) | 2–3 微米 |
| 艺术 | 1e6 | 生长温度 (600–700 °C) | 500–1000 纳米 |
| 硅柱种子 | 1e5 | ≈800 °C | ≈5 微米 |
| 这项工作 | 4e7 | 生长温度 (700 °C) | ≈150海里 |
表1:传统/提出的TDD减少方法的光子器件应用的TDD和缺点摘要。
补充 图1:广泛用于降低Si上外延Ge中TDD的四种典型方法:(a)热退火,(b)SiGe分级缓冲液,(c)纵横比捕获(ART)和(d)Si柱晶种。 请点击这里下载此图。
补充视频 1:圆形 SEG Ge 中由于成像力而弯曲的 TD 示意图。 请点击此处下载此视频。
讨论
在本工作中,实验显示了4 x 107 / cm2 的TDD。为了进一步降低TDD,协议中主要有2个关键步骤:SEG掩膜制备和外延Ge生长。
图4所示的模型表明,当APR,W窗口/(W窗口+ W掩模)小至0.1时,TDD可以降低到107 / cm2在聚结Ge中。为了进一步降低TDD,应准备具有较小APR的SEG口罩。如步骤2.1.2所述,W窗口和W掩模的最小值分别为0.5μm和0.3μm,受所采用的EB光刻系统中分辨率的限制。降低APR的一种简单方法是修改光刻和蚀刻工艺(例如,使用另一种光刻胶,使用更好的光刻系统,使用更薄的SiO2层和较浅的BHF蚀刻等)。成熟的光刻和蚀刻工艺将使SEG掩模的窄于100 nm。本工作在W掩模≤1 μm时得到具有平坦顶面的聚结Ge。因此,在目前的生长条件下,100 nm的W窗口和900 nm的W掩模(APR = 0.1)将为我们提供具有平坦顶面的聚结Ge。
除此之外,SEG掩模制备的修改应减少SEG掩模的边缘起伏,从而抑制Ge SEG层之间的取向错误。由于SEG掩模制备的修改,SEG Ge层聚结时的TD产生(图11)将被抑制。
计算结果(图3)显示,需要抑制SiO2上的Ge生长以降低TDD。SiO 2上Ge生长的抑制是由Ge生长步骤的改变(即生长温度升高,SEG掩模旋转,引入H2气体和降低GeH 4气体44,45压力)带来的。
本工作提出/验证的TDD还原方法在Ge光子器件中的应用方面优于现有方法(即TDD在没有任何热退火或厚缓冲层的情况下被还原)。最高工艺温度为700 °C,即生长温度,空隙高度为≈150 nm。与现有方法相比,最高温度低于退火温度(典型值为900 °C)7,空隙高度比SiGe梯度缓冲层(通常为几μm)10、 用于ART的SiO2 沟槽(通常为0.5-1 μm)13和 用于Si柱上Ge生长的缓冲层(通常为≈5 μm)18更浅。 表1总结了传统方法/现有方法的比较。
考虑到典型Ge光子器件的占位面积(≈100 μm 2),TDD低于106/cm2,TD < 1/器件将是最终目标。由于该方法TDD的理论极限为0,因此TDD低于106/cm 2是可以实现的。为了实现这一目标,将研究更优化的光刻和蚀刻。
披露声明
作者没有什么可透露的。
致谢
这项工作得到了日本文部科学省(MEXT)的日本科学促进会(JSPS)KAKENHI(17J10044)的资助。制造工艺得到了日本文部科学省"纳米技术平台"(项目编号12024046)的支持。作者要感谢东京大学的K. Yamashita先生和平田S. Ms. Hirata女士在TEM观测方面的帮助。
材料
| Name | Company | Catalog Number | Comments |
| AFM | SII NanoTechnology | SPI-3800N | |
| BHF | DAIKIN | BHF-63U | |
| CAD design | AUTODESK | AutoCAD 2013 | Software |
| CH3COOH | Kanto-Kagaku | Acetic Acid | for Electronics |
| CVD | Canon ANELVA | I-2100 SRE | |
| Developer | ZEON | ZED | |
| Developer rinse | ZEON | ZMD | |
| EB writer | ADVANTEST | F5112+VD01 | |
| Furnace | Koyo Thermo System | KTF-050N-PA | |
| HF, 0.5 % | Kanto-Kagaku | 0.5 % HF | |
| HF, 50 % | Kanto-Kagaku | 50 % HF | |
| HNO3, 61 % | Kanto-Kagaku | HNO3 1.38 | for Electronics |
| I2 | Kanto-Kagaku | Iodine 100g | |
| Photoresist | ZEON | ZEP520A | |
| Photoresist remover | Tokyo Ohka | Hakuri-104 | |
| Surfactant | Tokyo Ohka | OAP | |
| TEM | JEOL | JEM-2010HC |
参考文献
- Giovane, L. M., Luan, H. C., Agarwal, A. M., Kimerling, L. C. Correlation between leakage current density and threading dislocation density in SiGe p-i-n diodes grown on relaxed graded buffer layers. Applied Physics Letters. 78 (4), 541-543 (2001).
- Wang, J., Lee, S. Ge-photodetectors for Si-based optoelectronic integration. Sensors. 11, 696-718 (2011).
- Ishikawa, Y., Saito, S. Ge-on-Si photonic devices for photonic-electronic integration on a Si platform. IEICE Electronics Express. 11 (24), 1-17 (2014).
- Cai, Y. Materials science and design for germanium monolithic light source on silicon, Ph.D. dissertation. , Dept. Mater. Sci. Eng., Massachusetts Inst. Technol. Cambridge, MA, USA. (2009).
- Wada, K., Kimerling, L. C. Photonics and Electronics with Germanium. , Wiley. Hoboken, NJ, USA. 294(2015).
- Higashitarumizu, N., Ishikawa, Y. Enhanced direct-gap light emission from Si-capped n+-Ge epitaxial layers on Si after post-growth rapid cyclic annealing: Impact of non-radiative interface recombination toward Ge/Si double heterostructure lasers. Optics Express. 25 (18), 21286-21300 (2017).
- Luan, H. C., et al. High-quality Ge epilayers on Si with low threading-dislocation densities. Applied Physics. Letters. 75 (19), 2909-2911 (1999).
- Nayfeha, A., Chui, C. O., Saraswat, K. C. Effects of hydrogen annealing on heteroepitaxial-Ge layers on Si: Surface roughness and electrical quality. Applied Physics Letters. 85 (14), 2815-2817 (2004).
- Choi, D., Ge, Y., Harris, J. S., Cagnon, J., Stemmer, S. Low surface roughness and threading dislocation density Ge growth on Si (001). Journal of Crystal Growth. 310 (18), 4273-4279 (2008).
- Currie, M. T., Samavedam, S. B., Langdo, T. A., Leitz, C. W., Fitzgerald, E. A. Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing. Applied Physics Letters. 72 (14), 1718-1720 (1998).
- Liu, J. L., Tong, S., Luo, Y. H., Wan, J., Wang, K. L. High-quality Ge films on Si substrates using Sb surfactant-mediated graded SiGe buffers. Applied Physics Letters. 79 (21), 3431-3433 (2001).
- Yoon, T. S., Liu, J., Noori, A. M., Goorsky, M. S., Xie, Y. H. Surface roughness and dislocation distribution in compositionally graded relaxed SiGe buffer layer with inserted-strained Si layers. Applied Physics Letters. 87 (1), 012014(2005).
- Langdo, T. A., Leitz, C. W., Currie, M. T., Fitzgerald, E. A., Lochtefeld, A., Antoniadis, D. A. High quality Ge on Si by epitaxial necking. Applied Physics Letters. 76 (25), 3700-3702 (2000).
- Park, J. S., Bai, J., Curtin, M., Adekore, B., Carroll, M., Lochtefeld, A. Defect reduction of selective Ge epitaxy in trenches on Si(001) substrates using aspect ratio trapping. Applied Physics Letters. 90 (5), 052113(2007).
- Fiorenza, J. G., et al. Aspect ratio trapping: A unique technology for integrating Ge and III-Vs with silicon CMOS. ECS Transactions. 33 (6), 963-976 (2010).
- Salvalaglio, M., et al. Engineered Coalescence by Annealing 3D Ge Microstructures into High-Quality Suspended Layers on Si. Applied Materials & Interfaces. 7 (34), 19219-19225 (2015).
- Bergamaschini, R., et al. Self-aligned Ge and SiGe three-dimensional epitaxy on dense Si pillar arrays. Surface Science Reports. 68 (3), 390-417 (2013).
- Isa, F., et al. Highly Mismatched, Dislocation-Free SiGe/Si Heterostructures. Advanced Materials. 28 (5), 884-888 (2016).
- Yako, M., Ishikawa, Y., Wada, K. Coalescence induced dislocation reduction in selectively grown lattice-mismatched heteroepitaxy: Theoretical prediction and experimental verification. Journal of Applied Physics. 123 (18), 185304(2018).
- Yako, M., Ishikawa, Y., Abe, E., Wada, K. Defects and Their Reduction in Ge Selective Epitaxy and Coalescence Layer on Si With Semicylindrical Voids on SiO2 Masks. IEEE Journal of Selected Topics in Quantum Electronics. 24 (6), 8201007(2018).
- Park, J. S., Bai, J., Curtin, M., Carroll, M., Lochtefeld, A. Facet formation and lateral overgrowth of selective Ge epitaxy on SiO2-patterned Si(001) substrates. Journal of Vacuum Science & Technology B. 26 (1), 117-121 (2008).
- Bai, J., et al. Study of the defect elimination mechanisms in aspect ratio t.rapping Ge growth. Applied Physics Letters. 90 (10), 101902(2007).
- Montalenti, F., et al. Dislocation-Free SiGe/Si Heterostructures. Crystals. 8 (6), 257(2018).
- Zhang, H. L. Calculation of shuffle 60° dislocation width and Peierls barrier and stress for semiconductors silicon and germanium. European Physical Journal B. 81 (2), 179-183 (2011).
- Kim, M., Olubuyide, O. O., Yoon, J. U., Hoyt, J. L. Selective Epitaxial Growth of Ge-on-Si for Photodiode Applications. ECS Transactions. 16 (10), 837-847 (2008).
- Yako, M., Kawai, N. J., Mizuno, Y., Wada, K. The kinetics of Ge lateral overgrowth on SiO2. Proceedings of MRS Fall Meeting. , (2015).
- Kamino, T., Yaguchi, T., Hashimoto, T., Ohnishi, T., Umemura, K. A FIB Micro-Sampling Technique and a Site Specific TEM Specimen Preparation Method. Introduction to Focused Ion Beams. , Springer. Boston, MA. (2005).
- Park, J. S., et al. Low-defect-density Ge epitaxy on Si(001) using aspect ratio trapping and epitaxial lateral overgrowth. Electrochemical and Solid-State Letters. 12 (4), H142-H144 (2009).
- Li, Q., Jiang, Y. B., Xu, H., Hersee, S., Han, S. M. Heteroepitaxy of high-quality Ge on Si by nanoscale Ge seeds grown through a thin layer of SiO2. Applied Physics Letters. 85 (11), 1928-1930 (2004).
- Halbwax, M., et al. Epitaxial growth of Ge on a thin SiO2 layer by ultrahigh vacuum chemical vapor deposition. Journal of Crystal Growth. 308 (1), 26-29 (2007).
- Leonhardt, D., Ghosh, S., Han, S. M. Origin and removal of stacking faults in Ge islands nucleated on Si within nanoscale openings in SiO2. Journal of Applied Physics. 10 (7), 073516(2011).
- Takada, Y., Osaka, J., Ishikawa, Y., Wada, K. Effect of Mesa Shape on Threading Dislocation Density in Ge Epitaxial Layers on Si after Post-Growth Annealing. Japanese Journal of Applied Physics. 49 (4S), 04DG23(2010).
- Ishikawa, Y., Wada, K. Germanium for silicon photonics. Thin Solid Films. 518 (6), S83-S87 (2010).
- Nagatomo, S., Ishikawa, Y., Hoshino, S. Near-infrared laser annealing of Ge layers epitaxially grown on Si for high-performance photonic devices. Journal of Vacuum Science & Technology B. 35 (5), 051206(2017).
- Ayers, J. E., Schowalter, L. J., Ghandhi, S. K. Post-growth thermal annealing of GaAs on Si(001) grown by organometallic vapor phase epitaxy. Journal of Crystal Growth. 125 (1), 329-335 (1992).
- Wang, G., et al. A model of threading dislocation density in strain-relaxed Ge and GaAs epitaxial films on Si (100). Applied Physics Letters. 94 (10), 102115(2009).
- Leonhardt, D., Ghosh, S., Han, S. M. Defects in Ge epitaxy in trench patterned SiO2 on Si and Ge substrates. Journal of Crystal Growth. 335 (1), 62-65 (2011).
- Sammak, A., Boer, W. B., Nanver, L. K. Ge-on-Si: Single-crystal selective epitaxial growth in a CVD reactor. ECS Transactions. 50 (9), 507-512 (2012).
- Ishikawa, Y., Wada, K., Cannon, D. D., Liu, J., Luan, H. C., Kimerling, L. C. Strain-induced band gap shrinkage in Ge grown on Si substrate. Applied Physics Letters. 82 (13), 2044-2046 (2003).
- Bolkhovityanov, Y. B., Gutakovskii, A. K., Deryabin, A. S., Sokolov, L. V. Edge Misfit Dislocations in GexSi1–x/Si(001) (x~1) Heterostructures: Role of Buffer GeySi1–y (y < x) Interlayer in Their Formation. Physics of the Solid State. 53 (9), 1791-1797 (2011).
- Bourret, A. How to control the self-organization of nanoparticles by bonded thin layers. Surface Science. 432 (1), 37-53 (1999).
- Hirth, J. P., Lothe, J. Grain boundaries. Theory of Dislocations, 2nd ed. 19, Wiley. New York, NY, USA. 697-750 (1982).
- Mizuno, Y., Yako, M., Luan, N. M., Wada, K. Strain tuning of Ge bandgap by selective epigrowth for electro-absorption modulators. Proceedings of SPIE Photonics West, San Francisco, CA, USA. 9367, 1-6 (2015).
- Nam, J. H., et al. Lateral overgrowth of germanium for monolithic integration of germanium-on-insulator on silicon. Journal of Crystal Growth. 416 (15), 21-27 (2015).
- Fitch, J. T. Selectivity Mechanisms in Low Pressure Selective Epitaxial Silicon Growth. Journal of The Electrochemical Society. 141 (4), 1046-1055 (1994).
- Ye, H., Yu, J. Germanium epitaxy on silicon. Science and Technology of Advanced Materials. 15 (2), 1-9 (2014).
转载和许可
请求许可使用此 JoVE 文章的文本或图形
请求许可探索更多文章
This article has been published
Video Coming Soon
版权所属 © 2025 MyJoVE 公司版权所有,本公司不涉及任何医疗业务和医疗服务。