Method Article
Bir Tarama Elektron Mikroskobu tarafından Yarıiletken Malzemelerin Genişletilmiş Kusur Kapsamlı Karakterizasyonu
Bu Makalede
Özet
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
Özet
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
Giriş
Bu kusurlar Yarıiletken malzemelerin 1-3 elektronik yapısı üzerinde bir etki genişletilmiş yıllardır bilinmektedir. elektronik cihazlar ve sensörler ve solar-hücre malzemesi olarak diğer uygulamaların performansı üzerinde genişletilmiş kusurları etkisi geniş deneysel ve kuramsal soruşturma altında. Bununla birlikte, genişletilmiş kusurların varlığı yarıiletkenlerin elektronik devletlerin hesaplanması için genel kabul görmüş bir teori vardır. Bu ideal kristal kafesin sapma durumunda ve aynı zamanda türleri ve genişletilmiş kusurları yapılandırması hakkında geniş çeşitlilik yanı sıra aralarında ve 0-dim içsel ve olası kombinasyonlara elektronik yapı hesaplamaları karmaşıklığı nedeniyle dışsal kusurlar.
genişletilmiş kusurların ana tip çıkıklar (1 boyutlu kusurlar) ve tane sınırları (2 boyutlu kusurlar) bulunmaktadır. Aşağıda, cotaramalı elektron mikroskobu (SEM) gerçekleştirilebilir deneyler açısından uzatılmış kusurlar bu tip hem ncentrate. Burada sunulan deneysel yöntemler bu nedenle, yapısal, optik ve elektriksel genişletilmiş kusurları özellikleri ve genişletilmiş kusurları içeren yarı iletken malzemeler elektronik devletlerin dolaylı bilgi hakkında bilgi verir. kusur ilgili elektronik devletlerin kontrolü yarıiletkenlerin uygulama ve yarı iletken cihazların çalışması için merkezi bir konudur.
genişletilmiş kusurların yapısal soruşturma için elektron backscatter kırınım (EBSD) tekniği uygulanabilir. Genellikle, bir EBSD ölçüm, her noktada sabit bir elektron ışını ile noktası eşlemesi ile gerçekleştirilir. EBSD daha sonra, tek kristalli materyal halinde ve kristalli malzemeler tanelerinin numunenin kristal kafesinin kristalografik yönlenmesi hakkında bilgi verir. for Kikuchi bantları ile oluşturulan deneysel olarak belirlenen kırınım desenleri var amaç malzemenin kristal uzay grubundan belirlenen taklit desenleri ile karşılaştırılarak analiz edilecek. oryantasyon verilerin değerlendirilmesi için yazılım komşu haritalama noktaları kristalografik koordinat sistemleri arasındaki misorientation açısını hesaplamak mümkün ise, aralarında tane sınırı tipi tespit edilebilir. misorientation açısı daha küçük 15 °, düşük açılı tane sınırı (LAGB) mevcut ise; aksi takdirde bu, yüksek açılı dane sınırı (HAGB) 'dir. HAGB tipi Σ -1 tesadüf kafes yatan örgü nokta fraksiyonudur onun Σ değeri ile karakterize edilir. Çok simetrik ikiz sınırı 4 Yani, Σ = 3 duruyor. Numune yüzeyinin iki düzlemde EBSD haritalama dönüşümlerin pozisyonları doğru bir bilgi, tane sınırı uçağın tipi w ile ölçülebilir isei Miller hkl da Randle 5 tarafından önerilen bir yöntemle değerlendirilebilir endeksleri.
Son zamanlarda, elektron kırınımı modelinin değerlendirilmesi için yeni bir prosedür Wilkinson ve arkadaşları tarafından elde edildi. Komple yerel gerilme tensörü tüm bileşenlerinin hesaplanması sağlar 6 yani., Mutlak üç normal gerginlik değerleri ve üç kayma gerilme bileşenler. Bu hesaplama, aynı kristalografik yönlendirme ile gerilmemiş kristal bölgesinde alınan bir referans modeline göre karşılık gelen sapma örüntüsünde, eşlenerek, her ölçüm noktası için gerçekleştirilir. Bu değerlendirme yordam adı ccEBSD verir çapraz korelasyon tekniği kullanılarak EBSD desen karakteristik özelliklerinin küçük kaymaların belirlenmesi dayanmaktadır. Seçilen bir referans noktasına göreli olarak, gerilme bileşenleri ve kafes rotasyonlar 10 -4 ve 0.006 & # arasında precisions ile ölçülebilir176 ;, sırasıyla, 7. doğrultusunda ccEBSD ölçümleri uygulanması tane sınırları boyunca taramaları veya dislokasyon düzenlemeleri boyunca, tek bir lokal olarak tutar, yanı sıra bu uzatılmış kusurların soyu alanları aralığını belirler.
çıkıkları ve tane sınırları optik özellikleri spektral ve görüntüleme katodolüminesans (CL) teknikleri ile incelenebilir. lüminesan sinyal SEM primer elektron ışını ile yarı iletken malzemede oluşan elektron delikli çiftlerin radyatif rekombinasyon kaynaklanır. lüminesans şiddeti radyatif rekombinasyon zaman toplam azınlık taşıyıcısı yaşam süresi oranı, radyasyon rekombinasyon verimliliği ile orantılıdır. Bu oran kusurlar tarafından yerel olarak etkilenir olduğunda, parlaklık dağılımında bir kontrast CL görüntüleri görülmektedir. Normal olarak, uzatılmış kusurlar radyatif olmayan rekombinasyon merkezleri ve bu nedenle, L olarak hareketbant bant rekombinasyondan uminescence rahatsız yarı iletken göre uzatılmış kusurlar yakın azaltılır. Ancak, çıkıkları da yanı sıra tahıl sınırları Si, Ge ve bazı bileşik yarı iletken malzemeler, söz konusu karakteristik lüminesans bantları (doğrudan ya da olmayan, doğrudan) bant-to-band rekombinasyon daha düşük foton enerjileri gösteren gözlenen edilir dökme malzeme 8-10. Bir örnek olarak, bağlı silikon gofret ve Sekiguchi ve işçiler 11-13 tarafından çok kristal silikon geniş CL soruşturma çıkık ve LAGBs bant aralığı sığ ve derin seviyelerde oluşması sorumlu olduğunu ortaya koymuştur. İlgili radiatif geçişler CL spektrumları D hatları olarak belirtilir. Bununla birlikte, oksijen yağış ve geçiş metali yabancı tarafından çıkıkları düzenlemeleri ve çıkık kirlenme eşlik suşu alanının rolü halen interpretat için tartışmalıdırD hattı ışıma iyon. bir tat genişletilmiş kusur lüminesan hattı enerji konumunun bir atama başarıyla yapılabilir Ama, daha sonra ışık yayılması spektrumunda bu özel hat varlığı, bu kusurun varlığı için bir sinyal olarak alınabilir. Parlaklık yoğunluğu arttırmak için örneğin., Radyatif olmayan bir göre ışıma rekombinasyon, CL araştırmalar dolaylı bant yapıları ile yarı iletken malzeme, düşük sıcaklıklarda (kriyo-Cl) gerçekleştirilebilir gerekir.
Burada sözü edilen uzatılabilir kusurlar elektriksel özellikleri SEM elektron ışını indüksiyon akımı (EBIC) görüntülemesi ile karakterize edilir. primer elektron huzmesi ile oluşturulur, elektron-delik çifti yerleşik bir elektrik alanı ile ayrılır, bu akımı gözlenebilir. Bu alan, genişletilmiş kusurlar kendi elektrik potansiyeli ya da örnek yüzeyi üzerine Schottky kişiler tarafından oluşturulmuş olabilir. EBIC görüntünedeniyle elektriksel olarak aktif kusurları bir değişken rekombinasyon davranışına şarj toplama verimliliği yerel varyasyonları sonuçları kontrast. Onlar hatasız bölgelere oranla bir EBIC görüntüde koyu görünmesini sağlayacak şekilde genişletilmiş kusurlar genellikle artan taşıyıcı rekombinasyonu göstermektedir. Kusurların 14 fiziksel tabanlı modeller çerçevesinde, kontrast profil denir EBIC sinyalinin, mekansal bağımlılık kantitatif değerlendirme azınlık taşıyıcı difüzyon uzunluğu ve ömür boyu belirlenmesi yanı sıra yüzey rekombinasyon hızını sağlar. Bu parametreler, sıcaklığa bağlı olduğu için, EBIC araştırmalar da gürültü oranı gelişmiş bir sinyal elde etmek için, düşük sıcaklıkta (kriyo-EBIC) yapılmalıdır. Seçenek olarak ise, sıcaklığa bağlı EBIC ölçümleri Kittler ve birlikte çalışanlar 15,16 tarafından önerilen bir modele göre dislokasyon derin seviyede yabancı madde konsantrasyonunun belirlenmesini sağlar.
yarı iletkenler genişletilmiş kusurları optik ve elektriksel özellikleri kirlenme ile ve taramalı elektron mikroskobu ile çözülemeyecek 0-dim içsel kusurları 17 önemli ölçüde etkilemiş olabilir dikkat edilmelidir. Ancak, deneysel yöntemler, ccEBSD, CL ve Ebiç kombinasyonu, genişletilmiş kusurları görselleştirmek için ve SEM onların temel özelliklerini ölçmek için şansı sunuyor. Gelecekteki uygulamalar, sadece arıza analizi değil, aynı zamanda kontrolü ve kusur mühendisliği amaçlanan kusur için, bu güçlü bir araç yarı iletken cihazların performansının geliştirilmesi önemli bir rol oynayacaktır.
Protokol
Cryo-CL Deneyi 1. Numune Hazırlama
- (Burada silikon) yarı iletken bir malzemeden bir kütle örnek kullanarak, bir düzlemsel yüzey ile, 0.2 ve 0.5 mm arasında aralığında 5 x 5 mm kalınlığa sahip bir maksimum yüzey alanı.
- örnek ve etanol veya aseton gibi bir organik çözücü ile birlikte numune tutucu temizleyin. 1 dakika için 1:10 oranında hidroflorik asit (% 40) ve deiyonize su çözeltisi içinde dalarak örnek silikon oksit tabakasında yüzey tabakasının çıkarılması. de-iyonize su ile örnek yıkayın.
- Değirmen indiyum tel parçası mekanik numunesininkine ve yaklaşık 0.5 mm'lik bir kalınlığa sahip tekabül eden bir yüzey alanı olan bir indiyum folyo oluşturmak için.
- , Metalik soket üzerinde 60 ° -Ön eğik numune tutucu montaj numune tutucu ve üstüne numune üzerinde indiyum folyo koyun.
- bir ısıtma plakası üzerine soketi yerleştirin.
- Bir termometre ile, ısıtma plakası sokete kontrol sıcaklığını Anahtarıindiyum folyo eritme işlemi yakın olacak şekilde R ve 150 ° C soket ısıtın.
Not: indiyum 157 ° C 'de erime noktasına ulaşır, ancak folyo sünek olmalıdır gerekli değildir. - 1 saniye bir kürdan ile numune üzerinde basarak indiyum folyo üzerine örnek sabitleyin.
- Isıtma plakası kapatın ve 30 dakika boyunca tüm sistemi soğutmak.
Cryo-EBIC Deneyi 2. Numune Hazırlama
- (Burada silikon) yarı iletken bir malzemeden bir kütle örnek kullanarak, bir düzlemsel yüzey ile, 0.2 ve 0.5 mm arasında 5 x 5 mm kalınlığa sahip bir maksimum yüzey alanı.
- örnek ve etanol veya aseton gibi bir organik çözücü ile birlikte numune tutucu temizleyin. 1 dakika için 1:10 oranında hidroflorik asit (% 40) ve deiyonize su çözeltisi içinde dalarak örnek silikon oksit tabakasında yüzey tabakasının çıkarılması. de-iyonize su ile örnek yıkayın.
- sa monte edinmple bir metalizasyon sistemi içine ve metal buharlaştırılması (örn., p-tipi Si, N-tipi Si Au Al) numunenin üst yüzeyi üzerine bir Schottky-temas oluşturmak üzere.
- silikon örneğinin arka tarafındaki akışkan galyum-indiyum ötektik bir damlacık yatırın ve bir omik temas üretmek için üzerinde smear.
ccEBSD Deneyleri 3. Numune Hazırlama
- Öğütme ve (ajanları taşlama ve parlatma tane boyutu küçüldükçe adımları parlatma bir dizi uygulayarak düz bir örnek yüzeyi hazırlayın, örneğin., Ilk elmas pasta 3 um bir kağıda, sonra elmas macun 1 mikron, son parlatma bir titreşimli parlatıcı üzerinde ) parlatma süspansiyonu ile. her bir adım arasında de-iyonize su ile örnek yıkayın.
- 3 dakika boyunca ultrasonik bir banyoda etanol içinde örnek temizleyerek yüzey hazırlığı tamamlayın.
- Mekanik sabitleme ile metalik numune tutucu veya iki taraflı yapışkan c üzerinde yapıştırılarak örnek sabitleyinarbon sekmesi.
4. Sahne Cryo-CL Deneyi
- Sıvı azot (LN) ve 8 saat bir deney süresince sıvı helyum (LHE) olarak kriyojenlerin kullanılabilirliğini sağlamak.
- SEM cryo-sahne kullanın.
- SEM içine pozisyon ölçüm park konumundan ışık toplama eliptik ayna yerleştirin.
- Sahnede bir direkt bant boşluk geçiş ile: (toplu GaAs örnek burada) bir test örneği monte edin.
- Sütun odası vana açılana kadar SEM odasına boşaltın. 20 kV, 240 um açıklık boyutu, yüksek akım mod AÇIK, 1 elektron demetinin tarama hızı, 200 büyütme ve piksel ortalama gürültü azaltma SEM görüntüleme parametreleri hızlanma yüksek gerilim (YG) ayarlayın.
- İkincil elektronlar ile görüntüleme için Everhart Thornley dedektörü kullanın. elektron ışını 15 mm (WD) çalışma mesafesinde numune yüzeyine odaklanmış kadar kutup parçasının doğru sahne taşıyın.
- monokromatör için güç kaynağı açarak CL algılama sistemi start-up yordamı çalıştırmak, photomultiplier tüp için yüksek gerilim güç kaynağı (PMT), PMT soğutma sistemi ve CL kontrol programı ile dizüstü bilgisayar. CL kontrol programını başlatın ve zamana karşı PMT sinyalinin ölçümü seçin.
- PMT kontrast (maksimum) ve parlaklık (% 46) için uygun değerleri ayarlayın.
- deneyler kaydetmek için bir günlük dosyası oluşturun.
- eğerek ve ayna döndürerek test numunesi üzerinde ayrılmaz CL yoğunluğunu en üst düzeye çıkarmak için ışık toplama ayna ayarlayın. CL kontrol programı kullanarak bir CL testi spektrumu kaydedin.
- SEM odasına Vent test örneği kaldırmak, numune tutucu üzerinde indiyum folyo üzerindeki gerçek örnek monte ve SEM odasına boşaltın.
- Esnek vakum tüpleri ile bir diyafram pompa girişi ile SEM kriyojenik gazlar için bir çıkış bağlayın. bir sızdırmazlık elemanı olarak bir o-ring ile merkezleme halkaları kullanın ve düzeltmeksıkma halkaları ile o. hortum bağlantı bir sönümleme ağırlık entegrasyonu mekanik sistemin stabilize.
- Varsa bir o sirkülasyon sistemi esnek bir vakum tüp diyafram pompa çıkışını bağlayın. bir sızdırmazlık elemanı olarak bir o-ring ile merkezleme halkaları kullanın ve sıkma halkaları ile sabitleyin.
- SEM sahnede uygun fiş konnektörü ile sıcaklık kontrol ünitesinin sıcaklık sensörü bağlayın. sıcaklık kontrol ünitesinin güç kaynağına açınız.
- SEM kriyojenik gazlar için çıkışa sonraki esnek vakum tüpü ısıtma bandı birleştirin.
- koruyucu gözlük ve koruyucu eldiven giyin. LHE Dewar içine sıvı He için boru yerleştirin. SEM cryo aşamasında kriyojenik gazlar için girişi O aktarma borusunun çıkışını bağlayın.
- 240 mikron, yüksek akım mod ON, elektronun tarama hızı 20 kV, diyafram boyutu elektron ışın parametreleri YG Set1 kiriş, 200 büyütme ve piksel ortalama gürültü azaltma.
- İkincil elektronlar ile görüntüleme için Everhart Thornley dedektörü kullanın. kutup parçası doğru sahne taşıyın ve CL deneyler için WD = 15 mm numune yüzeyine elektron ışını odaklanır.
- Numune yüzeyinde ilgi alanı seçmek ve tüm soğutma aşağı işlemi sırasında bütün bölge üzerinde tarayın. ilgi bölgesinde numunenin yüzey aşamasının uygun bir konumlandırma WD = 15 mm olan tüm CL deneme sırasında emin olun.
- En düşük hedef sıcaklığını girerek soğuma işlemi başlatın (örn., 5 K) teknik kılavuzuna uygun sıcaklık denetleyicisi PID kontrol için uygun parametreler. LHE aktarma tüpünün vanasını açın.
- Numune sıcaklığı, diyafram pompası O basınç ve soğuma işlemi sırasında PMT gelen entegre CL sinyali çıkışını izleyin. RCL yoğunluk PMT zarar vermemek için düşük sıcaklıklarda çok yükselirse monokromotor yarık genişliğini educe.
- Hedef sıcaklığa ulaşmak için gerekirse LHE aktarma tüpünün ağzını artırın.
- hedef sıcaklığa ulaştıktan sonra odaklanmış görüntüler için WD = 15 mm yeniden kurmak. Gerçek örnek üzerinde maksimum ayrılmaz CL yoğunluğu ışık toplama aynanın ayarı giderin.
- Set uygun ızgara değerleri (mm başına 300 satır, 1000 nm'de yangını), spektral bölge (1,050 nm 1.600), basamak genişliği (5 nm) (5 sn) ölçüm noktası başına, zaman ve genişliğini (1 mm) yarık silikon numunesi üzerinde spektral CL ölçümleri. CL kontrol programı kullanarak ve laptop sabit diske kaydetmek numunenin rekor CL spektrumları.
- pankromatik CL görüntüleme ve sırasıyla monokrom CL görüntüleme için özel dalga boyunda ızgara bir yangını için monokromatör olarak düzlemsel ayna seçin. Parlaklığı ayarlayın ve kontrastPMT sinyali gri değerleri bağlı doğrusal aralığı içinde CL görüntü değerleri.
- Uygun görüntü çözünürlüğünü ayarlayın (örneğin., 1024 x 768 piksel) CL görüntüleme için, tarama hızı ve gürültü azaltma yöntemini (örn., En düşük tarama hızı 14 piksel ortalama veya daha yüksek tarama ile kombine 200 ve 1.000 aralığında bir büyütme için hız 8 hat ortalamasının üzerinde 20 hat) ile birlikte. SEM kontrol programı ile Kayıt CL görüntüleri ve bilgisayarın sabit diskine kaydedebilirsiniz.
- adını ve günlük dosyasına tüm ölçüm oturumu sırasında ölçülen her spektrum ve görüntü parametrelerini girin.
- Elektron demetinin HV kapatın ve sıcaklığa bağlı CL araştırmalar için sıcaklık kontrol içine daha yüksek bir hedef sıcaklığa girerek örnek sıcaklığını değiştirmeden önce SEM sütun odası vanasını kapatın.
Not: Bu SEM odacıklı vakum dur istikrarsızlıkların elektron tabancası bir kapatılmasını önlemek içinIsıtma-up ing. - SEM sütun odası vanasını açın ve yeni hedef sıcaklığa ulaşıldığında ve SEM odasında sistem vakum tekrar kararlı olduğunda HV açın.
- , PMT için deklanşöre kapatmak, SEM sütun odası vanasını kapatın, elektron ışını HV kapatın PMT güç kaynağı ve soğutucu kapatın ve düşük sıcaklıklarda planlanan CL ölçümleri bitirdikten sonra ısınma yordamı çalıştırın.
- SEM haznesi açmadan cryo-CL deney için monte edilmiştir ek aygıtlar ve araçları kaldırın.
- SEM bölmesine en az 12 saat süre ile kapalı bırakın. numune tutucu sıcaklığı oda sıcaklığında olduğundan emin olmak için kontrol edin. Aksi takdirde, SEM bölmesine açmadan önce oda sıcaklığına numune tutucu ısınır.
Not: Bu, SEM bölmesine nem önlemektir. - aşamasından örneği kaldırmak ve SEM odasına tahliye.
5. Sahne Cryo-EBIC Deneyi
- en8 saat bir deney süresince LHE kullanılabilirliği emin olun.
- SEM cryo-sahne kullanın.
- mika bir levha üst yüzeyinde bir buharlaştırılarak Au tabaka ile mevcut olduğundan emin olun.
- yukarı ve daha sonra ilk numune tutucuya yukarı Schottky-temas mika gerçek örnek Au tabakası ile mika parçası yığını. Gerçek numunenin Schottky-temas ve mika buharlaştırılarak Au katmandaki diğer birinde bir kontak ucunu koyun.
- Sütun odası vana açılana kadar SEM odasına boşaltın. SEM görüntüleme parametreleri HV, delik büyüklüğü, tarama hızı, büyütme ve gürültü azaltma uygun değerleri ayarlayın.
- örnek akım amplifikatörü açmak ve örnek akımının üç ondalık basamak görüntülenir, böylece ölçüm aralığı seçin.
- deneyler kaydetmek için bir günlük dosyası oluşturun.
- cryo-CL deneyler 4.16 arasındaki adımları 4.12 gerçekleştirin.
- S Uygun değerlerini ayarlayınEM EBIC görüntüleme için YG, açıklık boyutu, büyütme, tarama hızı ve gürültü azaltma yöntemi (tane sınırları EBIC görüntüleme parametreleri önerilen aralık parametreleri 10 30 1000 kadar, açıklık boyutu 20 mikron 60, HV için kV 20 olan tarama hızı ve piksel veya kare ortalama alma) için 14'e büyütme, 9 için.
- EBIC görüntüleme örnek akım detektörü kullanın. kutup parçası doğru aşama getirin ve 15 ve 25 mm arasında bir WD elektron demeti odaklanır.
- Numune yüzeyinde ilgi alanı seçmek ve tüm soğutma aşağı işlemi sırasında ilgi bütün bölge üzerinde tarayın.
- En düşük hedef sıcaklığını girerek soğuma işlemi başlatın (örn., 200 K) teknik kılavuzuna uygun sıcaklık denetleyicisi PID kontrol için uygun parametreler. LHE aktarma tüpünün vanasını açın.
- Serin sırasında diyafram pompası örnek sıcaklığı ve O basıncını izlemeking aşağı.
- SEM ekranı bölmek ve sıcaklık ile görüntülerin değişimini izlemek için örnek akım detektörü gelen EBIC sinyaline paralel olarak Everart Thornley dedektör ikincil elektronların sinyalini izler.
- SEM YG, açıklık boyutu, büyütme, tarama hızı ve gürültü azaltma parametreleri yeniden ayarlayın yüksek kontrastlı EBIC görüntü almak için. Düşük sıcaklıklarda ekran taşmasını önlemek için de örnek akım amplifikatör ölçüm aralığı yeniden ayarlayın.
- hedef sıcaklığa ulaştıktan sonra elektron ışınını yeniden odaklanır.
- EBIC görüntüleri kaydetmek. günlük dosyası içine adını ve her görüntünün parametreleri girin.
- Elektron demetinin HV kapatın ve sıcaklığa bağlı EBIC araştırmalar için sıcaklık kontrol içine hedef sıcaklığının daha yüksek bir değer girerek örnek sıcaklığını değiştirmeden önce SEM sütun odası vanasını kapatın. SEM sütun odası vanasını açın ve HV açtığınızda yeni hedef temperature ulaşılır ve sistem vakum tekrar stabildir.
- Elektron demetinin YG kapatın SEM sütun odası vanasını kapatın ve düşük sıcaklıklarda planlanan EBIC ölçümleri bitirdikten sonra ısınma yordamı çalıştırın.
- SEM haznesi açmadan cryo-EBIC deney için monte edilmiştir ek aygıtlar ve araçları kaldırın.
- SEM bölmesine en az 12 saat süre ile kapalı bırakın. numune tutucu sıcaklığı oda sıcaklığında sigorta için kontrol edin. Aksi takdirde, SEM bölmesine açmadan önce oda sıcaklığına numune tutucu ısınır.
- aşamasından örneği kaldırmak ve SEM odasına tahliye.
6. Sahne ccEBSD Deneyleri
- Küçük bir mengene içinde ya da bir numune tutucu pim üzerine örnek monte elektron ışın yönüne 65 ° ve 70 ° akrabası aralığındaki önceden eğik.
- Alternatif olarak, SEM 6 eksenli Zeminin üzerine numuneyi yerleştirin ve tiltNumune yüzeyi, normal ve elektron ışın yönü 65 ° ila 70 ° aralığında bir açı oluşturacak şekilde, tüm safhaları. sahne dedektörleri ve oda duvarları ile çarpışır olmaz emin olun.
- Sütun odası vana açılana kadar SEM odasına boşaltın. Uygun SEM görüntüleme parametreleri YG (20 kV), diyafram (120 mikron), yüksek akım mod AÇIK, tarama hızı değerleri (örneğin., 5), büyütme (örn., 3000) ve gürültü azaltma (piksel ortalama) olarak ayarlayın.
- 12 ve 22 mm arasında WD numune yüzeyi üzerinde elektron ışını Odak.
- elektron ışını ivme gerilimi kapatın ve kolon odası vanasını kapatın.
- EBSD dedektörü için güç kaynağı açın. SEM odasında konumunu ölçmek için park pozisyonundan EBSD dedektörü taşıyın.
- Sütun odası vanasını açın ve elektron ışın ivme gerilimine açın. Bir bölgeye elektron demeti yeniden odakNumune yüzeyinde ilgi.
- EBSD kontrol yazılımı açın ve seçilen WD kalibrasyon dosyası yüklenemedi.
- kullanma kılavuzuna göre EBSD denetim yazılımı ölçümü ayarlayın.
- EBSD kullanma kılavuzuna göre arka plan toplayabileceklerdir.
- EBSD desen merkezinin konumu ve EBSD kontrol yazılımı seçilen WD dedektör mesafesini okuyunuz.
- gerçek ölçümlere ilgi bölgesine bitişik numunenin bir bölgede elektron demeti Odak. stabilizasyon için yaklaşık 1 saat boyunca orada taramak için ışın bırakın.
- Bütün EBSD ölçüm sırasında fazla 1 mikron geçmemelidir ışın sürüklenme miktarını kontrol edin.
- faiz ve yeniden odak bölgeye elektron ışını gidin.
- Program hattı ilgi bölgenin eğim eksenine paralel tarar. ışın haritalama kullanmak ayarı (haritalama aşama değil). s sayısı için uygun değerleri seçinTeps (örn., 100), adım boyutu (örn., 50 nm), pozlama süresi (örneğin., 43 msn), çerçeve ortalama (örn., 10) ve dedektör binning (örn., 2 x 2).
- "Tüm görüntüleri kaydetmek" seçtiğinizden emin olun. ölçüm hızlandırmak için endeksleme devre dışı bırakın.
- son tarama bitene kadar çizgi taramaları çalıştırın.
- elektron ışını ivme gerilimi kapatın ve kolon odası vanasını kapatın.
- park konumuna ve EBSD kontrol ünitesini kapatmak için ölçüm konumundan EBSD dedektörü geri çekin.
- , Odasına Vent örneği kaldırmak ve tahliye.
CL-veri 7. analizi:
- Bilinen spektral çizgilerinin spektral pozisyonlarını karşılaştırarak ızgara kalibrasyon kontrol (örneğin, literatür ile toplu ve yapmacıksız GaAs test örneği lüminesans hatlarının zirveleri) ve gerekirse dalga boyu kalibrasyonu değiştirin.
- (Int kaydedildi CL spektrumları düzeltin Her ölçüm noktasında gelen duyarlılık değeri ile ölçülen yoğunluğu bölünmesi ile yangını ızgara ve PMT oluşan optik sistemin dalga boyuna bağımlı duyarlılık ile dalga boyuna karşı ensity).
- CL görüntünün her pikselin gri değerini ayıklayın ve en azından numunede elektron etkileşim hacminin ölçekte, görüntüdeki ilgi her bölge için gri değerlerinin ortalamasını alın.
- PMT verilen kontrast ve parlaklık değerleri için CL yoğunluğuna bağlı olarak, CL görüntüleri ortalama gri değerlerinin bir kalibrasyon eğrisi ilgi bölge için CL yoğunluğunu belirlemek.
- Ortalama CL şiddetini bütün CL görüntüsünün ben CL ve CL dedektör karanlık sinyal Ben 0 değerlendirin.
- Aşağıdaki denklem ile CL görüntüdeki parlak ve karanlık görünen bölgeler arasındaki kontrastı C CL hesaplayın:
d / 53872 / 53872eq1.jpg "/>
EBIC-veri 8. Analiz:
- Bir EBIC görüntünün her pikselin gri değerini Özü ve bir EBIC kontrast açısından EBIC yoğunluğunun uzaysal varyasyonları ölçmek için ilgi her bölge için gri değerlerinin ortalamasını alın.
- Nedeniyle C. Donolato ve RO Bell 18 mekansal çözüme gri değerlerinden EBIC kontrast profilini belirlemek.
- EBIC kontrast profillerinin alanı ve varyansını hesaplayınız.
- Donolato 14 tarafından verilen kurallara göre böyle EBIC kontrast profilinin difüzyon uzunluğu ve hesaplanan alan azınlık yük taşıyıcılarının yüzey rekombinasyon hızı ve varyans gibi fiziksel parametreleri belirlemek.
ccEBSD Deney 9. Analizi
- Kaydedilen EBSD kalıplarının değerlendirilmesi için Paul Chekhonin tarafından programlanan in-house yazılı yazılım "ccEBSD" kullanın.
- Bir appropriat seçinsoylarının yok bir örnek bölgesinde yer alan gereken bir ölçüm noktasından referans desen olarak hareket edecek, e EBSD deseni.
- desen ilgi en az 15 yaygın olarak dağıtılan bölgeleri uygulayın.
- daha fazla değerlendirme için EBSD kontrol yazılımı ile belirlenmiştir desen merkezi ve dedektör mesafesi koordinatlarını kullanın.
- Değerlendirme için ilgili parametreler, geri kalanını girin yani., Analiz malzemenin elastik sabitleri, tilt açılarındaki tarama doğrultusunda adımlar ve adım büyüklüğü, dedektör boyutu ve piksel, dedektör kendi çözünürlük ve numune sayısı yanı sıra dedektör binning.
- 2-boyutlu Fourier dönüşümü (6 piksel iç filtre ve 40 piksel dış filtrenin) hesaplanması sırasında bir band geçiren filtre kullanın.
- değerlendirme programını çalıştırın.
- Değerlendirme metin dosyasından sayısal sonuçlarını Oku "protocol.txt" geleneksel elektronik tablo programı w kullanaraktavuk hesaplama bitti.
Sonuçlar
bir yarı-iletken malzeme içinde uzatılmış kusurları, yapısal, elektriksel ve optik özellikler, taramalı elektron mikroskobu ile farklı deneysel yöntemler ile araştırılmıştır. Genellikle, aynı örnek üzerinde bu özellikleri araştırmak mümkündür ve hatta bir tane sınır veya çıkıkları yerelleştirilmiş bir düzenleme gibi farklı bir tek kusur üzerinde, örnek hazırlama ile ilgili bazı çabaları ile. Bununla birlikte, bunun nedeni, fiziksel kusur özelliklerinin kontrolü için kullanılan yarı iletken malzeme ile primer elektron ışını özel etkileşim ürünleri, CL EBIC ya ccEBSD incelemeler ile elde edilebilir uzaysal çözünürlük her biri diğerinden farklı olduğu not edilmelidir. Şekil 1'de, şematik çizimler CL düşük sıcaklıklarda ölçümlerinin (Şekil 1A), EBIC araştırmalar için montaj için uygun SEM uygun bir set-up (Şekil 1B için verilmiştir güçlü) ve (cc) EBSD testleri (Şekil 1C) için gerekli olan ana donanım elemanlarının düzeni.
Burada verilen tüm temsilcisi sonuçları dolaylı elektronik bant yapısı ile bir yarı iletken malzeme için bir vitrin olarak silikon için elde edilmiştir. Bu bant yapısı nedeniyle direkt bant boşluğu yapıları ile yarı iletkenler ile karşılaştırıldığında ışınım geçişler düşük olasılığa tüm lüminesans ölçümleri engellemektedir. istatistiksel güvence sonuçlar için yeterli ışıldama yoğunluğunu gerçekleştirmek için zordur. Aşağıda, deneysel prosedürler plastik deformasyonu yolu ile hem de silikon, tek kristallerde sıvı faz yeniden kristalleştirme ile indüklenen dislokasyon araştırılması için tarif edilmiştir. Buna ek olarak, ikiz tane sınırları ile bir silikon iki kristal ve düşük açılı tane sınırı üzerinde araştırmalar sunulmuştur.
Şekil 2A, sıcaklık ısıl çiftiyle ölçüldü edildiği kriyo-numune tutucu için iyi bir ısı teması garanti etmek için indiyum folyo üzerindeki bir numunenin, uygun konumlandırma bir örneğini göstermektedir. Bu silikon, yaklaşık 200 um ila 500 arasında bir numune kalınlığının bakire halde Si tek bir kristali için ölçülmüştür Şekil 2B'de verilmektedir 5 K CL spektrumları kadar sıcaklıklarda kriyo-CL araştırmalar için uygun olduğunu deneysel olarak kanıtlanmıştır , plastik deformasyon sonrası ve ek tavlama sonra. SEM elektron ışını 20 kV elektron ışını ivme gerilimi ve büyük hacimde bağlı elektron delikli çifti üretimi için yüksek CL yoğunluğu ile sonuçlanan odaklanmamış tarama modunda yaklaşık 45 nA bir prob akımı (çalıştırılmıştır orta uyarma yoğunluğu (450 x 250 x 3) um 3) hakkında. Bu tarama modu, örnek yüzeyi WD = 15 mm aslında ama elektronik WD = 0 ayarlanır. CL görüntüleme, tabii ki, elektron ışını, birkaç nm Örnek yüzeyi üzerinde ancak odaklanmamış tarama modu birincil elektronlar için bir mikron aynı penetrasyon derinliği ile elektron ışınının bir noktada çapı getirir ve burada odaklı gerekmektedir. 1024 x 768 piksel çözünürlüğe sahip mağaza görüntü başına satın alma zamanı elektron ışını tarama hızı 14 de piksel ortalama modunda yaklaşık 10 dakika oldu. Buna gore deneysel olarak odaklanmamış tarama modu için, araştırma altındaki numune bölgenin sıcaklığı nedeniyle elektron ışını ısı enerji transferi bazı 0.1 K daha fazla artış olduğunu teyit edilmiştir. Odaklı modunda, yerel numune ısıtma kuvvetle sırayla örnek doping ve sıcaklık kendisi 20 bağlıdır ısı iletkenliği bağlıdır. Si örnek yetiştirilen şamandıra bölgesi için p-katkılı odaklı tarama modunda, yerel bir sıcaklık artışı DT olarak, 10 ila 15 cm -3 bir konsantrasyonda Boron ileyaklaşık 2 K 5 K Kriyostaz sıcaklığında meydana gelen ve DT ve ≈ 0.3 K 25 K at
dislokasyon optik özelliklerini incelemek için, bir kütle Si örnek 420 ° C de 295 MPa ikinci bir deformasyon adımı ve ardından 800 ° C'de 16 Mpa'lık bir basınç altında plastik deformasyona tabi tutulmuştur. Deforme numunenin bir kısmı yüzeyinde Şekil 2C'de gösterilen kayma çizgileri, iki farklı 111 odaklı kayma düzlemleri ilgili dislokasyon süzülme işlemleri ile kaynaklanır. kayma çizgileri geri saçılmış elektron (BSE) tarafından görüntülenmiştir olabilir. kayma çizgileri çıkıkları çoğu üzerine yaslandığı kafesler uçaklarının izlerini göstermektedir. Monokromatik CL (mono-CL) görüntüleri (Şekil 2B ve 2E) D4 ve D3 ışıma bantları enerjik pozisyonlarda elde edildi ve kayma hatları nedeniyle yüzey topografya profili önemli ölçüde zarar yok. Bu CL soruşturma a tarafından doğrulandıfter CL yoğunluğu şerit desenler kayma düzlemi izleri paralel başlangıçta dalgalı numune yüzeyinde aynı hemen hemen değişmeden lüminesans şerit model gösterdi dikkatli bir yüzey parlatma. o görüntüden nicel CL parlaklık şiddetinin yerel dağılımı analiz planlanan, daha sonra CL görüntü CL sinyali ve gri değeri arasındaki ilişkinin doğrusal aralığında kaydedilen gerekmektedir. Bu ilişki görüntü gri değeri ve dedektör için verilen kontrast ve parlaklık değerleri fotomultiplier mutlak sinyal arasındaki korelasyonu ölçerek deneysel olarak tespit edilebilir. en iyi sonuçları elde etmek için daha sonra, numune yüzeyinden CL yoğunluğu küçük varyasyonlarını görselleştirmek için amaçlanmıştır Aksine, doğrusal olmayan bir sinyal-gri değer ilişkisi SEM Görüntüleme işlemi sırasında daha önce uygulanmalıdır. Düşük sıcaklıklarda bir kütle Si örnek CL görüntünün uzaysal çözünürlüğü etkileşim boyutuna göre belirlenirnumunedeki birincil elektronların hacmi, bu etkileşim hacminin büyüklüğü elektron-delik çiftleri 21 radyatif rekombinasyon hacmine göre sadece marjinal küçük olduğu için. Odaklanmış ve sabit ışın için etkileşim hacim çapı, yaklaşık 3 um verilen deneysel koşullar 22 altındadır.
ccEBSD tarafından genişletilmiş kusurları çevreleyen gerilme alanının tahmini bile son derece gergin örnek bölgelerde yeterli kalitede Kikuchi desen kayıt gerektirir. Bir örneği Şekil 3A verilmiştir. Bu desenleri elde etmek için, numune yüzeyi istenmeyen yüzey tabakalarının serbest olmalıdır (oksitler, karbon kirliliği, vb.). İyi sonuçlar, aşağıdaki deney parametreleri ile elde edilebilir: elektron ışını 20 keV 12 nA WD = 15 mm gelen ışına 60 ° ila 70 °, 2 x 2 EBSD dete arasında normal numune yüzeyinin hızıylaölçme noktası ve Kikuchi depolama başına beş ila on kare üzerinden ortalama 672 x 512 piksel çözünürlüğe verir ctor piksel binning, EBSD dedektör kare başına 20 ile 43 milisaniye arasında yüksek, maruziyet süresi ayarlanmış sinyal amplifikasyon kazancı, indeksleme olmadan her ölçüm noktası için görüntü olarak desen. bir Kikuchi desen için toplam satın alma zamanı nedeniyle ışın vardiya için gerekli zaman çerçeveleri artı 10 birkaç milisaniye sayısı ile çarpımı pozlama süresi tahmin edilebilir, okuma ve depolama. 50 nM'lik bir değeri EBSD eşleme olan iki örnek konum arasında iyi en az bir adım boyutu kadar, deneysel ortaya çıktı. Bu elektron kırınımı kontrast elde çözünürlük ile ilgili son kuramsal düşünceler 23 ile uyum içindedir. EBSD eşleme sırasında ışın sürüklenme önlemek için, haritayı çalıştırmadan önce ilgili bölgenin hemen mahallede ışın tarama ile en az 15 dakika beklemek zorunda tavsiye edilir.Sadece EBSD hat eğim ekseni aynı hat üzerinde bir referans deseni ile gerçekçi gerilme verileri sağlamak numune paralel tarar olduğu bulunmuştur. Aksi takdirde, gerçek örnek eğim açısının çok dikkatli bir şekilde belirlenmesi gereklidir veya alternatif olarak, bir hat uzunluğu, birkaç um ile sınırlı olmalıdır tenteli eksenine dik tarama.
8-bit JPEG yazarlar (PC) biri tarafından yazılmış bir programdır "ccEBSD" Fourier dönüşümü (FT) ve çapraz korelasyon ile değerlendirilmiştir olarak Kikuchi desen saklanır. Program ref ayrıntılı olarak açıklanan ve ark 6 Wilkinson geliştirilmiş bir çözüm dayanır. Kikuchi desen 19., birkaç (15 - 19) alt desenleri (128 x 128 piksel) karakteristik parlak bant geçişleri gibi özellikler (bkz Şekil 3A ve 3B) ile tanımlanmalıdır. Tüm alt desenler FT ile analiz edilmesi gerekir. Bir bant geçiren filtre FT tüm görüntüleri uygulanacak vardır (iç yarıçap 6 pidüşük frekanslarda, dış yarıçapı daha yüksek frekanslar için 40 piksel) için xels Fourier uzayında bant geçiren filtre (bakınız Şekil 3C) dışında sıfıra tüm değerleri ayarlamak için. Daha sonra, çapraz-korelasyon (cc) fonksiyonu (Şekil 3D), referans Kikuchi deseninden ilgili alt örüntüsü, FT (Şekiller 3E ve 3F) ile her bir alt-desen FT arasında hesaplanacak şekilde yer alır. Cc-fonksiyonlar (Şekil 3D) 'de tepe pozisyonları, alt kalıpları nispi yer değiştirme tespit edilebilir. Bu yer değiştirmeler kullanılarak, normal ve kesme zorlanması bileşenleri hesaplanabilir. Malzeme bağımlı elastik sabitleri biliniyorsa, aynı zamanda gerilme bileşenleri tespit edilebilir. Voigt tarafından gösterimde, bu sabitleri C 11 = 165.7 GPa, C 12 = 63.9 GPa ve kübik kafes 24 ile Si C 44 = 79,9 GPa vardır. bir Kikuchi pa tüm alt desen sonuçlarının kombinasyonuttern suşu değerlendirme doğruluğunu artırır. Bir silikon tek kristal bir kusur serbest bölgeye bir ccEBSD çizgi tarama belirlenen istatistiki hata tüm suş tensör bileşenleri için 2 x 10 -4 olduğu bulunmuştur. Bununla birlikte, uzun bir arıza ortaya çıktığında için niceliksel sonuçlar elde etmek için, bir referans model olarak Kikuchi model seçimi önemlidir. Şekil 2'de gösterildiği gibi, örneğin, örnek tamamen dislokasyon ile kaplıdır, varsa, Jiang ve ark., 25 tarafından önerilen karmaşık prosedürler uygun referans model bulmak için uygulanabilir.
CcEBSD kullanımı için bir durum, bir sıvı faz, yeniden kristalleşmesini indüklemek için yüksek enerjili bir elektron ışını ile muamele edilmiş bir silisyum ([001] -Yüzey yönde) daha kolay (bakınız Şekil 4). Yeniden kristalleşme pistinde kayma hatları disl gösteren BSE görüntüde görülebilirizleri ile kayma düzlemleri üzerinde onumu hareketi görüntüsü (Şekil 4A) kenarlarına paralel. CL araştırmalar plastik bir şekilde deforme numune için aynı deney koşulları altında gerçekleştirilmiştir. (Sırasıyla Şekiller 4B, 4C ve 4D), bant için bant geçiş ve D4 ve D2, dislokasyon lüminesans bantların enerjilerde kaydedilen mono- CL ve görüntüler, yeniden neden uzatılmış kusurlar uzamsal dağılımını göstermektedir -crystallization prosedür. bant-to-band geçiş ve D hattı lüminesans bantları arasında bir lokal anti-korelasyon mono-CL görüntülerden anlaşılmaktadır olabilir. Bu elektron ışınının bir noktada modunda kafalı 1, 2 ve 3 (bakınız Şekil 4A) ölçüldü CL spektrumları (Şekil 4E) tarafından desteklenmektedir. Yeniden kristalleşme iz (Şekil 4A beyaz çizgi) önünde bir çizgi tarama olarak gerçekleştirilen ccEBSD soruşturmaları, yerel gerilme tensör componen itibarençizgi tarama boyunca ts (Şekil 4F ve 4G) tespit edilebilir. Bu istatistiksel hata içinde, değerleri bu model bant için bant geçiş hakim olduğu bir bölgede yer alıyorsa, özellikle Kikuchi desen referans modeli olarak kullanıldığı bağlı olmadığını, kanıtlanmış oldu. Normal suşları Tr (ε) toplamı 5 x 10 -4 değerini aştığında çıkık ilgili elektronik geçişler görünür. Tr (ε) yeniden kristalleştirme parçaya yakın bir yaklaşık 150 um uzunluğunda bir bölge tarama için sıfıra eşit olmadığı için, örnek yüzeye yakın bir hacimde ortalama kafes genişlemesi vardır. Değerlendirme programı "ccEBSD" de presupposed olarak elastisite doğrusal teoriye göre, 33 σ normal gerilme sıfıra eşittir. EBSD hat taramasında bir çatlak varsa, o zaman bir ccEBSD değerlendirme nedeniyle Kikuchi desen Cau ani değişimlerine bir referans deseni ile tüm aşırı tarama yapılamazçatlak geometrik etkileri ile sed.
Ne Si tane sınırlarının yapısal, optik ve elektriksel özelliklerinin araştırılması için tarif edilen deney yöntemleri ile prensip olarak elde edilebilir 10 17 cm Bor p-tipi katkılama Si iki kristal Şekil 5'te gösterilmektedir -3. Geleneksel EBSD haritası Kikuchi desen sadece indeksleme toplama yazılımı ile desen kazanılmasından sonra hemen yapılır haritanın her noktada kristal yönelimi hakkında tam bilgi verir. Buna ek olarak, aynı zamanda tane sınırlarının türü programı (Şekil 5A) yönetmek alışılmış EBSD verileri ile görüntülenebilir. Bir LAGB'nin saptanması için, önemli bir açısı, iki bitişik ölçüm noktalarında kristal kafesinin misorientation için tanımlanması yer alır. 1 ° 'lik bir minimum değer, uygun olduğu kanıtlanmıştır. İçinLAGB EBSD haritasında gösterilen misorientation açısı 4.5 ° 'dir. Aynı örnek alan (Şekil 5B) EBIC görüntü oda sıcaklığında ölçülmüştür. tutarsız Σ3 tane sınırları ve LAGB koyu çizgiler olarak burada görünür. Bu etki, yerel olarak yüksek bir taşıyıcı rekombinasyon kaynaklanır. LAGB'nin (bkz Şekil 5H), (60 ± 12) um difüzyon uzunluğu ve (4.1 ± 0.4) bir rekombinasyon hızı karşısında EBIC sinyalinin kontrast profilinden 10 4 cm sn -1 belirlenmiştir x Donolato 14 ile model çerçevesinde azınlık yük taşıyıcıları. Özellikle mide kelepçesi çevresinde tüm numune yüzeyine yayılmış ve konsantre EBIC görüntüdeki tek karanlık noktalar, diş çıkıkları pozisyonlarını göstermektedir. 4 K CL görüntüleme incelemelerde, LAGB bant için bant geçiş enerjileri (Şekil 5C), beklendiği gibi, ama surprisi mono-CL resimde karanlık görünürngly de genellikle dislokasyon atanan D4 bandın (Şekil 4D) enerjilerinde bir mono-CL görüntü. Bununla birlikte, LAGB D1 / D2 lüminesans bantları (Şekil 5E) tekabül eden 1,530 nm bir dalga boyunda bir mono-CL görüntü olumlu. Bu parlaklık davranış LAGB oluşturan çıkıkların Mahallesi'nde nokta kusurları ile tetiklendiği düşünülmektedir. Bir çizgi yerel gerilme alanını belirlemek için LAGB'nin üzerinden tarama Buna ek olarak, ccEBSD işlem gerçekleştirildi. elektron ışını ivme gerilimi her Kikuchi desen için artan bir toplam satın alma zamanı pahasına suşu belirlenmesi için uzaysal çözünürlüğü artırmak için 10 kV düşürülmüştür. Çift desenler Kikuchi desen bir analizini önlemek görünür, çünkü Şekiller 5F ve 5G gösterilen normal ve kayma gerilme bileşenleri, sırasıyla, (yaklaşık 50 nm üzeri) LAGB'nin merkez bölgesi için hesaplanan edilemez. Dahaüzerinde LAGB'nin her iki tarafında EBSD desen çapraz-korelasyon yöntemi yalnızca kırınım modeli küçük varyasyonlar için uygulanabileceği için, iki farklı referans desenleri ile ilişkili olması gerekir. Yani, iki referans desenleri nedeniyle iki alt taneleri arasında büyük misorientation açıya sol tarafında ve LAGB'nin sağ taraftaki toplanmıştır. Bununla birlikte, şekil değiştirme bileşenleri LAGB'nin her iki tarafında simetrik olarak davrandığı heyecan verici. soyu bileşenlerin konumu bağımlılığı diyagramlardır LAGB'nin suşu alanının aralığı her iki alt taneler halinde yaklaşık 350 nm uzanır göstermektedir. Aksine, bant-to-bant geçiş mono-CL görüntüde yerel değişen kontrast diyagramı ve EBIC görüntü (Şekil 5H) 'de EBIC sinyal kontrast, parlaklık gösterir sinyali üzerinde LAGB'nin etkisi ve EBIC sinyali üzerinde 10 mikron ± kadar değişir ve merkezden 1.5 mikron ± LAGB'nin sırasıyla. Bu genişletilmiş kusurların farklı özelliklerinin incelenmesi için yerel çözünürlük kuvvetle uygulanan deneysel yöntem ve parametrelerine bağlıdır baştan deyimi doğrular.

Şekil 1. CL, EBIC ve ccEBSD Ölçümleri için Set Up. (A) SEM saha emisyon tabanca, görüntüleme ve analizi için farklı delikler, cryo-numune tutucu, CL ışık toplama aynadaki numune, monokromatör ile kızılötesi ışık IR-PMT, (B) Schottky EBIC soruşturma ve (C) kristal yönelimi hakkında bilgi almak için sayısal analiz edilebilir bir Kikuchi desen oluşumu ve depolanması için set-up için örnek temas yanı sıra ccEBSD tarafından kristal kafes çarpıtmalar üzerine.d / 53872 / 53872fig1large.jpg "target =" _ blank "> bu rakamın daha büyük bir versiyonunu görmek için lütfen buraya tıklayınız.
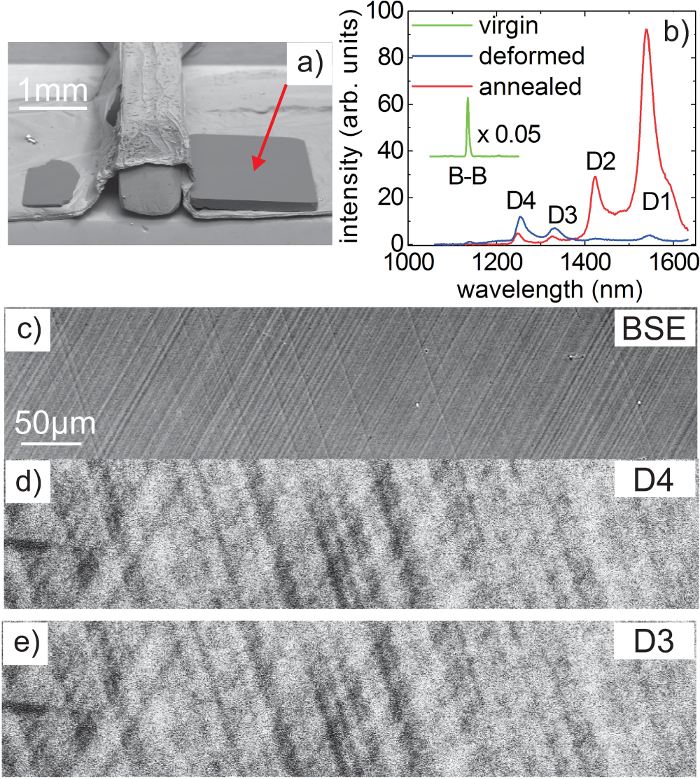
Bir yapay olarak deforme Silikon Tek Crystal Şekil 2. CL Spektral ve Görüntüleme Araştırmalar. (A) cryo-numune tutucu üzerinde konumlandırılmış indiyum folyo üzerine Silikon örnekleri. Plastik olarak deforme bir örnek için (B) yüksek düzeyde bir saflığa Si tek kristal (bakire) için ölçülen CL-spektrumu, ve ek tavlama işleminden sonra. spektrumları karakteristik geçişler bir bant-to-bant geçiş için BB ile her zamanki gibi etiketlenmiş ve D1 çıkığı kaynaklı lüminesans bantları için D4 edilir. Deforme Si kristalinin yüzeyinde (C) Kayma çizgileri geri saçılan elektron (BSE) tarafından görüntülendi (Şekil 2A kırmızı okla işaretli). Bu sonuçlar, farklı kayma Sistemli kullanımlı plastik deformasyonu göstermeyeMS. Şekil 2D ve 2E olarak, D4 hattı ve D3 hattı için mono-CL görüntüleri BSE görüntü (Şekil 2C) de gösterilen aşağıda aynı örnek bölge için ölçülen her biri, sırasıyla gösterilmektedir. Bir görmek için buraya tıklayınız Bu rakamın daha büyük bir versiyonu.

CcEBSD Analiz Kursu Adımlar görselleştirme Şekil 3. Görüntüler. (A) alt desen gerçek numune pozisyonundan Full Kikuchi desen. (B) alt desen biri ve (C) onun süzülmüş Fourier dönüşümü. (E) örnek ve (F) filtrelenmiş Fourier dönüşümü üzerine bir referans konumuna karşılık gelen alt model. (D) çapraz korelasyon fonksiyonu (CCalt desen Fourier-dönüşümleri hesaplanan F). CCF parlaklık ayrıntılarını görselleştirmek için% 20 oranında artmıştır. Bu rakamın büyük halini görmek için lütfen buraya tıklayınız.

Re-kristalleşme sonra Şekil 4. Si Gofret için CL ve ccEBSD Araştırmalar. Yüksek enerjili elektron ışını ile tedavi sonrası yeniden kristalize malzemenin bir parça ile Si gofret yüzeyinden (A) BSE görüntü. CL spektral araştırmalar için noktalar 1, 2 ve 3 pozisyonları ccEBSD taraması yapıldı yön ok çizgisi yanı sıra işaretlenir. Bant için bant geçiş (B) 'nin enerji konumlarında çekilen (A)' da gösterilen örnek bölgenin (BD) Mono-CL ve görüntüler,D4 (C) ve D2 (D) lüminesans bandı. (E) CL spektrumları ccEBSD soruşturma hesaplanan doğrultusunda tarama (A) boyunca noktalar 1, 2 ve 3. Normal (F) ve kayma gerilme bileşenlerinin (G) ölçülen. Görüntülemek için tıklayınız daha büyük bir versiyonu bu rakamın.

Şekil 5. EBSD, sarı ve siyah bir LAGB'nin ikiz tane sınırları ile Si iki kristal HAGBs ve LAGB. (A) EBSD oryantasyon harita ile bir Silikon Bi-kristal EBIC, CL ve ccEBSD Araştırmalar. Tahıl yüzey normal yönü gösterilir. (B) numune alan RT (A) tutarlı (sarı ok) ve incohere de EBIC görüntünt (mavi ok) ikiz tane sınırları belirtilmiştir. (CE) BB (C) enerjilerde mono- CL görüntü D4 (D) D1 / D2 (S) EBIC görüntü (B) kırmızı bir dikdörtgen ile işaretlenmiş LAGB bölgesinde yer almaktadır. (F), normal ve LAGB'nin genelinde ccEBSD incelemelerden hesaplanan kesme gerilme bileşenleri (G). 4K ve mide kelepçesi arasında oda sıcaklığında EBIC görüntü BB mono- CL görüntüde bulunan kontrast (H) karşılaştırması. Farklı ölçekleme unutmayın gerilme bileşeni diyagramları ve CL ve EBIC-kontrast şemada x-koordinatı. Bu rakamın büyük halini görmek için lütfen buraya tıklayınız.
Tartışmalar
SEM yarı iletken malzeme genişletilmiş hatayı tespit etmek için hem de ccEBSD, CL ve EBIC araştırmalar uygulanmasıyla da yapısal, optik ve elektriksel özelliklere karakterize imkanı sunar. Genel olarak, aynı numune üzerinde aynı anda tüm üç yöntem gerçekleştirmek mümkün değildir. Makul bir sırayla yapıldığında Ancak, farklı tamamlayıcı soruşturma yöntemleri ile elde edilen sonuçların bir arada, genişletilmiş hasar sebebiyle fiziksel etkilerinin doğası daha derin bir anlayışa yol açar.
genişletilmiş kusurların optik özellikleri hakkında bilgi veren CL ölçümleri için, protokolde kritik bir adımdır örnek konumlandırma prosedürü iyi sağlayan indiyum folyo ısıtma sırasında dolayı numunenin kusurların istenmeyen tavlama (adım 1.6) (olduğu numune tutucu ile numunenin termal ve elektriksel temas). Önerilen yönteme alternatifOda sıcaklığında iletken gümüş macun ile numune tutucu üzerine numuneyi monte etmektir. Bununla birlikte, deneyim macun içinde organik çözücünün SEM tarama sırasında numune yüzeyi üzerinde C-kirlenmesine neden olduğu bilinmektedir. kirlenme CL görüntülerinin kalitesini yanı sıra EBSD kırınım desenleri alçaltır. Ayrıca, adım 4.21 silikon parlaklık yoğunluğunun ani yükselişi örnek soğutma aşağı sırasında oluşabilecek özel dikkat gerektirir. Bu fotomultiplier performansını zarar verebilir. Ön ayna hizalama içinde RT'de bir test numunesi üzerinde gerçekleştirilmiştir çünkü Aksine, gerçek numune için beklenmedik düşük parlaklık yoğunluğunun durum için, bir ışık toplama ayna (protokol numaralı 4.23) ayarını artırmak için çalışmalısınız dalga boyunun biraz daha farklı bir dizi.
Yöntemin enstrümantal sınırlamaları ile ilgili olarak, bir hesaba alması gerektiğini çok düşük temperat denumune ile aşamasında sadece araştırılmaktadır numune alanı sınırlayan x ve y-yönlerinde ± 5 mm ile hareket ettirilebilir etmiş olur. Bu sınırlama, geçiş borusunun gevrek kırılma tehlikesi kaynaklanmaktadır. 1.1 ve 1.2 de verilen kriyo-deneyler için örnek boyutları da deneysel koşullar ile sınırlıdır. Bu nedenle örneklerin yüzey alanı ısı dağıtma tertibatı üzerine optimal bir termal teması sağlamak için numune tutucu boyutuna ayarlanmalıdır. silikon örneklerinin düşük tavsiye edilen kalınlık cryo-deneyler için numune sıcaklık gradyanı sınırlar. 200 um bir numunesi kalınlığı için, yüzey bölgesi birincil elektronlar için etkileşim hacminin merkezi ısı numune tutucusunun yüzeyinde ölçülen sıcaklık ile karşılaştırıldığında daha az 5 K artış olduğu bulunmuştur. yüksek tarama hızı ve adım 4.5 ve 4.17 serin aşağı prosedür için sadece önerilen düşük büyütme, inci sağlamakilgi e bölge temiz tutulur. Bunun nedeni SEM odasında kalan gaz yoğuşma tuzak olarak hareket örnek bölgelerin geri kalanı sıcaklığın üzerinde her zaman biraz bir sıcaklığı korur taramalı elektron ışını ile ısı transferi olduğunu. Genellikle, CL spektroskopi için adım 4.24 listelenen tüm parametrelerin ekipman listesine göre kurmak deneysel tarafından toplu silikon sözde D hattı luminescence ölçümü için optimize edilmiştir. lüminesans araştırmalar diğer yarı iletken malzemeler üzerinde yapılacak ise parametreler adapte olmak zorunda.
gözlenen lüminesans enerji bölgesi bağımsız olarak bütün bir rekombinasyon hacminde ışınımsal rekombinasyon süreçlerden geçen ışık da ayna ile toplanır ve çünkü ışık toplama aynasından CL ölçümleri sonuçları bir başka sınırlaması gelen gri değerini belirler atama olan CL görüntü pikselÖrnek yüzey üzerinde elektron ışını konumuna ed. (Uyarma hacmine karşılaştırılabilir) rekombinasyon hacmi çapı bile düşük büyütmede piksel boyutundan daha büyük olduğundan, bu etki bu nedenle, uzaysal çözünürlüğü sınırlar, lüminesans sinyalinin bir mekansal bulaşmasını neden olur ve. Bununla birlikte, CL soruşturma orta spektral çözünürlükte mono veya pankromatik lüminesans yerel dağılımının bir görüntüleme sağlayan ve bir yüksek spektral çözünürlüğe vermek için fotolüminesans soruşturma ile kombine edilebilir. Alternatif bir deneysel yöntem ölçümleri CL olarak son, çıkık ilgili fotolüminesans mikroskobik ve spektroskopik haritalama Tajima ve işçiler 26 grup tarafından önerilmiştir. fotolüminesans haritalama uzaysal çözünürlüğü CL görüntülerde açıkça daha düşüktür, ancak fotoluminesans araştırmalar ayrıca derin seviye emisyon bant Corre kutuplaşmasını veriyorçıkıklar yonunun büküm ve eğim yapıları 27,28 ile LAGBs belirlenecek.
genişletilmiş kusurların elektriksel özellikleri içgörü vermek EBIC soruşturma, söz konusu olduğunda, bir karşılaştırılabilir mekansal çözünürlüğe sahip yarıiletken malzemelerde yerel değişen yük toplama verimliliği görüntüleme için alternatif yöntemler vardır. Bununla birlikte, EBIC ölçümleri için, kritik adımlar protokolde almaktadır. Yani adım 5.13 yılında, azalan sıcaklıkla EBIC görüntüsünün değişimi genişletilmiş kusurların sıcaklığa bağlı özelliklerinden kaynaklandığı tahmin edilmektedir. Ancak, temasların kalitesi RT altındaki sıcaklıklarda değiştirebilir ve dolayısıyla EBIC görüntüsünü etkiler. Sıcaklık, çünkü siliko kartvizit ayırıcı tabaka, farklı ısıl genleşme katsayıları, n-tipi silikon halinde p-tipi halinde ve Au ile Al, uygun bir tabaka ile hazırlandı Schottky temas etkin alt tabaka. Bundan başka, bir galyum-indiyum ötektik yapılan ohmik kontak 160 K Normalde altındaki sıcaklıklarda stabil değildir, iletişim kalitesinin azaltılması neden güçlü büyük alanlar için EBIC sinyali azalmıştır. Bu durumda, iletişim yenilenmelidir. Oda sıcaklığında EBIC araştırmalar için, EBSD ölçümleri için iletişim, uygun bir taşıyıcı levha numunenin bağlanması ile yapılabilir de düşünülebilir. EBIC ölçümlerinin başka enstrümantal sınırlama örnek yüzeyi üzerinde temas ucu sahiplerinin Çıkıntılı neden olur. iletişim ucu tutucu ve WD en az 15 mm olmalıdır SEM kutup parçası arasında bir çarpışmayı önlemek için.
uzatılmış kusurlar uzun menzilli zorlama alan tahmin etmek için de kullanılabilir ccEBSD araştırmalar için deneysel prosedür, aşağıdaki adımları kritiktir. Deneyin en zorlu kısmı numune hazırlama, özellikle son parlatma işlemi (psahip rotocol No 3.1) ek yüzey kusurlarının oluşumunu önlemek için dikkatli yapılmalıdır. Resim Kikuchi desen elde edilebilir ise, numune yüzeyinden genellikle kalitesi yeterli değildir. Ancak, plastik deformasyondan sonra yüzeyi üzerinde kayma çizgileri ile, silikon, tek kristallerden, iyi bir kırınım paterni ccEBSD değerlendirme prosedürü için uygun olan elde edilebilir. Bu numunelerin yüzey pürüzlülüğü, 500 nm'ye kadar olan erim içindeki bir yükseklik farkına elde atomik kuvvet mikroskopi ile analiz edilmiştir. Bu nedenle, son derece yüksek iç suşları ya da amorf yüzey tabakaları bulanık difraksiyon yerine numune yüzeyinden kusurlu düzgünlüğü sorumlu olduğu görünmektedir. Bir başka konu arka kıyasla tutarlı dağınık elektronlardan düşük bir sinyal olabilir. Daha sonra, sabit hızlanma gerilimi ve / veya arka plan sinyalinin bir tam ölçekli bir tespite (Protokol Adım No. 6.12) en sonda akımının bir artışyararlı yeniden. Uzun süreli ccEBSD ölçüm sırasında numune hareketini en aza indirmek için mekanik örnek düzeltmek için tavsiye edilir (protokol numaralı 3.2).
olay elektron ışını örnek yüzey göreceli eğim aşamasının tilt tarafından gerçekleştirilmektedir eğer ccEBSD araştırmaları için Enstrümantal sınırlamalar ortaya çıkabilir. nedeniyle kutup parçası ve oda duvarları ile bir çarpışma riskine örnek hareket için güçlü kısıtlamalar sonra vardır. Ayrıca, şiddetle nedeniyle numunenin hata, ilk olarak, dikey taramalar iç suşlar için büyük bir meblağ hatası var çünkü, (ve dolayısıyla SEM ekranda yatay olarak görünen) eğim eksenine paralel tek hat taramaları kullanılması tavsiye edilir tilt. İkinci olarak, EBSD sırasında yanal çözünürlük ona dik daha eğim ekseni boyunca yüksek (70 ° eğim için yaklaşık 3 faktör) 'dir. ccEBSD araştırmalardan Si için hesaplanan gerilme tensör bileşenlerinin değeri için alt sınırı hakkında2 x 10 rasgele hata olduğunu -4. Ek olarak ccEBSD tekniği referans noktasına atıfta veya farklı tahıllardan EBSD desenleri üst üste tane sınırları, çok yakın büyük kafes dönmeler (> 4 °) varlığında uygulanamaz vurgulamak gerekir. streyn belirlenmesi uzaysal çözünürlüğü ile ilgili ccEBSD araştırmaların fiziksel sınırlama Örnek yatırma ekseni boyunca yaklaşık 50 nm olduğu tespit edilmiştir, elektron kırınımı aralığında kaynaklanmaktadır. İç suşların belirlenmesi için X-ışını kırınım deneyleri ile karşılaştırıldığında, bunun nedeni daha X-ışını μ kırınımı durumunda X-ışınlarının önemli ölçüde daha büyük bir etkileşim hacminin açık bir avantajdır. yarı iletken malzeme, bir polarscope izotropik kırılma indisi düzensizliklerin araştırılması dahili gerilimlerin saptanması için uygulanabilir, ancak bu yöntem uzaysal çözünürlüğü daha düşük olanbirkaç yüz 29 nm. kristaller mekansal çözülmüş üç boyutlu deformasyon durumunun belirlenmesi için alternatif bir yöntem yüksek dereceli Laue bölgeleri (HOLZ) hatlarının bölme dayanır. Bu yöntem, elektron interferometre 30 bir elektron biprism kullanarak bir transmisyon elektron mikroskobu (TEM) 'de gerçekleştirilmelidir. Bununla birlikte, SEM ccEBSD araştırmalarda aksine, TEM araştırması gevşetici etkisi nedeniyle iç suşları değişikliği örnek bir folyo hazırlık gerektirir.
Bundan sonraki çalışmalarda, ccEBSD ölçümleri de düşük sıcaklıklarda gerçekleştirilir. Bu, aynı genişletilmiş defekt, aynı zamanda aynı sıcaklıkta değil, sadece soruşturmayı yapısal, optik ve elektriksel özellikleri sağlayacaktır.
Açıklamalar
The authors have nothing to disclose.
Teşekkürler
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
Malzemeler
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
Referanslar
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
Yeniden Basımlar ve İzinler
Bu JoVE makalesinin metnini veya resimlerini yeniden kullanma izni talebi
Izin talebiThis article has been published
Video Coming Soon
JoVE Hakkında
Telif Hakkı © 2020 MyJove Corporation. Tüm hakları saklıdır