Method Article
Исчерпывающая характеристика протяженных дефектов в полупроводниковых материалах на растровом электронном микроскопе
В этой статье
Резюме
The optical, electrical, and structural properties of dislocations and of grain boundaries in semiconductor materials can be determined by experiments performed in a scanning electron microscope. Electron microscopy has been used to investigate cathodoluminescence, electron beam induced current, and diffraction of backscattered electrons.
Аннотация
Extended defects such as dislocations and grain boundaries have a strong influence on the performance of microelectronic devices and on other applications of semiconductor materials. However, it is still under debate how the defect structure determines the band structure, and therefore, the recombination behavior of electron-hole pairs responsible for the optical and electrical properties of the extended defects. The present paper is a survey of procedures for the spatially resolved investigation of structural and of physical properties of extended defects in semiconductor materials with a scanning electron microscope (SEM). Representative examples are given for crystalline silicon. The luminescence behavior of extended defects can be investigated by cathodoluminescence (CL) measurements. They are particularly valuable because spectrally and spatially resolved information can be obtained simultaneously. For silicon, with an indirect electronic band structure, CL measurements should be carried out at low temperatures down to 5 K due to the low fraction of radiative recombination processes in comparison to non-radiative transitions at room temperature. For the study of the electrical properties of extended defects, the electron beam induced current (EBIC) technique can be applied. The EBIC image reflects the local distribution of defects due to the increased charge-carrier recombination in their vicinity. The procedure for EBIC investigations is described for measurements at room temperature and at low temperatures. Internal strain fields arising from extended defects can be determined quantitatively by cross-correlation electron backscatter diffraction (ccEBSD). This method is challenging because of the necessary preparation of the sample surface and because of the quality of the diffraction patterns which are recorded during the mapping of the sample. The spatial resolution of the three experimental techniques is compared.
Введение
Уже давно известно , что в течение многих десятилетий протяженные дефекты оказывают влияние на электронную структуру полупроводниковых материалов 1-3. Влияние протяженных дефектов на характеристики электронных устройств и других приложений, таких как датчики и солнечных элементов материалов находится под обширной экспериментальной и теоретических исследований. Тем не менее, нет общепринятой теории для расчета электронных состояний полупроводников при наличии протяженных дефектов. Это связано со сложностью расчетов электронной структуры в случае отклонения от идеальной кристаллической решетки, а также к большому разнообразию в отношении типов и конфигурации протяженных дефектов, а также возможные комбинации между ними и с 0-тусклый внутренней и внешние дефекты.
Основными типами протяженных дефектов являются вывихи (1-мерные дефекты) и границы зерен (2-мерные дефекты). В дальнейшем, мы сотрудничаемncentrate на обоих этих типов протяженных дефектов с точки зрения экспериментов, которые можно выполнить с помощью сканирующего электронного микроскопа (SEM). Экспериментальные методы, представленные здесь, дают информацию о структурных, оптических и электрических свойств протяженных дефектов и, следовательно, косвенным знанием электронных состояний в полупроводниковых материалов, содержащих протяженные дефекты. Контроль дефектов, связанных с электронными состояниями является центральным вопросом для применения полупроводников и работы полупроводниковых приборов.
Для структурного исследования протяженных дефектов, электронная дифракция обратного рассеяния (ЭИ) метод может быть применен. Обычно, измерение ЭИ выполняется путем точечного отображения со стационарным электронным пучком в каждой точке. то ЭИ дает информацию о кристаллографической ориентации кристаллической решетки образца в случае монокристаллического материала и зерен в поликристаллических материалов. FoR, что цель экспериментально определенные картины дифракции, образуемые полосами Кикучи должны быть проанализированы путем сравнения с имитацией моделей, определяемых из пространственной группы кристалла материала. Если программное обеспечение для оценки данных ориентации может вычислить угол разориентации между кристаллографических системами координат соседних точек отображения, тип границы зерна между ними может быть определена. Если угол разориентации меньше, чем 15 °, граница низкий угол зерна (ЛРБЖ) присутствует; в противном случае это граница зерна под большим углом (HAGB). Тип HAGB характеризуется значением Е , где Σ -1 доля точек решетки , лежащих на решетке совпадений. Так, Σ = 3 означает высоко симметричной двойной границы 4. Если отображение ЭИ на двух плоскостях поверхности образца может быть измерена с точным знанием позиций отображений, типа межзеренной плоскости шIth индексами Миллера HKL также может быть оценена с помощью способа , предложенного Рэндл 5.
В последнее время новая процедура для оценки картины дифракции электронов была получена Wilkinson и др. 6 , которая позволяет рассчитывать все компоненты полного локального тензора деформации, то есть., Абсолютные значения трех нормальных напряжения и деформации три сдвига компоненты. Этот расчет выполняется для каждой точки измерения в отображении из соответствующей дифракционной картины относительно эталонного шаблона, принятым на недеформированном области кристалла с той же кристаллографической ориентацией. Эта процедура оценки основана на определении малых сдвигов характерных черт узора EBSD с использованием метода кросс-корреляции, которая дает название ccEBSD. По отношению к выбранной опорной точки, компоненты деформации и повороты решетки могут быть измерены с точностей 10 -4 и 0.006 & #176 ;, соответственно 7. Применение измерений ccEBSD в линии сканирования по границам зерен, или вдоль расположений дислокаций, можно определить локально количество, а также диапазон деформации полей этих протяженных дефектов.
Оптические свойства дислокаций и границ зерен можно исследовать с помощью спектрального и обработки изображений катодолюминесценции методов (CL). Сигнал люминесценции обусловлена излучательной рекомбинации электронно-дырочных пар, которые образуются в полупроводниковом материале первичным электронным пучком РЭМ. Интенсивность люминесценции пропорциональна эффективность излучательной рекомбинации, которая является отношение общего времени жизни неосновных носителей к радиационному времени рекомбинации. Когда это отношение влияет на местах дефектами, контраст в распределении люминесценции можно наблюдать в изображениях CL. Как правило, расширенные дефекты действуют как безызлучательное центры рекомбинации и, следовательно, лuminescence от межзонных-рекомбинации по сравнению с ненарушенной полупроводника уменьшается вблизи протяженных дефектов. Тем не менее, в случае Si, Ge и некоторых сложных полупроводниковых материалов, на дислокациях, а также на границах зерен, характерные полосы люминесценции наблюдаются показывая энергий фотонов более низких, чем у (прямого или непрямого) полосового к полосе рекомбинации в объемном материале 8-10. В качестве примера, обширные исследования CL склеенных пластин кремния и многожильных кристаллического кремния путем Секигучи и сотрудниками 11-13 показали , что вывихи и LAGBs ответственны за возникновение мелких и глубоких уровней в запрещенной зоне. Соответствующие излучательные переходы обозначены как D линий в спектрах КЛ. Тем не менее, роль поля деформаций, сопровождающих механизмы дислокаций и загрязнения дислокаций путем осаждения кислорода и примесей переходных металлов остается спорным для interpretatион D линии люминесценции. Но, если присвоение энергетического положения линии люминесценции к явному расширенного дефекта может быть успешно сделано, то возникновение этой конкретной линии в спектре люминесценции можно воспринимать как сигнал на наличие этого дефекта. Для увеличения интенсивности люминесценции, то есть., Радиационная рекомбинация по отношению к безызлучательной один, CL исследования должны быть выполнены при низких температурах (крио-CL) для полупроводниковых материалов с косвенными зонных структур.
Электрические свойства протяженных дефектов, рассмотренных здесь характеризуются визуализации электронного пучка индукционный ток (ЕБИК) в РЭМ. Этот ток можно наблюдать, когда электронно-дырочные пары, генерируемые первичным электронным пучком разделены встроенным электрическим полем. Это поле может быть сгенерирован с помощью электрического потенциала самих протяженных дефектов или с помощью контактов Шоттки на поверхности образца. ЕБИК изображениеконтрастные результаты от локальных вариаций эффективности заряда сбора в связи с той или иной поведения при рекомбинации электрически активных дефектов. Протяженные дефекты обычно показывают повышенную рекомбинацией носителей, так что они выглядят более темными в ЕБИК изображения, чем дефект свободных областей. В рамках физически обоснованных моделей дефектов 14, количественная оценка пространственной зависимости сигнала ЕБИК, который называется контраст профиль, позволяет определять неосновных носителей длины диффузии и долгий срок службы, а также скорость поверхностной рекомбинации. Так как эти параметры зависят от температуры, ЕБИК исследования также следует проводить при низкой температуре (крио-ЕБИК), чтобы получить усиленный сигнал-шум. В качестве альтернативы, зависящие от измерения температуры ЕБИК позволяют определить концентрации примесей глубоких уровней при вывихах в соответствии с моделью, предложенной КИТТЛЕР и сотрудниками 15,16.
Следует отметить , что оптические и электрические свойства протяженных дефектов в полупроводниках может быть существенное влияние загрязнения и 0-тусклых собственных дефектов 17 , которые не могут быть решены с помощью сканирующей электронной микроскопии. Тем не менее, сочетание экспериментальных методов, ccEBSD, CL и EBIC, предлагает возможность визуализировать протяженных дефектов и количественной оценки их основных свойств в РЭМ. Для будущих применений, где не только анализ отказов, но и дефект управления и инженерии дефектов предназначены, этот мощный инструмент будет играть важную роль в улучшении эксплуатационных характеристик полупроводниковых приборов.
протокол
1. Подготовка образцов для крио-CL эксперимента
- Используйте Пробу из полупроводникового материала (здесь: кремний) с плоской поверхностью, максимальная площадь поверхности 5 х 5 мм и толщиной в пределах между 0,2 и 0,5 мм.
- Очистите образец и держатель образца с органическими растворителями, такими как этанол или ацетон. Удалите поверхностный слой оксида кремния на образце купанием в растворе фтористоводородной кислоты (40%) и деионизованной водой в соотношении 1:10 в течение 1 мин. Промыть образец с деионизованной водой.
- Мельница кусок проволоки индий механически с образованием фольги индий с удельной площадью поверхности, соответствующей спектру образца, и с толщиной около 0,5 мм.
- Установите -Pre-наклонен держатель образца 60 ° на металлическую розетку, поместите фольгу индия на держателе образца и образца на вершине.
- Поместите гнездо на нагревательной пластине.
- Включите нагревательную плиту, контрольную температуру гнезда с Thermometeи нагревают гнездо до 150 ° C, так что процесс плавления фольги индий неизбежна.
Примечание: Не обязательно, что индий достигает точки плавления при 157 ° C, но пленка должна быть пластичным. - Закрепите образец на фольгу индий, нажав на образце с деревянной зубочисткой в течение 1 сек.
- Выключите нагревательную плиту и охладить всю систему в течение примерно 30 мин.
2. Подготовка образцов для крио-ЕБИК эксперимента
- Используйте Пробу из полупроводникового материала (здесь: кремний) с плоской поверхностью, максимальная площадь поверхности 5 х 5 мм и толщину в пределах от 0,2 до 0,5 мм.
- Очистите образец и держатель образца с органическими растворителями, такими как этанол или ацетон. Удалите поверхностный слой оксида кремния на образце купанием в растворе фтористоводородной кислоты (40%) и деионизованной водой в соотношении 1:10 в течение 1 мин. Промыть образец с деионизованной водой.
- Установите саmple в систему металлизации и испаряются металла (например., Al на р-типа Si, Au на N-типа Si) на верхнюю поверхность образца с образованием Шоттки контакта.
- Депозит капельку жидкости эвтектического галлий-индий на обратной стороне образца кремния и намазать его на производить омического контакта.
3. Подготовка образцов для ccEBSD экспериментов
- Подготовьте плоскую поверхность образца , с применением последовательности шлифовки и полировки шаги с уменьшением размера частиц шлифовального и полирующих веществ (например., Сначала алмазной пастой 3 мкм на листе бумаги, а затем алмазной пастой 1 мкм, последняя доводки на вибрационном полировальной с полировкой подвеской). Промыть образец деионизированной водой между каждым шагом.
- Завершить подготовку поверхности путем очистки образца в этаноле в ультразвуковой ванне в течение 3 мин.
- Закрепить образец металлического держателя образца путем механической фиксации или путем склеивания на двусторонней клейкой САрбона вкладка.
4. Выполнение Крио-CL Эксперимент
- Обеспечить наличие криогенных как жидкий азот (LN) и жидкого гелия (LHE) для длительности эксперимента 8 ч.
- Использование крио-сцены в РЭМ.
- Вставьте светособирающую эллиптическую зеркало от места стоянки для измерения положения в SEM.
- Установите тестовый образец (здесь: масса образца GaAs) с прямым переходом ширины запрещенной зоны на сцене.
- Вакуумирование камеры SEM, пока не откроется колонка камеры клапана. Установите SEM параметры обработки изображений ускорения высокого напряжения (ВН) до 20 кВ, размер апертуры до 240 мкм, высоким током в режиме ON, скорость сканирования электронного пучка на 1, увеличение до 200, и снижения уровня шума в среднем пикселей.
- С помощью детектора Эверхарт Thornley для получения изображения с вторичными электронами. Переместить сцену к полюсном наконечнике, пока электронный луч не может быть сфокусирован на поверхности образца на рабочей дистанции (WD) 15 мм,
- Выполните процедуру запуска системы обнаружения CL путем включения питания для монохроматора, высоковольтный источник питания для фотоумножителя (ФЭУ), система охлаждения ФЭУ и ноутбук с программой управления CL. Запустить программу управления CL и выбрать измерение ФЭУ сигнала в зависимости от времени.
- Установите соответствующие значения для контраста (максимум) и яркости (46%) ФЭУ.
- Создайте файл журнала для записи экспериментов.
- Отрегулируйте светособирающую зеркало, чтобы максимизировать интегральной интенсивности CL на испытательном образце, наклоняя и поворачивая зеркало. Запишите тестовый спектр CL с помощью программы управления CL.
- Удаление воздуха из камеры SEM, удалите тестовый образец, смонтировать фактический образец на индий фольги на держателе образца и вакуумировать камеру SEM.
- Ссылка выходное отверстие для криогенных газов РЭМ с входом диафрагменного насоса осуществляется при помощи гибких вакуумных трубок. С помощью центрирующих колец с уплотнительным кольцом в качестве уплотняющего элемента и зафиксироватьона с зажимными кольцами. Стабилизировать систему механически путем интеграции демпфирующей массы в муфте шланга.
- Подключите выход из мембранного насоса с помощью гибкой вакуумной трубки системы рециркуляции He, если он доступен. Используйте центрирующие кольца с уплотнительным кольцом в качестве уплотнительного элемента и закрепите его с помощью обойм.
- Подключить датчик температуры блока регулирования температуры с соответствующим разъемом на этапе SEM. Включите источник питания блока управления температурой.
- Установите нагревательный кабель на гибкой вакуумной трубки рядом с выпускным отверстием для криогенных газов РЭМ.
- Носите защитные очки и защитные перчатки. Вставьте трубку для жидкости He в LHe Дьюара. Подключение выходе перекачивающего трубки он со входом для криогенных газов крио-стадии SEM.
- Установка параметров электронного пучка HV 20 кВ, размер апертуры до 240 мкм, высокого тока в режиме ON, скорость сканирования электроналуч 1, увеличение до 200, и снижение уровня шума в среднем пикселей.
- С помощью детектора Эверхарт Thornley для получения изображения с вторичными электронами. Переместить сцену к полюсного наконечника и сфокусировать пучок электронов на поверхности образца при WD = 15 мм для экспериментов CL.
- Выберите интересующую область на поверхности образца и сканирования по всему региону в течение всей процедуры охлаждения вниз. Убедитесь, что в течение всего эксперимента CL поверхность образца в интересующей области находится на WD = 15 мм, с помощью соответствующего расположения сцены.
- Запустите остывающей процедуру, введя самую низкую заданную температуру (например., 5 K) и соответствующие параметры для ПИД - регулятора в регулятор температуры в соответствии с техническим руководством. Откройте клапан переноса трубы LHe.
- Монитор температуры образца, давление со стороны He мембранного насоса, а также интегральный выходной сигнал CL от ФЭУ во время остывающей процедуры. рширину развиваются щели монохроматора, если интенсивность CL становится слишком высокой при низких температурах, чтобы избежать повреждения ФЭУ.
- Увеличьте отверстие трансферной трубки LHe, если это необходимо для достижения заданной температуры.
- Восстановите WD = 15 мм для сфокусированных изображений после достижения заданной температуры. Устраните регулировку света собирающим зеркалом для максимальной интегральной интенсивности КЛ на фактическом образце.
- Установите соответствующие значения для решетки (300 линий на мм, полыхают при 1000 нм), спектральная область (1050 до 1600 нм), ширина шага (5 нм), время в точке измерения (5 сек) и ширина щели (1 мм) спектральные измерения CL на образце кремния. Запись CL спектры образца с помощью программы управления CL и сохранить их на жесткий диск ноутбука.
- Выберите плоскую зеркало в монохроматор для панхроматическим CL визуализации и блеске решетки на определенной длине волны для монохроматического CL визуализации соответственно. Отрегулируйте яркость и контрастностьЗначения изображения CL в линейном диапазоне зависимости значений серого из сигнала ФЭУ.
- Отрегулировать соответствующее разрешение изображения (например., 1024 х 768 пикселей), скорость сканирования и способ уменьшения шума для создания изображений CL (например., Для увеличения в диапазоне от 200 до 1000 самая низкая скорость сканирования 14 в сочетании со средним пикселей или выше сканирования скорость 8 в сочетании с линией в среднем более 20 строк). Запись CL изображений с помощью программы управления SEM и сохранить их на жестком диске компьютера.
- Введите имя и параметры каждого спектра и изображения, измеренной в ходе всей измерительной сессии в лог-файл.
- Выключите HV электронного пучка и закрыть клапан колонки камеры SEM перед изменением температуры образца, введя более высокую заданную температуру в контроллер температуры для зависящей от температуры CL исследований.
Примечание: Это, чтобы избежать остановленных электронной пушки по нестабильностей SEM камеры вакуумного дурИНГ нагрева помещений. - Откройте колонку клапанной камеры SEM и включите HV при достижении новой заданной температуры и система вакуума в камере SEM является стабильным снова.
- Выключите HV электронного пучка, закройте колонки камеры клапана SEM, закрыть затвор для ФЭУ, выключите электропитание и охладитель ФЭУ и запустить разминка процедуру после окончания плановых измерений CL при низких температурах.
- Удалите дополнительные устройства и инструменты, которые были собраны для эксперимента крио-CL без открытия камеры SEM.
- Оставьте камеру SEM закрытым в течение по крайней мере 12 часов. Проверьте, чтобы гарантировать, что температура держатель образца при комнатной температуре. В противном случае, разогреть держатель образца до комнатной температуры перед открытием камеры SEM.
Примечание: Это, чтобы предотвратить попадание влаги в камере SEM. - Удалить образец из стадии и вакуумировать камеру SEM.
5. Выполнение Крио-ЕБИК Эксперимент
- EnУбедитесь, что наличие LHe для продолжительности эксперимента 8 ч.
- Использование крио-сцены в РЭМ.
- Убедитесь в том, что пластина слюды доступен с испарившейся слоем Au на верхней поверхности.
- Стек на держателе образца первой кусок слюды с слоем Au вверх, а затем фактический образец на слюду с Шоттки контактом вверх. Поместите один контактный наконечник на Шоттки контакта действительного образца, а другой на испаренной Au слой слюды.
- Вакуумирование камеры SEM, пока не откроется колонка камеры клапана. Установите соответствующие значения параметров SEM визуализации HV, размер диафрагмы, скорость сканирования, увеличения и уменьшения шума.
- Включите образец усилителя тока и выбрать диапазон измерений, так что отображаются три знака после запятой тока образца.
- Создайте файл журнала для записи экспериментов.
- Выполните действия, описанные 4.12 4.16 из экспериментов крио-CL.
- Установите соответствующие значения SEM параметры HV, размер диафрагмы, увеличение, скорость сканирования, а также способ уменьшения шума для визуализации ЕБИК (рекомендуемый диапазон параметров для ЕБИК визуализации границ зерен от 10 до 20 кВ для HV, от 20 до 60 мкм для размера диафрагмы, от 30 до 1000 для увеличения, от 9 до 14 лет для скорости сканирования и пиксела или кадра усреднения).
- Используйте образец детектора тока для визуализации ЕБИК. Переместить сцену к полюсном наконечнике и сфокусировать электронный пучок на WD в диапазоне от 15 до 25 мм.
- Выберите интересующую область на поверхности образца и сканирование по всей интересующей нас области в течение всей процедуры охлаждения вниз.
- Запустите остывающей процедуру, введя самую низкую заданную температуру (например., 200 K) и соответствующие параметры для ПИД - регулятора в регулятор температуры в соответствии с техническим руководством. Откройте клапан переноса трубы LHe.
- Монитор температуры образца и давления He из мембранного насоса в прохладноеING-вниз.
- Разделить экран SEM и мониторинга сигнала вторичных электронов от детектора Everart Thornley параллельно с сигналом ЕБИК из образца детектора тока, чтобы наблюдать за изменением изображения с температурой.
- Перенастраивать параметры SEM HV, размер диафрагмы, увеличение, скорость сканирования, а также снижение уровня шума, чтобы получить ЕБИК изображения высокой контрастности. Повторно настроить также диапазон измерения образца усилителя тока, чтобы избежать переполнения дисплея при низких температурах.
- Переориентировать электронный луч после достижения заданной температуры.
- Запись изображения ЕБИК. Введите имя и параметры каждого изображения в файл журнала.
- Выключите HV электронного пучка и закрыть клапан колонки камеры SEM перед изменением температуры образца, введя более высокое значение заданной температуры в контроллер температуры для зависящей от температуры ЕБИК исследований. Откройте СЭМ колонку клапанной камеры и включите HV, когда новая мишень тэmperature достигается и система вакуумной стабилизировались.
- Выключите HV электронного пучка, закройте клапан колонки камеры SEM и запустить разминка процедуру после окончания плановых измерений ЕБИК при низких температурах.
- Удалите дополнительные устройства и инструменты, которые были собраны для эксперимента крио-ЕБИК без открытия камеры SEM.
- Оставьте камеру SEM закрытым в течение по крайней мере 12 часов. Проверьте, чтобы обеспечить температуру держатель образца при комнатной температуре. В противном случае, разогреть держатель образца до комнатной температуры перед открытием камеры SEM.
- Удалить образец из стадии и вакуумировать камеру SEM.
6. Выполнение экспериментов ccEBSD
- Установить образец в пределах небольшого порока или на цапфе держатель образца, который предварительно наклонена в диапазоне от 65 ° до 70 ° по отношению к направлению пучка электронов.
- В качестве альтернативы, поместить образец на стадии eucentric 6 оси в РЭМ и наклонятьВесь этап таким образом, чтобы поверхность образца нормально и направление пучка электронов под углом в пределах от 65 ° до 70 °. Убедитесь в том, что сцена не будут сталкиваться с детекторами и стенок камеры.
- Вакуумирование камеры SEM, пока не откроется колонка камеры клапана. Установите соответствующие значения SEM параметров визуализации HV (20 кВ), диафрагма (120 мкм), режим высокого тока ON, скорость сканирования (например., 5), увеличение (например., 3000) , а также снижение уровня шума (средний пиксель).
- Фокусировки электронного пучка на поверхности образца при WD в диапазоне от 12 до 22 мм.
- Выключить напряжение ускорения пучка электронов и закрыть колонку камеры клапана.
- Включите источник питания для детектора EBSD. Переместите детектор ЭИ от места стоянки для измерения положения в камере SEM.
- Откройте столбец камеры клапан и включить напряжение ускорения электронного пучка. Переориентировать электронного луча на областьпроценты на поверхности образца.
- Откройте программное обеспечение управления ЭИ и загрузите файл калибровки для выбранной компании WD.
- Настройка измерения в программном обеспечении управления ЭИ в соответствии с руководством по эксплуатации.
- Выполните приобретение фона в соответствии с руководством по эксплуатации ЭИ.
- Считать положение центральной линии рисунка протектора EBSD и расстояние детектора для выбранного WD из программного обеспечения управления ЭИ.
- Фокус электронный пучок в области образца, прилегающих к области, представляющей интерес для реальных измерений. Оставьте луч сканировать там в течение приблизительно 1 часа для стабилизации.
- Проверьте величину дрейфа пучка, который не должен превышать более чем 1 мкм в течение всего измерения на EBSD.
- Перейдите электронный пучок в интересующей области и переориентировать.
- Расписание линия сканирует параллельно оси наклона в интересующей области. Используйте отображение луча (не этап отображения) установку. Выберите соответствующие значения для числа сTEPS (например., 100), размер шага (например., 50 нм), время экспозиции (например., 43 мс), средний кадр (например., 10) и детектор бининг (например., 2 х 2).
- Не забудьте выбрать "сохранить все изображения". Отключение индексирования для ускорения измерений.
- Запуск сканирования строки до последнего сканирования не будет закончена.
- Выключить напряжение ускорения пучка электронов и закрыть колонку камеры клапана.
- Отвести детектор ЭИ из положения измерения в стояночное положение и выключите блок управления ЭИ.
- Удалить воздух из камеры, удалить образец и эвакуировать.
7. Анализ CL-данных:
- Проверьте решетки калибровки путем сравнения спектральных позиций известных спектральных линий (например, пики линий люминесценции объемного и ненапряженных GaAs испытуемого образца с данными в литературе) и при необходимости изменить калибровки длины волны.
- Исправьте записанные спектры CL (INT ensity от длины волны) по отношению к зависимые от длины волны чувствительности оптической системы, состоящей из решетки и Blaze ПМТ делением измеренной интенсивности на соответствующее значение чувствительности в каждой точке измерения.
- Извлечь значение серого каждого пикселя изображения и CL усреднить значения серого для каждого региона интерес в изображении, по крайней мере, по шкале от объема взаимодействия электронов в образце.
- Определить интенсивность ХЛ для интересующей области от калибровочной кривой усредненных значений серого образов Сl, в зависимости от интенсивности ХЛ при заданных контрастности и яркости ФЭУ.
- Оценка средней интенсивности CL I CL всего CL изображения и темный сигнал I 0 детектора CL.
- Рассчитывают контраст C CL между светлыми и темными , появляющихся областей в изображении CL следующим уравнением:
d / 53872 / 53872eq1.jpg "/>
8. Анализ ЕБИК-данных:
- Извлечь значение серого каждого пиксела на ЕБИК изображения и усреднить значения серого для каждого региона, представляющие интерес для количественной оценки пространственных вариаций интенсивности ЕБИК с точки зрения контраста ЕБИК.
- Определить профиль ЕБИК контраст с пространственно решенных серых значений из - за C. Donolato и RO Bell 18.
- Вычислить площадь и дисперсию профилей ЕБИК контраста.
- Определение физических параметров , таких как длина диффузии и скорости поверхностной рекомбинации неосновных носителей заряда от расчетной площади и дисперсии контраста профиля ЕБИК согласно правилам, установленным Donolato 14.
9. Анализ ccEBSD экспериментов
- Используйте в дом письменное программное обеспечение "ccEBSD" запрограммирован Пол Чехонин для оценки записанных образцов EBSD.
- Выберите appropriatе модель ЭИ, который будет действовать в качестве эталонного шаблона из измерительной точки, которая должна быть расположена в зоне образца отсутствующего штаммов.
- Применяют по крайней мере 15 широко распространенных областей, представляющих интерес по образцу.
- Используйте координаты центральной линии рисунка протектора, а расстояние детектора, которые были определены с помощью программного обеспечения управления ЭИ для дальнейшей оценки.
- Введите остальные параметры имеют значение для оценки, то есть., Упругие константы анализируемого материала, количество шагов в линии сканирования и размер шага, размера детектора и его разрешение в пикселях детектора и образца углов наклона, а также детектор бининг.
- Используйте полосовой фильтр во время расчета 2-мерного преобразования Фурье (внутренний фильтр 6 пикселей и внешнего фильтра 40 пикселей).
- Запустите программу оценки.
- Считать численные результаты из текстового файла оценки "времени протокол", используя обычную программу электронных таблиц шКурица вычисление закончено.
Результаты
Исследованы структурные, электрические и оптические свойства протяженных дефектов в полупроводниковом материале с помощью различных экспериментальных методов в сканирующем электронном микроскопе. Как правило, можно исследовать эти свойства на том же образце, и с некоторыми усилиями, касающиеся подготовки образцов, даже на отдельной одного дефекта как границы зерен или локализованное расположение дислокаций. Тем не менее, следует отметить, что из-за специфических продуктов взаимодействия первичного пучка электронов с полупроводниковым материалом, используемым для контроля физических свойств дефектов, пространственное разрешение, которое может быть достигнуто за счет ХЛ, ЕБИК или ccEBSD исследований отличается друг от друга. На рисунке 1, схематичные приведены для соответствующей настройки РЭМ подходит для измерений КЛ при низких температурах (рис 1а) узла для ЕБИК исследований (рис 1В ), а также расположение основных аппаратных элементов , необходимых для (CC) EBSD испытаний (рис 1C).
Все репрезентативные результаты, приведенные здесь, получены для кремния в качестве образца для полупроводникового материала с непрямым электронной зонной структуры. Эта структура полосы препятствует все измерения люминесценции из-за низкой вероятности излучательных переходов по сравнению с полупроводниками с прямой ширина запрещенной зоны структур. Для реализации достаточной интенсивности люминесценции для статистически обеспеченном результатов является сложной задачей. В дальнейшем экспериментальные методики описаны для исследования дислокаций, индуцированных пластической деформации, а также с помощью метода жидкофазного рекристаллизации в монокристаллах кремния. Кроме того, исследования на кремниевой би-кристалле с двумя границами зерен и границы зерен с низким углом представлены.
На фиг.2А показан пример соответствующего позиционирования образца на фольгу индий , чтобы гарантировать хороший тепловой контакт с держателем крио-образца , в котором температура измеряется с помощью термопары. Экспериментально доказано , что для кремния, образец толщиной приблизительно 200 до 500 мкм хорошо подходит для крио-CL исследований при температурах до 5 К. CL спектры приведены на рисунке 2В были измерены для монокристалла Si в девственном состоянии , после пластической деформации и после дополнительного отжига. Электронный пучок в РЭМ функционировал при электронном ускоряющем напряжении пучка 20 кВ и зонда ток приблизительно 45 нА в режиме расфокусированным сканирования, что приводит к высокой интенсивности ХЛ за счет генерации электронно-дырочных пар в большом объеме ( о (450 х 250 х 3) мкм 3) с умеренной плотностью возбуждения. В этом режиме сканирования поверхности образца на самом деле на WD = 15 мм, а в электронном виде WD = 0 корректируется. Для CL формирования изображения, конечно, электронный пучок должен быть сфокусирован, который дает диаметр пятна электронного пучка на поверхности образца нескольких нм, но с той же глубиной проникновения нескольких мкм для первичных электронов, как и в режиме расфокусированным сканирования. Время сбора за изображение с разрешением магазина 1024 х 768 пикселей было около 10 мин в режиме усреднения пикселей при скорости сканирования 14 электронного пучка. Она была рассчитана и экспериментально подтверждено, что для режима расфокусированным сканирования температура области исследуемого образца не увеличивается не более, чем некоторые 0,1 К при передаче тепловой энергии за счет пучку электронов. В сфокусированного режиме локального нагрева образца сильно зависит от теплопроводности , которая в свою очередь зависит от легирования образца и самой температуре 20. Для плавающей зоны , выращенного образца Si, P , легированного бором в концентрации 10 15 см -3, в режиме сфокусированного сканирования, локальное повышение температуры & Delta ; t изоколо 2 K происходило при температуре криостата 5 К, и & Delta; t ≈ 0,3 К при 25 К.
Для изучения оптических свойств дислокаций, Пробу Si подвергают пластической деформации при давлении 16 МПа при температуре 800 ° С, а затем на второй стадии деформации при 295 МПа при 420 ° C. Линии скольжения, показанные на рис 2С на поверхности части деформированного образца, обусловлены дислокационного скольжения процессов на двух различных 111-ориентированных плоскостей скольжения. Линии скольжения могут быть визуализированы с помощью обратного рассеяния электронов (BSE). Линии скольжения указывают следы плоскостей решеток, на которых большинство дислокаций выровнены. Монохроматические CL (моно-CL) изображения (рисунки 2D и 2E) были приобретены на энергетические позиции полос люминесценции D4 и D3 и существенно не страдают от профиля рельефа поверхности , вызванное линиями скольжения. Это было проверено с помощью CL расследований аосле тщательная полировка поверхности, которые показали такую же почти неизменном виде рисунка люминесценции полосы, как на первоначально волнистой поверхности образца, где CL модели интенсивности полосы параллельны плоскости скольжения следов. Если планируется проанализировать локальное распределение интенсивности люминесценции CL количественно с изображения, то CL изображение должно быть записано в линейном диапазоне соотношения между сигналом CL и серого значения. Это соотношение может быть определено экспериментально путем измерения корреляции между значением изображения серого и абсолютного сигнала ФЭУ при заданных контрастности и яркости для детектора. Наоборот, если она предназначена для визуализации малых вариаций интенсивности ХЛ на поверхности образца, то для достижения наилучших результатов, нелинейный сигнал-серый значение соотношение должно быть применено уже во время процесса формирования изображения в РЭМ. Пространственное разрешение на CL изображения на объемном образце Si при низких температурах определяется размером взаимодействияОбъем первичных электронов в образце, так как размер этого объема взаимодействия лишь незначительно меньше , чем объем для излучательной рекомбинации электронно-дырочных пар 21. Диаметр объема взаимодействия для целенаправленного и стационарного пучка составляет около 3 мкм при заданных условиях эксперимента 22.
Оценка поля деформации окружающей протяженных дефектов от ccEBSD требует записи моделей Кикучи с достаточным качеством даже на весьма напряженными регионах образца. Пример приведен на фигуре 3А. Чтобы получить эти образцы, поверхность образца должна быть свободна от нежелательных поверхностных слоев (оксидов, загрязнение углерода и др.). Хорошие результаты могут быть достигнуты с помощью следующих экспериментальных параметров: электронный пучок при 20 кэВ и 12 нА, наклон поверхности образца нормального между 60 ° и 70 ° по отношению к падающему пучку при WD = 15 мм, 2 х 2 ЭИ Deteт е р пиксель бининг, который дает разрешение 672 х 512 пикселей, усиление усиление сигнала установлен высокий уровень безопасности, время экспозиции от 20 до 43 мс на кадр на детекторе EBSD, усреднение по пяти до десяти кадров в измерительной точке и хранения Kikuchi рисунок в виде изображений для каждой точки измерения без индексации. Общее время сбора для одного шаблона Kikuchi можно оценить по времени экспозиции, умноженному на число кадров, плюс несколько 10 мс из-за времени, необходимого для смещения луча, считывать и хранение. Значение 50 нм оказалось экспериментально, чтобы быть хорошим минимальный размер шага между двумя образцами позиций в отображении EBSD. Это согласуется с недавними теоретическими соображениями 23 , касающихся достижимой разрешающей способности для дифракции электронов контраста. Чтобы избежать дрейфа пучка при отображении EBSD, рекомендуется подождать по крайней мере 15 мин со сканированием луча в непосредственной близости от области, представляющей интерес перед запуском карты.Было установлено, что только ЭИ линия сканирует параллельно оси наклона образца обеспечивают реалистичные данные деформации с эталонным рисунком на той же строке. В противном случае, очень тщательное определение фактического угла наклона образца необходимо, или в качестве альтернативы длина линии сканирования перпендикулярно к оси наклона должен быть ограничен до нескольких микрометров.
Шаблон Кикучи хранится в виде 8-битных JPEGs оценивали с помощью преобразования Фурье (FT) и кросс-корреляции с программой "ccEBSD", написанной одним из авторов (ПК). Программа основана на алгоритме , разработанном Уилкинсон et.al. 6, подробно описанной в работе. 19. В структуре Кикучи, несколько (15 - 19) подшаблонов (128 х 128 пикселей) должны быть определены с характерными особенностями в виде ярких пересечений полосы (см фиг 3A и 3B). Все подшаблонов должны быть проанализированы с помощью FT. Полосовой фильтр должен быть применен ко всем изображениям FT (внутренний радиус 6 пиxels для низких частот, внешний радиус 40 пикселей для более высоких частот) , чтобы установить все значения к нулю вне полосового фильтра в пространстве Фурье (см Рисунок 3C). Тогда функция взаимной корреляции (сс) (рис 3D) должен быть рассчитан между FT каждого суб-модели с соответствующим FT суб-шаблон (рис 3Е и 3F) от опорной точки Кикучи рисунка. С позиций пиков в CC-функций (рис 3D), относительные смещения подшаблонов могут быть определены. С помощью этих перемещений, нормальные и касательные компоненты деформации могут быть вычислены. Если материал зависимые упругие константы известны, также компоненты напряжения могут быть определены. В обозначениях по Фойгта, эти константы C 11 = 165,7 ГПа, C 12 = 63,9 ГПа и C 44 = 79,9 ГПа для Si с кубической решеткой 24. Сочетание результатов от всех подшаблонов одного Кикучи раttern повышает точность оценки деформации. Статистическая погрешность определяется из ccEBSD линии сканирования на свободной области дефекта в монокристалл кремния оказывается 2 х 10 -4 для всех компонент тензора деформаций. Тем не менее, для получения количественных результатов для случая протяженных дефектов, выбор шаблона Kikuchi как эталонного шаблона имеет важное значение. Если, например, образец полностью покрыта дислокаций , как показано на рисунке 2, сложные процедуры, которые предложены Jiang и др. , 25 может быть применен , чтобы выяснить , соответствующий эталонный образец.
Ситуация для использования ccEBSD легче для кремниевую пластину ([001] -поверхностью ориентации) , обработанной электронным пучком высокой энергии , чтобы вызвать образование жидкой фазы рекристаллизации (смотри рисунок 4). Вокруг дорожки повторной кристаллизации, линии скольжения видны в BSE изображения, указывающего DISLocation движение на плоскостях скольжения со следами параллельно краям изображения (рисунок 4A). ХЛ исследования проводились в тех же экспериментальных условиях, что и для пластически деформированного образца. Изображения моно-CL, записанные при энергиях перехода зона-полосы и дислокации полос люминесценции D4 и D2 (фиг 4B, 4C и 4D, соответственно), показывают пространственное распределение протяженных дефектов , вызванных повторной процедура кристаллизация. Местный анти-корреляция между переходом зона-полосы и полос люминесценции D линии могут быть выведены из изображений моно-CL. Это подтверждается спектрами CL (рис 4Е) , которые были измерены при выборочных позициях 1, 2 и 3 (см Рисунок 4A) в месте режиме электронного пучка. Из ccEBSD исследований , выполненных в виде линии сканирования перед повторной кристаллизации дорожки (белая линия на рисунке 4A), локального тензора деформации ComponenТ.С. вдоль линии сканирования может быть определена (рис 4F и 4G). Было доказано, что в пределах статистической погрешности, значения не зависят от какой именно шаблон Кикучи был использован в качестве эталонного шаблона, если этот образец находится в области, где в переходной полосе к группе является доминирующим. Связанные с этим дислокационные электронные переходы появляются , когда сумма нормальных напряжений Тг (е) превышает значение 5 × 10 -4. Поскольку Тг (ε) не равна нулю при сканировании в области около 150 мкм длиной, близкой к рекристаллизации дорожке, существует средняя решетка дилатацию в объеме вблизи к поверхности образца. Согласно линейной теории упругости, нормальное напряжение σ 33 равна нулю , как предполагается в программе оценки "ccEBSD". Если есть трещина на ЭИ строчной развертки, то оценка ccEBSD не может быть выполнена по всей сканирования с одной опорной узором из-за резких изменений паттерна Кау KikuchiСЭД геометрическими эффектами трещины.
Что может быть достигнуто в принципе экспериментальными методами , описанными для исследования структурных, оптических и электрических свойств границ зерен в Si показано на рисунке 5 для Si би-кристалле р-типа легирования с концентрацией бора 10 17 см -3. Традиционная ЭИ карта дает полную информацию о ориентации кристалла в каждой точке карты, где только индексация картины Кикучи выполняется сразу после приобретения картины с помощью программного обеспечения приобретения. Кроме того, также тип границ зерен могут быть отображены с помощью традиционных данных EBSD управляющих программ (Рисунок 5А). Для обнаружения ЛРБЖ, критический угол должен быть определен для разориентации кристаллической решетки в двух соседних точках измерения. Минимальное значение 1 ° было доказано, что это необходимо. ДляЛРБЖ показано на карте EBSD, угол разориентации составляет 4,5 °. ЕБИК-изображение той же области образца (рис 5B) измеряли при комнатной температуре. Некогерентные границы Σ3 зерна и ЛРБЖ выступают здесь как темные линии. Этот эффект обусловлен местной повышенной рекомбинацией носителей. Из профиля контраста сигнала ЕБИК через ЛРБЖ (см, рис 5H), длина диффузии (60 ± 12) мкм и скорости рекомбинации (4,1 ± 0,4) × 10 4 см с -1 были определены для неосновных носителей заряда в рамках модели с помощью Donolato 14. Отдельные темные точки на изображении ЕБИК, разбросанные по всей поверхности образца и концентрированные особенно в непосредственной близости от ЛРБЖ, указывают положения пронизывающих дислокаций. В исследованиях изображений CL при 4 К, ЛРБЖ кажется темным на изображении моно-CL при энергиях зона-полосы перехода (рис 5в), как ожидалось, но surprisingly также в моно-CL изображения в энергии зоны Д4 (рис 4D) , который обычно назначается для дислокаций. Тем не менее, ЛРБЖ выглядит яркой в моно-CL изображением на длине волны 1530 нм , соответствующей полос люминесценции D1 / D2 (рис 5д). Такое поведение люминесценции, как полагают, индуцированный точечных дефектов в окрестности дислокаций, составляющих ЛРБЖ. Кроме того, процедура ccEBSD была выполнена в виде линии сканирования через ЛРБЖ, чтобы определить его локальное поле деформаций. Ускоряющее напряжение электронного пучка была снижена до 10 кВ с целью увеличения пространственного разрешения для определения деформации за счет увеличенного общего времени приобретения для каждого шаблона Кикучи. Нормальные и касательные компоненты деформации, показанные на рисунках 5F и 5G, соответственно, не может быть рассчитана для центральной области ЛРБЖ (более 50 нм) , так как двойные модели появляются , которые мешают анализ моделей Кикучи. Большеболее, модели ЭИ с обеих сторон ЛРБЖ должны быть соотнесены с двумя различными эталонные диаграммы направленности, так как метод взаимной корреляции может быть применен только для малых вариаций дифракционной картины. Таким образом, две эталонные диаграммы направленности были собраны на левой стороне и на правой стороне ЛРБЖ из-за большого угла разориентации между двумя субгранулами. Тем не менее, это интересно, что компоненты деформации ведут себя симметрично по обе стороны от ЛРБЖ. Диаграммы позиции зависимости компонентов деформации показывают, что диапазон поля деформации от ЛРБЖ простирается до примерно 350 нм в обоих субгранулами. Наоборот, диаграмма из локального изменения контраста в переходе моно-CL изображение , зона-группы, и в отличие от сигнала ЕБИК в ЕБИК изображении (рис 5H), указывает на то, что влияние ЛРБЖ на сигнал люминесценции и на сигнале ЕБИК диапазонов до ± 10 мкм и ± 1,5 мкм от центра от ЛРБЖ, соответственно. Это подтверждает заявление, с самого начала, что локальное разрешение для исследования различных свойств протяженных дефектов сильно зависит от экспериментального метода и параметров прикладной.

Рисунок 1. Настройка для CL, ЕБИК и ccEBSD измерений. (А) SEM с ружьем автоэмиссии, различные отверстия для визуализации и анализа образца на держателе крио-пробу, CL светособирающую зеркала, монохроматора а ИК-PMT для инфракрасного света, (B) Шоттки контакт образца для ЕБИК исследований и (с) установка для формирования и хранения шаблона Кикучи , которые могут быть проанализированы численно , чтобы получить информацию о ориентации кристалла, а также на кристаллической решетке искажений по ccEBSD.d / 53872 / 53872fig1large.jpg "целевых =" _blank "> Пожалуйста, нажмите здесь, чтобы посмотреть увеличенную версию этой фигуры.
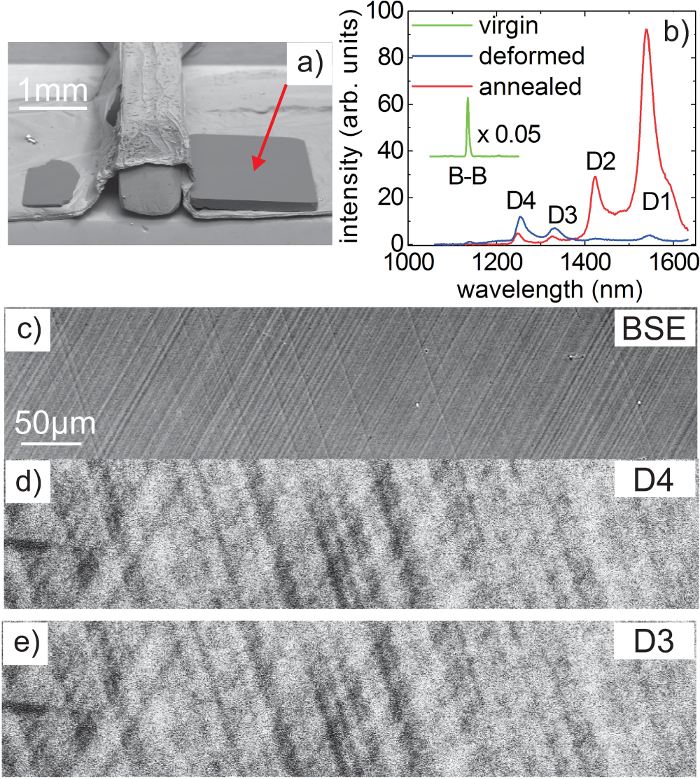
Рисунок 2. CL Спектральный и визуализации Исследования по пластически деформированный монокристалл кремния. (А) Кремниевые образцы на индий фольги , расположенной на держателе крио-образца. (В) , CL-спектры измерены для высокой чистоты Si монокристалла (девственница), для пластически деформированного образца, и после дополнительного отжига. Характерные переходы в спектрах помечены как обычно, с BB для перехода зона-диапазона, и D1 до D4 для дислокаций индуцированных полос люминесценции. (C) Линии скольжения на поверхности деформированного кристалла Si (отмечен красной стрелкой на рисунке 2А) , отображаемых обратно рассеянных электронов (BSE). Эти результаты показывают, пластической деформации для различных противовирусные скольженияМиз. На рисунках 2D и 2Е, изображения моно-CL для линии D4 и D3 линии показаны, соответственно, причем каждое измеренное по той же области образца ниже , что показано на BSE-изображении (рис 2С). Пожалуйста , нажмите здесь для просмотра большая версия этой фигуры.

Рисунок 3. Изображения Визуализация шагов в процессе ccEBSD анализа. (A) Полный Кикучи образец из фактического положения образца с подразделом рисунком. (B) Один из подшаблонов и (С) его фильтруют преобразование Фурье. (E) , соответствующие суб-шаблон из исходного положения на образце и (F) его фильтрованной преобразования Фурье. (D) кросс-корреляционная функция (CCF) вычисляется из Фурье-преобразования суб-шаблона. Яркость CCF была увеличена на 20% , чтобы визуализировать детали. Пожалуйста , нажмите здесь , чтобы посмотреть увеличенную версию этой фигуры.

Рисунок 4. CL и ccEBSD Исследования для вафельных После Si рекристаллизации. (А) BSE изображение с поверхности пластины с Si колее рекристаллизованным материала после обработки электронным пучком высокой энергии. Позиции точек 1, 2 и 3 для CL спектральных исследований отмечены, а также линии с направлением стрелки, где была выполнена ccEBSD сканирования. (BD) Mono-CL изображения области образца , показанного в (А), принятые на энергетические позиции полосы-зона перехода (В),D4 (C) и D2 (D) полоса люминесценции. (E) CL спектры , измеренные в точках 1, 2 и 3. Нормальная (F) и компонент деформации сдвига (G) вдоль линии сканирования в (A), рассчитано из ccEBSD исследований. Пожалуйста , нажмите здесь , чтобы увидеть увеличенную версию этой фигуры.

Рисунок 5. ЭИ, ЕБИК, CL и ccEBSD Исследования на кремниевой Bi-кристалле с HAGBs и ЛРБЖ. (A) EBSD карте ориентации на Si би-кристалле с двумя границами зерен в желтый и ЛРБЖ в черном цвете. Ориентация нормали поверхности зерна указывается. (B) ЕБИК изображения при КТ области образца в (А) , где когерентное (желтая стрелка) и incohereнт (синяя стрелка) двойные границы зерен указаны. (CE) Изображения моно-CL при энергиях BB (C), D4 (D) и D1 / D2 (E) принадлежат к ЛРБЖ области , который отмечен красным прямоугольником в ЕБИК изображения (B). Нормальный (F) и сдвиговые компоненты деформации (G) , рассчитанные из ccEBSD исследований через ЛРБЖ. (Н) Сравнение контраста , найденного в изображении BB моно-CL при 4К и в ЕБИК изображении при комнатной температуре через ЛРБЖ. Обратите внимание на различное масштабирование на Х-координата на диаграммах компонентов деформации и на диаграмме Cl- и ЕБИК контраста. Пожалуйста , нажмите здесь , чтобы посмотреть увеличенную версию этой фигуры.
Обсуждение
СЭМ дает возможность локализовать протяженных дефектов в полупроводниковом материале, а также характеризовать их структурные, оптические и электрические свойства путем применения ccEBSD, CL и ЕБИК исследований. В общем, это не представляется возможным выполнить все три метода одновременно на том же образце. Тем не менее, сочетание результатов, полученных разными методами дополнительное расследование, когда выполняется в разумной последовательности, приводит к более глубокому пониманию физической природы эффектов, вызванных протяженными дефектами.
Для измерений ХЛ, дающих информацию об оптических свойствах протяженных дефектов, важным шагом в протоколе является процедура позиционирование образца (шаг 1,6) из-за нежелательного отжига дефектов в образце во время нагрева фольги индий (что обеспечивает хороший тепловой и электрический контакт образца с держателем образца). Альтернативой процедуре, предложеннойявляется установка образца на держатель образца проводящей серебряной пастой при комнатной температуре. Тем не менее, из опыта известно, что органический растворитель в пасте может привести к загрязнению углерода на поверхности образца во время сканирования в РЭМ. Загрязнение ухудшает качество изображений CL, а также закономерности ЭИ дифракции. Кроме того, шаг 4,21 требует особого внимания, где может произойти резкий подъем интенсивности люминесценции кремния во время остывания образца. Это может нанести вред производительности ФЭУ. Напротив, для случая неожиданной низкой интенсивности люминесценции для действительного образца, следует попытаться улучшить регулировку света собирающей зеркала (протокол № 4.23), поскольку предварительное выравнивание зеркала проводилось на тестовом образце при комнатной температуре в немного другой диапазон длин волн.
Что касается инструментальных ограничения метода, необходимо учитывать, что при очень низкой TEMPERATUres этап с образцом можно перемещать только на ± 5 мм в х и у направлениях, ограничивающей площадь исследуемых образцов. Это ограничение связано с опасностью хрупкого разрушения переноса трубы He. Образцы размеры для крио-экспериментов, приведенных в пунктах 1.1 и 1.2 также ограничены условиями эксперимента. Таким образом, площадь поверхности образцов должны быть отрегулированы по размеру держателя образца, чтобы обеспечить оптимальный тепловой контакт на радиаторе. Низкая рекомендуемая толщина образцов кремния ограничивает градиент температуры в образце для крио-экспериментов. При толщине образца 200 мкм, было обнаружено, что температура в центре объема взаимодействия для первичных электронов в области поверхности, чтобы быть увеличена менее чем на 5 К по сравнению с температурой, измеренной на поверхности держателя образца. Высокая скорость сканирования и низкий коэффициент увеличения предложил только для остывания процедуры в пунктах 4.5 и 4.17, убедитесь, что йе область интереса содержится в чистоте. Это происходит из-за передачи тепла с помощью растрового электронного луча, который всегда слегка поддерживает температуру выше температуры остальной части образца областей, которые действуют как ловушка для конденсации остаточного газа в камере SEM. Как правило, все параметры, перечисленные на этапе 4.24 для CL спектроскопии оптимизированы для измерения так называемой D линии люминесценции в объемном кремнии путем экспериментальной установки в соответствии с перечнем оборудования. Параметры должны быть адаптированы, если исследования люминесценции должны быть выполнены на других полупроводниковых материалов.
Независимо от области энергий люминесценции наблюдается, дальнейшее ограничение результатов измерений CL от светособирающую зеркала, потому что свет, исходящий от радиационных процессов рекомбинации во всем объеме рекомбинации собирают зеркала и, таким образом, определяет серую значение соответствующего пиксель CL изображение, которое является правопреемникомред к положению электронного пучка на поверхности образца. Поскольку диаметр объема рекомбинации (что сопоставимо с объемом возбуждения) больше, чем размер пикселя даже при малом увеличении, этот эффект вызывает пространственное смазывание сигнала люминесценции, и, следовательно, ограничивает пространственное разрешение. Тем не менее, исследование CL дает возможность визуализации локального распределения моно- или панхроматическим люминесценции со средним спектральным разрешением и может сочетаться с фотолюминесцентных исследований, чтобы дать более высокую спектральное разрешение. В последнее время в качестве альтернативы экспериментальный метод чайльд измерения, микроскопическое и спектроскопические отображение связанных с дислокационной фотолюминесценции была предложена группой Tajima и сотрудников 26. Пространственное разрешение отображения фотолюминесценции явно ниже, чем в ХЛ изображениях, но фотолюминесцентные исследования дополнительно позволяет поляризацию глубоких уровней полосы излучения соответствуюные с дислокаций , которые будут определены в LAGBs с твист и наклона конструкций 27,28.
В случае ЕБИК исследований, которые дают представление о электрических свойств протяженных дефектов, не существует никаких альтернативных методов для визуализации локально различной эффективности заряда сбора в полупроводниковых материалах с сравнительно пространственным разрешением. Тем не менее, также для измерения ЕБИК, критические шаги включены в протокол. Таким образом, в шаге 5.13, изменение изображения ЕБИК с понижением температуры, как ожидается, возникают от температурных зависимых свойств протяженных дефектов. Тем не менее, качество контактов может изменяться при температурах ниже комнатной температуры и, следовательно, влияет на ЕБИК изображение. Температура влияет на контакт Шоттки, выполненный с соответствующим слоем Al в случае р-типа и с Au в случае п-типа кремния, из-за различных коэффициентов теплового расширения, отделяющих контактный слой из силикомарганцап субстрат. Кроме того, омический контакт сделан эвтектики галлий-индий не стабилен при температурах ниже 160 К. Как правило, снижение качества контакта приводит к сильно снизилась сигнал ЕБИК для больших площадей. В этом случае, контакты должны быть возобновлены. Для ЕБИК исследований при комнатной температуре, также возможно, что контакты для измерения EBSD могут быть сделаны путем приклеивания образца к соответствующей несущей платы. Еще одно инструментальное ограничение измерений ЕБИК вызвано выступающими держателей контактный наконечник над поверхностью образца. Для того, чтобы предотвратить столкновение между держателем контактного наконечника и полюсном наконечнике SEM программы WD должно быть не менее 15 мм.
В экспериментальном порядке ccEBSD исследований, которые могут быть использованы для оценки дальнего поля деформации протяженных дефектов, следующие шаги имеют решающее значение. Наиболее сложной частью эксперимента является подготовка проб, особенно процедура последней полировки (рrotocol Нет. 3.1), которая должна быть выполнена тщательно, чтобы избежать образования дополнительных поверхностных дефектов. Если ни один шаблон Кикучи не может быть получен, часто качество поверхности образца не достаточно. Тем не менее, из монокристаллов кремния с линиями скольжения на поверхности после пластической деформации, хорошая картина дифракции может быть получена, который хорошо подходит для процедуры оценки ccEBSD. Шероховатость поверхности этих образцов анализировали с помощью атомно-силовой микроскопии выдающее изменения высоты в диапазоне до 500 нм. Таким образом, чрезвычайно высокие внутренние напряжения или аморфный поверхностные слои, как представляется, отвечают за размытых дифракционных картин, а не несовершенством гладкости поверхности образца. Еще одна проблема может быть низкий уровень сигнала от когерентно рассеянных электронов по сравнению с фоном. Тогда увеличение тока зонда при постоянном напряжении ускорения и / или более точного определения фонового сигнала (протокол шаг № 6.12) вповторно полезно. Чтобы свести к минимуму движение образца во время длительной измерения ccEBSD рекомендуется зафиксировать образец механически (протокол № 3.2).
Инструментальные ограничения для ccEBSD исследований могут возникнуть, если наклон поверхности образца относительно падающего пучка электронов осуществляется наклоном сцены. Есть тогда сильные ограничения для движения образца из-за риска столкновения с полюсным наконечником и стенок камеры. Кроме того, настоятельно рекомендуется использовать только сканирование линии, которые параллельны оси наклона (и, таким образом, появляется на экране по горизонтали SEM), так как, во-первых, вертикальные развертки имеют большую погрешность суммы для внутренних деформаций из-за ошибки выборки наклон. Во-вторых, во время EBSD, боковое разрешение выше (примерно в 3 раза по 70 ° наклона) вдоль оси поворота, чем перпендикулярно к ней. Нижний предел для значения компонент тензора деформаций, вычисленной для Si от ccEBSD исследований составляет около2 х 10 -4 , которая является случайной ошибки. Кроме того, следует подчеркнуть, что метод ccEBSD не может быть применен в присутствии больших поворотов решетки (> 4 °) относительно базовой точки или очень близко к границам зерен, где ЭИ узоры из разных зерен перекрывают друг друга. Физическое ограничение ccEBSD исследований, касающихся пространственного разрешения определения деформаций связано с диапазоном дифракции электронов, которое было установлено, что примерно 50 нм вдоль оси образца наклона. По сравнению с дифракционных экспериментах рентгеновского излучения для определения внутренних напряжений, это является явным преимуществом из-за значительно большего объема взаимодействия рентгеновских лучей, даже в случае рентгеновской мю-дифракции. Для получения полупроводниковых материалов, исследование возмущений изотропных показателя преломления с помощью polarscope также может быть применен для определения внутренних напряжений, но пространственное разрешение этого метода ниже, чемнескольких сотен нм 29. Альтернативный метод определения пространственно-разрешенной трехмерной деформированного состояния в кристаллах основан на расщеплении высшего порядка Лауэ зон (HOLZ) линий. Этот метод должен быть выполнен в просвечивающем электронном микроскопе (ПЭМ) с использованием электронного Бипризма для электронного интерферометрии 30. Тем не менее, в отличие от ccEBSD исследований в РЭМ, ПЭМ исследование требует подготовки фольги из образца, который изменяет внутренние напряжения из-за релаксационных эффектов.
В дальнейших исследованиях, измерения ccEBSD также будет выполняться при низких температурах. Это позволит следствию структурные, оптические и электрические свойства, а не только на том же расширенном дефект, но и при той же температуре.
Раскрытие информации
The authors have nothing to disclose.
Благодарности
Support of this work by the German Research Foundation (DFG) within the framework of the Research Training Group 1621 is gratefully acknowledged by Paul Chekhonin. All authors are grateful to Dietmar Temmler (Fraunhofer FEP Dresden) for providing the electron beam processed Si samples showing liquid phase re-crystallisation. Special thanks go to Stefan Saager and Jakob Holfeld for the preparation of the figures for the SEM equipment and the EBSD set-up. We thank Michael Stavola for detailed discussions and help with this work.
Материалы
| Name | Company | Catalog Number | Comments |
| Cryogenic liquids: | Linde http://www.linde-gas.de, Air Liquide http://www.airliquide.de/ | ||
| Liquid helium ( LHe ) | for cooling of the cryostat | ||
| Liquid nitrogen ( LN2 ) | for cooling of the PMT R5509-73 | ||
| Indium wire | chemPUR http://chempur.de/ | 900898 | CL sample preparation: for good electrical and thermal coupling between cryostat and sample |
| Mica | plano GmbH http://www.plano-em.de/ | V3 | isolation of EBIC sample holder and good thermal coupling to the cryostat |
| Aluminium wire, gold wire | chemPUR http://chempur.de/ | 009013, 900891 | purity 99.99%, material for formation of Schottky contact for EBIC measurements |
| Indium-Gallium eutectic solution | Alfa Aesar | 12478 | to form ohmic contact on the backside of the sample for EBIC measurements |
| Liquid chemicalsVLSI Selectipur (de-ionized water, acetone, ethanol) | VWR | 52182674, 51152090 | for sample preparation: cleaning and surface treatment |
| Hydrofluoric acid | VWR | 1,003,382,500 | necessary to remove surface oxide layer on Silicon samples immediately before investigation; follow safety precautions! |
| MicroCloth | Buehler http://www.buehler.com/ | 40-7222 | polishing cloth |
| MasterMet 1 (0.02 µm) | Buehler http://www.buehler.com/ | 40-6380-006 | SiO2 polishing suspension |
| Scanning electron microscope (SEM) | Carl Zeiss AG http://www.zeiss.de/microscopy/ | Ultra 55 | field emission gun |
| SEM-CL system | EMSystems | customized, following equipment belongs to CL system: | |
| SEM stage for cryostat | Kammrath & Weiss http://www.kammrath-weiss.com | ||
| KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-06-4609C-7674 | cooling of sample |
| Liquid He transfer line for KONTI cryostat | Cryovac http://www.cryovac.de/ | 3-01-3506C-SO | |
| Cryogenic Temperature Controller | Cryovac http://www.cryovac.de/ | TIC-304 MA | controlling the flow rate of cryogenic |
| Photomultiplier Tube (PMT) | Hamamatsu http://www.hamamatsu.com | R5509-73 | for NIR spectral range |
| PMT housing and cooler | Hamamatsu http://www.hamamatsu.com | C9940-2 | |
| HV power supply | Heinzinger electronic GmbH http://www.heinzinger.de/ | LNC 3000-10 neg | for operating of the PMT |
| Monochromator | Sol Instruments Ltd. http://www.solinstruments.com | MS2004i | |
| PMT | Hamamatsu http://www.hamamatsu.com | R3896 | for visible spectral range |
| CCD digital camera | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | HS 101 H | for visible spectral range |
| Control program | Proscan GmbH, Proscan Special Instruments Ltd. http://www.proscan.de | PSI line | for controlling spectral CL measurements with CCD or PMT detectors |
| Laptop | Dell | Latitude 110L | hardware for running the control program |
| LHe dewar | cryotherm http://www.cryotherm.de/ | Stratos 100 SL | container for cryogenic |
| LN2 dewar | container for cryogenic | ||
| Protective glasses | pulsafe | protective equipment | |
| Protective gloves | tempex | Protect line Mod. 4081052 | protective equipment |
| Heating tape | Thermocax Isopad GmbH http://www.isopad-solutions.com | IT-TeMS 6 | to prevent or reduce icing of the flexible hoses during cooling |
| Diaphragm pump | Vacuubrand GmbH & Co KG http://www.vacuubrand.com | ME4 | to provide the flow rate of the cryogenic |
| Vacuum accessoires: flexible hoses, seals, locking rings | connectors for cryogenic CL or EBIC set-up | ||
| Specimen current EBIC amplifier | KE developments / Deben http://deben.co.uk/ | Type 31 | Measuring the EBIC current |
| High vacuum chamber with metal evaporation | customized | formation of Schottky contact for EBIC measurements | |
| Heating plate | Retsch GmbH http://www.retsch.de | SG1 | CL sample preparation |
| EBSD detector Nordlys | HKL | no more available; can be replaced by the Oxford EBSD detectors NordlysMax3 or NordlysNano | |
| EBSD acquisition and evaluation software Channel 5 | HKL | no more available; can be replaced by the Oxford EBSD Software AZtecHKL | |
| ccEBSD program ccEBSD_v1.07.exe | in house written program | for use please contact authors | |
| EBSD interface with remote control system | Carl Zeiss AG http://www.zeiss.de/microscopy/ | necessary for the electron beam control and parameter transfer between EBSD system and SEM | |
| Vibromet2 | Buehler, http://www.buehler.com/ | 671635160 | vibratory polisher |
Ссылки
- Alexander, H. Chapter 6, Dislocations. Electronic Structure and Properties of Semiconductors. Schröter, E. , Materials Science and Technology; 4. VCH Basel. 249-319 (1991).
- Mahajan, S. Defects in semiconductors and their effects on devices. Acta Mater. 48, 137-149 (2000).
- Holt, D. B., Yacobi, B. G. Extended Defects in Semiconductors- Electronic Properties, Device Effects and Structures. , Cambridge University Press. (2007).
- Hornstra, J. Models of grain boundaries in the diamond lattice. Physica. 25 (1-6), 409-422 (1959).
- Randle, V. Crystallographic characterization of planes in the scanning electron microscope. Mater. Charact. 34 (1), 29-34 (1995).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High-resolution elastic strain measurement from electron backscatter diffraction patterns: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. High resolution mapping of strains and rotations using electron backscatter diffraction: New levels of sensitivity. Ultramicroscopy. 106 (4-5), 307-313 (2006).
- Drozdov, N. A., Patrin, A. A., Tkachev, V. D. Recombination radiation on dislocations in silicon. JETP Lett. 23 (11), 597-599 (1976).
- Dean, P. J., Williams, G. M., Blackmore, G. Novel type of optical transition observed in MBE grown CdTe. J Phys. D: Appl. Phys. 17 (11), 2291-2300 (1984).
- Nacke, M., Allardt, M., Chekhonin, P., Hieckmann, E., Skrotzki, W., Weber, J. Investigations on residual strains and the cathodoluminescence and electron beam induced current signal of grain boundaries in silicon. J. Appl. Phys. 115 (16), 163511-1-163511-8 (2014).
- Ikeda, K., Sekiguchi, T., Ito, S., Suezawa, M. EBIC and Cathodoluminescence Study of the Bonded Silicon Wafers. Solid State Phenom. 63-64, 481-488 (1998).
- Sekiguchi, T., Ito, S., Kanai, A. Cathodoluminescence study on the tilt and twist boundaries in bonded silicon wafers. Mater. Sci. Eng. B. 91-92 (4), 244-247 (2002).
- Lee, W., Chen, J., Chen, B., Chang, J., Sekiguchi, T. Cathodoluminescence study of dislocation-related luminescence from small-angle grain boundaries in multicrystalline silicon. Appl. Phys. Lett. 94, 112103(2009).
- Donolato, C. Theory of beam induced current characterization of grain boundaries in polycrystalline solar cells. J. Appl. Phys. 54 (3), 1314-1322 (1983).
- Kittler, M., et al. Regular Dislocation Networks in Silicon as a Tool for Nanostructure Devices used in Optics, Biology, and Electronics. Small. 3 (6), 964-973 (2007).
- Kveder, V., Kittler, M., Schröter, W. Recombination activity of contaminated dislocations in silicon: A model describing electron-beam-induced current contrast behavior. Phys. Rev. B. 63, 115208(2001).
- Higgs, V., Lighthowlers, E. C., Norman, C. E., Kightley, P. Characterisation of dislocations in the presence of transition metal contamination. Mater. Sci. Forum. 83-87, 1309-1314 (1992).
- Donolato, C., Bell, R. O. Characterization of grain boundaries in polycrystalline solar cells using a computerized electron beam induced current system. Rev. Sci. Instrum. 54 (8), 1005-1008 (1983).
- Wilkinson, A. J., Meaden, G., Dingley, D. J. chap. 17, Mapping Strains Using Electron Backscatter Diffraction. Electron Backscatter Diffraction in Material Science. Schwartz, A. J., Kumar, M., Adams, B. L., Field, D. P. , 2nd Edition, Kluwer Academics/Plenum Publishers. New York. 231-249 (2009).
- Childs, G. B., Ericks, L. Y., Powell, R. W. National Bureau of Standards. Thermal Conductivity of Solids at Room Temperature and Below: A Review and Compilation of the Literature. , http://digital.library.unt.edu/ark:/67531/metadc13173/m1/1 (1973).
- Yacobi, B. G., Holt, D. B. Cathodoluminescence Microscopy of Inorganic Solids. , Plenum Press. New York. (1990).
- Everhart, T. E., Hoff, P. H. Determination of Kilovolt Electron Energy Dissipation vs Penetration Distance in Solid Materials. J. Appl. Phys. 42 (13), 5837-5846 (1971).
- Zaefferer, S., Elhami, N. N. Theory and application of electron channelling contrast imaging under controlled diffraction conditions. Acta Mater. 75, 20-50 (2014).
- Schulze, G. Metallphysik. , Akademie Verlag. Berlin. (1967).
- Jiang, J., Britton, T. B., Wilkinson, A. J. Evolution of intragranular stresses and dislocation densities during cyclic deformation of polycrystalline copper. Acta Mater. 94, 193-204 (2015).
- Inoue, M., Sugimoto, H., Tajima, M., Oshita, Y., Ogura, A. Microscopic and spectroscopic mapping of dislocation-related photoluminescence in multicrystalline silicon wafers. J. Mater. Sci.: Mater. Electron. 19, 132-134 (2008).
- Kato, G., Tajima, M., Toyota, H., Ogura, A. Polarized photoluminescence imaging analysis around small-angle grain boundaries in multicrystalline silicon wafers for solar cells. Jpn. J. Appl. Phys. 53, 080303(2014).
- Tajima, M. Spectroscopy and Topography of Deep-Level Luminescence in Photovoltaic Silicon. IEEE J. Photov. 4 (6), 1452-1458 (2014).
- Yablon, A. D. Optical and mechanical effects of frozen-in stresses and strains in optical fibres. IEEE J. Sel. Top. Quant. 10 (2), 300-311 (2004).
- Herring, R., Norouzpour, M., Saitoh, K., Tanaka, N., Tanji, T. Determination of three-dimensional strain state in crystals using self-interfered split HOLZ lines. Ultramicroscopy. 156, 37-40 (2015).
Перепечатки и разрешения
Запросить разрешение на использование текста или рисунков этого JoVE статьи
Запросить разрешениеThis article has been published
Video Coming Soon
Авторские права © 2025 MyJoVE Corporation. Все права защищены