Method Article
プラズマによる高c軸ZnO薄膜の合成とキャラクタリゼーションは、化学気相堆積システムとそのUV光検出器アプリケーションを強化しました
要約
We offered a method to directly synthesize high c-axis (0002) ZnO thin film by plasma enhanced chemical vapor deposition. The as-synthesized ZnO thin film combined with Pt interdigitated electrode was used as sensing layer for ultraviolet photodetector, showing a high performance through a combination of its good responsivity and reliability.
要約
本研究では、 高 Cγ軸(0002)優先配向した酸化亜鉛(ZnO)薄膜を正常かつ効率的にプラズマ化学気相堆積(PECVD)システムを用いて、異なる合成温度を介してシリコン(Si)基板上に合成されています。異なる合成結晶構造上の温度、表面形態および光学的特性の影響が検討されています。 X線回折(XRD)パターンは(0002)回折ピークの強度は400 O C.まで増大合成温度に強くなったことを示し(0002)の回折強度ピークが徐々に(10-10)の出現に伴って弱くなった400 O Cの過剰に合成された温度上昇などの回折ピークRTのフォトルミネッセンス(PL)スペクトルは、強い近接バンド端の周りに375 nmで観察した(NBE)排出し、約575 nmのウントに位置無視できる深いレベル(DL)の発光を示しましたER 高 C -軸のZnO薄膜。電界放出走査電子顕微鏡(FE-SEM)画像は、均一な表面を明らかにし、小さな粒子サイズ分布を有します。 ZnOの薄膜はまた、透過率を測定するために同じパラメータの下でガラス基板上に合成されています。
紫外線(UV)光検出器用途のために、櫛型白金(Pt)薄膜(厚さ約100 nm)は、従来の光リソグラフィプロセスを介して製造され、無線周波数(RF)マグネトロンスパッタリング。オーム接触を達成するために、デバイスは、10分間の急速熱アニーリング(RTA)システム450によって、O℃でアルゴン状況でアニールしました。体系的な測定の後に、電流-電圧(I - V)写真、暗電流の曲線および時間依存性の光電流応答の結果は、高Cγ軸ZnO薄膜は、適切な感知層であることを示し、良好な応答性と信頼性を示しました紫外線光検出器アプリケーション用。
概要
ZnOのは、そのようなRTと大きな励起子で高い化学的安定性、低コスト、非毒性、光ポンピングのための低電力しきい値、広い直接バンドギャップ(3.37 eV)でなど、そのユニークな特性のために有望なワイドバンドギャップ機能半導体材料であります〜60 meVで1-2の結合エネルギー。近年、酸化亜鉛薄膜は、透明導電性酸化物(TCO)フィルム、青色発光素子、電界効果トランジスタ、及びガスセンサ3-6を含む多くの応用分野において使用されています。その一方で、ZnOは、インジウムとスズの希少かつ高価であるために、インジウムスズ酸化物(ITO)を置換する候補物質です。さらに、ZnOは、可視波長領域とITO膜7-8と比べて低抵抗で高い光透過率を有しています。したがって、ZnOを製造、特性評価およびアプリケーションは広く報告されています。この本研究では、簡単なANにより高い C -軸(0002)のZnO薄膜を合成することに焦点を当てて効果的方法とUV光検出器に向けて実用化dは。
最近の研究レポートの所見は、高品質のZnO薄膜は、ゾル-ゲル法、高周波マグネトロンスパッタリング、有機金属化学気相成長(MOCVD)などの様々な技術によって、など9-14で合成することができることを示しています。それぞれの技術は、その利点と欠点があります。例えば、スパッタ成膜の主な利点は、非常に高い融点を有するそのターゲット材料が楽基板上にスパッタリングされています。対照的に、スパッタリング法は、フィルムを構成するためのリフトオフと結合することは困難です。我々の研究では、プラズマ強化化学蒸着(PECVD)システムは、高品質のC -軸のZnO薄膜を合成するために使用しました。プラズマ衝撃は、薄膜の密度を増加させ、イオンの分解反応速度を高めることができる15の合成工程における重要な要因です。におけるまた、高い成長速度および大面積の均一な堆積は、PECVD法のための他の特徴的な利点です。
合成技術を除いて、基板上の良好な接着性は、別の問題であると認めて。 ZnOとサファイアは同じ六方格子構造を有しているので、多くの研究では、Cの -planeサファイアが広く高 Cγ軸のZnO薄膜を合成するための基質として使用されてきました。しかし、酸化亜鉛は、粗い表面形態及び面内方向16に配向したZnO と C -planeサファイア(18%)の間の大きな格子ミスフィットに起因する高い残留(欠陥に関連する)のキャリア濃度を示すサファイア基板上に合成しました。サファイア基板に比べて、Siウエハは、ZnOの合成のための他の広く使用されている基板です。 Siウエハが広く、半導体産業で使用されてきました。したがって、Si基板上に高品質のZnO薄膜の成長は非常に重要であるとnecesSARY。残念なことに、ZnOとSiの結晶構造および熱膨張係数は、結晶品質の劣化につながる明らかに異なっています。過去10年間、多大な努力は、ZnOバッファ層17、種々のガス雰囲気18中のアニーリング、及びSi基板の表面19の不動態化を含む様々な方法を用いて、Si基板上へのZnO薄膜の品質を改善するためになされています。本研究は、成功した任意のバッファ層または前処理することなく、Si基板上に高 C -軸ZnO薄膜を合成するための簡単かつ効果的方法を提供します。実験結果は、最適な成長温度の下で合成されたZnO薄膜は良好な結晶および光学的特性を示したことが示されました。結晶構造、RFプラズマ組成、表面形態、及びZnO薄膜の光学特性は、X線回折(XRD)、光学発光分光法(OES)、電界放出SCにより調べましたそれぞれの電子顕微鏡(FE-SEM)、及びRTのフォトルミネッセンス(PL)スペクトルをアニング。また、酸化亜鉛薄膜の透過率も確認及び報告されました。
合成されたZnO薄膜は、UV光検出器用途のための感知層はまた、本研究で検討したように機能しました。 UV光検出器は、UV監視、光スイッチ、火炎警報、およびミサイル加温システム20-21に大きな潜在的な用途があります。このようなオーミックコンタクトとショットキーコンタクトを含む正の固有負(PIN)モードおよび金属 - 半導体 - 金属(MSM)構造として実施された光検出器の多くの種類があります。各タイプは、それ自身の利点と欠点を有します。現在、MSM光検出器構造は、その優れた応答性、信頼性、応答性能と回復時間22〜24に集中的な関心を集めています。ここに示す結果はMSMオーミック接触モードを使用したことを示していますZnO薄膜ベースのUV光検出器を作製しました。光検出器のような種類は、典型的には、 高い Cγ軸ZnO薄膜は、UV光検出器に適した検出層であることを示し、良好な応答性と信頼性を明らかにする。
プロトコル
1。基板の準備とクリーニング
- Siの(100)ウエハから10ミリメートル×10ミリメートルのシリコン基板をカットします。
- 10ミリメートル×10ミリメートルのガラス基板をカットします。
- 15分間イソプロパノール次いで、10分間アセトンでシリコンとガラス基板を洗浄するために超音波洗浄器を使用して10分間アルコール、および。
- 脱イオン(DI)水で3回の基板を洗浄します。
- ブロー乾燥窒素銃で基板を。
2. DEZnを調製および保存
注:また、DEZnを呼ばジエチル亜鉛(C 2 H 5)2 Znが、二つのエチル基に結合した亜鉛の中心から成る高度に発火性有機亜鉛化合物です。 DEZnをを使用しているとき人で作業しないでください。 DEZnを非常に毒性であり、酸素や水分に敏感であり、水の近くDEZnをを配置しないようにしてください。常に防護マスク、目の保護具を着用。すべての手順は、フード内で実行する必要があります。最も重要なのは、未使用のDEZnをaがb必要がありますeは5 O Cの環境下に保存されています。
注意:DEZnを最初に使用するために、手順2に従っていない場合は、ステップ3から実験を開始します。
- ボトルから30ミリリットルDEZnをを引き出した後、鋼シリンダー内に置かビーカーに注入するために注射器を使用してください。
- 反応室でボンベを接続するための亜鉛メッキ鉄パイプを使用してください。
- (6トール)真空環境における鋼製シリンダーをポンプダウンする機械式ポンプとボールバルブを使用してください。
注:DEZnを深刻な酸素と反応し、それが真空環境中に維持されなければなりません。 - 5°Cの環境で使用されていないDEZnを保管してください。
3. PECVD室の準備とZnO薄膜の合成
注:プラズマ化学気相成長法の概略図を図1に示されています。
- 30ミリメートルで、シャワーヘッド電極と試料台との間の作動距離を設定します。 適切な場所に反応室の試料ステージに基板を配置します。
- ロータリーポンプを開いて、徐々にゲートバルブ、バタフライバルブを開きます。
- 反応室の背景圧力は30ミリトールより低くなるまで待ちます。
- ゲートバルブ、バタフライバルブを閉じて、ロータリーポンプに接続します。
- その後、3×10 -6 Torrの高真空に到達するために、ターボポンプと相対ゲートバルブを開きます。
- 必要な真空状態に達した後、熱コントローラを開き、(異なる実験パラメータ200、300、400、500、600 O C)合成温度に試料ステージを加熱します。
- 温度と圧力が必要な状態に到達すると、ターボポンプを閉じ、同時にロータリーポンプに接続するゲートバルブやバタフライバルブを開きます。
- 次に、ガス入口バルブを開き、アルゴングラムをオン同時にフローコントローラとして。
- チャンバ内にアルゴンガス(0.167ミリリットル/秒)で流れます。
- 500ミリトールのチャンバ圧力を設定します。
- RF(13.56MHzの)発電機とのマッチングネットワークをオンにし、その後、サンプルを15分間表面パージするため、100WのRFパワーを設定します。
- サンプルのパージを終えた後、70 WにダウンRF電力をオン
- 次に、二酸化炭素ガス制御装置及びガス入口バルブをオン。
- チャンバ内に二酸化炭素(0.5ミリリットル/秒)で流れます。
- 6トールで作動圧を設定します。
- チャンバ圧力は6トルに達した後、同時にDEZnをに接続されたチャンバと開放ボール弁にジエチル亜鉛(DEZnを)を搬送するためのキャリアガスとして高純アルゴン(0.167ミリリットル/秒)で流れます。同時に、ZnO膜の合成を開始します。
- 5分間のZnO膜のプラズマ合成を継続します。
- ZnO膜が合成された後、順次は、RF発生器、ボールバルブ、熱詐欺をオフにしますコントローラと、ガス入口弁と一緒にガス流量コントローラのすべて。
- 試料ステージの温度が室温まで冷却すると、サンプルを取り出してください。注:冷却速度は約1.8 O℃/分です。
合成されたZnO薄膜上にインターデジット状パターンの4準備
注:リソグラフィプロセスの概略を図3に示されています。
- 10分間150°Cの時のように合成したZnOサンプルを焼くためにホットプレートを使用してください。
- スピンコーターの上にサンプルを配置し、その後のZnO試料に100μlのフォトレジストの溶液(S1813)を分注します。
- 10秒間800rpmでスピンコーターを実行してから、均一に薄膜を生成するために30秒間3000rpmでに加速します。
- ソフトベーク90秒間105 O CでフォトレジストでコーティングされたZnO系サンプル。
- ソフトベークした後、フォトレジストコーティングされたサンプルトゥルを露出させるためにUV光を使用しマスクアライナによりフォトマスクをGH。露光時間は2秒であり、電力は400 Wです。
注意:フォトマスクのパターンがある幅広の0.03ミリメートルと長い4ミリメートル(14ペア)および図2に示すように0.15ミリメートルの電極間の間隔を有し、互いにかみ合っ-などの設計されたそれは注目に値すること総感光面積は、検出器のための84.32ミリメートル2です。 - 露光手順の後、ピンセットで試料をクリップし、その後希釈現像液に浸す35の開発のサンプルを取得するために左右に振る行動から(現像液の50 mlの脱イオン水150mlを混合)。
- DI水を用いて開発されたサンプルを洗浄し、窒素ガスで乾燥しました。
- 無傷のパターンを確認するために、光学顕微鏡を使用してください。ない場合は、フォトレジストを除去するためにアセトンを使用し、完全なパターンが得られるまで繰り返して、4.7に4.2を繰り返します。
- ハード20分間120°Cのでサンプルを焼きます。
5。 Ptの上部電極とケミカルリフトオフの堆積
- 化学リフトオフ手順に進む前に開発されたサンプルの上に薄い導電性のPt層(100 nm)を堆積させるために、RFマグネトロンスパッタ装置を使用してください。
- 13ミリメートルで、ターゲットと基板との間の距離を設定します。
- 5ミリトールの低真空に到達するために機械式ポンプを使用してください。
- その後、7×10 -7 Torrの高真空を得るために、ターボポンプを使用しています。
- チャンバーは高真空になるまで待って、ターボポンプを閉じて、その後、機械式ポンプを開きます。
- チャンバ圧力は、100ミリトールの作動圧力に達するまでMAS流量コントローラによってチャンバに0.3ミリリットル/秒でアルゴンガスを流します。
- 電源を放電し、25分間試料上にPt薄膜電極をスパッタリングするために15 WのDC電力を設定直流(DC)電源をオンにします。
- Pt電極層は、マグネトロンsputtによって堆積された後方法をering、チャンバーから試料を取り出します。
- フォトレジストを除去するために超音波洗浄器による化学リフトオフアセトン液にサンプルを浸し。
- 徹底的にフォトレジストを除去するために1分で洗浄時間を設定し、ZnO薄膜上に櫛型状のPt電極を得ます。
6. RTA処理
- RTAシステムにとして製作のPt / ZnOのサンプルを置きます。
- 20ミリトールにRTAチャンバの圧力をポンプダウンする機械式ポンプとゲートバルブを使用してください。
- チャンバ圧力は20ミリトールに到達するまで、チャンバ内に0.3ミリリットル/秒でアルゴンガスを流入し、5トルの作動圧を設定待ちます。
- 次に、100°C / minと加熱速度を設定します。
- その後、10分間450 O Cでサンプルをアニール。
- アニールした後、サンプルを室温に冷却するまで、サンプルを取り出して待ちます。
結果
高いcは a軸配向性を有する酸化亜鉛(0002)薄膜が正常PECVD装置を用いてSi基板上に合成されています。二酸化炭素(CO 2)及びジエチル亜鉛(DEZnを)は、それぞれ、酸素や亜鉛の前駆体として使用しました。酸化亜鉛薄膜の結晶構造は、ZnO薄膜が最も強い(0002)回折ピーク400 O Cで合成したことを示す、X線回折(図4)によって特徴付けました。合成温度は500 O Cまで増加するとき、(0002)回折ピークは、(10-10)回折ピークの出現に伴って弱くなりました。合成温度は600℃でOに設定されている場合には特に、すべてのZnOの回折ピークが消えます- その場 OESは、ZnO合成処理 ( 図5)の間にプラズマ化学組成を監視するために使用しました。結果は、亜鉛、O 2 と一酸化炭素(CO)酸化亜鉛の合成が生じたときに発光ピークが検出されました。 FE-SEM像は、ZnO薄膜が異なる合成温度(図6A-E)を有する異なる表面形態を示すことを明らかにする。均質な表面および小さな粒度分布ではC. oを 300及び400で得られました酸化亜鉛薄膜の光学特性は、PL スペクトル ( 図7)によって決定しました。結果は、ZnO薄膜が強いNBE発光を示す300と400 O Cで無視できるのDL放射 を用いて合成することを示します。 C. oを 600と300の温度が増加するにつれて短波長に加えて、NBE発光シフト透過率測定は、200、300及び400 O Cで合成したZnO薄膜の平均可視光透過率80%以上(図8A-B)との良好な透明性を有することを示しています。興味深いことに、透過率が減少しましたdramat合成温度は500℃。の過剰まで増加したとき的には
ZnO薄膜とPt櫛形電極と組み合わせたUV光検出器の性能が検討されています。特徴から、光検出器の電流は、明らかにその暗条件下で(図9)と比較して、光照射下で増強されました。また、 私ことが観察された- V曲線が対称である、ZnO薄膜とPt電極との間にMSMオーミック接触行動を反映しています。光検出器の時間依存性の光電流応答がオフとUV光(38ミリワット/ cm 2)で、5Vのバイアスで5回(図10)をオンにして測定しました。

プラズマ化学気相Dの模式図を図1epositionシステム。 この図の拡大版をご覧になるにはこちらをクリックしてください。

図2.白金櫛形電極と組み合わせたZnO系紫外線光検出器の模式図。 この図の拡大版をご覧になるにはこちらをクリックしてください。

シリコン基板上に合成されたZnO膜上に作製したPt櫛形電極のためのリソグラフィ・プロセスの図3のフロー・チャート。工程(A)は、150°C ので合成されたZnO薄膜を焼くためにホットプレートを使用しています 10分間、表面の水分を除去します。 工程(B)をスピンコートZnO薄膜上へのフォトレジスト。 90の過剰のフォトレジスト溶剤を除去するためのソフトステップ(C)は、105 O CでフォトレジストでコーティングされたZnOサンプルを焼きます。ステップ(D)は 2S用のフォトマスクを介してUV光を露光します。ステップ(E)は、フォトレジストを除去するために、開発者を使用しています。ステップ(F)は、次のハードRFマグネトロンスパッタリングを調製するための、より耐久性のある保護層を作るために20分間120°Cの時のサンプルを焼きます。工程(G)が開発され、試料上に薄いPt層を堆積させるために、RFマグネトロンスパッタ法を用いています。ステップ(H)は、リフトオフするために、サンプルを、アセトンを使用しています。 この図の拡大版をご覧になるにはこちらをクリックしてください。
_upload / 53097 / 53097fig4.jpg "/>
別の合成温度で合成したZnO薄膜については、図4のX線回折パターンは、200から600までの範囲であったO C. X線はCuのKα線(λ= 1.54 オングストローム )によって放出されました。走査角度が80 O 30 Oから設定し、ステップサイズは0.01 Oをしたとステップ当たりの時間は0.15秒でした。 ZnOの(10-10)回折ピークが31.59 Oに位置しているのに対し、ZnOの(0002)回折ピークは、34.24 Oに配置されています。他の回折ピークは、基板信号から来る。 この図の拡大版をご覧になるにはこちらをクリックしてください。

図5。 で- 400 O Cで合成されたZnO薄膜中のRFプラズマのためのその場 OESスペクトルデータは、参照28からのCO種とし て決定されているnmの449、517および559に位置するピーク信号を確認しました。 466、471および482 nmでのピーク位置信号は、亜鉛種とし て決定され、634 nmでのO 2種とし て決定されます。 325と430nmの間の範囲にあり、複雑な信号は、DEZnを分解種として決定されます。監視対象時間は7秒であった。 この図の拡大版をご覧になるにはこちらをクリックしてください。

異なる合成temperatuで合成たZnO薄膜の図6.プレーンビューSEM像 (A)200(B)300(C)400(D)500、および(E)600 O Cを含む解像度、それぞれ。 この図の拡大版をご覧になるにはこちらをクリックしてください。

別の合成温度で合成されたZnO薄膜の図7 RT PLスペクトルは、200から600までの範囲であったO C.ザPL測定は、100%のレーザパワー効率の下で325 nmでのHe-Cdレーザを用いました。露光時間は10秒でした。検出範囲は325から750ナノメートルであった。 この図の拡大版をご覧になるにはこちらをクリックしてください。
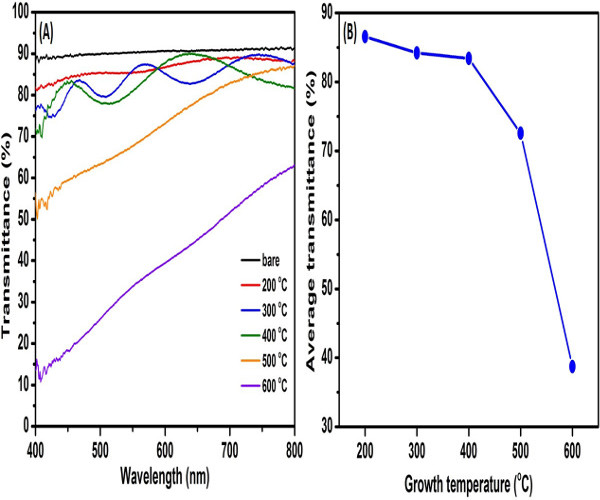
図8.異なる合成温度で合成したZnO薄膜の光透過スペクトル 800 nmの400から測定(A)一般的な光透過スペクトル。 (B)合成温度の関数としての平均透過率の値が。 この図の拡大版をご覧になるにはこちらをクリックしてください。
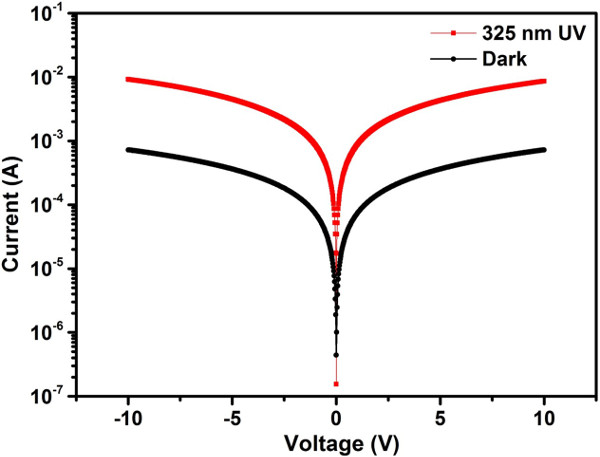
図9. 私 - 。製作ZnO薄膜系紫外線光検出器のV特性の測定は、(電力38ミリワット/ cm 2の(赤い曲線)の密度と暗状態で325nmの紫外光照射下にありました黒色の曲線)、および精巣は10 Vに-10 Vからバイアス電圧であった。この図の拡大版をご覧になるにはこちらをクリックしてください。

図のUV検出器をベースとZnO薄膜のための10時間依存光電流応答。測定はの両方のターンUV光(38ミリワット/ cm 2)を下に5 Vのバイアスでオン/オフの円切り替える回す5回にわたって実施されました紫外線の-onとターンオフ時間は10秒であった。 この図の拡大版をご覧になるにはこちらをクリックしてください。
ディスカッション
重要なステップや修正
ステップ1では、基板は完全に洗浄し、1.3〜1.5は、基板にはグリースや有機及び無機の汚染がないことを確認するために、続いて、ステップする必要があります。基板表面上の油脂、又は有機及び無機の汚染を大幅に膜の密着性が低下します。
ステップ2は、ZnO膜の製造工程の前に最も重要な手順です。 DEZnを、非常に毒性があり、水と激しく反応し、簡単に空気と接触すると発火します。 DEZnを非常に慎重に鋼製シリンダー内に噴射した後、すぐに6トルまでポンプダウンする必要があります。ステップ3では、少しでも異なる設定が異なる結果につながるため、各実験パラメータとステップが正確に完了したことを確認してください。
ステップ4は、リソグラフィの実験室および非UV光照射及びdを回避するためにクリーンルーム内で行わなければなりませんUST-pollutionor粒子汚染の影響。ステップ5において、DC放電用電源の電力を徐々に上昇させるべきです。それ以外の場合はPtターゲットが破壊されます。ステップ6において、試料は、試料が均一に加熱することができることを保証するために、RTAチャンバの中央に配置されるべきです。
データ分析
合成温度は、高品質のCを合成するための重要なパラメータである熱膨張係数とZnO薄膜とSi基板との間の界面エネルギーと熱的不整合歪みの効果が顕著に結晶配向に影響を与えることができるので、ZnO薄膜をγ軸。これは、明らかにXRDパターン(図4)から観察することができます。最強のZnO(0002)回折ピークは、温度がPECVD法によりSi基板上にCγ軸ZnO薄膜を合成するための最適な合成の温度であることを示し、400 O Cで得られました。さらに増加に伴い500°Cのまでの合成温度で、ZnO結晶品質の劣化につながります。合成温度は600℃。に設定したときまた、ZnO薄膜はアモルファス相に変換これは、十分に高い温度( すなわち、400 O C)が安定したサイトを見つけるために分子の能力を高め、高い結晶品質を有するZnO薄膜が得られ、十分なエネルギーを与えることができると仮定することができます。同時に、欠員、格子間、及びZnO中の転位などの一般的な欠陥も低減されています。過度の高温( すなわち、500と600 O C)が25を用いた場合しかし、ZnOはZn及びO 2分子に分解します。また、酸化亜鉛(6.7×10 -6 K -1)26薄膜とSiとの間の異なる熱膨張係数(4.18×10 -6 K -1)、900 Kで27基板が熱的不整合strをもたらします界面エネルギーとAIN効果。上記の現象は、多結晶またはアモルファス相が得られ、ZnO薄膜の結晶品質を劣化させる可能性があります。
ZnOの合成プロセスの間にプラズマ化学組成を監視するため、 内 - RFプラズマのインサイチュ OESスペクトル分析(図5)を行いました。 OES分析結果は、三強いZnの発光ピークが約475nmの登場し、他の別個の発光ピークは、O 2とCOの信号28のように決定したことが示されています。また、325と430 nmの間の範囲にあり、いくつかの複雑な発光ピークがDEZnを分解種として決定されます。合成プロセス中のプラズマ化学組成のその場監視-上記の有益な情報は、OESが中のために有用な道具であることを示しています。
酸化亜鉛薄膜の表面形態は、FE-SEMで観察しました<強い>(図6A-E)。これは、ZnOは密に球状の粒子でかつ小さい粒径分布を詰め300,400 入出力 Cショーで合成することが分かります。その合成された状態と比較すると、他のZnO薄膜は、多結晶またはアモルファス相を示唆し、無秩序と不規則な表面を示します。これは、SEM画像は、前のXRDの結果と一致していることは注目に値します。
光学特性は、325nmでのHe-Cdレーザを用いてRT PLスペクトルを測定しました。 PL測定(図7)から、すべてのZnO薄膜は、励起子-励起子衝突過程29を介して自由励起子の再結合に起因しているの周りに375ナノメートルに位置強いNBE発光ピークを示します。同時に合成温度を200に設定したとき、周りの575 nmの位置幅広い欠陥関連のDLの発光ピークが得られ、500℃。また、NBE発光をブルーシフトを有することが見出され増加合成温度で、より短い波長へ。一般に、DLの発光は、酸素空孔と格子間亜鉛30としてのZnO相中の不純物との様々な構造的欠陥と呼ばれ、ブルーシフトが原因ZnO薄膜31に強い残留異方性株です。したがって、PL結果は、合成された温度がかなりのZnO薄膜の光学的性質に影響を与えることができることを反映しています。すべてのZnO試料のうち、300で合成し、400 oが高い(0002)XRD回折ピークを伴う支配NBE発光ピークと無視できるDLの発光を示しC 2つだけのサンプル。
全合成のZnO薄膜の透明度は、透過スペクトル(図8A)と、算出されたそれぞれのZnOサンプルの平均透過率値(図8B)によって測定しました。 ZnOのサンプルの平均透過率値は、200で300合成しますND全可視領域での400°Cの約80%であるが、500と600°Cので合成した試料は、特に600℃で合成されたOたZnO試料について、比較的低い透過率を示します高い温度で合成されたZnOサンプルの減少透過率の理由は、今までまだ不明です。しかしながら、高いCは透明度の高い優先配向のZnOは文字は将来の高透過率のZnOベースの光電子デバイスに使用することができることを示す、得られたγ軸。
ZnOの位相は一般環境中の酸素分子を吸着し、UV照明下で酸素分子を脱着することができるので、UV光検出器として使用することができます。大きく減少につながる、表面近傍の空乏層を生じる、酸素分子は、ZnOの伝導帯[ - - →O 2 O 2 + E]から自由電子を捕捉することによって酸化亜鉛表面に吸着することができZnOの導電率。酸化亜鉛は、酸化亜鉛( 例えば、UV光)のバンドギャップよりも多くの光子エネルギーによって照射されたとき、電子-正孔対が生成され、[Hʋ→E - + さ h +]。電子-正孔対から、これらのキャリアは、表面に向かって移動し、吸着した酸素分子を中和する、[H + + O 2 - →O 2]。中和酸素分子が簡単著しく導電率の増加を作るのZnOの表面を形成する脱着することができます。従って、この理論によれば、 高い C -軸ZnO薄膜は、UV検出器を製造するために検出層として使用しました。で、UV光照射と時間依存性の光電流応答(図9、図10)ことなく、V曲線 -作製したPt / ZnOの光検出器のUV検出特性は、Iを測定することによって調査し、確認しました。明らかな対称動作は、Oかもしれませんbserved、RTAにより450 O℃でアルゴン中でポストアニールした後に高品質のオーミックコンタクトは、Pt / ZnOの界面において達成されたことを示します。 測定されたIによると- V曲線 、暗電流は、約0.36ミリアンペアと光電流は、UV照射さと暗状態との間の電流の差を示す、5 Vで約4.3ミリアンペアです。紫外線光検出器の性能は、その応答と回復時間に依存して重要であるため、時間依存性の光電流応答が実装されました。反応時間は、通常、最大光電流の90%に接近する時間として定義され、回復時間は、最大光電流の10%に減衰する時間です。時間依存性の光電流応答測定から、応答および回復時間は、それぞれ、約3,9秒です。さらに、UV光は、信頼性を試験するために5回オンとオフしました。上記の測定によると、ZnO系紫外線光検出器は、高速を示しています応答および商業UV光検出器用途のための潜在的な開発に使用することができ、高い信頼性、。
要約すると、この本研究は、合成温度の微調整とのPECVDによりSi基板上に高 C -軸優先配向ZnO薄膜を合成する方法を提供します。最適なC -軸ZnO薄膜は、可視光に結晶構造、光学特性、および透明性の面で競争力のある機能的な特性を示す400°Cので合成しました。オーミック接触とPtの櫛形電極と組み合わせたZnO系紫外線光検出器は5 VのバイアスでUV光(38 mWのセンチ-2)の下で、高速応答性と高い信頼性を発揮するこの本研究では、両方の研究に貴重な方向とアプリケーションの可能性業界。
PECVD技術の潜在的な利点と欠点
プラズマ増強CHEMiCalの蒸着(PECVD)は、基板上に固体状態に蒸気状態から薄膜を合成するために使用されている有用な技術です。プラズマは一般に、通常、通常、それぞれ、下部電極として使用される上部電極と試料台として使用されるシャワーヘッド電極との間にDCまたはRF電源によって発信されます。これら二つの電極の間の空間は、反応ガスの化学反応が充填されています。試料の結晶配向性組成物は、合成条件及び反応物前駆体の比に依存します。例えば、DEZnを及びCO 2の前駆体は、それぞれ、酸化亜鉛に薄膜を合成するために、亜鉛と酸素の供給源を提供するために使用されたように。明らかに、プラズマは、この技術の主な特徴です。プラズマを介して効果的に基板表面に拡散支援、イオン化された反応体原子又は分子を高め、その後、容易に高密度configuratioを形成するために、隣接イオン化原子又は分子と反応N薄膜。その結果、全てのサンプルは、合成プロセス中のエネルギッシュなイオン衝撃に暴露することができます。
プラズマ反応が連続合成プロセス中に発生されるため、PECVD法の主な利点は、(a)より低い合成温度を、ほぼすべてのサンプルは、(100から450 O Cに )低温で合成することができる、(b)は、高アスペクト比の条件が利用可能である(使用高密度プラズマ場合)、(c)は、高堆積速度、最適化されたガス供給と(d)のRF動力シャワーヘッドは、均一なプラズマ処理、(e)は、良好な薄膜表面の均一性、及び(f)の化学物質を提供します組成構造を細かく制御することができます。
しかし、PECVD法は、化学反応および高密度プラズマ衝撃を伴い、それはいくつかの制限および欠点を有します。全体のプロセスは、化学的及び微粒子汚染、必要な慎重かつ適切な取り扱いを大量に生成されます。ハイ純粋なガスは、この技術で必要とされるので、溶液中で処理することができるようDEZnをのような特定の前駆体の制限。ソースは、揮発性前駆体を調製するために、いくつかの溶媒に溶解する能力を持たない場合、キャリアガスは、合成を行うためにチャンバ内に試薬ガスを提供しないであろう。高密度プラズマ衝撃は、薄膜の均一性および品質を向上させることができるが、また、高い残留応力が薄膜の破壊をもたらす作成されます。また、この技術は、従来の化学蒸着(CVD)と比較してコストが少し高くをもたらす余分なDCまたはRF電力供給システムを必要とします。
今後の方向性と応用
そのような作動圧力、ガス組成、ガス流量、RF電力、反応物前駆体などのような多くのプロセスパラメータは、すべてのPECVD法で薄膜を合成するための相互依存しています。唯一の合成温度の変化が検討されていますこれは、研究を発表しました。さらにこの技術の限界や能力を調査するために必要な作業の多くは、依然として存在します。例えば、ガス組成物は、薄膜の化学量論比を変化させる可能性があり、使用圧力は、多様な薄膜構造をもたらすイオン化ガスの平均自由行程に影響を与える可能性があります。そのため、今後の課題は、上記のパラメーターによって結晶品質やプロパティを操作する方法をさらに理解するために必要になります。
PECVD技術は広く、通常、低い処理温度を必要とする半導体を薄膜の合成の製造に使用されています。 PECVD法が許可され、柔軟なデバイスのアプリケーションにおいて用いることができるポリマー基板上に薄膜を合成するために使用されてきました。低温用途に加えて、我々は既にHIGで使用することができる合成温度を増加させることによって非極性ZnO薄膜を作製しました時間効率の発光ダイオード(LED)または環境センサー技術。
開示事項
The authors declare that they have no competing financial interests.
謝辞
この作品は、財政的に科学技術省と中国の共和国の国立科学評議会のサポートされていた(契約番号NSC 101から2221-E-027から042と101から2622 NSC-E-027から003-CC2)。 DH魏のおかげで博士Shechtman賞国立台北科技大学(台北TECH) 賞。
資料
| Name | Company | Catalog Number | Comments |
| RF power supply | ADVANCED ENERGY | RFX-600 | |
| Butterfly valve | MKS | 253B-1-40-1 | |
| Mass flow controller | PROTEC INSTRUMENTS | PC-540 | |
| Pressure controller | MKS | 600 series | |
| Heater | UPGRADE INSTRUMENT CO. | UI-TC 3001 | |
| Sputter gun | AJA INTERNATIONAL | A320-HA | |
| DEZn 1.5M | ACROS ORGANIC USA, New Jersey | also called Diethylzinc (C2H5)2Zn | |
| Spin coater | SWIENCO | PW - 490 | |
| I-V measurement | Keithley | Model: 2400 | |
| Photocondutive measurement | Home-built | ||
| UV light sourse | Panasonic | ANUJ 6160 | |
| Mask aligner | Karl Suss | MJB4 | |
| Photoresist | Shipley a Rohm & Haas company | S1813 | |
| Developer | Shipley a Rohm & Haas company | MF319 | |
| Silicon wafer | E-Light Technology Inc | 12/0801 | |
| Glass substrate | CORNING | 1737 | P-type / Boron |
参考文献
- Choppali, U., Kougianos, E., Mohanty, S. P., Gorman, B. P. Influence of annealing on polymeric derived ZnO thin films on sapphire. Thin Solid Films. 545, 466-470 (2013).
- Bedia, F. Z., et al. Effect of tin doping on optical properties of nanostructured ZnO thin films grown by spray pyrolysis technique. J. Alloy. Compd. 616, 312-318 (2014).
- Liu, W. S., Wu, S. Y., Hung, C. Y., Tseng, C. H., Chang, Y. L. Improving the optoelectronic properties of gallium ZnO transparent conductive thin films through titanium doping. J. Alloy. Compd. 616, 268-274 (2014).
- Baik, K. H., Kim, H., Kim, J., Jung, S., Jang, S. Nonpolar light emitting diode with sharp near-ultraviolet emissions using hydrothermally grown ZnO on p-GaN. Appl. Phys. Lett. 103, 091107(2013).
- Han, S. J., Huang, W., Shi, W., Yu, J. S. Performance improvement of organic field-effect transistor ammonia gas sensor using ZnO/PMMA hybrid as dielectric layer. Sens Actuator B-Chem. 203, 9-16 (2014).
- Chizhov, A. S., et al. Visible light activated room temperature gas sensors based on nanocrystalline ZnO sensitized with CdSe quantum dots. Sens Actuator B-Chem. 205, 305-312 (2014).
- Li, C., et al. Effects of substrate on the structural, electric and optical properties of Al-doped ZnO films prepared by radio frequency magnetron sputtering. Thin Solid Films. 517, 3265-3268 (2009).
- Ellmer, K. Resistivity of polycrystalline zinc oxide films: current status and physical limit. J. Phys. D: Appl. Phys. 34, 3097(2001).
- Wang, F. G., et al. optical and electrical properties of Hf-doped ZnO transparent conducting films prepared by sol-gel method. J. Alloy. Compd. 623, 290-297 (2015).
- Senay, V., et al. ZnO thin film synthesis by reactive radio frequency magnetron sputtering. Appl. Surf. Sci. 318, 2-5 (2014).
- Chi, P. W., Su, C. W., Jhuo, B. H., Wei, D. H. Photoirradiation caused controllable wettability switching of sputtered highly aligned c-axis-oriented zinc oxide columnar films. Int. J. Photoenergy. 2014, 765209(2014).
- Jamal, R. K., Hameed, M. A., Adem, K. A. Optical properties of nanostructured ZnO prepared by a pulsed laser deposition technique. Mater. Lett. 132, 31-33 (2014).
- Kobayashi, T., Nakada, T. Effects of post-deposition on transparent conductingZnO:B thin films grown by MOCVD. Jpn. J. Appl. Phys. 53, 05FA03(2014).
- Chao, C. H., et al. Postannealing effect at various gas ambients on ohmic contacts of Pt/ZnO nanobilayers toward ultraviolet photodetectors. Int. J. Photoenergy. 2013, 372869-1155 (2013).
- Barankin, M. D., Gonzalez II, E., Ladwig, A. M., Hicks, R. F. Plasma-enhanced chemical vapor deposition of zinc oxide at atmospheric pressure and low temperature. 91, 924-930 (2007).
- Fons, P., et al. Uniaxial locked epitaxy of ZnO on the α face of sapphire. Appl. Phys. Lett. 77, 1801(2000).
- Ko, H. J., Chen, Y., Hong, S. K., Yao, T. akafumi MBE growth of high-quality ZnO films on epi-GaN. J. Cryst. Growth. 209, 816-821 (2000).
- Park, D. J., Lee, J. Y., Park, T. E., Kim, Y. Y., Cho, H. K. Improved microstructural properties of a ZnO thin film using a buffer layer in-situ annealed in argon ambient. Thin Solid Films. 515, 6721-6725 (2000).
- Kim, M. S., et al. Nitrogen-passivation effects of Si substrates on the properties of ZnO epitaxial layers grown by using plasma-assisted molecular beam epitaxy. J. Korean Phys. Soc. 56, 827-831 (2010).
- Li, G. M., Zhang, J. W., Hou, X. Temperature dependence of performance of ZnO-based metal-semiconductor-metal ultraviolet photodetectors. Sens. Actuator A-Phys. 209, 149-153 (2014).
- Wang, X. F., et al. superhigh gain visible-blind UV detector and optical logic gates based on nonpolar a-axial GaN nanowire. Nanoscale. 6, 12009-12017 (2014).
- Inamdar, S. I., Rajpure, K. Y. High-performance metal-semiconductor-metal UV photodetector based on spray deposited ZnO thin films. J. Alloy. Compd. 595, 55-59 (2014).
- Tian, C. G., et al. Effects of continuous annealing on the performance of ZnO based metal-semiconductor-metal ultraviolet photodetectors. Mater. Sci. Eng. B-Adv. Funct.Solid-State Mater. 184, 67-71 (2014).
- Chen, H. Y., et al. Realization of a self-powered ZnO MSM UV photodetector with high responsivity using an asymmetric pair of Au electrodes. J. Mater. Chem. C. 2, 9689-9694 (2014).
- Subramanyam, T. K., Srinivasulu Naidu,, S,, Uthanna, S. Effect of substrate temperature on the physical properties of DC reactive magnetron sputtered ZnO films. Opt. Mater. 13, 239-247 (1999).
- Iwanaga, H., Kunishige, A., Takeuchi, S. Anisotropic thermal expansion in wurtzite-type crystals. J. Mater. Sci. 35, 2451-2454 (2000).
- Okaji, M. Absolute thermal expansion measurements of single-crystal silicon in the range 300-1300 K with an interferometric dilatometer. Int. J. Thermophys. 9, 1101-1109 (1988).
- Pearse, R. W. B., Lichtenberg, A. J. The identification of molecular spectra. , 4th ed, Chapman and Hall. (1976).
- Chao, C. H., Wei, D. H. Growth of non-polar ZnO thin films with different working pressures by plasma enhanced chemical vapor deposition. Jpn. J. Appl. Phys. 53, 11RA05(2014).
- Lin, B., Fu, Z., Green Jia, Y. luminescent center in undoped zinc oxide films deposited on silicon substrate. Appl. Phys. Lett. 79, 943-945 (2001).
- Koida, T., et al. Radiative and nonradiative excitonic transitions in nonpolar (110) and polar (000) and (0001) ZnO epilayers. Appl. Phys. Lett. 84 (110), 1079(2004).
転載および許可
このJoVE論文のテキスト又は図を再利用するための許可を申請します
許可を申請さらに記事を探す
This article has been published
Video Coming Soon
Copyright © 2023 MyJoVE Corporation. All rights reserved
当社はcookieを使用しています。
「続行」をクリックすることで、当社のcookieへの同意となります。
